- 3.2Impact Factor
- 6.4CiteScore
- 16 daysTime to First Decision
Electronic Packaging Materials and Technology Applications
This special issue belongs to the section “Electronic Materials“.
Special Issue Information
Dear Colleagues,
In light of the escalating demand for advanced electronic devices, the domains of 2.5D/3DIC packaging, power device packaging, and low-temperature application packaging have acquired significant attention. These packaging techniques find application in cutting-edge electronic products such as smart devices, electric vehicles, solar energy converters, 5G equipment, and flexible electronics. Consequently, the development of packaging materials, processes, and applications holds critical importance in addressing human well-being, energy concerns, advanced communication equipment, and biomedical products.
We hereby introduce a Special Issue on "Electronic Packaging Materials and Technology Applications". Our collection contains a wide spectrum of research issues, including electronic packaging, solder joint, twinned Cu film, transient liquid phase bonding, metal-metal direct bonding, 3DIC interconnection, power device packaging, low-temperature alloys, materials characterization, and reliability issues—all relevant to advanced packaging technology. We eagerly anticipate the support and contributions of experts in these fields.
Dr. Yu-An Shen
Prof. Dr. Chih-Ming Chen
Guest Editors
Manuscript Submission Information
Manuscripts should be submitted online at www.mdpi.com by registering and logging in to this website. Once you are registered, click here to go to the submission form. Manuscripts can be submitted until the deadline. All submissions that pass pre-check are peer-reviewed. Accepted papers will be published continuously in the journal (as soon as accepted) and will be listed together on the special issue website. Research articles, review articles as well as short communications are invited. For planned papers, a title and short abstract (about 250 words) can be sent to the Editorial Office for assessment.
Submitted manuscripts should not have been published previously, nor be under consideration for publication elsewhere (except conference proceedings papers). All manuscripts are thoroughly refereed through a single-blind peer-review process. A guide for authors and other relevant information for submission of manuscripts is available on the Instructions for Authors page. Materials is an international peer-reviewed open access semimonthly journal published by MDPI.
Please visit the Instructions for Authors page before submitting a manuscript. The Article Processing Charge (APC) for publication in this open access journal is 2600 CHF (Swiss Francs). Submitted papers should be well formatted and use good English. Authors may use MDPI's English editing service prior to publication or during author revisions.
Keywords
- packaging process
- 2.5D/3DIC packaging
- power electronic packaging
- low-temperature application packaging
- packaging materials
- solder joint
- electroplated film for electronic packaging
- transient liquid phase bonding
- metal&ndash
- metal direct bonding
- reliability analysis in electronic packaging
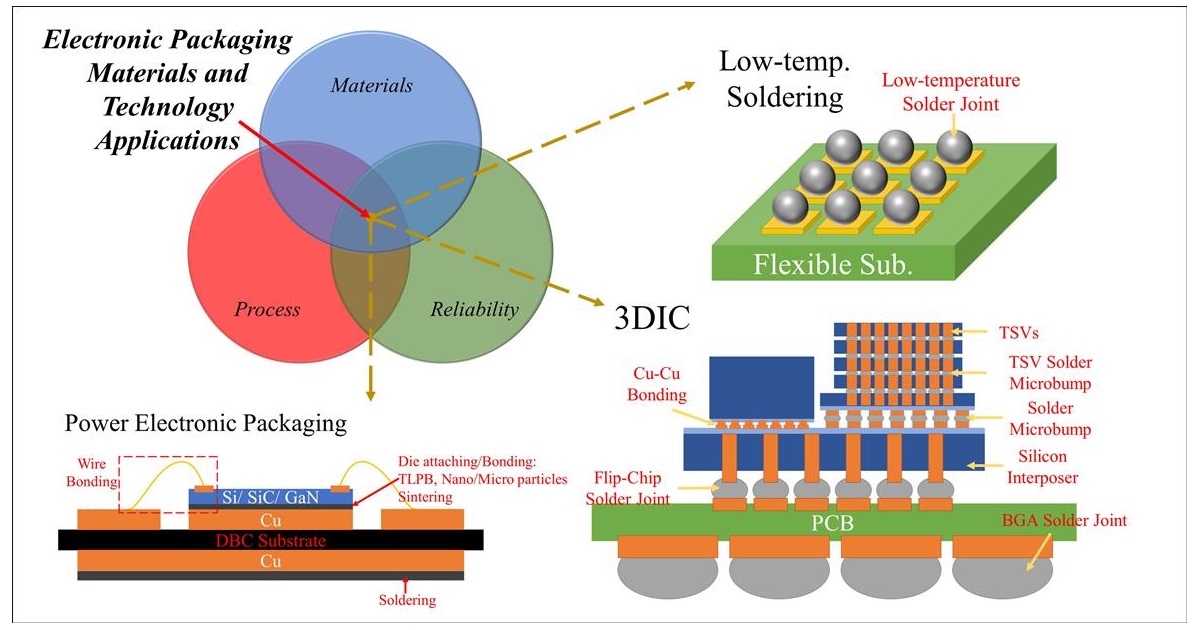
Benefits of Publishing in a Special Issue
- Ease of navigation: Grouping papers by topic helps scholars navigate broad scope journals more efficiently.
- Greater discoverability: Special Issues support the reach and impact of scientific research. Articles in Special Issues are more discoverable and cited more frequently.
- Expansion of research network: Special Issues facilitate connections among authors, fostering scientific collaborations.
- External promotion: Articles in Special Issues are often promoted through the journal's social media, increasing their visibility.
- e-Book format: Special Issues with more than 10 articles can be published as dedicated e-books, ensuring wide and rapid dissemination.

