A Comparative Study on the Degradation Behaviors of Ferroelectric Gate GaN HEMT with PZT and PZT/Al2O3 Gate Stacks
Abstract
1. Introduction
2. Device Design and Fabrication
3. Device Performance and Discussion
4. Conclusions
Author Contributions
Funding
Data Availability Statement
Conflicts of Interest
References
- Mishra, U.K.; Shen, L.; Kazior, T.E.; Wu, Y.F. GaN-based RF power devices and amplifiers. Proc. IEEE 2008, 96, 287–305. [Google Scholar] [CrossRef]
- Mishra, U.K.; Parikh, P.; Wu, Y.F. AlGaN/GaN HEMTs—An overview of device operation and applications. IEEE Electron Device Lett. 2012, 90, 1022–1031. [Google Scholar] [CrossRef]
- Saito, W.; Takada, Y.; Kuraguchi, M.; Tsuda, K.; Omura, I. Recessed-gate structure approach toward normally off high-voltage AlGaN/GaN HEMT for power electronics applications. IEEE Trans. Electron Devices 2006, 53, 356–362. [Google Scholar] [CrossRef]
- Pengelly, R.S.; Wood, S.M.; Milligan, J.W.; Sheppard, S.T.; Pribble, W.L. A review of GaN on SiC high electron-mobility power transistors and MMICs. IEEE Trans. Microw. Theory Tech. 2012, 60, 1764–1783. [Google Scholar] [CrossRef]
- Hao, Y.; Yang, L.; Ma, X.; Ma, J.; Cao, M.; Pan, C.; Wang, C.; Zhang, J. High-Performance Microwave Gate-Recessed AlGaN/AlN/GaN MOS-HEMT with 73% Power-Added Efficiency. IEEE Electron Device Lett. 2011, 32, 626–628. [Google Scholar] [CrossRef]
- Yu, Q.; Shi, C.; Yang, L.; Lu, H.; Zhang, M.; Wu, M.; Hou, B.; Jia, F.; Guo, F.; Ma, X.; et al. High Current and Linearity AlGaN/GaN/-Graded-AlGaN:Si-doped/GaN Heterostructure for Low Voltage Power Amplifier Application. IEEE Electron Device Lett. 2023, 44, 582–585. [Google Scholar] [CrossRef]
- Zhang, M.; Ma, X.-H.; Yang, L.; Mi, M.; Hou, B.; He, Y.; Wu, S.; Lu, Y.; Zhang, H.-S.; Zhu, Q.; et al. Influence of Fin Configuration on the Characteristics of AlGaN/GaN Fin-HEMTs. IEEE Trans. Electron Devices 2018, 65, 1745–1752. [Google Scholar] [CrossRef]
- Chen, K.J.; Häberlen, O.; Lidow, A.; Tsai, C.L.; Ueda, T.; Uemoto, Y.; Wu, Y.-F. GaN-on-Si Power Technology: Devices and Applications. IEEE Trans. Electron Devices 2017, 64, 779–795. [Google Scholar] [CrossRef]
- Zhang, M.; Chen, Y.; Guo, S.; Lu, H.; Zhu, Q.; Mi, M.; Wu, M.; Hou, B.; Yang, L.; Ma, X.; et al. Influence of Gate Geometry on the Characteristics of AlGaN/GaN Nanochannel HEMTs for HighLinearity Applications. Micromachines 2023, 14, 1513. [Google Scholar] [CrossRef] [PubMed]
- Hao, L.Z.; Zhu, J.; Liu, Y.J.; Liao, X.W.; Wang, S.L.; Zhou, J.J.; Kong, C.; Zeng, H.Z.; Zhang, Y.; Zhang, W.L.; et al. Normally-off characteristics of LiNbO3/AlGaN/GaN ferroelectric field-effect transistor. Thin Solid Film. 2012, 520, 6313–6317. [Google Scholar] [CrossRef]
- Lee, C.-T.; Yang, C.-L.; Tseng, C.-Y.; Chang, J.-H.; Horng, R.-H. GaN-Based Enhancement-Mode Metal-Oxide-Semiconductor High Electron Mobility Transistors Using LiNbO3 Ferroelectric Insulator on Gate-Recessed Structure. IEEE Trans. Electron. Devices 2015, 62, 2481–2487. [Google Scholar] [CrossRef]
- Chen, L.; Ma, X.; Zhu, J.; Hou, B.; Song, F.; Zhu, Q.; Zhang, M.; Yang, L.; Hao, Y. Polarization Engineering in PZT/AlGaN/GaN High-Electron-Mobility Transistors. IEEE Trans. Electron Devices 2018, 65, 3149–3155. [Google Scholar] [CrossRef]
- Li, L.; Liao, Z.; Gauquelin, N.; Nguyen, M.; Hueting, R.; Gravesteijn, D.; Lobato, I.; Houwman, E.; Lazar, S.; Verbeeck, J.; et al. Epitaxial Stress-Free Growth of High Crystallinity Ferroelectric PbZr0.52Ti0.48O3 on GaN/AlGaN/Si(111) Substrate. Adv. Mater. Interfaces 2018, 5, 1700921. [Google Scholar] [CrossRef]
- Stolichnov, I.; Malin, L.; Muralt, P.; Setter, N. Ferroelectric Gate for control of transport properties of two-dimensional electron gas at AlGaN/GaN heterostructures. Appl. Phys. Lett. 2006, 88, 043512. [Google Scholar] [CrossRef]
- Zhang, K.; Wu, M.; Lei, X.; Chen, W.; Zheng, X.; Ma, X.; Hao, Y. Observation of threshold voltage instabilities in AlGaN/GaN MIS HEMTs. Semicond. Sci. Technol. 2014, 29, 075019. [Google Scholar] [CrossRef]
- Lagger, P.; Ostermaier, C.; Pobegen, G.; Pogany, D. Towards understanding the origin of threshold voltage instability of AlGaN/GaN MIS-HEMTs. In Proceedings of the 2012 International Electron Devices Meeting, San Francisco, CA, USA, 10–13 December 2012; pp. 13.1.1–13.1.4. [Google Scholar] [CrossRef]
- Liu, S.-C.; Chen, B.-Y.; Lin, Y.-C.; Hsieh, T.-E.; Wang, H.-C.; Chang, E.Y. GaN MIS-HEMTs With Nitrogen Passivation for Power Device Applications. IEEE Electron Device Lett. 2014, 35, 1001–1003. [Google Scholar] [CrossRef]
- Lu, B.; Matioli, E.; Palacios, T. Tri-Gate Normally-Off GaN Power MISFET. IEEE Electron Device Lett. 2012, 33, 360–362. [Google Scholar] [CrossRef]
- Müller, J.; Polakowski, P.; Müller, S.; Mulaosmanovic, H.; Ocker, J.; Mikolajick, T.; Slesazeck, S.; Müller, S.; Ocker, J.; Mikolajick, T.; et al. High endurance strategies for hafnium oxide based ferroelectric field effect transistor. In Proceedings of the 2016 16th Non-Volatile Memory Technology Symposium (NVMTS), Pittsburgh, PA, USA, 17–19 October 2016; pp. 1–7. [Google Scholar] [CrossRef]

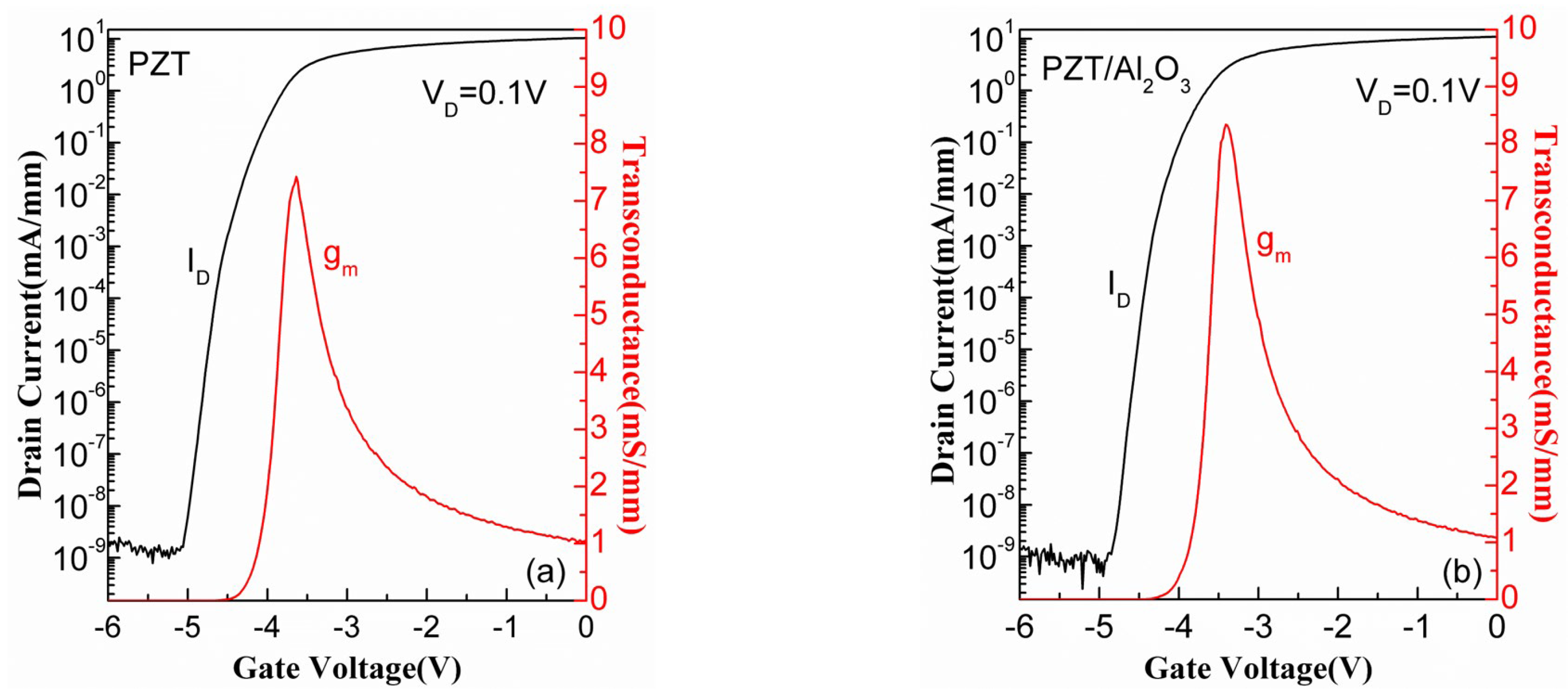


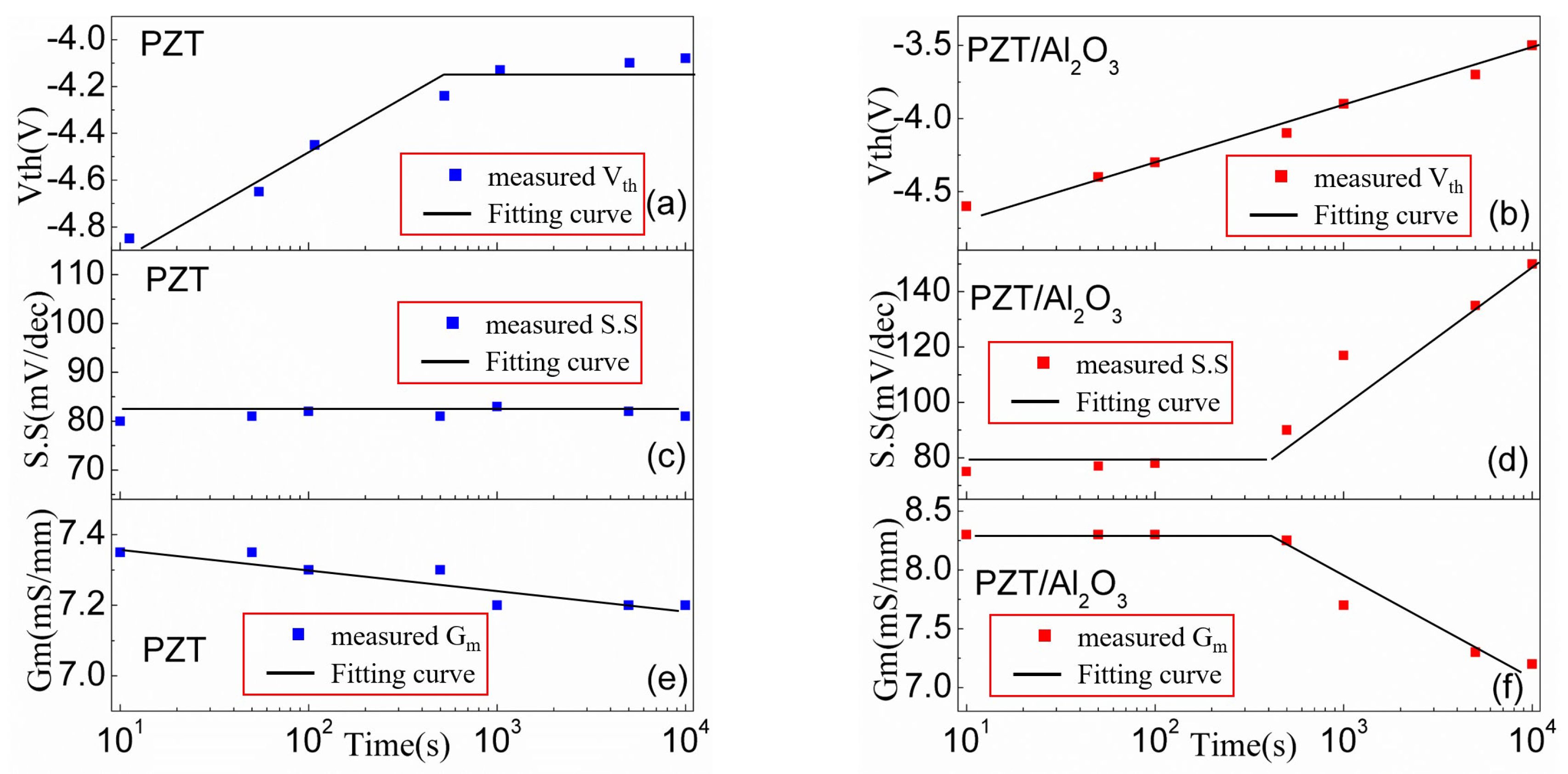
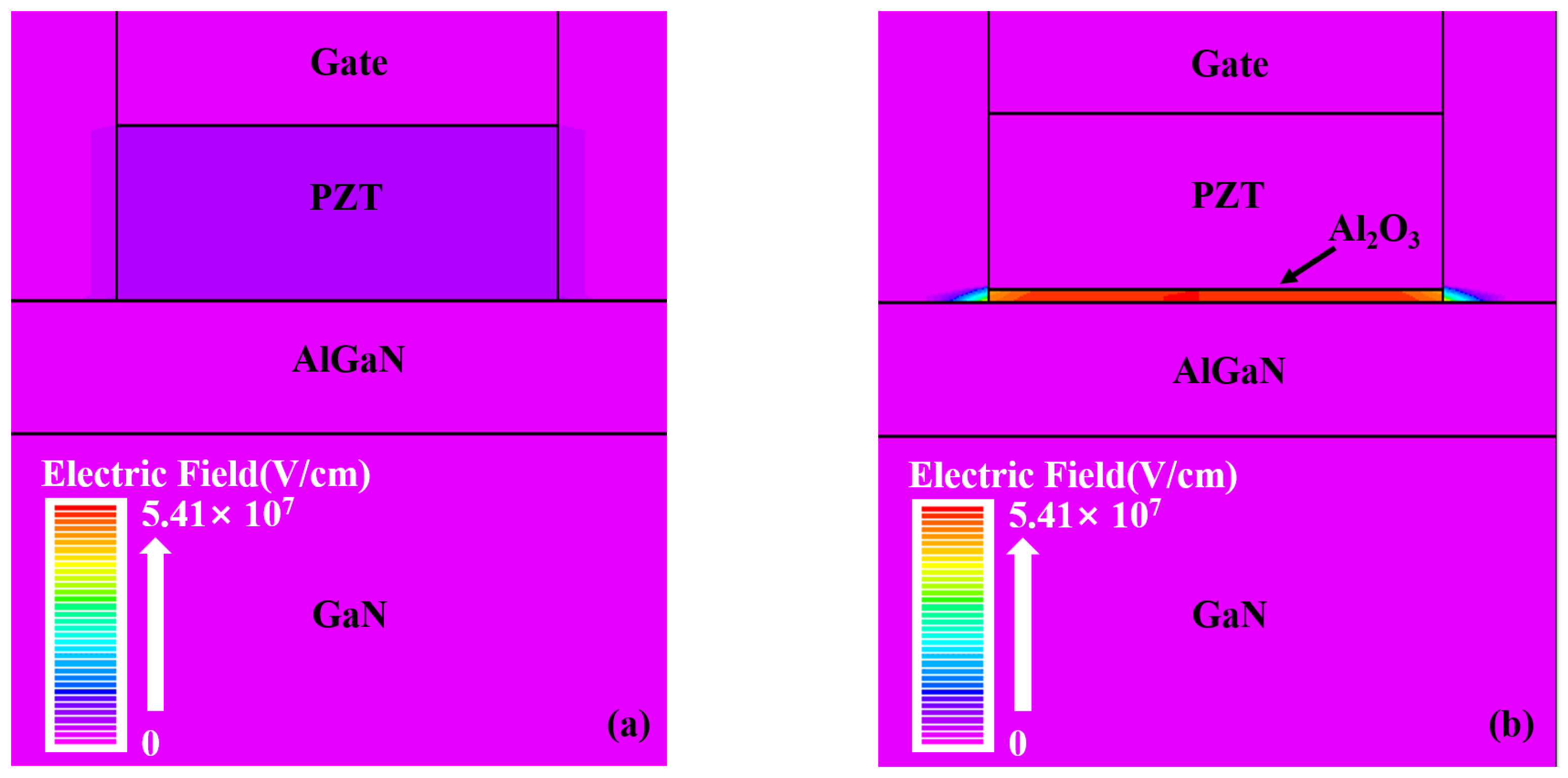
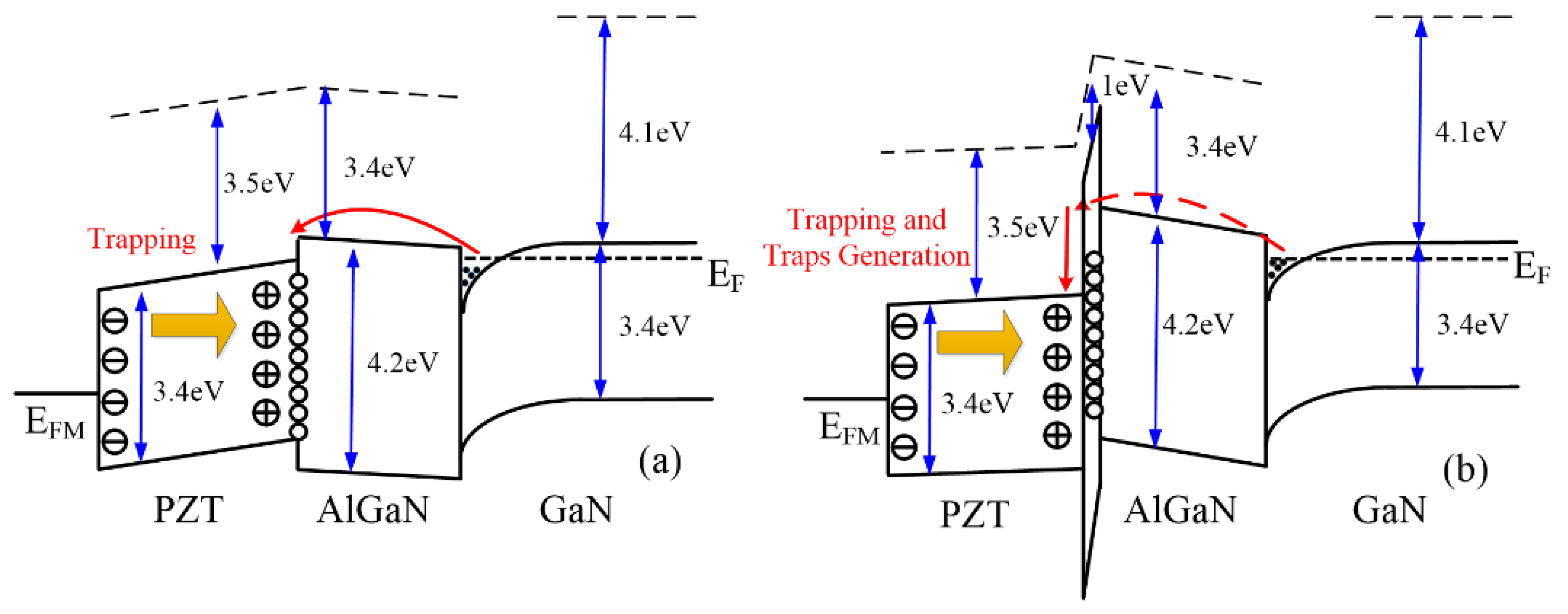
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2024 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Chen, L.; Lu, Z.; Fu, C.; Bi, Z.; Que, M.; Sun, J.; Sun, Y. A Comparative Study on the Degradation Behaviors of Ferroelectric Gate GaN HEMT with PZT and PZT/Al2O3 Gate Stacks. Micromachines 2024, 15, 101. https://doi.org/10.3390/mi15010101
Chen L, Lu Z, Fu C, Bi Z, Que M, Sun J, Sun Y. A Comparative Study on the Degradation Behaviors of Ferroelectric Gate GaN HEMT with PZT and PZT/Al2O3 Gate Stacks. Micromachines. 2024; 15(1):101. https://doi.org/10.3390/mi15010101
Chicago/Turabian StyleChen, Lixiang, Zhiqi Lu, Chaowei Fu, Ziqiang Bi, Miaoling Que, Jiawei Sun, and Yunfei Sun. 2024. "A Comparative Study on the Degradation Behaviors of Ferroelectric Gate GaN HEMT with PZT and PZT/Al2O3 Gate Stacks" Micromachines 15, no. 1: 101. https://doi.org/10.3390/mi15010101
APA StyleChen, L., Lu, Z., Fu, C., Bi, Z., Que, M., Sun, J., & Sun, Y. (2024). A Comparative Study on the Degradation Behaviors of Ferroelectric Gate GaN HEMT with PZT and PZT/Al2O3 Gate Stacks. Micromachines, 15(1), 101. https://doi.org/10.3390/mi15010101





