Metal-Assisted Catalytic Etching (MACE) for Nanofabrication of Semiconductor Powders
Abstract
:1. Introduction
2. Mechanistic Aspects of MACE
- Etching can be either local or remote.
- Local etching results in the formation of etch track pores that have a width and shape determined by the size and shape of the metal deposit.
- Remote etching generates tortuous pores analogous to ReEtching.
- The space charge layers (SCL) around metal nanoparticles interact with one another, which facilitates co-operative etching.
- The efficacy of hole injection at the metal/semiconductor interface depends on the elemental composition of the metal, semiconductor doping, and the temperature.
- The balance between remote and local etching can be controlled by metal nanoparticle size, metal nanoparticle density, elemental composition of the metal, semiconductor doping, and temperature; therefore, these parameters are used to control the pore size distribution as well as whether the walls of etch track pores are solid or porous.
3. Materials and Methods
4. Results of Powder Etching
5. Conclusions and Perspectives
6. Patents
Author Contributions
Funding
Conflicts of Interest
References
- Chemla, M.; Homma, T.; Bertagna, V.; Erre, R.; Kubo, N.; Osaka, T. Survey of the metal nucleation processes on silicon surfaces in fluoride solutions: From dilute HF to concentrated NH4F solutions. J. Electroanal. Chem. 2003, 559, 111–123. [Google Scholar] [CrossRef]
- Ogata, Y.H.; Kobayashi, K.; Motoyama, M. Electrochemical Metal Deposition on Silicon. Curr. Opin. Solid State Mater. Sci. 2006, 10, 163–172. [Google Scholar] [CrossRef]
- Carraro, C.; Maboudian, R.; Magagnin, L. Metallization and nanostructuring of semiconductor surfaces by galvanic displacement processes. Surf. Sci. Rep. 2007, 62, 499–525. [Google Scholar] [CrossRef]
- Schonekerl, S.; Acker, J. The Role of the Molecular Hydrogen Formation in the Process of Metal-Ion Reduction on Multicrystalline Silicon in a Hydrofluoric Acid Matrix. Nanomaterials 2021, 11, 982. [Google Scholar] [CrossRef] [PubMed]
- Schönekerl, S.; Acker, J. The Kinetics and Stoichiometry of Metal Cation Reduction on Multi-Crystalline Silicon in a Dilute Hydrofluoric Acid Matrix. Nanomaterials 2020, 10, 2545. [Google Scholar] [CrossRef]
- Kolasinski, K.W. Surface Science: Foundations of Catalysis and Nanoscience, 4th ed.; Wiley: Chichester, UK, 2019. [Google Scholar]
- Kolasinski, K.W.; Barclay, W.B.; Sun, Y.; Aindow, M. The stoichiometry of metal assisted etching of Si in V2O5 + HF and HOOH + HF solutions. Electrochim. Acta 2015, 158, 219–228. [Google Scholar] [CrossRef]
- Yae, S.; Morii, Y.; Fukumuro, N.; Matsuda, H. Catalytic activity of noble metals for metal-assisted chemical etching of silicon. Nanoscale Res. Lett. 2012, 7, 352. [Google Scholar] [CrossRef] [Green Version]
- Smith, Z.R.; Smith, R.L.; Collins, S.D. Mechanism of nanowire formation in metal assisted chemical etching. Electrochim. Acta 2013, 92, 139–147. [Google Scholar] [CrossRef]
- Hu, Y.; Peng, K.-Q.; Qiao, Z.; Huang, X.; Zhang, F.-Q.; Sun, R.-N.; Meng, X.-M.; Lee, S.-T. Metal-Catalyzed Electroless Etching of Silicon in Aerated HF/H2O Vapor for Facile Fabrication of Silicon Nanostructures. Nano Lett. 2014, 14, 4212–4219. [Google Scholar] [CrossRef]
- Liu, L.; Peng, K.Q.; Hu, Y.; Wu, X.L.; Lee, S.T. Fabrication of Silicon Nanowire Arrays by Macroscopic Galvanic Cell-Driven Metal Catalyzed Electroless Etching in Aerated HF Solution. Adv. Mater. 2014, 26, 1410–1413. [Google Scholar] [CrossRef]
- Hu, Y.; Peng, K.Q.; Liu, L.; Qiao, Z.; Huang, X.; Wu, X.L.; Meng, X.M.; Lee, S.T. Continuous-flow Mass Production of Silicon Nanowires via Substrate-Enhanced Metal-Catalyzed Electroless Etching of Silicon with Dissolved Oxygen as an Oxidant. Sci. Rep. 2014, 4. [Google Scholar] [CrossRef]
- Huo, C.; Wang, J.; Fu, H.; Li, X.; Yang, Y.; Wang, H.; Mateen, A.; Farid, G.; Peng, K.-Q. Metal-Assisted Chemical Etching of Silicon in Oxidizing HF Solutions: Origin, Mechanism, Development, and Black Silicon Solar Cell Application. Adv. Funct. Mater. 2020, 30, 2005744. [Google Scholar] [CrossRef]
- Li, X.; Bohn, P.W. Metal-assisted chemical etching in HF/H2O2 produces porous silicon. Appl. Phys. Lett. 2000, 77, 2572–2574. [Google Scholar] [CrossRef]
- Kolasinski, K.W. Porous Silicon Formation by Galvanic Etching. In Handbook of Porous Silicon, 2nd ed.; Canham, L.T., Ed.; Springer: Berlin, Germany, 2014; pp. 23–33. [Google Scholar]
- Ashruf, C.M.A.; French, P.J.; Bressers, P.M.M.C.; Kelly, J.J. Galvanic porous silicon formation without external contacts. Sens. Actuators A 1999, 74, 118–122. [Google Scholar] [CrossRef]
- Ashruf, C.M.A.; French, P.J.; Bressers, P.M.M.C.; Sarro, P.M.; Kelly, J.J. A new contactless electrochemical etch-stop based on a gold/silicon/TMAH galvanic cell. Sens. Actuators A 1998, 66, 284–291. [Google Scholar] [CrossRef]
- Peng, K.-Q.; Yan, Y.-J.; Gao, S.-P.; Zhu, J. Synthesis of large-area silicon nanowire arrays via self-assembling nanoelectrochemistry. Adv. Mater. 2002, 14, 1164–1167. [Google Scholar] [CrossRef]
- Tsujino, K.; Matsumura, M. Helical nanoholes bored in silicon by wet chemical etching using platinum nanoparticles as catalyst. Electrochem. Solid State Lett. 2005, 8, C193–C195. [Google Scholar] [CrossRef]
- Sharstniou, A.; Niauzorau, S.; Ferreira, P.M.; Azeredo, B.P. Electrochemical nanoimprinting of silicon. Proc. Natl. Acad. Sci. USA 2019, 116, 10264–10269. [Google Scholar] [CrossRef] [Green Version]
- Azeredo, B.P.; Lin, Y.-W.; Avagyan, A.; Sivaguru, M.; Hsu, K.; Ferreira, P. Direct Imprinting of Porous Silicon via Metal-Assisted Chemical Etching. Adv. Funct. Mater. 2015, 26, 2929–2939. [Google Scholar] [CrossRef]
- Bastide, S.; Torralba, E.; Halbwax, M.; Le Gall, S.; Mpogui, E.; Cachet-Vivier, C.; Magnin, V.; Harari, J.; Yarekha, D.; Vilcot, J.-P. 3D Patterning of Si by Contact Etching With Nanoporous Metals. Front. Chem. 2019, 7. [Google Scholar] [CrossRef]
- Sugita, T.; Lee, C.-L.; Ikeda, S.; Matsumura, M. Formation of Through-Holes in Si Wafers by Using Anodically Polarized Needle Electrodes in HF Solution. ACS Appl. Mater. Interfaces 2011, 3, 2417–2424. [Google Scholar] [CrossRef]
- Peng, K.-Q.; Zhang, M.L.; Lu, A.J.; Wong, N.B.; Zhang, R.Q.; Lee, S.T. Ordered silicon nanowire arrays via nanosphere lithography and metal-induced etching. Appl. Phys. Lett. 2007, 90, 163123. [Google Scholar] [CrossRef]
- Huang, Z.; Fang, H.; Zhu, J. Fabrication of Silicon Nanowire Arrays with Controlled Diameter, Length, and Density. Adv. Mater. 2007, 19, 744–748. [Google Scholar] [CrossRef]
- Deckman, H.W.; Dunsmuir, J.H. Natural lithography. Appl. Phys. Lett. 1982, 41, 377–379. [Google Scholar] [CrossRef]
- Hulteen, J.C.; Vanduyne, R.P. Nanosphere Lithography—A Materials General Fabrication Process for Periodic Particle Array Surfaces. J. Vac. Sci. Technol. A 1995, 13, 1553–1558. [Google Scholar] [CrossRef]
- Yang, S.M.; Jang, S.G.; Choi, D.G.; Kim, S.; Yu, H.K. Nanomachining by colloidal lithography. Small 2006, 2, 458–475. [Google Scholar] [CrossRef]
- Cheung, H.Y.; Lin, H.; Xiu, F.; Wang, F.Y.; Yip, S.; Ho, J.C.; Wong, C.Y. Mechanistic Characteristics of Metal-Assisted Chemical Etching in GaAs. J. Phys. Chem. C 2014, 118, 6903–6908. [Google Scholar] [CrossRef]
- Fredriksson, H.; Alaverdyan, Y.; Dmitriev, A.; Langhammer, C.; Sutherland, D.S.; Zaech, M.; Kasemo, B. Hole-mask colloidal lithography. Adv. Mater. 2007, 19, 4297–4302. [Google Scholar] [CrossRef]
- Lu, Y.; Xiong, H.; Jiang, X.; Xia, Y.; Prentiss, M.; Whitesides, G.M. Asymmetric Dimers Can Be Formed by Dewetting Half-Shells of Gold Deposited on the Surfaces of Spherical Oxide Colloids. J. Am. Chem. Soc. 2003, 125, 12724–12725. [Google Scholar] [CrossRef]
- Fenollosa, R.; Meseguer, F. Non-Close-Packed Artificial Opals. Adv. Mater. 2003, 15, 1282–1285. [Google Scholar] [CrossRef]
- Stafiniak, A.; Prażmowska, J.; Macherzyński, W.; Paszkiewicz, R. Nanostructuring of Si substrates by a metal-assisted chemical etching and dewetting process. RSC Adv. 2018, 8, 31224–31230. [Google Scholar] [CrossRef] [Green Version]
- Hwang, T.Y.; An, G.H.; Lim, J.H.; Myung, N.V.; Choa, Y.H. Morphology control of ordered Si nanowire arrays by nanosphere lithography and metal-assisted chemical etching. Jpn. J. Appl. Phys. 2014, 53, 05HA07. [Google Scholar] [CrossRef]
- Torralba, E.; Le Gall, S.; Lachaume, R.; Magnin, V.; Harari, J.; Halbwax, M.; Vilcot, J.-P.; Cachet-Vivier, C.; Bastide, S. Tunable Surface Structuration of Silicon by Metal Assisted Chemical Etching with Pt Nanoparticles under Electrochemical Bias. ACS Appl. Mater. Interfaces 2016, 8, 31375–31384. [Google Scholar] [CrossRef] [Green Version]
- Pinna, E.; Le Gall, S.; Torralba, E.; Mula, G.; Cachet-Vivier, C.; Bastide, S. Mesopore Formation and Silicon Surface Nanostructuration by Metal-Assisted Chemical Etching With Silver Nanoparticles. Front. Chem. 2020, 8. [Google Scholar] [CrossRef]
- Huang, Z.; Geyer, N.; Werner, P.; de Boor, J.; Gösele, U. Metal-Assisted Chemical Etching of Silicon: A Review. Adv. Mater. 2011, 23, 285–308. [Google Scholar] [CrossRef] [PubMed]
- Toor, F.; Miller, J.B.; Davidson, L.M.; Nichols, L.; Duan, W.; Jura, M.P.; Yim, J.; Forziati, J.; Black, M.R. Nanostructured silicon via metal assisted catalyzed etch (MACE): Chemistry fundamentals and pattern engineering. Nanotechnology 2016, 27, 412003. [Google Scholar] [CrossRef]
- Li, X.L. Metal assisted chemical etching for high aspect ratio nanostructures: A review of characteristics and applications in photovoltaics. Curr. Opin. Solid State Mater. Sci. 2012, 16, 71–81. [Google Scholar] [CrossRef]
- Srivastava, R.P.; Khang, D.Y. Structuring of Si into Multiple Scales by Metal-Assisted Chemical Etching. Adv. Mater. 2021. [Google Scholar] [CrossRef]
- Ray, S.K.; Katiyar, A.K.; Raychaudhuri, A.K. One-dimensional Si/Ge nanowires and their heterostructures for multifunctional applications-a review. Nanotechnology 2017, 28. [Google Scholar] [CrossRef] [PubMed]
- Zhou, W.; Dai, X.; Lieber, C.M. Advances in nanowire bioelectronics. Rep. Prog. Phys. 2017, 80, 016701. [Google Scholar] [CrossRef]
- Kara, S.A.; Keffous, A.; Giovannozzi, A.M.; Rossi, A.M.; Cara, E.; D’Ortenzi, L.; Sparnacci, K.; Boarino, L.; Gabouze, N.; Soukane, S. Fabrication of flexible silicon nanowires by self-assembled metal assisted chemical etching for surface enhanced Raman spectroscopy. RSC Adv. 2016, 6, 93649–93659. [Google Scholar] [CrossRef]
- Balderas-Valadez, R.F.; Agarwal, V.; Pacholski, C. Fabrication of porous silicon-based optical sensors using metal-assisted chemical etching. RSC Adv. 2016, 6, 21430–21434. [Google Scholar] [CrossRef] [Green Version]
- Toor, F.; Oh, J.; Branz, H.M. Efficient nanostructured ‘black’ silicon solar cell by copper-catalyzed metal-assisted etching. Prog. Photovoltaics 2015, 23, 1375–1380. [Google Scholar] [CrossRef]
- Pei, Z.; Hu, H.; Li, S.; Ye, C. Fabrication of Orientation-Tunable Si Nanowires on Silicon Pyramids with Omnidirectional Light Absorption. Langmuir 2017, 33, 3569–3575. [Google Scholar] [CrossRef] [PubMed]
- Peng, K.-Q.; Xu, Y.; Wu, Y.; Yan, Y.; Lee, S.-T.; Zhu, J. Aligned single-crystal Si nanowire arrays for photovoltaic applications. Small 2005, 1, 1062–1067. [Google Scholar] [CrossRef] [PubMed]
- Gonchar, K.A.; Moiseev, D.V.; Bozhev, I.V.; Osminkina, L.A. Influence of H2O2 concentration on the structural and photoluminescent properties of porous silicon nanowires fabricated by metal-assisted chemical etching. Mater. Sci Semicond. Process. 2021, 125, 105644. [Google Scholar] [CrossRef]
- Georgobiani, V.A.; Gonchar, K.A.; Osminkina, L.A.; Timoshenko, V.Y. Structural and photoluminescent properties of nanowires formed by the metal-assisted chemical etching of monocrystalline silicon with different doping level. Semiconductors 2015, 49, 1025–1029. [Google Scholar] [CrossRef]
- Georgobiani, V.A.; Gonchar, K.A.; Zvereva, E.A.; Osminkina, L.A. Porous Silicon Nanowire Arrays for Reversible Optical Gas Sensing. Phys. Status Solidi 2018, 215, 1700565. [Google Scholar] [CrossRef]
- Xu, B.; Khouri, W.; Fobelets, K. Two-Sided Silicon Nanowire Array/Bulk Thermoelectric Power Generator. IEEE Electron. Device Lett. 2014, 35, 596–598. [Google Scholar] [CrossRef]
- Chan, C.K.; Peng, H.; Liu, G.; McIlwrath, K.; Zhang, X.F.; Huggins, R.A.; Cui, Y. High-performance lithium battery anodes using silicon nanowires. Nat. Nanotech. 2008, 3, 31–35. [Google Scholar] [CrossRef]
- McSweeney, W.; Geaney, H.; O’Dwyer, C. Metal-assisted chemical etching of silicon and the behavior of nanoscale silicon materials as Li-ion battery anodes. Nano Res. 2015, 8, 1395–1442. [Google Scholar] [CrossRef]
- Armstrong, M.J.; O’Dwyer, C.; Macklin, W.J.; Holmes, J.D. Evaluating the performance of nanostructured materials as lithium-ion battery electrodes. Nano Res. 2014, 7, 1–62. [Google Scholar] [CrossRef] [Green Version]
- Shin, H.C.; Corno, J.A.; Gole, J.L.; Liu, M.L. Porous silicon negative electrodes for rechargeable lithium batteries. J. Power Sources 2005, 139, 314–320. [Google Scholar] [CrossRef]
- Dai, F.; Yi, R.; Yang, H.; Zhao, Y.; Luo, L.; Gordin, M.L.; Sohn, H.; Chen, S.; Wang, C.; Zhang, S.; et al. Minimized Volume Expansion in Hierarchical Porous Silicon upon Lithiation. ACS Appl. Mater. Interfaces 2019, 11, 13257–13263. [Google Scholar] [CrossRef] [PubMed]
- Kolasinski, K.W. Photochemical and nonthermal chemical modification of porous silicon for biomedical applications. In Porous Silicon for Biomedical Applications; Santos, H., Ed.; Woodhead Publishing: London, UK, 2014; pp. 52–80. [Google Scholar]
- Dohnalová, K.; Gregorkiewicz, T.; Kůsová, K. Silicon quantum dots: Surface matters. J. Phys. Cond. Matter 2014, 26, 173201. [Google Scholar] [CrossRef] [PubMed]
- Jarvis, K.L.; Barnes, T.J.; Prestidge, C.A. Surface chemistry of porous silicon and implications for drug encapsulation and delivery applications. Adv. Colloid Interface Sci. 2012, 175, 25–38. [Google Scholar] [CrossRef]
- Li, Y.; Calder, S.; Yaffe, O.; Cahen, D.; Haick, H.; Kronik, L.; Zuilhof, H. Hybrids of Organic Molecules and Flat, Oxide-Free Silicon: High-Density Monolayers, Electronic Properties, and Functionalization. Langmuir 2012, 28, 9920–9929. [Google Scholar] [CrossRef]
- Peng, W.; Rupich, S.M.; Shafiq, N.; Gartstein, Y.N.; Malko, A.V.; Chabal, Y.J. Silicon Surface Modification and Characterization for Emergent Photovoltaic Applications Based on Energy Transfer. Chem. Rev. 2015, 115, 12764–12796. [Google Scholar] [CrossRef]
- Hochbaum, A.I.; Gargas, D.; Hwang, Y.J.; Yang, P. Single Crystalline Mesoporous Silicon Nanowires. Nano Lett. 2009, 9, 3550–3554. [Google Scholar] [CrossRef] [Green Version]
- Chiappini, C.; Martinez, J.O.; De Rosa, E.; Almeida, C.S.; Tasciotti, E.; Stevens, M.M. Biodegradable nanoneedles for localized delivery of nanoparticles in vivo: Exploring the biointerface. ACS Nano 2015, 9, 5500–5509. [Google Scholar] [CrossRef] [Green Version]
- Wang, J.; Hu, Y.; Zhao, H.; Fu, H.; Wang, Y.; Huo, C.; Peng, K.-Q. Oxidant Concentration Modulated Metal/Silicon Interface Electrical Field Mediates Metal-Assisted Chemical Etching of Silicon. Adv. Mater. Interfaces 2018, 5, 1801132. [Google Scholar] [CrossRef]
- Tamarov, K.; Swanson, J.D.; Unger, B.A.; Kolasinski, K.W.; Ernst, A.T.; Aindow, M.; Lehto, V.-P.; Riikonen, J. Controlling the nature of etched Si nanostructures: High versus low load metal-assisted catalytic etching (MACE) of Si powders. ACS Appl. Mater. Interfaces 2020, 12, 4787–4796. [Google Scholar] [CrossRef] [PubMed]
- Tamarov, K.; Kiviluoto, R.; Swanson, J.D.; Unger, B.A.; Ernst, A.T.; Aindow, M.; Riikonen, J.; Lehto, V.-P.; Kolasinski, K.W. Low-Load Metal-Assisted Catalytic Etching Produces Scalable Porosity in Si Powders. ACS Appl. Mater. Interfaces 2020, 12, 48969–48981. [Google Scholar] [CrossRef] [PubMed]
- Cao, M.W.; Song, X.Y.; Zhai, J.; Wang, J.B.; Wang, Y.L. Fabrication of highly antireflective silicon surfaces with superhydrophobicity. J. Phys. Chem. B 2006, 110, 13072–13075. [Google Scholar] [CrossRef] [PubMed]
- Alhmoud, H.; Brodoceanu, D.; Elnathan, R.; Kraus, T.; Voelcker, N.H. A MACEing silicon: Towards single-step etching of defined porous nanostructures for biomedicine. Prog. Mater. Sci. 2021, 116, 100636. [Google Scholar] [CrossRef]
- Peng, F.; Su, Y.; Wei, X.; Lu, Y.; Zhou, Y.; Zhong, Y.; Lee, S.-T.; He, Y. Silicon-Nanowire-Based Nanocarriers with Ultrahigh Drug-Loading Capacity for In Vitro and In Vivo Cancer Therapy. Angew. Chem. Int. Ed. Engl. 2013, 52, 1457–1461. [Google Scholar] [CrossRef]
- Kozlov, N.K.; Natashina, U.A.; Tamarov, K.P.; Gongalsky, M.B.; Solovyev, V.V.; Kudryavtsev, A.A.; Sivakov, V.; Osminkina, L.A. Recycling of silicon: From industrial waste to biocompatible nanoparticles for nanomedicine. Mater. Res. Express 2017, 4, 095026. [Google Scholar] [CrossRef] [Green Version]
- Yae, S.; Hirano, T.; Matsuda, T.; Fukumuro, N.; Matsuda, H. Metal nanorod production in silicon matrix by electroless process. Appl. Surf. Sci. 2009, 255, 4670–4672. [Google Scholar] [CrossRef]
- Kolasinski, K.W.; Unger, B.A.; Ernst, A.T.; Aindow, M. Crystallographically Determined Etching and Its Relevance to the Metal-Assisted Catalytic Etching (MACE) of Silicon Powders. Front. Chem. 2019, 6, 651. [Google Scholar] [CrossRef]
- Peng, K.-Q.; Lu, A.J.; Zhang, R.Q.; Lee, S.T. Motility of Metal Nanoparticles in Silicon and Induced Anisotropic Silicon Etching. Adv. Funct. Mater. 2008, 18, 3026–3035. [Google Scholar] [CrossRef]
- Kolasinski, K.W. Silicon nanostructures from electroless electrochemical etching. Curr. Opin. Solid State Mater. Sci. 2005, 9, 73–83. [Google Scholar] [CrossRef]
- Chiappini, C. MACE Silicon Nanostructures. In Handbook of Porous Silicon, 2nd ed.; Canham, L.T., Ed.; Springer: Berlin, Germay, 2014; pp. 171–186. [Google Scholar]
- Li, S.Y.; Ma, W.H.; Zhou, Y.; Chen, X.H.; Xiao, Y.Y.; Ma, M.Y.; Zhu, W.J.; Wei, F. Fabrication of porous silicon nanowires by MACE method in HF/H2O2/AgNO3 system at room temperature. Nanoscale Res. Lett. 2014, 9, 196. [Google Scholar] [CrossRef] [Green Version]
- Li, M.; Li, Y.; Liu, W.; Yue, L.; Li, R.; Luo, Y.; Trevor, M.; Jiang, B.; Bai, F.; Fu, P.; et al. Metal-assisted chemical etching for designable monocrystalline silicon nanostructure. Mater. Res. Bull. 2016, 76, 436–449. [Google Scholar] [CrossRef]
- Kolasinski, K.W. Porous Silicon Formation by Stain Etching. In Handbook of Porous Silicon, 2nd ed.; Canham, L.T., Ed.; Springer: Berlin, Germany, 2017; pp. 1–21. [Google Scholar]
- Kolasinski, K.W.; Gimbar, N.J.; Yu, H.; Aindow, M.; Mäkilä, E.; Salonen, J. Regenerative Electroless Etching of Silicon. Angew. Chem. Int. Ed. Engl. 2017, 56, 624–627. [Google Scholar] [CrossRef]
- Turner, D.R. On the mechanism of chemically etching germanium and silicon. J. Electrochem. Soc. 1960, 107, 810–816. [Google Scholar] [CrossRef]
- Acker, J.; Rietig, A.; Steinert, M.; Hoffmann, V. Mass and Electron Balance for the Oxidation of Silicon during the Wet Chemical Etching in HF/HNO3 Mixtures. J. Phys. Chem. C 2012, 116, 20380–20388. [Google Scholar] [CrossRef]
- Steinert, M.; Acker, J.; Wetzig, K. New Aspects on the Reduction of Nitric Acid during Wet Chemical Etching of Silicon in Concentrated HF/HNO3 Mixtures. J. Phys. Chem. C 2008, 112, 14139–14144. [Google Scholar] [CrossRef]
- Steinert, M.; Acker, J.; Oswald, S.; Wetzig, K. Study on the Mechanism of Silicon Etching in HNO3-Rich HF/HNO3 Mixtures. J. Phys. Chem. C 2007, 111, 2133–2140. [Google Scholar] [CrossRef]
- Hoffmann, V.; Steinert, M.; Acker, J. Analysis of gaseous reaction products of wet chemical silicon etching by conventional direct current glow discharge optical emission spectrometry (DC-GD-OES). J. Anal. At. Spectrom. 2011, 26, 1990–1996. [Google Scholar] [CrossRef]
- Kolasinski, K.W.; Gogola, J.W.; Barclay, W.B. A test of Marcus theory predictions for electroless etching of silicon. J. Phys. Chem. C 2012, 116, 21472–21481. [Google Scholar] [CrossRef]
- Dudley, M.E.; Kolasinski, K.W. Stain etching with Fe(III), V(V) and Ce(IV) to form microporous silicon. Electrochem. Solid State Lett. 2009, 12, D22–D26. [Google Scholar] [CrossRef]
- Lehmann, V.; Gösele, U. Porous silicon formation: A quantum wire effect. Appl. Phys. Lett. 1991, 58, 856–858. [Google Scholar] [CrossRef]
- Kolasinski, K.W. Charge Transfer and Nanostructure Formation During Electroless Etching of Silicon. J. Phys. Chem. C 2010, 114, 22098–22105. [Google Scholar] [CrossRef]
- Kolasinski, K.W.; Barclay, W.B. The Stoichiometry of Electroless Silicon Etching in Solutions of V2O5 and HF. Angew. Chem. Int. Ed. Engl. 2013, 52, 6731–6734. [Google Scholar] [CrossRef] [PubMed]
- Gondek, C.; Lippold, M.; Röver, I.; Bohmhammel, K.; Kroke, E. Etching Silicon with HF-H2O2-Based Mixtures: Reactivity Studies and Surface Investigations. J. Phys. Chem. C 2014, 118, 2044–2051. [Google Scholar] [CrossRef]
- Kolasinski, K.W. Electron transfer during metal-assisted and stain etching of silicon. Semicond. Sci. Technol. 2016, 31, 014002. [Google Scholar] [CrossRef] [Green Version]
- Kolasinski, K.W. The Mechanism of Metal-Assisted Etching. In Porous Silicon: From Formation to Application: Formation and Properties; Korotcenkov, G., Ed.; CRC Press: Boca Raton, FL, USA, 2015; Volume 1, pp. 291–304. [Google Scholar]
- Kolasinski, K.W. The mechanism of galvanic/metal-assisted etching of silicon. Nanoscale Res. Lett. 2014, 9, 432. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Rezvani, S.J.; Gunnella, R.; Neilson, D.; Boarino, L.; Croin, L.; Aprile, G.; Fretto, M.; Rizzi, P.; Antonioli, D.; Pinto, N. Effect of carrier tunneling on the structure of Si nanowires fabricated by metal assisted etching. Nanotechnology 2016, 27, 345301. [Google Scholar] [CrossRef] [PubMed]
- Kolasinski, K.W. Etching of Silicon in Fluoride Solutions. Surf. Sci. 2009, 603, 1904–1911. [Google Scholar] [CrossRef]
- Kolasinski, K.W.; Hartline, J.D.; Kelly, B.T.; Yadlovskiy, J. Dynamics of Porous Silicon Formation by Etching in HF + V2O5 Solutions. Mol. Phys. 2010, 108, 1033–1043. [Google Scholar] [CrossRef]
- Kolasinski, K.W.; Yadlovskiy, J. Stain etching of Silicon with V2O5. Phys. Status Solidi C 2011, 8, 1749–1753. [Google Scholar] [CrossRef]
- Kolasinski, K.W. Bubbles: A review of their relationship to the formation of thin films and porous materials. Mesoporous Biomater. 2014, 1, 49–60. [Google Scholar] [CrossRef]
- Khorasaninejad, M.; Abedzadeh, N.; Jawanda, A.S.; O, N.; Anantram, M.P.; Saini, S.S. Bunching characteristics of silicon nanowire arrays. J. Appl. Phys. 2012, 111, 044328. [Google Scholar] [CrossRef]
- Li, C.; Fobelets, K.; Tymieniecki, M.S.; Hamayun, M.; Durrani, Z.A.K.; Green, M. Bunch-Free Electroless-Etched Si Nanowire Array. ECS Trans. 2011, 33, 9–13. [Google Scholar] [CrossRef]
- Alexander, F.R. Drying of thin colloidal films. Rep. Prog. Phys. 2013, 76, 046603. [Google Scholar]
- Bellet, D.; Canham, L. Controlled Drying: The key to better quality porous semiconductors. Adv. Mater. 1998, 10, 487–490. [Google Scholar] [CrossRef]
- Canham, L.T. Drying Techniques Applied to Porous Silicon. In Handbook of Porous Silicon, 2nd ed.; Canham, L.T., Ed.; Springer: Berlin, Germany, 2014; pp. 559–566. [Google Scholar]
- Mallavarapu, A.; Ajay, P.; Sreenivasan, S.V. Enabling Ultrahigh-Aspect-Ratio Silicon Nanowires Using Precise Experiments for Detecting the Onset of Collapse. Nano Lett. 2020, 20, 7896–7905. [Google Scholar] [CrossRef]
- Cheng, S.L.; Chung, C.H.; Lee, H.C. A Study of the Synthesis, Characterization, and Kinetics of Vertical Silicon Nanowire Arrays on (001)Si Substrates. J. Electrochem. Soc. 2008, 155, D711–D714. [Google Scholar] [CrossRef]
- Gonchar, K.A.; Kitaeva, V.Y.; Zharik, G.A.; Eliseev, A.A.; Osminkina, L.A. Structural and Optical Properties of Silicon Nanowire Arrays Fabricated by Metal Assisted Chemical Etching With Ammonium Fluoride. Front. Chem. 2019, 6. [Google Scholar] [CrossRef] [Green Version]
- Koker, L.; Wellner, A.; Sherratt, P.A.J.; Neuendorf, R.; Kolasinski, K.W. Laser–assisted formation of porous silicon in diverse fluoride solutions: Hexafluorosilicate deposition. J. Phys. Chem. B 2002, 106, 4424–4431. [Google Scholar] [CrossRef]
- Lehmann, V. Electrochemistry of Silicon: Instrumentation, Science, Materials and Applications; Wiley-VCH: Weinheim, Germany, 2002. [Google Scholar]
- Sailor, M.J. Fundamentals of Porous Silicon Preparation: Preparation, Characterization and Applications. In Porous Silicon in Practice; Wiley-VCH Verlag: Weinheim, Germany, 2012; pp. 1–42. [Google Scholar] [CrossRef]
- Kolasinski, K.W.; Gimbar, N.J.; Mäkilä, E.; Salonen, J. Stain etching to produce photoluminescent porous Si powders. In Proceedings of the Porous Semiconductors Science and Technology, Tarragona, Spain, 6–11 March 2016. [Google Scholar]
- Loni, A.; Barwick, D.; Batchelor, L.; Tunbridge, J.; Han, Y.; Li, Z.Y.; Canham, L.T. Extremely High Surface Area Metallurgical-Grade Porous Silicon Powder Prepared by Metal-Assisted Etching. Electrochem. Solid State Lett. 2011, 14, K25–K27. [Google Scholar] [CrossRef]
- Kolasinski, K.W.; Swanson, J.D.; Roe, B.; Lee, T. Response of Photoluminescence of H-Terminated and Hydrosilylated Porous Si Powders to Rinsing and Temperature. Surfaces 2020, 3, 27. [Google Scholar] [CrossRef]
- Ouertani, R.; Hamdi, A.; Amri, C.; Khalifa, M.; Ezzaouia, H. Formation of silicon nanowire packed films from metallurgical-grade silicon powder using a two-step metal-assisted chemical etching method. Nanoscale Res. Lett. 2014, 9, 574. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Li, X.; Xiao, Y.; Bang, J.H.; Lausch, D.; Meyer, S.; Miclea, P.-T.; Jung, J.-Y.; Schweizer, S.L.; Lee, J.-H.; Wehrspohn, R.B. Upgraded Silicon Nanowires by Metal-Assisted Etching of Metallurgical Silicon: A New Route to Nanostructured Solar-Grade Silicon. Adv. Mater. 2013, 25, 3187–3191. [Google Scholar] [CrossRef] [PubMed]
- Li, X.; Xiao, Y.; Yan, C.; Zhou, K.; Miclea, P.-T.; Meyer, S.; Schweizer, S.L.; Sprafke, A.; Lee, J.-H.; Wehrspohn, R.B. Self-purification model for metal-assisted chemical etching of metallurgical silicon. Electrochim. Acta 2015, 138, 476–480. [Google Scholar] [CrossRef]
- Li, X.; Lee, J.-H.; Sprafke, A.N.; Wehrspohn, R.B. Black metallurgical silicon for solar energy conversion. Semicond. Sci. Technol. 2016, 31, 014009. [Google Scholar] [CrossRef]
- Matsumoto, A.; Son, H.; Eguchi, M.; Iwamoto, K.; Shimada, Y.; Furukawa, K.; Yae, S. General corrosion during metal-assisted etching of n-type silicon using different metal catalysts of silver, gold, and platinum. RSC Adv. 2020, 10, 253–259. [Google Scholar] [CrossRef] [Green Version]
- Savin, H.; Repo, P.; von Gastrow, G.; Ortega, P.; Calle, E.; Garín, M.; Alcubilla, R. Black silicon solar cells with interdigitated back-contacts achieve 22.1% efficiency. Nat Nano 2015, 10, 624–628. [Google Scholar] [CrossRef] [Green Version]
- Otto, M.; Algasinger, M.; Branz, H.; Gesemann, B.; Gimpel, T.; Fuechsel, K.; Kaesebier, T.; Kontermann, S.; Koynov, S.; Li, X.P.; et al. Black Silicon Photovoltaics. Adv. Opt. Mater. 2015, 3, 147–164. [Google Scholar] [CrossRef]
- Liu, X.G.; Coxon, P.R.; Peters, M.; Hoex, B.; Cole, J.M.; Fray, D.J. Black silicon: Fabrication methods, properties and solar energy applications. Energy Environ. Sci. 2014, 7, 3223–3263. [Google Scholar] [CrossRef] [Green Version]
- Ivanova, E.P.; Hasan, J.; Webb, H.K.; Gervinskas, G.; Juodkazis, S.; Truong, V.K.; Wu, A.H.F.; Lamb, R.N.; Baulin, V.A.; Watson, G.S.; et al. Bactericidal activity of black silicon. Nat. Commun. 2013, 4, 2838. [Google Scholar] [CrossRef] [PubMed]
- Cao, Y.; Zhou, Y.R.; Liu, F.Z.; Zhou, Y.Q.; Zhang, Y.; Liu, Y.; Guo, Y.K. Progress and Mechanism of Cu Assisted Chemical Etching of Silicon in a Low Cu2+ Concentration Region. ECS J. Solid State Sci. Technol. 2015, 4, P331–P336. [Google Scholar] [CrossRef]
- Wang, Y.; Yang, L.; Liu, Y.; Mei, Z.; Chen, W.; Li, J.; Liang, H.; Kuznetsov, A.; Xiaolong, D. Maskless inverted pyramid texturization of silicon. Sci. Rep. 2015, 5, 10843. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Wang, Y.; Liu, Y.; Yang, L.; Chen, W.; Du, X.; Kuznetsov, A. Micro-structured inverted pyramid texturization of Si inspired by self-assembled Cu nanoparticles. Nanoscale 2017, 9, 907–914. [Google Scholar] [CrossRef]
- Toor, F.; Miller, J.B.; Davidson, L.M.; Duan, W.; Jura, M.P.; Yim, J.; Forziati, J.; Black, M.R. Metal assisted catalyzed etched (MACE) black Si: Optics and device physics. Nanoscale 2016, 8, 15448–15466. [Google Scholar] [CrossRef] [PubMed]
- Chen, W.; Liu, Y.; Yang, L.; Wu, J.; Chen, Q.; Zhao, Y.; Wang, Y.; Du, X. Difference in anisotropic etching characteristics of alkaline and copper based acid solutions for single-crystalline Si. Sci. Rep. 2018, 8, 3408. [Google Scholar] [CrossRef]
- Hylton, J.D.; Burgers, A.R.; Sinke, W.C. Alkaline etching for reflectance reduction in multicrystalline silicon solar cells. J. Electrochem. Soc. 2004, 151, G408–G427. [Google Scholar] [CrossRef]
- Zubel, I. Effect of cations on silicon anisotropic etching process in solutions containing TMAH and TMAH with tensioactive compounds. Sens. Actuators A Phys. 2020, 303, 111829. [Google Scholar] [CrossRef]
- Philipsen, H.G.G.; Kelly, J.J. Influence of chemical additives on the surface reactivity of Si in KOH solution. Electrochim. Acta 2009, 54, 3526–3531. [Google Scholar] [CrossRef]
- Shah, I.A.; van der Wolf, B.M.A.; van Enckevort, W.J.P.; Vlieg, E. Wet chemical etching of silicon {111}: Autocatalysis in pit formation. J. Electrochem. Soc. 2008, 155, J79–J84. [Google Scholar] [CrossRef]
- Papet, P.; Nichiporuk, O.; Kaminski, A.; Rozier, Y.; Kraiem, J.; Lelievre, J.-F.; Chaumartin, A.; Fave, A.; Lemiti, M. Pyramidal texturing of silicon solar cell with TMAH chemical anisotropic etching. Sol. Energy Mater. 2006, 90, 2319–2328. [Google Scholar] [CrossRef]
- Haiss, W.; Raisch, P.; Bitsch, L.; Nichols, R.J.; Xia, X.H.; Kelly, J.J.; Schiffrin, D.J. Surface termination and hydrogen bubble surfaces during anisotropic dissolution adhesion on Si(100) in aqueous KOH. J. Electroanal. Chem. 2006, 597, 1–12. [Google Scholar] [CrossRef] [Green Version]
- Hines, M.A.; Chabal, Y.J.; Harris, T.D.; Harris, A.L. Measuring the structure of etched silicon surfaces with Raman spectroscopy. J. Chem. Phys. 1994, 101, 8055–8072. [Google Scholar] [CrossRef]
- Baum, T.; Schiffrin, D.J. Mechanistic aspects of anisotropic dissolution of materials etching of single-crystal silicon in alkaline solutions. J. Chem. Soc. Faraday Trans. 1998, 94, 691–694. [Google Scholar] [CrossRef]
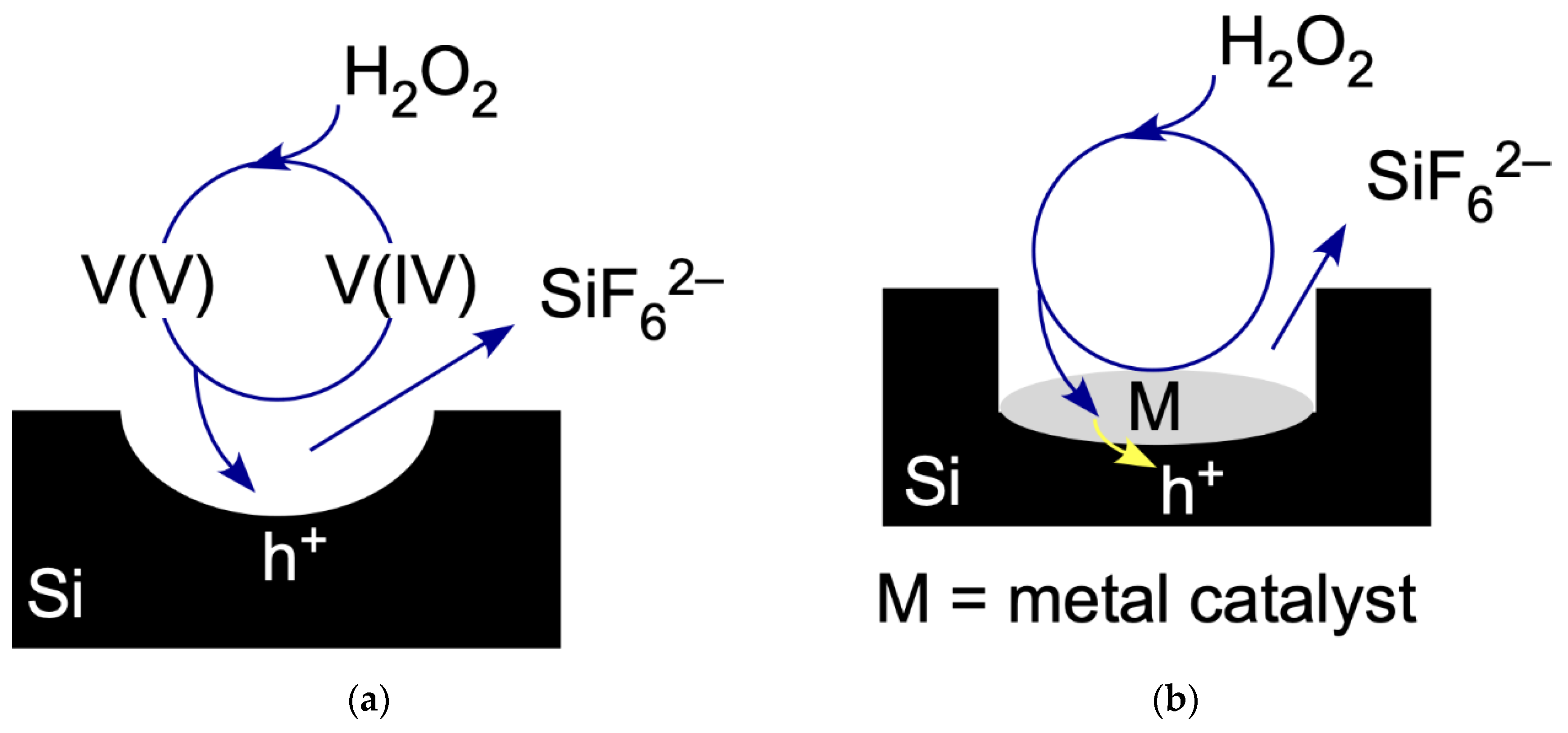
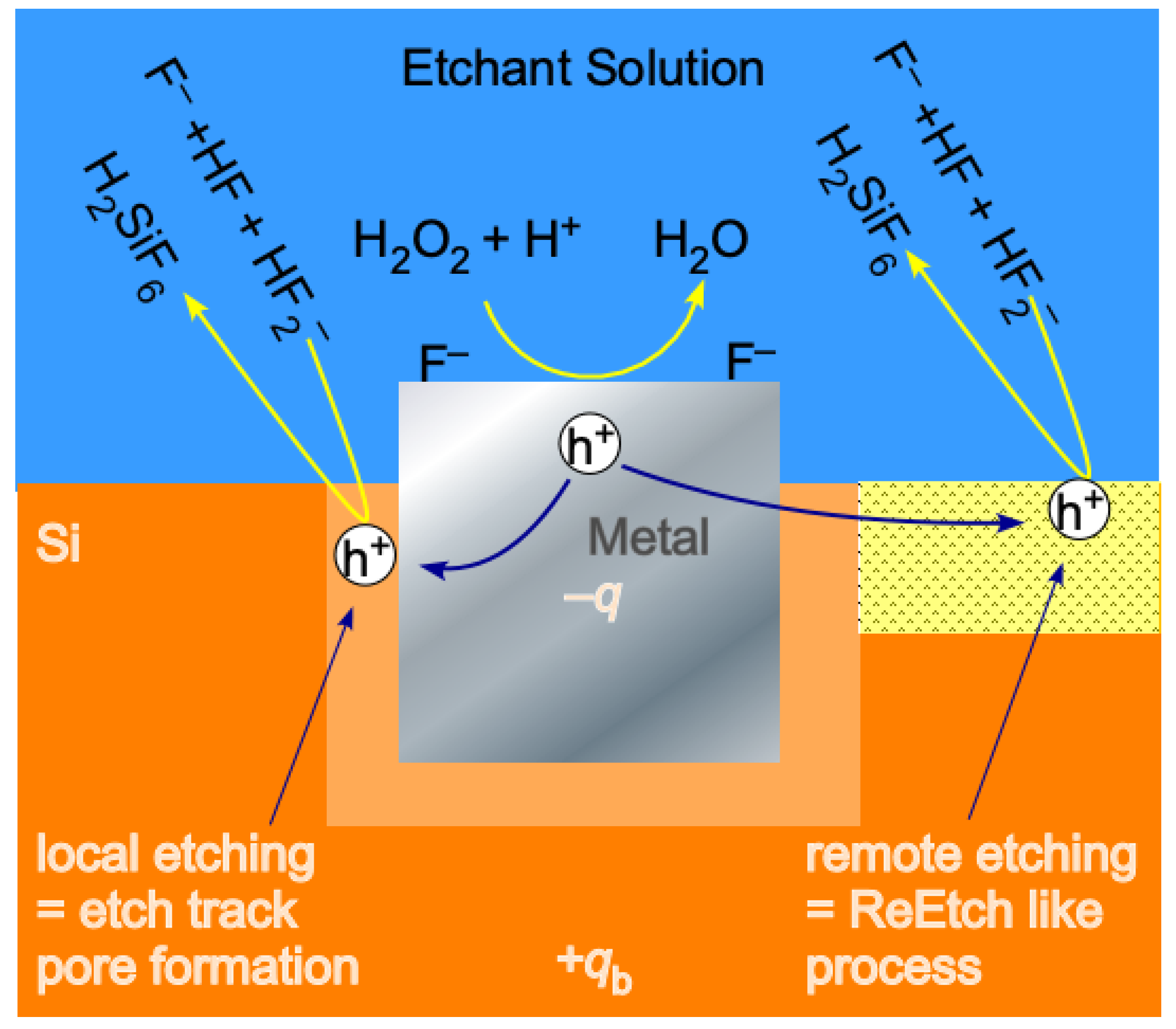




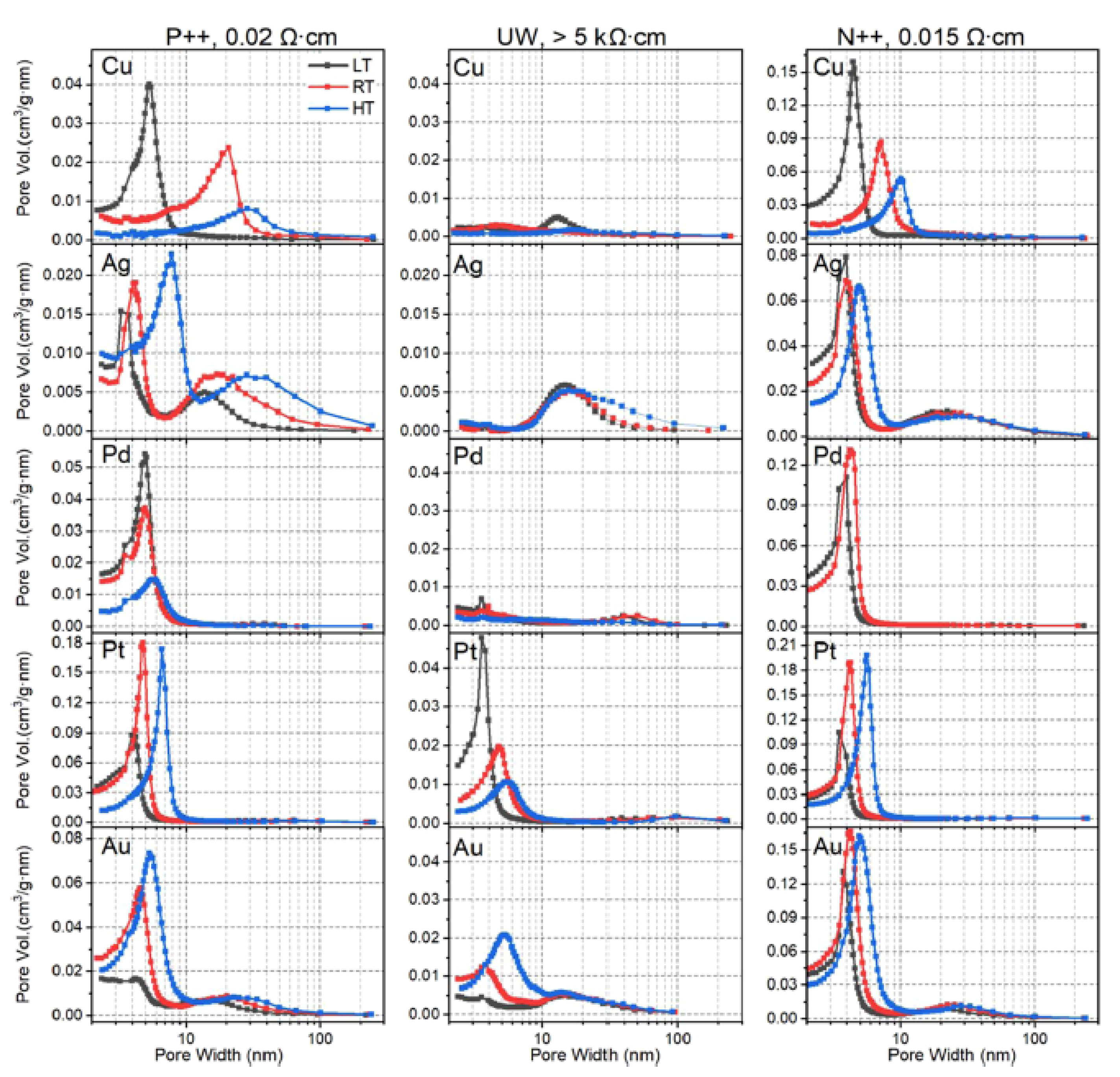
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the author. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Kolasinski, K.W. Metal-Assisted Catalytic Etching (MACE) for Nanofabrication of Semiconductor Powders. Micromachines 2021, 12, 776. https://doi.org/10.3390/mi12070776
Kolasinski KW. Metal-Assisted Catalytic Etching (MACE) for Nanofabrication of Semiconductor Powders. Micromachines. 2021; 12(7):776. https://doi.org/10.3390/mi12070776
Chicago/Turabian StyleKolasinski, Kurt W. 2021. "Metal-Assisted Catalytic Etching (MACE) for Nanofabrication of Semiconductor Powders" Micromachines 12, no. 7: 776. https://doi.org/10.3390/mi12070776
APA StyleKolasinski, K. W. (2021). Metal-Assisted Catalytic Etching (MACE) for Nanofabrication of Semiconductor Powders. Micromachines, 12(7), 776. https://doi.org/10.3390/mi12070776





