A Low Temperature Drifting Acoustic Wave Pressure Sensor with an Integrated Vacuum Cavity for Absolute Pressure Sensing
Abstract
1. Introduction
2. Design and Simulation
3. Fabrication Process
4. Experiments and Results
5. Conclusions
Author Contributions
Funding
Acknowledgments
Conflicts of Interest
References
- Coquin, G.A.; Tiersten, H.F. Analysis of the Excitation and Detection of Piezoelectric Surface Waves in Quartz by Means of Surface Electrodes. J. Acoust. Soc. Am. 1967, 41, 921–939. [Google Scholar] [CrossRef]
- Wang, T.; Wang, J.; He, J.; Wu, C.; Luo, W.; Shuai, Y.; Zhang, W.; Chen, X.; Zhang, J.; Lin, J. A Comprehensive Study of a Micro-Channel Heat Sink Using Integrated Thin-Film Temperature Sensors. Sensors 2018, 18, 299. [Google Scholar] [CrossRef] [PubMed]
- Guarino, A.; Poberaj, G.; Rezzonico, D.; Degl’Innocenti, R.; Günter, P. Electro–Optically Tunable Microring Resonators in Lithium Niobate. Nat. Photonics 2007, 1, 407–410. [Google Scholar] [CrossRef]
- Wang, T.; Wang, J.; He, J.; Wu, C.; Luo, W.; Shuai, Y.; Zhang, W.; Lee, C. Investigation of the Temperature Fluctuation of Single-Phase Fluid Based Microchannel Heat Sink. Sensors 2018, 18, 1498. [Google Scholar] [CrossRef] [PubMed]
- Yang, X.; Fei, C.; Li, D.; Sun, X.; Hou, S.; Chen, J.; Yang, Y. Multi-Layer Polymer-Metal Structures for Acoustic Impedance Matching in High-Frequency Broadband Ultrasonic Transducers Design. Appl. Acoust. 2020, 160, 107123. [Google Scholar] [CrossRef]
- Barlian, A.A.; Park, W.T.; Mallon, J.R.; Rastegar, A.J.; Pruitt, B.L. Review: Semiconductor Piezoresistance for Microsystems. Proc. IEEE 2009, 97, 513–552. [Google Scholar] [CrossRef]
- Fricke, S.; Friedberger, A.; Seidel, H.; Schmid, U. A Robust Pressure Sensor for Harsh Environmental Applications. Sens. Actuators A Phys. 2012, 184, 16–21. [Google Scholar] [CrossRef]
- Hong, Y.; Sharples, S.D.; Clark, M.; Somekh, M.G. Rapid and accurate analysis of surface and pseudo-surface waves using adaptive laser ultrasound techniques. Ultrasonics 2004, 42, 515–518. [Google Scholar] [CrossRef]
- Eswaran, P. Mems Capacitive Pressure Sensors: A Review on Recent Development and Prospective. Int. J. Eng. Technol. 2013, 5, 2734–2746. [Google Scholar]
- Borrero, G.A.; Bravo, J.P.; Mora, S.F.; Velásquez, S.; Segura-Quijano, F.E. Design and Fabrication of Saw Pressure, Temperature and Impedance Sensors Using Novel Multiphysics Simulation Models. Sens. Actuators A Phys. 2013, 203, 204–214. [Google Scholar] [CrossRef]
- Okojie, R.S.; Lukco, D.; Nguyen, V.; Savrun, E. 4H-SiC Piezoresistive Pressure Sensors at 800 °C With Observed Sensitivity Recovery. IEEE Electron Device Lett. 2015, 36, 174–176. [Google Scholar] [CrossRef]
- Kumar, S.S.; Pant, B.D. Design principles and considerations for the ‘ideal’ silicon piezoresistive pressure sensor: A focused review. Microsyst. Technol. 2014, 20, 1213–1247. [Google Scholar] [CrossRef]
- Koechlin, M.; Sulser, F.; Sitar, Z.; Poberaj, G.; Gunter, P. Free-Standing Lithium Niobate Microring Resonators for Hybrid Integrated Optics. IEEE Photonics Technol. Lett. 2010, 22, 251–253. [Google Scholar] [CrossRef]
- Phan, H.-P.; Dao, D.V.; Nakamura, K.; Dimitrijev, S.; Nguyen, N.-T. The Piezoresistive Effect of SiC for MEMS Sensors at High Temperatures: A Review. J. Microelectromech. Syst. 2015, 24, 1663–1677. [Google Scholar] [CrossRef]
- Fu, S.; Wang, W.; Qian, L.; Li, Q.; Lu, Z.; Shen, J.; Song, C.; Zeng, F.; Pan, F. High-Frequency Surface Acoustic Wave Devices Based on ZnO/SiC Layered Structure. IEEE Electron Device Lett. 2019, 40, 103–106. [Google Scholar] [CrossRef]
- Takai, T.; Iwamoto, H.; Takamine, Y.; Yamazaki, H.; Fuyutsume, T.; Kyoya, H.; Nakao, T.; Kando, H.; Hiramoto, M.; Toi, T.; et al. High-Performance SAW Resonator on New Multilayered Substrate Using LiTaO3 Crystal. IEEE Trans. Ultrason. Ferroelectr. Freq. Control 2017, 64, 1382–1389. [Google Scholar] [CrossRef]
- Bjurström, J.; Wingqvist, G.; Yantchev, V.; Katardjiev, I. Temperature compensation of liquid FBAR sensors. J. Micromech. Microeng. 2007, 17, 651–658. [Google Scholar] [CrossRef]
- Lu, W.; Feng, Y.; Zhu, C.; Zheng, J. Temperature compensation of the SAW yarn tension sensor. Ultrasonics 2017, 76, 87–91. [Google Scholar] [CrossRef]
- Bjurström, J.; Yantchev, V.; Katardjiev, I. Thin Film Lamb Wave Resonant Structures—The First Approach. Solid State Electron. 2006, 50, 322–326. [Google Scholar] [CrossRef]
- Li, W.; Liang, T.; Liu, W.; Jia, P.; Chen, Y.; Xiong, J.; Lei, C.; Hong, Y.; Li, Y. Wireless passive pressure sensor based on sapphire direct bonding for harsh environments. Sens. Actuators A 2018, 280, 406–412. [Google Scholar] [CrossRef]
- Kropelnicki, P.; Muckensturm, K.M.; Mu, X.J.; Randles, A.B.; Cai, H.; Ang, W.C.; Tsai, J.M.; Vogt, H. CMOS-compatible ruggedized high-temperature Lamb wave pressure sensor. J. Micromech. Microeng. 2013, 23, 085018. [Google Scholar] [CrossRef]
- Mu, X.; Kropelnicki, P.; Wang, Y.; Randles, A.B.; Chai, K.T.C.; Cai, H.; Gu, Y.D. Dual Mode Acoustic Wave Sensor for Precise Pressure Reading. Appl. Phys. Lett. 2014, 105, 113507. [Google Scholar] [CrossRef]

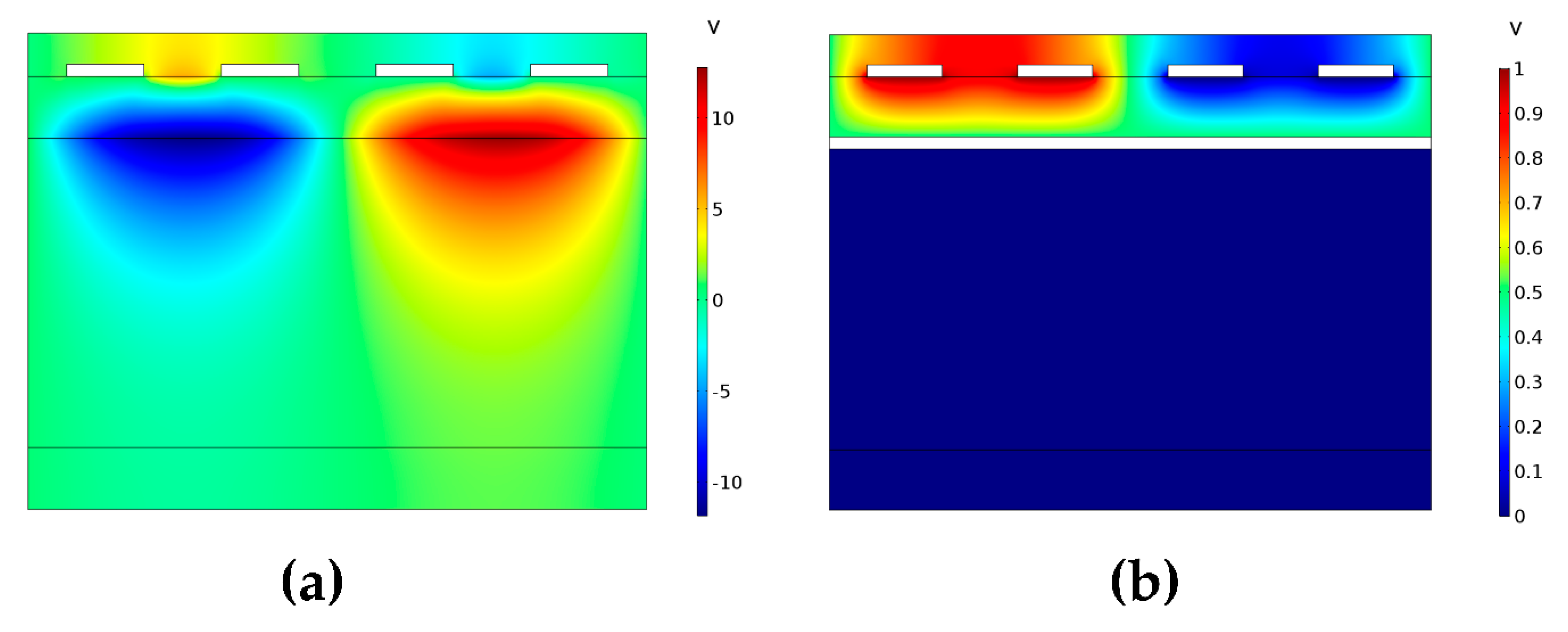
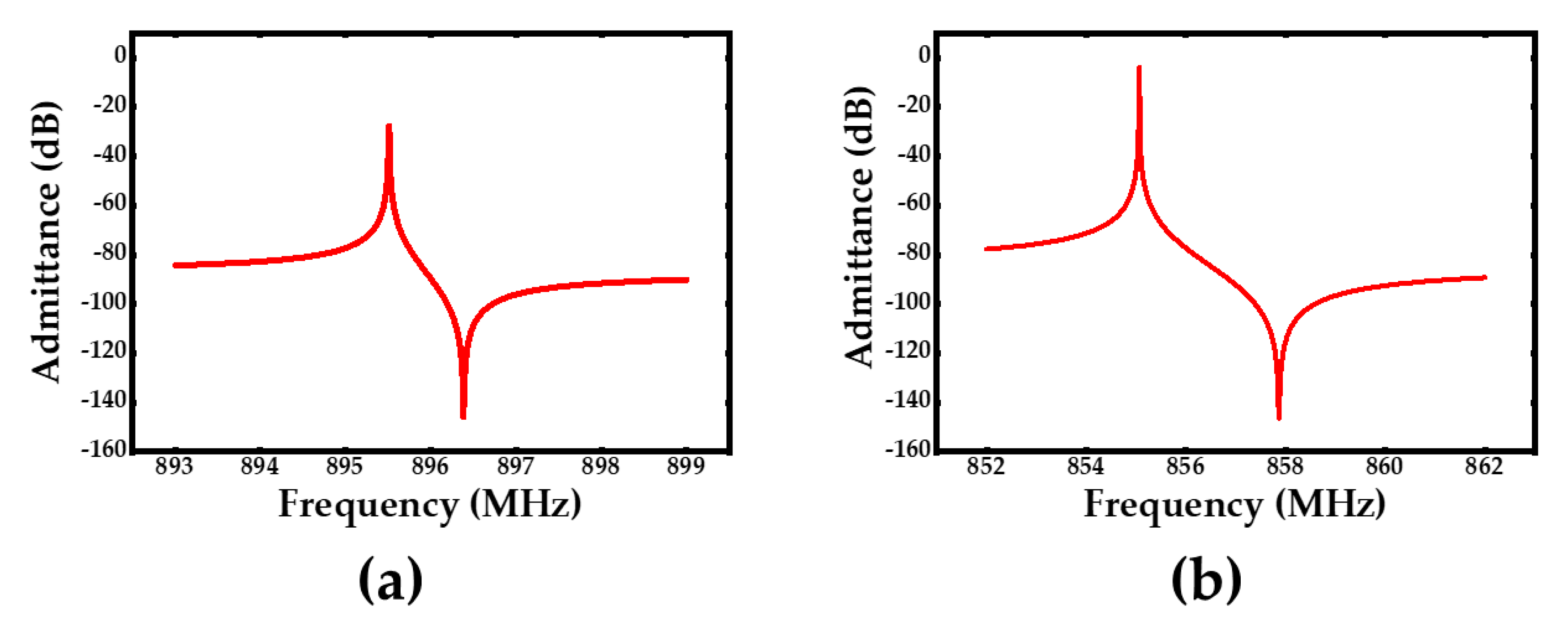
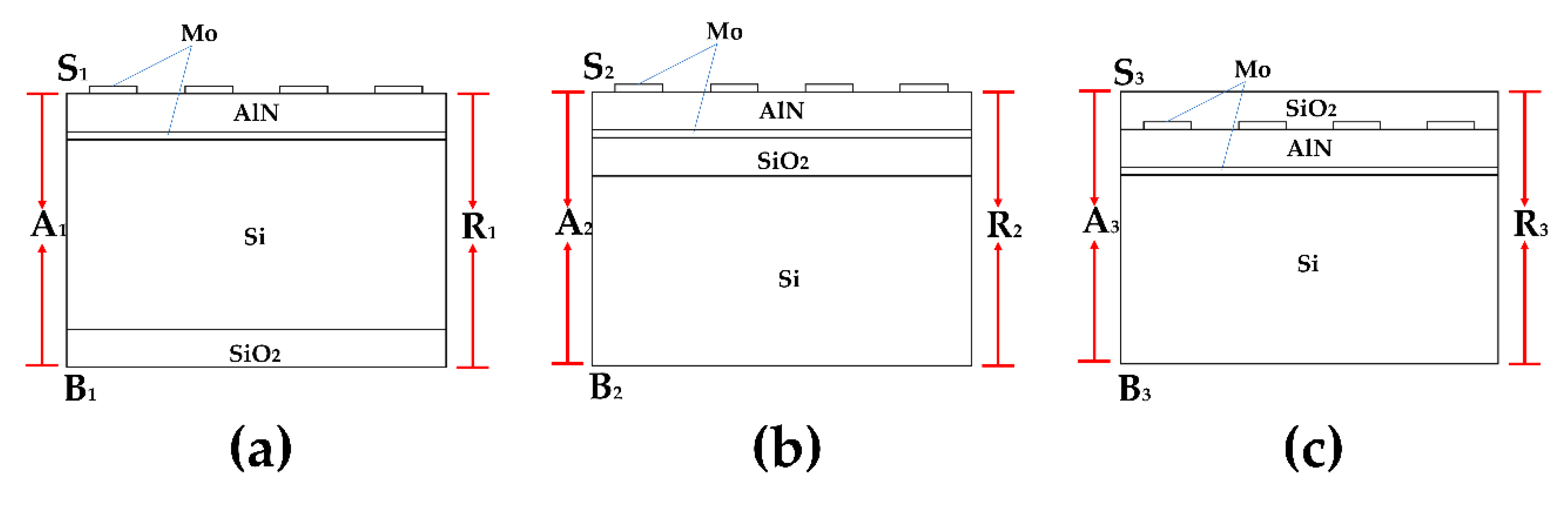


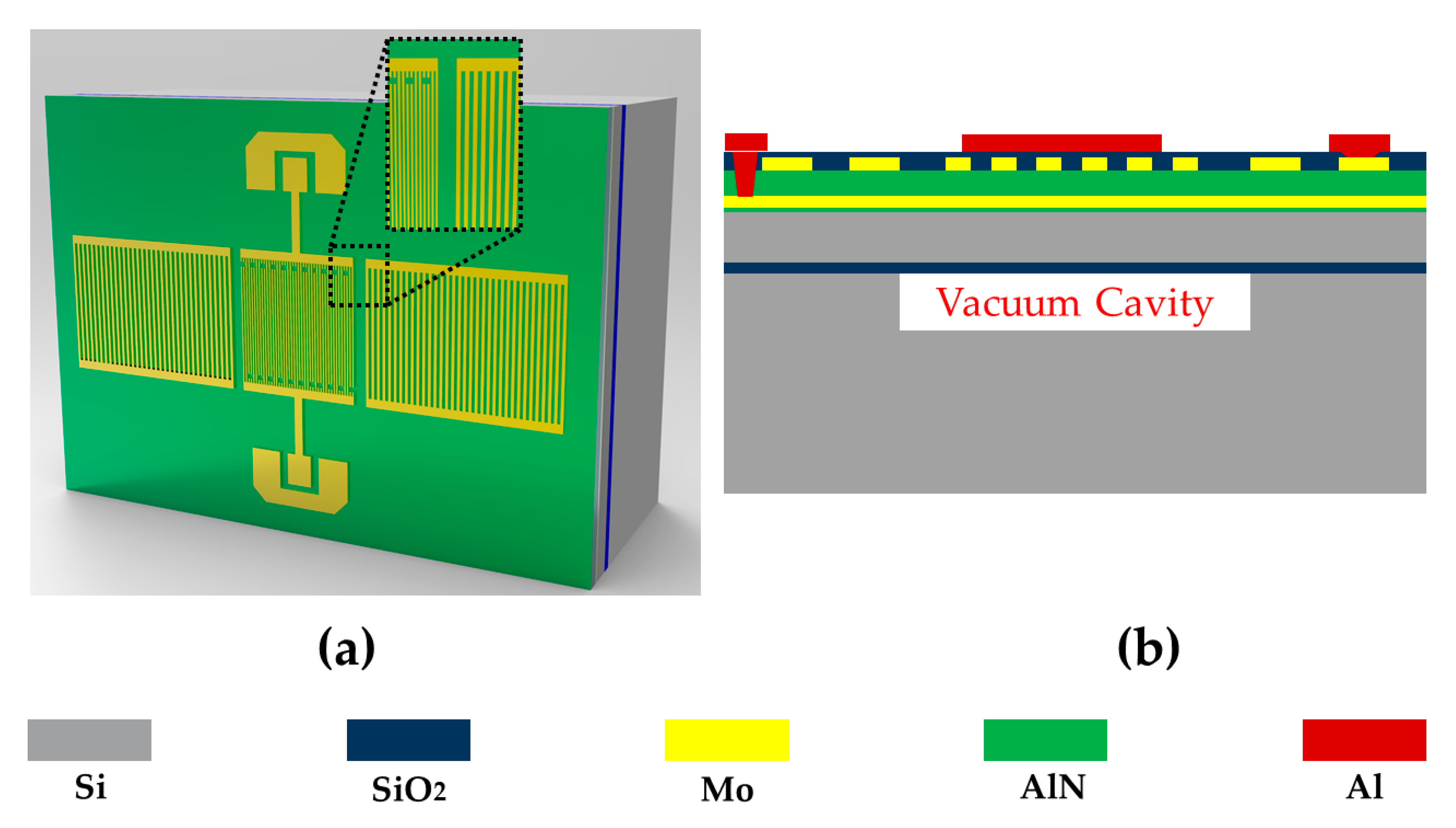
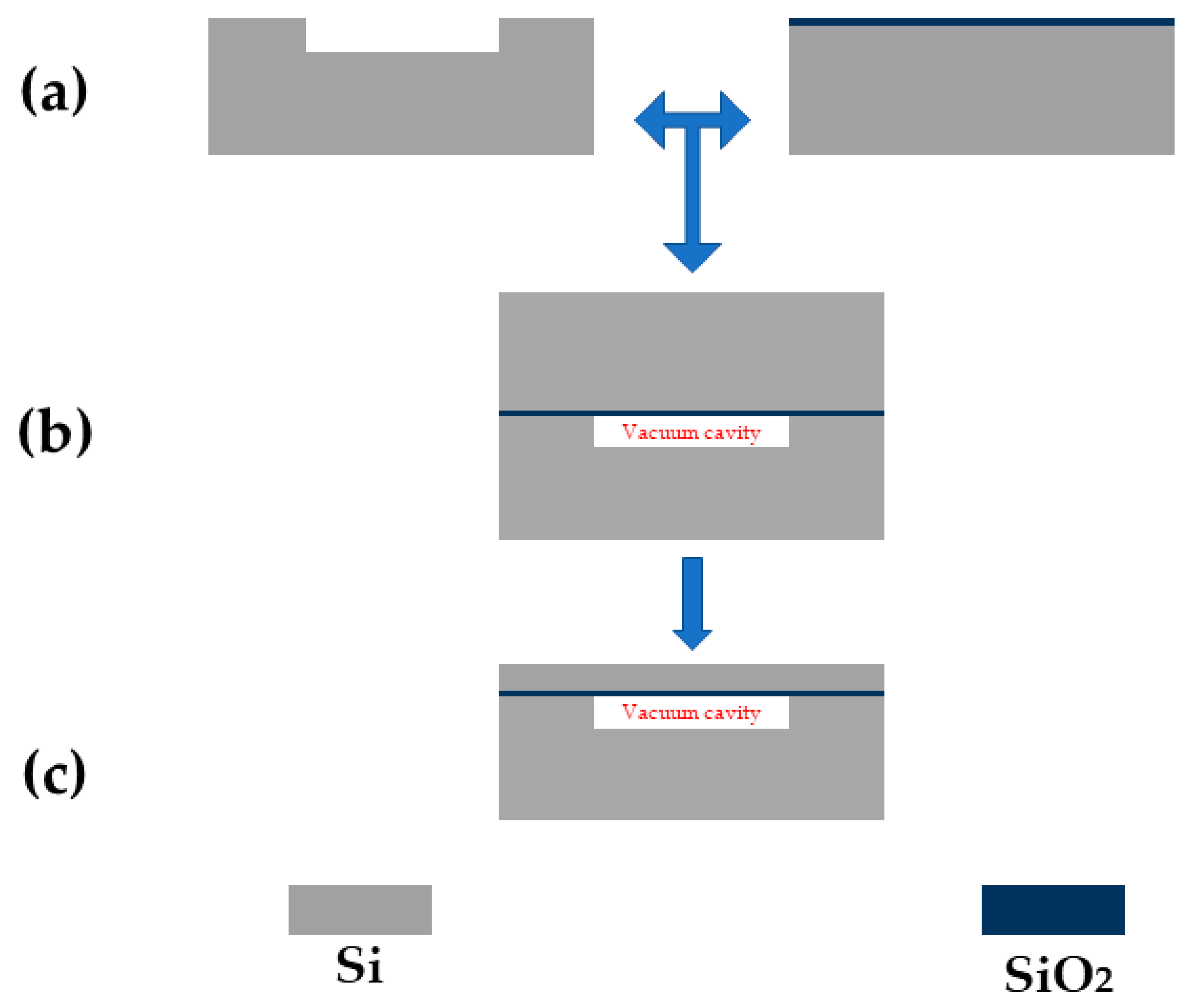
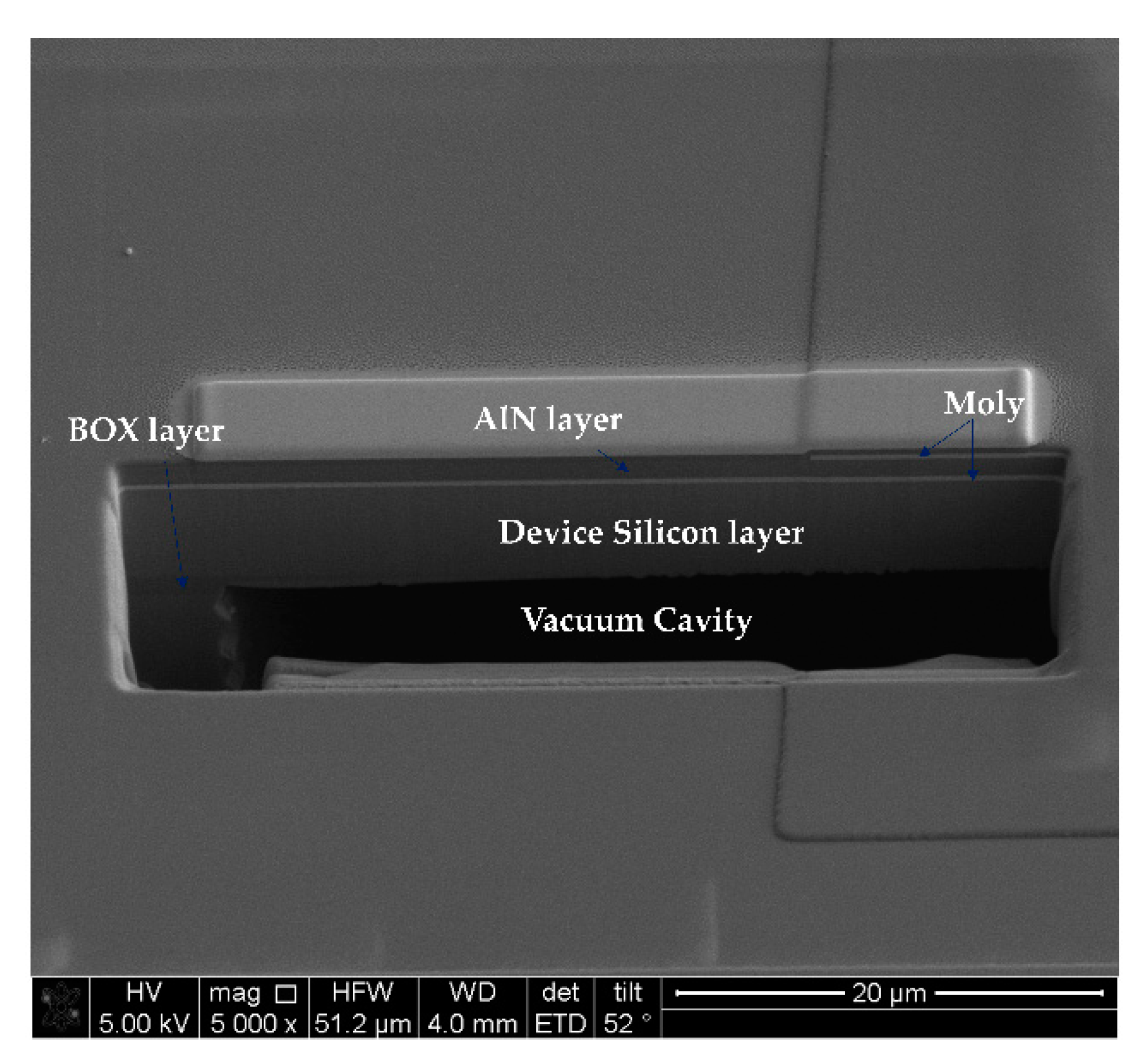
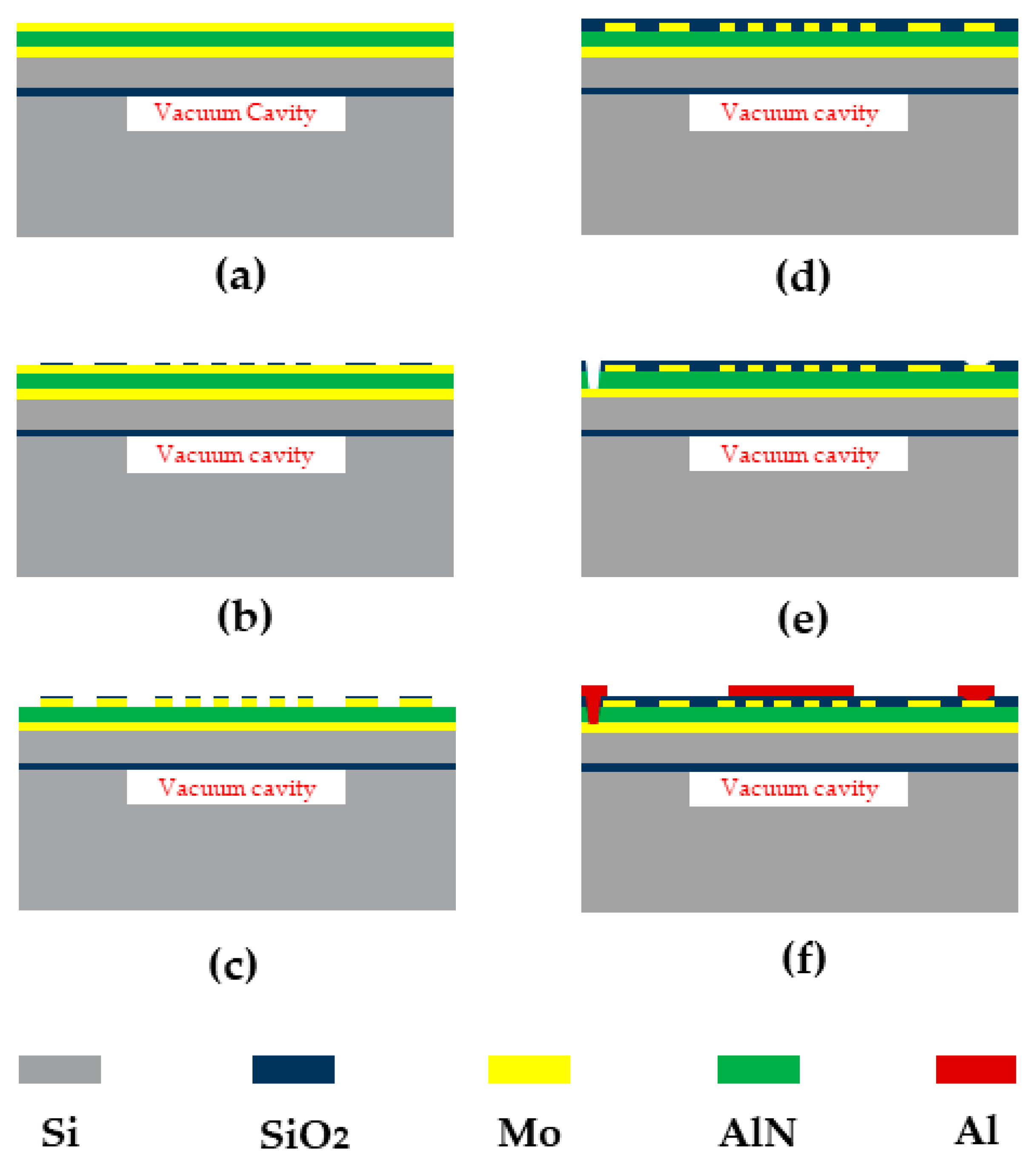

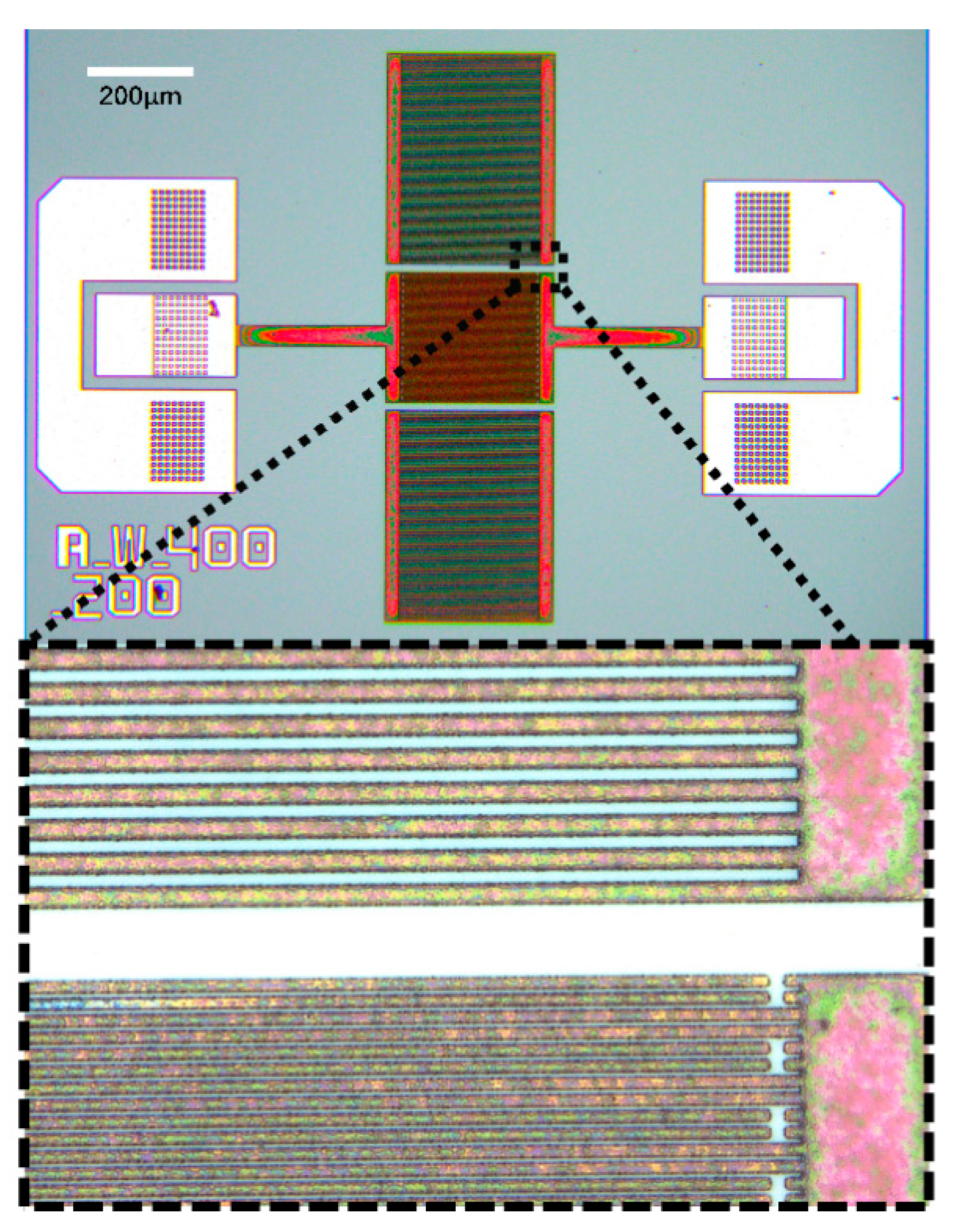
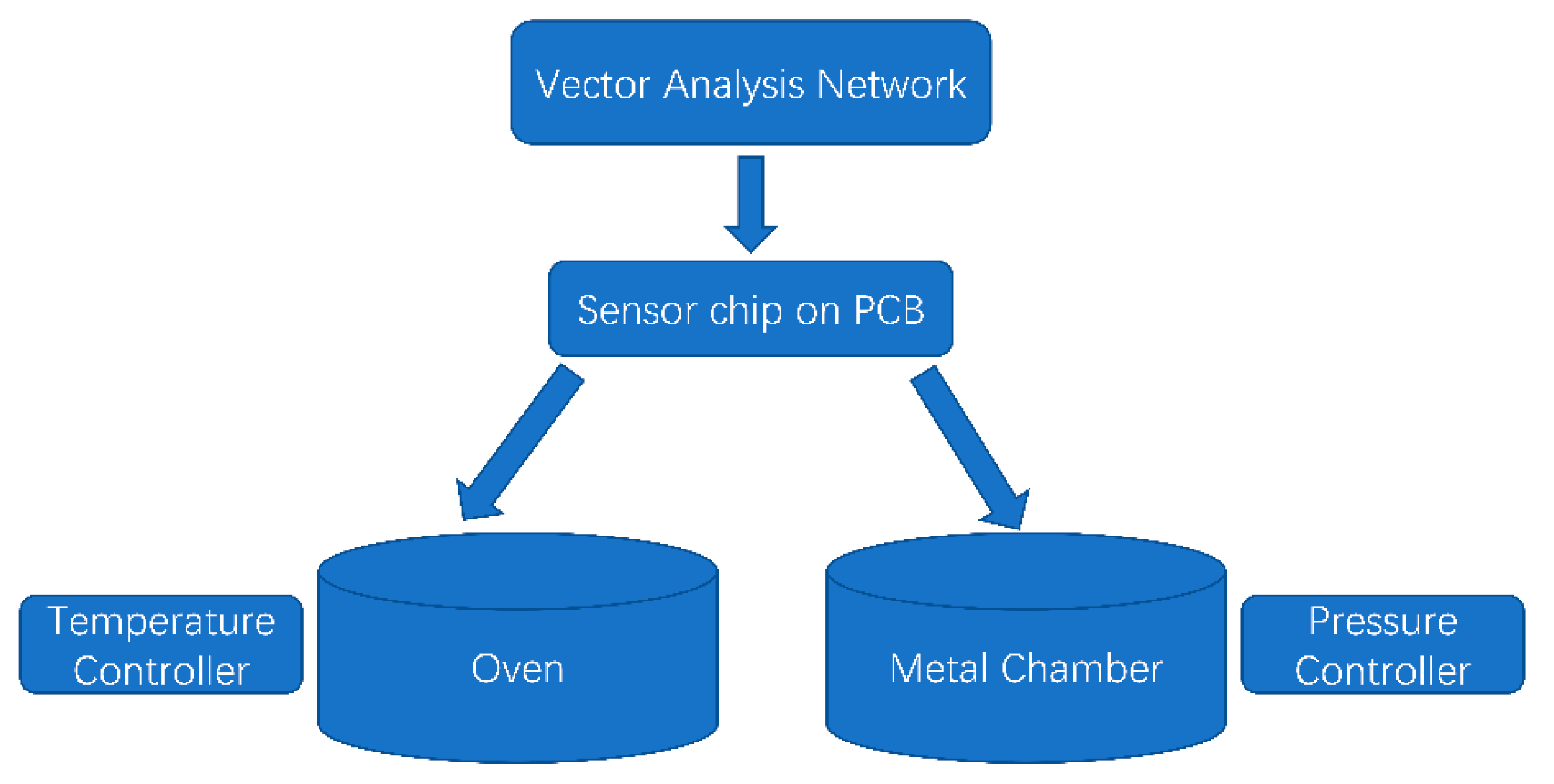
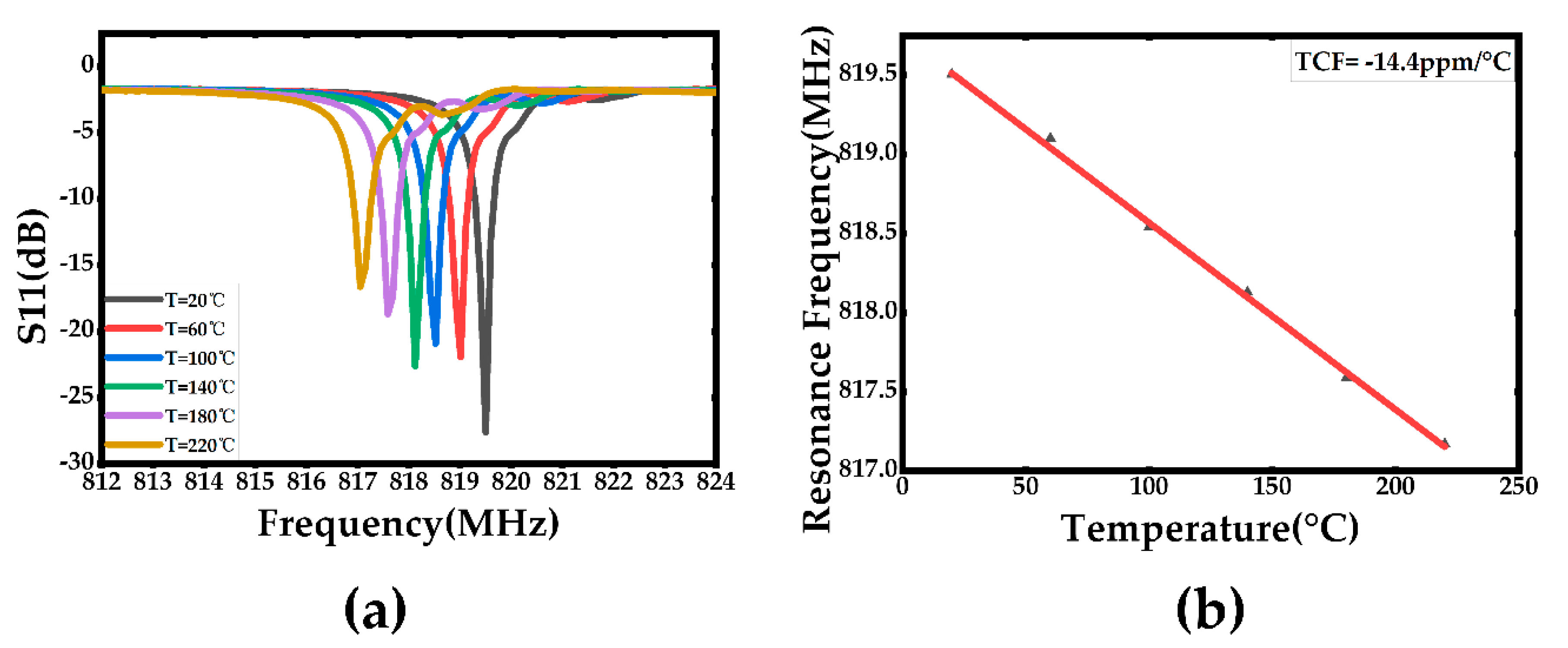
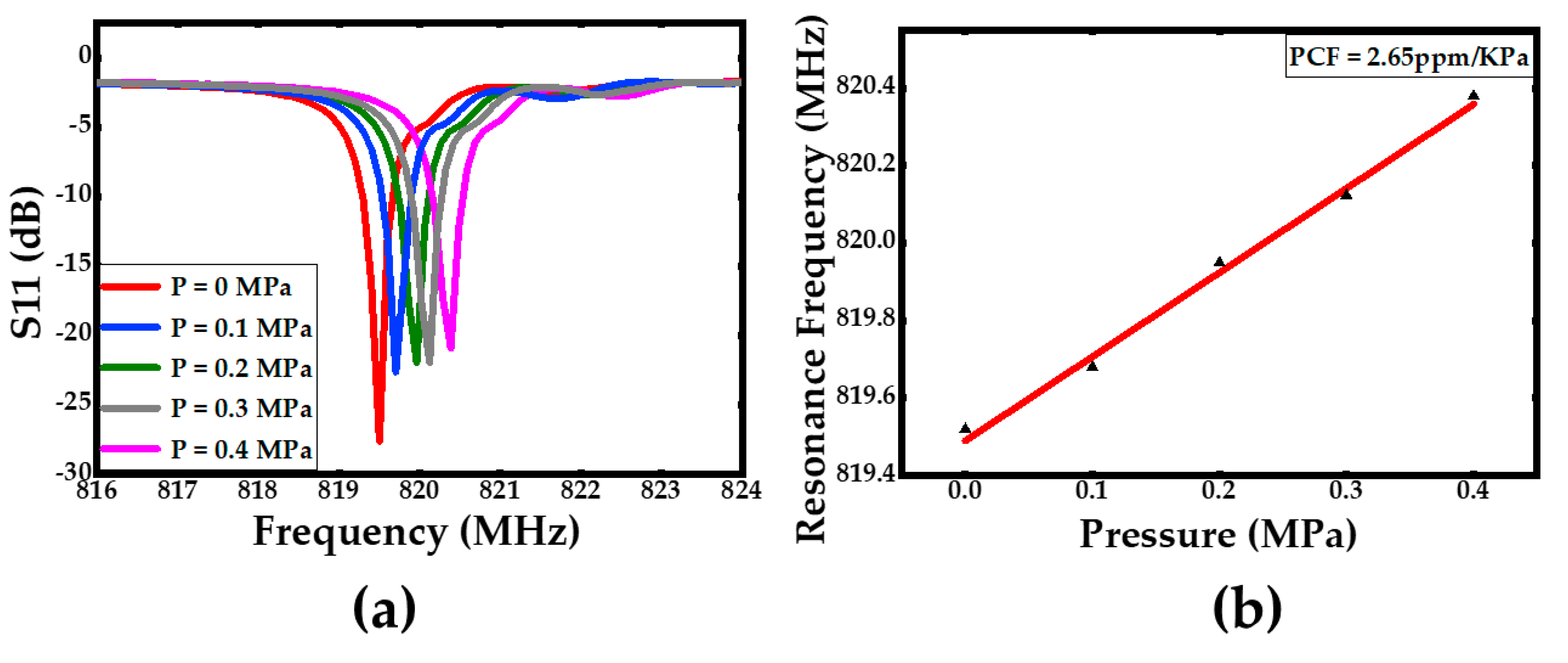
| Boundary | Mechanical Boundary Conditions Setting |
|---|---|
| S1, S2, S3, B1, B2, B3 | Stress-free boundary |
| A1, A2, A3, R1, R2, R3 | Periodic boundary |
| AlN | Si | SiO2 | Mo | |||
|---|---|---|---|---|---|---|
| Elastic constants, cij (GPa) | c11 c12 c13 c33 c44 c66 | 410.06 100.69 83.82 286.24 100.58 154.70 | Young’s modulus E (GPa) | 170 | 70 | 385 |
| Temperature coefficient of elastic constants TECij (10e-6/K−1) | TCE11 TCE12 TCE13 TCE33 TCE44 TCE66 | −10.65 −11.67 −11.22 −11.13 −10.82 −10.80 | Temperature coefficient of Young’s modulus TCE (10e-6/K−1) | −63 | 200 | −181 |
| Thermal expansionαij (10e-6/ K−1) | α11 α22 α33 | 5.27 5.27 4.15 | 2.6 2.6 2.6 | 0.55 0.55 0.55 | 3.49 3.49 3.49 | |
| Mass density ρ(kg/m3) | ρ | 3300 | 2329 | 2200 | 10,200 |
© 2020 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Wang, T.; Tang, Z.; Lin, H.; Zhan, K.; Wan, J.; Wu, S.; Gu, Y.; Luo, W.; Zhang, W. A Low Temperature Drifting Acoustic Wave Pressure Sensor with an Integrated Vacuum Cavity for Absolute Pressure Sensing. Sensors 2020, 20, 1788. https://doi.org/10.3390/s20061788
Wang T, Tang Z, Lin H, Zhan K, Wan J, Wu S, Gu Y, Luo W, Zhang W. A Low Temperature Drifting Acoustic Wave Pressure Sensor with an Integrated Vacuum Cavity for Absolute Pressure Sensing. Sensors. 2020; 20(6):1788. https://doi.org/10.3390/s20061788
Chicago/Turabian StyleWang, Tao, Zhengjie Tang, Huamao Lin, Kun Zhan, Jiang Wan, Shihao Wu, Yuandong Gu, Wenbo Luo, and Wanli Zhang. 2020. "A Low Temperature Drifting Acoustic Wave Pressure Sensor with an Integrated Vacuum Cavity for Absolute Pressure Sensing" Sensors 20, no. 6: 1788. https://doi.org/10.3390/s20061788
APA StyleWang, T., Tang, Z., Lin, H., Zhan, K., Wan, J., Wu, S., Gu, Y., Luo, W., & Zhang, W. (2020). A Low Temperature Drifting Acoustic Wave Pressure Sensor with an Integrated Vacuum Cavity for Absolute Pressure Sensing. Sensors, 20(6), 1788. https://doi.org/10.3390/s20061788




