Memory Characteristics of Thin Film Transistor with Catalytic Metal Layer Induced Crystallized Indium-Gallium-Zinc-Oxide (IGZO) Channel
Abstract
:1. Introduction
2. Experiment
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- Lue, H.T.; Lai, S.C.; Hsu, T.H.; Hsiao, Y.H.; Du, P.Y.; Wang, S.Y.; Hsieh, K.Y.; Liu, R.; Lu, C.Y. A critical review of charge-trapping NAND flash devices. In Proceedings of the 2008 9th International Conference on Solid-State and Integrated-Circuit Technology, Beijing, China, 20–23 October 2008; p. 4734663. [Google Scholar]
- Zhao, C.; Zhao, C.Z.; Taylor, S.; Chalker, P.R. Review on non-volatile memory with high-k dielectric: Flash for generation beyond 32 nm. Materials 2014, 7, 5117–5145. [Google Scholar] [CrossRef] [Green Version]
- Ramkumar, K.; Prabhakar, V.; Keshavarzi, A.; Kouznetsov, I.; Geha, S. SONOS memories: Advances in materials and devices. MRS Adv. 2017, 2, 209–221. [Google Scholar] [CrossRef]
- Compagnoni, C.M.; Goda, A.; Spinelli, A.S.; Feeley, P.; Lacaita, A.L.; Visconti, A. Reviewing the evolution of the NAND flash technology. Proc. IEEE 2017, 105, 1609. [Google Scholar] [CrossRef]
- Nomura, K.; Ohta, H.; Takagi, A.; Kamiya, T.; Hirano, M.; Hosono, H. Room-temperature fabrication of transparent flexible thin-film transistors using amorphous oxide semiconductors. Nature 2004, 432, 488–492. [Google Scholar] [CrossRef]
- Jianhen, S.; Hong, T.; Lee, H.-M.; Kim, K.; Sasase, M.; Kim, J.; Hosono, H.; Park, J.-S. Amorphous IGZO TFT with High Mobility of ~70 cm2/(Vs) via Vertical Dimension. ACS Appl. Mater. Interfaces 2004, 11, 40300–40309. [Google Scholar]
- Oota, M.; Ando, Y.; Tsuda, K.; Koshida, T.; Oshita, S.; Suzuki, A.; Fukushima, K.; Nagatsuka, S.; Onuki, T.; Hodo, R.; et al. 3D-stacked CAAC-In-Ga-Zn Oxide Fets with Gate Length of 72 nm. In Proceedings of the 2019 IEEE International Electron Devices Meeting (IEDM), San Francisco, CA, USA, 7–11 December 2019. [Google Scholar]
- Wu, K.; Zhang, J.; Li, Y.; Wang, X.; Liu, Y.; Yu, Q.; Chen, T. Design of AM Self-Capacitive Transparent Touch Panel Based on a-IGZO Thin-Film Transistors. IEEE Access 2020, 2989435, 76929–76934. [Google Scholar] [CrossRef]
- Cho, M.H.; Choi, C.H.; Seul, H.J.; Cho, H.C.; Jeong, J.K. Achieving a Low-Voltage, High-Mobility IGZO Transistor through and ALD-Derived Bilayer Channel and a Hafnia-Based Gate Dielectric Stack. ACS Appl. Mater. Interfaces 2021, 13, 16628–16640. [Google Scholar] [CrossRef] [PubMed]
- Samanta, S.; Chand, U.; Xu, S.; Han, K.; Wu, Y.; Wang, C.; Kumar, A.; Velluri, H.; Li, Y.; Fong, X.; et al. Low Subthreshold Swing and High Mobility Amorphous Indium-Gallium-Zinc-Oxide Thin-Film Transistor with Thin HfO2 Gate Dielectric and Excellent Uniformity. IEEE Electron Device Lett. 2020, 41, 856–859. [Google Scholar] [CrossRef]
- Chu, Y.L.; Young, S.-J.; Ji, L.-W.; Yan, S.-P. Fabrication and Characterization of a-IGZO Thin-Film Transistors with and without Passivation Layers. ECS J. Solid State SCI. Technol. 2021, 10, 027002. [Google Scholar] [CrossRef]
- Jeon, S.; Ahn, S.-E.; Song, I.; Kim, C.J.; Chung, U.-I.; Lee, E.; Yoo, I.; Nathan, A.; Lee, S.; Ghaffarzadeh, K.; et al. Gated three-terminal device architecture to eliminate persistent photoconductivity in oxide semiconductor photosensor arrays. Nat. Mater. 2012, 11, 301–305. [Google Scholar] [CrossRef] [PubMed]
- Yu, Y.; Lv, N.; Zhang, D.; Wei, Y.; Wang, M. High-Mobility Amorphous InGaZnO Thin-Film Transistors with Nitrogen Introduced Via Low-Temperature Annealing. IEEE Electron Device Lett. 2021, 42, 1480–1483. [Google Scholar] [CrossRef]
- Koretomo, D.; Shuhei, H.; Marin, M.; Yusaku, M.; Mamoru, F. Marked improvement in reliability of 150 °C processed IGZO thin-film transistors by applying hydrogenated IGZO as a channel material. Appl. Phys. Express 2020, 13, 076501. [Google Scholar] [CrossRef]
- Cho, M.H.; Seol, H.; Song, A.; Choi, S.; Song, Y.; Yun, P.S.; Chung, K.-B.; Bae, J.U.; Park, K.-S.; Jeong, J.K. Comparative Study on Performance of IGZO Transistors With Sputtered and Atomic Layer Deposited Channel Layer. IEEE Trans. Electron Devices 2019, 66, 1780–1788. [Google Scholar] [CrossRef]
- Mo, F.; Tagawa, Y.; Jin, C.; Ahn, M.; Saraya, T.; Hiramoto, T.; Kobayashi, M. Low-Voltage Operating Ferroelectric FET with Ultrathin IGZO Channel for High-Density Memory Application. IEEE J. Electron Devices Soc. 2020, 8, 717–723. [Google Scholar] [CrossRef]
- Shi, L.; Wang, J.; Zhang, Y. Synergistic improvement of device performance and bias stress stability of IGZO TFT via back-channel graded nitrogen doping. Mater. Lett. 2021, 305, 130749. [Google Scholar] [CrossRef]
- Kim, Y.S.; Lee, M.-H.; Lim, J.H.; Park, J.-S. Impact of tandem IGZO/ZnON TFT with energy-band aligned structure. Appl. Phys. Lett. 2020, 117, 143505. [Google Scholar] [CrossRef]
- Park, C.B.; Na, H.I.; Yoo, S.S.; Park, K.-S. Electromechanical properties of amorphous indium-gallium-zinc-oxide transistors structured with an island configuration on plastic. Appl. Phys. Express 2016, 9, 031101. [Google Scholar] [CrossRef]
- Kim, W.-G.; Tak, Y.J.; Ahn, B.D.; Jung, T.S.; Chung, K.-B.; Kim, H.J. High-pressure gas activation for amorphous indium-gallium-zinc-oxide thin-film transistors at 100 °C. Sci. Rep. 2016, 6, 23039. [Google Scholar] [CrossRef] [PubMed]
- Petti, L.; Munzenrieder, N.; Vogt, C.; Faber, H.; Buthe, L.; Cantarella, G.; Bottacchi, F.; Anthopoulos, T.D.; Troster, G. Metal oxide semiconductor thin-film transistor for flexible electronics. Appl. Phys. Rev. 2016, 3, 021303. [Google Scholar] [CrossRef] [Green Version]
- Shin, Y.; Kim, S.T.; Kim, K.; Kim, M.Y.; Oh, S.; Jeong, J.K. The mobility enhancement of indium gallium zinc oxide transistors via low-temperature crystallization using a tantalum catalytic layer. Sci. Rep. 2017, 7, 10885. [Google Scholar] [CrossRef] [PubMed]
- Suzuki, A.; Yuichi, Y.; Mizukami, S.; Tsuda, K.; Ito, M.; Ohchima, K.; Matsumoto, N.; Yakubo, Y.; Miyata, S.; Okuno, N.; et al. Characteristics and Application of CAAC-IGZO FET with Gate Length of 13 nm. ECS Trans. 2020, 98, 13–27. [Google Scholar] [CrossRef]
- Kato, K.; Shionoiri, Y.; Sekine, Y.; Furutani, K.; Hatano, T.; Aoki, T.; Sasaki, M.; Tomatsu, H.; Koyama, J.; Yamazaki, S. Evaluation of off-state current characteristics of transistor using oxide semiconductor material, indium-gallium-zinc oxide. Jpn. J. Appl. Phys. 2012, 5, 021201. [Google Scholar] [CrossRef]
- Kobayashi, Y.; Matsudo, S.; Matsubayashi, D.; Suzawa, H.; Sakakura, M.; Hanaoka, K.; Okazaki, Y.; Yamamoto, T.; Hondo, S.; Hamada, T.; et al. Electrical characteristics and short-channel effect of c-axis aligned crystal indium gallium zinc oxide transistor with short channel length. Jpn. J. Appl. Phys. 2014, 53, 04EF03. [Google Scholar] [CrossRef]
- Kang, Y.; Lee, W.; Kim, J.; Keum, K.; Kang, S.-H.; Jo, J.-W.; Park, S.K.; Kim, Y.-H. Effects of crystalline structure of IGZO thin films on the electrical and photo-stability of metal-oxide thin-film transistors. Mater. Res. Bull. 2021, 139, 111252. [Google Scholar] [CrossRef]
- Kurokawa, Y.; Aoki, T.; Kozuma, M.; Kimura, H.; Kanemura, T.; Ando, Y.; Yamazaki, S. CAAC-IGZO FET/Si-FET hybrid structured analog multiplier and vector-by-matrix multiplier for neural network. Jpn. J. Appl. Phys. 2020, 59, SGGB03. [Google Scholar] [CrossRef]
- Yamazaki, S.; Atsumi, T.; Dairiki, K.; Okazaki, K.; Kimizuka, N. In-Ga-Zn-Oxide semiconductor and its transistor characteristics. ECS J. Solid State Sci. Technol. 2014, 3, Q3012–Q3022. [Google Scholar] [CrossRef]
- Yamazaki, S.; Yamazaki, S.; Suzawa, H.; Inoue, K.; Kato, K.; Hirohashi, T.; Okazaki, K.; Kimizuka, N. Properties of crystalline In-Ga-Zn-oxide semiconductor and its transistor characteristics. Jpn. J. Appl. Phys. 2014, 53, 04ED18. [Google Scholar] [CrossRef]
- Wang, X.; Shen, Z.; Li, J.; Wu, S. Preparation and Properties of Crystalline IGZO Thin Films. Membrane 2021, 11, 134. [Google Scholar] [CrossRef] [PubMed]
- Kunitake, H.; Ohshima, K.; Tsuda, K.; Matsumoto, N.; Koshida, T.; Ohshita, S.; Sawai, H.; Yanagisawa, Y.; Saga, S.; Arasawa, R.; et al. A C-Axis-Aligned Crystalline In-Ga-Zn Oxide FET with a Gate Length of 21 nm Suitable for Memory Applications. IEEE J. Electron Devices Soc. 2019, 7, 495–502. [Google Scholar] [CrossRef]
- Setten, M.J.V.; Dekkers, H.F.W.; Kljucar, L.; Mitard, J.; Pashartis, C.; Subhechha, S.; Rassoul, N.; Delhougne, R.; Kar, G.S.; Pourtois, G. Oxygen Defect Stability in Amorphous, C-Axis Aligned, and spinel IGZO. ACS Appl. Electron. Mater. 2021, 3, 4037–4046. [Google Scholar] [CrossRef]
- Hwang, A.Y.; Kim, S.T.; Ji, H.; Shin, Y.; Jeong, J.K. Metal-induced crystallization of amorphous zinc tin oxide semiconductors for high mobility thin-film transistors. Appl. Phys. Lett. 2016, 108, 152111. [Google Scholar] [CrossRef]
- Zhang, J.; Wen, X.; Hu, L.; Xu, W.; Zhu, D.; Cao, P.; Liu, W.; Han, S.; Liu, X.; Jia, F.; et al. C-axis oriented crystalline IGZO thin-film transistors by magnetron sputtering. J. Mater. Chem. C 2017, 5, 2388. [Google Scholar] [CrossRef]
- Kurokawa, Y.; Okamoto, Y.; Nakagawa, T.; Aoki, T.; Ikeda, M.; Kozuma, M.; Osada, T.; Ikeda, T.; Yamade, N.; Okazaki, Y.; et al. Applications of crystalline indium-gallium-zinc-oxide technology to LSI: Memory, processor, Image sensor, and field programmable gate array. In Proceedings of the Fifth Asia Symposium on Quality Electronic Design (ASQED 2013), Penang, Malaysia, 26–28 August 2013. [Google Scholar]
- Kozuma, M.; Okamoto, Y.; Nakagawa, T.; Aoki, T.; Ikeda, M.; Osada, T.; Kurokawa, Y.; Ikeda, T.; Yamade, N.; Okazaki, Y.; et al. Crystalline In-Ga-Zn-O FET-based configuration memory for multi-context field-programmable gate array realizing fine-grained power gating. Jpn. J. Appl. Phys. 2014, 53, 04EF12. [Google Scholar] [CrossRef] [Green Version]
- Matsuzaki, T.; Onuki, T.; Nagatsuka, S.; Inoue, H.; Ishizu, T.; Ieda, Y.; Yamade, N.; Miyairi, H.; Sakakura, M.; Shionoiri, Y.; et al. A 16-level-cell memory with c-axis-aligned a-b-plane-anchored crystal In-Ga-Zn oxide FET using threshold voltage cancel write method. Jpn. J. Appl. Phys. 2016, 55, 04EE02. [Google Scholar] [CrossRef]
- Kandpal, K. A review of evolution comes in non-volatile semiconductor memories like SONOS with the role of high-k dielectric material. IOSR J. Eng. IOSRJEN 2014, 4, 13–17. [Google Scholar] [CrossRef]
- Lee, M.C.; Wong, H.Y. Threshold voltage instability mechanisms of nitride-based charge trap flash memory—A review. J. Nanosci. Nanotechnol. 2014, 14, 4799–4812. [Google Scholar] [CrossRef] [PubMed]
- Breuil, L.; Lisoni, J.G.; Blomme, P.; Van den Bosch, G.; Van Houdt, J. HfO2 based high-k inter-gate dielectrics for planar NAND flash memory. IEEE Electron Device Lett. 2014, 35, 45–47. [Google Scholar] [CrossRef]
- Tang, Z.; Liu, Z.; Zhu, X. Progress of high-k dielectric applicable to SONOS-type nonvolatile semiconductor memories. Trans. Electr. Electron. Mater. 2010, 11, 155–165. [Google Scholar] [CrossRef]
- Jeong, S.; Jang, S.; Han, H.; Kim, H.; Choi, C. C-axis aligned crystalline indium-gallium-zinc oxide (CAAC-IGZO) and high-k charge trapping film for flash memory application. J. Alloys Compd. 2021, 888, 161440. [Google Scholar] [CrossRef]
- Linfeng, L.; Peng, J. High-Performance Indium-Gallium-Zinc-Oxide thin-film transistors based on anodic aluminum oxide. Trans. Electron Device 2011, 58, 1452–1455. [Google Scholar] [CrossRef]
- Li, Q.; Yu, Y.-H.; Bhatia, C.S.; Marks, L.D.; Lee, S.C.; Chung, Y.W. Low-temperature magnetron sputter-deposition, hardness, and electrical resistivity of amorphous and crystalline alumina thin films. J. Vac. Sci. Technol. A Vac. Surf. Films 2000, 18, 2333–2338. [Google Scholar] [CrossRef] [Green Version]
- Fulton, C.C.; Lucovsky, G.; Nemanich, R.J. Electronic properties of the Zr-ZrO2-SiO2-Si(100) gate stack structure, J. Appl. Phys. 2006, 99, 063708. [Google Scholar] [CrossRef] [Green Version]
- Lee, C.B.; Kang, B.S.; Benayad, A.; Lee, M.J.; Ahn, S.-E.; Kim, K.H.; Stefanovich, G.; Park, Y.; Yoo, I.K. Effects of metal electrodes on the resistive memory switching property of NiO thin films. Appl. Phys. Lett. 2008, 93, 042115. [Google Scholar] [CrossRef]
- Nomura, K.; Kamiya, T.; Hosono, H. Highly stable amorphous In-Ga-Zn-O thin-film transistors produced by eliminating deep subgap defects. Appl. Phys. Lett. 2011, 99, 053505. [Google Scholar] [CrossRef]
- Zan, H.W.; Yeh, C.-C.; Meng, H.-F.; Tsai, C.-C.; Chen, L.-H. Achieving high field-effect mobility in amorphous indium-gallium-zinc oxide by capping a strong reduction layer. Adv. Mater. 2012, 24, 3509–3514. [Google Scholar] [CrossRef]
- Rajachidambaram, M.S.; Pandey, A.; Vilayurganapathy, S.; Nachimuthu, P.; Thevuthasan, S.; Herman, G.S. Improved stability of amorphous zinc tin oxide thin film transistors using molecular passivation. Appl. Phys. Lett. 2013, 103, 171602. [Google Scholar] [CrossRef]
- Robertson, J.; Guo, Y. Light induced instability mechanism in amorphous InGaZn oxide semiconductors. Appl. Phys. Lett. 2014, 104, 162102. [Google Scholar] [CrossRef]
- Ma, P.; Du, L.; Wang, Y.; Jiang, R.; Xin, Q.; Li, Y.; Song, A. Low voltage operation of IGZO thin film transistors enabled by ultrathin Al2O3 gate dielectric. Appl. Phys. Lett. 2018, 112, 023501. [Google Scholar] [CrossRef] [Green Version]
- Hwang, E.S.; Kim, J.S.; Jeon, S.M.; Lee, S.J.; Jang, Y.; Cho, D.Y.; Hwang, C.S. In2Ga2ZnO7 oxide semiconductor-based charge trap device for NA for NAND flash memory. Nanotechnology 2018, 29, 155203. [Google Scholar] [CrossRef]
- Lei, H.; Qin, P.; Ke, W.; Guo, Y.; Dai, X.; Chen, Z.; Wang, H.; Li, B.; Zheng, Q.; Fang, G. Performance enhancement of polymer solar cells with high work function CuS modified ITO as anodes. Org. Electron 2015, 22, 173–179. [Google Scholar] [CrossRef]
- Kumar, B.; Kauzhik, B.K.; Negi, Y.S. Perspectives and challenges for organic thin film transistors: Materials, devices, processes and applications. J. Mater. Sci. Mater. Electron. 2014, 25, 1–30. [Google Scholar] [CrossRef]

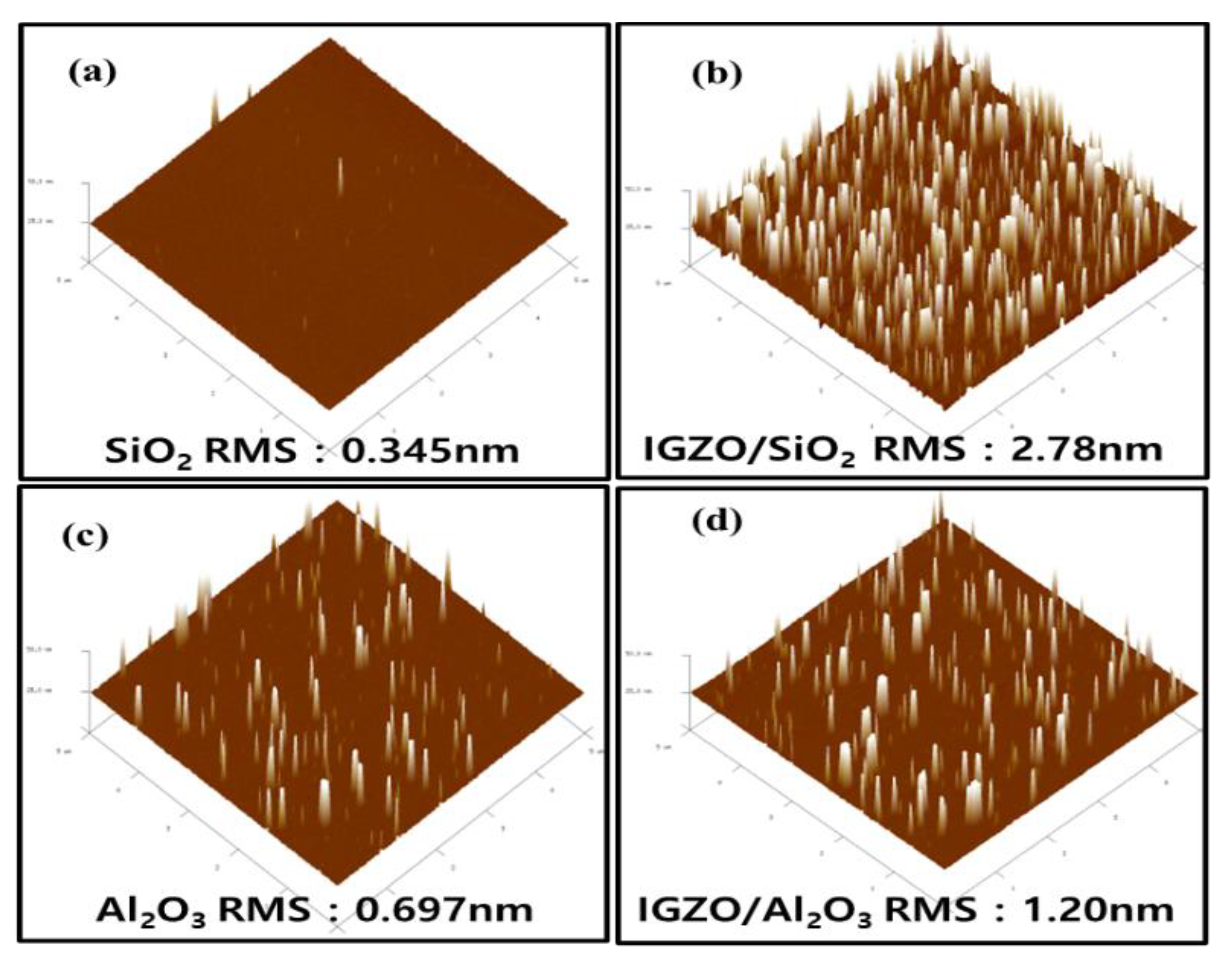
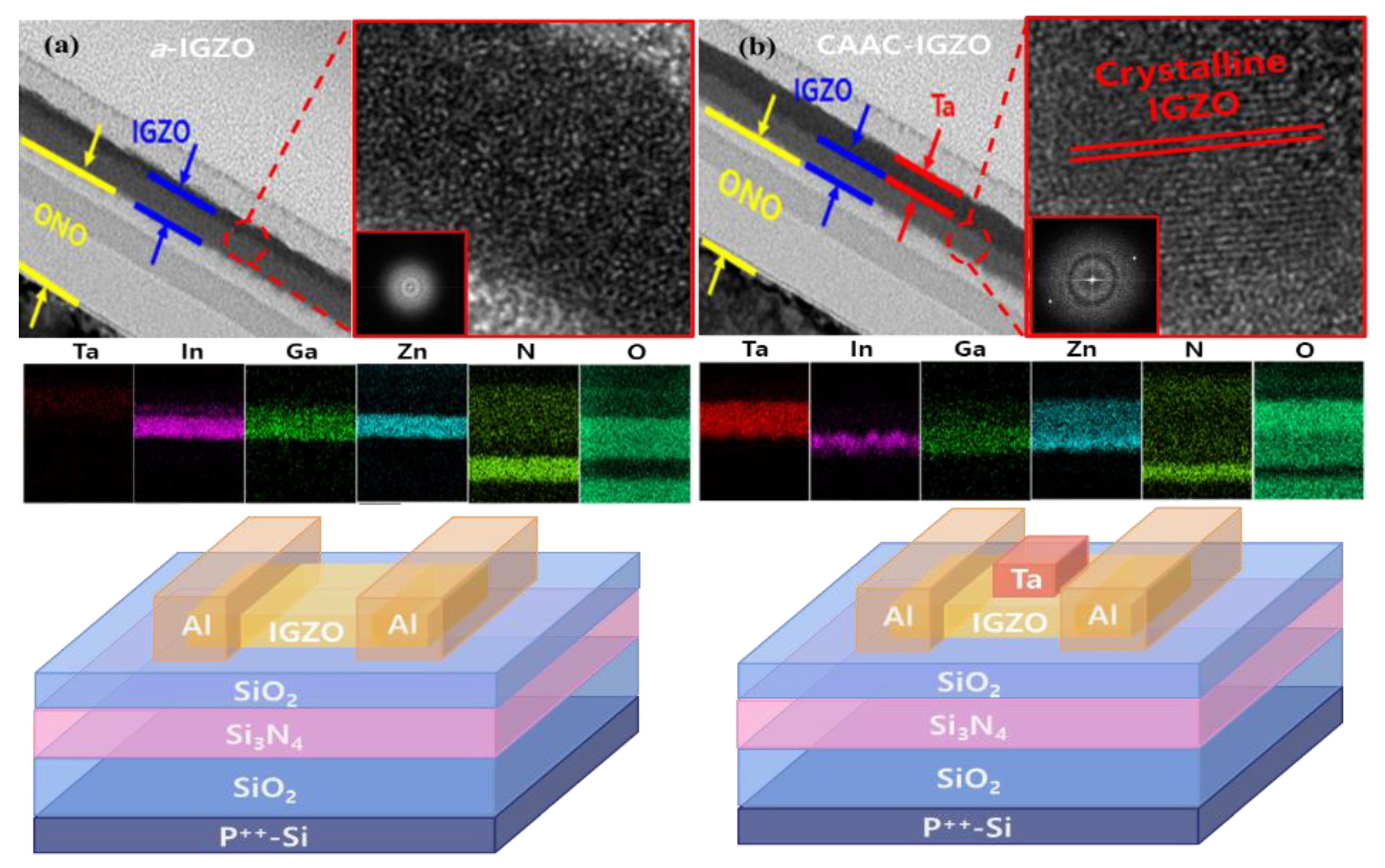

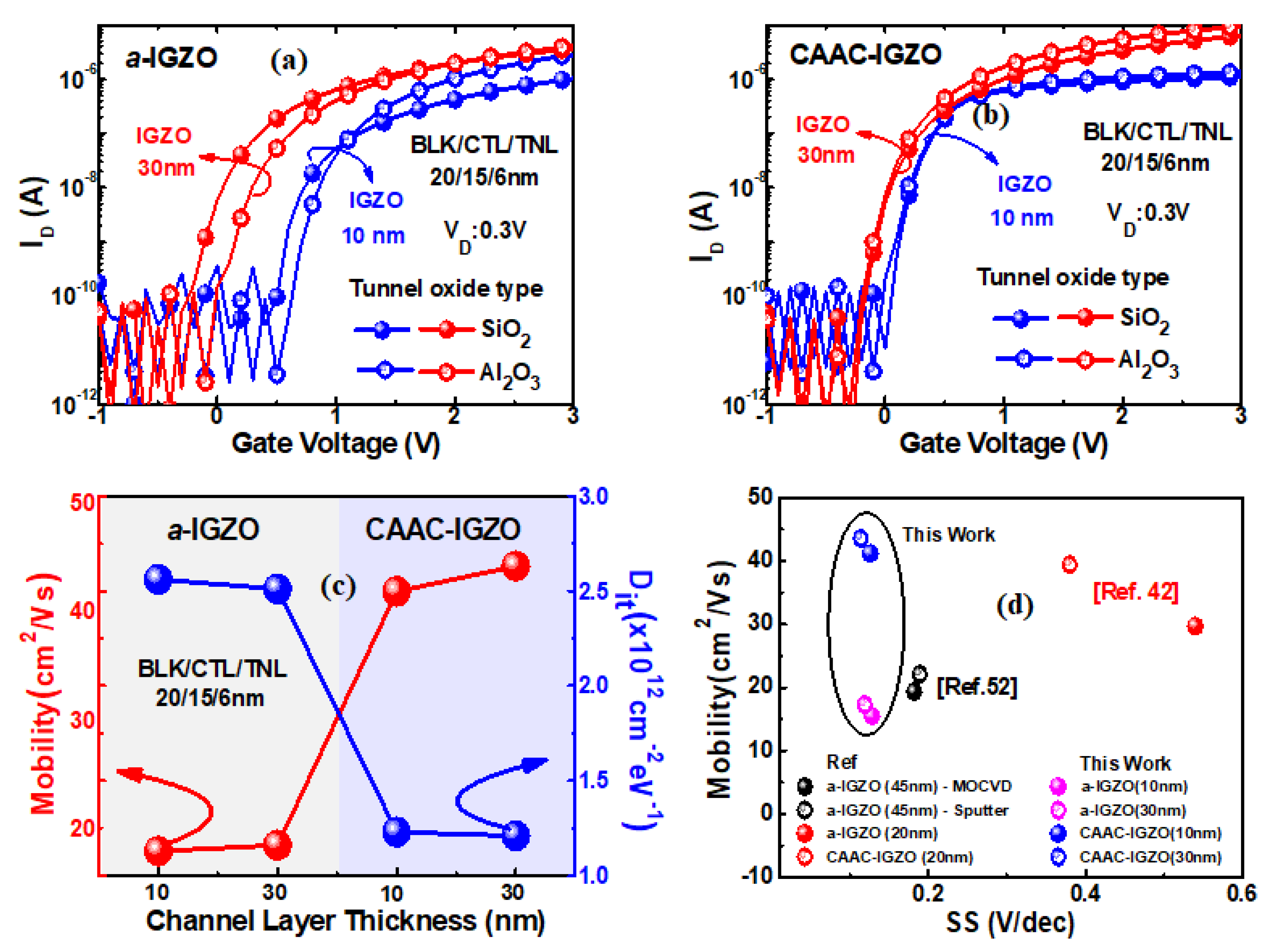

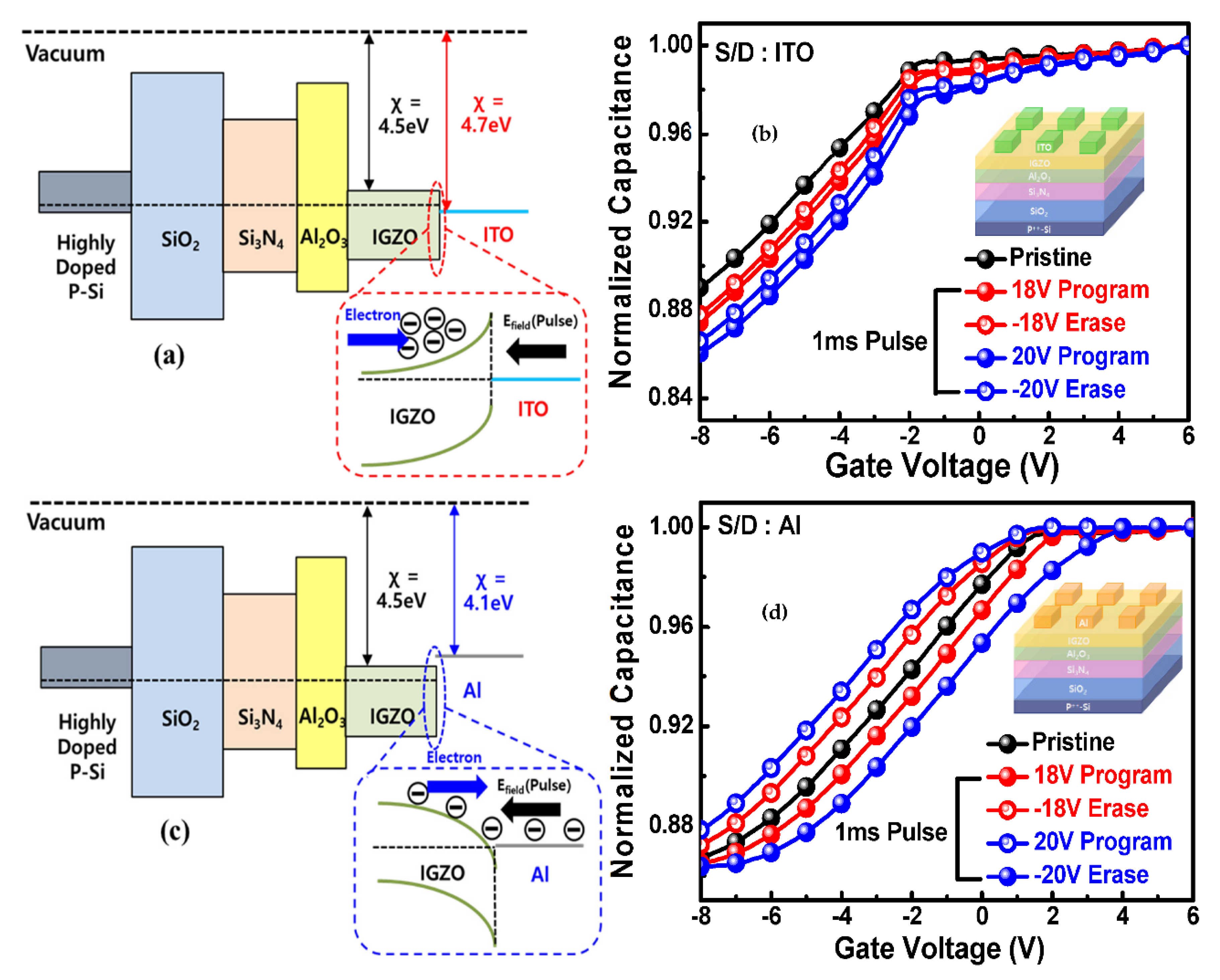
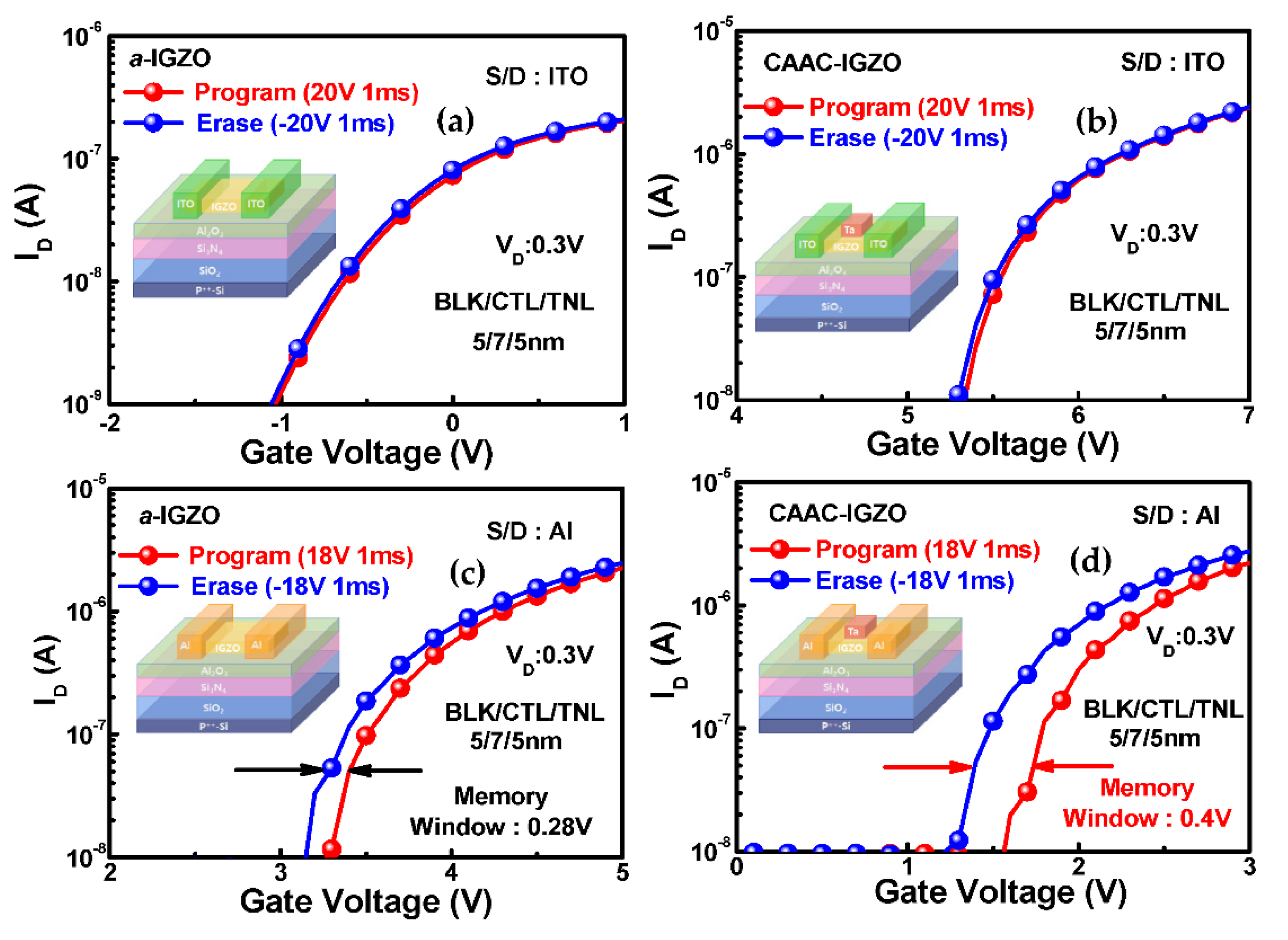
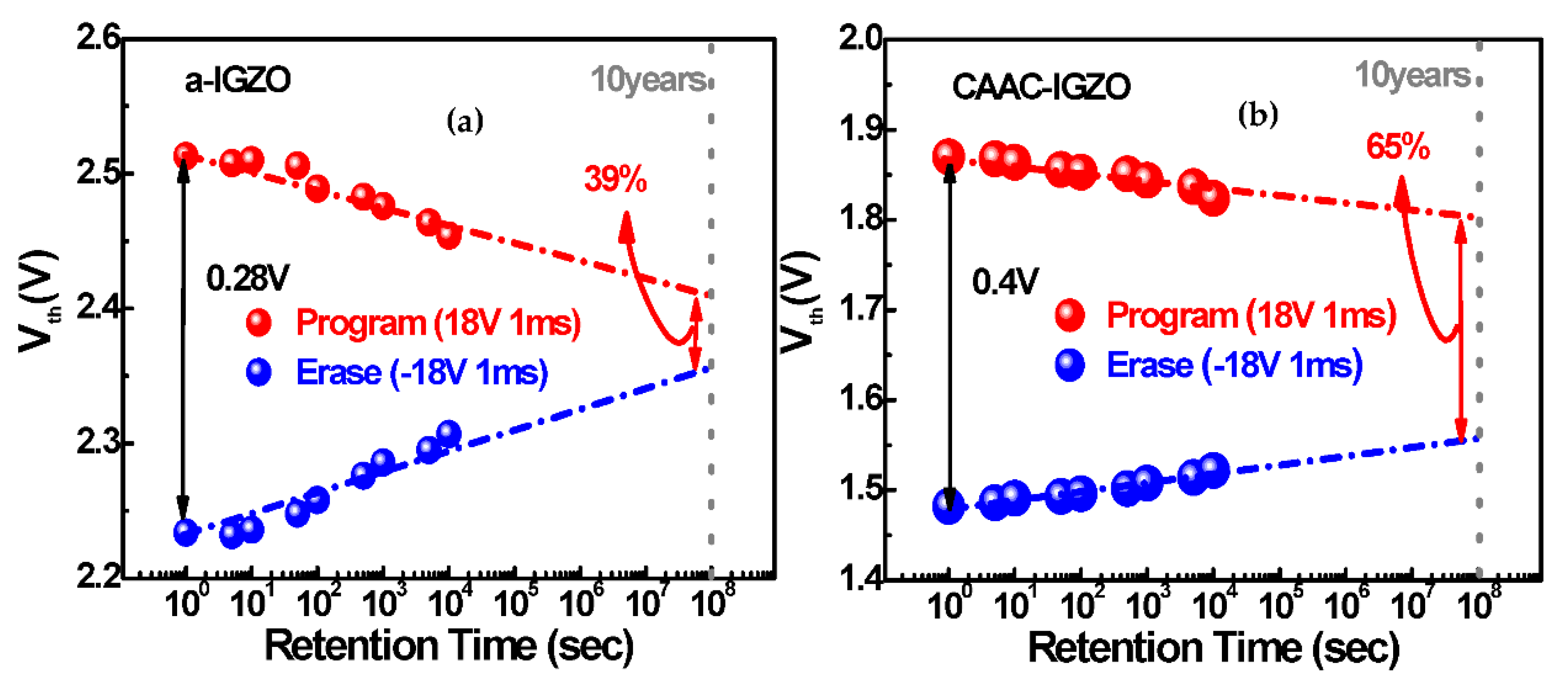
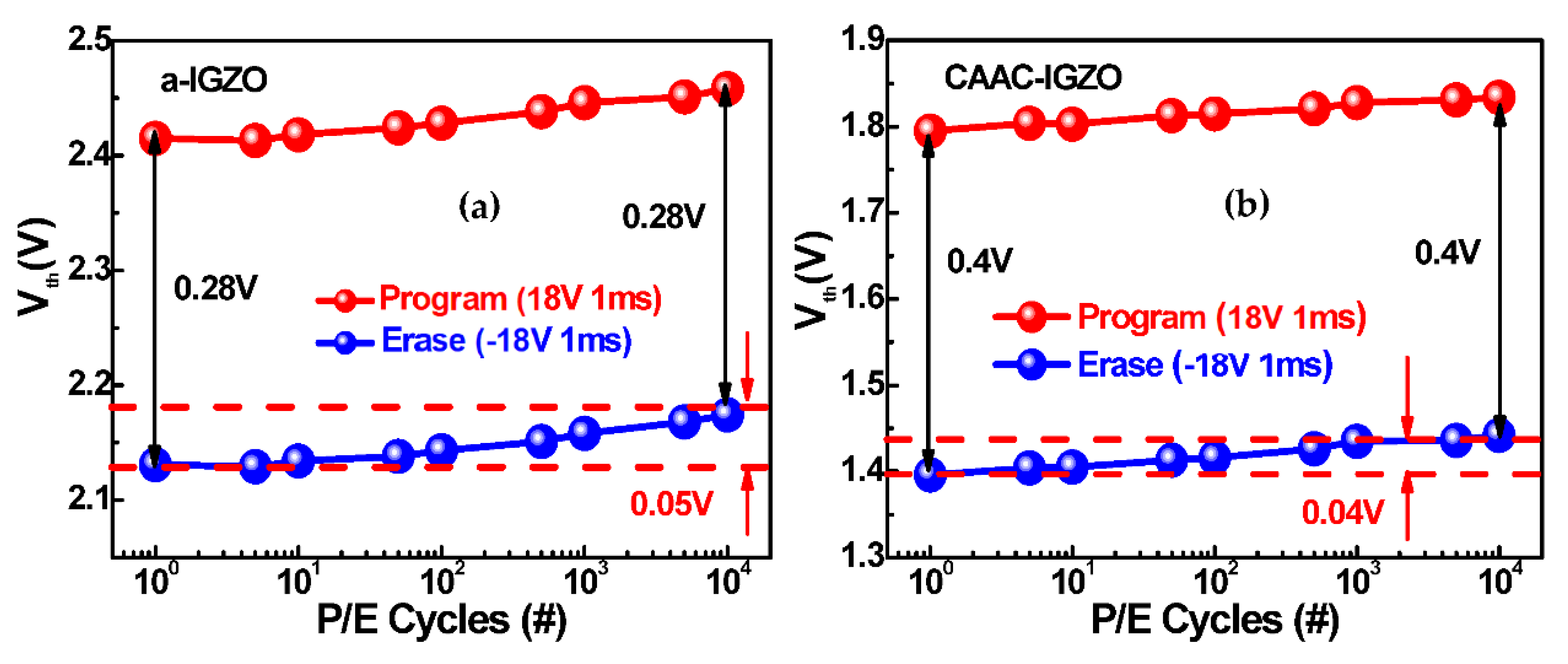
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Han, H.; Jang, S.; Kim, D.; Kim, T.; Cho, H.; Shin, H.; Choi, C. Memory Characteristics of Thin Film Transistor with Catalytic Metal Layer Induced Crystallized Indium-Gallium-Zinc-Oxide (IGZO) Channel. Electronics 2022, 11, 53. https://doi.org/10.3390/electronics11010053
Han H, Jang S, Kim D, Kim T, Cho H, Shin H, Choi C. Memory Characteristics of Thin Film Transistor with Catalytic Metal Layer Induced Crystallized Indium-Gallium-Zinc-Oxide (IGZO) Channel. Electronics. 2022; 11(1):53. https://doi.org/10.3390/electronics11010053
Chicago/Turabian StyleHan, Hoonhee, Seokmin Jang, Duho Kim, Taeheun Kim, Hyeoncheol Cho, Heedam Shin, and Changhwan Choi. 2022. "Memory Characteristics of Thin Film Transistor with Catalytic Metal Layer Induced Crystallized Indium-Gallium-Zinc-Oxide (IGZO) Channel" Electronics 11, no. 1: 53. https://doi.org/10.3390/electronics11010053
APA StyleHan, H., Jang, S., Kim, D., Kim, T., Cho, H., Shin, H., & Choi, C. (2022). Memory Characteristics of Thin Film Transistor with Catalytic Metal Layer Induced Crystallized Indium-Gallium-Zinc-Oxide (IGZO) Channel. Electronics, 11(1), 53. https://doi.org/10.3390/electronics11010053




