Explorations on Growth of Blue-Green-Yellow-Red InGaN Quantum Dots by Plasma-Assisted Molecular Beam Epitaxy
Abstract
:1. Introduction
2. Experiment Details
2.1. Self-Assembled Growth of InGaN QDs
2.2. Measurements of Surface Morphology and Optical Properties
3. Results and Discussion
3.1. Formation Mechanism of Self-Assembled InGaN QDs by PA-MBE
3.2. Parameter Optimization of InGaN QDs
3.3. Phase Diagram of InGaN QDs Grown by PA-MBE
3.4. Nitrogen Modulation Epitaxy Method Based on SK Mode
3.5. Fabrication of InGaN QDs Green LED
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Liu, Z.; Lin, C.H.; Hyun, B.R.; Sher, C.W.; Lv, Z.; Luo, B.; Jiang, F.; Wu, T.; Ho, C.-H.; Kuo, H.-C.; et al. Micro Light Emitting Diodes with Quantum Dots in Display Technology. Light Sci. Appl. 2020, 9, 1–23. [Google Scholar] [CrossRef] [PubMed]
- Wierer Jr, J.J.; Tansu, N. III-Nitride Micro-Leds for Efficient Emissive Displays. Laser Photonics Rev. 2019, 13, 1900141. [Google Scholar] [CrossRef]
- Wang, L.; Wang, L.; Yu, J.; Hao, Z.; Luo, Y.; Sun, C.; Han, Y.J.; Xiong, B.; Wang, J.; Li, H.T. Abnormal Stranski-Krastanov Mode Growth of Green InGaN Quantum Dots: Morphology, Optical Properties, and Applications in Light Emitting Devices. ACS Appl. Mater. Interfaces 2019, 11, 1228–1238. [Google Scholar] [CrossRef] [PubMed]
- Frost, T.; Su, G.L.; Hazari, A.; Dallesasse, J.M.; Bhattacharya, P. Red and near-Infrared III-Nitride Quantum Dot Lasers. IEEE J. Sel. Top. Quantum Electron. 2017, 23, 1–9. [Google Scholar] [CrossRef]
- Bulashevich, K.A.; Karpov, S.Y. Impact of Surface Recombination on Efficiency of III-Nitride Light Emitting Diodes. Phys. Status Solidi-Rapid Res. Lett. 2016, 10, 480–484. [Google Scholar] [CrossRef]
- Li, P.P.; Zhao, Y.B.; Li, H.J.; Che, J.M.; Zhang, Z.H.; Li, Z.C.; Zhang, Y.Y.; Wang, L.C.; Liang, M.; Yi, X.Y.; et al. Very High External Quantum Efficiency and Wall-Plug Efficiency 527nm InGaN Green Leds by MOCVD. Opt. Express 2018, 26, 33108–33115. [Google Scholar] [CrossRef]
- Jiang, X.; Zheng, C.; Mo, C.; Wang, X.; Zhang, J.; Quan, Z.; Liu, J.L.; Jiang, F.Y. Study on the Performance of InGaN-Based Green Led by Designing Different Preparing Layers. Opt. Mater. 2019, 89, 505–511. [Google Scholar] [CrossRef]
- Lv, Q.; Liu, J.; Mo, C.; Zhang, J.; Wu, X.; Wu, Q.; Jiang, F. Realization of Highly Efficient InGaN Green Leds with Sandwich-Like Multiple Quantum Well Structure: Role of Enhanced Interwell Carrier Transport. ACS Photonics 2019, 6, 130–138. [Google Scholar] [CrossRef]
- Royo, P.; Stanley, R.P.; Ilegems, M.; Streubel, K.; Gulden, K.H. Experimental Determination of the Internal Quantum Efficiency of AlGaInP Microcavity Light Emitting Diodes. J. Appl. Phys. 2002, 91, 2563–2568. [Google Scholar] [CrossRef] [Green Version]
- Boroditsky, M.; Gontijo, I.; Jackson, M.; Vrijen, R.; Yablonovitch, E.; Krauss, T.; Cheng, C.C.; Scherer, A.; Bhat, R.; Krames, M. Surface Recombination Measurements on III-V Candidate Materials for Nanostructure Light-Emitting Diodes. J. Appl. Phys. 2000, 87, 3497–3504. [Google Scholar] [CrossRef] [Green Version]
- Wang, Y.; Duan, B.; Deng, G.; Yu, Y.; Niu, Y.; Yu, J.; Ma, H.; Shi, Z.; Zhang, B.; Zhang, Y. The Study of Properties of Blue-Green InGaN/GaN Multiple Quantum Wells Grown at Different Pressures. Superlattices Microstruct. 2021, 153, 106863. [Google Scholar] [CrossRef]
- Samuel, B.; Cooper, D.; Rochat, N.; Mavel, A.; Barbier, F.; Dussaigne, A. Origins of Nanoscale Emission Inhomogeneities of High Content Red Emitting InGaN/InGaN Quantum Wells. J. Appl. Phys. 2021, 129, 173105. [Google Scholar] [CrossRef]
- Srivastava, S.K.; Pramanik, M.; Palit, D.; Mathur, B.K.; Kar, A.K.; Ray, B.S.; Haeuseler, H.; Cordes, W. Electrical, Optical, and Scanning Tunneling Microscopic Studies on Layer Type CdIn2S4−x Sex (1.75 ≤ x ≤ 2.75). Chem. Mater. 2001, 13, 4342–4347. [Google Scholar] [CrossRef]
- Zhao, C.; Tang, C.W.; Lai, B.; Cheng, G.; Wang, J.; Lau, K.M. Low-Efficiency-Droop InGaN Quantum Dot Light Emitting Diodes Operating in the “Green Gap”. Photonics Res. 2020, 8, 750–754. [Google Scholar] [CrossRef]
- Schulz, S.; O’Reilly, E.P. Theory of Reduced Built-in Polarization Field in Nitride-Based Quantum Dots. Phys. Rev. B 2010, 82, 033411. [Google Scholar] [CrossRef]
- Wu, Y.-R.; Lin, Y.-Y.; Huang, H.-H.; Singh, J. Electronic and Optical Properties of Ingan Quantum Dot Based Light Emitters for Solid State Lighting. J. Appl. Phys. 2009, 105, 013117. [Google Scholar] [CrossRef] [Green Version]
- Wang, L.; Yang, D.; Hao, Z.B.; Luo, Y. Metal-Organic-Vapor Phase Epitaxy of InGaN Quantum Dots and Their Applications in Light-Emitting Diodes. Chin. Phys. B 2015, 24, 067303. [Google Scholar] [CrossRef]
- Banerjee, A.; Frost, T.; Jahangir, S.; Stark, E.; Bhattacharya, P. InGaN/GaN Self-Organized Quantum Dot Lasers Grown by Molecular Beam Epitaxy. J. Cryst. Growth 2013, 378, 566–570. [Google Scholar] [CrossRef]
- Lv, W.; Wang, L.; Wang, J.; Xing, Y.; Zheng, J.; Yang, D.; Hao, Z.; Luo, Y. Green and Red Light-Emitting Diodes Based on Multilayer InGaN/GaN n Dots Grown by Growth Interruption Method. Jpn. J. Appl. Phys. 2013, 52, 08JG13. [Google Scholar] [CrossRef]
- Wei, X.; Al Muyeed, S.A.; Xue, H.; Palmese, E.; Song, R.; Tansu, N.; Wierer, J.J. Near-Infrared Electroluminescence of Algan Capped InGaN Quantum Dots Formed by Controlled Growth on Photoelectrochemical Etched Quantum Dot Templates. Photonics Res. 2022, 10, 33–40. [Google Scholar] [CrossRef]
- Iida, D.; Ohkawa, K. Recent Progress in Red Light-Emitting Diodes by III-Nitride Materials. Semicond. Sci. Technol. 2022, 37, 013001. [Google Scholar] [CrossRef]
- Cho, I.W.; Lee, B.; Ryu, M.Y.; Lee, K.; Kim, J.S. Luminescence Properties of InGaN/GaN Light-Emitting Diodes with Violet, Blue, and Green Emission. J. Korean Phys. Soc. 2021, 78, 275–279. [Google Scholar] [CrossRef]
- Dussaigne, A.; Barbier, F.; Damilano, B.; Chenot, S.; Grenier, A.; Papon, A.M.; Samuel, B.; Ben Bakir, B.; Vaufrey, D.; Pillet, J.C.; et al. Full InGaN Red Light Emitting Diodes. J. Appl. Phys. 2020, 128, 135704. [Google Scholar] [CrossRef]
- Mariette, H. Formation of Self-Assembled Quantum Dots Induced by the Stranski-Krastanow Transition: A Comparison of Various Semiconductor Systems. Comptes Rendus Phys. 2005, 6, 23–32. [Google Scholar] [CrossRef]
- Hums, C.; Finger, T.; Hempel, T.; Christen, J.; Dadgar, A.; Hoffmann, A.; Krost, A. Fabry-Perot Effects in InGaN/GaN Heterostructures on Si-Substrate. J. Appl. Phys. 2007, 101, 033113. [Google Scholar] [CrossRef]
- Kumagai, Y.; Kikuchi, J.; Matsuo, Y.; Kangawa, Y.; Tanaka, K.; Koukitu, A. Thermodynamic Analysis of Inn and InxGa1−XN Movpe Using Various Nitrogen Sources. J. Cryst. Growth 2004, 272, 341–347. [Google Scholar] [CrossRef]
- Liu, L.; Wang, L.; Liu, N.; Yang, W.; Li, D.; Chen, W.; Feng, Z.C.; Lee, Y.C.; Ferguson, I.; Hu, X. D Investigation of the Light Emission Properties and Carrier Dynamics in Dual-Wavelength InGaN/GaN Multiple-Quantum Well Light Emitting Diodes. J. Appl. Phys. 2012, 112, 083101. [Google Scholar] [CrossRef]
- Zhao, C.; Tang, C.W.; Cheng, G.; Wang, J.; Lau, K.M. InGaN Quantum Dots with Short Exciton Lifetimes Grown on Polar C-Plane by Metal-Organic Chemical Vapor Deposition. Mater. Res. Express 2020, 7, 115903. [Google Scholar] [CrossRef]
- Damilano, B.; Demolon, P.; Brault, J.; Huault, T.; Natali, F.; Massies, J. Blue-Green and White Color Tuning of Monolithic Light Emitting Diodes. J. Appl. Phys. 2010, 108, 073115. [Google Scholar] [CrossRef]
- Cho, J.; Schubert, E.F.; Kim, J.K. Efficiency Droop in Light-Emitting Diodes: Challenges and Countermeasures. Laser Photonics Rev. 2013, 7, 408–421. [Google Scholar] [CrossRef]
- Hader, J.; Moloney, J.V.; Koch, S.W. Temperature-Dependence of the Internal Efficiency Droop in GaN-Based Diodes. Appl. Phys. Lett. 2011, 99, 181127. [Google Scholar] [CrossRef]
- Malyutenko, V.K.; Bolgov, S.S.; Podoltsev, A. Current Crowding Effect on the Ideality Factor and Efficiency Droop in Blue Lateral InGaN/GaN Light Emitting Diodes. Appl. Phys. Lett. 2010, 97, 251110. [Google Scholar] [CrossRef]
- Verzellesi, G.; Saguatti, D.; Meneghini, M.; Bertazzi, F.; Goano, M.; Meneghesso, G.; Zanoni, E. Efficiency Droop in InGaN/GaN Blue Light-Emitting Diodes: Physical Mechanisms and Remedies. J. Appl. Phys. 2013, 114, 071101. [Google Scholar] [CrossRef]
- Zhao, Y.; Oh, S.H.; Wu, F.; Kawaguchi, Y.; Tanaka, S.; Fujito, K.; Speck, J.S.; Denbaars, S.; Nakamura, S. Green Semipolar (2021) InGaN Light-Emitting Diodes with Small Wavelength Shift and Narrow Spectral Linewidth. Appl. Phys. Express 2013, 6, 062102. [Google Scholar] [CrossRef]
- Lv, W.; Wang, L.; Wang, L.; Xing, Y.; Yang, D.; Hao, Z.; Luo, Y. InGaN Quantum Dot Green Light-Emitting Diodes with Negligible Blue Shift of Electroluminescence Peak Wavelength. Appl. Phys. Express 2014, 7, 025203. [Google Scholar] [CrossRef]
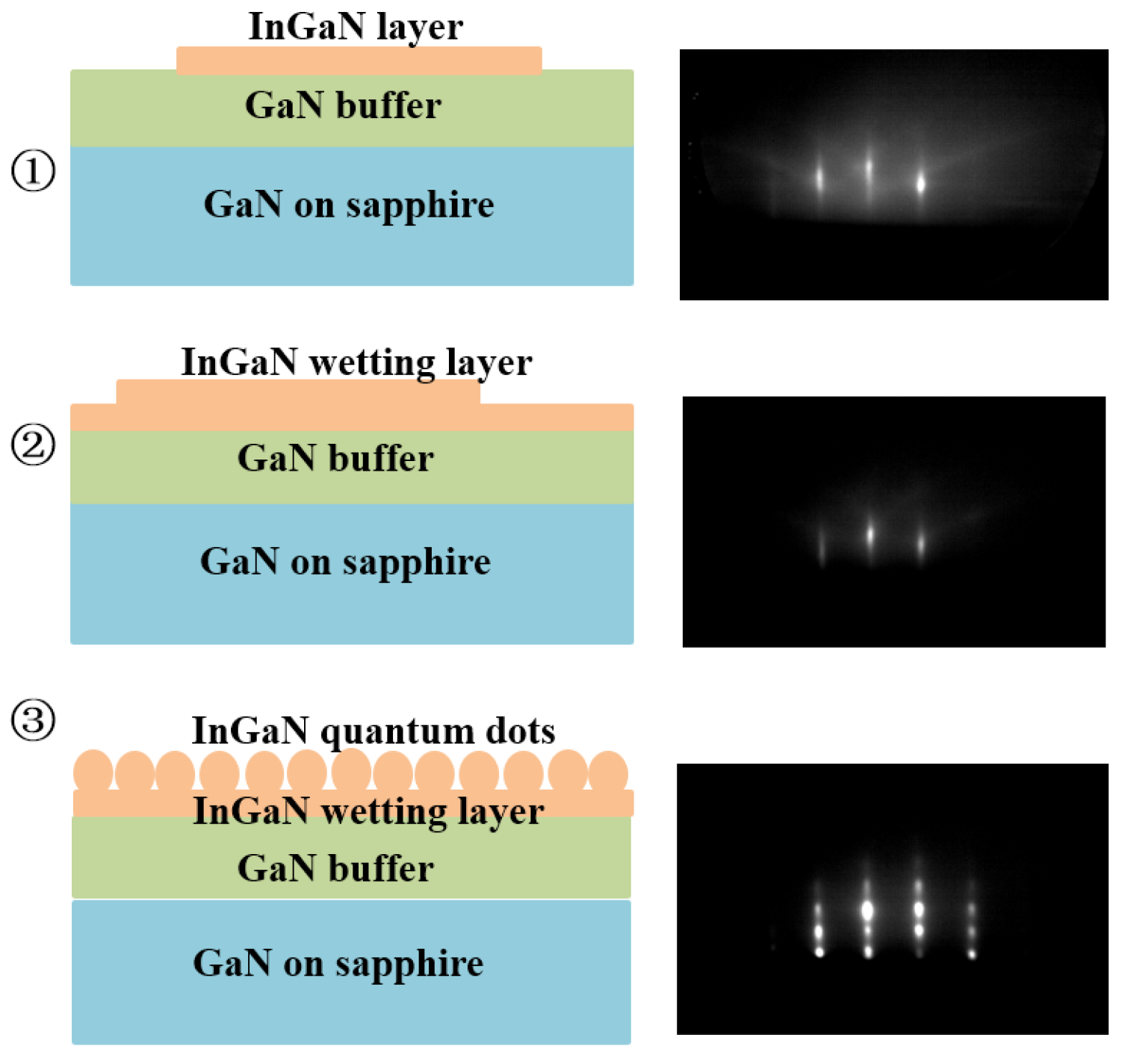
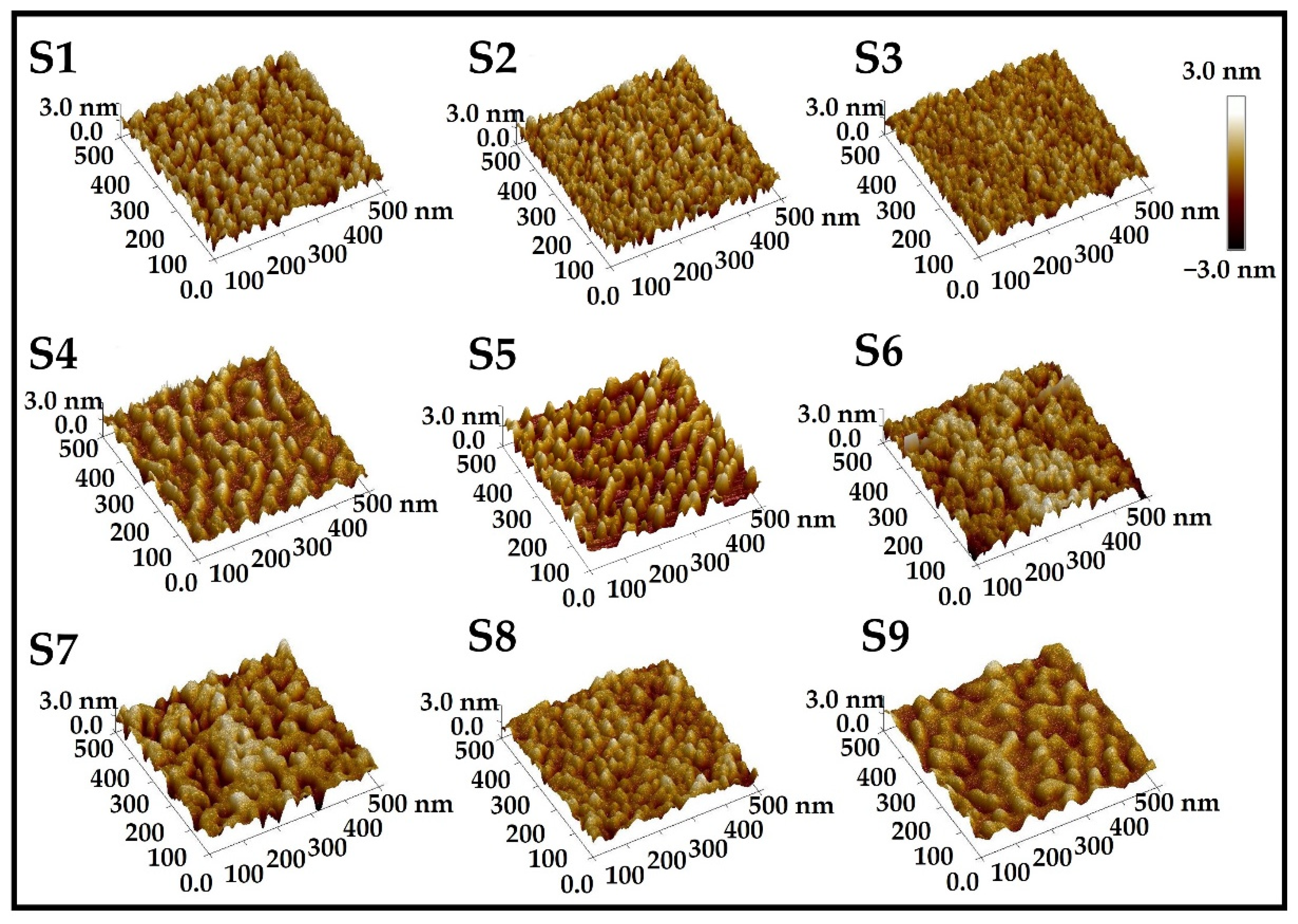
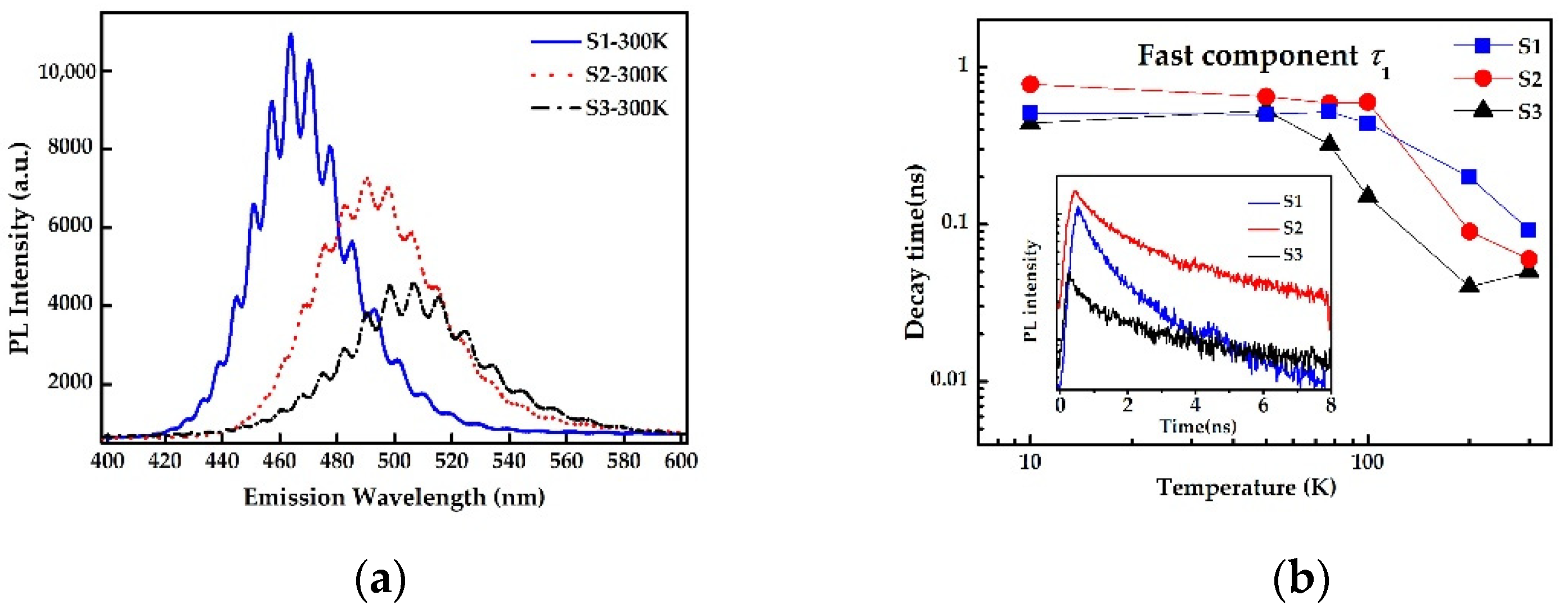

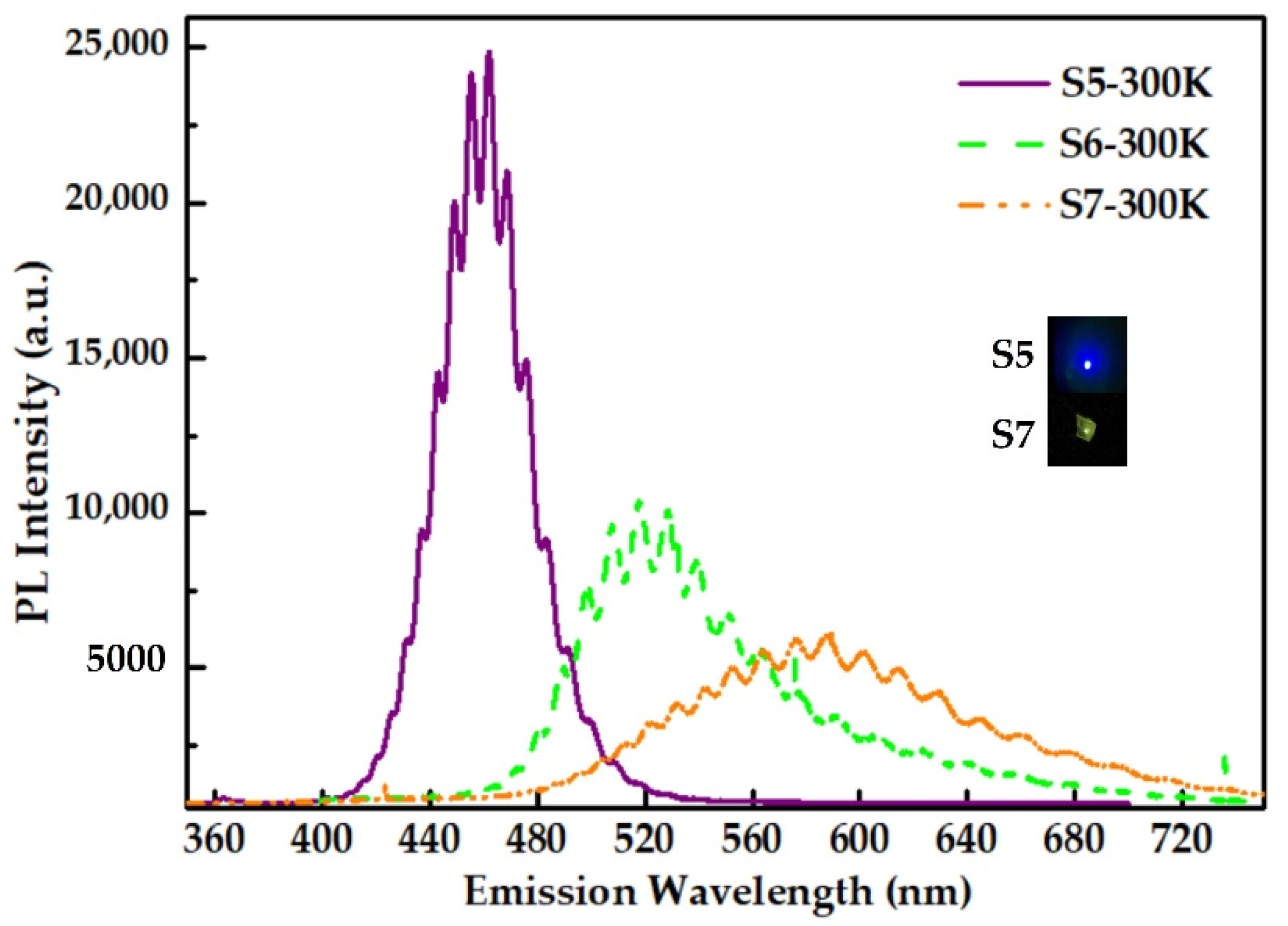
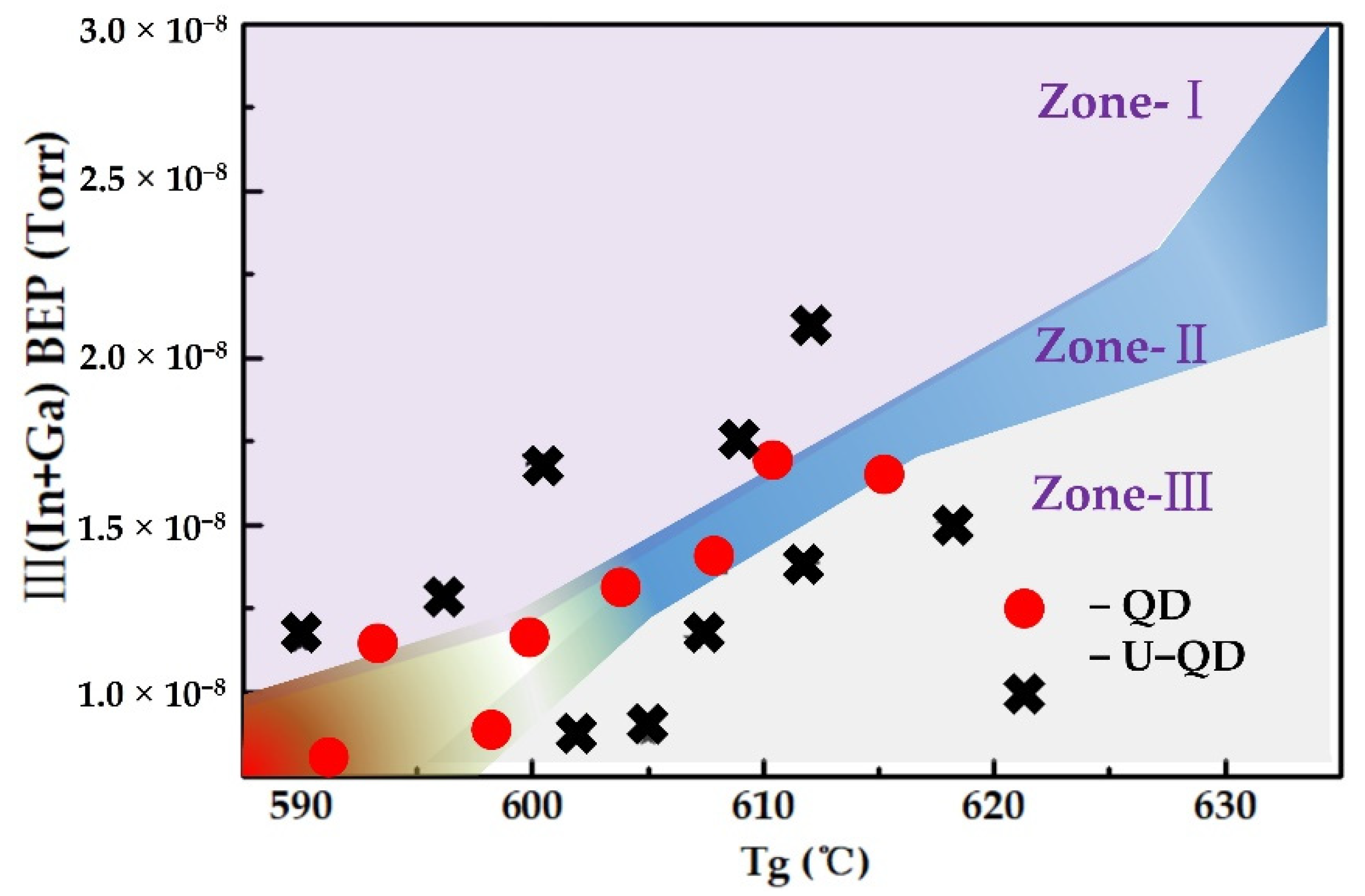


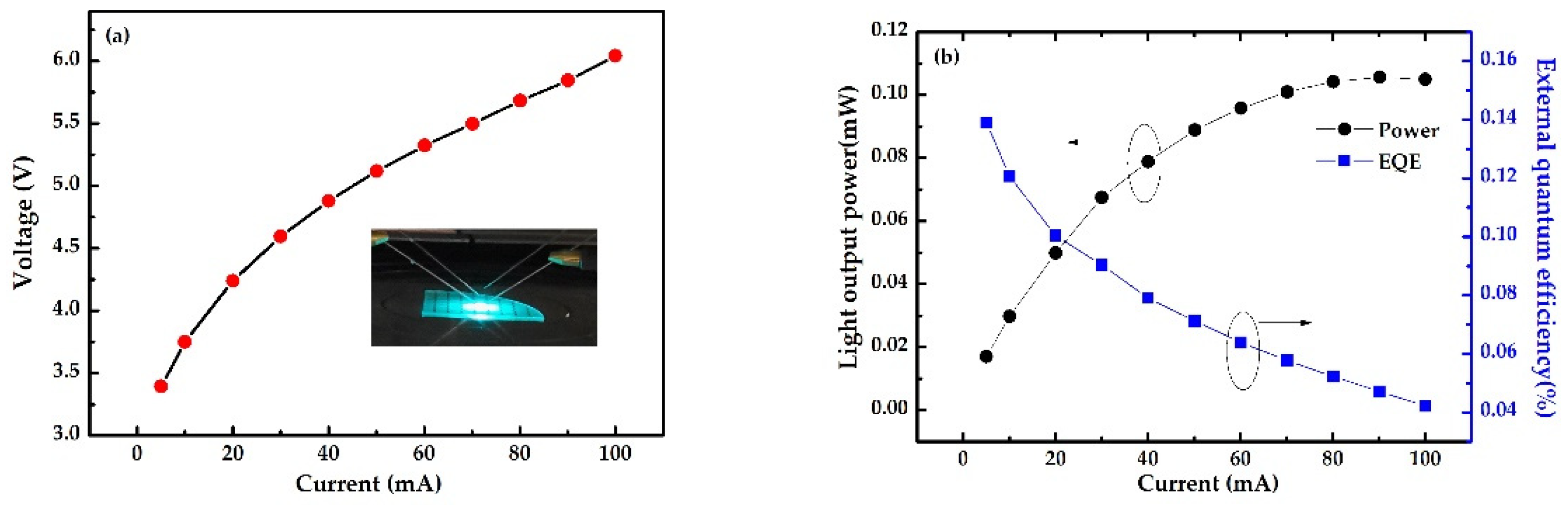
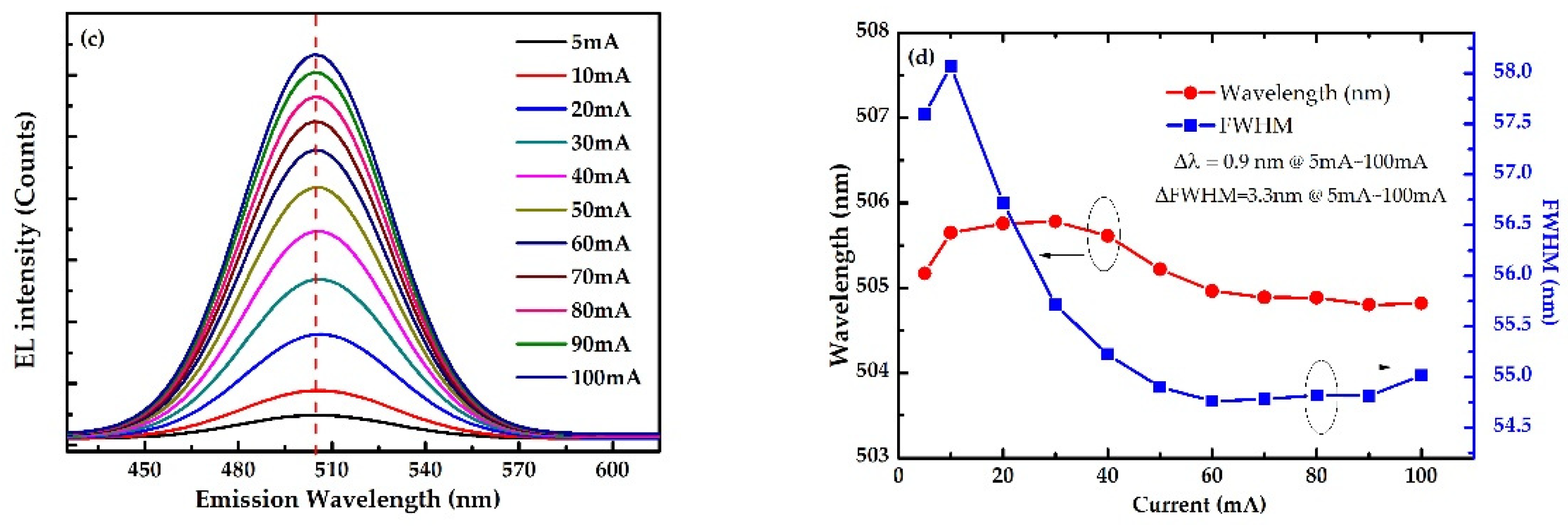
| Sample | Tg/(°C) | N2 Flux/Power (Sccm/W) | Tg/(min) | In BEP/(torr) | Ga BEP/(torr) | λ@RT/(nm) |
|---|---|---|---|---|---|---|
| S1 | 610 | 1.5/430 | 7 | 1.2 × 10−8 | 4 × 10−9 | 463 |
| S2 | 610 | 1.5/430 | 7 | 1 × 10−8 | 6 × 10−9 | 496 |
| S3 | 610 | 1.5/430 | 7 | 9 × 10−9 | 7 × 10−9 | 507 |
| S4 | 610 | 1.0/400 | 7 | 1.2 × 10−8 | 4 × 10−9 | 460 |
| S5 | 610 | 0.6/350 | 7 | 1.2 × 10−8 | 4 × 10−9 | 462 |
| S6 | 605 | 1.5/430 | 7 | 9 × 10−9 | 3 × 10−9 | 523 |
| S7 | 595 | 1.5/430 | 7 | 7.5 × 10−9 | 2.5 × 10−9 | 581 |
| S8 | 605 | 1.5/430 | 4 + (30 s/30 s) ∗ 3 | 9 × 10−9 | 3 × 10−9 | 598 |
| S9 | 605 | 1.5/430 | 4 + (15 s/15 s) ∗ 6 | 9 × 10−9 | 3 × 10−9 | 622 |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2022 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Zhang, X.; Xing, Z.; Yang, W.; Qiu, H.; Gu, Y.; Suzuki, Y.; Kaneko, S.; Matsuda, Y.; Izumi, S.; Nakamura, Y.; et al. Explorations on Growth of Blue-Green-Yellow-Red InGaN Quantum Dots by Plasma-Assisted Molecular Beam Epitaxy. Nanomaterials 2022, 12, 800. https://doi.org/10.3390/nano12050800
Zhang X, Xing Z, Yang W, Qiu H, Gu Y, Suzuki Y, Kaneko S, Matsuda Y, Izumi S, Nakamura Y, et al. Explorations on Growth of Blue-Green-Yellow-Red InGaN Quantum Dots by Plasma-Assisted Molecular Beam Epitaxy. Nanomaterials. 2022; 12(5):800. https://doi.org/10.3390/nano12050800
Chicago/Turabian StyleZhang, Xue, Zhiwei Xing, Wenxian Yang, Haibing Qiu, Ying Gu, Yuta Suzuki, Sakuya Kaneko, Yuki Matsuda, Shinji Izumi, Yuichi Nakamura, and et al. 2022. "Explorations on Growth of Blue-Green-Yellow-Red InGaN Quantum Dots by Plasma-Assisted Molecular Beam Epitaxy" Nanomaterials 12, no. 5: 800. https://doi.org/10.3390/nano12050800
APA StyleZhang, X., Xing, Z., Yang, W., Qiu, H., Gu, Y., Suzuki, Y., Kaneko, S., Matsuda, Y., Izumi, S., Nakamura, Y., Cai, Y., Bian, L., Lu, S., & Tackeuchi, A. (2022). Explorations on Growth of Blue-Green-Yellow-Red InGaN Quantum Dots by Plasma-Assisted Molecular Beam Epitaxy. Nanomaterials, 12(5), 800. https://doi.org/10.3390/nano12050800





