High Linearity Synaptic Devices Using Ar Plasma Treatment on HfO2 Thin Film with Non-Identical Pulse Waveforms
Abstract
1. Introduction
2. Materials and Methods
3. Results
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Demchenko, Y.; de Laat, C.; Membrey, P. Defining architecture components of the Big Data Ecosystem. In Proceedings of the 2014 International Conference on Collaboration Technologies and Systems (CTS), Minneapolis, MN, USA, 19–23 May 2014. [Google Scholar] [CrossRef]
- Merolla, P.A.; Arthur, J.V.; Alvarez-Icaza, R.; Cassidy, A.S.; Sawada, J.; Akopyan, F.; Jackson, B.L.; Imam, N.; Guo, C.; Nakamura, Y.; et al. A million spiking-neuron integrated circuit with a scalable communication network and interface. Science 2014, 345, 668–673. [Google Scholar] [CrossRef] [PubMed]
- Mead, C. Analog VLSI and Neural Systems; Addison-Wesley: Boston, MA, USA, January 1989; p. 3. [Google Scholar]
- Yu, S.; Gao, B.; Fang, Z.; Yu, H.; Kang, J.; Wong, H.-S.P. A neuromorphic visual system using RRAM synaptic devices with sub-pJ energy and tolerance to variability: Experimental characterization and large-scale modeling. In Proceedings of the 2012 International Electron Devices Meeting, San Francisco, CA, USA, 10–13 December 2012; pp. 10.4.1–10.4.4. [Google Scholar] [CrossRef]
- Woo, J.; Padovani, A.; Moon, K.; Kwak, M.; Larcher, L.; Hwang, H. Linking Conductive Filament Properties and Evolution to Synaptic Behavior of RRAM Devices for Neuromorphic Applications. IEEE Electron Device Lett. 2017, 38, 1220–1223. [Google Scholar] [CrossRef]
- Ohno, T.; Hasegawa, T.; Tsuruoka, T.; Terabe, K.; Gimzewski, J.K.; Aono, M. Short-term plasticity and long-term potentiation mimicked in single inorganic synapses. Nat. Mater. 2011, 10, 591–595. [Google Scholar] [CrossRef] [PubMed]
- Thunder, S.; Pal, P.; Wang, Y.-H.; Huang, P.-T. Ultra Low Power 3D-Embedded Convolutional Neural Network Cube Based on α-IGZO Nanosheet and Bi-Layer Resistive Memory. In Proceedings of the 2021 International Conference on IC Design and Technology (ICICDT), Dresden, Germany, 15–17 September 2021. [Google Scholar] [CrossRef]
- Hughes, J.R. Post-tetanic potentiation. Physiol. Rev. 1958, 38, 91–113. [Google Scholar] [CrossRef] [PubMed]
- Ielmini, D.; Wong, H.-S.P. In-Memory Computing with Resistive Switching Devices. Nat. Electron. 2018, 1, 333–343. [Google Scholar] [CrossRef]
- Pal, P.; Thunder, S.; Tsai, M.-J.; Huang, P.-T.; Wang, Y.H. Benchmarking the Performance of Heterogeneous Stacked RRAM with CFETSRAM and MRAM for Deep Neural Network Application Amidst Variation and Noise. In Proceedings of the 2021 International Symposium on VLSI Technology, Systems and Applications (VLSI-TSA), Hsinchu, Taiwan, 19–22 April 2021; pp. 1–2. [Google Scholar] [CrossRef]
- Wang, I.-T.; Chang, C.-C.; Chiu, L.-W.; Chou, T.; Hou, T.-H. 3D Ta/TaOx/TiO2/Ti synaptic array and linearity tuning of weight update for hardware neural network applications. Nanotechnology 2016, 27, 365204. [Google Scholar] [CrossRef] [PubMed]
- Chandrasekaran, S.; Simanjuntak, F.M.; Panda, D.; Tseng, T.Y. Enhanced synaptic linearity in ZnO-based invisible memristive synapse by introducing double pulsing scheme. IEEE Trans. Electron Devices 2019, 66, 4722–4726. [Google Scholar] [CrossRef]
- Chen, P.-Y.; Lin, B.; Wang, I.-T.; Hou, T.-H.; Ye, J.; Vrudhula, S.; Seo, J.-S.; Cao, Y.; Yu, S. Mitigating effects of non-ideal synaptic device characteristics for on-chip learning. In Proceedings of the 2015 IEEE/ACM International Conference on Computer-Aided Design (ICCAD), Austin, TX, USA, 2–6 November 2015. [Google Scholar] [CrossRef]
- Kim, H.-D.; Yun, M.J.; Hong, S.M.; Park, J.H.; Jeon, D.S.; Kim, T.G. Impact of roughness of bottom electrodes on the resistive switching properties of platinum/nickel nitride/nickel 1 × 1 crossbar array resistive random access memory cells. Microelectron. Eng. 2014, 126, 169–172. [Google Scholar] [CrossRef]
- Cavallini, M.; Hemmatian, Z.; Riminucci, A.; Prezioso, M.; Morandi, V.; Murgia, M. Regenerable Resistive Switching in Silicon Oxide Based Nanojunctions. Adv. Mater. 2012, 24, 1197–1201. [Google Scholar] [CrossRef] [PubMed]
- Peng, W.-C.; Chen, Y.-C.; He, J.-L.; Ou, S.-L.; Horng, R.-H.; Wuu, D.-S. Tunability of p- and n-channel TiOx thin film transistors. Sci. Rep. 2018, 8, 9255. [Google Scholar] [CrossRef] [PubMed]
- Pal, P.; Mazumder, S.; Huang, C.-W.; Lu, D.D.; Wang, Y.-H. Impact of the Barrier Layer on the High Thermal and Mechanical Stability of a Flexible Resistive Memory in a Neural Network Application. ACS Appl. Electron. Mater. 2022, 4, 1072–1081. [Google Scholar] [CrossRef]
- Sze, S.M.; Ng, K.K. Physics of Semiconductor Devices, 3rd ed.; John Wiley & Sons: Hoboken, NJ, USA, 2006. [Google Scholar] [CrossRef]
- Monaghan, S.; Hurley, P.; Cherkaoui, K.; Negara, M.; Schenk, A. Determination of electron effective mass and electron affinity in HfO2 using MOS and MOSFET structures. Solid-State Electron. 2009, 53, 438–444. [Google Scholar] [CrossRef]
- Yoon, J.H.; Song, S.J.; Yoo, I.-H.; Seok, J.Y.; Yoon, K.J.; Kwon, D.E.; Park, T.H.; Hwang, C.S. Highly Uniform, Electroforming-Free, and Self-Rectifying Resistive Memory in the Pt/Ta2O5/HfO2-x/TiN Structure. Adv. Funct. Mater. 2014, 24, 5086–5095. [Google Scholar] [CrossRef]
- Pal, P.; Lee, K.-J.; Thunder, S.; De, S.; Huang, P.-T.; Kampfe, T.; Wang, Y.-H. Bending Resistant Multi-bit Memristor for Flexible Precision Inference Engine Application. IEEE Trans. Electron Devices 2022, 69, 4737–4743. [Google Scholar] [CrossRef]
- Wei, Y.; Xu, Q.; Wang, Z.; Liu, Z.; Pan, F.; Zhang, Q.; Wang, J. Growth properties and optical properties for HfO2 thin films deposited by atomic layer deposition. J. Alloys Compd. 2018, 735, 1422–1426. [Google Scholar] [CrossRef]
- Samanta, S.; Rahaman, S.Z.; Roy, A.; Jana, S.; Chakrabarti, S.; Panja, R.; Roy, S.; Dutta, M.; Ginnaram, S.; Prakash, A.; et al. Understanding of multi-level resistive switching mechanism in GeOx through redox reaction in H2O2/sarcosine prostate cancer biomarker detection. Sci. Rep. 2017, 7, 1–12. [Google Scholar] [CrossRef] [PubMed]
- Calka, P.; Sowinska, M.; Bertaud, T.; Walczyk, D.; Dabrowski, J.; Zaumseil, P.; Walczyk, C.; Gloskovskii, A.; Cartoixà, X.; Suñé, J.; et al. Engineering of the Chemical Reactivity of the Ti/HfO2 Interface for RRAM: Experiment and Theory. ACS Appl. Mater. Interfaces 2014, 6, 5056–5060. [Google Scholar] [CrossRef] [PubMed]
- Woo, J.; Moon, K.; Song, J.; Lee, S.; Kwak, M.; Park, J.; Hwang, H. Improved synaptic behavior under identical pulses using AlOx/HfO2 bilayer RRAM array for neuromorphic systems. IEEE Electron Device Lett. 2016, 37, 994–997. [Google Scholar] [CrossRef]
- Ku, B.; Abbas, Y.; Kim, S.; Sokolov, A.S.; Jeon, Y.-R.; Choi, C. Improved resistive switching and synaptic characteristics using Ar plasma irradiation on the Ti/HfO2 interface. J. Alloys Compd. 2019, 797, 277–283. [Google Scholar] [CrossRef]
- Hasegawa, T.; Ohno, T.; Terabe, K.; Tsuruoka, T.; Nakayama, T.; Gimzewski, J.K.; Aono, M. Learning abilities achieved by a single solid-state atomic switch. Adv. Mater. 2010, 22, 1831–1834. [Google Scholar] [CrossRef] [PubMed]
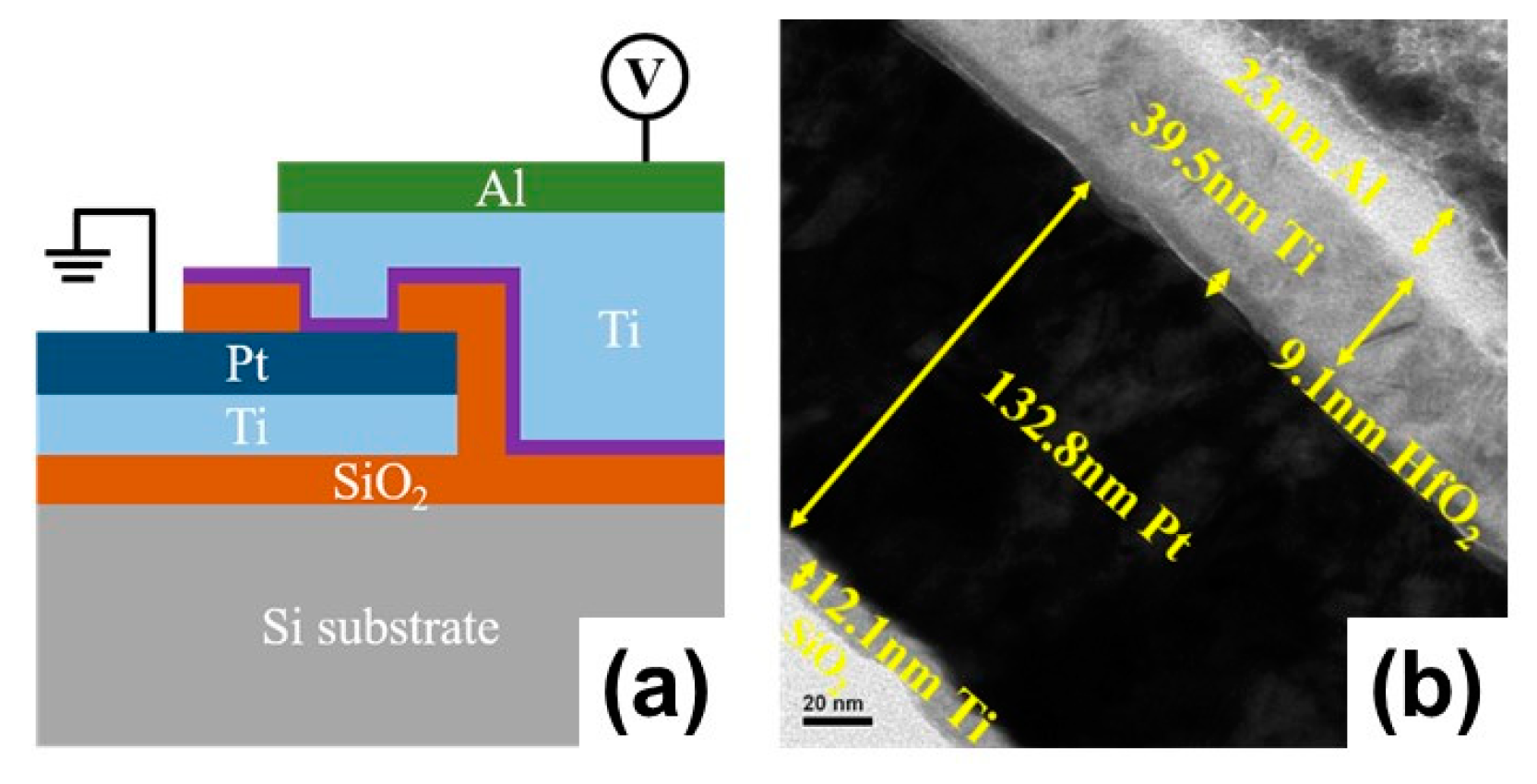




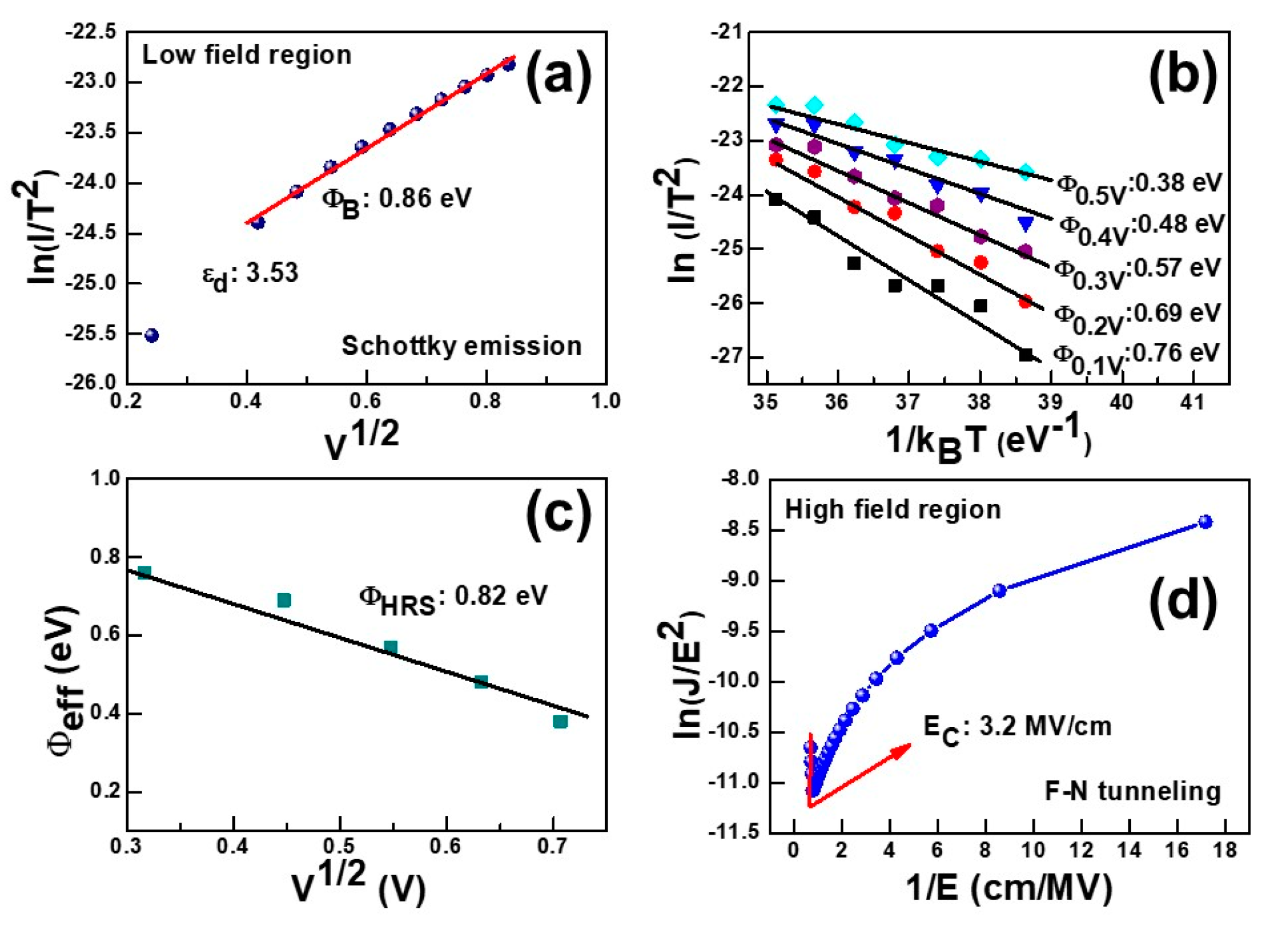





Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2022 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Lee, K.-J.; Weng, Y.-C.; Wang, L.-W.; Lin, H.-N.; Pal, P.; Chu, S.-Y.; Lu, D.; Wang, Y.-H. High Linearity Synaptic Devices Using Ar Plasma Treatment on HfO2 Thin Film with Non-Identical Pulse Waveforms. Nanomaterials 2022, 12, 3252. https://doi.org/10.3390/nano12183252
Lee K-J, Weng Y-C, Wang L-W, Lin H-N, Pal P, Chu S-Y, Lu D, Wang Y-H. High Linearity Synaptic Devices Using Ar Plasma Treatment on HfO2 Thin Film with Non-Identical Pulse Waveforms. Nanomaterials. 2022; 12(18):3252. https://doi.org/10.3390/nano12183252
Chicago/Turabian StyleLee, Ke-Jing, Yu-Chuan Weng, Li-Wen Wang, Hsin-Ni Lin, Parthasarathi Pal, Sheng-Yuan Chu, Darsen Lu, and Yeong-Her Wang. 2022. "High Linearity Synaptic Devices Using Ar Plasma Treatment on HfO2 Thin Film with Non-Identical Pulse Waveforms" Nanomaterials 12, no. 18: 3252. https://doi.org/10.3390/nano12183252
APA StyleLee, K.-J., Weng, Y.-C., Wang, L.-W., Lin, H.-N., Pal, P., Chu, S.-Y., Lu, D., & Wang, Y.-H. (2022). High Linearity Synaptic Devices Using Ar Plasma Treatment on HfO2 Thin Film with Non-Identical Pulse Waveforms. Nanomaterials, 12(18), 3252. https://doi.org/10.3390/nano12183252





