Anisotropic Etching of InGaN Thin Films with Photoelectrochemical Etching to Form Quantum Dots
Abstract
1. Introduction
2. Materials and Methods
3. Results and Discussion
3.1. Photoelectrochemical Etching Results
3.2. Photoelectrochemical Etching Model
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Wierer, J.J.; Tansu, N.; Fischer, A.J.; Tsao, J.Y. III-nitride quantum dots for ultra-efficient solid-state lighting. Laser Photonics Rev. 2016, 10, 612–622. [Google Scholar] [CrossRef]
- Wang, L.; Wei, Z.X.; Chen, C.J.; Wang, L.; Fu, H.Y.; Zhang, L.; Chen, K.C.; Wu, M.C.; Dong, Y.H.; Hao, Z.B.; et al. 1.3 GHz E-O bandwidth GaN-based micro-LED for multi-gigabit visible light communication. Photon. Res. 2021, 9, 792–802. [Google Scholar] [CrossRef]
- Wei, Z.; Zhang, L.; Wang, L.; Chen, C.-J.; Pepe, A.; Liu, X.; Chen, K.-C.; Wu, M.-C.; Dong, Y.; Wang, L.; et al. 2 Gbps/3 m air–underwater optical wireless communication based on a single-layer quantum dot blue micro-LED. Opt. Lett. 2020, 45, 2616–2619. [Google Scholar] [CrossRef]
- Ladd, T.D.; Jelezko, F.; Laflamme, R.; Nakamura, Y.; Monroe, C.; O’Brien, J.L. Quantum computers. Nature 2010, 464, 45–53. [Google Scholar] [CrossRef]
- Holmes, M.J.; Zhu, T.; Massabuau, F.C.-P.; Jarman, J.; Oliver, R.A.; Arakawa, Y. Pure single-photon emission from an InGaN/GaN quantum dot. APL Mater. 2021, 9, 061106. [Google Scholar] [CrossRef]
- Arakawa, Y.; Sakaki, H. Multidimensional quantum well laser and temperature dependence of its threshold current. Appl. Phys. Lett. 1982, 40, 939–941. [Google Scholar] [CrossRef]
- Tachibana, K.; Someya, T.; Arakawa, Y. Nanometer-scale InGaN self-assembled quantum dots grown by metalorganic chemical vapor deposition. Appl. Phys. Lett. 1999, 74, 383–385. [Google Scholar] [CrossRef]
- Ee, Y.-K.; Zhao, H.; Arif, R.A.; Jamil, M.; Tansu, N. Self-assembled InGaN quantum dots on GaN emitting at 520nm grown by metalorganic vapor-phase epitaxy. J. Cryst. Growth 2008, 310, 2320–2325. [Google Scholar] [CrossRef]
- Kadir, A.; Meissner, C.; Schwaner, T.; Pristovsek, M.; Kneissl, M. Growth mechanism of InGaN quantum dots during metalorganic vapor phase epitaxy. J. Cryst. Growth 2011, 334, 40–45. [Google Scholar] [CrossRef]
- Damilano, B.; Grandjean, N.; Dalmasso, S.; Massies, J. Room-temperature blue-green emission from InGaN/GaN quantum dots made by strain-induced islanding growth. Appl. Phys. Lett. 1999, 75, 3751–3753. [Google Scholar] [CrossRef]
- Frost, T.; Banerjee, A.; Sun, K.; Chuang, S.L.; Bhattacharya, P. InGaN/GaN Quantum Dot Red 630 nm Laser. IEEE J. Quantum Electron. 2013, 49, 923–931. [Google Scholar] [CrossRef]
- Reddy, G.V.A.; Shaik, H.; Kumar, K.N.; Shetty, H.D.; Jafri, R.I.; Naik, R.; Gupta, J.; Sattar, S.A.; Doreswamy, B.H. Synthesis, characterizations, and electrochromic studies of WO3 coated CeO2 nanorod thin films for smart window applications. Phys. B Condens. Matter 2022, 647, 414395. [Google Scholar] [CrossRef]
- Mantarcı, A. Detailed Structural and Morphological Characterization of InGaN Thin Films Grown by RF Magnetron Sputtering with Various Substrate Temper. Celal Bayar Univ. J. Sci. 2019, 15, 151–160. [Google Scholar] [CrossRef]
- Zhang, X.; Xing, Z.; Yang, W.; Qiu, H.; Gu, Y.; Suzuki, Y.; Kaneko, S.; Matsuda, Y.; Izumi, S.; Nakamura, Y.; et al. Explorations on Growth of Blue-Green-Yellow-Red InGaN Quantum Dots by Plasma-Assisted Molecular Beam Epitaxy. Nanomaterials 2022, 12, 800. [Google Scholar] [CrossRef]
- Yu, J.D.; Wang, L.; Yang, D.; Hao, Z.B.; Luo, Y.; Sun, C.Z.; Han, Y.J.; Xiong, B.; Wang, J.; Li, H.T. Improving the internal quantum efficiency of green InGaN quantum dots through coupled InGaN/GaN quantum well and quantum dot structure. Appl. Phys. Express 2015, 8, 094001. [Google Scholar] [CrossRef]
- Zhao, C.; Tang, C.W.; Lai, B.; Cheng, G.; Wang, J.; Lau, K.M. Low-efficiency-droop InGaN quantum dot light-emitting diodes operating in the green gap. Photon. Res. 2020, 8, 750–754. [Google Scholar] [CrossRef]
- Xiao, X.Y.; Fischer, A.J.; Wang, G.T.; Lu, P.; Koleske, D.D.; Coltrin, M.E.; Wright, J.B.; Liu, S.; Brener, I.; Subramania, G.S.; et al. Quantum-Size-Controlled Photoelectrochemical Fabrication of Epitaxial InGaN Quantum Dots. Nano Lett. 2014, 14, 5616–5620. [Google Scholar] [CrossRef]
- Xiao, X.Y.; Fischer, A.J.; Coltrin, M.E.; Lu, P.; Koleske, D.D.; Wang, G.T.; Polsky, R.; Tsao, J.Y. Photoelectrochemical etching of epitaxial InGaN thin films: Self-limited kinetics and nanostructuring. Electrochim. Acta 2015, 162, 163–168. [Google Scholar] [CrossRef]
- Xiao, X.Y.; Lu, P.; Fischer, A.J.; Coltrin, M.E.; Wang, G.T.; Koleske, D.D.; Tsao, J.Y. Influence of pH on the Quantum-Size-Controlled Photoelectrochemical Etching of Epitaxial InGaN Quantum Dots. J. Phys. Chem. C 2015, 119, 28194–28198. [Google Scholar] [CrossRef]
- Muyeed, S.A.A.; Wei, X.; Borovac, D.; Song, R.; Tansu, N.; Jonathan, J.; Wierer, J. Controlled growth of InGaN quantum dots on photoelectrochemically etched InGaN quantum dots templates. J. Cryst. Growth 2020, 540, 125652. [Google Scholar] [CrossRef]
- Wei, X.; Muyeed, S.A.A.; Peart, M.R.; Sun, W.; Tansu, N.; Wierer, J.J. Room temperature luminescence of passivated InGaN quantum dots formed by quantum-sized-controlled photoelectrochemical etching. Appl. Phys. Lett. 2018, 113, 121106. [Google Scholar] [CrossRef]
- Wei, X.; Al Muyeed, S.A.; Xue, H.; Palmese, E.; Song, R.; Tansu, N.; Wierer, J.J. Near-infrared electroluminescence of AlGaN capped InGaN quantum dots formed by controlled growth on photoelectrochemical etched quantum dot templates. Photon. Res. 2022, 10, 33–40. [Google Scholar] [CrossRef]
- Rajeshwar, K. Fundamentals of Semiconductor Electrochemistry and Photoelectrochemistry. Encycl. Electrochem. 2007, 6, 1–53. [Google Scholar]
- Gwyddion. Available online: http://gwyddion.net (accessed on 20 January 2023).
- Birner, S.; Zibold, T.; Andlauer, T.; Kubis, T.; Sabathil, M.; Trellakis, A.; Vogl, P. nextnano: General Purpose 3-D Simulations. IEEE Trans. Electron Devices 2007, 54, 2137–2142. [Google Scholar] [CrossRef]
- Kadir, A.; Bellmann, K.; Simoneit, T.; Pristovsek, M.; Kneissl, M. Influence of group III and group V partial pressures on the size and density of InGaN quantum dots in MOVPE. Phys. Status Solidi A 2012, 209, 2487–2491. [Google Scholar] [CrossRef]
- Lv, W.B.; Wang, L.; Wang, J.X.; Hao, Z.B.; Luo, Y. InGaN/GaN multilayer quantum dots yellow-green light-emitting diode with optimized GaN barriers. Nanoscale Res. Lett. 2012, 7, 617. [Google Scholar] [CrossRef] [PubMed]
- Figge, S.; Tessarek, C.; Aschenbrenner, T.; Hommel, D. InGaN quantum dot growth in the limits of Stranski-Krastanov and spinodal decomposition. Phys. Status Solidi B 2011, 248, 1765–1776. [Google Scholar] [CrossRef]
- Wang, G.T.; Li, Q.; Wierer, J.J.; Koleske, D.D.; Figiel, J.J. Top–down fabrication and characterization of axial and radial III-nitride nanowire LEDs. Phys. Status Solidi A 2014, 211, 748–751. [Google Scholar] [CrossRef]
- Al Taradeh, N.; Frayssinet, E.; Rodriguez, C.; Morancho, F.; Sonneville, C.; Phung, L.-V.; Soltani, A.; Tendille, F.; Cordier, Y.; Maher, H. Characterization of m-GaN and a-GaN Crystallographic Planes after Being Chemically Etched in TMAH Solution. Energies 2021, 14, 4241. [Google Scholar] [CrossRef]
- Stocker, D.A.; Schubert, E.F.; Redwing, J.M. Crystallographic wet chemical etching of GaN. Appl. Phys. Lett. 1998, 73, 2654–2656. [Google Scholar] [CrossRef]
- Chuang, S.L. Physics of Photonic Devices, 2nd ed.; John Wiley & Sons: Hoboken, NJ, USA, 2009; p. xvii. 821p. [Google Scholar]
- David, A.; Grundmann, M.J. Influence of polarization fields on carrier lifetime and recombination rates in InGaN-based light-emitting diodes. Appl. Phys. Lett. 2010, 97, 033501. [Google Scholar] [CrossRef]
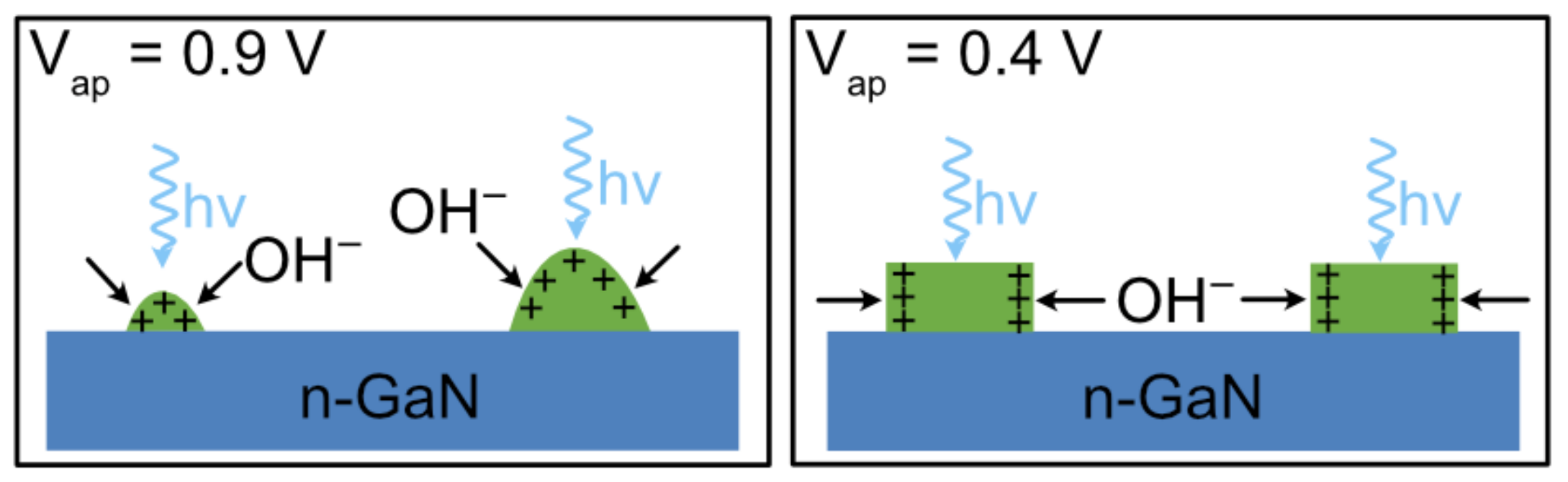

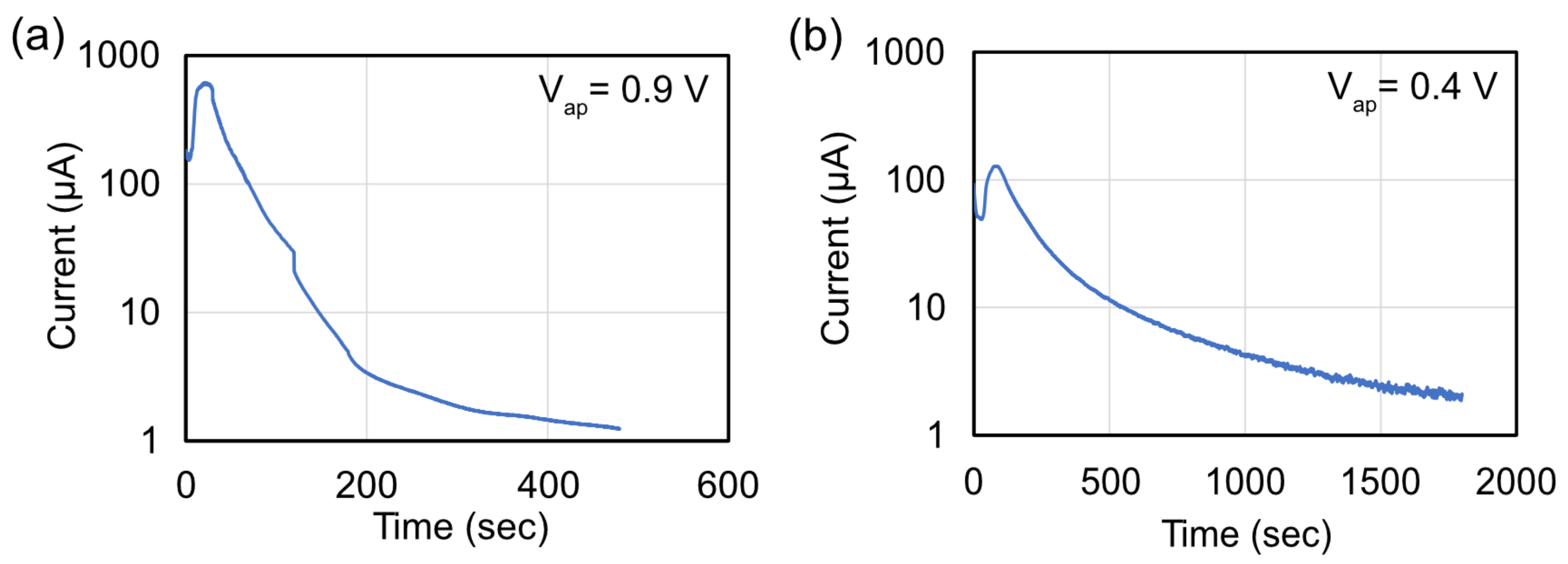
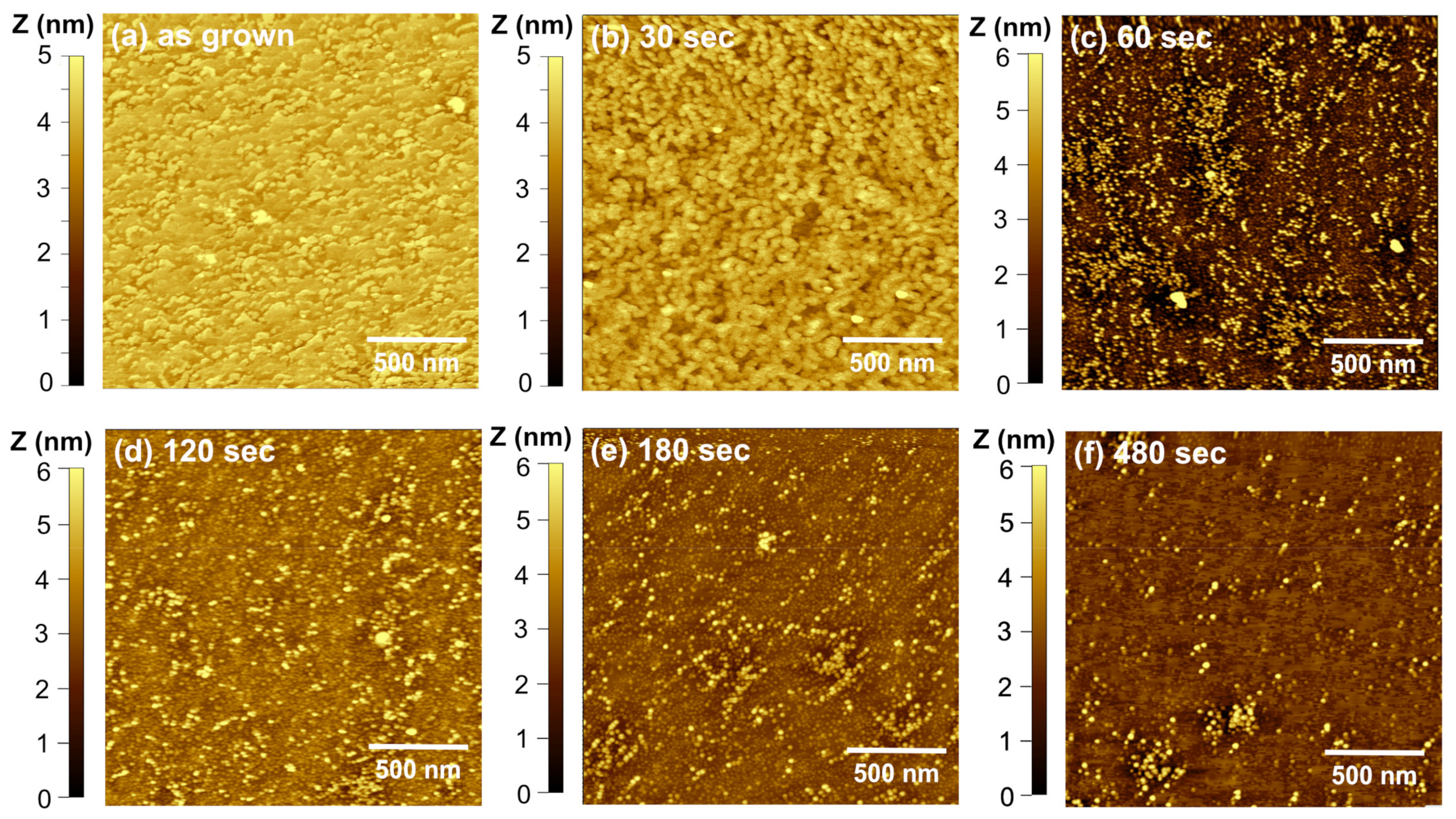




Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Wei, X.; Al Muyeed, S.A.; Xue, H.; Wierer, J.J., Jr. Anisotropic Etching of InGaN Thin Films with Photoelectrochemical Etching to Form Quantum Dots. Materials 2023, 16, 1890. https://doi.org/10.3390/ma16051890
Wei X, Al Muyeed SA, Xue H, Wierer JJ Jr. Anisotropic Etching of InGaN Thin Films with Photoelectrochemical Etching to Form Quantum Dots. Materials. 2023; 16(5):1890. https://doi.org/10.3390/ma16051890
Chicago/Turabian StyleWei, Xiongliang, Syed Ahmed Al Muyeed, Haotian Xue, and Jonathan J. Wierer, Jr. 2023. "Anisotropic Etching of InGaN Thin Films with Photoelectrochemical Etching to Form Quantum Dots" Materials 16, no. 5: 1890. https://doi.org/10.3390/ma16051890
APA StyleWei, X., Al Muyeed, S. A., Xue, H., & Wierer, J. J., Jr. (2023). Anisotropic Etching of InGaN Thin Films with Photoelectrochemical Etching to Form Quantum Dots. Materials, 16(5), 1890. https://doi.org/10.3390/ma16051890






