Ultraviolet Response in Coplanar Silicon Avalanche Photodiodes with CMOS Compatibility
Abstract
:1. Introduction
2. Design and Results
3. Discussion
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Xu, W.Z.; Shi, Y.T.; Ren, F.F.; Ren, F.; Zhou, D.L.; Su, L.; Liu, Q.; Cheng, L.; Ye, J.; Chen, D.J.; et al. Magnesium ion-implantation-based gallium nitride pin photodiode for visible-blind ultraviolet detection. Photonics Res. 2019, 7, B48–B54. [Google Scholar] [CrossRef]
- Cai, Q.; You, H.; Guo, H.; Wang, J.; Liu, B.; Xie, Z.; Chen, D.J.; Lu, H.; Zheng, Y.D.; Zhang, R. Progress on AlGaN-based solar-blind ultraviolet photodetectors and focal plane arrays. Light Sci. Appl. 2021, 10, 94. [Google Scholar] [CrossRef] [PubMed]
- Chen, J.; Ouyang, W.; Yang, W.; He, J.H.; Fang, X. Recent progress of heterojunction ultraviolet photodetectors: Materials, integrations, and applications. Adv. Funct. Mater. 2020, 30, 1909909. [Google Scholar] [CrossRef]
- Lee, C.J.; Won, C.H.; Lee, J.H.; Hahm, S.H.; Park, H. GaN-based ultraviolet passive pixel sensor on silicon (111) substrate. Sensors 2019, 19, 1051. [Google Scholar] [CrossRef] [Green Version]
- Yang, S.; Zhou, D.; Xu, W.Z.; Cai, X.L.; Lu, H.; Chen, D.J.; Ren, F.F.; Zhang, R.; Zheng, Y.D. 4H-SiC ultraviolet avalanche photodiodes with small gain slope and enhanced fill factor. IEEE Photonics J. 2017, 9, 6801508. [Google Scholar] [CrossRef]
- Di Benedetto, L.; Landi, G.; Licciardo, G.D.; Neitzert, H.C.; Bellone, S. Photovoltaic behavior of V 2 O 5/4H-SiC Schottky diodes for cryogenic applications. IEEE J. Electron Devices Soc. 2015, 3, 418–422. [Google Scholar] [CrossRef]
- Gilaberte Basset, M.; Setzpfandt, F.; Steinlechner, F.; Beckert, E.; Pertsch, T.; Gräfe, M. Perspectives for applications of quantum imaging. Laser Photonics Rev. 2019, 13, 1900097. [Google Scholar] [CrossRef] [Green Version]
- Korde, R.; Geist, J. Quantum efficiency stability of silicon photodiodes. Appl. Opt. 1987, 26, 5284–5290. [Google Scholar] [CrossRef]
- Nanver, L.K.; Qi, L.; Mohammadi, V.; Mok, K.R.M.; De Boer, W.B.; Golshani, N.; Sammak, A.; Scholtes, T.L.M.; Gottwald, A.; Kroth, U.; et al. Robust UV/VUV/EUV PureB photodiode detector technology with high CMOS compatibility. IEEE J. Sel. Top. Quantum Electrons 2014, 20, 306–316. [Google Scholar] [CrossRef]
- Koda, Y.; Kuroda, R.; Nakazawa, T.; Nakao, Y.; Sugawa, S.A. UV Si-photodiode with almost 100% internal Q.E. and high transmittance on-chip multilayer dielectric stack. Proc. SPIE 2013, 8659, 86590J. [Google Scholar]
- Qi, L.; Mok, K.R.C.; Aminian, M.; Charbon, E.; Nanver, L.K. UV-sensitive low dark-count PureB single-photon avalanche diode. IEEE Trans. Electron Devices 2014, 61, 3768–3774. [Google Scholar] [CrossRef]
- Alirezaei, I.S.; Andre, N.; Sedki, A.; Gerard, P.; Flandre, D. An Ultra-thin ultraviolet enhanced backside-illuminated single-photon avalanche diode with 650 nm-thin silicon body based on SOI technology. IEEE J. Sel. Top. Quantum Electrons 2021, 28, 1–10. [Google Scholar] [CrossRef]
- Laforce, F. Low noise optical receiver using Si APD. Proc. SPIE 2019, 7212, 721210. [Google Scholar]
- Chung, C.; Backes, T.; Dittmar, C.; Karpinski, W.; Kirn, T.; Louis, D.; Schwering, G.; Wlochal, M.; Schael, S. The Development of SiPM-based fast time-of-flight detector for the AMS-100 experiment in space. Instruments 2022, 6, 14. [Google Scholar] [CrossRef]
- Cheng, Z.; Xu, H.; Chen, Y. Design of low noise avalanche photodiode single element detectors and linear arrays through CMOS process. Proc. SPIE 2019, 10978, 109780F. [Google Scholar]
- Tan, L.J.J.; Ong, D.S.G.; Ng, J.S.; Tan, C.H.; Jones, S.K.; Qian, Y.; David, J.P.R. Temperature dependence of avalanche breakdown in InP and InAlAs. IEEE J. Quantum Electrons 2010, 46, 1153–1157. [Google Scholar] [CrossRef]
- Steindl, B.; Enne, R.; Schidl, S.; Zimmermann, H. Linear mode avalanche photodiode with high responsivity integrated in high-voltage CMOS. IEEE Electron Device Lett. 2014, 35, 897–899. [Google Scholar] [CrossRef]
- Xia, Z.; Zang, K.; Liu, D.; Zhou, M.; Kim, T.J.; Zhang, H.; Xue, M.; Park, J.; Morea, M.; Ryu, J.H.; et al. High-sensitivity silicon ultraviolet p+-in avalanche photodiode using ultra-shallow boron gradient doping. Appl. Phys. Lett. 2017, 111, 081109. [Google Scholar] [CrossRef]
- Yampolsky, M.; Pikhay, E.; Roizin, Y. Embedded UV Sensors in CMOS SOI Technology. Sensors 2022, 22, 712. [Google Scholar] [CrossRef]
- Garin, M.; Heinonen, J.; Werner, L.; Pasanen, T.P.; Vähänissi, V.; Haarahiltunen, A.; Juntunen, M.A.; Savin, H. Black-silicon ultraviolet photodiodes achieve external quantum efficiency above 130%. Phys. Rev. Lett. 2020, 125, 117702. [Google Scholar] [CrossRef]
- Alirezaei, I.S.; Andre, N.; Flandre, D. Enhanced ultraviolet avalanche photodiode with 640-nm-thin silicon body based on SOI technology. IEEE Trans. Electron Devices 2020, 67, 4641–4644. [Google Scholar] [CrossRef]
- Liu, Q.L.; Liu, C.; Wang, Y.T.; Hao, L.X.; Huang, Y.Q.; Hu, A.Q.; Guo, X. Development of silicon single photon detector and its application in high-precision satellite-to-ground time comparison (Invited). Infrared Laser Eng. 2021, 50, 20211004. [Google Scholar]
- Sze, S.M.; Ng, K.K. Physics of Semiconductor Devices; John Wiley & Sons: New York, NY, USA, 2006. [Google Scholar]
- Kim, G.; Kim, I.G.; Baek, J.H.; Kwon, O.K. Enhanced frequency response associated with negative photoconductance in an InGaAs/InAlAs avalanche photodetector. Appl. Phys. Lett. 2003, 83, 1249–1251. [Google Scholar] [CrossRef] [Green Version]
- Decoster, D.; Harari, J. (Eds.) Optoelectronic Sensors; John Wiley & Sons: Hoboken, NJ, USA, 2013. [Google Scholar]
- Tan, C.H.; Ng, J.S.; Rees, G.J.; David, J.P.R. Statistics of avalanche current buildup time in single-photon avalanche diodes. IEEE J. Sel. Top. Quantum Electrons 2007, 13, 906–910. [Google Scholar] [CrossRef]
- Kuvås, R.; Lee, C.A. Quasistatic approximation for semiconductor avalanches. J. Appl. Phys. 1970, 41, 1743–1755. [Google Scholar] [CrossRef]
- Kaneda, T.; Takanashi, H. Avalanche buildup time of silicon avalanche photodiodes. Appl. Phys. Lett. 1975, 26, 642–644. [Google Scholar] [CrossRef]
- Emmons, R.B. Avalanche photodiode frequency response. J. Appl. Phys. 1967, 38, 3705–3714. [Google Scholar] [CrossRef]
- Kaneda, T.; Takanashi, H.; Matsumoto, H.; Yamaoka, T. Avalanche buildup time of silicon reach through photodiodes. J. Appl. Phys. 1976, 47, 4960–4963. [Google Scholar] [CrossRef]
- Johnson, K.M. High-speed photodiode signal enhancement at avalanche breakdown voltage. IEEE Trans. Electron Devices 1965, 12, 55–63. [Google Scholar] [CrossRef]
- Soci, C.; Zhang, A.; Xiang, B.; Dayeh, S.A.; Aplin, D.P.R.; Park, J.; Bao, X.Y.; Lo, Y.H.; Wang, D. ZnO nanowire UV photodetectors with high internal gain. Nano Lett. 2007, 7, 1003–1009. [Google Scholar] [CrossRef]

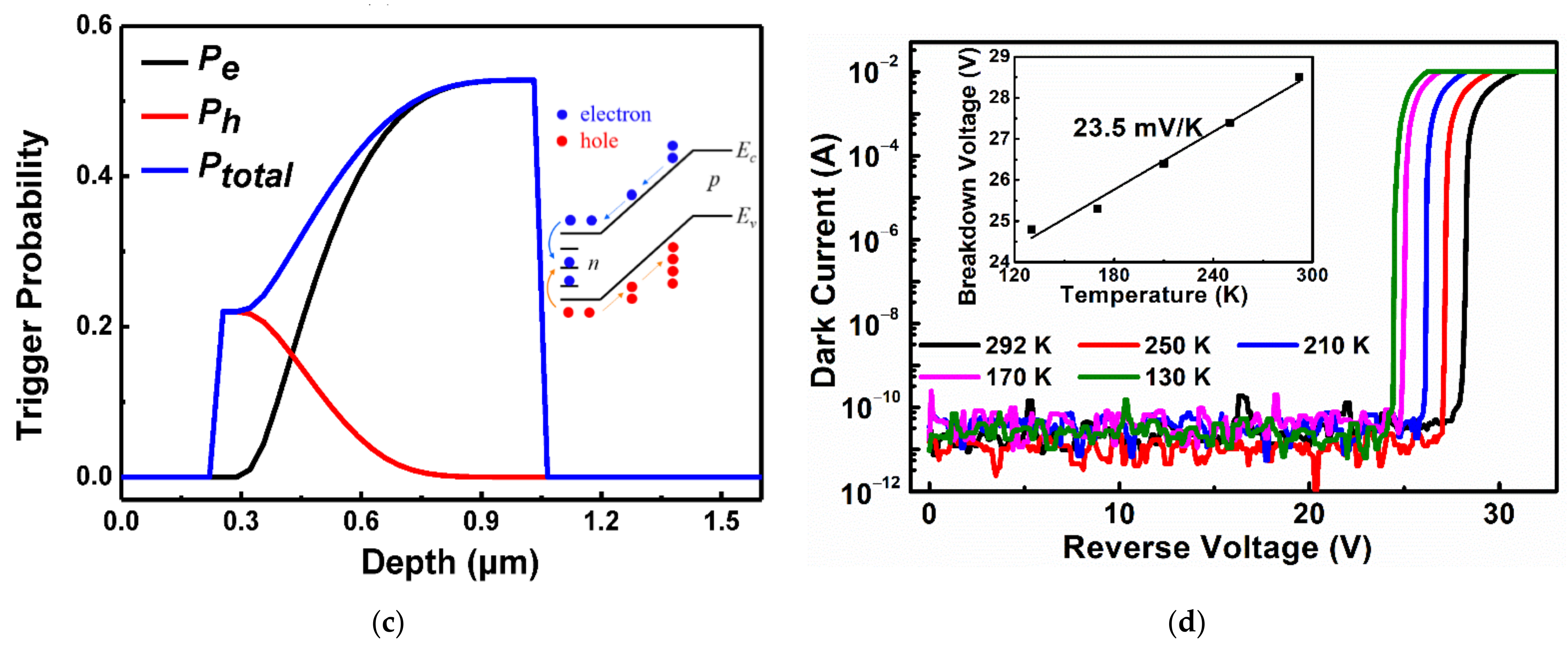

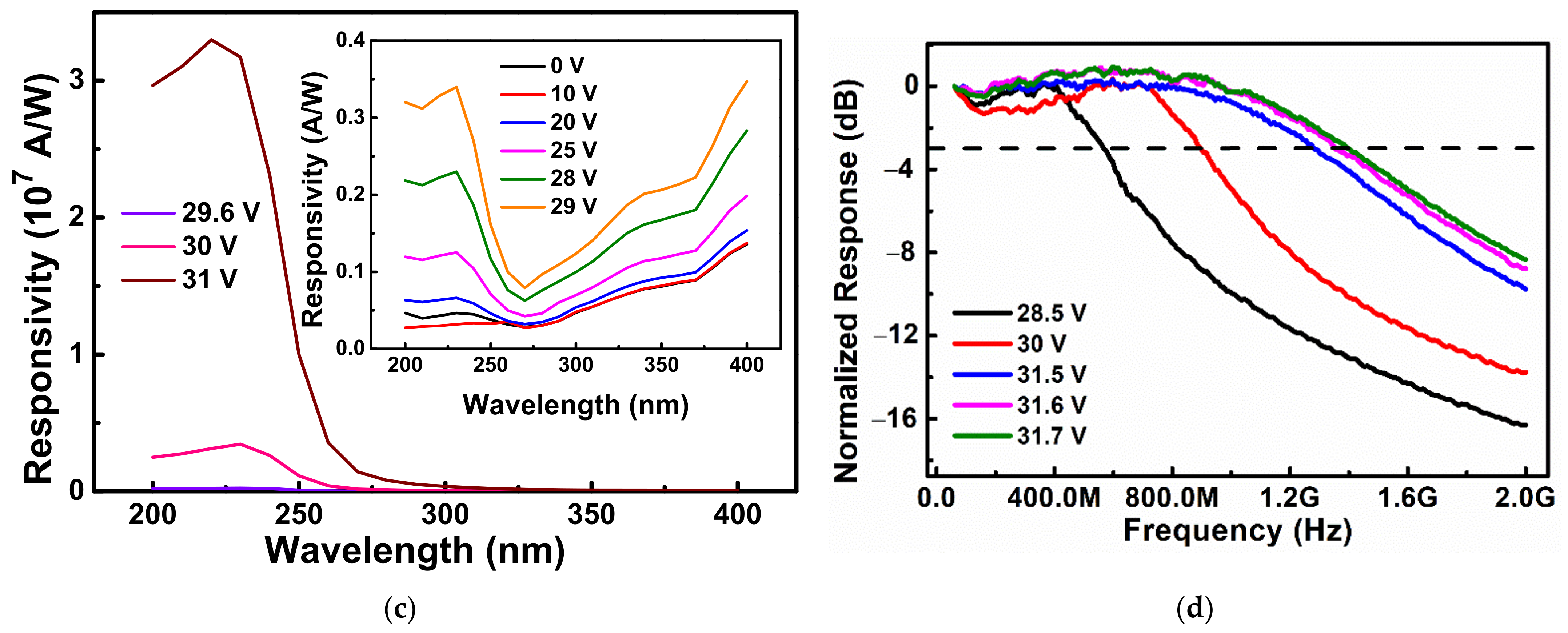
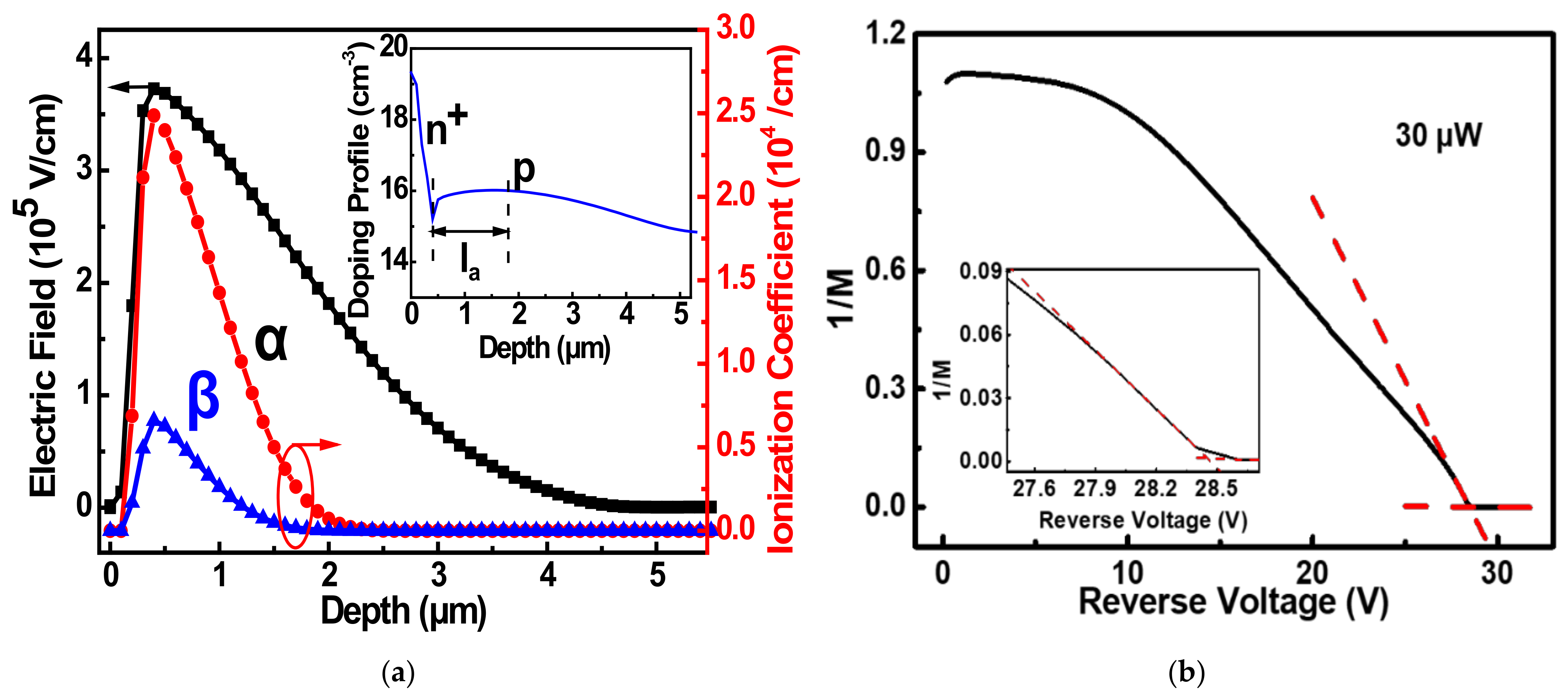
| Reference | Structure | Responsivity | Wavelength | Bias |
|---|---|---|---|---|
| [10] | photodiode | 0.2 A/W | 256 nm | 2 V |
| [18] | photodiode | 0.06 A/W | 260 nm | 0 V |
| [19] | photodiode | 0.1 A/W | 255 nm | 0 V |
| [20] | photodiode | 0.2 A/W | 200 nm | 0 V |
| [21] | APD | 0.18 A/W | 275 nm | 4 V |
| [12] | APD | 0.05 A/W | 291 nm | 4 V |
| ~103 A/W | Vex = 0.5 V | |||
| This work | APD | 0.5 mA/W | 261 nm | 10 V |
| 4 × 103 A/W | Vex = 1.5 V |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2022 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Liu, Q.; Xu, L.; Jin, Y.; Zhang, S.; Wang, Y.; Hu, A.; Guo, X. Ultraviolet Response in Coplanar Silicon Avalanche Photodiodes with CMOS Compatibility. Sensors 2022, 22, 3873. https://doi.org/10.3390/s22103873
Liu Q, Xu L, Jin Y, Zhang S, Wang Y, Hu A, Guo X. Ultraviolet Response in Coplanar Silicon Avalanche Photodiodes with CMOS Compatibility. Sensors. 2022; 22(10):3873. https://doi.org/10.3390/s22103873
Chicago/Turabian StyleLiu, Qiaoli, Li Xu, Yuxin Jin, Shifeng Zhang, Yitong Wang, Anqi Hu, and Xia Guo. 2022. "Ultraviolet Response in Coplanar Silicon Avalanche Photodiodes with CMOS Compatibility" Sensors 22, no. 10: 3873. https://doi.org/10.3390/s22103873
APA StyleLiu, Q., Xu, L., Jin, Y., Zhang, S., Wang, Y., Hu, A., & Guo, X. (2022). Ultraviolet Response in Coplanar Silicon Avalanche Photodiodes with CMOS Compatibility. Sensors, 22(10), 3873. https://doi.org/10.3390/s22103873





