Advanced Etching Techniques of LiNbO3 Nanodevices
Abstract
:1. Introduction
2. Experimental Methods
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Data Availability Statement
Conflicts of Interest
References
- Boyd, G.D.; Miller, R.C.; Nassau, K.; Bond, W.L.; Savage, A. LiNbO3: An efficient phase matchable nonlinear optical material. Appl. Phys. Lett. 1964, 5, 234–236. [Google Scholar] [CrossRef]
- Nassau, K.; Levinstein, H.J. Ferroelectric behavior of lithium niobate. Appl. Phys. Lett. 1965, 7, 69–70. [Google Scholar] [CrossRef]
- Weis, R.S.; Gaylord, T.K. Lithium niobate: Summary of physical properties and crystal structure. Appl. Phys. A 1985, 37, 191–203. [Google Scholar]
- Zhuang, R.; He, J.; Qi, Y.; Li, Y. High-Q thin-film lithium niobate microrings fabricated with wet etching. Adv. Mater. 2023, 35, 2208113. [Google Scholar]
- Zhang, B.; Wang, L.; Chen, F. Recent advances in femtosecond laser processing of LiNbO3 crystals for photonic applications. Laser Photonics Rev. 2020, 14, 1900407. [Google Scholar]
- Poberaj, G.; Hu, H.; Sohler, W.; Günter, P. Lithium niobate on insulator (LNOI) for micro-photonic devices. Laser Photonics Rev. 2012, 6, 488–503. [Google Scholar]
- Wang, C.; Zhang, M.; Stern, B.; Lipson, M.; Lončar, M. Nanophotonic lithium niobate electro-optic modulators. Opt. Express 2018, 26, 1547. [Google Scholar]
- Wang, C.; Zhang, M.; Chen, X.; Bertrand, M.; Shams-Ansari, A.; Chandrasekhar, S.; Winzer, P.; Lončar, M. Integrated lithium niobate electro-optic modulators operating at CMOS-compatible voltages. Nature 2018, 562, 101–104. [Google Scholar]
- Kong, Y.; Bo, F.; Wang, W.; Zheng, D.; Liu, H.; Zhang, G.; Rupp, R.; Xu, J. Recent progress in lithium niobate: Optical damage, defect simulation, and on-chip devices. Adv. Mater. 2019, 32, 1806452. [Google Scholar]
- Hu, H.; Ricken, R.; Sohler, W. Etching of Lithium Niobate: From Ridge Waveguides to Photonic Crystal Structures. European Conference on Integrated Optics (ECIO): Paderborn, Germany, 2008; pp. 75–78. [Google Scholar]
- Li, X.P.; Chen, K.X.; Hu, Z.F. Low-loss bent channel waveguides in lithium niobate thin film by proton exchange and dry etching. Opt. Mater. Express 2018, 8, 1322. [Google Scholar]
- Wang, J.; Ma, J.; Huang, H.; Ma, J.; Jafri, H.M.; Fan, Y.; Yang, H.; Wang, Y.; Chen, M.; Liu, D.; et al. Ferroelectric domain-wall logic units. Nat. Commun. 2022, 13, 3255. [Google Scholar] [PubMed]
- Ma, J.; Ma, J.; Zhang, Q.; Peng, R.; Wang, J.; Liu, C.; Wang, M.; Li, N.; Chen, M.; Cheng, X.; et al. Controllable conductive readout in self-assembled, topologically confined ferroelectric domain walls. Nat. Nanotechnol. 2018, 13, 947–952. [Google Scholar] [PubMed]
- Sharma, P.; Zhang, Q.; Sando, D.; Lei, C.H.; Liu, Y.; Li, J.; Nagarajan, V.; Seidel, J. Nonvolatile ferroelectric domain wall memory. Sci. Adv. 2017, 3, e1700512. [Google Scholar] [PubMed]
- Choi, T.; Lee, S.; Choi, Y.J.; Kiryukhin, V.; Cheong, S.W. Switchable ferroelectric diode and photovoltaic effect in BiFeO3. Science 2009, 324, 63–66. [Google Scholar] [CrossRef] [PubMed]
- Eliseev, E.A.; Morozovska, A.N.; Svechnikov, G.S.; Gopalan, V.; Shur, V.Y. Static conductivity of charged domain walls in uniaxial ferroelectric semiconductors. Phys. Rev. B 2011, 83, 235313. [Google Scholar]
- Schröder, M.; Haußmann, A.; Thiessen, A.; Soergel, E.; Woike, T.; Eng, L.M. Conducting domain walls in lithium niobate single crystals. Adv. Funct. Mater. 2012, 22, 3936–3944. [Google Scholar]
- Werner, C.S.; Herr, S.J.; Buse, K.; Sturman, B.; Soergel, E.; Razzaghi, C.; Breunig, I. Large and accessible conductivity of charged domain walls in lithium niobate. Sci. Rep. 2017, 7, 9862. [Google Scholar]
- Li, H.; Xia, Y.; Xu, B.; Guo, H.; Yin, J.; Liu, Z. Memristive behaviors of LiNbO3 ferroelectric diodes. Appl. Phys. Lett. 2010, 97, 1. [Google Scholar]
- Wang, S.; Wang, W.; Yakopcic, C.; Shin, E.; Subramanyam, G.; Taha, T.M. Experimental study of LiNbO3 memristors for use in neuromorphic computing. Microelectron. Eng. 2017, 168, 37–40. [Google Scholar]
- Huang, S.; Luo, W.; Pan, X.; Zhao, J.; Qiao, S.; Shuai, Y.; Zhang, K.; Bai, X.; Niu, G.; Wu, C.; et al. Resistive switching effects of crystal-ion-slicing fabricated LiNbO3 single crystalline thin film on flexible polyimide substrate. Adv. Electron. Mater. 2021, 7, 2100301. [Google Scholar] [CrossRef]
- Wang, J.; Pan, X.; Luo, W.; Shuai, Y.; Xie, Q.; Xu, J.; Song, Z.; Wu, C.; Zhang, W. Memristive synapse based on single-crystalline LiNbO3 thin film with bioinspired microstructure for experience-based dynamic image mask generation. Adv. Electron. Mater. 2023, 9, 2201064. [Google Scholar]
- Chai, X.; Jiang, J.; Zhang, Q.; Hou, X.; Meng, F.; Wang, J.; Gu, L.; Zhang, D.W.; Jiang, A.Q. Nonvolatile ferroelectric field-effect transistors. Nat. Commun. 2020, 11, 2811. [Google Scholar] [PubMed]
- Jiang, A.Q.; Geng, W.P.; Lv, P.; Hong, J.; Jiang, J.; Wang, C.; Chai, X.J.; Lian, J.W.; Zhang, Y.; Huang, R.; et al. Ferroelectric domain wall memory with embedded selector realized in LiNbO3 single crystals integrated on Si wafers. Nat. Mater. 2020, 19, 1188–1194. [Google Scholar] [PubMed]
- Jiang, A.Q.; Zhang, Y. Next-generation ferroelectric domain-wall memories: Principle and architecture. NPG Asia Mater. 2019, 11, 2. [Google Scholar]
- Xie, Z.; Zhu, S. LiNbO3 crystals: From bulk to film. Adv. Photonics 2022, 4, 30502. [Google Scholar]
- Pan, X.; Luo, W.; Shuai, Y.; Hu, S.; Luo, W.; Qiao, G.; Zhou, T.; Wang, J.; Xie, Q.; Huang, S.; et al. Hardware implementation of edge neural network computing for sensor with memristors based on single-crystalline LiNbO3 thin film. IEEE Sens. J. 2023, 23, 8526–8534. [Google Scholar]
- Liang, X.; Chen, X.; Yang, X.; Ni, J. The fabrication of LiNbO3 memristors for electronic synapses using oxygen annealing. Nanotechnology 2021, 32, 25706. [Google Scholar]
- Zhu, D.; Shao, L.; Yu, M.; Cheng, R.; Desiatov, B.; Xin, C.J.; Hu, Y.; Holzgrafe, J.; Ghosh, S.; Shams-Ansari, A.; et al. Integrated photonics on thin-film lithium niobate. Adv. Opt. Photonics 2021, 13, 242–352. [Google Scholar]
- Osipov, A.A.; Osipov, A.A.; Iankevich, G.A.; Speshilova, A.B.; Shakhmin, A.; Berezenko, V.I.; Alexandrov, S.E. Deep etching of LiNbO3 using inductively coupled plasma in SF6-based gas mixture. J. Microelectromech. S. 2021, 30, 90–95. [Google Scholar]
- Wang, T.J.; Huang, C.F.; Wang, W.S.; Wei, P.K. A novel wet-etching method using electric-field-assisted proton exchange in LiNbO3. J. Lightwave Technol. 2004, 22, 1764–1771. [Google Scholar]
- Guyot, C.; Ulliac, G.; Dahdah, J.; Qiu, W.; Bernal, M.P.; Baida, F.; Courjal, N. Optical characterization of ultra-short bragg grating on lithium niobate ridge waveguide. Opt. Lett. 2014, 39, 371–374. [Google Scholar] [PubMed]
- Kozlov, A.; Moskalev, D.; Salgaeva, U.; Bulatova, A.; Krishtop, V.; Volyntsev, A.; Syuy, A. Reactive ion etching of x-cut LiNbO3 in an ICP/TCP system for the fabrication of an optical ridge waveguide. Appl. Sci. 2023, 13, 2097. [Google Scholar]
- Bahadori, M.; Yang, Y.; Goddard, L.L.; Gong, S. High performance fully etched isotropic microring resonators in thin-film lithium niobate on insulator platform. Opt. Express 2019, 27, 22025. [Google Scholar] [PubMed]
- Shen, C.; Wang, C.; Zhu, Y.; Wu, J.; Chen, Y.; Li, Z.; Huang, K.; Zhao, X.; Song, S.; Zhang, J.; et al. A comparative study of dry-etching nanophotonic devices on a LiNbO3-on-insulator material platform. SPIE 2020, 11781, 212–217. [Google Scholar]
- Li, Y.; Lan, T.; Yang, D.; Xiang, M.; Dai, J.; Li, C.; Wang, Z. Research of selective etching in LiNbO3 using proton-exchanged wet etching technique. Mater. Res. Express 2020, 7, 056202. [Google Scholar]
- Si, G.; Danner, A.J.; Teo, S.L.; Teo, E.J.; Teng, J.; Bettiol, A.A. Photonic crystal structures with ultrahigh aspect ratio in lithium niobate fabricated by focused ion beam milling. J. Vac. Sci. Technol. B. 2011, 29, 021205. [Google Scholar]
- Chiarini, M.; Bentini, G.G.; Bianconi, M.; Nicola, P.D. High definition surface micromachining of linbo3 by ion implantation. Nucl. Instrum. Meth. B 2010, 268, 3049–3054. [Google Scholar]
- Denicola, P.; Sugliani, S.; Montanari, G.B.; Menin, A.; Vergani, P.; Meroni, A.; Astolfi, M.; Borsetto, M.; Consonni, G.; Longone, R.; et al. Fabrication of smooth ridge optical waveguides in LiNbO3 by ion implantation-assisted wet etching. J. Light. Technol. 2013, 31, 1482–1487. [Google Scholar]
- Gui, L.; Hu, H.; Garcia-Granda, M.; Sohler, W.; Berth, G.; Zrenner, A. Ferroelectric Microdomains in Plasma-Etched Ridges on X-cut Lithium Niobate; European Conference on Integrated Optics (ECIO): Paderborn, Germany, 2008; pp. 71–74. [Google Scholar]
- Osipov, A.A.; Alexandrov, S.E.; Iankevich, G.A. The effect of a lithium niobate heating on the etching rate in SF6 ICP plasma. Mater. Res. Express 2019, 6, 046306. [Google Scholar]
- Zhang, D.; Zhang, P.; Zhou, H.; Cui, Y.; Pun, E.Y. Surface etching of MgO: LiNbO3 crystal by Ti metal for integrated optics. J. Electrochem. Soc. 2010, 157, 486–492. [Google Scholar]
- Ren, Z.; Heard, P.J.; Marshall, J.M.; Thomas, P.A.; Yu, S. Etching characteristics of LiNbO3 in reactive ion etching and inductively coupled plasma. J. Appl. Phys. 2008, 103, 034109. [Google Scholar]
- Jun, D.; Wei, J.; Png, C.E.; Si, G.; Son, J.; Yang, H.; Danner, A.J. Deep anisotropic LiNbO3 etching with SF6/Ar inductively coupled plasmas. J. Vac. Sci. Technol. B. 2012, 30, 011208. [Google Scholar]
- Aryal, A.; Stricklin, I.; Behzadirad, M.; Branch, D.; Siddiqui, A.; Busani, T. High-quality dry etching of LiNbO3 assisted by proton substitution through H2-plasma surface treatment. Nanomaterials 2022, 12, 2836. [Google Scholar] [PubMed]
- Queste, S.; Ulliac, G.; Jeannot, J.; Malek, C.K. DRIE of non-conventional materials: First results. In Proceedings of the 4th international conference on multimaterial micro manufacture, Cardiff, Wales, 9–11 September 2008; pp. 9–11. [Google Scholar]
- Wang, C.; Wang, T.; Zhang, W.; Jiang, J.; Chen, L.; Jiang, A. Analog ferroelectric domain-wall memories and synaptic devices integrated with Si substrates. Nano Res. 2022, 15, 3606–3613. [Google Scholar]
- Zhang, W.J.; Wang, C.; Jiang, J.; Jiang, A.Q. Fast operations of nonvolatile ferroelectric domain wall memory with inhibited space charge injection. ACS Appl. Mater. Inter. 2022, 14, 32227–32235. [Google Scholar]
- Wang, C.; Jiang, J.; Chai, X.; Lian, J.; Hu, X.; Jiang, A.Q. Energy-efficient ferroelectric domain wall memory with controlled domain switching dynamics. ACS Appl. Mater. Inter. 2020, 12, 44998–45004. [Google Scholar]
- Chen, Y.; Zhuang, X.; Chai, X.; Jiang, X.; Sun, J.; Jiang, J.; Jiang, A. Improved polarization retention in LiNbO3 single-crystal memory cells with enhanced etching angles. J. Mater. Sci. 2021, 56, 11209–11218. [Google Scholar]
- Lecestre, A.; Benchabane, S.; Robert, L.; Salut, R.; Ulliac, G.; Blind, P. Electroplated Ni mask for plasma etching of submicron-sized features in LiNbO3. Microelectron. Eng. 2013, 105, 95–98. [Google Scholar]
- Korkishko, Y.N.; Fedorov, V.A.; Micheli, D.M.P.; Baldi, P.; El, H.K.; Leycuras, A. Relationships between structural and optical properties of proton-exchanged waveguides on Z-cut lithium niobate. Appl. Opt. 1996, 35, 7056–7060. [Google Scholar]
- Piecha, J.; Szot, K.; Pilch, M.; Gruszka, I.; Molak, A. Influence of proton exchange on LiNbO3 crystals structure. Ferroelectrics 2014, 466, 1–7. [Google Scholar]
- Korkishko, Y.N. Structural phase diagram of HxLi1-xNbO3 waveguides: The correlation between optical and structural properties. IEEE J. Sel. Top. Quant. 1996, 2, 187–196. [Google Scholar]
- Lian, J.; Tao, J.; Chai, X.; Zhang, Y.; Jiang, A. Effects of atmosphere, metal films, temperatures and holding time on the surface topography and electrical conductivity of LiNbO3 single crystals. Ceram. Int. 2019, 45, 9736–9753. [Google Scholar]
- Boes, A.; Yudistira, D.; Crasto, T.; Steigerwald, H.; Sivan, V.; Limboeck, T.; Friend, J.; Mailis, S.; Soergel, E.; Mitchell, A. Ultraviolet laser induced domain inversion on chromium coated lithium niobate crystals. Opt. Mater. Express 2014, 4, 241. [Google Scholar]
- Herdiech, M.W.; Zhu, X.; Morales-Acosta, M.D.; Walker, F.J.; Altman, E.I. The modification of ferroelectric LiNbO3 (0001) surfaces using chromium oxide thin films. Phys. Chem. Chem. Phys. 2015, 17, 9488–9498. [Google Scholar] [PubMed]
- Kaczmarek, S.M.; Jablonski, R.; Pracka, I.; Swirkowicz, M.; Wojtkowska, J.; Warchol, S. Radiation defects in LiNbO3 single crystals doped with Cr3+ ions. Cryst. Res. Technol. 1999, 34, 729–735. [Google Scholar]
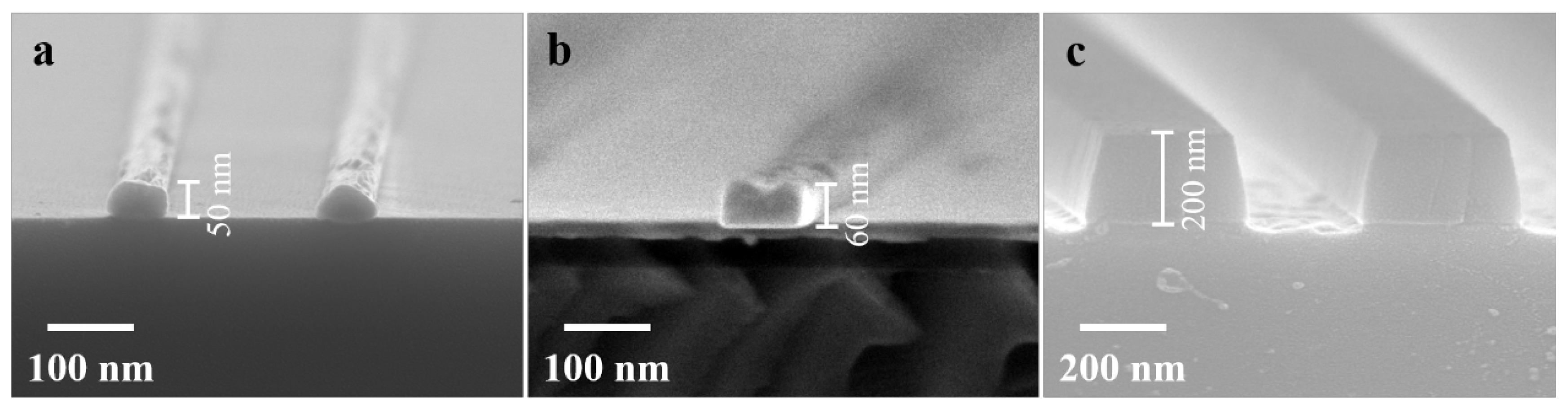
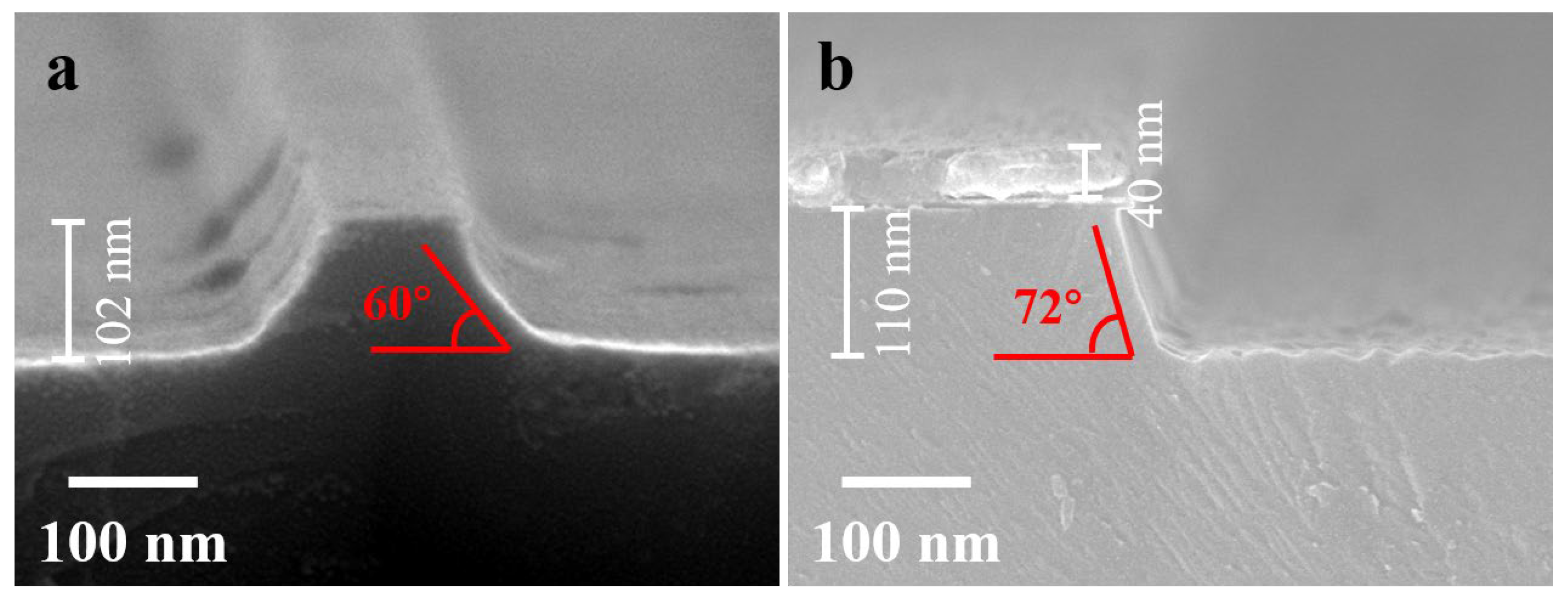

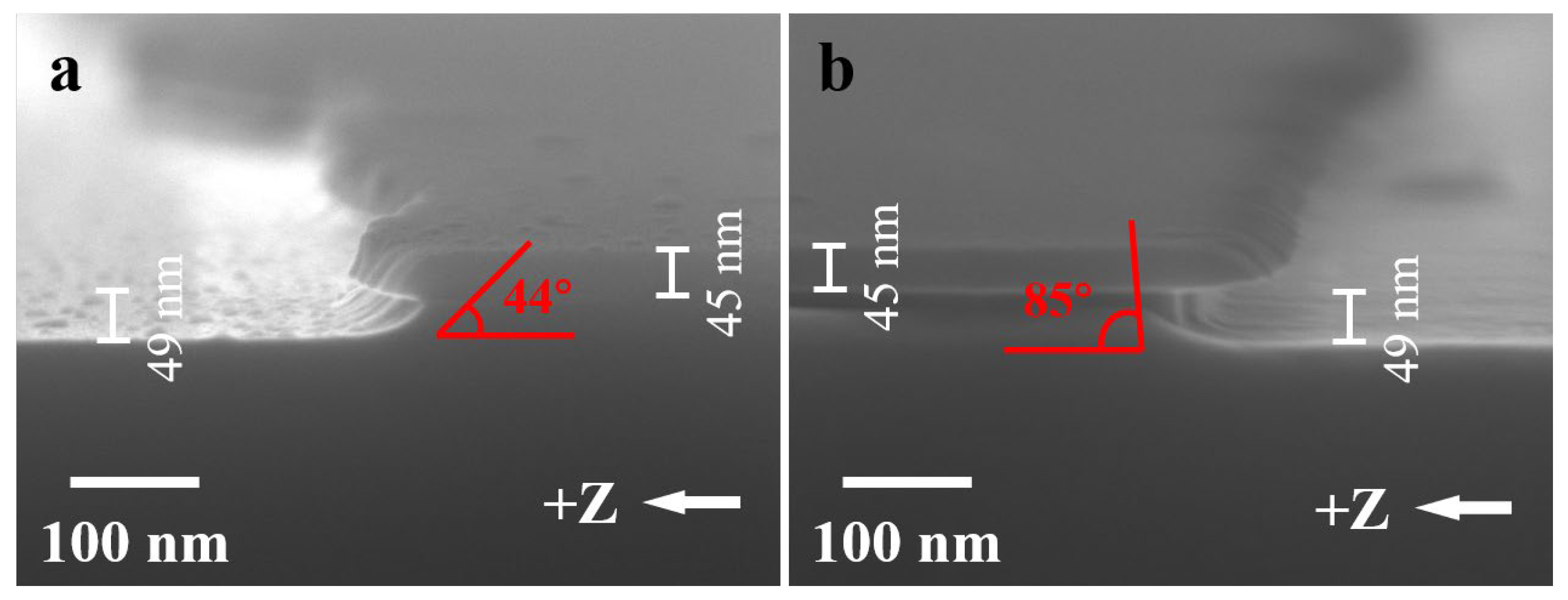

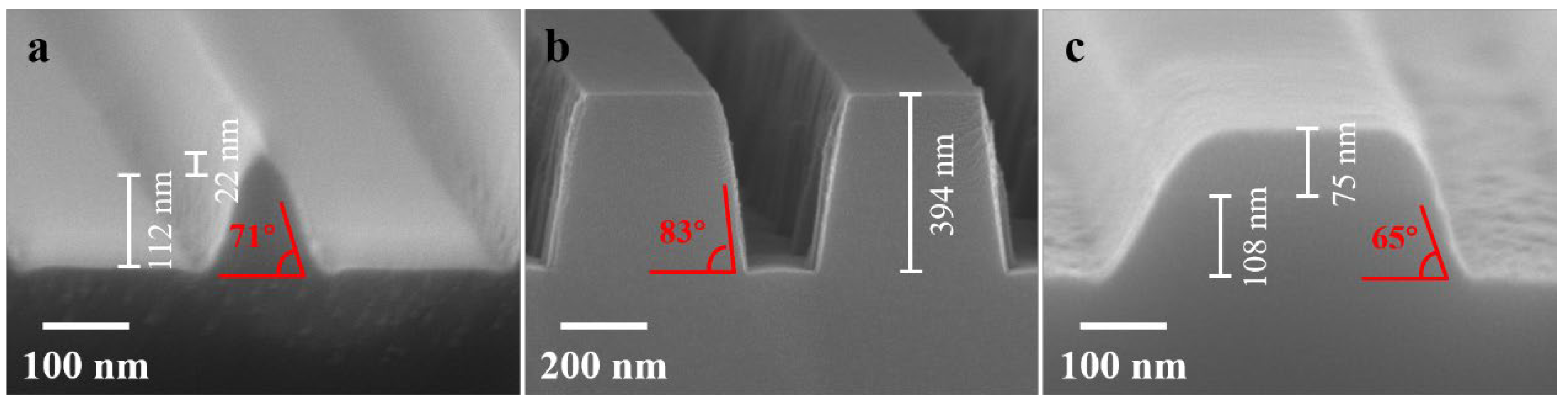
| Samples | Masks | Equipment | Processes | Etching Rates (nm/min) | Sidewall Angles (°) | Etching Selectivity Ratio |
|---|---|---|---|---|---|---|
| 1 | Cr | RIE | Dry etching | 10 | 60 | ~3:1 |
| 2 | Ni | RIE | Dry etching | 11 | 72 | ~5.5:1 |
| 3 | Cr | RIE | Proton exchange, then dry etching | 13 | 70 | ~4:1 |
| 4 | SiO2 | / | High temperature treated in reduction atmosphere, then SC-1 wet etching | 4.9 | 44–85 | / |
| 5 | Cr | RIE | High temperature treated in reduction atmosphere, then dry etching | 11.5 | 85 | ~3.5:1 |
| 6 | Cr | RIE | Dry etching, then high temperature treated in reduction atmosphere, then SC-1 wet etching | 10 | Concavity-90 | ~3:1 |
| 7 | Cr | RIE | Dry etching, then high temperature treated with Al in reduction atmosphere, then SC-1 wet etching | 10 | 90 | ~3:1 |
| 8 | Cr | ICP | Dry etching | 37 | 71 | ~4:1 |
| 9 | Ni | ICP | Dry etching | 79 | 83 | ~6:1 |
| 10 | SiO2 | ICP | Cl-based gases dry etching | 108 | 65 | 0.86:1 |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Shen, B.; Hu, D.; Dai, C.; Yu, X.; Tan, X.; Sun, J.; Jiang, J.; Jiang, A. Advanced Etching Techniques of LiNbO3 Nanodevices. Nanomaterials 2023, 13, 2789. https://doi.org/10.3390/nano13202789
Shen B, Hu D, Dai C, Yu X, Tan X, Sun J, Jiang J, Jiang A. Advanced Etching Techniques of LiNbO3 Nanodevices. Nanomaterials. 2023; 13(20):2789. https://doi.org/10.3390/nano13202789
Chicago/Turabian StyleShen, Bowen, Di Hu, Cuihua Dai, Xiaoyang Yu, Xiaojun Tan, Jie Sun, Jun Jiang, and Anquan Jiang. 2023. "Advanced Etching Techniques of LiNbO3 Nanodevices" Nanomaterials 13, no. 20: 2789. https://doi.org/10.3390/nano13202789
APA StyleShen, B., Hu, D., Dai, C., Yu, X., Tan, X., Sun, J., Jiang, J., & Jiang, A. (2023). Advanced Etching Techniques of LiNbO3 Nanodevices. Nanomaterials, 13(20), 2789. https://doi.org/10.3390/nano13202789






