Performance Enhancement in N2 Plasma Modified AlGaN/AlN/GaN MOS-HEMT Using HfAlOX Gate Dielectric with Γ-Shaped Gate Engineering
Abstract
1. Introduction
2. Materials and Methods
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Hu, J.; Zhang, Y.; Sun, M.; Piedra, D.; Chowdhury, N.; Palacios, T. Materials and processing issues in vertical GaN power electronics. Mater. Sci. Semicond. Process. 2018, 78, 75–84. [Google Scholar] [CrossRef]
- Ardaravičius, L.; Matulionis, A.; Liberis, J.; Kiprijanovic, O.; Ramonas, M.; Eastman, L.F.; Shealy, J.R.; Vertiatchikh, A. Electron drift velocity in AlGaN/GaN channel at high electric fields. Appl. Phys. Lett. 2003, 83, 4038–4040. [Google Scholar] [CrossRef]
- Basu, S.; Singh, P.K.; Sze, P.W.; Wang, Y.H. AlGaN/GaN Metal oxide-semiconductor high electron mobility transistor with liquid phase deposited Al2O3 as gate dielectric. J. Electrochem. Soc. 2010, 157, 947–951. [Google Scholar] [CrossRef]
- Borga, M.; Meneghini, M.; Benazzi, D.; Canato, E.; Püsche, R.; Derluyn, J.; Abid, I.; Medjdoub, F.; Meneghessoa, G.; Zanoni, E. Buffer breakdown in GaN-on-Si HEMTs: A comprehensive study based on a sequential growth experiment. Microelectron. Reliab. 2019, 100, 1–5. [Google Scholar] [CrossRef]
- Mazumder, S.; Wang, Y.H. Investigation of HfSiOX Passivation Effect on AlGaN/GaN HEMT. In Proceedings of the 2020 International Symposium on Devices, Circuits and Systems (ISDCS), Howrah, India, 4–6 March 2020; pp. 1–4. [Google Scholar]
- Jun, L.; Zhao, S.L.; Mi, M.H.; Hou, B.; Yang, X.L.; Zhang, J.C.; Ma, X.H.; Hao, Y. Trap states induced by reactive ion etching in AlGaN/GaN high-electron-mobility transistors. Chin. Phys. B 2015, 24, 117305. [Google Scholar]
- Im, K.S.; Ha, J.B.; Kim, K.W.; Lee, J.S.; Kim, D.S.; Choi, H.C.; Lee, J.H. AlGaN/GaN-based normally-off GaN MOSFET with stress controlled 2DEG source and drain. Phys. Status Solidi 2010, 7, 2013–2015. [Google Scholar] [CrossRef]
- Xu, Z.; Wang, J.; Cai, Y.; Liu, J.; Jin, C.; Yang, Z.; Wang, M.; Yu, M.; Xie, B.; Wu, W.; et al. Enhancement mode (E-Mode) AlGaN/GaN MOSFET with 10−13 A/mm leakage current and 1012 ON/ OFF current ratio. IEEE Electron Device Lett. 2014, 35, 1200–1202. [Google Scholar] [CrossRef]
- Han, K.; Zhu, L. GaN MOSHEMT employing HfO2 as a gate dielectric with partially etched barrier. Semicond. Sci. Technol. 2017, 32, 095004. [Google Scholar] [CrossRef]
- Adak, S.; Swain, S.K.; Singh, A.; Pardeshi, H.; Pati, S.K.; Sarkar, C.K. Study of HfAlO/AlGaN/GaN MOS-HEMT with source field plate structure for improved breakdown voltage. Phys. E 2014, 64, 152–157. [Google Scholar] [CrossRef]
- Min, B.J.; Yoon, S.; Won, K.T.; Lam, L.J. Enhancement of magnetic properties in (Ga,Mn)N nanowires due to plasma treatment. Appl. Phys. Lett. 2006, 89, 152113. [Google Scholar]
- Mazumder, S.; Li, S.H.; Wu, Z.G.; Wang, Y.H. Combined Implications of UV/O3 Interface Modulation with HfSiOX Surface Passivation on AlGaN/AlN/GaN MOS-HEMT. Crystals 2021, 11, 136. [Google Scholar] [CrossRef]
- Tsurumi, N.; Ueno, H.; Murata, T.; Ishida, H.; Uemoto, Y.; Ueda, T.; Inoue, K.; Tanaka, T. AlN passivation over AlGaN/GaN HFETs for surface heat spreading. IEEE Trans. Electron. 2010, 57, 980–985. [Google Scholar] [CrossRef]
- Dutta, G.; Das Gupta, N.; Das Gupta, A. Effect of Sputtered-Al2O3 Layer Thickness on the Threshold Voltage of III-Nitride MIS-HEMTs. IEEE Trans. Electron. 2016, 63, 1450–1458. [Google Scholar] [CrossRef]
- Zhou, H.; Lou, X.; Kim, S.B.; Chabak, K.D.; Gordon, R.G.; Ye, P.D. Enhancement-mode AlGaN/GaN fin-MOSHEMTs on Si substrate with atomic layer epitaxy MgCaO. IEEE Electron Device Lett. 2017, 38, 1294–1297. [Google Scholar] [CrossRef]
- Yue, Y.; Hao, Y. AlGaN/GaN MOS-HEMT with HfO2 Dielectric and Al2O3 Interfacial Passivation Layer Grown by Atomic Layer Deposition. IEEE Electron Device Lett. 2008, 29, 838–840. [Google Scholar] [CrossRef]
- Byun, Y.C.; Lee, J.G.; Meng, X.; Lee, J.S. Low temperature (100 °C) atomic layer deposited-ZrO2 for recessed gate GaN HEMTs on Si. Appl. Phys. Lett. 2017, 111, 082905. [Google Scholar] [CrossRef]
- Wu, T.Y.; Lin, S.K.; Sze, P.W.; Huang, J.J.; Chien, W.C.; Hu, C.C.; Tsai, M.J.; Wang, Y.H. AlGaN/GaN MOSHEMTs With Liquid-Phase-Deposited TiO2 as Gate Dielectric. IEEE Trans. Electron Devices 2009, 56, 2911–2916. [Google Scholar] [CrossRef]
- Shen, L.; Zhang, D.; Cheng, X. Performance Improvement and Current Collapse Suppression of Al2O3/AlGaN/GaN HEMTs Achieved by Fluorinated Graphene Passivation. IEEE Electron Device Lett. 2017, 38, 596–599. [Google Scholar] [CrossRef]
- Li, S.; Hu, Q.; Wang, X.; Li, T. Improved Interface Properties and Dielectric Breakdown in Recessed AlGaN/GaN MOSHEMTs Using HfSiOx as Gate Dielectric. IEEE Electron Device Lett. 2019, 40, 295–298. [Google Scholar] [CrossRef]
- Shi, Y.T.; Xu, W.Z.; Zeng, C.K.; Ren, F.F.; Ye, J.D.; Zhou, D.; Chen, D.J.; Zhang, R.; Zheng, Y.; Lu, H. High-k HfO2-Based AlGaN/GaN MIS-HEMTs With Y2O3 Interfacial Layer for High Gate Controllability and Interface Quality. IEEE J. Electron Devices Soc. 2019, 8, 15–19. [Google Scholar] [CrossRef]
- Murugapandiyan, P.; Mohanbabu, A.; Rajya Lakshmi, V.; Ramakrishnan, V.N.; Varghese, A.; Wasim, M.; Baskaran, S.; Kumar, R.S.; Janakiraman, V. Performance analysis of HfO2/InAlN/AlN/GaN HEMT with AlN buffer layer for high power microwave applications. J. Sci. Adv. Mater. Devices 2020, 5, 192–198. [Google Scholar] [CrossRef]
- Cui, X.; Cheng, W.; Hua, Q.; Liang, R.; Hu, W.; Wang, Z.L. Enhanced performances of AlGaN/GaN HEMTs with dielectric engineering of HfZrOx. Nano Energy 2020, 68, 104361. [Google Scholar] [CrossRef]
- Rastogi, A.C.; Sharma, R.N. Structural and electrical characteristics of metal-insulator-semiconductor diodes based on Y2O3 dielectric thin films on silicon. J. Appl. Phys. 1992, 71, 5041. [Google Scholar] [CrossRef]
- Jung, H.S.; Lee, S.A.; Rha, S.H.; Lee, S.Y.; Kim, H.K.; Kim, D.H.; Oh, K.H.; Park, J.M.; Kim, W.H.; Song, M.W.; et al. Impacts of Zr Composition in Hf1-xZrxOy Gate Dielectrics on Their Crystallization Behavior and Bias-Temperature-Instability Characteristics. IEEE Trans. Electron. 2011, 58, 2094–2103. [Google Scholar] [CrossRef]
- Zhu, W.J.; Tamagawa, T.; Gibson, M.; Furukawa, T.; Ma, T.P. Effect of Al Inclusion in HfO2 on the Physical and Electrical Properties of the Dielectrics. IEEE Electron Device Lett. 2002, 23, 649–651. [Google Scholar] [CrossRef]
- Colon, A.; Shi, J. High-K insulating materials for AlGaN/GaN metal insulator semiconductor heterojunction field effect transistors. Solid State Electron. 2014, 99, 25–30. [Google Scholar] [CrossRef]
- Lin, J.; Monaghan, S.; Cherkaoui, K.; Povey, I.M.; Sheehan, B.; Hurley, P.K. Examining the relationship between capacitance-voltage hysteresis and accumulation frequency dispersion in InGaAs metal-oxide semiconductor structures based on the response to post-metal annealing. Microelectron. Eng. 2017, 178, 204–208. [Google Scholar] [CrossRef]
- Mohanbabu, A.; Mohankumar, N.; Godwin Raj, D.; Sarkar, P. Efficient III-Nitride MIS-HEMT devices with high-k gate dielectric for high-power switching boost converter circuits. Superlattice Microstruct. 2017, 103, 270–284. [Google Scholar] [CrossRef]
- Liu, L.; Xi, Y.; Ahn, S.; Ren, F.; Gila, B.P.; Pearton, S.J.; Kravchenko, I.I. Characteristics of gate leakage current and breakdown voltage of AlGaN/GaN high electron mobility transistors after postprocess annealing. J. Vac. Sci. Technol. B Microelectron. Nanom. Struct. 2014, 32, 1–5. [Google Scholar] [CrossRef]
- Liu, S.C.; Chen, B.Y.; Lin, Y.C.; Hsieh, T.E.; Wang, H.C.; Chang, E.Y. GaN MIS-HEMTs with Nitrogen Passivation for Power Device Applications. IEEE Electron Device Lett. 2014, 35, 1001–1003. [Google Scholar]
- Zheng, Y.Y.; Yue, H.; Cheng, Z.J.; Qian, F.; Yu, N.J.; Hua, M.X. A study on Al2O3 passivation in GaN MOS-HEMT by pulsed stress. Chin. Phys. B 2008, 17, 1405. [Google Scholar] [CrossRef]
- Cai, Y.; Zhou, Y.; Lau, K.M.; Chen, K.J. Enhancement-Mode AlGaN/GaN HEMTs with Low On-Resistance and Low Knee Voltage. IEEE Trans. Electron. 2006, 89, 1025–1030. [Google Scholar] [CrossRef]
- Rahman, M.M.; Kim, J.G.; Kim, D.H.; Kim, T.W. Characterization of Al Incorporation into HfO2 Dielectric by Atomic Layer Deposition. Micromechanics 2019, 10, 361. [Google Scholar]
- Kalb, W.L.; Batlogg, B. Calculating the trap density of states in organic field-effect transistors from experiment: A comparison of different methods. Phys. Rev. B 2010, 81, 1–13. [Google Scholar] [CrossRef]
- Marron, T.; Takashima, S. Impact of annealing on ALD Al2O3 gate dielectric for GaN MOS devices. Phys. Status Solidi C 2012, 9, 907–910. [Google Scholar] [CrossRef]
- Wang, Q.; Cheng, X.; Zheng, L.; Shen, L.; Li, J.; Zhang, D.; Qian, R.; Yu, Y. Interface engineering of an AlNO/AlGaN/GaN MIS diode induced by PEALD alternate insertion of AlN in Al2O3. RSC Adv. 2017, 7, 11745–11751. [Google Scholar] [CrossRef]
- Reddy, M.S.P.; Park, W.S.; Im, K.S.; Lee, J.H. Dual-surface modification of AlGaN/GaN HEMTs using TMAH and piranha solutions for enhancing current and 1/f-Noise Characteristics. IEEE J. Electron Devices Soc. 2018, 6, 791–796. [Google Scholar] [CrossRef]
- Medjdoub, F.; Sarazin, N.; Tordjman, M.; Magis, M.; di Forte-Poisson, M.A.; Knez, M.; Delos, E.; Gaquiere, C.; Delage, S.L.; Kohn, E. Characteristics of Al2O3/AlInN/GaN MOSHEMT. Electron. Lett. 2007, 43, 691–692. [Google Scholar] [CrossRef]
- Suria, A.J.; Yalamarthy, A.S.; Heuser, T.A.; Bruefach, A.; Chapin, C.A.; So, H.; Senesky, D.G. Thickness engineering of atomic layer deposited Al2O3 films to suppress interfacial reaction and diffusion of Ni/Au gate metal in AlGaN/GaN HEMTs up to 600 C in air. App. Phys. Lett. 2017, 110, 253505. [Google Scholar] [CrossRef]
- Freedsman, J.J.; Egawa, T.; Yamaoka, Y.; Yano, Y.; Ubukata, A.; Tabuchi, T.; Matsumoto, K. Normally-OFF Al2O3/AlGaN/GaN MOS-HEMT on 8 in. Si with Low Leakage Current and High Breakdown Voltage (825 V). Appl. Phys. Express 2014, 7, 041003. [Google Scholar]
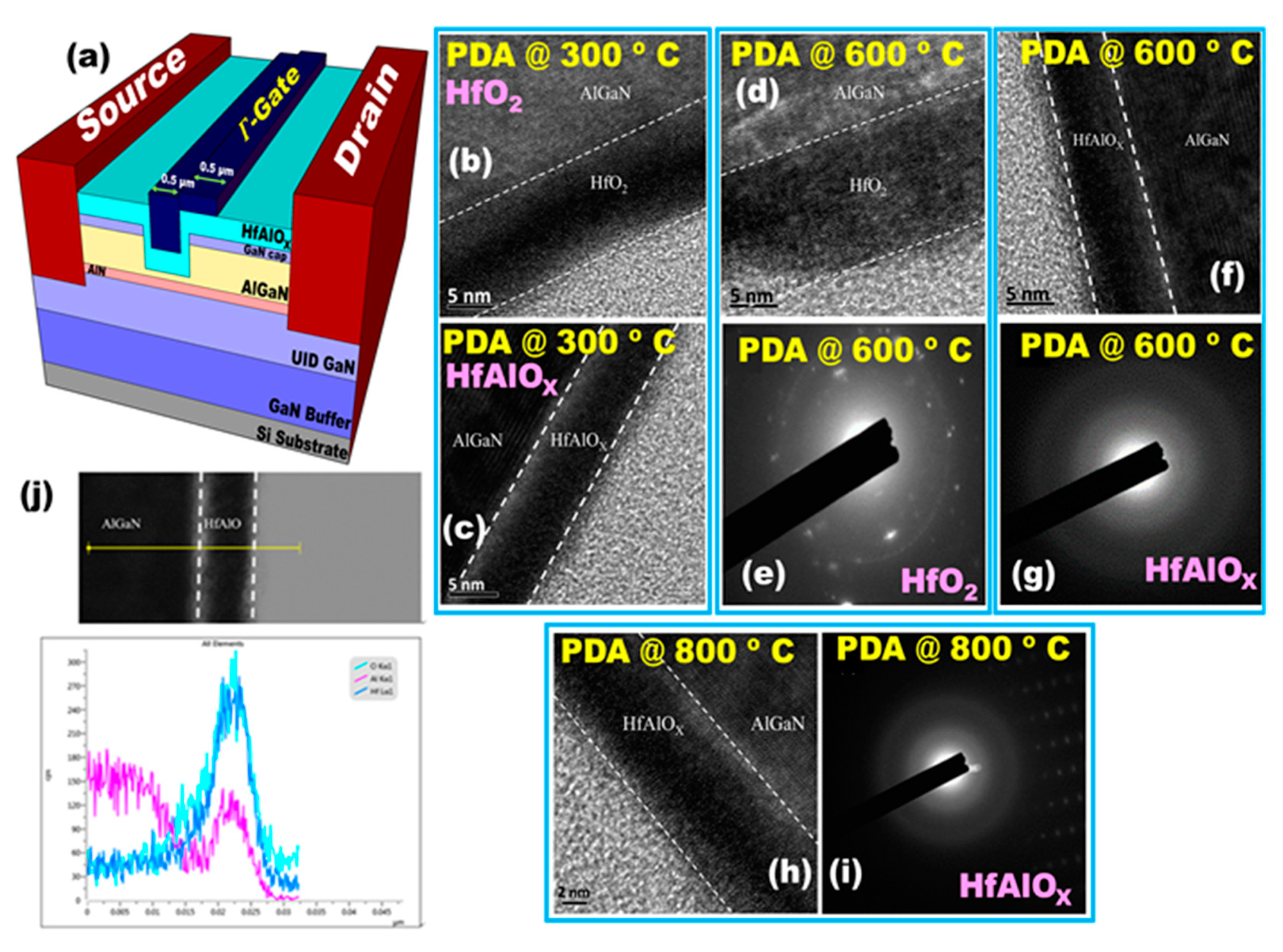



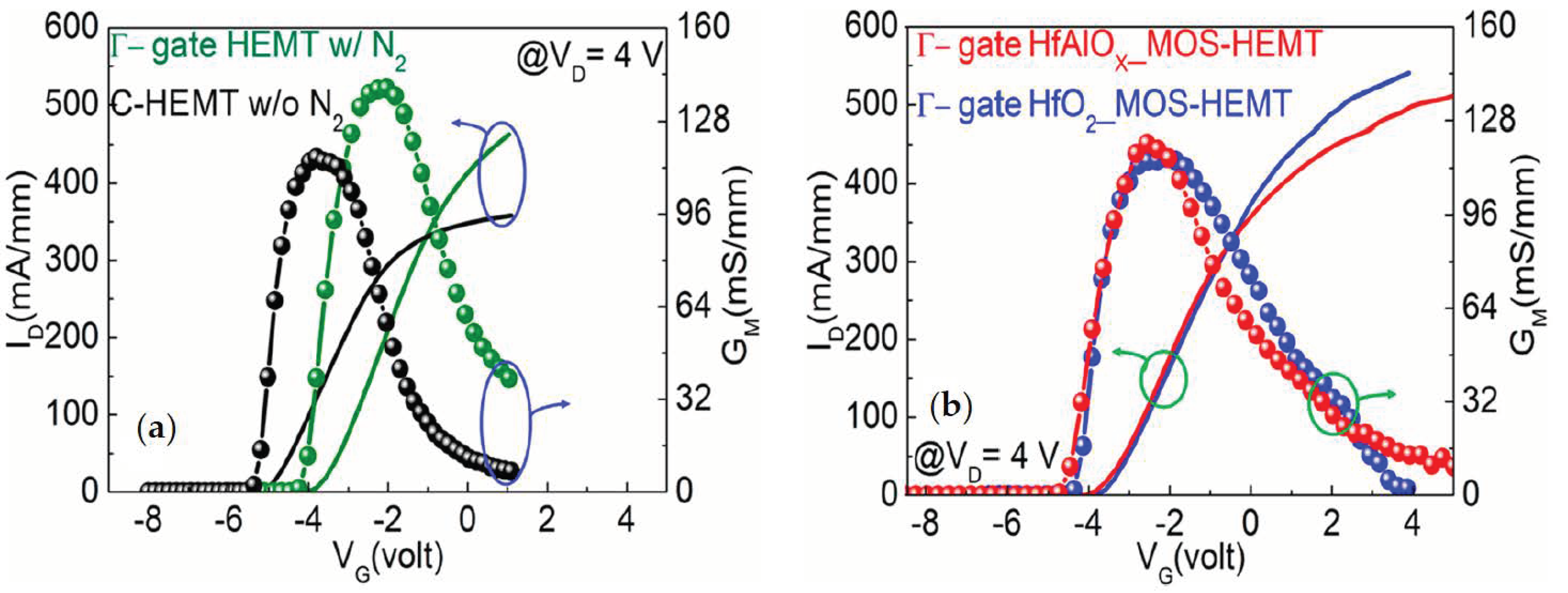




| Parameters | Non-Recessed HEMT | Partially-Recessed HEMT | Partially-Recessed HfO2 MOS-HEMT | Partially-Recessed HfAlOX MOS-HEMT |
|---|---|---|---|---|
| IDMAX (mA/mm) | 520 (VG = 1 V) | 570 (VG = 1 V) | 775 (VG = 4 V) | 870 (VG = 5 V) |
| VTH (V) | −4.9 | −3.55 | −3.41 | −3.55 |
| GMMAX (mS/mm) (@ VD = 4 V) | 114 | 139 | 116 | 118 |
| SS (mV/dec) | 110 | 101 | 86 | 90 |
| ION/IOFF | 1.04 | 2.9 | 2.3 | 1.8 |
| IG (A/mm) (@VG =−12 V) | ||||
| Current collapse (%) | - | 18 | 13 | 4 |
| Dit () | - | |||
| Hysteresis (∆V) (V) | - | - | 0.48 | 0.15 |
| VBR (V) | - | 107 | 145 | 195 |
| Parameters | Ref. [21] | Ref. [23] | Ref. [39] | Ref. [40] | Ref. [41] | This Work |
|---|---|---|---|---|---|---|
| Epi structure | GaN/AlGaN/GaN | GaN/AlGaN/AlN/GaN | AlInN/AlN/GaN | GaN/AlGaN/GaN | GaN/AlGaN/AlN/GaN | GaN/AlGaN/AlN/GaN |
| LG (µm) | 1 | 5 | 0.2 | 50 | 1.5 | 0.5 |
| Dielectric materials | HfO2/Y2O3 | HfZrOX | Al2O3 | Al2O3 | Al2O3 | HfAlOX |
| Dielectric Thickness (nm) | 12/1 | 20 | 5 | 50 | 20 | 10 |
| IDMAX (mA/mm) | 600 | 705 | 1150 | ~160 | 300 | 870 |
| GMMAX (mS/mm) | 4.5 (@VD = 0.05 V) | 54 (@VD = 10 V) | 185 | 77 (@VD = 15 V) | 79 (@VD = 8 V) | 118 (@VD = 4 V) |
| SS (mV/dec) | 70 | 85 | - | - | 74 | 90 |
| ION/IOFF | 109 | 106 | - | - | 1.8 | |
| IG | 10−10 A/mm (@VG = −9 V) | ~10−7 A/mm (@VG = −10 V) | ~10−4 A/mm (@ VG = −15 V) | > 10−5 A/m2 (@ VG = −5 V) | 10−11 A/mm (@ VG = -6 V) | A/mm (@VG = −12 V) |
| Current collapse (%) | - | < 9% | - | - | - | ~4% |
| Dit (cm−2·eV−1) | 1012 | 1.1 109 | - | - | - | 1.8 1012 |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Yang, S.-K.; Mazumder, S.; Wu, Z.-G.; Wang, Y.-H. Performance Enhancement in N2 Plasma Modified AlGaN/AlN/GaN MOS-HEMT Using HfAlOX Gate Dielectric with Γ-Shaped Gate Engineering. Materials 2021, 14, 1534. https://doi.org/10.3390/ma14061534
Yang S-K, Mazumder S, Wu Z-G, Wang Y-H. Performance Enhancement in N2 Plasma Modified AlGaN/AlN/GaN MOS-HEMT Using HfAlOX Gate Dielectric with Γ-Shaped Gate Engineering. Materials. 2021; 14(6):1534. https://doi.org/10.3390/ma14061534
Chicago/Turabian StyleYang, Shun-Kai, Soumen Mazumder, Zhan-Gao Wu, and Yeong-Her Wang. 2021. "Performance Enhancement in N2 Plasma Modified AlGaN/AlN/GaN MOS-HEMT Using HfAlOX Gate Dielectric with Γ-Shaped Gate Engineering" Materials 14, no. 6: 1534. https://doi.org/10.3390/ma14061534
APA StyleYang, S.-K., Mazumder, S., Wu, Z.-G., & Wang, Y.-H. (2021). Performance Enhancement in N2 Plasma Modified AlGaN/AlN/GaN MOS-HEMT Using HfAlOX Gate Dielectric with Γ-Shaped Gate Engineering. Materials, 14(6), 1534. https://doi.org/10.3390/ma14061534





