An Optimized Structure of Split-Gate Resurf Stepped Oxide UMOSFET
Abstract
:1. Introduction
2. Device Structure and Principles of Operation
3. Fabrication Procedure
4. Results and Discussion
5. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- Wei, Y.; Luo, X.R.; Ge, W.W.; Zhao, Z.Y.; Ma, Z.; Wei, J. A Split Triple-Gate Power LDMOS with Improved Static-State and Switching Performance. IEEE Trans. Electron. Devices 2019, 66, 2669–2674. [Google Scholar] [CrossRef]
- Zhang, G.S.; Zhang, W.T.; He, J.Q.; Zhu, X.H.; Zhang, S.; Zhao, J.C.; Zhang, Z.; Qiao, M.; Zhou, X.; Li, Z.J.; et al. Experiments of a Novel low on-resistance LDMOS with 3-D Floating Vertical Field Plate. In Proceedings of the 31st International Symposium on Power Semiconductor Devices and ICs, Shanghai, China, 19–23 May 2019; pp. 507–510. [Google Scholar]
- Hu, Y.; Wang, H.; Du, C.X.; Du, Y.Z.; Deng, P.G.; He, J.; Song, L.; Zhou, H.Q.; Wu, Y. A new 600V partial SOI LDMOS with step-doped drift region. In Proceedings of the 6th Asia Symposium on Quality Electronic Design (ASQED), Kula Lumpur, Malaysia, 4–5 August 2015; pp. 161–165. [Google Scholar]
- Li, Q.; Bao, T.T.; Li, H.O.; Sun, T.Y.; Zuo, Y. Uniform shallow trenches termination design for high-voltage VDMOS transistor. Electron. Lett. 2020, 56, 104–105. [Google Scholar] [CrossRef]
- Zhou, X.; Feng, Q.Y.; Chen, X.P. The Study of P-pillar and Trench Technology in VDMOS. In Proceedings of the 2019 PhotonIcs & Electromagnetics Research Symposium—Spring (PIERS-Spring), Rome, Italy, 17–20 June 2019; pp. 1552–1556. [Google Scholar]
- Yang, H.J.; Feng, Q.Y. Design Novel Structure of High-voltage MOSFET with Double-Trench Gates. In Proceedings of the 2019 PhotonIcs & Electromagnetics Research Symposium—Spring (PIERS-Spring), Rome, Italy, 17–20 June 2019; pp. 1012–1017. [Google Scholar]
- Park, C.; Azam, M.; Dengel, G.; Shibib, A.; Terrill, K. A New 200 V Dual Trench MOSFET with Stepped Oxide for Ultra Low RDS (on). In Proceedings of the 31st International Symposium on Power Semiconductor Devices and ICs, Shanghai, China, 19–23 May 2019; pp. 95–98. [Google Scholar]
- Gong, X.Q.; Zhang, Y.F.; Hao, L.; Wu, H.Z.; Ding, Y.; Liu, M.X. Effect of Trench Bottom Implantation on the Performance of Trench MOSFET. In Proceedings of the 2019 IEEE International Conference on Integrated Circuits, Technologies and Applications (ICTA), Chengdu, China, 13–15 November 2019; pp. 115–116. [Google Scholar]
- Liu, Y.F.; Feng, Q.Y.; Yang, H.Y.; Jin, T. Influence of Different Ion Implantation and Diffusion Models on UMOS Threshold Voltage. In Proceedings of the 2019 PhotonIcs & Electromagnetics Research Symposium-Spring (PIERS-Spring), Rome, Italy, 17–20 June 2019; pp. 3376–3379. [Google Scholar]
- Lin, Z. Study on the Intrinsic Origin of Output Capacitor Hysteresis in Advanced Superjunction MOSFETs. IEEE Electron. Device Lett. 2019, 40, 1297–1300. [Google Scholar] [CrossRef]
- Kang, H.; Udrea, F. Theory of 3-D Superjunction MOSFET. IEEE Trans. Electron. Devices 2019, 66, 66–5254. [Google Scholar] [CrossRef]
- Lin, Z.; Guo, J.W.; Wang, Z.H.; Li, P.; Hu, S.D.; Zhou, J.L.; Tang, F. Novel Isolation Structure for High-Voltage Integrated Superjunction MOSFETs. IEEE Electron. Device Lett. 2020, 41, 115–118. [Google Scholar] [CrossRef]
- Ye, Z.Y.; Liu, L.; Yao, Y.; Lin, M.Z.; Wang, P.F. Fabrication of a 650V Superjunction MOSFET with Built-in MOS-Channel Diode for Fast Reverse Recovery. IEEE Electron. Device Lett. 2019, 40, 1159–1162. [Google Scholar] [CrossRef]
- Cao, Z.; Duan, B.X.; Song, H.T.; Xie, F.Y.; Yang, Y.T. Novel Superjunction LDMOS with a High-K Dielectric Trench by TCAD Simulation Study. IEEE Trans. Electron. Devices 2019, 66, 2327–2332. [Google Scholar] [CrossRef]
- Kato, H.; Nishiguchi, T.; Shimomura, S.; Miyashita, K.; Kobayashi, K. Mechanism and Control Technique of Wafer Warpage in Process Integration for Trench Field Plate Power MOSFET. IEEE Trans. Semicond. Manuf. 2019, 32, 417–422. [Google Scholar] [CrossRef]
- Ding, Y.; Liu, M.X.; He, M.; Zhang, Y.F.; Chen, R.Z.; Gong, X.Q. Design and fabrication of charge-balanced SGRSO MOSFET. In Proceedings of the 2019 IEEE International Conference on Electron Devices and Solid-State Circuits (EDSSC), Xian, China, 12–14 June 2019. [Google Scholar]
- Wang, Y.; Hu, H.-F.; Yu, C.-H.; Wei, J.-T. Advanced hexagonal layout design for split-gate reduced surface field stepped oxide U-groove metal–oxide–semiconductor field-effect transistor. IET Power Electron. 2015, 8, 678–684. [Google Scholar]
- Park, C.; Havanur, S.; Shibib, A.; Terrill, K. 60 V rating split gate trench MOSFETs having best-in-class specific resistance and figure-of-merit. In Proceedings of the 28st International Symposium on Power Semiconductor Devices and ICs, Prague, Czech Republic, 12–16 June 2016; pp. 387–390. [Google Scholar]
- Wang, Y.; Yu, C.; Li, M.; Cao, F.; Liu, Y. High-Performance Split-Gate-Enhanced UMOSFET with Dual Channels. IEEE Trans. Electron. Devices 2017, 64, 1455–1460. [Google Scholar] [CrossRef]
- Baliga, B.J. GD-MOSFET Structure. In Advanced Power MOSFET Concepts; Springer Science and Business Media: New York, NY, USA, 2010; pp. 241–322. [Google Scholar]
- Wang, Y.; Hu, H.F.; Yu, C.H.; Lan, H. High-performance split-gate enhanced UMOSFET with p-pillar structure. IEEE Trans. Electron. Devices 2013, 60, 2302–2307. [Google Scholar] [CrossRef]
- Wang, Y.; Lan, H.; Cao, F.; Liu, Y.T.; Shao, L. A novel power UMOSFET with a variable K dielectric layer. Chin. Phys. Soc. 2012, 21, 569–572. [Google Scholar] [CrossRef]
- Wang, Y.; Hu, H.; Jiao, W. High-Performance Gate-Enhanced Power UMOSFET with Optimized Structure. IEEE Electron. Device Lett. 2010, 31, 1281–1283. [Google Scholar] [CrossRef]
- Wang, Y.; Hu, H.F.; Dou, Z.; Yu, C.H. Way of operation to improve performance for advanced split-gate resurf stepped oxide UMOSFET. IET Power Electron. 2014, 7, 2964–2968. [Google Scholar] [CrossRef]
- Hattori, Y.; Nakashima, K.; Kuwahara, M.; Yoshida, T.; Yamauchi, S. Design of a 200V Super Junction MOSFET with n-buffer regions and its Fabrication by Trench Filling. In Proceedings of the 16st International Symposium on Power Semiconductor Devices and ICs, Kitakyushu, Japan, 24–27 May 2004; pp. 189–192. [Google Scholar]
- Shibata, T.; Noda, Y.; Yamauchi, S.; Nogami, S.; Yamaoka, T.; Hattori, Y.; Yamaguchi, H. 200V Trench Filling Type Super Junction MOSFET with Orthogonal Gate Structure. In Proceedings of the 19st International Symposium on Power Semiconductor Devices and ICs, Jeju, Korea, 27–31 May 2007; pp. 37–40. [Google Scholar]
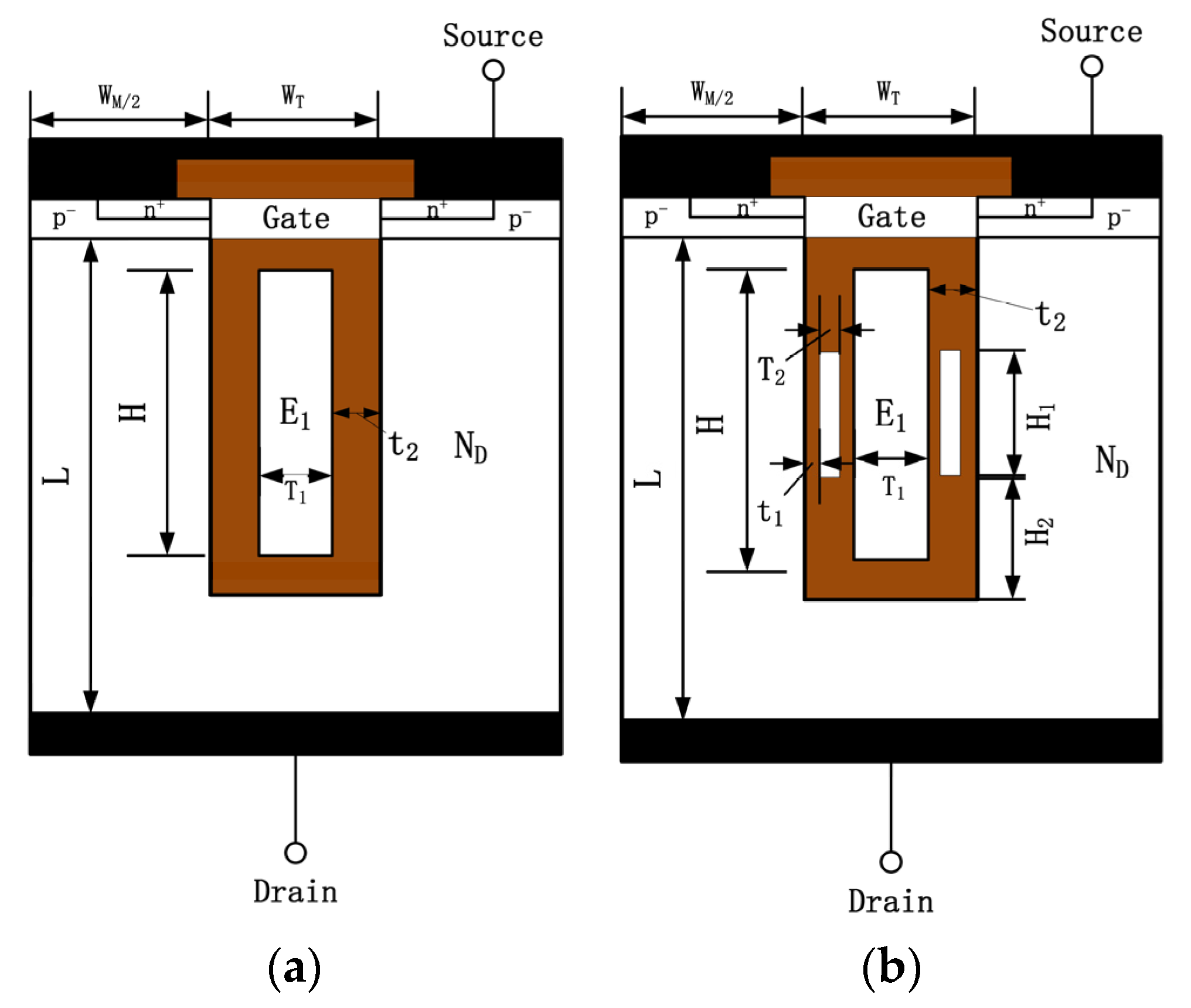
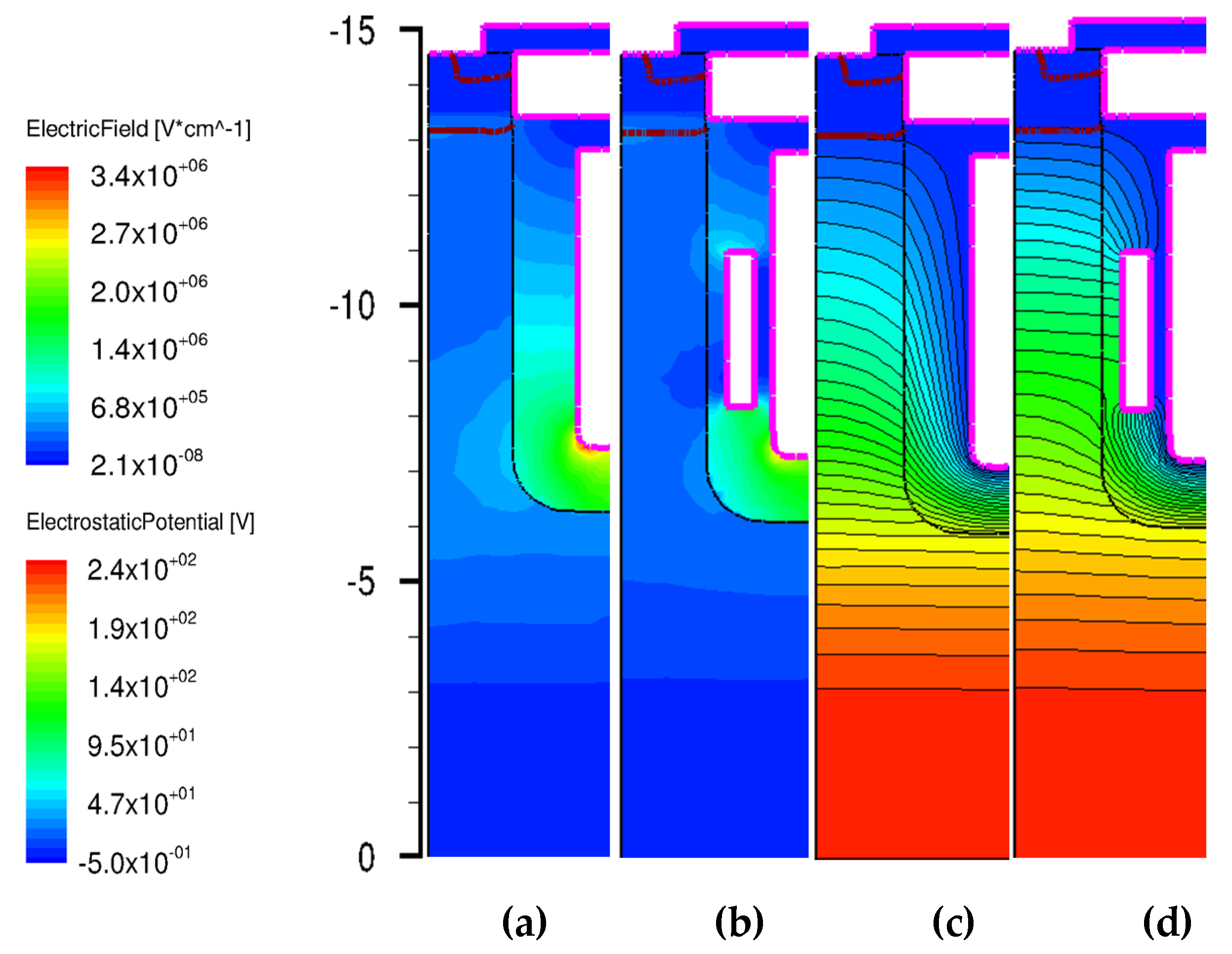





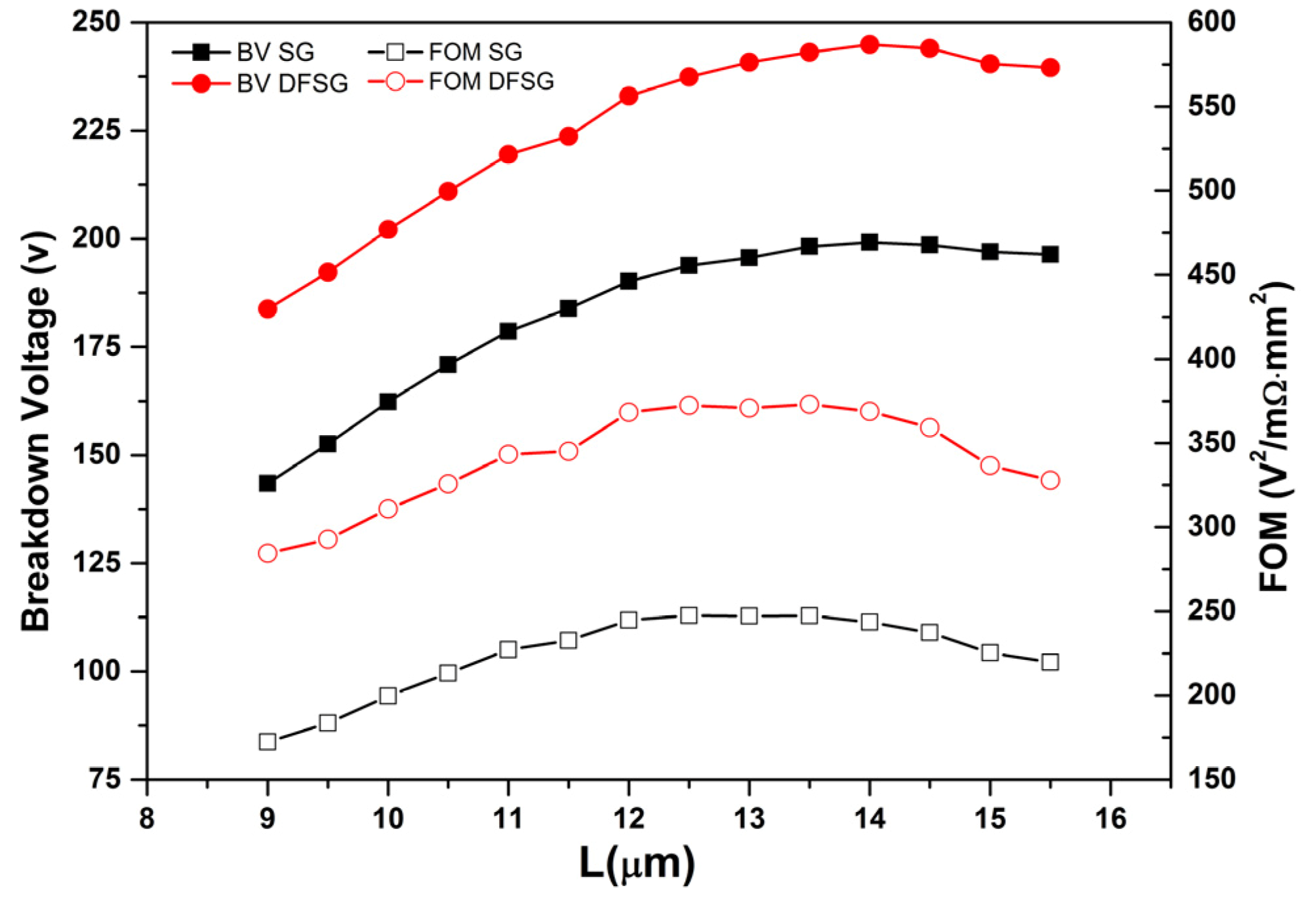
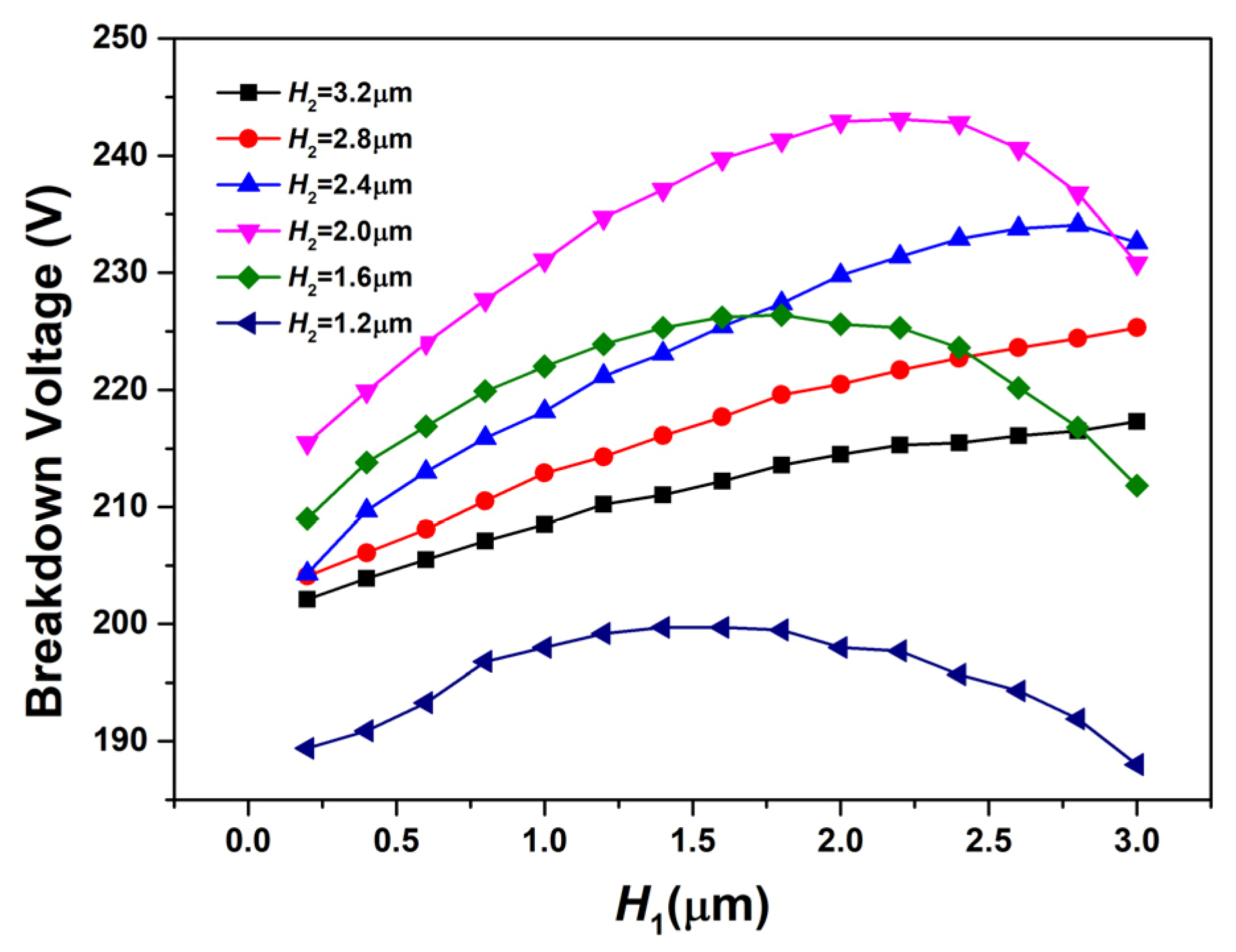
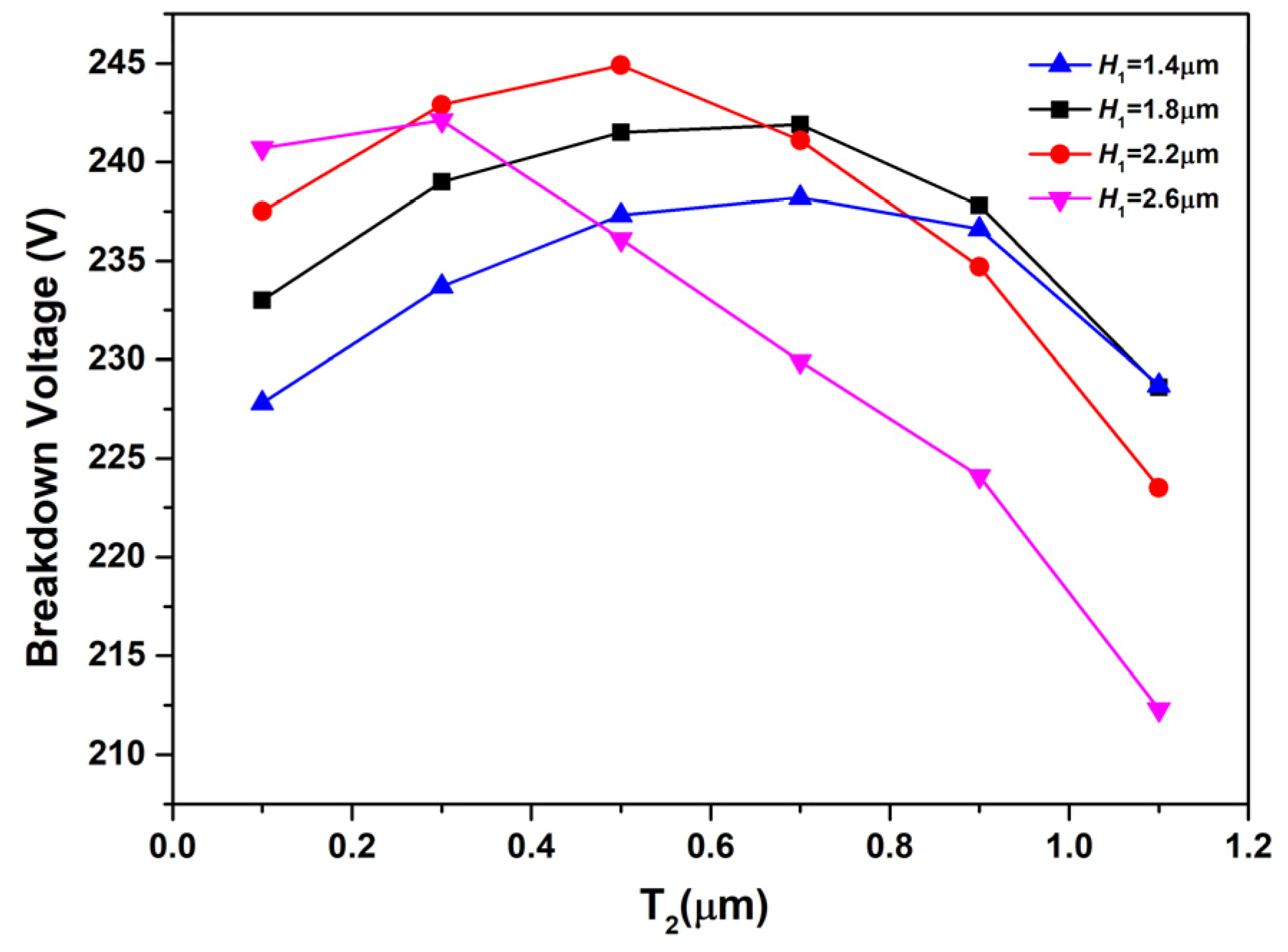
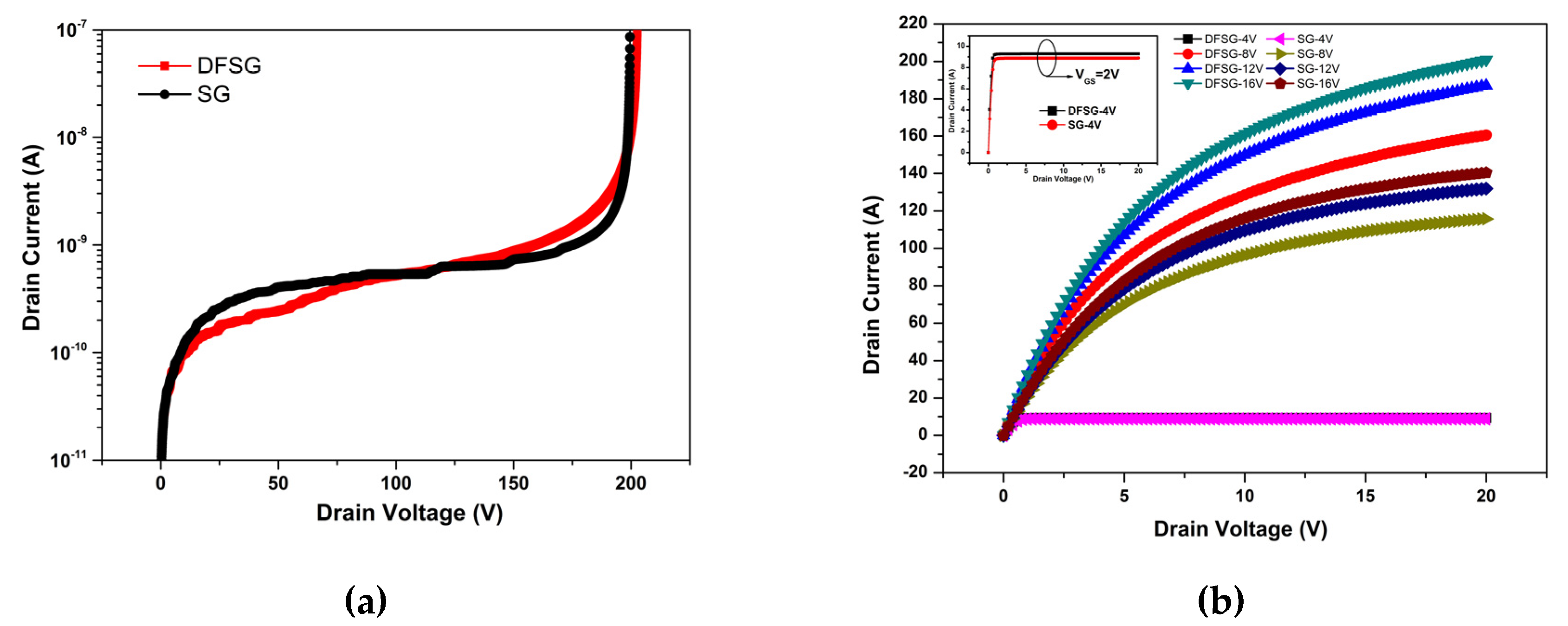
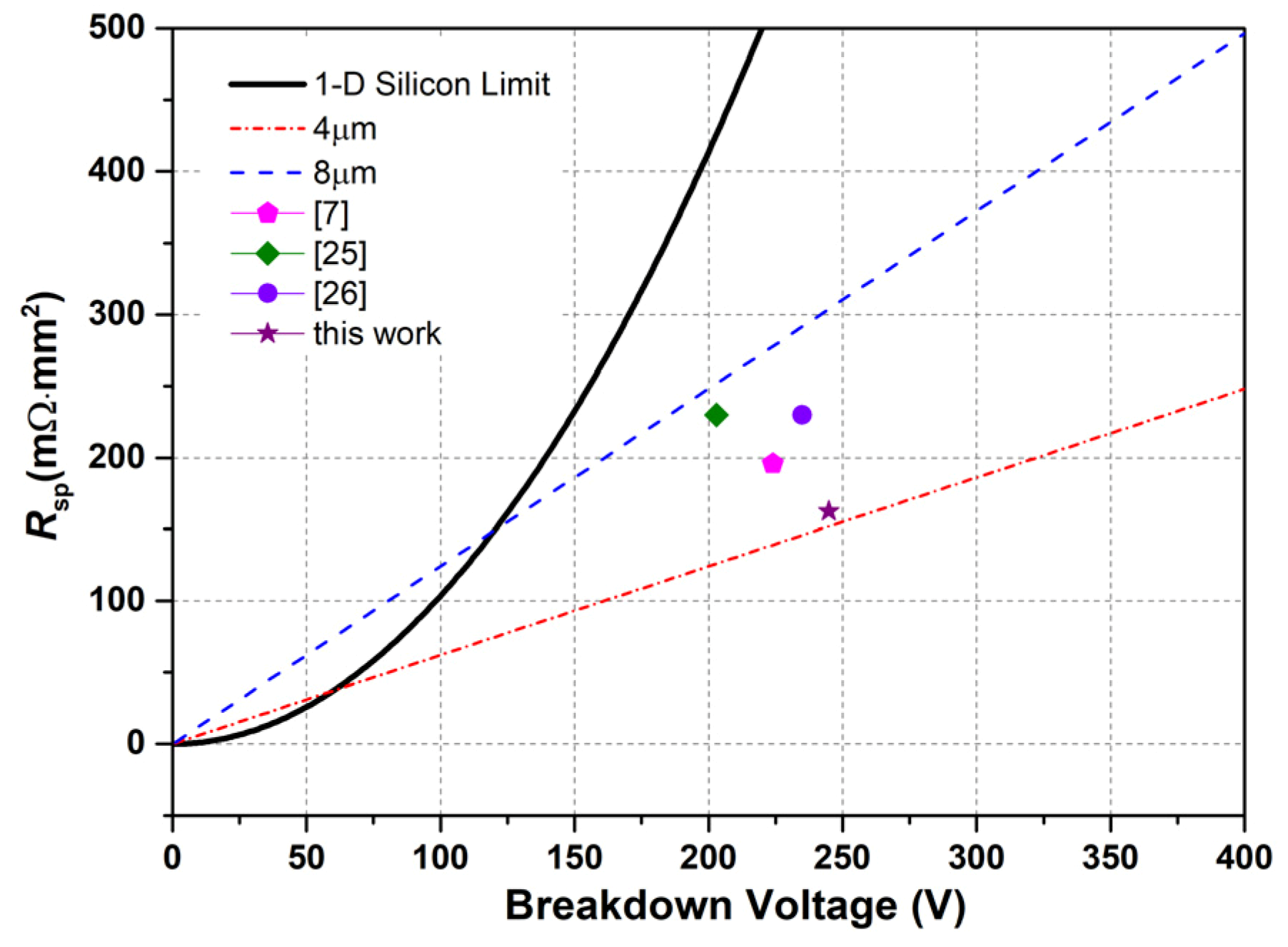
| Parameter | Value |
|---|---|
| Depth of trench in drift region (HT) | 7.5 μm |
| Depth of gate (HG) | 1.0 μm |
| Depth of n+ source junction | 0.2 μm |
| Depth of p-body junction | 0.8 μm |
| Doping of p-body | 1.5 × 1018 cm−3 |
| width of trench (WT) | 3.6 μm |
| Width of mesa (WM) | 3.2 μm |
| Width of source electrode E1 (T1) | 1.6 μm |
| Thickness of split-gate oxide for SGRSO (t2) | 1.2 μm |
| Doping of n-drift region (ND) | 4.5 × 1015 cm−3 |
| Width of floating electrodes (T2) | 0.5 μm |
| Length of floating electrodes (H1) | 2.2 μm |
| Depth of floating electrodes (H2) | 2.0 μm |
| Thickness of n-drift region (L) | 13.5 μm |
| Height of source electrode of SGRSO (H) | 6.3 μm |
© 2020 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Chen, R.; Wang, L.; Jiu, N.; Zhang, H.; Guo, M. An Optimized Structure of Split-Gate Resurf Stepped Oxide UMOSFET. Electronics 2020, 9, 745. https://doi.org/10.3390/electronics9050745
Chen R, Wang L, Jiu N, Zhang H, Guo M. An Optimized Structure of Split-Gate Resurf Stepped Oxide UMOSFET. Electronics. 2020; 9(5):745. https://doi.org/10.3390/electronics9050745
Chicago/Turabian StyleChen, Runze, Lixin Wang, Naixia Jiu, Hongkai Zhang, and Min Guo. 2020. "An Optimized Structure of Split-Gate Resurf Stepped Oxide UMOSFET" Electronics 9, no. 5: 745. https://doi.org/10.3390/electronics9050745
APA StyleChen, R., Wang, L., Jiu, N., Zhang, H., & Guo, M. (2020). An Optimized Structure of Split-Gate Resurf Stepped Oxide UMOSFET. Electronics, 9(5), 745. https://doi.org/10.3390/electronics9050745




