Plasma Enhanced Atomic Layer Deposition of Tantalum (V) Oxide
Abstract
1. Introduction
2. Materials and Methods
3. Results and Discussions
3.1. Atomic Layer Deposition of Ta-O Thin Films
3.2. Morphology of Films on Si
3.3. Chemical Composition of the Films
3.4. Crystal Structure
3.5. SEM of Tantalum Oxide Coated Steel
3.6. Electrochemical Studies
4. Conclusions
Supplementary Materials
Author Contributions
Funding
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Pfeiffer, K.; Schulz, U.; Tünnermann, A.; Szeghalmi, A. Antireflection coatings for strongly curved glass lenses by atomic layer deposition. Coatings 2017, 7, 118. [Google Scholar] [CrossRef]
- Rossnagel, S.M.; Sherman, A.; Turner, F. Plasma-enhanced atomic layer deposition of Ta and Ti for interconnect diffusion barriers. J. Vac. Sci. Technol. B Microelectron. Nanom. Struct. 2000, 18, 2016. [Google Scholar] [CrossRef]
- Malygin, A.A.; Drozd, V.E.; Malkov, A.A.; Smirnov, V.M. From V. B. Aleskovskii’s “framework” Hypothesis to the Method of Molecular Layering/Atomic Layer Deposition. Chem. Vap. Depos. 2015, 21, 216–240. [Google Scholar] [CrossRef]
- Maximov, M.; Nazarov, D.; Rumyantsev, A.; Koshtyal, Y.; Ezhov, I.; Mitrofanov, I.; Kim, A.; Medvedev, O.; Popovich, A. Atomic layer Depos. of lithium-nickel-silicon oxide cathode material for thin-film lithium-ion batteries. Energies 2020, 13, 2345. [Google Scholar] [CrossRef]
- Metalorganics.Ru. Available online: http://www.metalorganics.ru/files/PR-ME-R/PR-TA1-R2.htm (accessed on 13 August 2021).
- Kukli, K.; Ritala, M.; Leskelä, M. Atomic layer deposition and chemical vapor deposition of tantalum oxide by successive and simultaneous pulsing of tantalum ethoxide and tantalum chloride. Chem. Mater. 2000, 12, 1914–1920. [Google Scholar] [CrossRef]
- Kariniemi, M.; Niinistö, J.; Vehkamäki, M.; Kemell, M.; Ritala, M.; Leskelä, M.; Putkonen, M. Conformality of remote plasma-enhanced atomic layer deposition processes: An experimental study. J. Vac. Sci. Technol. A Vacuum Surf. Film. 2012, 30, 01A115. [Google Scholar] [CrossRef]
- Song, H.J.; Lee, C.S.; Kang, S.W. Increment of the dielectric constant of Ta2O5 thin films by retarding interface oxide growth on Si substrates. Electrochem. Solid-State Lett. 2001, 4, 13–14. [Google Scholar] [CrossRef]
- Sønsteby, H.H.; Nilsen, O.; Fjellvåg, H. Atomic layer deposition of (K,Na) (Nb,Ta)O3 thin films. J. Vac. Sci. Technol. A Vacuum Surf. Film 2016, 34, 041508. [Google Scholar] [CrossRef]
- Liu, J.; Banis, M.N.; Li, X.; Lushington, A.; Cai, M.; Li, R.; Sham, T.K.; Sun, X. Atomic layer deposition of lithium tantalate solid-state electrolytes. J. Phys. Chem. C 2013, 117, 20260–20267. [Google Scholar] [CrossRef]
- Gu, D.; Li, J.; Dey, S.K.; De Waard, H.; Marcus, S. Nanochemistry, nanostructure, and electrical properties of Ta2O5 film deposited by atomic layer deposition and plasma-enhanced atomic layer deposition. J. Vac. Sci. Technol. B Microelectron. Nanom. Struct. 2006, 24, 2230. [Google Scholar] [CrossRef]
- Alimardani, N.; King, S.W.; French, B.L.; Tan, C.; Lampert, B.P.; Conley, J.F. Investigation of the impact of insulator material on the performance of dissimilar electrode metal-insulator-metal diodes. J. Appl. Phys. 2014, 116, 024508. [Google Scholar] [CrossRef]
- Egorov, K.V.; Kuzmichev, D.S.; Chizhov, P.S.; Lebedinskii, Y.Y.; Hwang, C.S.; Markeev, A.M. In Situ Control of Oxygen Vacancies in TaOx Thin Films via Plasma-Enhanced Atomic Layer Deposition for Resistive Switching Memory Applications. ACS Appl. Mater. Interfaces 2017, 9, 13286–13292. [Google Scholar] [CrossRef] [PubMed]
- Egorov, K.V.; Kuzmichev, D.S.; Sigarev, A.A.; Myakota, D.I.; Zarubin, S.S.; Chizov, P.S.; Perevalov, T.V.; Gritsenko, V.A.; Hwang, C.S.; Markeev, A.M. Hydrogen radical enhanced atomic layer deposition of TaOx: Saturation studies and methods for oxygen deficiency control. J. Mater. Chem. C 2018, 6, 9667–9674. [Google Scholar] [CrossRef]
- Yang, W.S.; Kang, S.W. Comparative study on chemical stability of dielectric oxide films under HF wet and vapor etching for radiofrequency microelectromechanical system application. Thin Solid Films 2006, 500, 231–236. [Google Scholar] [CrossRef]
- Kukli, K.; Kemell, M.; Vehkamäki, M.; Heikkilä, M.J.; Mizohata, K.; Kalam, K.; Ritala, M.; Leskelä, M.; Kundrata, I.; Fröhlich, K. Atomic layer deposition and properties of mixed Ta2O5 and ZrO2 films. AIP Adv. 2017, 7, 025001. [Google Scholar] [CrossRef]
- Kim, M.K.; Kim, W.H.; Lee, T.; Kim, H. Growth characteristics and electrical properties of Ta2O5 grown by thermal and O3-based atomic layer deposition on TiN substrates for metal-insulator-metal capacitor applications. Thin Solid Films 2013, 542, 71–75. [Google Scholar] [CrossRef]
- Jenkins, M.A.; Austin, D.Z.; Holden, K.E.K.; Allman, D.; Conley, J.F. Laminate Al2O3/Ta2O5 Metal/Insulator/Insulator/Metal (MIIM) Devices for High-Voltage Applications. IEEE Trans. Electron Devices 2019, 66, 5260–5265. [Google Scholar] [CrossRef]
- Ma, P.; Lu, J.; Aubuchon, J.; Gung, T.-J.; Chang, M. (Invited) Plasma Enhanced Atomic Layer Deposition of TaN Films for Advanced Interconnects. ECS Trans. 2019, 33, 169–176. [Google Scholar] [CrossRef]
- Kwon, J.D.; Park, J.S.; Lee, H.C.; Kang, S.W. A chemical reaction path design for the atomic layer deposition of tantalum nitride thin films. Electrochem. Solid-State Lett. 2006, 9, 282–284. [Google Scholar] [CrossRef]
- Chung, H.-S.; Kwon, J.-D.; Kang, S.-W. Plasma-Enhanced Atomic Layer Deposition of TaN Thin Films Using Tantalum-Pentafluoride and N2H2Ar Plasma. J. Electrochem. Soc. 2006, 153, C751. [Google Scholar] [CrossRef]
- Chaker, A.; Vallee, C.; Pesce, V.; Belahcen, S.; Vallat, R.; Gassilloud, R.; Posseme, N.; Bonvalot, M.; Bsiesy, A. Topographically selective deposition. Appl. Phys. Lett. 2019, 114, 043101. [Google Scholar] [CrossRef]
- Choi, B.J.; Zhang, J.; Norris, K.; Gibson, G.; Kim, K.M.; Jackson, W.; Zhang, M.X.M.; Li, Z.; Yang, J.J.; Williams, R.S. Trilayer Tunnel Selectors for Memristor Memory Cells. Adv. Mater. 2016, 28, 356–362. [Google Scholar] [CrossRef]
- Fang, Q.; Hodson, C.; Liu, M.; Fang, Z.W.; Potter, R.; Gunn, R. Preliminary Investigation of High-K Materials-TiO2 Doped Ta2O5 Films by Remote Plasma Ald. Phys. Procedia 2012, 32, 379–388. [Google Scholar] [CrossRef]
- Song, S.J.; Park, T.; Yoon, K.J.; Yoon, J.H.; Kwon, D.E.; Noh, W.; Lansalot-Matras, C.; Gatineau, S.; Lee, H.K.; Gautam, S.; et al. Comparison of the atomic layer deposition of tantalum oxide thin films using Ta(NtBu)(NEt2)3, Ta(NtBu)(NEt2)2Cp, and H2O. ACS Appl. Mater. Interfaces 2017, 9, 537–547. [Google Scholar] [CrossRef] [PubMed]
- Kim, S.-W.; Kwon, S.-H.; Jeong, S.-J.; Kang, S.-W. Improvement of Copper Diffusion Barrier Properties of Tantalum Nitride Films by Incorporating Ruthenium Using PEALD. J. Electrochem. Soc. 2008, 155, H885. [Google Scholar] [CrossRef]
- Park, T.J.; Kim, J.H.; Jang, J.H.; Na, K.D.; Hwang, C.S.; Kim, G.M.; Choi, K.J.; Jeong, J.H. Effective work function tunability and interfacial reactions with underlying HfO2 layer of plasma-enhanced atomic layer deposited TaCxNy films. Appl. Phys. Lett. 2008, 92, 12–15. [Google Scholar] [CrossRef]
- Park, T.J.; Kim, J.H.; Jang, J.H.; Na, K.D.; Hwang, C.S.; Kim, J.H.; Kim, G.M.; Choi, J.H.; Choi, K.J.; Jeong, J.H. Improved electrical performances of plasma-enhanced atomic layer deposited TaCx Ny films by adopting Ar H2 plasma. Appl. Phys. Lett. 2007, 91, 2005–2008. [Google Scholar] [CrossRef]
- Lee, H.J.; Park, J.S.; Kwon, S.H. Plasma-enhanced atomic layer deposition of tantalum nitride thin films using tertiary-amylimido-tris(dimethylamido)tantalum and hydrogen plasma. J. Electroceram. 2016, 36, 165–169. [Google Scholar] [CrossRef]
- Nabatame, T.; Ohi, A.; Ito, K.; Takahashi, M.; Chikyo, T. Role of the (Ta/Nb)Ox/Al2O3 interface on the flatband voltage shift for Al2O3/(Ta/Nb)Ox/Al2O3 multilayer charge trap capacitors. J. Vac. Sci. Technol. A Vacuum Surf. Film 2015, 33, 01A118. [Google Scholar] [CrossRef]
- Heil, S.B.S.; Roozeboom, F.; van de Sanden, M.C.M.; Kessels, W.M.M. Plasma-assisted atomic layer deposition of Ta2O5 from alkylamide precursor and remote O2 plasma. J. Vac. Sci. Technol. A Vac. Surf. Film 2008, 26, 472–480. [Google Scholar] [CrossRef][Green Version]
- Yoon, J.H.; Kim, K.M.; Song, S.J.; Seok, J.Y.; Yoon, K.J.; Kwon, D.E.; Park, T.H.; Kwon, Y.J.; Shao, X.; Hwang, C.S. Pt/Ta2O5/HfO2-x/Ti Resistive Switching Memory Competing with Multilevel NAND Flash. Adv. Mater. 2015, 27, 3811–3816. [Google Scholar] [CrossRef]
- Han, J.H.; Kim, H.Y.; Lee, S.C.; Kim, D.H.; Park, B.K.; Park, J.S.; Jeon, D.J.; Chung, T.M.; Kim, C.G. Growth of tantalum nitride film as a Cu diffusion barrier by plasma-enhanced atomic layer deposition from bis((2-(dimethylamino)ethyl)(methyl)amido)methyl(tert-butylimido)tantalum complex. Appl. Surf. Sci. 2016, 362, 176–181. [Google Scholar] [CrossRef]
- Kim, H.; Lavoie, C.; Copel, M.; Narayanan, V.; Park, D.G.; Rossnagel, S.M. The physical properties of cubic plasma-enhanced atomic layer deposition TaN films. J. Appl. Phys. 2004, 95, 5848–5855. [Google Scholar] [CrossRef]
- Kim, H.; Cabral, C.; Lavoie, C.; Rossnagel, S.M. The Growth of Tantalum Thin Films by Plasma-Enhanced. Mater. Res. 2002, 716, B8.5. [Google Scholar]
- Kim, H.; Kellock, A.J.; Rossnagel, S.M. Growth of cubic-TaN thin films by plasma-enhanced atomic layer deposition. J. Appl. Phys. 2002, 92, 7080–7085. [Google Scholar] [CrossRef]
- Chang, C.-C.; Pan, F.-M.; Chen, C.-W. Effect of Surface Reduction Treatments of Plasma-Enhanced Atomic Layer Chemical Vapor Deposited TaNx on Adhesion with Copper. J. Electrochem. Soc. 2010, 157, G62. [Google Scholar] [CrossRef]
- Kim, H.; Rossnagel, S.M. Plasma-enhanced atomic layer deposition of tantalum thin films: The growth and film properties. Thin Solid Films 2003, 441, 311–316. [Google Scholar] [CrossRef]
- Kim, H.; Cabral, C.; Lavoie, C.; Rossnagel, S.M. Diffusion barrier properties of transition metal thin films grown by plasma-enhanced atomic-layer deposition. J. Vac. Sci. Technol. B Microelectron. Nanom. Struct. 2002, 20, 1321. [Google Scholar] [CrossRef]
- Fujiwara, H. Spectroscopic Ellipsometry: Principles and Applications; John Wiley & Sons: Hoboken, NJ, USA, 2007; pp. 1–369. [Google Scholar] [CrossRef]
- Järrendahl, K.; Arwin, H. Multiple sample analysis of spectroscopic ellipsometry data of semi-transparent films. Thin Solid Films 1998, 313–314, 114–118. [Google Scholar] [CrossRef]
- Damart, T.; Coillet, E.; Tanguy, A.; Rodney, D. Numerical study of the structural and vibrational properties of amorphous Ta2O5 and TiO2-doped Ta2O5. J. Appl. Phys. 2016, 119, 175106. [Google Scholar] [CrossRef]
- Reisman, A.; Holtzberg, F.; Berkenblit, M.; Berry, M. Reactions of the Group VB Pentoxides with Alkali Oxides and Carbonates. III. Thermal and X-Ray Phase Diagrams of the System K2O or K2CO3 with Ta2O5. J. Am. Chem. Soc. 1956, 78, 4514–4520. [Google Scholar] [CrossRef]
- Manukumar, K.N.; Kishore, B.; Manjunath, K.; Nagaraju, G. Mesoporous Ta2O5 nanoparticles as an anode material for lithium ion battery and an efficient photocatalyst for hydrogen evolution. Int. J. Hydrogen Energy 2018, 43, 18125–18135. [Google Scholar] [CrossRef]
- Koshtyal, Y.; Nazarov, D.; Ezhov, I.; Mitrofanov, I.; Kim, A.; Rymyantsev, A.; Lyutakov, O.; Popovich, A.; Maximov, M. Atomic layer deposition of nio to produce active material for thin-film lithium-ion batteries. Coatings 2019, 9, 301. [Google Scholar] [CrossRef]
- Jamil, S.; Yu, R.; Wang, Q.; Fasehullah, M.; Huang, Y.; Yang, Z.; Yang, X.; Wang, X. Enhanced cycling stability of nickel-rich layered oxide by tantalum doping. J. Power Sources 2020, 473, 228597. [Google Scholar] [CrossRef]
- Li, X.; Liu, J.; Banis, M.N.; Lushington, A.; Li, R.; Cai, M.; Sun, X. Atomic layer deposition of solid-state electrolyte coated cathode materials with superior high-voltage cycling behavior for lithium ion battery application. Energy Environ. Sci. 2014, 7, 768–778. [Google Scholar] [CrossRef]


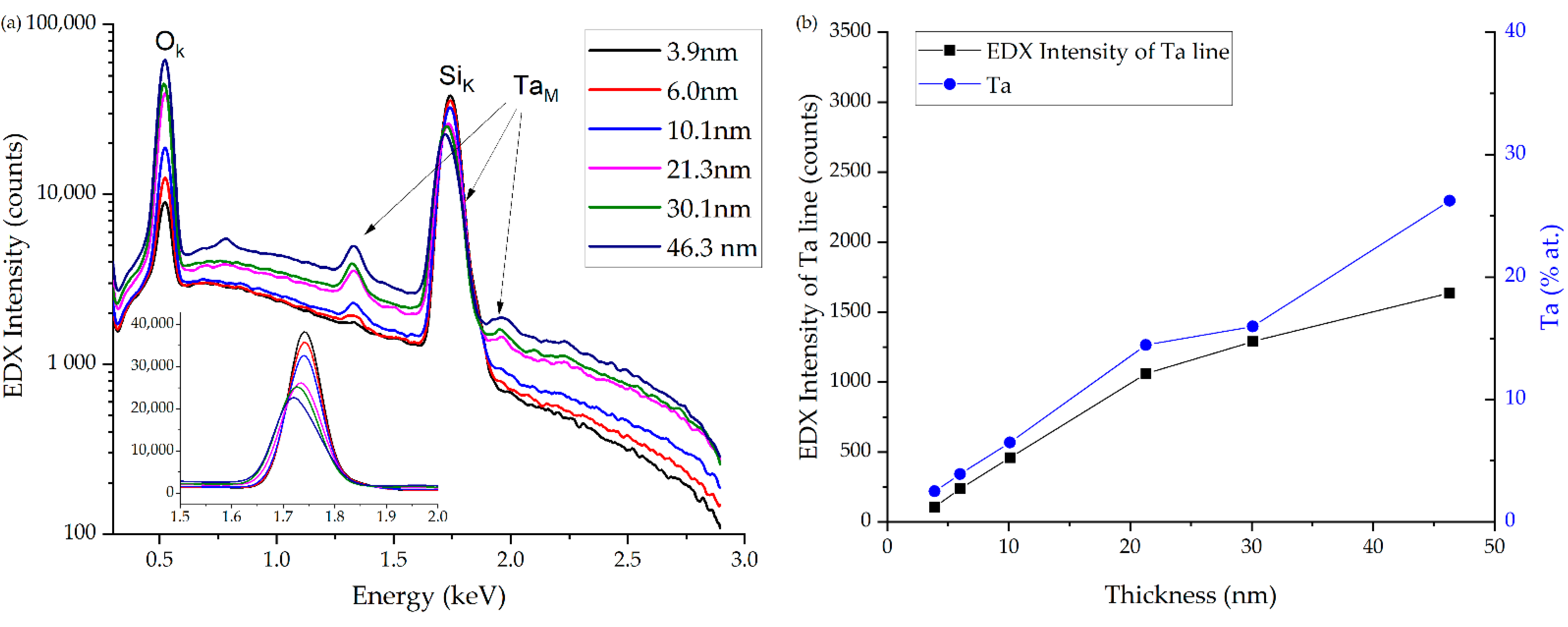
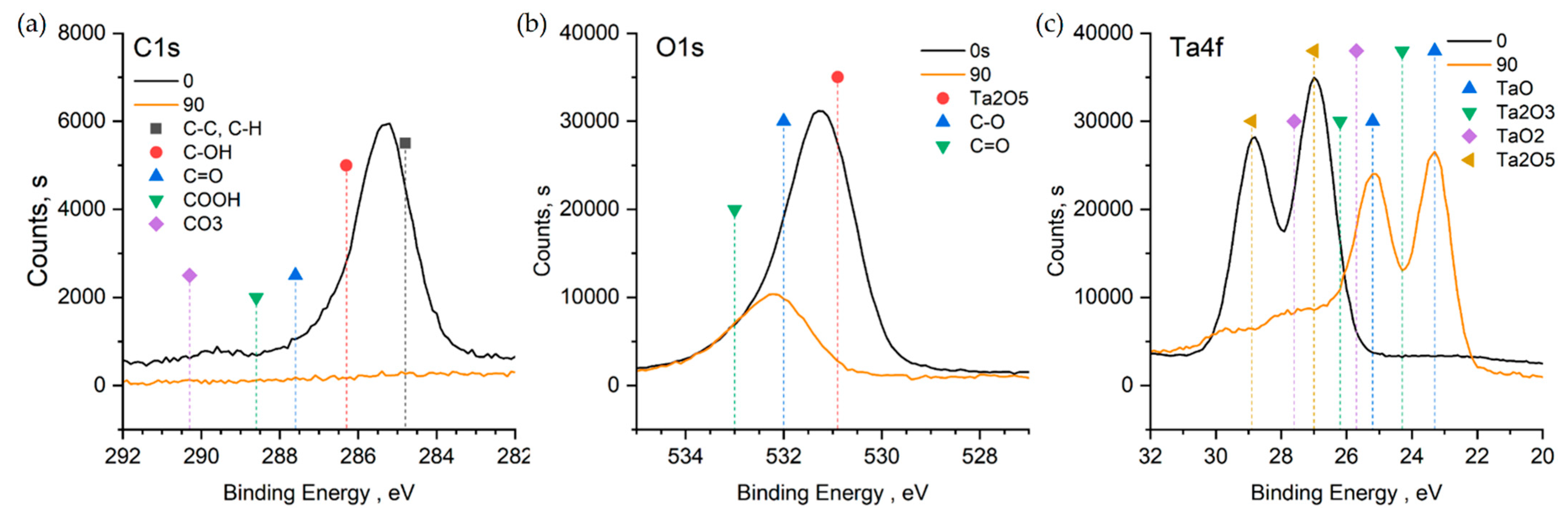



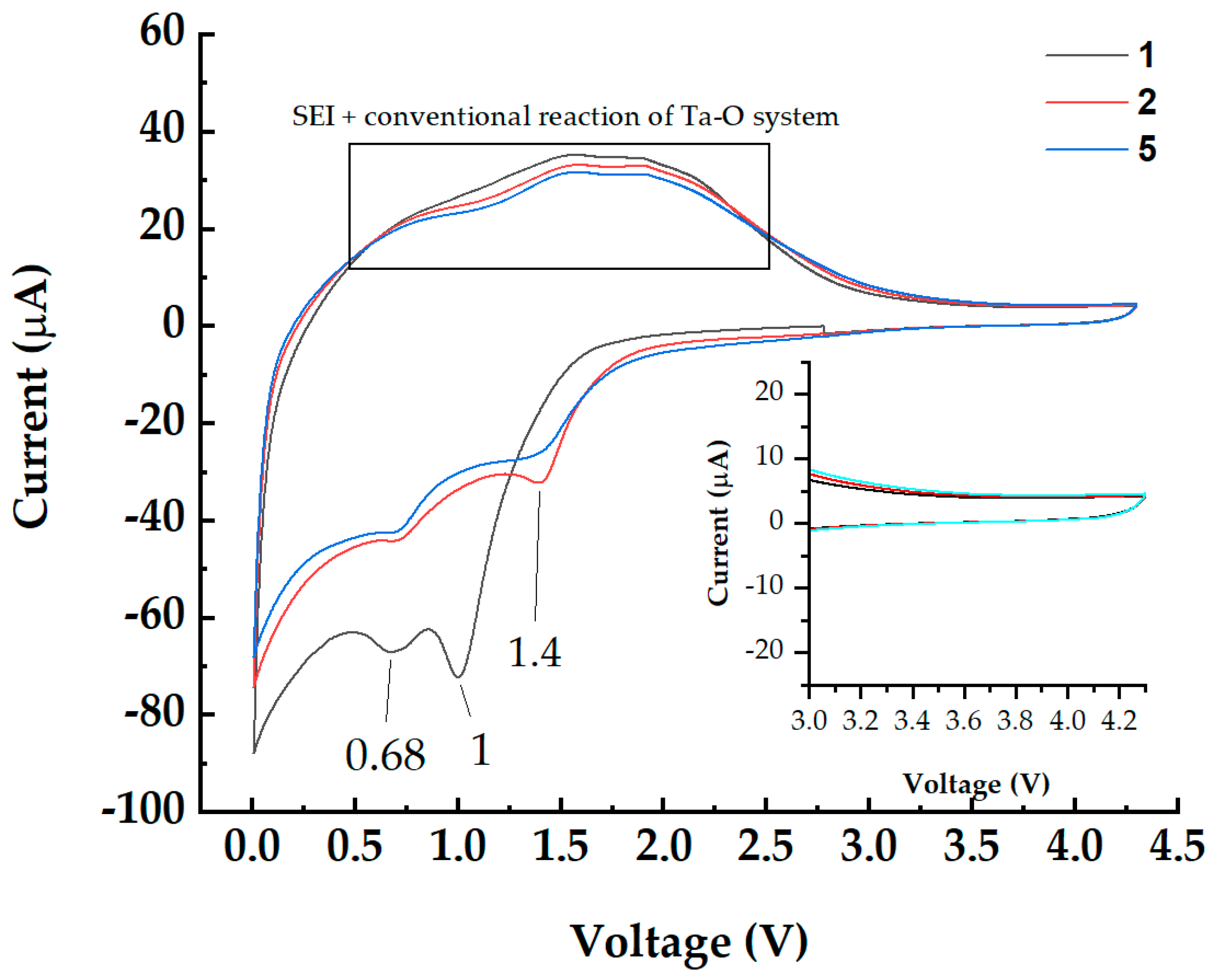
| Precursor A CAS No | Precursor B | Reagent Temperature °C | Reactor Temperature °C | Substrate | Growth Per Cycle (GPC) nm/cycle | Chemical Compound | Ref. |
|---|---|---|---|---|---|---|---|
| Ta(OEt)5 6074-84-6 | O2 plasma | 110 | 220 | Si, TiN | 0.09 | Ta2O5 | [7] |
| O2 plasma | - | 260 | Si | 0.075 | Ta2O5 | [8] | |
| H2O2 | 185 | 300 | Si | 0.049 | Ta2O5 | [1] | |
| H2O | 70 | 200–350 | Si | 0.040 ± 0.001 | Ta2O5 | [9] | |
| H2O | 190 | 225 | Si | 0.05 | Ta2O5 | [10] | |
| O2 plasma, H2O | - | 300 | SiO2, Si | - | Ta2O5 | [11] | |
| H2O | - | 250 | SiO2, Si | - | Ta2O5 | [12] | |
| H2, H2O | - | 300 | Si, TiN | - | Ta2O5 | [13] | |
| H2 | - | 300 | Si | 0.052 | Ta2O5 | [14] | |
| H2O | - | 250 | Si | - | Ta2O5 | [15] | |
| O3 | 95 | 300 | SiO2 | 0.035 | Ta2O5 | [16] | |
| O3 | 160 | 100–400 | TiN/SiO2 | 0.095–0.113 | Ta2O5 | [17] | |
| TBTEMT Ta[N(CH3)(C2H5)]3[=NC(CH3)3] 511292-99-2 | H2O | 90 | 210 | Al2O3, SiO2 | 0.051 | Ta2O5 | [18] |
| H2, Ar:H2 | - | 150–350 | Si | - | TaN | [19] | |
| TaF5 7783-71-3 | H2, Ar plasma | 70 | 350 | - | 0.035 | TaN | [20] |
| Mixed H2 + Ar + N2 | 70 | 350 | SiO2, Si | 0.041 | TaN | [21] | |
| TBTMET, TBTDMT, Ta[N(CH3)2]3[=NC(CH3)3] 69039-11-8 | O2 plasma | 60 | 250 | Si | 0.01 | Ta2O5 | [22] |
| N2:H2, NH3, O2 | - | 300–400 | SiO2, Si | - | Ta2O5 | [23] | |
| O2 plasma | 55 | 300 | Si | 0.11 | Ta2O5 | [24] | |
| TBTDET, Ta[N(C2H5)2]3[=NC(CH3)3] 169896-41-7 | H2O | 100 | 150–350 | Si | 0.077 | Ta2O5 | [25] |
| TAIMATA 629654-53-1 | N2+H2 plasma | 60 | 230 | SiO2, Si(100) | 0.13 | TaN | [26] |
| Ar + H2 | - | 300 | SiO2, Si(100), HfO2 | - | TaC, TaN | [27] | |
| Ar+H2 | 70 | 350 | SiO2, Si | 0.09–0.1 | TaN | [28] | |
| H2 | 60 | 230 | SiO2, Si | 0.13 | TaN, TaC | [29] | |
| H2O | - | 200 | Si | - | TaN | [30] | |
| PDMAT, Ta[N(CH3)2]5 19824-59-0 | O2 plasma | 65 | 100–225 | Si(100) | 0.08–0.087 | Ta2O5 | [31] |
| (t-BuN)(Et2N)2CpTa 852212-55-6 | H2O | - | 200 | - | - | Ta2O5 | [32] |
| Ta(NtBu)Me(dmaema)2 | NH3 plasma | 100–120 | 200–250 | SiO2, Si | 0.062 | TaN | [33] |
| TaCl5 7721-01-9 | H2O | 90 | 250–450 | Si | 0.011–0.065 | Ta2O5 | [6] |
| H2:N2 | 90 | 300 | Si(001), SiO2 | 0.024 | TaN | [34] | |
| H2:N2 | - | 300 | Si | 0.008–0.01 | TaN | [35] | |
| H2:N2 | 100 | 100–400 | Si(001), SiO2 | 0.024 | TaN | [36] | |
| H2:N2 | 110 | 300 | SiO2 | - | TaN | [37] | |
| Atomic H | 100 | 25–300 | SiO2, Si | 0.008 | Ta | [38] | |
| Atomic H | 100–120 | 25–400 | Si | 0.016–0.16 | Ta | [2] | |
| Atomic H | 100 | 400 | Si(001), SiO2 | 0.008 | Ta | [39] |
| No | Reagent Temperature °C | Time Pulse/Purge, s | Reactor Temperature °C | Number of Cycles | GPC nm/cycle |
|---|---|---|---|---|---|
| Ta-O_1 | 70 | 1/5 | 300 | 500 | 0.0041 |
| Ta-O_2 | 90 | 1/5 | 300 | 500 | 0.0057 |
| Ta-O_3 | 110 | 1/5 | 300 | 500 | 0.0093 |
| Ta-O_4 | 160 | 1/5 | 300 | 500 | 0.0433 |
| Ta-O_5 | 190 | 1/5 | 300 | 500 | 0.0486 |
| Ta-O_6 | 190 | 1.5/5 | 300 | 1000 | 0.0463 |
| Ta-O_7 | 190 | 0.5/5 | 300 | 500 | 0.0426 |
| Ta-O_8 | 190 | 2/5 | 300 | 500 | 0.0464 |
| Ta-O_9 | 190 | 1/10 | 300 | 500 | 0.0439 |
| Ta-O_10 | 190 | 1/15 | 300 | 500 | 0.0472 |
| Ta-O_11 | 190 | 1.5/10 | 300 | 500 | 0.0501 |
| Ta-O_12 | 190 | 1/5 | 225 | 500 | 0.0547 |
| Ta-O_13 | 190 | 1/5 | 250 | 500 | 0.0502 |
| Ta-O_14 | 190 | 1/5 | 350 | 500 | 0.0467 |
| Ta-O_15 | 190 | 1/5 | 300 | 50 | 0.0780 |
| Ta-O_16 | 190 | 1/5 | 300 | 100 | 0.0600 |
| Ta-O_17 | 190 | 1/5 | 300 | 200 | 0.0505 |
| Spectra | Before Etching, at. % | After Etching, at. % |
|---|---|---|
| O1s | 52.46 | 48.89 |
| Ta4f | 20.64 | 51.11 |
| C1s | 26.90 | 0 |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Fedorov, P.; Nazarov, D.; Medvedev, O.; Koshtyal, Y.; Rumyantsev, A.; Tolmachev, V.; Popovich, A.; Maximov, M.Y. Plasma Enhanced Atomic Layer Deposition of Tantalum (V) Oxide. Coatings 2021, 11, 1206. https://doi.org/10.3390/coatings11101206
Fedorov P, Nazarov D, Medvedev O, Koshtyal Y, Rumyantsev A, Tolmachev V, Popovich A, Maximov MY. Plasma Enhanced Atomic Layer Deposition of Tantalum (V) Oxide. Coatings. 2021; 11(10):1206. https://doi.org/10.3390/coatings11101206
Chicago/Turabian StyleFedorov, Pavel, Denis Nazarov, Oleg Medvedev, Yury Koshtyal, Aleksander Rumyantsev, Vladimir Tolmachev, Anatoly Popovich, and Maxim Yu Maximov. 2021. "Plasma Enhanced Atomic Layer Deposition of Tantalum (V) Oxide" Coatings 11, no. 10: 1206. https://doi.org/10.3390/coatings11101206
APA StyleFedorov, P., Nazarov, D., Medvedev, O., Koshtyal, Y., Rumyantsev, A., Tolmachev, V., Popovich, A., & Maximov, M. Y. (2021). Plasma Enhanced Atomic Layer Deposition of Tantalum (V) Oxide. Coatings, 11(10), 1206. https://doi.org/10.3390/coatings11101206








