Vertical Etching of Scandium Aluminum Nitride Thin Films Using TMAH Solution
Abstract
1. Introduction
2. Experiment
2.1. Film Deposition
2.2. Film Deposition
2.3. Nickel Mask Preparation and Lift-Off
2.4. ICP Etching for Layer
2.5. High Temperature Annealing
2.6. TMAH Wet Etching
3. Results and Discussion
4. Conclusions
Supplementary Materials
Author Contributions
Funding
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Tadigadapa, S.A.K.M.; Mateti, K. Piezoelectric MEMS sensors: State-of-the-art and perspectives. Meas. Sci. Technol. 2009, 20, 092001. [Google Scholar] [CrossRef]
- Dubois, M.-A.; Muralt, P. Properties of aluminum nitride thin films for piezoelectric transducers and microwave filter applications. Appl. Phys. Lett. 1999, 74, 3032–3034. [Google Scholar] [CrossRef]
- Mariotti, G.; Vannozzi, L. Fabrication, Characterization, and Properties of Poly (Ethylene-Co-Vinyl Acetate) Composite Thin Films Doped with Piezoelectric Nanofillers. Nanomaterials 2019, 9, 1182. [Google Scholar] [CrossRef] [PubMed]
- Jin, C.; Hao, N.; Xu, Z.; Trase, I.; Nie, Y.; Dong, L.; Closson, A.; Chen, Z.; Zhang, J.X.J. Flexible piezoelectric nanogenerators using metal-doped ZnO-PVDF films. Sens. Actuators A Phys. 2020, 305, 111912. [Google Scholar] [CrossRef] [PubMed]
- Pillai, G.; Li, S.-S. Piezoelectric MEMS Resonators: A Review. IEEE Sens. J. 2020, 21, 12589–12605. [Google Scholar] [CrossRef]
- Reza, A.W.; Prasad, M. Piezoelectric MEMS based acoustic sensors: A review. Sens. Actuators A Phys. 2020, 301, 111756. [Google Scholar]
- Hirata, K.; Yamada, H.; Uehara, M.; Anggraini, S.A.; Akiyama, M. First-principles study of piezoelectric properties and bonding analysis in (Mg, X, Al) N solid solutions (X = Nb, Ti, Zr, Hf). ACS Omega 2019, 4, 15081–15086. [Google Scholar] [CrossRef]
- Manna, S.; Talley, K.R.; Gorai, P.; Mangum, J.; Zakutayev, A.; Brennecka, G.L.; Stevanović, V.; Ciobanu, C.V. Enhanced Piezoelectric Response of AlN via CrN Alloying. Phys. Rev. Appl. 2018, 9, 034026. [Google Scholar] [CrossRef]
- Zhu, S.; Zhong, Q.; Li, N.; Hu, T.; Dong, Y.; Xu, Z.; Zhou, Y.; Fu, Y.H.; Singh, N. Integrated ScAlN photonic circuits on silicon substrate. In Proceedings of the 2020 Conference on Lasers and Electro-Optics (CLEO), San Jose, CA, USA, 10–15 May 2020; pp. 1–2. [Google Scholar]
- Ghatge, M.; Felmetsger, V.; Tabrizian, R. High Waveguide-Based ScAlN-on-Si UHF and SHF Resonators. In Proceedings of the 2018 IEEE International Frequency Control Symposium (IFCS), Olympic Valley, CA, USA, 21–24 May 2018; pp. 1–4. [Google Scholar]
- Li, N.; Ho, C.P.; Zhu, S.; Fu, Y.H.; Zhu, Y.; Lee, L.Y.T. Aluminium nitride integrated photonics: A review. Nanophotonics 2021, 10, 2347–2387. [Google Scholar] [CrossRef]
- Takeuchi, N. First-principles calculations of the ground-state properties and stability of ScN. Phys. Rev. B 2002, 65, 045204. [Google Scholar] [CrossRef]
- Akiyama, M.; Kano, K.; Teshigahara, A. Influence of growth temperature and scandium concentration on piezoelectric response of scandium aluminum nitride alloy thin films. Appl. Phys. Lett. 2009, 95, 162107. [Google Scholar] [CrossRef]
- Akiyama, M.; Kamohara, T.; Kano, K.; Teshigahara, A.; Takeuchi, Y.; Kawahara, N. Enhancement of piezoelectric response in scandium aluminum nitride alloy thin films prepared by dual reactive co-sputtering. Adv. Mater. 2009, 21, 593–596. [Google Scholar] [CrossRef] [PubMed]
- Teshigahara, A.; Hashimoto, K.; Akiyama, M. Scandium aluminum nitride: Highly piezoelectric thin film for RF SAW devices in multi GHz range. In Proceedings of the 2012 IEEE International Ultrasonics Symposium, Dresden, Germany, 7–10 October 2012; pp. 1–5. [Google Scholar]
- Wingqvist, G.; Tasnadi, F.; Zukauskaite, A.; Birch, J.; Arwin, H.; Hultman, L. Increased electromechanical coupling in w−ScxAl1−xN. Appl. Phys. Lett. 2010, 97, 112902. [Google Scholar] [CrossRef]
- Hashimoto, K.Y.; Sato, S.; Teshigahara, A.; Nakamura, T.; Kano, K. High-performance surface acoustic wave resonators in the 1 to 3 GHz range using a ScAlN/6H-SiC structure. IEEE Trans. Ultrason. Ferroelectr. Freq. Control 2013, 60, 637–642. [Google Scholar] [CrossRef]
- Wang, Q.; Lu, Y.; Mishin, S.; Oshmyansky, Y.; Horsley, D.A. Design, Fabrication, and Characterization of Scandium Aluminum Nitride-Based Piezoelectric Micromachined Ultrasonic Transducers. J. Microelectromech. Syst. 2017, 26, 1132–1139. [Google Scholar] [CrossRef]
- Beaucejour, R.; Roebisch, V.; Kochhar, A.; Moe, C.G.; Hodge, M.D.; Olsson, R.H. Controlling Residual Stress and Suppression of Anomalous Grains in Aluminum Scandium Nitride Films Grown Directly on Silicon. J. Microelectromech. Syst. 2022, 31, 604–611. [Google Scholar] [CrossRef]
- Airola, K.; Mertin, S.; Likonen, J.; Hartikainen, E.; Mizohata, K.; Dekker, J.; Sebastian, A.T.; Pensala, T. High-fidelity patterning of AlN and ScAlN thin films with wet chemical etching. Materialia 2022, 22, 101403. [Google Scholar] [CrossRef]
- Tang, Z.; Esteves, G.; Zheng, J.; Olsson, R.H., III. Vertical and Lateral Etch Survey of Ferroelectric AlN/Al1−xScxN in Aqueous KOH Solutions. Micromachines 2022, 13, 1066. [Google Scholar] [CrossRef]
- Pinto, R.M.; Gund, V.; Calaza, C.; Nagaraja, K.; Vinayakumar, K. Piezoelectric aluminum nitride thin-films: A review of wet and dry etching techniques. Microelectron. Eng. 2022, 257, 111753. [Google Scholar] [CrossRef]
- Luo, Z.; Shao, S.; Wu, T. Optimization of AlN and AlScN Film ICP Etching. In Proceedings of the 2021 IEEE 34th International Conference on Micro Electro Mechanical Systems (MEMS), Gainesville, FL, USA, 25–29 January 2021; pp. 638–641. [Google Scholar]
- James, R.; Pilloux, Y.; Hegde, H. Reactive ion beam etching of piezoelectric ScAlN for bulk acoustic wave device applications. In Journal of Physics: Conference Series; IOP Publishing: Bristol, UK, 2019; Volume 1407, p. 012083. [Google Scholar]
- Hardy, M.T.; Downey, B.P.; Meyer, D.J.; Nepal, N.; Storm, D.F.; Katzer, D.S. Epitaxial ScAlN Etch-Stop Layers Grown by Molecular Beam Epitaxy for Selective Etching of AlN and GaN. IEEE Trans. Semicond. Manuf. 2017, 30, 475–479. [Google Scholar] [CrossRef]
- Shao, S.; Luo, Z.; Lu, Y.; Mazzalai, A.; Tosi, C.; Wu, T. High Quality Co-Sputtering AlScN Thin Films for Piezoelectric Lamb-Wave Resonators. J. Microelectromech. Syst. 2022, 31, 328–337. [Google Scholar] [CrossRef]
- Kusano, Y.; Ishii, I.; Kamiya, T.; Teshigahara, A.; Luo, G.-L.; Horsley, D.A. High-SPL Air-Coupled Piezoelectric Micromachined Ultrasonic Transducers Based on 36% ScAlN Thin-Film. IEEE Trans. Ultrason. Ferroelectr. Freq. Control 2019, 66, 1488–1496. [Google Scholar] [CrossRef] [PubMed]
- Fichtner, S.; Wolff, N.; Lofink, F.; Kienle, L.; Wagner, B. AlScN: A III-V semiconductor based ferroelectric. J. Appl. Phys. 2019, 125, 114103. [Google Scholar] [CrossRef]
- Ababneh, A.; Kreher, H.; Schmid, U. Etching behaviour of sputter-deposited aluminium nitride thin films in and KOH solutions. Microsyst. Technol. 2008, 14, 567–573. [Google Scholar] [CrossRef]
- Cimalla, I.; Foerster, C.; Lebedev, V.; Cengher, D.; Ambacher, O. Wet chemical etching of AlN in KOH solution. Phys. Status Solidi C 2006, 3, 1767–1770. [Google Scholar] [CrossRef]
- Esteves, G.; Bischoff, J.; Schmidt, E.W.; Rodriguez, M.A.; Rosenberg, S.G.; Kotula, P.G. Formation of Al3Sc in Al0.8Sc0.2 thin films. Vacuum 2022, 200, 111024. [Google Scholar] [CrossRef]
- Aryal, A.; Stricklin, I.; Behzadirad, M.; Branch, D.W.; Siddiqui, A.; Busani, T. High-Quality Dry Etching of LiNbO3 Assisted by Proton Substitution through H2-Plasma Surface Treatment. Nanomaterials 2022, 12, 2836. [Google Scholar] [CrossRef]
- Koh, K.S.; Chin, J.; Chia, J.; Chiang, C.L. Quantitative studies on PDMS-PDMS interface bonding with piranha solution and its swelling effect. Micromachines 2012, 3, 427–441. [Google Scholar] [CrossRef]
- Sun, P.; Liu, G.; Lv, D.; Dong, X.; Wu, J.; Wang, D. Effective activation of halloysite nanotubes by piranha solution for amine modification via silane coupling chemistry. RSC Adv. 2015, 5, 52916–52925. [Google Scholar] [CrossRef]
- Liu, C.; Li, M.; Chen, B.; Zhang, Y.; Zhu, Y.; Wang, N. Evaluation of the Impact of Abnormal Grains on the Performance of Sc0.15Al0.85N-based BAW resonators and filters. J. Micromech. Microeng. 2022, 32, 034002. [Google Scholar] [CrossRef]
- Chen, P.-H.; Wu, S.; Chen, Y.-C.; Huang, J.-L.; Lii, D.-F.; Lin, Z.-X. Microstructure and piezoelectric properties of c-axis ScAlN films on the Y-128° LiNbO3 substrate. Surf. Coat. Technol. 2015, 284, 129–132. [Google Scholar] [CrossRef]
- Marta, C.; Olivares, V.F.J.; Mirea, T.; Olivares, J.; Iborra, E. Effects of post-deposition vacuum annealing on the piezoelectric properties of AlScN thin films sputtered on 200 mm production wafers. In Proceedings of the 2018 IEEE International Ultrasonics Symposium (IUS), Kobe, Japan, 22–25 October 2018; pp. 1–4. [Google Scholar]
- Li, M.; Chen, B.; Xie, J.; Song, W.; Zhu, Y. Effects of post-annealing on texture evolution of sputtered ScAlN films. In Proceedings of the 2020 IEEE International Ultrasonics Symposium (IUS), Las Vegas, NV, USA, 7–11 September 2020; pp. 1–3. [Google Scholar]
- Fichtner, S.; Reimer, T.; Chemnitz, S.; Lofink, F.; Wagner, B. Stress controlled pulsed direct current co-sputtered Al1−xScxN as piezoelectric phase for micromechanical sensor applications. APL Mater. 2015, 3, 116102. [Google Scholar] [CrossRef]
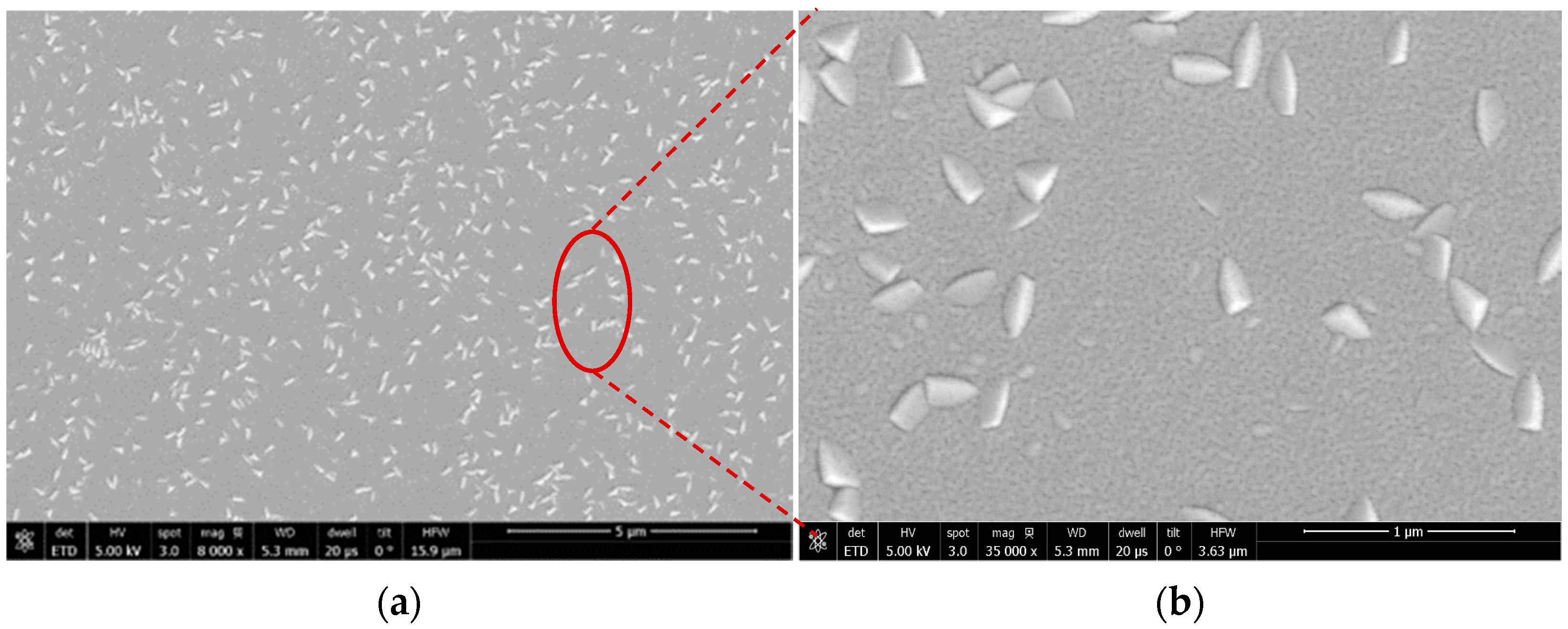
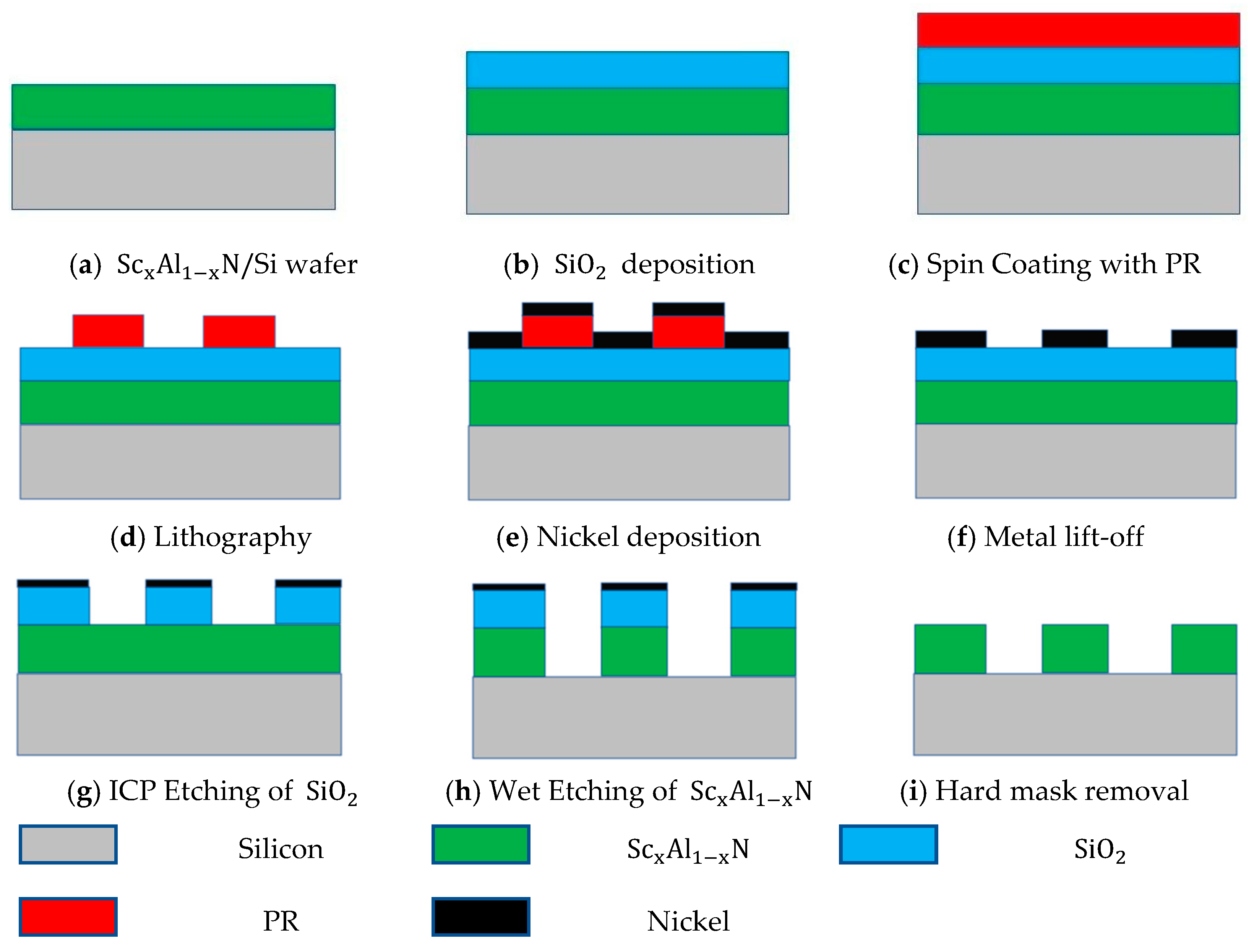
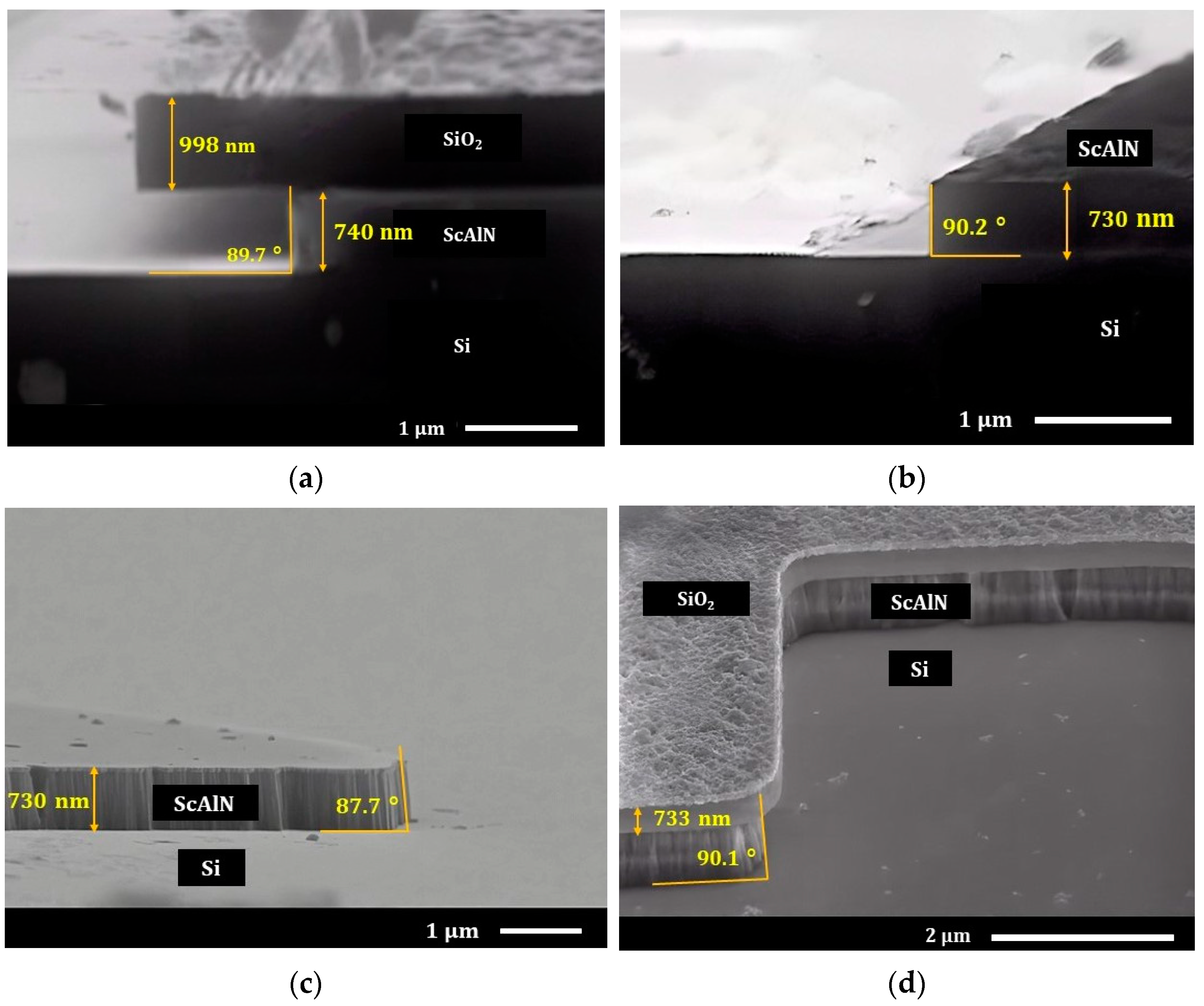
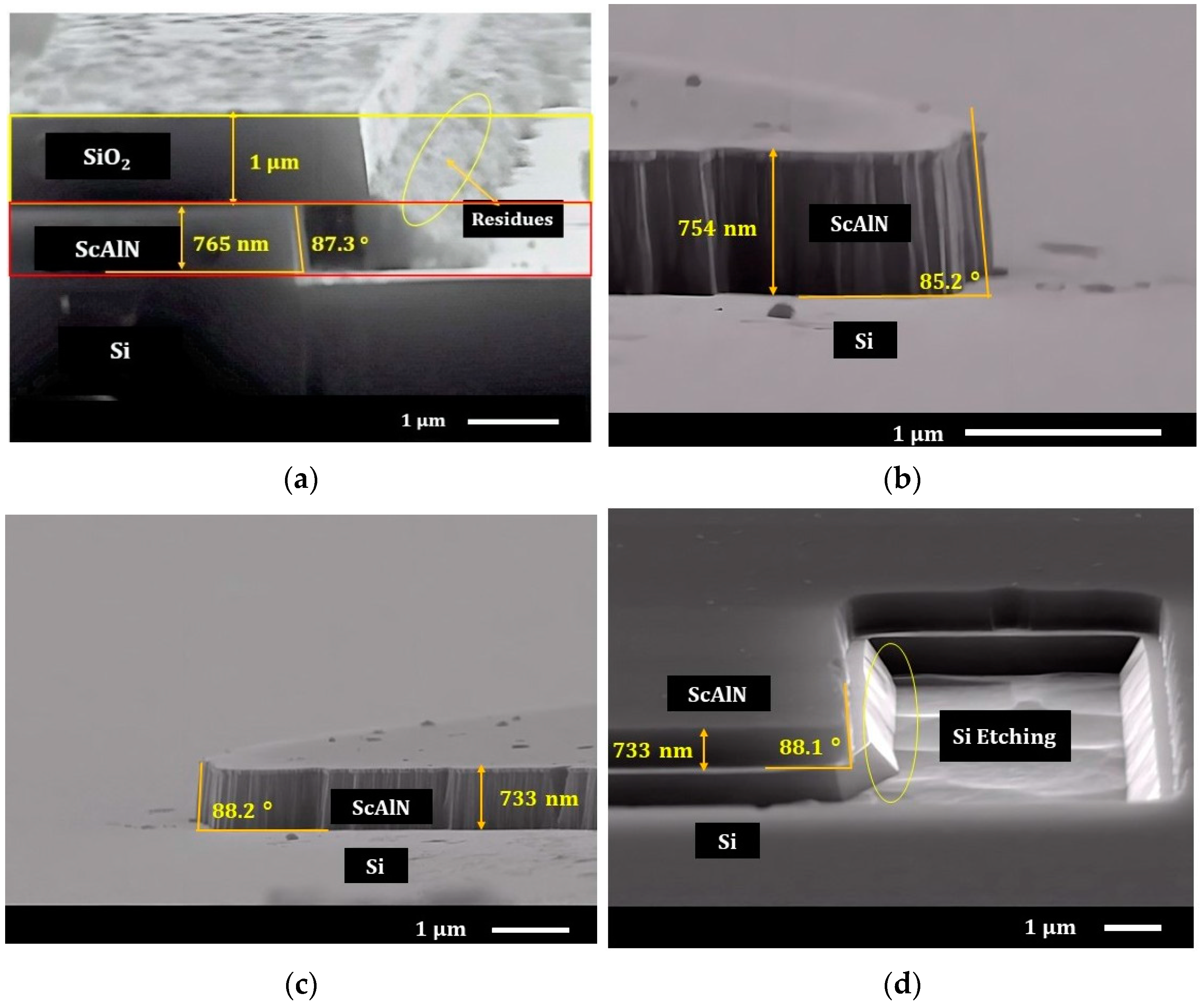
| Ref. | Material | Etch Process | Etchant Flow (sccm) | ICP/RIE Power (W) | RF Power/Voltage | Pressure (m Torr) | Etch Rate (nm/min) | Mask Used | Sidewall Profile (°) |
|---|---|---|---|---|---|---|---|---|---|
| [23] | ICP | // (15/30/5) | 550 | 80 W | 3.8 | <230 | PR | >77 | |
| [24] | IBE | Ar 100% | 715 V (Beam), 485 mA (Beam) | 17 | PR | 79 | |||
| RIBE | Ar/RG (60%/40%) | 19 | 76 | ||||||
| IBE | Ar 100% | 900 V (Beam), 600 mA (Beam) | 24 | 71 | |||||
| RIBE | Ar/RG (75%/25%) | 36 | 73 | ||||||
| [18] | RIE | (90/30/100) | 550 | 150 W | - | 160 | PR | - | |
| [25] | x = 0.2~0.16 | ICP | Ar (20/10/10) | 200 | 50 W/(30~70) W | - | 3.4 | - | - |
| [26] | ICP | (25/30/20) | 550 | 350 W | 37 | 130 | 77 | ||
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Shifat, A.S.M.Z.; Stricklin, I.; Chityala, R.K.; Aryal, A.; Esteves, G.; Siddiqui, A.; Busani, T. Vertical Etching of Scandium Aluminum Nitride Thin Films Using TMAH Solution. Nanomaterials 2023, 13, 274. https://doi.org/10.3390/nano13020274
Shifat ASMZ, Stricklin I, Chityala RK, Aryal A, Esteves G, Siddiqui A, Busani T. Vertical Etching of Scandium Aluminum Nitride Thin Films Using TMAH Solution. Nanomaterials. 2023; 13(2):274. https://doi.org/10.3390/nano13020274
Chicago/Turabian StyleShifat, A. S. M. Zadid, Isaac Stricklin, Ravi Kiran Chityala, Arjun Aryal, Giovanni Esteves, Aleem Siddiqui, and Tito Busani. 2023. "Vertical Etching of Scandium Aluminum Nitride Thin Films Using TMAH Solution" Nanomaterials 13, no. 2: 274. https://doi.org/10.3390/nano13020274
APA StyleShifat, A. S. M. Z., Stricklin, I., Chityala, R. K., Aryal, A., Esteves, G., Siddiqui, A., & Busani, T. (2023). Vertical Etching of Scandium Aluminum Nitride Thin Films Using TMAH Solution. Nanomaterials, 13(2), 274. https://doi.org/10.3390/nano13020274






