Imaging the Permittivity of Thin Film Materials by Using Scanning Capacitance Microscopy
Abstract
1. Introduction
2. Materials and Methods
2.1. Principles
2.2. Methods
3. Results
4. Discussion
- (1)
- With relative density (ρ) ~76.8% of MoO3 dielectric ceramics, the relative permittivity (εr) was ~8.31 [19]. The relative permittivity (εr) of 4.50 M NaCl solution was 32.2 [20]. In the present paper, MoO3 film-doped NaCl was treated with NaCl solution. The average value of εr of MoO3 film was about 8.0, and that of MoO3 film-doped NaCl was about 9.5. The experimental result of MoO3 were quantitatively consistent with other experimental results of the same material, the permittivity (εr) of MoO3-doped NaCl is significantly different from that of the undoped MoO3.
- (2)
- The packaging specification of the probe is tip radius R ≤ 10 nm and cone half angle θ ≤ 22°. The capacitance gradient vs. setting height z between the tip and the metal ground was measured. Fitted with Equation (17), the tip radius R = 16.6 nm and cone half angle θ = 20° were obtained. Since the probe was used for some time and may be blunt, the tip radius R =16.6 nm, and cone half angle θ = 20° were reasonable.
- (3)
- Similar to the chemical intercalation method [21], partial MoO3 film was treated with NaCl solution. There may be Na intercalation in MoO3-film doped NaCl. That was why the thickness and signal of SCM of MoO3 film was slightly weaker than that of MoO3 film-doped NaCl.
- (4)
- From the topography image of the film, the rise and fall of every point was regarded as the thickness change . The thickness of the film at every point was set as . The value of was obtained from the rise of 70 nm, which corresponded to the change from monocrystalline Si substrate to MoO3 film. In the topography image of the film, the rise and fall of every point was relative to the previous point, not relative to 70nm. The value of thickness was an approximate one.
- (5)
- The monocrystalline silicon substrate was partly coated with MoO3 film. A point of Si substrate area was chosen. Its measured capacitance gradient vs. setting height z between the tip, and the Si ground was just used to determine the constant , since Equation (17) was for metal ground.
- (6)
- There was no film on the area of Si substrate in Figure 3a. The results of h and εr of Si substrate area should be ignored.
5. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Binnig, G.; Rohrer, H.; Gerber, C.; Weibel, E. Tunneling through a Controllable Vacuum Gap. Appl. Phys. Lett. 1982, 40, 178–180. [Google Scholar] [CrossRef]
- Falco, G.D.; Carbone, F.; Commodo, M.; Minutolo, P.; D’Anna, A. Exploring Nanomechanical Properties of Soot Particle Layers by Atomic Force Microscopy Nanoindentation. Appl. Sci. 2021, 11, 8448. [Google Scholar] [CrossRef]
- Wang, Y.Y.; Wu, C.J.; Tang, J.Y.; Duan, M.Y.; Chen, J.; Ju, B.-F.; Chen, Y.-L. Measurement of Sub-Surface Microstructures Based on a Developed Ultrasonic Atomic Force Microscopy. Appl. Sci. 2022, 12, 5460. [Google Scholar] [CrossRef]
- Matey, J.R.; Blance, J. Scanning capacitance microscopy. J. Appl. Phys. 1985, 57, 1437–1444. [Google Scholar] [CrossRef]
- Matey, J.R. Scanning Capacitance Microscope. U.S. Patent 4,481,616, 6 November 1984. [Google Scholar]
- Kopanski, J.J.; Mayo, S. Intermittent-contact scanning capacitance microscope for lithographic overlay measurement. Appl. Phys. Lett. 1998, 72, 2469–2471. [Google Scholar] [CrossRef]
- Fumagalli, L.; Ferrari, G.; Sampietro, M.; Gomila, G. Dielectric-constant measurement of thin insulating films at low frequency by nanoscale capacitance microscopy. Appl. Phys. Lett. 2007, 91, 243110. [Google Scholar] [CrossRef]
- Bussmann, E.; Rudolph, M.; Subramania, G.S.; Misra, S.; Carr, S.M.; Langlois, E.; Dominguez, J.; Pluym, T.; Lilly, M.P.; Carroll, M.S. Scanning capacitance microscopy registration of buried atomic-precision donor devices. Nanotechnology 2015, 26, 085701. [Google Scholar] [CrossRef]
- Xu, J.; Li, J.Z.; Li, W. Calculating electrostatic interactions in atomic force microscopy with semiconductor samples. AIP Adv. 2019, 9, 105308. [Google Scholar] [CrossRef]
- Gramse, G.; Gomila, G.; Fumagalli, L. Quantifying the dielectric constant of thick insulators by electrostatic force microscopy: Effects of the microscopic parts of the probe. Nanotechnology 2012, 23, 205703. [Google Scholar] [CrossRef]
- Gomila, G.; Toset, J.; Fumagalli, L. Nanoscale capacitance microscopy of thin dielectric films. J. Appl. Phys. 2008, 104, 024315. [Google Scholar] [CrossRef]
- Fumagalli, L.; Gramse, G.; Esteban-Ferrer, D.; Edwards, M.A.; Gomila, G. Quantifying the dielectric constant of thick insulators using electrostatic force microscopy. Appl. Phys. Lett. 2010, 96, 183107. [Google Scholar] [CrossRef]
- Mahariq, I.; Kurt, H. On- and off-optical-resonance dynamics of dielectric microcylinders under plane wave illumination. J. Opt. Soc. Am. B 2015, 32, 1022–1030. [Google Scholar] [CrossRef]
- García, R.; Pérez, R. Dynamic atomic force microscopy methods. Surf. Sci. Rep. 2002, 47, 197–301. [Google Scholar] [CrossRef]
- Sadewasser, S.; Glatzel, T. Kelvin Probe Force Microscopy-From Single Charge Detection to Device Characterization. In Springer Series in Surface Sciences; Springer: Berlin/Heidelberg, Germany, 2018; Volume 65. [Google Scholar]
- Lee, D.T.; Pelz, J.P.; Bhushan, B. Instrumentation for direct, low frequency scanning capacitance microscopy, and analysis of position dependent stray capacitance. Rev. Sci. Instrum. 2002, 73, 3525–3533. [Google Scholar] [CrossRef]
- Fumagalli, L.; Ferrari, G.; Sampietro, M.; Casuso, I.; Martinez, E.; Samitier, J.; Gomila, G. Nanoscale capacitance imaging with attofarad resolution using ac current sensing atomic force microscopy. Nanotechnology 2006, 17, 4581–4587. [Google Scholar] [CrossRef] [PubMed]
- Hudlet, S.; Saint Jean, M.; Guthmann, C.; Berger, J. Evaluation of the capacitive force between an atomic force microscopy tip and a metallic surface. Eur. Phys. J. B 1998, 2, 5–10. [Google Scholar] [CrossRef]
- Zhou, D.; Pang, L.-X.; Wang, D.-W.; Reaney, I.M. Novel water-assisting low firing MoO3 microwave dielectric ceramics. J. Eur. Ceram. Soc. 2019, 39, 2374–2378. [Google Scholar] [CrossRef]
- Chandra, A. Static dielectric constant of aqueous electrolyte solutions: Is there any dynamic contribution? J. Chem. Phys. 2000, 113, 903–905. [Google Scholar] [CrossRef]
- Voiry, D.; Yamaguchi, H.; Li, J.; Silva, R.; Alves, D.C.; Fujita, T.; Chen, M.; Asefa, T.; Shenoy, V.B.; Eda, G.; et al. Enhanced catalytic activity in strained chemically exfoliated WS2 nanosheets for hydrogen evolution. Nat. Mater. 2013, 12, 850–855. [Google Scholar] [CrossRef]

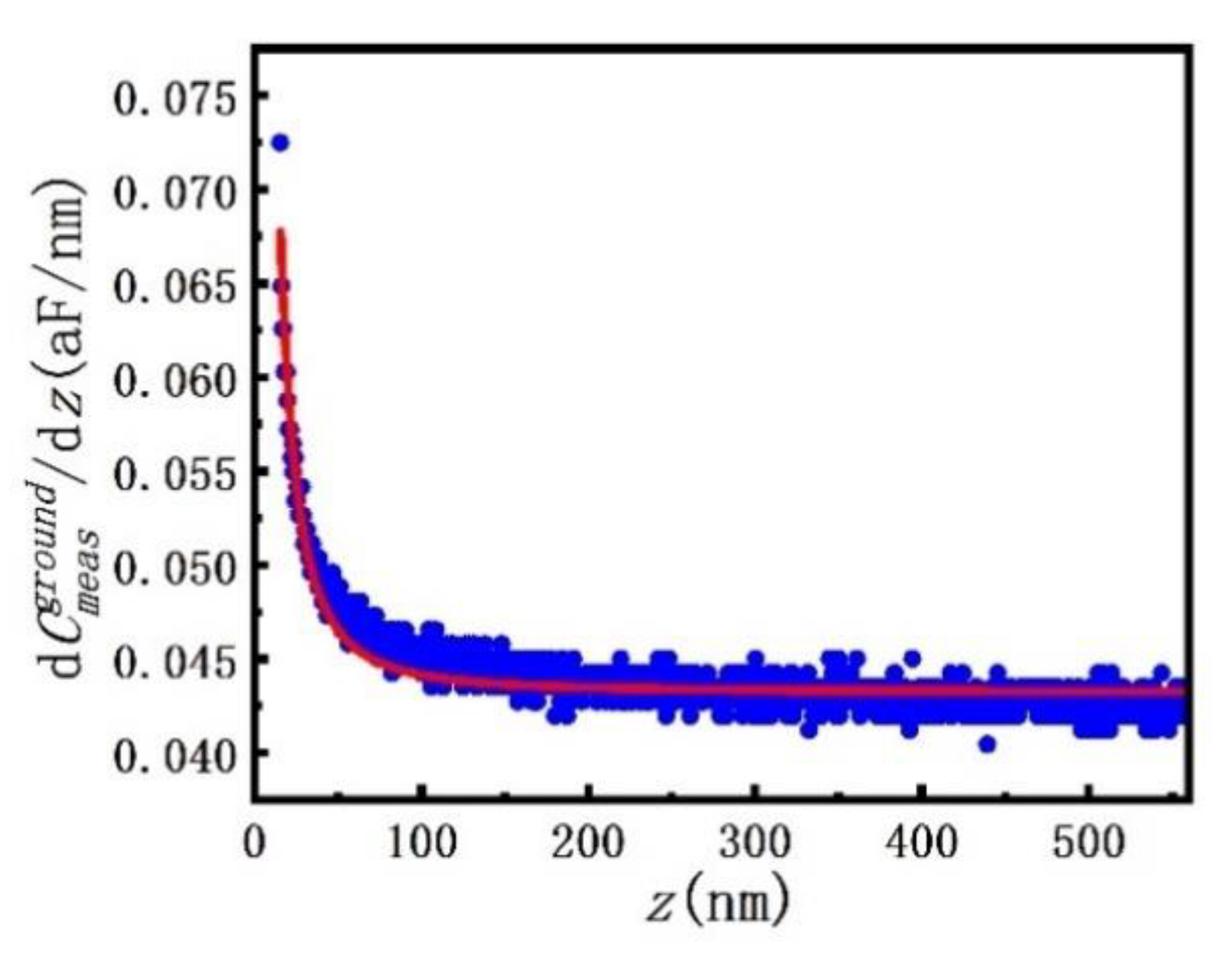



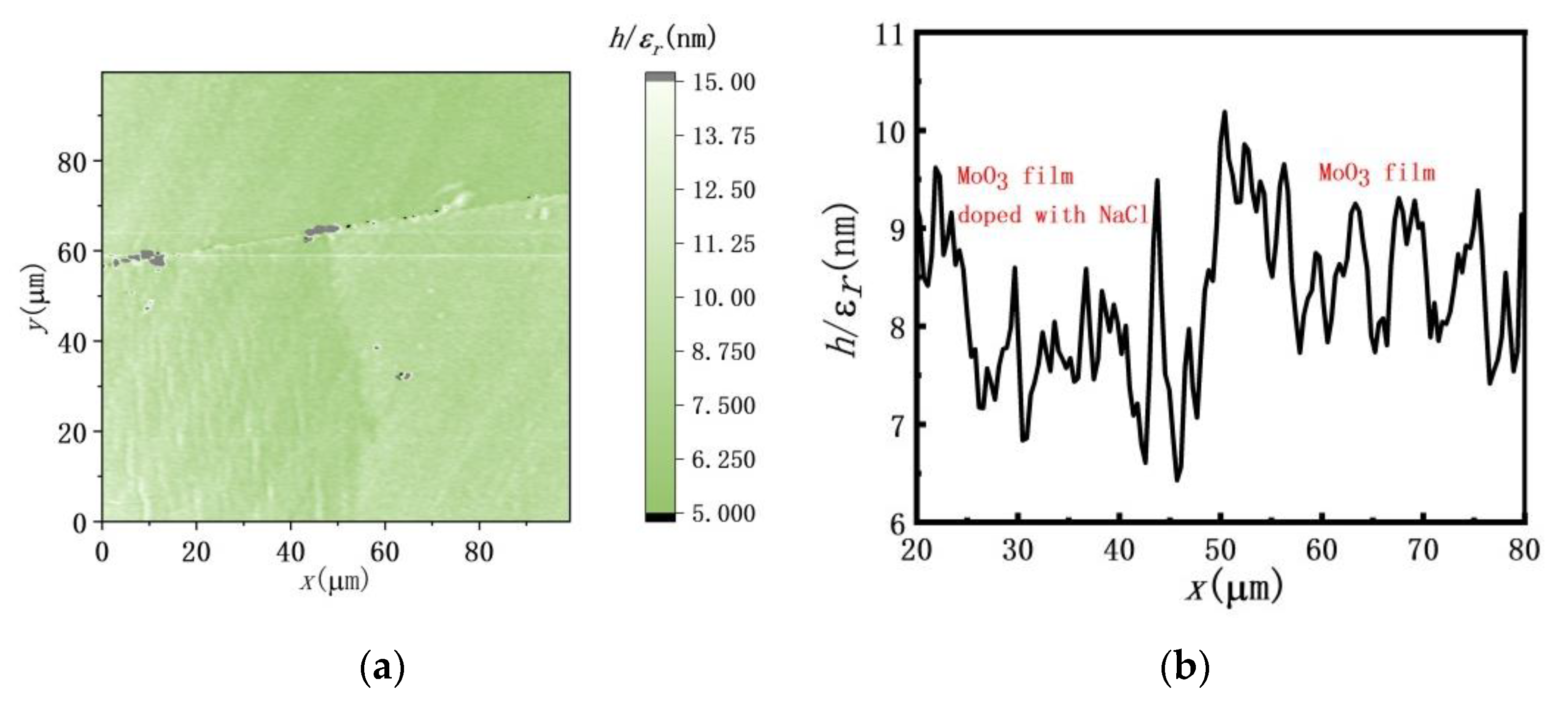
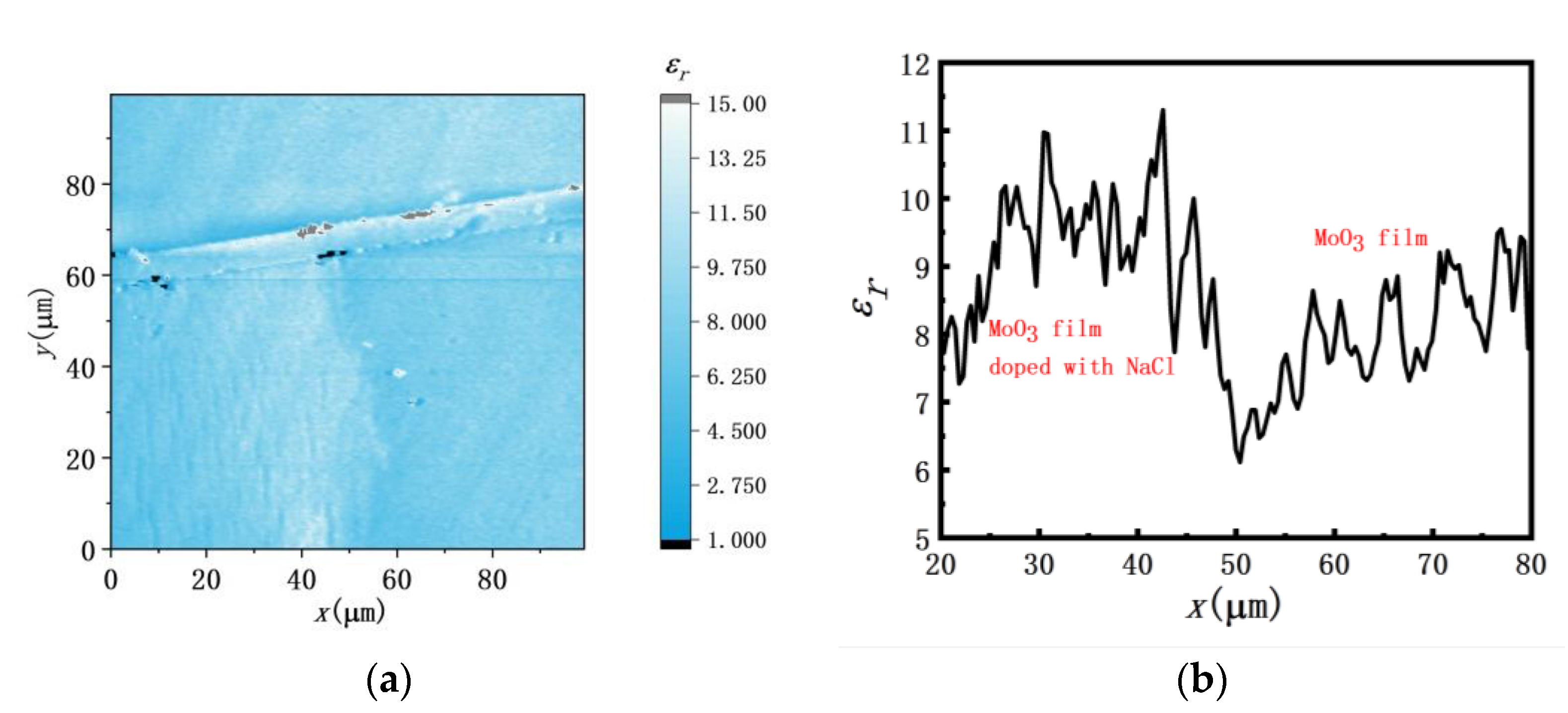
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2022 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Luo, Y.; Ding, X.; Chen, T.; Lin, G.; Su, T.; Chen, D. Imaging the Permittivity of Thin Film Materials by Using Scanning Capacitance Microscopy. Appl. Sci. 2022, 12, 11979. https://doi.org/10.3390/app122311979
Luo Y, Ding X, Chen T, Lin G, Su T, Chen D. Imaging the Permittivity of Thin Film Materials by Using Scanning Capacitance Microscopy. Applied Sciences. 2022; 12(23):11979. https://doi.org/10.3390/app122311979
Chicago/Turabian StyleLuo, Yongzhen, Xidong Ding, Tianci Chen, Guocong Lin, Tao Su, and Dihu Chen. 2022. "Imaging the Permittivity of Thin Film Materials by Using Scanning Capacitance Microscopy" Applied Sciences 12, no. 23: 11979. https://doi.org/10.3390/app122311979
APA StyleLuo, Y., Ding, X., Chen, T., Lin, G., Su, T., & Chen, D. (2022). Imaging the Permittivity of Thin Film Materials by Using Scanning Capacitance Microscopy. Applied Sciences, 12(23), 11979. https://doi.org/10.3390/app122311979






