Interface Material Modification to Enhance the Performance of a Thin-Film Piezoelectric-on-Silicon (TPoS) MEMS Resonator by Localized Annealing Through Joule Heating
Abstract
1. Introduction
2. Fabrication and Operation
2.1. Piezoelectric ZnO-on-Si Resonator Microfabrication Process Flow
2.2. Device Operation and Simulation Model
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Data Availability Statement
Conflicts of Interest
References
- Tang, K.-W.; Cheng, P.-C.; Trivedi, S.; Li, S.-S. Design and Characterization of an ALN Piezoelectric Mems Magnetometer. In Proceedings of the 2021 21st International Conference on Solid-State Sensors, Actuators and Microsystems (Transducers), Orlando, FL, USA, 20–24 June 2021; pp. 414–417. [Google Scholar]
- Ando, Y.; Shiina, Y. Investigating the effect of interatomic distance on friction force through MEMS-AFM based experiment. Appl. Surf. Sci. 2023, 637, 157991. [Google Scholar] [CrossRef]
- Liu, H.; Lee, C.; Kobayashi, T.; Tay, C.J.; Quan, C. Piezoelectric MEMS-based wideband energy harvesting systems using a frequency-up-conversion cantilever stopper. Sens. Actuators A Phys. 2012, 186, 242–248. [Google Scholar] [CrossRef]
- Gopalan, A.; Kommuri, U.K. Design and development of miniaturized low voltage triangular RF MEMS switch for phased array application. Appl. Surf. Sci. 2018, 449, 340–345. [Google Scholar] [CrossRef]
- Wang, J.; Ren, Z.; Nguyen, C.T.-C. 1.156-GHz self-aligned vibrating micromechanical disk resonator. IEEE Trans. Ultrason. Ferroelectr. Freq. Control 2004, 51, 1607–1628. [Google Scholar] [CrossRef]
- Zaman, A.; Alsolami, A.; Rivera, I.F.; Wang, J. Thin-Piezo on Single-Crystal Silicon Reactive Etched RF MEMS Resonators. IEEE Access 2020, 8, 139266–139273. [Google Scholar] [CrossRef]
- Ghaffari, S.; Ng, E.J.; Ahn, C.H.; Yang, Y.; Wang, S.; Hong, V.A.; Kenny, T.W. Accurate Modeling of Quality Factor Behavior of Complex Silicon MEMS Resonators. J. Microelectromech. Syst. 2015, 24, 276–288. [Google Scholar] [CrossRef]
- Huang, L.; Feng, Z.; Xiao, Y.; Sun, F.; Xu, J. High-Q and Low-Motional Impedance Piezoelectric mems Resonator through Mechanical Mode Coupling. In Proceedings of the IEEE 36th International Conference on Micro Electro Mechanical Systems (MEMS), Munich, Germany, 15–19 January 2023. [Google Scholar]
- Inomata, N.; Tonsho, Y.; Ono, T. Quality factor control of mechanical resonators using variable phononic bandgap on periodic microstructures. Sci. Rep. 2022, 12, 392. [Google Scholar] [CrossRef]
- Li, L.; Zhu, C.; Liu, H.; Li, Y.; Wang, Q.; Su, K. Quality Factor Enhancement of Piezoelectric MEMS Resonator Using a Small Cross-Section Connection Phononic Crystal. Sensors 2022, 22, 7751. [Google Scholar] [CrossRef]
- Demirci, M.U.; Nguyen, C.T.-C. Mechanically Corner-Coupled Square Microresonator Array for Reduced Series Motional Resistance. J. Microelectromech. Syst. 2006, 15, 1419–1436. [Google Scholar] [CrossRef]
- Lin, Y.-W.; Li, S.-S.; Xie, Y.; Ren, Z.; Nguyen, C.T.-C. Vibrating micromechanical resonators with solid dielectric capacitive transducer gaps. In Proceedings of the 2005 IEEE International Frequency Control Symposium and Exposition, Vancouver, BC, Canada, 29–31 August 2005; pp. 128–134. [Google Scholar]
- Hsu, W.; Lee, S.; Nguyen, C.T. In Situ Localized Annealing for Contamination Resistance and Enhanced Stability in Nickel Micromechanical Resonators. In Proceedings of the 10th International Conference on Solid-State Sensors and Actuators, Sendai, Japan, 7–10 June 1999; pp. 932–935. [Google Scholar]
- Xu, L.; Ren, J.; Jiang, Z.; Yu, J.; Wei, X. Effect of Joule heating on the performance of micromechanical piezoresistive oscillator. Sens. Actuators. A Phys. 2022, 333, 113234. [Google Scholar] [CrossRef]
- Wei, M.; Avila, A.; Rivera, I.; Baghelani, M.; Wang, J. ZnO on nickel RF micromechanical resonators for monolithic wireless communication applications. J. Micromech. Microeng. 2017, 27, 055006. [Google Scholar] [CrossRef]
- Wu, G.; Xu, J.; Ng, E.J.; Chen, W. MEMS Resonators for Frequency Reference and Timing Applications. J. Microelectromech. Syst. 2020, 29, 1137–1166. [Google Scholar] [CrossRef]
- Feng, T.; Yuan, Q.; Yu, D.; Wu, B.; Wang, H. Concepts and Key Technologies of Microelectromechanical Systems Resonators. Micromachines 2022, 13, 2195. [Google Scholar] [CrossRef] [PubMed]
- Liu, W.; Lu, Y.; Chen, Z.; Jia, Q.; Zhao, J.; Niu, B.; Wang, W.; Hao, Y.; Zhu, Y.; Yang, J.; et al. A GHz Silicon-Based Width Extensional Mode MEMS Resonator with Q over 10,000. Sensors 2023, 23, 3808. [Google Scholar] [CrossRef] [PubMed]
- Perelló-Roig, R.; Verd, J.; Bota, S.; Segura, J. A Tunable-Gain Transimpedance Amplifier for CMOS-MEMS Resonators Characterization. Micromachines 2021, 12, 82. [Google Scholar] [CrossRef] [PubMed]
- Hsu, W.-H.; Chen, H.-Y.; Lin, Z.-W.; Li, S.-S. A Novel Electrostatic Frequency Tuning Mechanism Based on a Vertically Coupled Cmos-Mems Resonator. In Proceedings of the IEEE 38th International Conference on Micro Electro Mechanical Systems (MEMS), Kaohsiung, Taiwan, 19–23 January 2025. [Google Scholar]
- Lin, Y.-T.; Chang, C.-Y.; Li, S.-S. High-Performance Piezoelectric Mems Resonators and Oscillators Leveraging Advanced High-Order Support Transducer Topologies. In Proceedings of the IEEE 38th International Conference on Micro Electro Mechanical Systems (MEMS), Kaohsiung, Taiwan, 19–23 January 2025. [Google Scholar]
- Li, L.; Lan, D.; Han, X.; Liu, T.; Dewdney, J.; Zaman, A.; Guneroglu, U.; Martinez, C.M.; Wang, J. Low Phase Noise, Dual-Frequency Pierce MEMS Oscillators with Direct Print Additively Manufactured Amplifier Circuits. Micromachines 2025, 16, 755. [Google Scholar] [CrossRef]
- Liu, T.H.; Han, X.; Pastrana, J.; Sepulveda, N.; Wang, J. Piezoelectric Lateral-Extensional Mode Resonators with Reconfigurable Electrode and Resonance Mode-Switching Behavior Enabled by a VO2 Thin-Film. IEEE Trans. Ultrason. Ferroelectr. Freq. Control 2022, 69, 2512–2525. [Google Scholar] [CrossRef]
- Guneroglu, U.; Zaman, A.; Alsolami, A.; Rivera, I.F.; Wang, J. Study of Frequency Trimming Ability and Performance Enhancement of Thin-Film Piezoelectric-on-Silicon MEMS Resonators by Joule Heating via Localized Annealing. IEEE Trans. Ultrason. Ferroelectr. Freq. Control 2025, 72, 686–696. [Google Scholar] [CrossRef]
- Rivera, I.; Avila, A.; Wang, J. Fourth-Order Contour Mode ZnO-on-SOI Disk Resonators for Mass Sensing Applications. Actuators 2015, 4, 60–76. [Google Scholar] [CrossRef]
- Abdolvand, R.; Lavasani, H.; Ho, G.; Ayazi, F. Thin-film piezoelectric-on-silicon resonators for high-frequency reference oscillator applications. IEEE Trans. Ultrason. Ferroelectr. Freq. Control 2008, 55, 2596–2606. [Google Scholar] [CrossRef]
- Dewdney, J.M. Low Loss VHF and UHF Filters for Wireless Communications Based on Piezoelectrically-Transduced Micromechanical Resonators. Ph.D. Thesis, University of South Florida, Tampa, FL, USA, 2012. [Google Scholar]
- Ho, G.; Abdolvand, R.; Sivapurapu, A.; Humad, S.; Ayazi, F. Piezoelectric-on-Silicon Lateral Bulk Acoustic Wave Micromechanical Resonators. J. Microelectromech. Syst. 2008, 17, 512–520. [Google Scholar] [CrossRef]
- Fu, H.C.; Leang, K.K. Teaching the Difference Between Stiffness and Damping [Lecture Notes]. IEEE Control Syst. Mag. 2012, 32, 95–97. [Google Scholar]
- Streller, F.; Wabiszewski, G.E.; Mangolini, F.; Feng, G.; Carpick, R.W. Tunable, Source-Controlled Formation of Platinum Silicides and Nanogaps from Thin Precursor Films. Adv. Mater. Interfaces 2014, 1, 1300120. [Google Scholar] [CrossRef]
- Chizh, K.V.; Dubkov, V.P.; Senkov, V.M.; Pirshin, I.V.; Arapkina, L.V.; Mironov, S.A.; Orekhov, A.S.; Yuryev, V.A. Low-temperature formation of platinum silicides on Polycrystalline Silicon. J. Alloys Compd. 2020, 843, 155908. [Google Scholar] [CrossRef]
- Kim, B.; Hopcroft, M.A.; Candler, R.N.; Jha, C.M.; Agarwal, M.; Melamud, R.; Chandorkar, S.A.; Yama, G.; Kenny, T.W. Temperature Dependence of Quality Factor in MEMS Resonators. J. Microelectromech. Syst. 2008, 17, 755–766. [Google Scholar] [CrossRef]
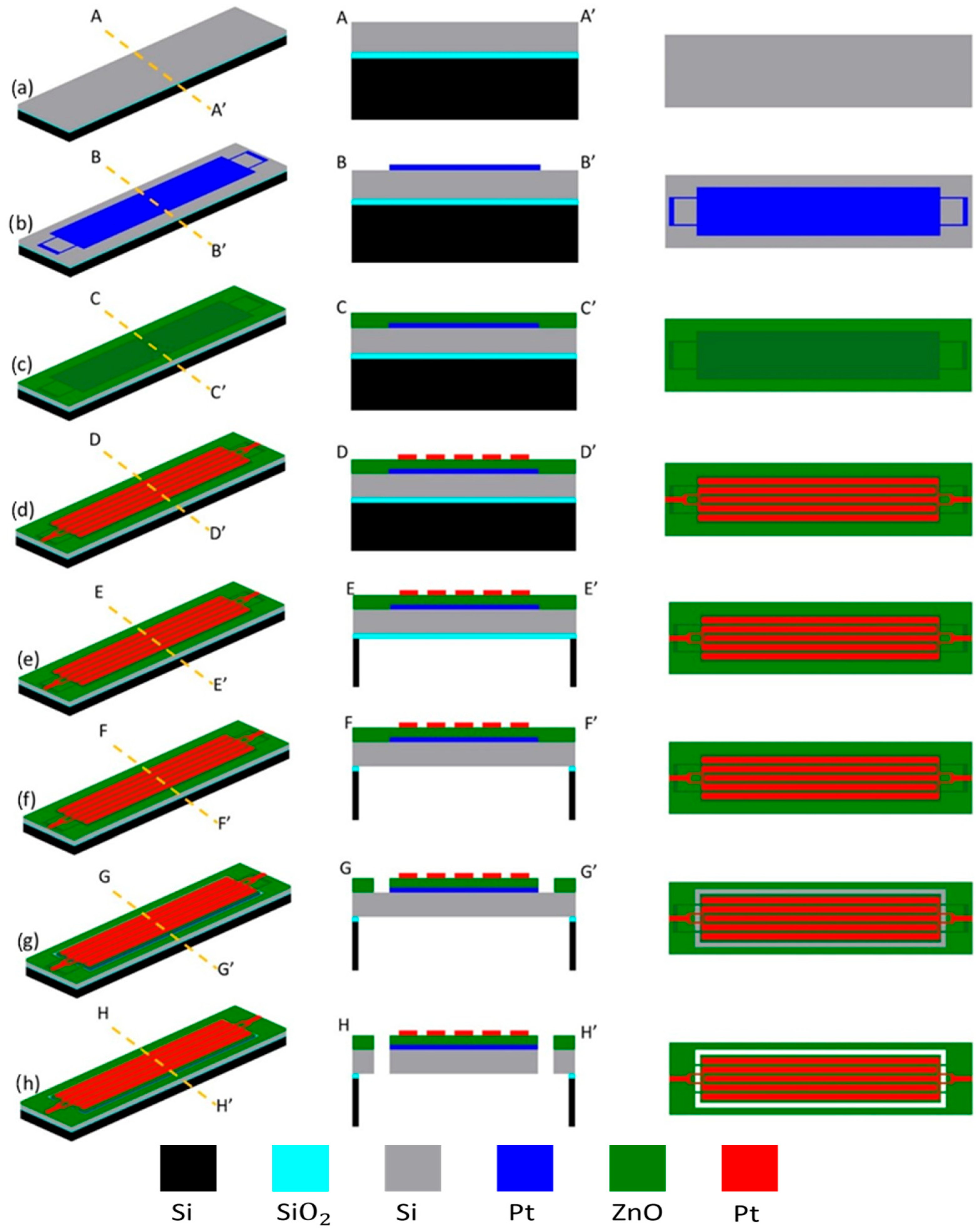
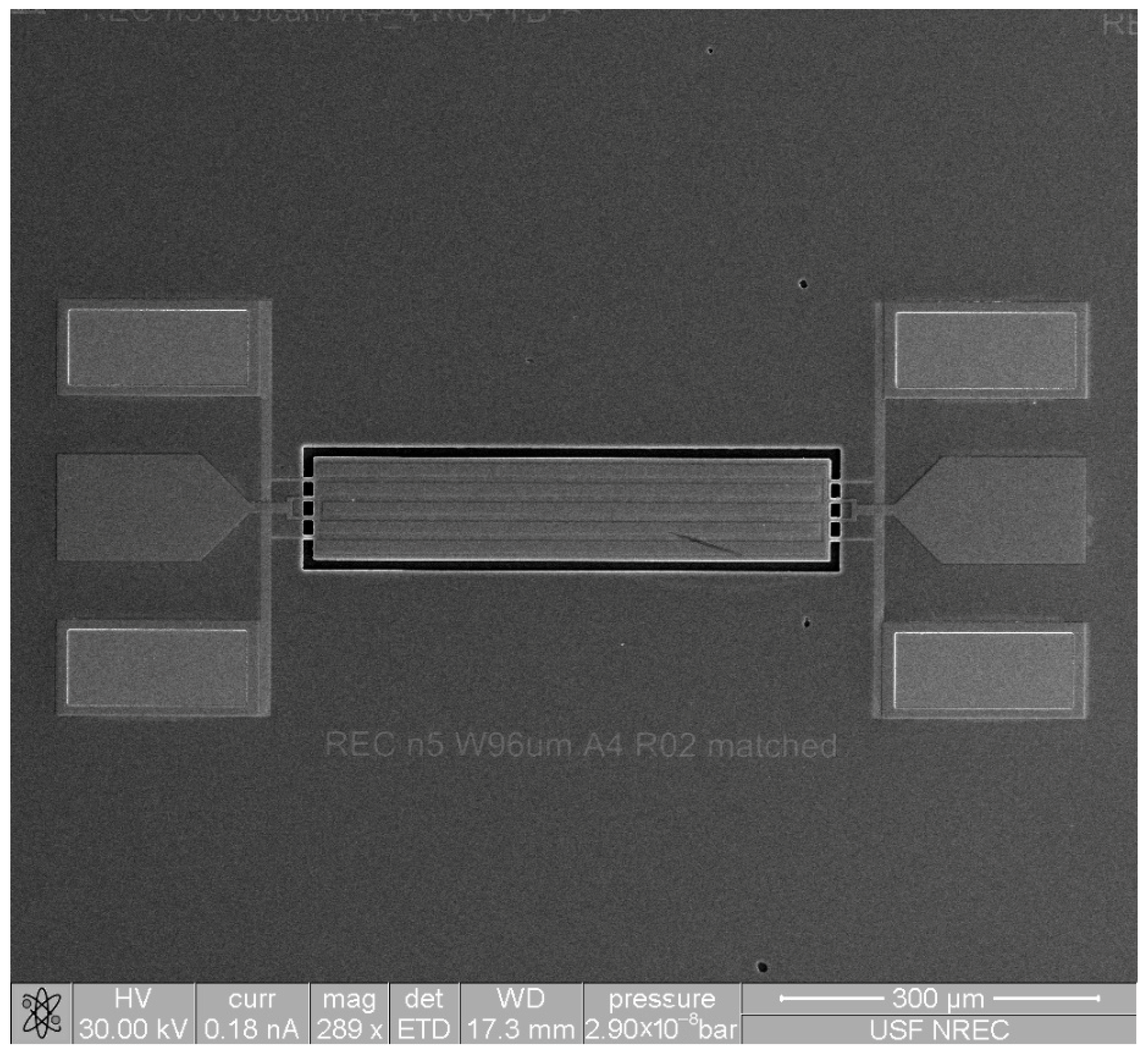

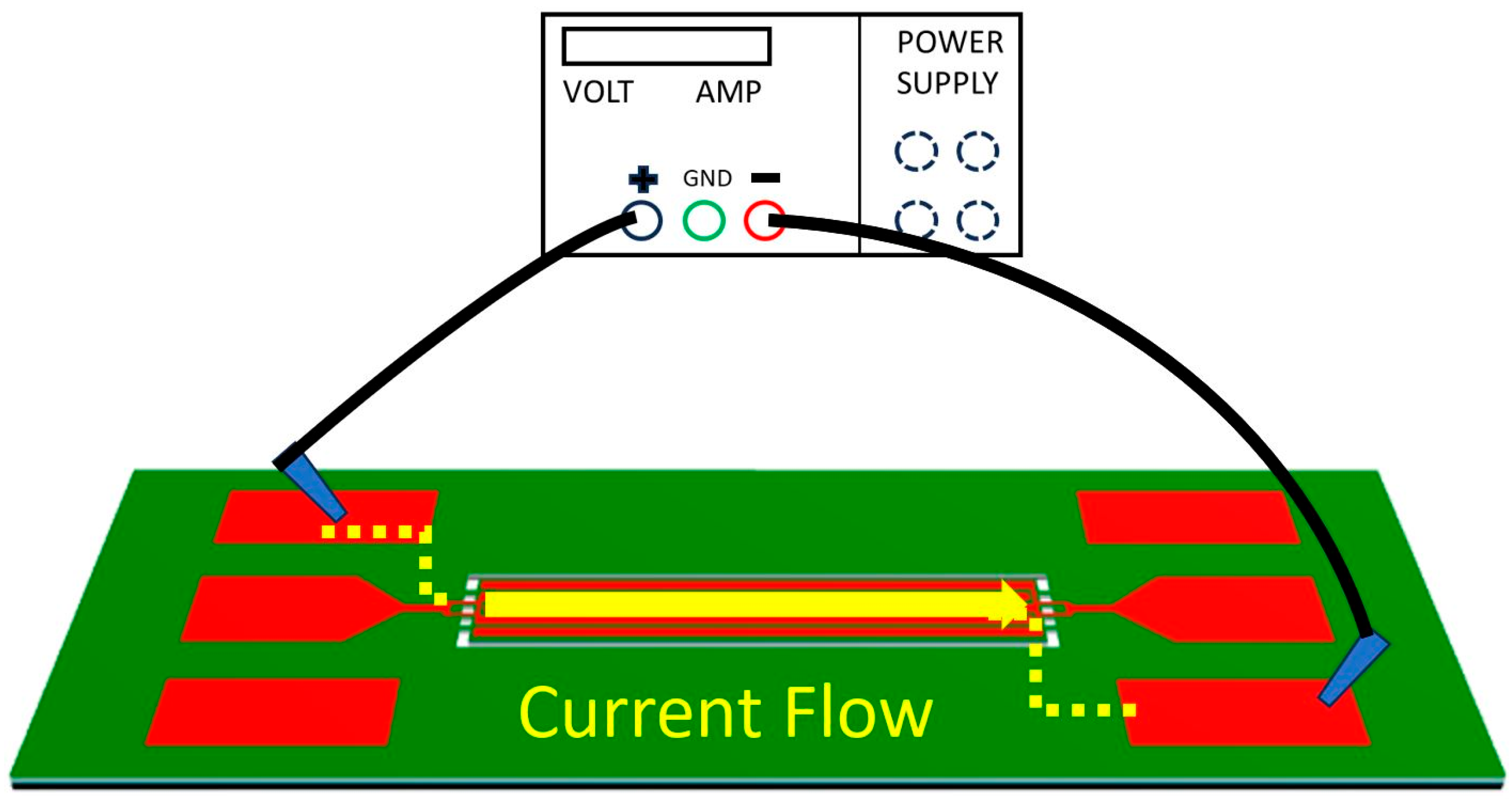
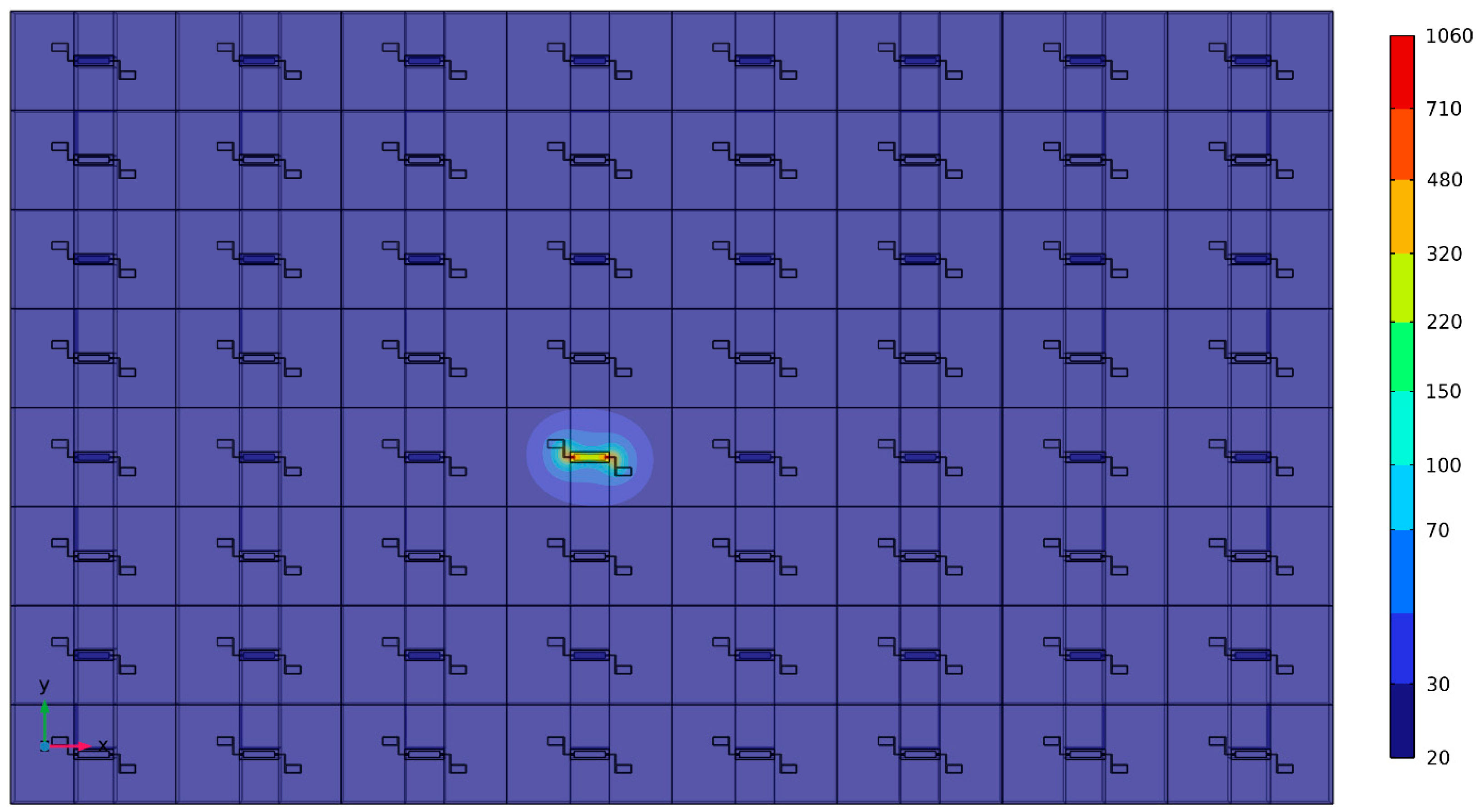
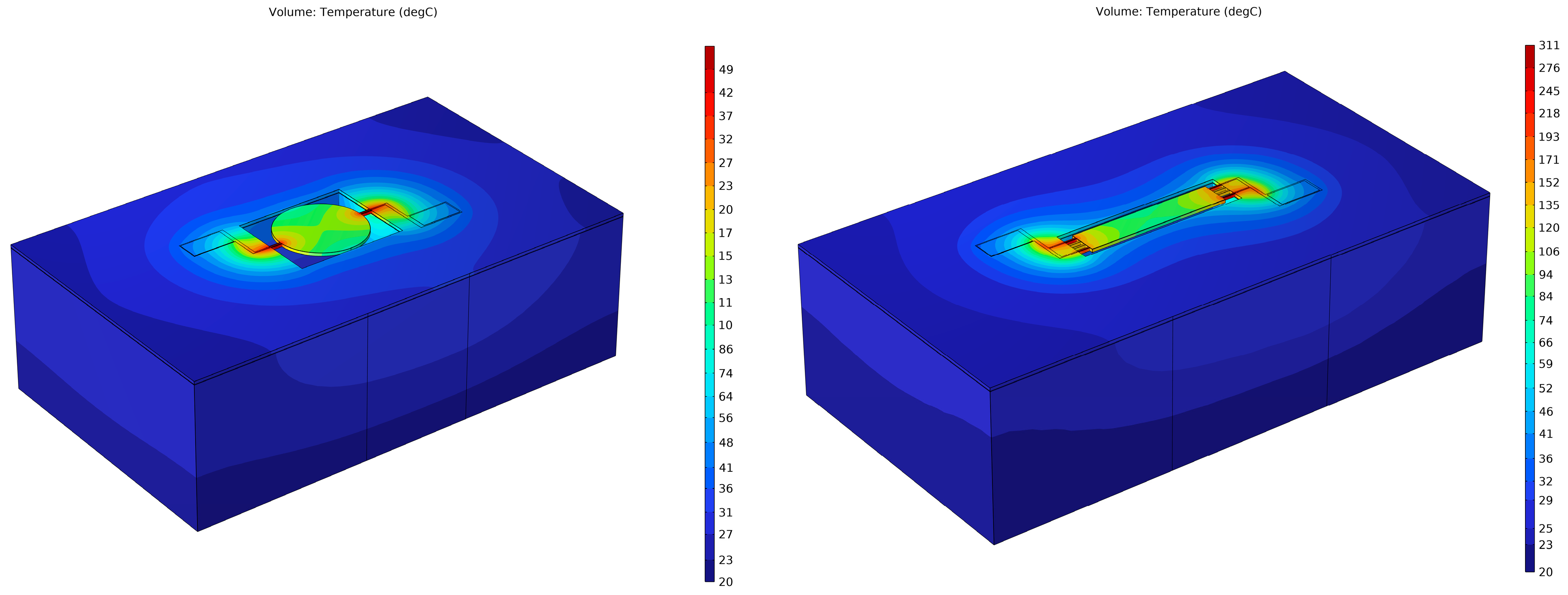

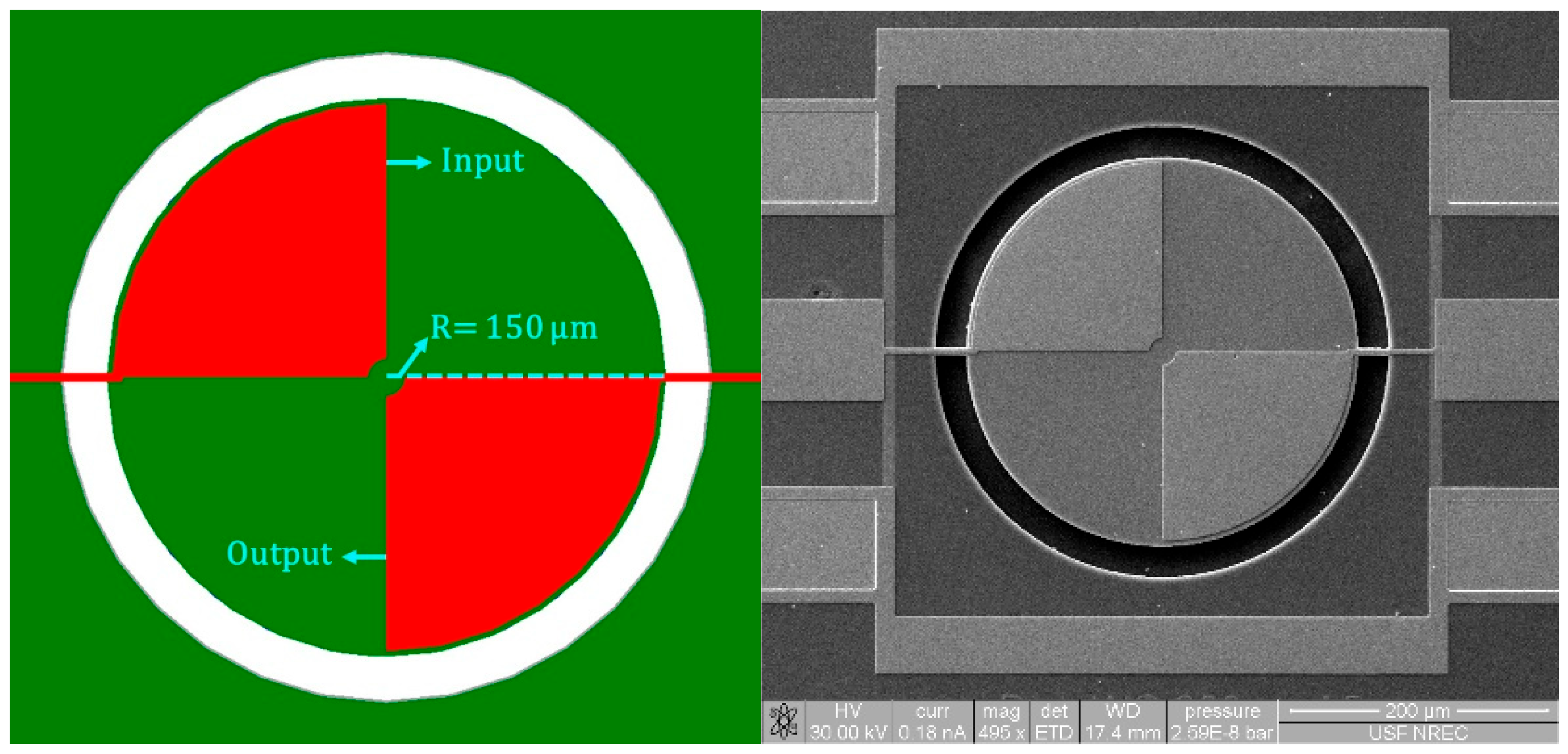


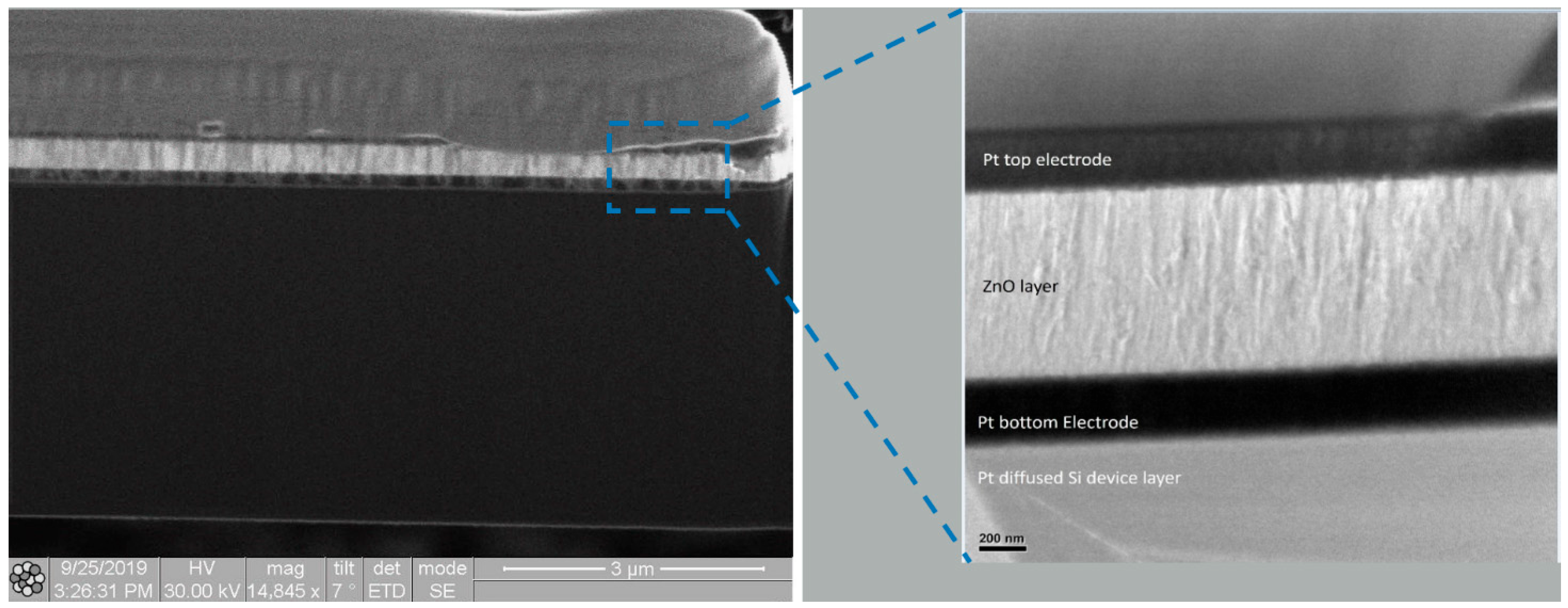
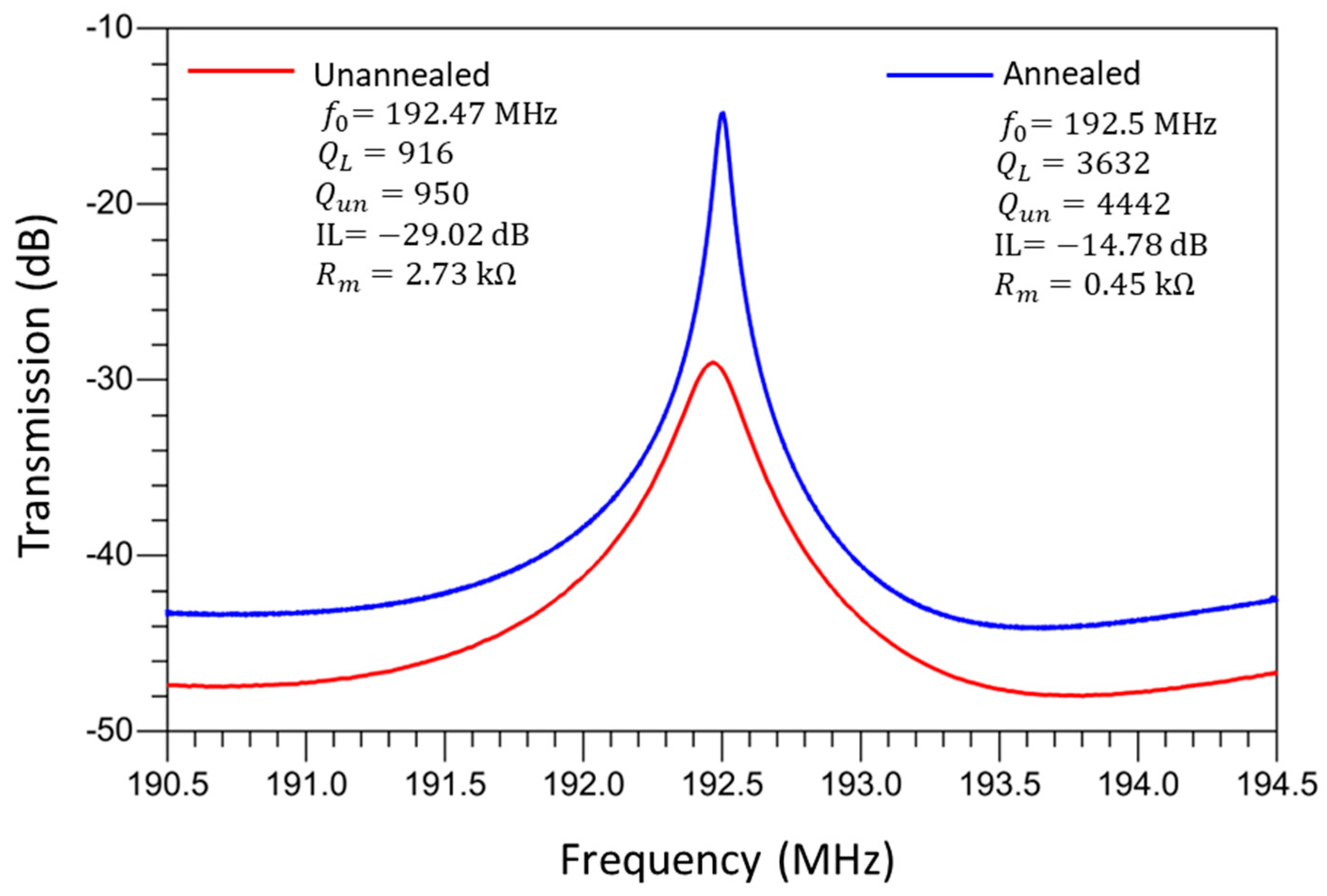
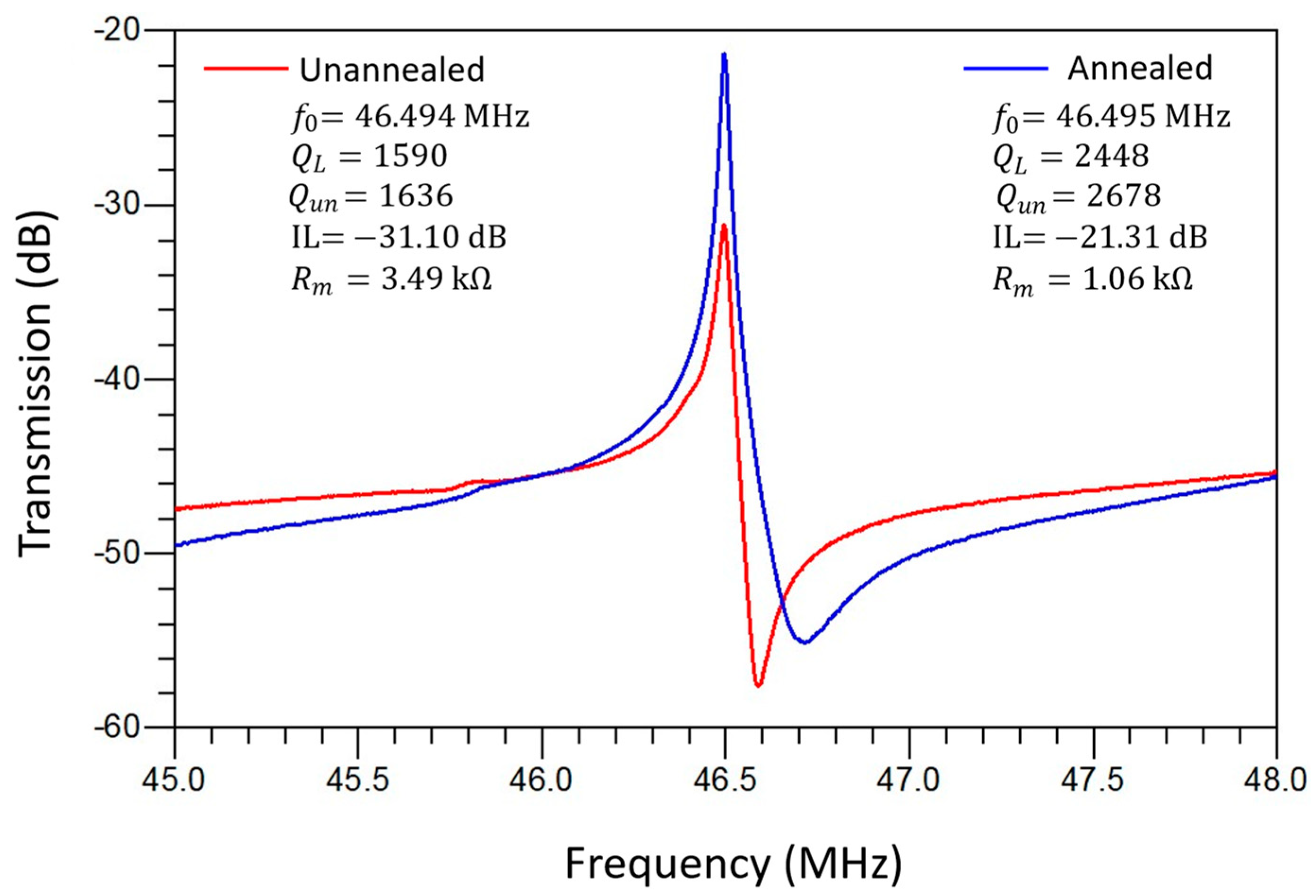
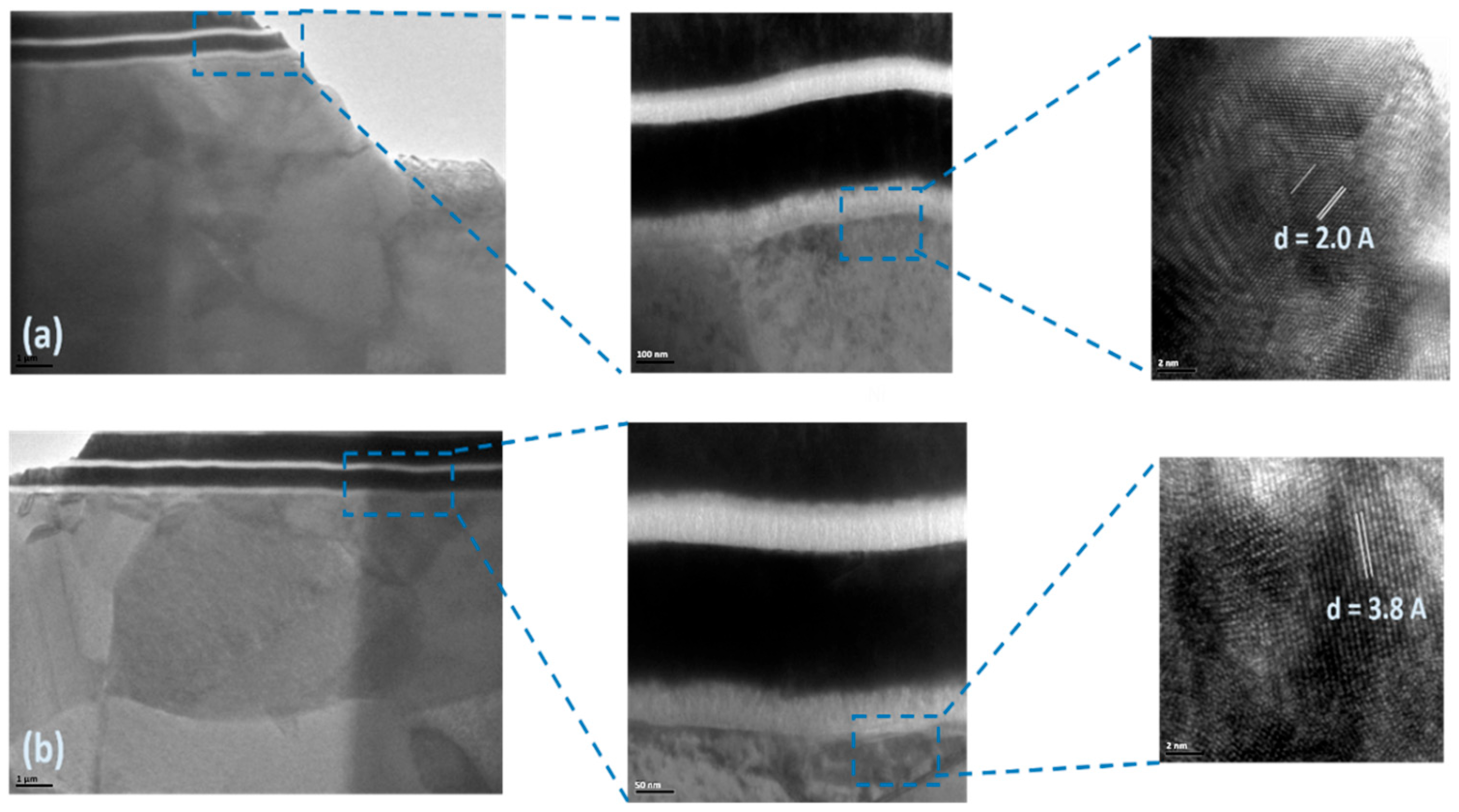
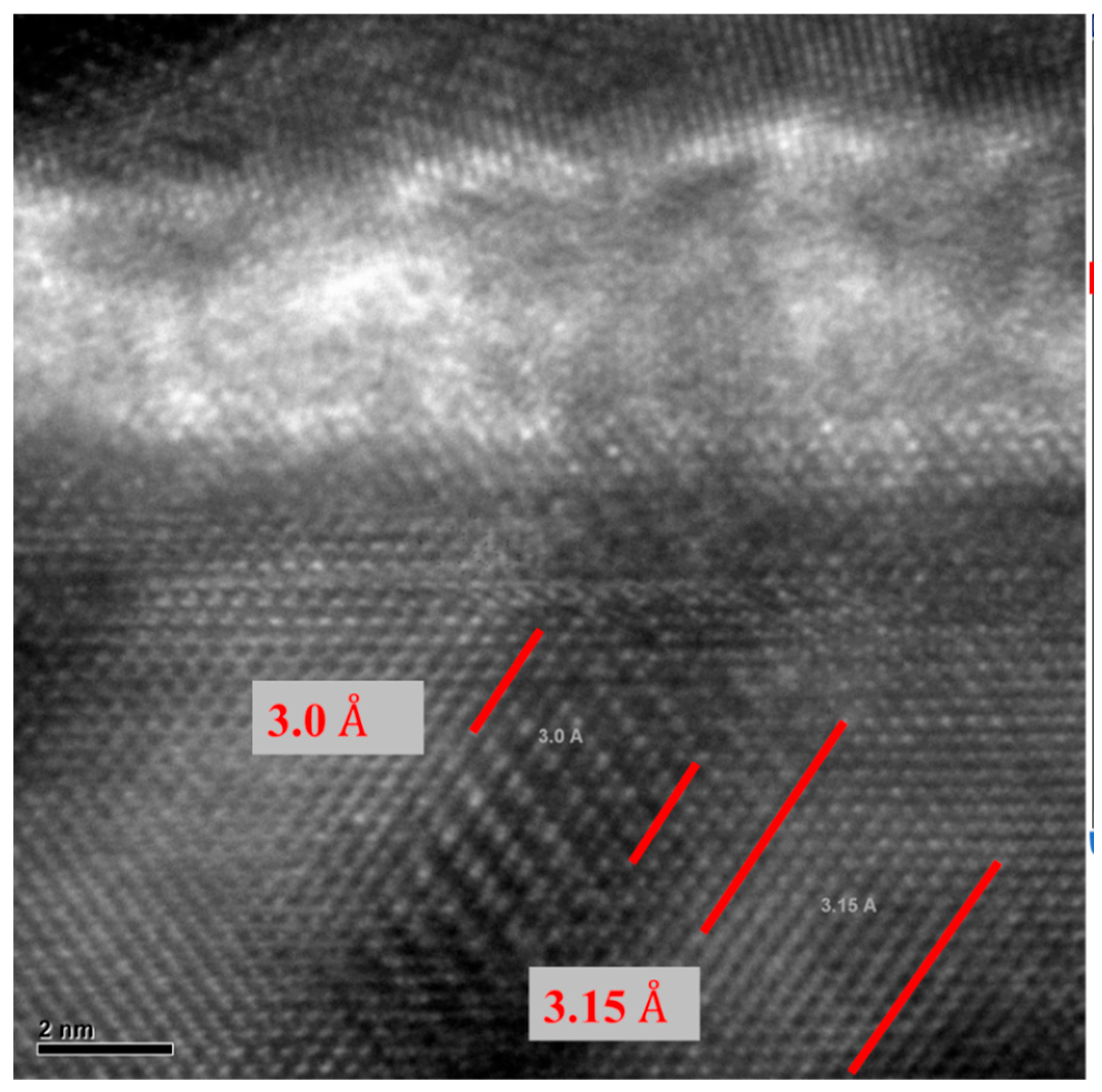
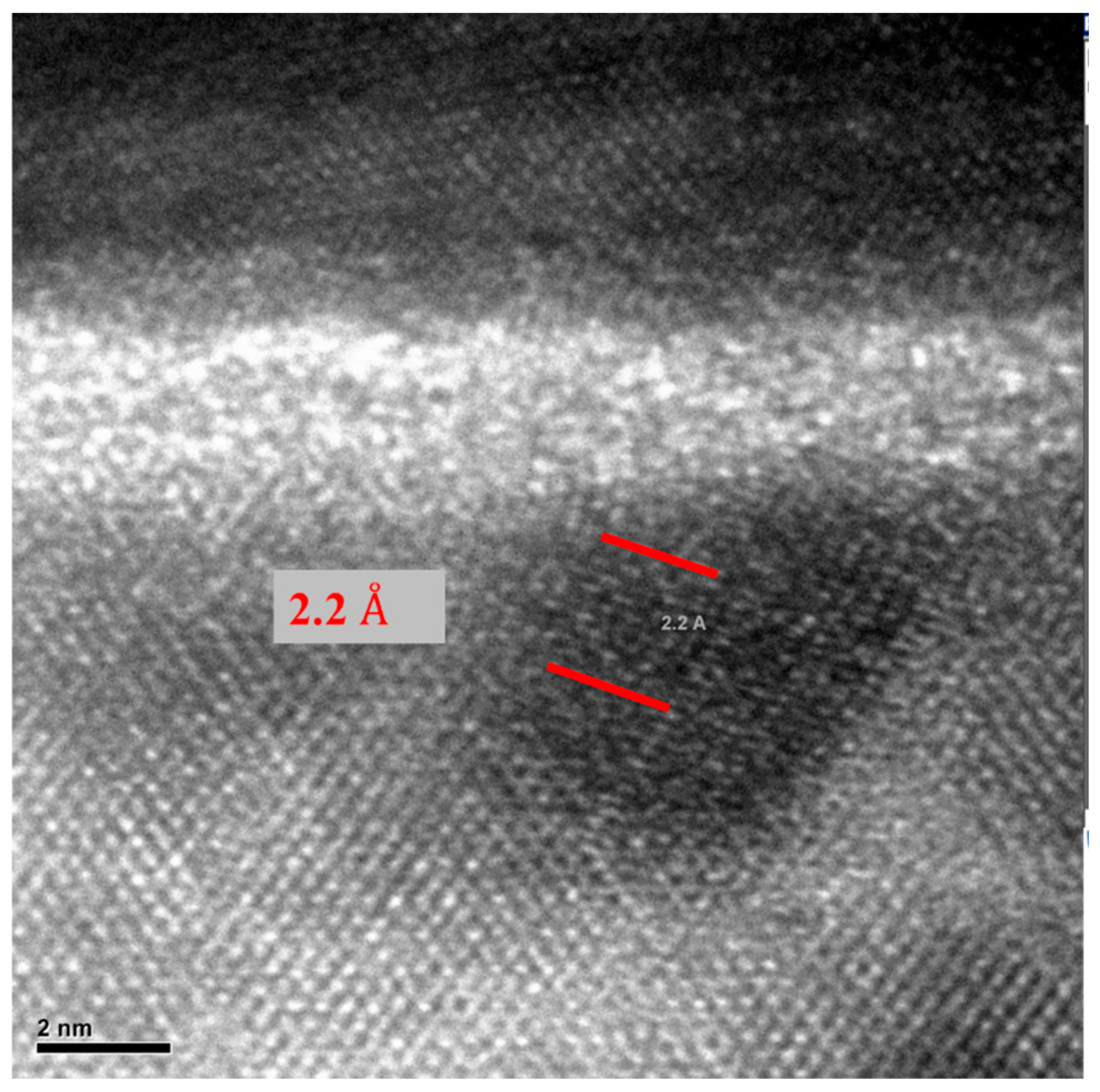
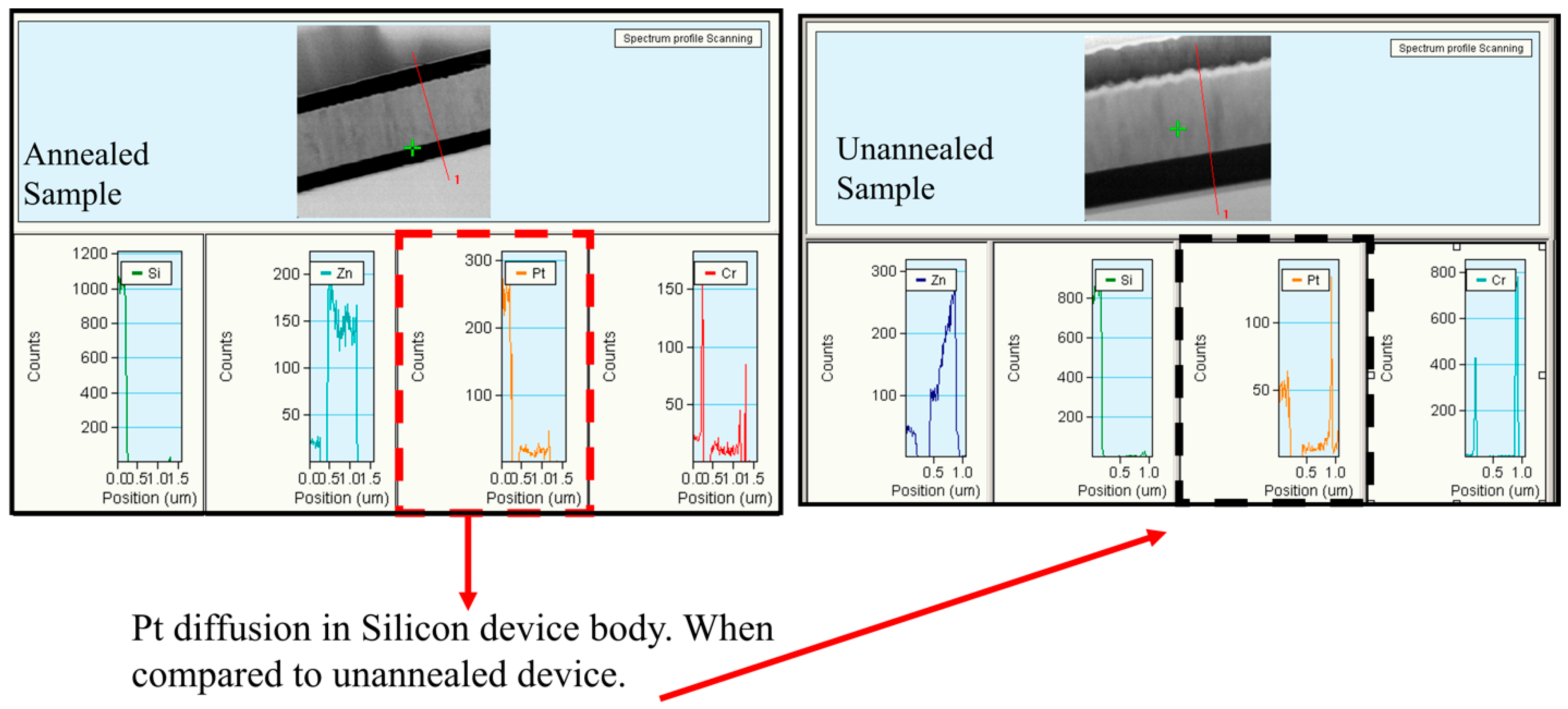
| Peak List | ||||
|---|---|---|---|---|
| No. | h | k | l | d (A) |
| 1 | 1 | 1 | 0 | 4.070 |
| 2 | 1 | 0 | 1 | 3.080 |
| 3 | 2 | 0 | 0 | 2.970 |
| 4 | 0 | 2 | 0 | 2.896 |
| 5 | 0 | 2 | 1 | 2.216 |
| 6 | 2 | 1 | 1 | 2.122 |
| 7 | 1 | 2 | 1 | 2.075 |
| 8 | 2 | 2 | 0 | 2.037 |
| 9 | 3 | 1 | 0 | 1.867 |
| 10 | 0 | 0 | 2 | 1.804 |
| Process Step Name | Current (A) | Average Power (W) | Time (min) | Energy Dosage (kJ) | Resonant Frequency (MHz) | Q-Factor | Insertion Loss (dB) |
|---|---|---|---|---|---|---|---|
| Unannealed Rectangular | - | - | - | - | 192.468 | 916 | −29.02 |
| Annealed Rectangular | 0.5 | 2 | 30 | 1.5 | 192.500 | 3632 | −14.78 |
| Unannealed Disk | - | - | - | - | 46.494 | 1590 | −31.10 |
| Annealed Disk | 0.5 | 2.5 | 25 | 3.75 | 46.495 | 2448 | −21.31 |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2025 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Zaman, A.; Guneroglu, U.; Alsolami, A.; Li, L.; Wang, J. Interface Material Modification to Enhance the Performance of a Thin-Film Piezoelectric-on-Silicon (TPoS) MEMS Resonator by Localized Annealing Through Joule Heating. Micromachines 2025, 16, 885. https://doi.org/10.3390/mi16080885
Zaman A, Guneroglu U, Alsolami A, Li L, Wang J. Interface Material Modification to Enhance the Performance of a Thin-Film Piezoelectric-on-Silicon (TPoS) MEMS Resonator by Localized Annealing Through Joule Heating. Micromachines. 2025; 16(8):885. https://doi.org/10.3390/mi16080885
Chicago/Turabian StyleZaman, Adnan, Ugur Guneroglu, Abdulrahman Alsolami, Liguan Li, and Jing Wang. 2025. "Interface Material Modification to Enhance the Performance of a Thin-Film Piezoelectric-on-Silicon (TPoS) MEMS Resonator by Localized Annealing Through Joule Heating" Micromachines 16, no. 8: 885. https://doi.org/10.3390/mi16080885
APA StyleZaman, A., Guneroglu, U., Alsolami, A., Li, L., & Wang, J. (2025). Interface Material Modification to Enhance the Performance of a Thin-Film Piezoelectric-on-Silicon (TPoS) MEMS Resonator by Localized Annealing Through Joule Heating. Micromachines, 16(8), 885. https://doi.org/10.3390/mi16080885






