A Novel Piezoresistive MEMS Pressure Sensors Based on Temporary Bonding Technology
Abstract
1. Introduction
2. Materials and Methods
2.1. Thin-Diaphragm Design
2.2. Piezoresistor Design
3. Pressure Sensor Fabrication
- (a)
- The production begins with an n-type (100) SOI wafer with the thickness of 405 +/−5 μm, on which is the device layer with the thickness and resistivity of 2 μm and 1–10 Ω/cm. The thickness of the buried oxide layer of the SOI wafer is of 0.4 μm.
- (b)
- Twice ion implantation on the device layer is performed to form the gauge piezoresistors and ohmic contact area respectively.
- (c)
- Silicon oxide as the insulating layer is deposited and the holes in the low resistance region are patterned and etched, followed by aluminum deposition as interconnection and electrodes with a thickness of 300 nm.
- (d)
- Sputtering deposition of Chromium/Copper (50 nm/500 nm) as the temporary bonding material and lifting-off to expose the effective device area.
- (e)
- Repeating the previous step (d) on a piece of BF33 wafer. The thickness of the BF33 is about 520 μm, and the surface roughness is less than 5 nm. It has high chemical stability and excellent mechanical flexibility, which can be used for wafer carriers bonded to silicon anodes and thin silicon wafers.
- (f)
- Bonding the device layer and the BF33 together through the thermocompression bonding technology.
- (g)
- Thinning handle layer with CMP (Chemical Mechanical Polishing) to a thickness of 60 μm and etching the handle layer after back-aligned lithography with silicon oxide as the etch stop layer to fabricate the cavity.
- (h)
- Sputtering a layer of aluminum on the upper BF33 by magnetron sputtering technology. The edge of the structure is also covered with aluminum, so that the upper layer of aluminum is electrically connected to the lower SOI sheet for the next anode bonding. Then, bonding the structure to another BF33 wafer by anodic bonding in a vacuum chamber at 5 × 10−4 Torr and polishing the BF33 to a thickness of 40 μm.
- (i)
- Dicing the device into the size of 1600 μm × 650 μm and separating the structure by immersing in a special etchant (H2SO4:H2O2:H2O = 1:1:40).
4. Results and Discussion
5. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- Kumar, S.S.; Pant, B.D. Design principles and considerations for the ‘ideal’ silicon piezoresistive pressure sensor: A focused review. Microsyst. Technol. 2014, 20, 1213–1247. [Google Scholar] [CrossRef]
- Starr, P.; Bartels, K.; Agrawal, M.; Bailey, S. Evolution of micromachined pressure transducers for cardiovascular applications. Sens. Actuators A Phys. 2015, 225, 8–19. [Google Scholar] [CrossRef]
- Kim, J.; Park, K.T.; Kim, H.C.; Chun, K. Fabrication of a piezoresistive pressure sensor for enhancing sensitivity using silicon nanowire. In Proceedings of the 2009 International Solid-State Sensors, Actuators and Microsystems Conference (TRANSDUCERS 2009), Denver, CO, USA, 21–25 June 2009; pp. 1936–1939. [Google Scholar]
- Zhang, M.; Yang, J.; He, Y.; Yang, F.; Yang, F.; Han, G.; Si, C.; Ning, J. Research on a 3D Encapsulation Technique for Capacitive MEMS Sensors Based on Through Silicon Via. Sensors 2019, 19, 93. [Google Scholar] [CrossRef] [PubMed]
- Su, J.L.; Zhang, X.W.; Zhou, G.P.; Xia, C.F.; Zhou, W.Q.; Huang, Q.A. A review: Crystalline silicon membranes over sealed cavities for pressure sensors by using silicon migration technology. J. Semicond. 2018, 39, 071005. [Google Scholar] [CrossRef]
- Guan, T.; Yang, F.; Wang, W.; Huang, X.; Jiang, B.; Zhang, D. The design and analysis of piezoresistive Shuriken-structured diaphragm micro-pressure sensors. J. Microelectromech. Syst. 2017, 26, 206–214. [Google Scholar] [CrossRef]
- Kumar, S.S.; Pant, B.D. Effect of piezoresistor configuration on output characteristics of piezoresistive pressure sensor: An experimental study. Microsyst. Technol. 2015, 22, 709–719. [Google Scholar] [CrossRef]
- Kalvesten, E.; Smith, L.; Tenerz, L.; Stemme, G. The first surface micromachined pressure sensor for cardiovascular pressure measurements. In Proceedings of the Eleventh Annual International Workshop on Micro Electro Mechanical Systems, (MEMS 98), Heidelberg, Germany, 25–29 January 1998; pp. 574–579. [Google Scholar]
- Gowrishetty, U.; Walsh, K.M.; Aebersold, J.; Jackson, D.; Millar, H.; Roussel, T. Development of ultra-miniaturized piezoresistive pressure sensors for biomedical applications. In Proceedings of the 2008 UGIM 2008 17th Biennial University/Government/Industry Micro/Nano Symposium, Louisville, KY, USA, 13–16 July 2008; pp. 89–92. [Google Scholar]
- Li, C.; Cordovilla, F.; Jagdheesh, R.; Ocaña, J. Design optimization and fabrication of a novel structural SOI piezoresistive pressure sensor with high accuracy. Sensors 2018, 18, 439. [Google Scholar] [CrossRef] [PubMed]
- Zheng, B.R.; Zhou, C.; Wang, Q.; Pan, X.M.; Xue, W. Ultra-small micro pressure sensor chip design and fabrication featuring high-sensitivity and good-linearity. Microsyst. Technol. 2014, 21, 173–179. [Google Scholar] [CrossRef]
- Zou, H.; Wang, J.; Li, X. High-performance low-range differential pressure sensors formed with a thin-film under bulk micromachining technology. J. Microelectromech. Syst. 2017, 26, 879–885. [Google Scholar] [CrossRef]
- Meng, X.; Zhao, Y. The design and optimization of a highly sensitive and overload-resistant piezoresistive pressure sensor. Sensors 2016, 16, 348. [Google Scholar] [CrossRef] [PubMed]
- Pramanik, C.; Saha, H.; Gangopadhyay, U. Design optimization of a high performance silicon MEMS piezoresistive pressure sensor for biomedical applications. J. Micromech. Microeng. 2006, 16, 2060. [Google Scholar] [CrossRef]
- Yu, H.; Huang, J. Design and Application of a High Sensitivity Piezoresistive Pressure Sensor for Low Pressure Conditions. Sensors 2015, 15, 22692–22704. [Google Scholar] [CrossRef] [PubMed]
- Smith, C.S. Piezoresistance effect in germanium and silicon. Phys. Rev. 1954, 94, 42. [Google Scholar] [CrossRef]
- Lin, L.; Chu, H.C.; Lu, Y.W. A simulation program for the sensitivity and linearity of piezoresistive pressure sensors. J. Microelectromech. Syst. 1999, 8, 514–522. [Google Scholar] [CrossRef]
- Goldenveizer, A.; Kaplunov, J.; Nolde, E. On Timoshenko-Reissner type theories of plates and shells. Int. J. Solids Struct. 1993, 30, 675–694. [Google Scholar] [CrossRef]
- Kulikov, G.; Plotnikova, S. Simple and effective elements based upon Timoshenko–Mindlin shell theory. Comput. Methods Appl. Mech. Eng. 2002, 191, 1173–1187. [Google Scholar] [CrossRef]
- Reddy, J.N. Theory and Analysis of Elastic Plates and Shells; CRC Press: Boca Raton, FL, USA, 2006. [Google Scholar]
- Hsu, T.R. MEMS and Microsystem: Design, Manufacturing and Nanoscale Engineering; China Industry and Information Technology Publishing Group: Beijing, China, 2004. [Google Scholar]
- Wei, C.; Zhou, W.; Wang, Q.; Xia, X.; Li, X. TPMS (tire-pressure monitoring system) sensors: Monolithic integration of surface-micromachined piezoresistive pressure sensor and self-testable accelerometer. Microelectron. Eng. 2012, 91, 167–173. [Google Scholar] [CrossRef]
- Wang, J.; Li, X. Single-side fabrication of multilevel 3-D microstructures for monolithic dual sensors. J. Microelectromech. Syst. 2015, 24, 531–533. [Google Scholar] [CrossRef]
- Je, C.H.; Lee, S.Q.; Yang, W.S. High sensitivity surface micromachined absolute pressure sensor. Procedia Eng. 2016, 168, 725–728. [Google Scholar] [CrossRef]
- Wang, J.; Chuai, R.; Yang, L.; Dai, Q. A surface micromachined pressure sensor based on polysilicon nanofilm piezoresistors. Sens. Actuators A Phys. 2015, 228, 75–81. [Google Scholar] [CrossRef]
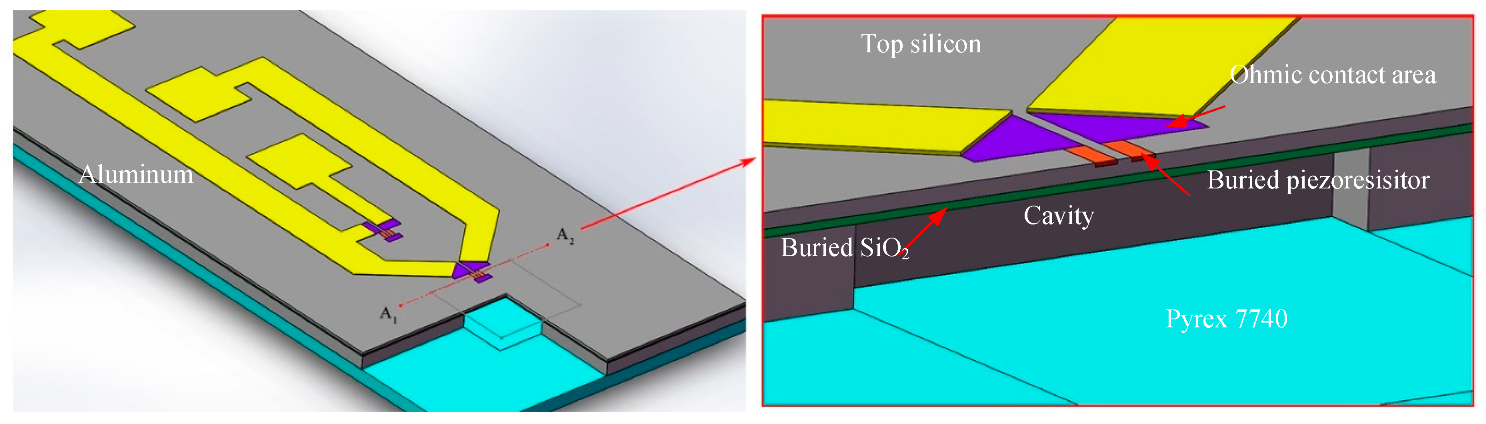

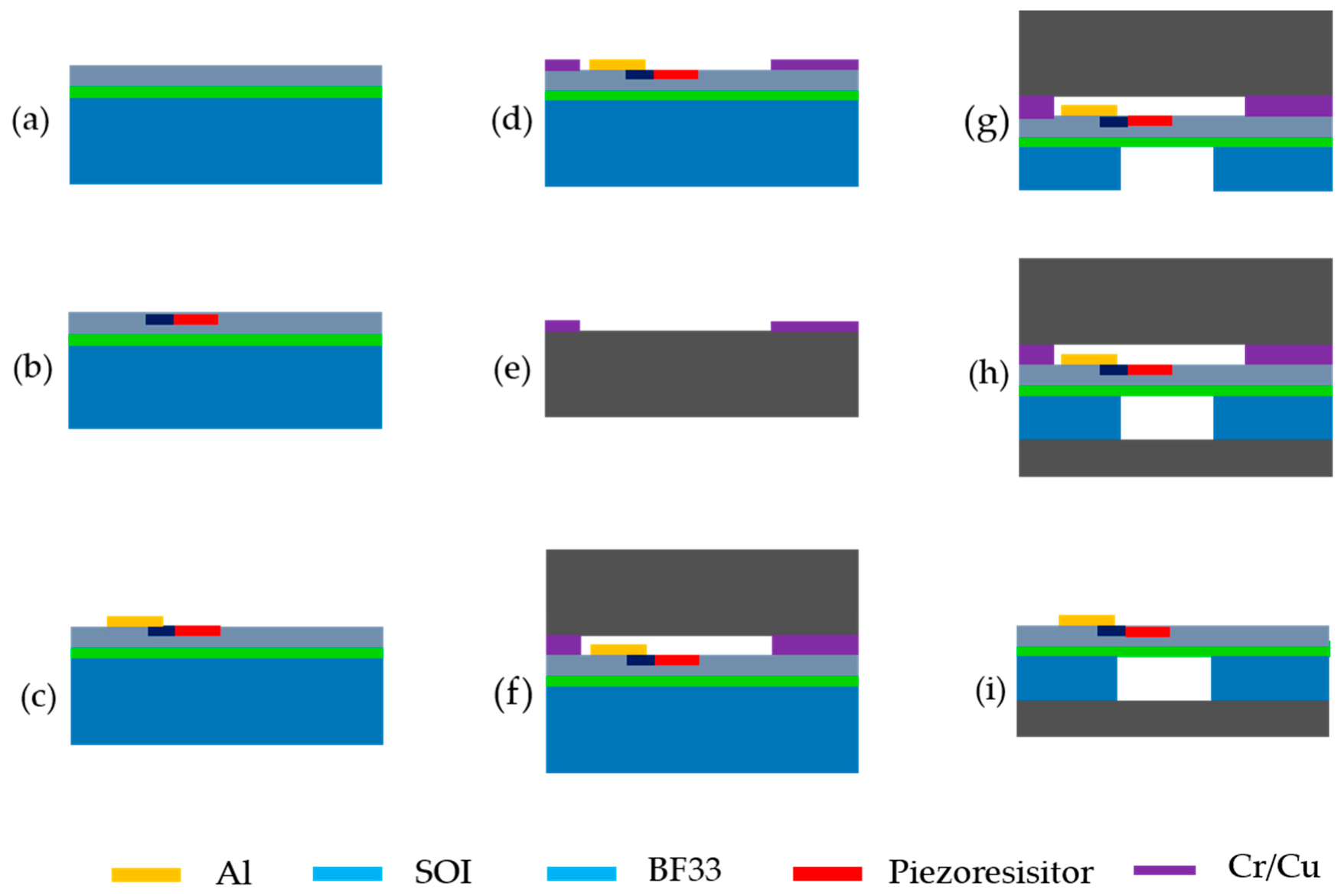
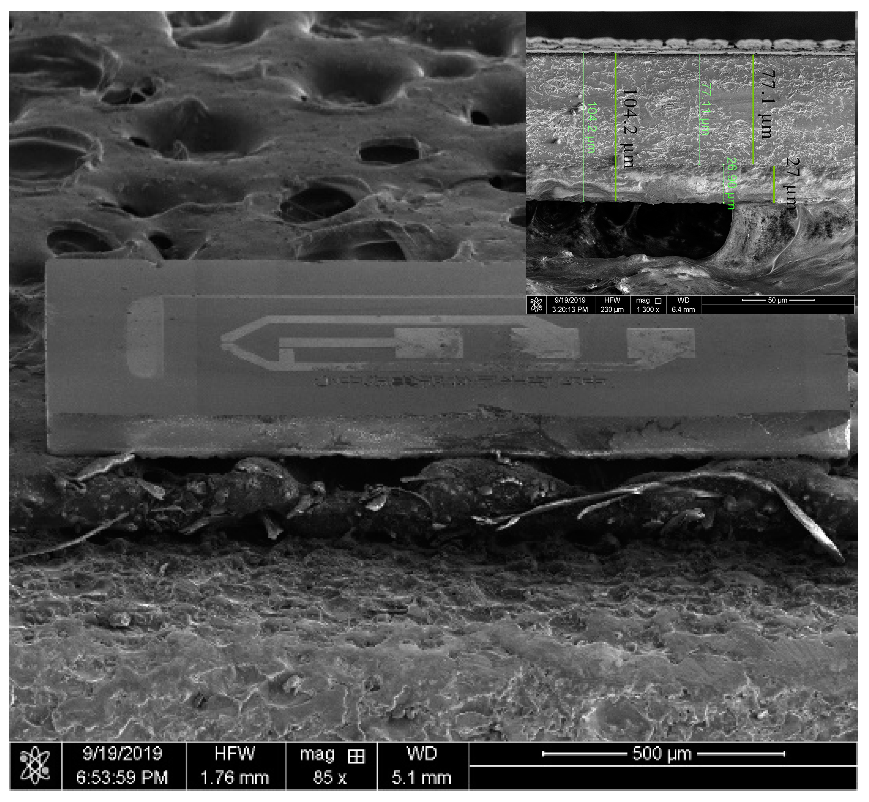
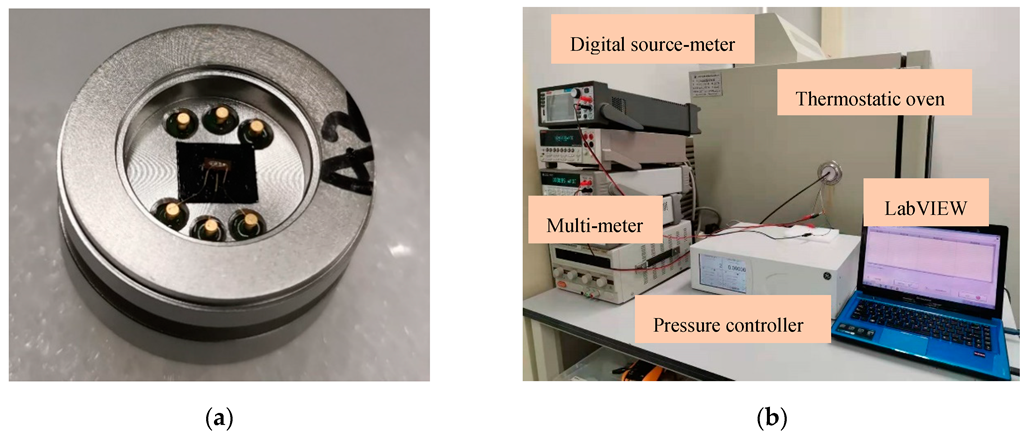



| Parameters | Values | Units |
|---|---|---|
| Diaphragm size | 100 × 100 | μm |
| Chip size | 1600 × 650 × 104 | μm |
| Sensitivity | 36 | μV/(V∙kPa) |
| Nonlinearity | 0.141 | % FSO |
| Hysteresis | 0.476 | % FSO |
| TCO (34–42 °C) | 8.11 × 10−4 | FSO/°C |
| TCS (34–42 °C) | 1.03 × 10−3 | FSO/°C |
| TCO (25–95 °C) | 0.186 × 10−4 | FSO/°C |
| TCS (25–95 °C) | 4.46 × 10−3 | FSO/°C |
© 2020 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Song, P.; Si, C.; Zhang, M.; Zhao, Y.; He, Y.; Liu, W.; Wang, X. A Novel Piezoresistive MEMS Pressure Sensors Based on Temporary Bonding Technology. Sensors 2020, 20, 337. https://doi.org/10.3390/s20020337
Song P, Si C, Zhang M, Zhao Y, He Y, Liu W, Wang X. A Novel Piezoresistive MEMS Pressure Sensors Based on Temporary Bonding Technology. Sensors. 2020; 20(2):337. https://doi.org/10.3390/s20020337
Chicago/Turabian StyleSong, Peishuai, Chaowei Si, Mingliang Zhang, Yongmei Zhao, Yurong He, Wen Liu, and Xiaodong Wang. 2020. "A Novel Piezoresistive MEMS Pressure Sensors Based on Temporary Bonding Technology" Sensors 20, no. 2: 337. https://doi.org/10.3390/s20020337
APA StyleSong, P., Si, C., Zhang, M., Zhao, Y., He, Y., Liu, W., & Wang, X. (2020). A Novel Piezoresistive MEMS Pressure Sensors Based on Temporary Bonding Technology. Sensors, 20(2), 337. https://doi.org/10.3390/s20020337






