Low Trapping Effects and High Blocking Voltage in Sub-Micron-Thick AlN/GaN Millimeter-Wave Transistors Grown by MBE on Silicon Substrate
Abstract
1. Introduction
2. Experimental Details
3. DC and RF Characteristics
4. Large Signal Characteristics (10 GHz and 40 GHz)
5. Conclusions
Author Contributions
Funding
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Mishra, U.K.; Parikh, P.; Wu, Y.F. AlGaN/GaN HEMTs—An overview of device operation and applications. Proc. IEEE 2002, 90, 1022–1031. [Google Scholar] [CrossRef]
- Moon, J.S.; Wong, D.; Hu, M.; Hashimoto, P.; Antcliffe, M.; McGuire, C.; Micovic, M.; Willadson, P. 55% PAE and high power Ka-band GaN HEMTs with linearized transconductance via n+ GaN source contact ledge. IEEE Electron Device Lett. 2008, 29, 834–837. [Google Scholar] [CrossRef]
- Jazaeri, F.; Sallese, J.M. Charge-based EPFL HEMT model. IEEE Trans. Electron. Devices 2019, 66, 1218–1229. [Google Scholar] [CrossRef]
- Liu, W.; Romanczyk, B.; Guidry, M.; Hatui, N.; Wurm, C.; Li, W.; Shrestha, P.; Zheng, X.; Keller, S.; Mishra, U.K. 6.2 W/Mm and Record 33.8% PAE at 94 GHz from N-Polar GaN Deep Recess MIS-HEMTs with ALD Ru Gates. IEEE Microw. Wirel. Compon. Lett. 2021, 31, 748–751. [Google Scholar] [CrossRef]
- Moon, J.S.; Grabar, R.; Wong, J.; Antcliffe, M.; Chen, P.; Arkun, E.; Khalaf, I.; Corrion, A.; Chappell, J.; Venkatesan, N.; et al. High-speed graded-channel AlGaN/GaN HEMTs with power added efficiency >70% at 30 GHz. Electron. Lett. 2020, 56, 678–680. [Google Scholar] [CrossRef]
- Makiyama, K.; Ozaki, S.; Ohki, T.; Okamoto, N.; Minoura, Y.; Niida, Y.; Kamada, Y.; Joshin, K.; Watanabe, K.; Miyamoto, Y. Collapse-free high power InAlGaN/GaN-HEMT with 3 W/mm at 96 GHz. In Proceedings of the 2015 Technical Digest—International Electron Devices Meeting (IEDM), Washington, DC, USA, 7–9 December 2015. [Google Scholar] [CrossRef]
- Moench, S.; Müller, S.; Reiner, R.; Waltereit, P.; Czap, H.; Basler, M.; Hückelheim, J.; Kirste, L.; Kallfass, I.; Quay, R.; et al. Monolithic Integrated AlGaN/GaN Power Converter Topologies on High-Voltage AlN/GaN Superlattice Buffer. Phys. Status Solidi (A) Appl. Mater. Sci. 2021, 218, 2000404. [Google Scholar] [CrossRef]
- Chang, J.; Afroz, S.; Nagamatsu, K.; Frey, K.; Saluru, S.; Merkel, J.; Taylor, S.; Stewart, E.; Gupta, S.; Howell, R. The Super-Lattice Castellated Field-Effect RF Amplifier. IEEE Electron Device Lett. 2019, 40, 1048–1051. [Google Scholar] [CrossRef]
- Micovic, M.; Brown, D.F.; Regan, D.; Wong, J.; Tang, Y.; Herrault, F.; Santos, D.; Burnham, S.D.; Tai, J.; Prophet, E.; et al. High Frequency GaN HEMTs for RF MMIC Applications. In Proceedings of the 2016 IEEE International Electron Devices Meeting (IEDM), San Francisco, CA, USA, 3–7 December 2016. [Google Scholar] [CrossRef]
- Chen, D.Y.; Malmros, A.; Thorsell, M.; Hjelmgren, H.; Kordina, O.; Chen, J.T.; Rorsman, N. Microwave Performance of “Buffer-Free” GaN-on-SiC High Electron Mobility Transistors. IEEE Electron Device Lett. 2020, 41, 828–831. [Google Scholar] [CrossRef]
- Chen, D.Y.; Wen, K.H.; Thorsell, M.; Lorenzini, M.; Hjelmgren, H.; Chen, J.T.; Rorsman, N. Impact of the Channel Thickness on Electron Confinement in MOCVD-Grown High Breakdown Buffer-Free AlGaN/GaN Heterostructures. Phys. Status Solidi (A) Appl. Mater. Sci. 2022, 2022, 2200496. [Google Scholar] [CrossRef]
- Jessen, G.H.; Fitch, R.C.; Gillespie, J.K.; Via, G.; Crespo, A.; Langley, D.; Denninghoff, D.J.; Trejo, M.; Heller, E.R.; Algan, A. Short-Channel Effect Limitations on High-Frequency Operation of AlGaN/GaN HEMTs for T-Gate Devices. IEEE Trans. Electron. Devices 2007, 54, 2589–2597. [Google Scholar] [CrossRef]
- Schwantuschke, D.; Godejohann, B.J.; Brückner, P.; Tessmann, A.; Quay, R. mm-Wave Operation of AlN/GaN-Devices and MMICs at V- & W-band. In Proceedings of the IEEE 22nd International Microwave and Radar Conference (MIKON), Poznan, Poland, 14–17 May 2018. [Google Scholar] [CrossRef]
- Gao, Z.H.; Meneghini, M.; Harrouche, K.; Kabouche, R.; Chiocchetta, F.; Okada, E.; Rampazzo, F.; De Santi, C.; Medjdoub, F.; Meneghesso, G.; et al. Short term reliability and robustness of ultra-thin barrier, 110 nm-gate AlN/GaN HEMTs. Microelectron. Reliab. 2021, 123, 1–6. [Google Scholar] [CrossRef]
- Harrouche, K.; Kabouche, R.; Okada, E.; Medjdoub, F. High Power AlN/GaN HEMTs with record power-added-efficiency >70% at 40 GHz. In Proceedings of the 2020 IEEE/MTT-S International Microwave Symposium (IMS), Los Angeles, CA, USA, 4–6 August 2020. [Google Scholar] [CrossRef]
- Godejohann, B.J.; Ture, E.; Müller, S.; Prescher, M.; Kirste, L.; Aidam, R.; Polyakov, V.; Brückner, P.; Breuer, S.; Köhler, K.; et al. AlN/GaN HEMTs grown by MBE and MOCVD: Impact of Al distribution. Phys. Status Solidi B Basic Res. 2017, 254, 3–7. [Google Scholar] [CrossRef]
- Medjdoub, F.; Kabouche, R.; Linge, A.; Grimbert, B.; Zegaoui, M.; Gamarra, P.; Lacam, C.; Tordjman, M.; Di Forte-Poisson, M.A. High electron mobility in high-polarization sub-10 nm barrier thickness InAlGaN/GaN heterostructure. Appl. Phys. Express 2015, 8, 5–9. [Google Scholar] [CrossRef]
- Yang, L.; Wang, X.; Wang, T.; Wang, J.; Zhang, W.; Quach, P.; Wang, P.; Liu, F.; Li, D.; Chen, L.; et al. Three Subband Occupation of the Two-Dimensional Electron Gas in Ultrathin Barrier AlN/GaN Heterostructures. Adv. Funct. Mater. 2020, 30, 2004450. [Google Scholar] [CrossRef]
- Harrouche, K.; Venkatachalam, S.; Grandpierron, F.; Okada, E.; Medjdoub, F. Impact of undoped channel thickness and carbon concentration on AlN/GaN-on-SiC HEMT performances. Appl. Phys. Express 2022, 15, 116504. [Google Scholar] [CrossRef]
- Pradhan, M.; Alomari, M.; Moser, M.; Di, F.; Hahn, H.; Heuken, M.; Burghartz, J.N. Physical Modeling of Charge Trapping Effects in GaN/Si Devices and Incorporation in the ASM-HEMT Model. IEEE J. Electron. Devices Soc. 2021, 9, 748–755. [Google Scholar] [CrossRef]
- Shinohara, K.; Regan, D.C.; Tang, Y.; Corrion, A.L.; Brown, D.F.; Wong, J.C.; Robinson, J.F.; Fung, H.H.; Schmitz, A.; Oh, T.C.; et al. Scaling of GaN HEMTs and Schottky Diodes for Submillimeter-Wave MMIC Applications. IEEE Trans. Electron. Devices 2013, 60, 2982–2996. [Google Scholar] [CrossRef]
- Allaei, M.; Shalchian, M.; Jazaeri, F. Modeling of Short-Channel Effects in GaN HEMTs. IEEE Trans. Electron. Devices 2020, 67, 3088–3094. [Google Scholar] [CrossRef]
- Kabouche, R.; Okada, E.; Dogmus, E.; Linge, A.; Zegaoui, M.; Medjdoub, F. Power Measurement Setup for On-Wafer Large Signal Characterization Up to Q-Band. IEEE Microw. Wirel. Compon. Lett. 2017, 27, 419–421. [Google Scholar] [CrossRef]
- Mohanty, S.K.; Chen, Y.Y.; Yeh, P.H.; Horng, R.H. Thermal Management of GaN-on-Si High Electron Mobility Transistor by Copper Filled Micro-Trench Structure. Sci. Rep. 2019, 9, 19691. [Google Scholar] [CrossRef]
- Rennesson, S.; Lecourt, F.; Defrance, N.; Chmielowska, M.; Chenot, S.; Lesecq, M.; Hoel, V.; Okada, E.; Cordier, Y.; De Jaeger, J.C. Optimization of Al0.29Ga0.71N/GaN high electron mobility heterostructures for high-power/frequency performances. IEEE Trans. Electron. Devices 2013, 60, 3105–3111. [Google Scholar] [CrossRef]
- Altuntas, P.; Lecourt, F.; Cutivet, A.; Defrance, N.; Okada, E.; Lesecq, M.; Rennesson, S.; Agboton, A.; Cordier, Y.; Hoel, V.; et al. Power Performance at 40 GHz of AlGaN/GaN High-Electron Mobility Transistors Grown by Molecular Beam Epitaxy on Si(111) Substrate. IEEE Electron Device Lett. 2015, 36, 303–305. [Google Scholar] [CrossRef]
- Soltani, A.; Gerbedoen, J.C.; Cordier, Y.; Ducatteau, D.; Rousseau, M.; Chmielowska, M.; Ramdani, M.; De Jaeger, J.C. Power performance of AlGaN/GaN high-electron-mobility transistors on (110) silicon substrate at 40 GHz. IEEE Electron Device Lett. 2013, 34, 490–492. [Google Scholar] [CrossRef]
- Medjdoub, F.; Zegaoui, M.; Grimbert, B.; Ducatteau, D.; Rolland, N.; Rolland, P.A. First demonstration of high-power GaN-on-silicon transistors at 40 GHz. IEEE Electron Device Lett. 2012, 33, 1168–1170. [Google Scholar] [CrossRef]
- Marti, D.; Tirelli, S.; Alt, A.R.; Roberts, J.; Bolognesi, C.R. 150-GHz cutoff frequencies and 2-W/mm output power at 40 GHz in a millimeter-wave AlGaN/GaN HEMT technology on silicon. IEEE Electron Device Lett. 2012, 33, 1372–1374. [Google Scholar] [CrossRef]
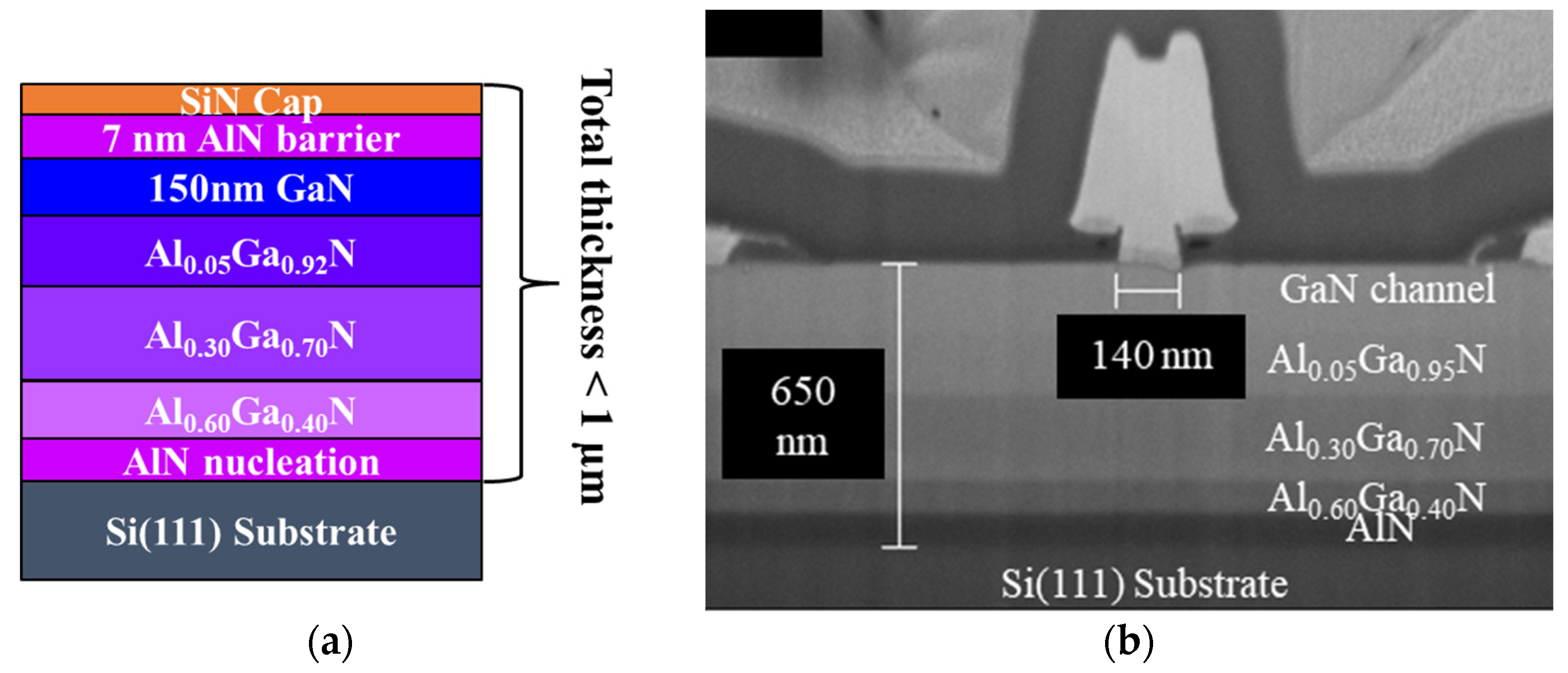
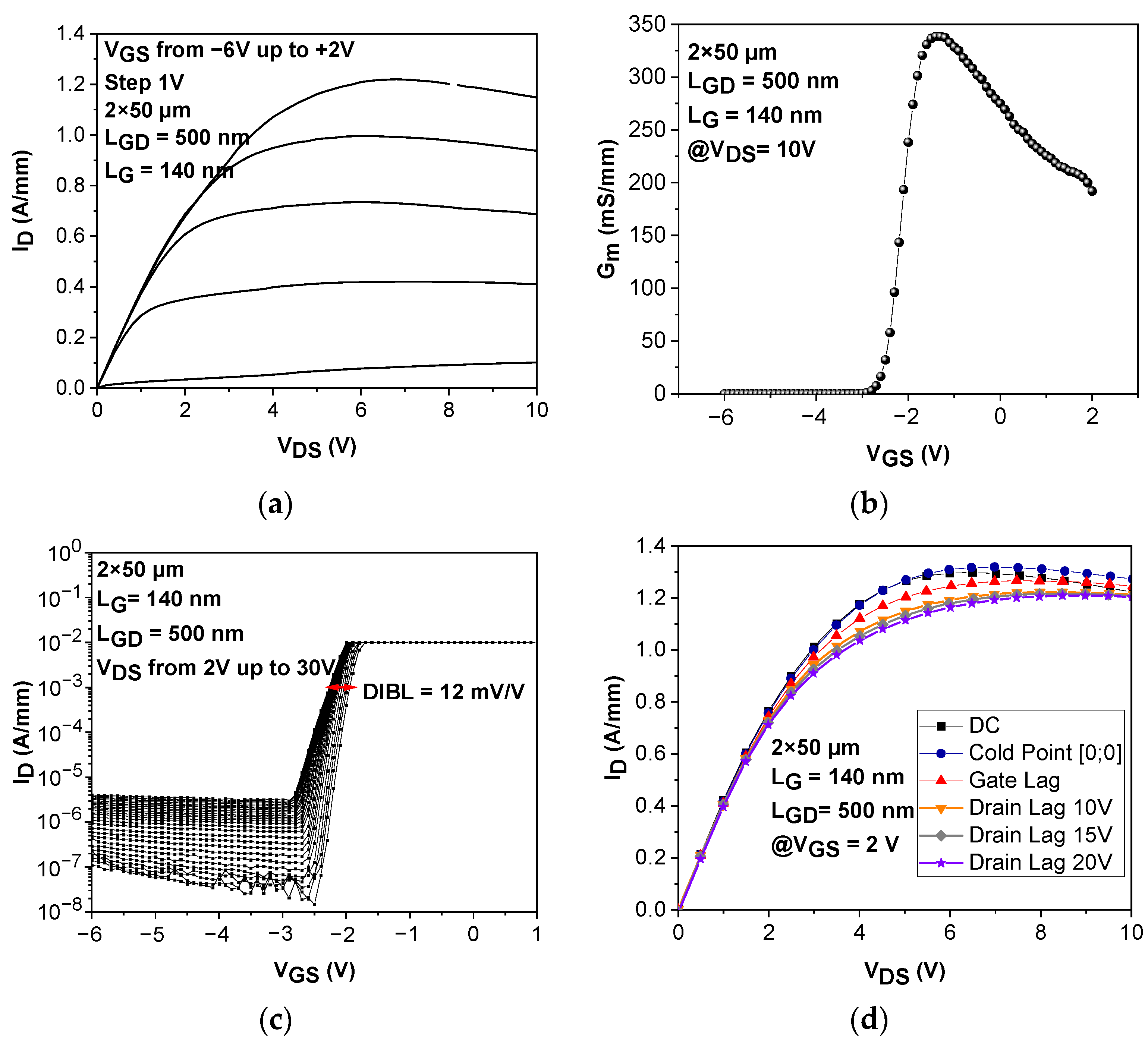

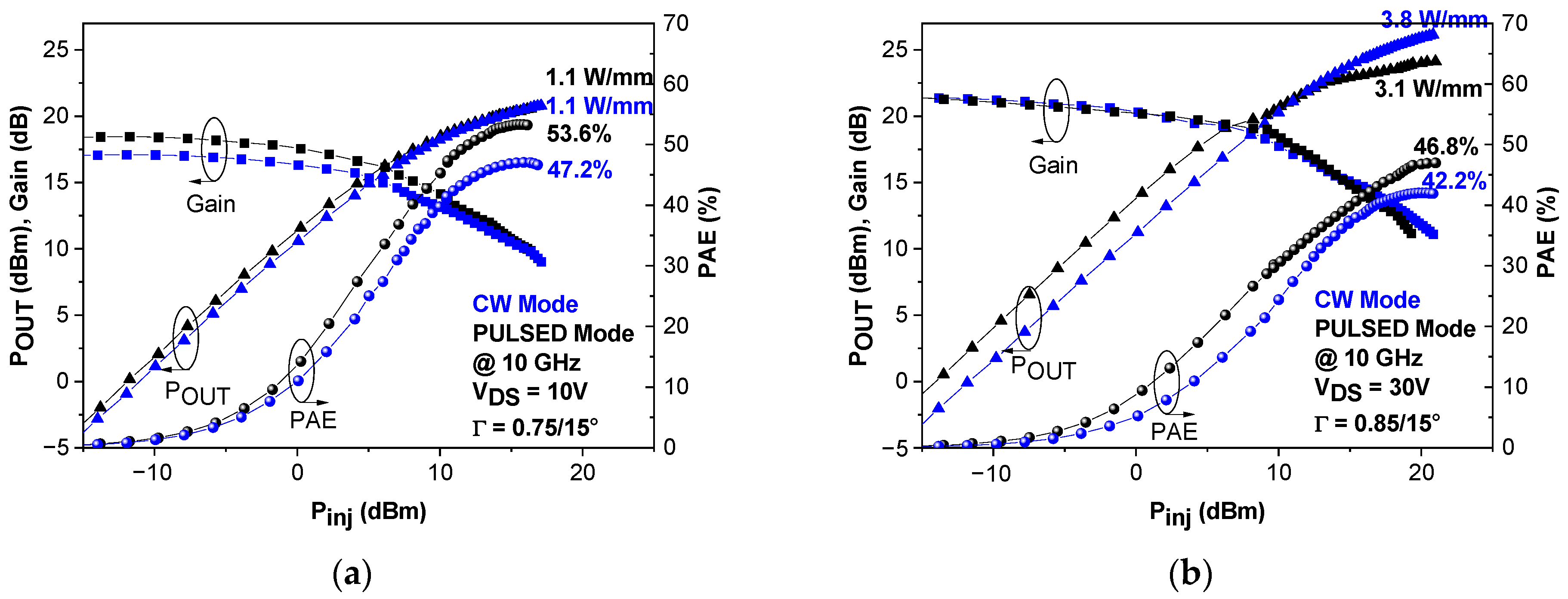
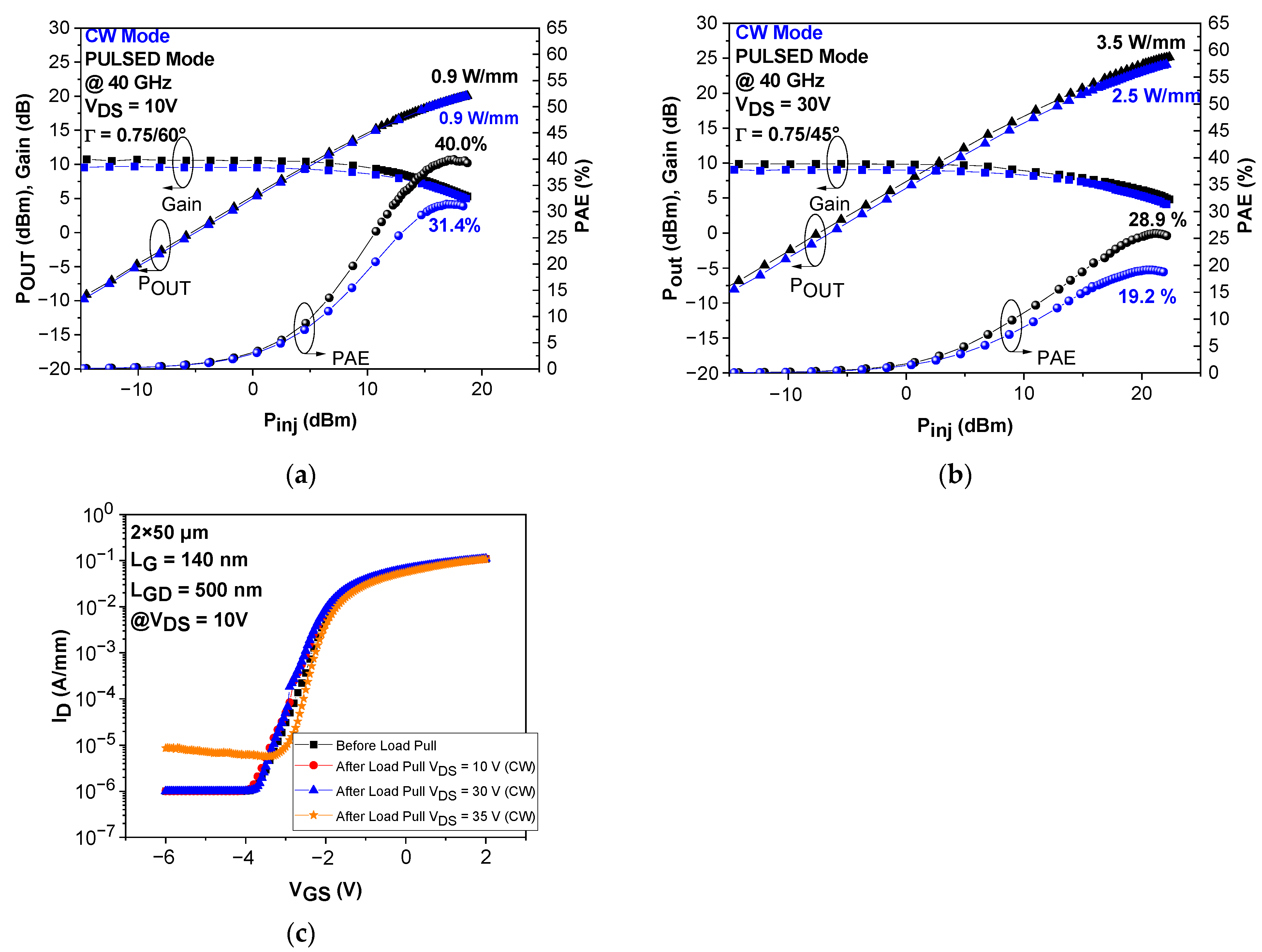
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Carneiro, E.; Rennesson, S.; Tamariz, S.; Harrouche, K.; Semond, F.; Medjdoub, F. Low Trapping Effects and High Blocking Voltage in Sub-Micron-Thick AlN/GaN Millimeter-Wave Transistors Grown by MBE on Silicon Substrate. Electronics 2023, 12, 2974. https://doi.org/10.3390/electronics12132974
Carneiro E, Rennesson S, Tamariz S, Harrouche K, Semond F, Medjdoub F. Low Trapping Effects and High Blocking Voltage in Sub-Micron-Thick AlN/GaN Millimeter-Wave Transistors Grown by MBE on Silicon Substrate. Electronics. 2023; 12(13):2974. https://doi.org/10.3390/electronics12132974
Chicago/Turabian StyleCarneiro, Elodie, Stéphanie Rennesson, Sebastian Tamariz, Kathia Harrouche, Fabrice Semond, and Farid Medjdoub. 2023. "Low Trapping Effects and High Blocking Voltage in Sub-Micron-Thick AlN/GaN Millimeter-Wave Transistors Grown by MBE on Silicon Substrate" Electronics 12, no. 13: 2974. https://doi.org/10.3390/electronics12132974
APA StyleCarneiro, E., Rennesson, S., Tamariz, S., Harrouche, K., Semond, F., & Medjdoub, F. (2023). Low Trapping Effects and High Blocking Voltage in Sub-Micron-Thick AlN/GaN Millimeter-Wave Transistors Grown by MBE on Silicon Substrate. Electronics, 12(13), 2974. https://doi.org/10.3390/electronics12132974






