Effects of Recessed-Gate Structure on AlGaN/GaN-on-SiC MIS-HEMTs with Thin AlOxNy MIS Gate
Abstract
1. Introduction
2. Experimental Methods
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- Mishra, U.K.; Parikh, P.; Wu, Y.-F. AlGaN/GaN HEMTs-An Overview of Device Operation and Applications. Proc. IEEE 2002, 90, 1022–1031. [Google Scholar] [CrossRef]
- Higashiwaki, M.; Mimura, T.; Matsui, T. AlGaN/GaN Heterostructure Field-Effect Transistors on 4H-SiC Substrates with Current-Gain Cutoff Frequency of 190 GHz. Appl. Phys. Express 2008, 1, 021103. [Google Scholar] [CrossRef]
- Lee, M.-S.; Kim, D.; Eom, S.; Cha, H.-Y.; Seo, K.-S. A Compact 30-W AlGaN/GaN HEMTs on Silicon Substrate with Output Power Density of 8.1 W/mm at 8 GHz. IEEE Electron Device Lett. 2014, 35, 995–997. [Google Scholar] [CrossRef]
- Mizuno, S.; Ohno, Y.; Kishimoto, S.; Maezawa, K.; Mizutani, T. Large Gate Leakage Current in AlGaN/GaN High Electron Mobility Transistors. Jpn. J. Appl. Phys. 2002, 41, 5125–5126. [Google Scholar] [CrossRef]
- Kanamura, M.; Kikkawa, T.; Iwai, T.; Imanishi, K.; Kubo, T.; Joshin, K. An Over 100 W n-GaN/n-AlGaN/GaN MIS-HEMT Power Amplifier for Wireless Base Station Applications. In Proceedings of the IEEE International Electron Devices Meeting (IEDM), Washington, DC, USA, 5–7 December 2005. [Google Scholar] [CrossRef]
- Adivarahan, V.; Gaevshi, M.; Sun, W.H.; Fatima, H.; Koudymov, A.; Saygi, S.; Simin, G.; Yang, J.; Khan, M.A.; Tarakji, A.; et al. Submicron Gate Si3N4/AlGaN/GaN-Metal-Insulator-Semiconductor Heterostructure Field-Effect Transistors. IEEE Electron Device Lett. 2003, 24, 541–543. [Google Scholar] [CrossRef]
- Kikuta, D.; Ao, J.P.; Ohno, Y. Gate leakage and electrical performance of AlGaN/GaN MIS-type HFET with evaporated silicon oxide layer. Solid-State Electron. 2006, 50, 316–321. [Google Scholar] [CrossRef]
- Yagi, S.; Shimizu, M.; Inada, M.; Yamamoto, Y.; Piao, G.; Okumura, H.; Yano, Y.; Akutsu, N.; Ohashi, H. High breakdown voltage AlGaN/GaN MIS-HEMT with SiN and TiO2 gate insulator. Solid-State Electron. 2006, 50, 1057–1061. [Google Scholar] [CrossRef]
- LaRoche, J.; Hoke, W.; Altman, D.; McClymonds, J.; Alcorn, P.; Smith, K.; Chumbes, E.; Letaw, J.; Kazior, T. Performance and Reliability of GaN MISHEMTs and MMIC Fabricated from GaN Grown on High Resistance <111> Si Substrates by Molecular Beam Epitaxy. In Proceedings of the International Conference on Compound Semiconductor Manufacturing Technology (CS MANTECH), New Orleans, LA, USA, 13–16 May 2013; pp. 345–348. [Google Scholar]
- Khan, M.A.; Hu, X.; Tarakji, A.; Simin, G.; Yang, J.; Gaska, R.; Shur, M.S. AlGaN/GaN metal-oxide-semiconductor heterostructure field-effect transistors on SiC substrates. Appl. Phys. Lett. 2000, 77, 1339–1341. [Google Scholar] [CrossRef]
- Hu, X.; Koudymov, A.; Simin, G.; Yang, J.; Khan, M.A.; Tarakji, A.; Shur, M.S.; Gaska, R. Si3N4/AlGaN/GaN-metal-insulator-semiconductor heterostructure field-effect transistors. Appl. Phys. Lett. 2001, 79, 2832–2834. [Google Scholar] [CrossRef]
- Hashizume, T.; Ootomo, S.; Hasegawa, H. Al2O3-based surface passivation and insulated gate structure for AlGaN/GaN HFETs. Phys. Status Solidi (C) 2001, 0, 2380–2384. [Google Scholar] [CrossRef]
- Kawano, A.; Kishimoto, S.; Ohno, Y.; Maezawa, K.; Mizutani, T.; Ueno, H.; Ueda, T.; Tanaka, T. AlGaN/GaN MIS-HEMTs with HfO2 gate insulator. Phys. Status Solidi (C) 2007, 7, 2700–2703. [Google Scholar] [CrossRef]
- Mehandru, R.; Luo, B.; Kim, J.; Ren, F.; Gila, B.P.; Onstine, A.H.; Abernathy, C.R.; Pearton, S.J.; Gotthold, D.; Birkhahn, R.; et al. AlGaN/GaN metal-oxide-semiconductor high electron mobility transistors using Sc2O3 as the gate oxide and surface passivation. Appl. Phys. Lett. 2003, 82, 2530–2532. [Google Scholar] [CrossRef]
- Khan, M.A.; Hu, X.; Sumin, S.; Lunev, A.; Yang, J.; Shur, M.S. AlGaN/GaN Metal Oxide Semiconductor Heterostructure Field Effect Transistor. IEEE Electron Device Lett. 2000, 21, 63–65. [Google Scholar] [CrossRef]
- Park, K.-Y.; Cho, H.-I.; Choi, H.-C.; Bae, Y.-H.; Lee, C.-S.; Lee, J.-L.; Lee, J.-H. Device Characteristics of AlGaN/GaN MIS-HFET Using Al2O3-HfO2 Laminated High-k Dielectric. Jpn. J. Appl. Phys. 2004, 43, L1433–L1435. [Google Scholar] [CrossRef]
- Marso, M.; Heidelberger, G.; Indlekofer, K.M.; Bernát, J.; Fox, A.; Korodoš, P.; Lüth, H. Origin of Improved RF Performance of AlGaN/GaN MOSHFETs Compared to HFETs. IEEE Trans. Electron Devices 2006, 53, 1517–1523. [Google Scholar] [CrossRef]
- Maroldt, S.; Haupt, C.; Pletschen, W.; Müller, S.; Quay, R.; Ambacher, O.; Schippel, C.; Schwierz, F. Gate-Recessed AlGaN/GaN Based Enhancement-Mode Electron Mobility Transistors for High Frequency Operation. Jpn. J. Appl. Phys. 2009, 48, 04C083. [Google Scholar] [CrossRef]
- Kim, D.-H.; Park, H.; Eom, S.-K.; Jeong, J.-S.; Cha, H.-Y.; Seo, K.-S. Ka-Band MMIC Using AlGaN/GaN-on-Si With Recessed High-k Dual MIS Structure. IEEE Electron Device Lett. 2018, 39, 995–998. [Google Scholar] [CrossRef]
- Downey, B.P.; Meyer, D.J.; Katzer, D.S.; Roussos, J.A.; Pan, M.; Gao, X. SiNx/InAlN/AlN/GaN MIS-HEMTs With 10.8 THz·V Johnson Figure of Merit. IEEE Electron Device Lett. 2014, 35, 527–529. [Google Scholar] [CrossRef]
- Fletcher, A.S.A.; Nirmal, D.; Arivazhagan, L.; Ajayan, J.; Varghese, A. Enhancement of Johnson figure of merit in III-V HEMT combined with discrete field plate and AlGaN blocking layer. Int. J. RF Microw. Comput. Aided Eng. 2020, 30, 22040. [Google Scholar] [CrossRef]
- Kang, M.-J.; Eom, S.-K.; Kim, H.-S.; Lee, C.-H.; Cha, H.-Y.; Seo, K.-S. Normally-off recessed-gate AlGaN/GaN MOS-HFETs with plasma enhanced atomic layer deposited AlOxNy gate insulator. Semicond. Sci. Technol. 2019, 34, 055018. [Google Scholar] [CrossRef]
- Nakazawa, S.; Shin, H.-A.; Tsurumi, N.; Anda, Y.; Hatsuda, T.; Ueda, T.; Nozaki, M.; Yamada, T.; Hosoi, T.; Shimura, T.; et al. Fast Switching Performance by 20 A/730 V AlGaN/GaN MIS-HEMT Using AlON Gate Insulator. In Proceedings of the IEEE International Electron Devices Meeting (IEDM), San Francisco, CA, USA, 2–6 December 2017. [Google Scholar] [CrossRef]
- Hosoi, T.; Watanabe, K.; Nozaki, M.; Yamada, T.; Shimura, T.; Watanabe, H. Mobility enhancement in recessed-gate AlGaN/GaN MOS-HFETs using an AlON gate insulator. Jpn. J. Appl. Phys. 2019, 58, SCCD16. [Google Scholar] [CrossRef]
- Her, J.-C.; Cho, H.-J.; Yoo, C.-S.; Cha, H.-Y.; Oh, J.-E.; Seo, K.-S. SiNx Prepassivation of AlGaN/GaN High-Electron-Mobility Transistors Using Remote-Mode Plasma-Enhanced Chemical Vapor Deposition. Jpn. J. Appl. Phys. 2010, 49, 041002. [Google Scholar] [CrossRef]
- Lee, N.-H.; Lee, M.; Choi, W.; Kim, D.; Jeon, N.; Choi, S.; Seo, K.-S. Effects of various surface treatments on gate leakage, subthreshold slope, and current collapse in AlGaN/GaN high-electron-mobility transistors. Jpn. J. Appl. Phys. 2014, 53, 4. [Google Scholar] [CrossRef]
- Schroder, D.K. Semiconductor Material and Device Characterization, 3rd ed.; John Wiley & Sons: Hoboken, NJ, USA, 2006; pp. 347–350. [Google Scholar]
- Dehan, M. Characterization and Modeling of SOI RF Integrated Components; Presses Universitaires de Louvain: Louvain-la-Neuve, Belgium, 2003; pp. 103–107. [Google Scholar]
- Dumka, D.C.; Lee, C.; Tserng, H.Q.; Saunier, P. RF reliability performance of AlGaN/GaN HEMTs onSi substate at 10 GHz. Elect. Lett. 2004, 40, 1554–1556. [Google Scholar] [CrossRef]
- Johnson, J.W.; Piner, E.L.; Vescan, A.; Therrien, R.; Rajagopal, P.; Roberts, J.C.; Brown, J.D.; Singhal, S.; Linthicum, K.J. 12 W/mm AlGaN-GaN HFETs on Silicon Substrates. IEEE Electron Device Lett. 2004, 25, 459–461. [Google Scholar] [CrossRef]
- Yoshida, S.; Tanomura, M.; Murase, Y.; Yamanoguchi, K.; Ota, K.; Matsunaga, K.; Shimawaki, H. A 76 GHz GaN-on-Silicon Power Amplifier for Automotive Radar System. In Proceedings of the 2009 IEEE MTT-S International Microwave Symposium Digest, Boston, MA, USA, 7–12 June 2009; pp. 665–668. [Google Scholar] [CrossRef]
- Hoshi, S.; Itoh, M.; Marui, T.; Okita, H.; Morino, Y.; Tamai, I.; Toda, F.; Seki, S.; Egawa, T. 12.88 W/mm GaN High Electron Mobility Transistor on Silicon Substrate for High Voltage Operation. Appl. Phys. Express 2009, 2, 061001. [Google Scholar] [CrossRef]
- Sun, H.; Alt, A.R.; Benedickter, H.; Bolognesi, C.R.; Feltin, E.; Carlin, J.-F.; Gonschorek, M.; Grandjean, N. Ultrahigh-Speed AlInN/GaN High Electron Mobility Transistors Grown on (111) High-Resistivity Silicon with FT = 143 GHz. Appl. Phys. Express 2010, 2, 094101. [Google Scholar] [CrossRef]
- Shinohara, K.; Regan, D.C.; Tang, Y.; Corrion, A.L.; Brown, D.F.; Wong, J.C.; Robinson, J.F.; Fung, H.H.; Schmitz, A.; Oh, T.C.; et al. Scaling of GaN HEMTs and Schottky Didoes for Submillimeter-Wave MMIC Applications. IEEE Trans. Electron Devices 2013, 60, 2982–2996. [Google Scholar] [CrossRef]
- Schuette, M.L.; Ketterson, A.; Song, B.; Beam, D.; Chou, T.-M.; Pilla, M.; Tserng, H.-Q.; Gao, X.; Guo, S.; Fay, P.J.; et al. Gate-Recessed Integrated E/D GaN HEMT Technology With fT/fmax > 300 GHz. IEEE Electron Device Lett. 2013, 34, 741–743. [Google Scholar] [CrossRef]
- Medjdoub, F.; Grimbert, B.; Ducatteau, D.; Rolland, N. Record Combination of Power-Gain Cut-Off Frequency and Three-Terminal Breakdown Voltage for GaN-on-Silicon Devices. Appl. Phys. Express 2013, 6, 044001. [Google Scholar] [CrossRef]
- Arulkumaran, S.; Ng, G.I.; Vicknesh, S.; Wang, H.; Ang, K.S.; Kumar, C.M.; Teo, K.L.; Ranjan, K. Demonstration of Submicron-Gate AlGaN/GaN High-Electron-Mobility Transistors on Silicon with Complementary Metal-Oxide-Semiconductor-Compatible Non-Gold Metal Stack. Appl. Phys. Express 2013, 6, 016501. [Google Scholar] [CrossRef]
- Arulkumaran, S.; Ng, G.I.; Vicknesh, S. Enhanced Breakdown Voltage with High Johnson’s Figure-of-Merit in 0.3-μm T-gate AlGaN/GaN HEMTs on Silicon by (NH4)2Sx Treatment. IEEE Electron Device Lett. 2013, 34, 1364–1366. [Google Scholar] [CrossRef]
- Ranjan, K.; Arulkumaran, S.; Ng, G.I.; Vicknesh, S. High Johnson’s figure of merit (8.32 THz·V) in 0.15-μm conventional T-gate AlGaN/GaN HEMTs on silicon. Appl. Phys. Express 2014, 7, 044102. [Google Scholar] [CrossRef]
- Huang, S.; Wei, K.; Liu, G.; Zheng, Y.; Wang, X.; Pang, L.; Kong, X.; Liu, X.; Tang, Z.; Yang, S.; et al. High-fMAX High Johnson’s Figure-of-Merit 0.2-μm Gate AlGaN/GaN HEMTs on Silicon Substrate With AlN/SiNx Passivation. IEEE Electron Device Lett. 2014, 35, 315–317. [Google Scholar] [CrossRef]
- Tsou, C.-W.; Lin, C.-Y.; Lian, Y.-W.; Hsu, S.S.H. 101-GHz InAlN/GaN HEMTs on Silicon with High Johnson’s Figure-of-Merit. IEEE Trans. Electron Devices 2015, 62, 2675–2678. [Google Scholar] [CrossRef]
- Yang, L.; Mi, M.; Hou, B.; Zhang, H.; Zhu, J.; Zhu, Q.; Lu, Y.; Zhang, M.; He, Y.; Chen, L.; et al. Enhanced gm and fT With High Johnson’s Figure-of-Merit in Thin Barrier AlGaN/GaN Figure-of-Merit in Thin Barrier AlGaN/GaN HEMTs by TiN-Based Source Contact Ledge. IEEE Electron Device Lett. 2017, 38, 1563–1566. [Google Scholar] [CrossRef]
- Fletcher, A.S.A.; Nirmal, D.; Ajayan, J.; Arivazhagan, L. Analysis of AlGaN/GaN HEMT using discrete field plate technique for high power and high frequency applications. Int. J. Electron. Commun. 2019, 99, 325–330. [Google Scholar] [CrossRef]
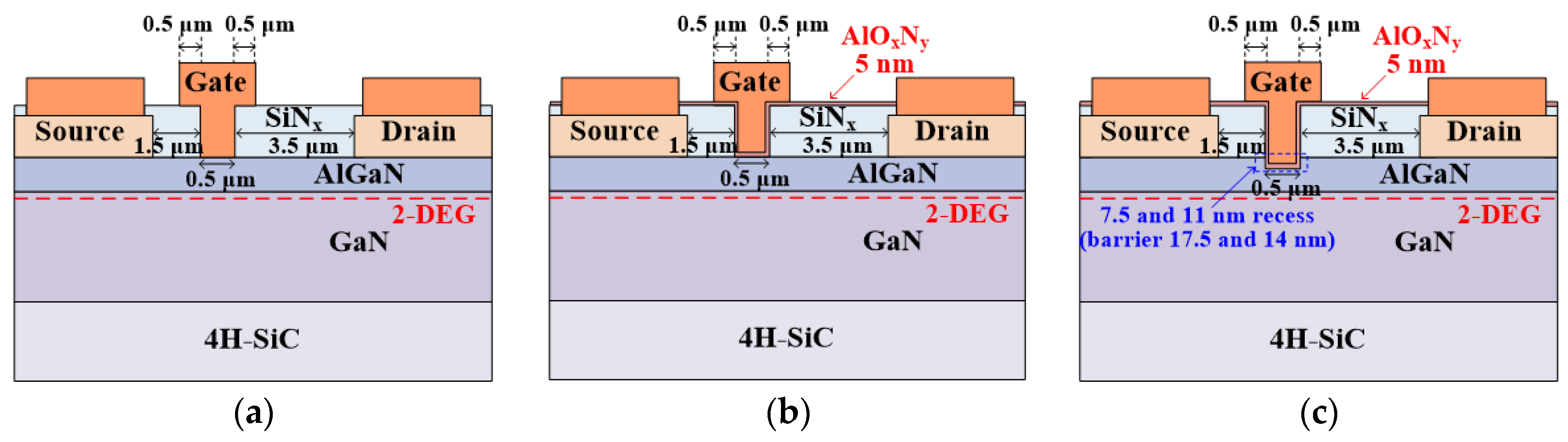
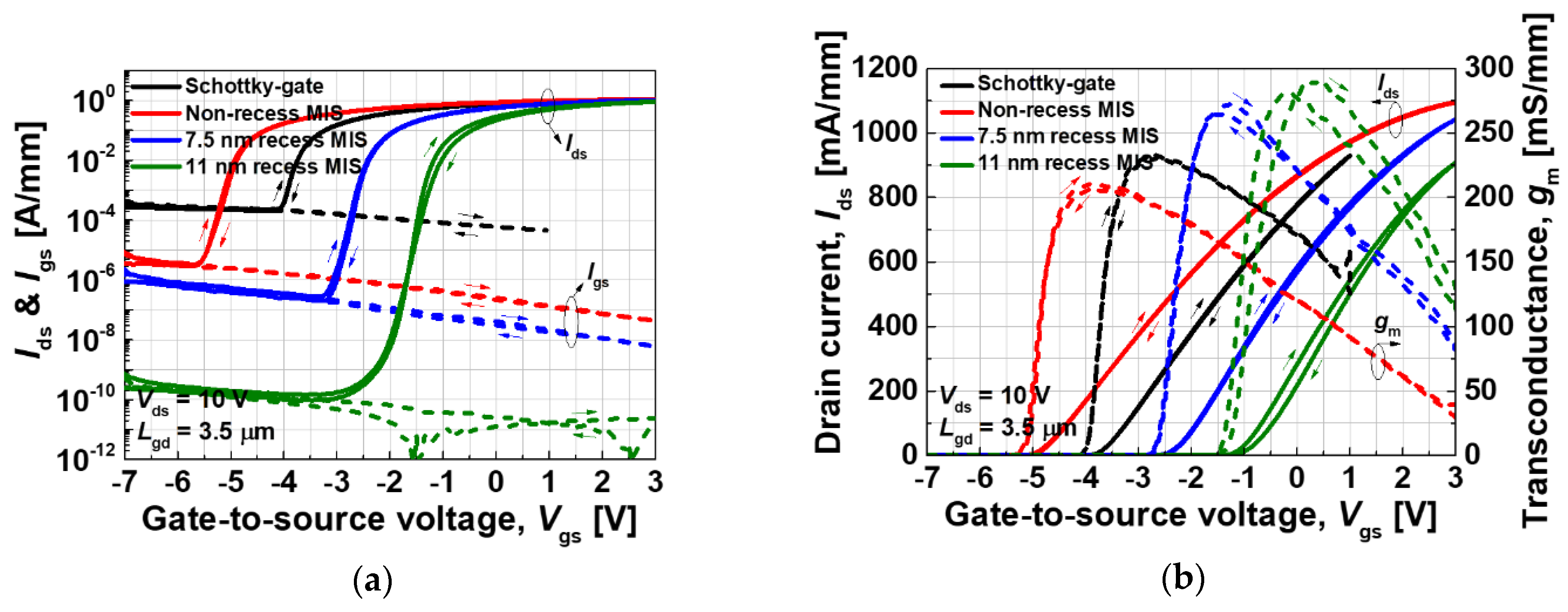








© 2020 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Kim, H.-S.; Kang, M.-J.; Kim, J.J.; Seo, K.-S.; Cha, H.-Y. Effects of Recessed-Gate Structure on AlGaN/GaN-on-SiC MIS-HEMTs with Thin AlOxNy MIS Gate. Materials 2020, 13, 1538. https://doi.org/10.3390/ma13071538
Kim H-S, Kang M-J, Kim JJ, Seo K-S, Cha H-Y. Effects of Recessed-Gate Structure on AlGaN/GaN-on-SiC MIS-HEMTs with Thin AlOxNy MIS Gate. Materials. 2020; 13(7):1538. https://doi.org/10.3390/ma13071538
Chicago/Turabian StyleKim, Hyun-Seop, Myoung-Jin Kang, Jeong Jin Kim, Kwang-Seok Seo, and Ho-Young Cha. 2020. "Effects of Recessed-Gate Structure on AlGaN/GaN-on-SiC MIS-HEMTs with Thin AlOxNy MIS Gate" Materials 13, no. 7: 1538. https://doi.org/10.3390/ma13071538
APA StyleKim, H.-S., Kang, M.-J., Kim, J. J., Seo, K.-S., & Cha, H.-Y. (2020). Effects of Recessed-Gate Structure on AlGaN/GaN-on-SiC MIS-HEMTs with Thin AlOxNy MIS Gate. Materials, 13(7), 1538. https://doi.org/10.3390/ma13071538




