Raman Scattering Study on the Influence of E-Beam Bombardment on Si Electron Lens
Abstract
1. Introduction
2. Results
2.1. Raman Spectra of MEMS Si Electron Lens Irradiated with Electron Beam
2.2. Raman Spectra of Carbon Rod and Carbon Deposited Si
2.3. XPS Analysis of MEMS Si Electron Lens Irradiated with Electron Beam
3. Discussion
4. Materials and Methods
4.1. Microcolumn Lens Electrode Fabrication Process
4.2. Raman Spectroscopy
4.3. Electron Beam Irradiation to Silicon Electron Lens through EPMA
5. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
Sample Availability
References
- Oh, T.S.; Kim, D.W.; Ahn, S.J.A.; Kim, Y.C.; Kim, H.S.; Ahn, S.J. Optimization of Electrostatic Lens Systems for Low-Energy Scanning Microcolumn Applications. J. Vac. Sci. Technol. A 2008, 26, 1443–1449. [Google Scholar] [CrossRef]
- Kim, H.S.; Ahn, S.J.; Kim, D.W.; Oh, T.S.; Ahn, S.J. Efficient Electron Beam Condensing for Low-Energy Micro-Column Lithography. Microelectron. J. 2008, 39, 94–98. [Google Scholar] [CrossRef]
- Kratschmer, E.; Kim, H.S.; Thomson, M.G.R.; Lee, K.Y.; Rishton, S.A.; Yu, M.L.; Zolgharnain, S.; Hussey, B.W.; Chang, T.H.P. Experimental evaluation of a 20 × 20 mm footprint microcolumn. J. Vac. Sci. Technol. A 1996, 14, 3792–3796. [Google Scholar] [CrossRef]
- Lee, Y.B.; Kim, H.W.; Kim, D.W.; Ahn, S.J.; Kim, H.S. The Design and Fabrication of a Wafer-Scale Microlens for Multiple Microcolumns. J. Multifunct. Mater. Photosci. 2020, 11, 207–212. [Google Scholar]
- Reimer, L. Transmission Electron Microscopy-Physics of Image Formation and Microanalysis, 3rd ed.; Springer: Berlin, Germany, 1993; pp. 457–463. [Google Scholar]
- Reimer, L.; Wächter, M. Contribution to the Contamination Problem in Transmission Electron Microscopy. Ultramicroscopy 1978, 3, 169–174. [Google Scholar] [CrossRef]
- Lau, D.; Hughes, A.E.; Muster, T.H.; Davis, T.J.; Glenn, A.M. Electron-Beam-Induced Carbon Contamination on Silicon: Characterization Using Raman Spectroscopy and Atomic Force Microscopy. Microsc. Microanal. 2010, 16, 13–20. [Google Scholar] [CrossRef]
- Kim, Y.M.; Choi, J.H.; Song, K.; Kim, Y.S.; Kim, Y.J. Experimentally Minimized Contaminative Condition of Carbonaceous Artifacts in Transmission Electron Microscope, Korean. J. Microsc. 2009, 39, 73–77. [Google Scholar]
- Wei, X.L.; Liu, Y.; Chen, Q.; Peng, L.M. Controlling Electron-Beam-Induced Carbon Deposition on Carbon Nanotubes by Joule Heating. Nanotechnology 2008, 19, 355304. [Google Scholar] [CrossRef]
- No, J.H.; Lee, T.K. Rapid Bacterial Identification Using Raman Spectroscopy. Korean J. Microbiol. 2017, 53, 71–78. [Google Scholar]
- Yoo, W.S.; Kim, J.H.; Han, S.M. Multiwavelength Raman Characterization of Silicon Stress near Through-Silicon vias and Its Inline Monitoring Applications. J. Micro/Nanolithogr. MEMS MOEMS 2014, 13, 011205. [Google Scholar] [CrossRef]
- Adu, K.W.; Williams, M.D.; Reber, M.; Jayasingha, R.; Gutierrez, H.R.; Sumanasekera, G.U. Probing Phonos in Nonpolar Semiconducting Nanowires with Raman Spectroscopy. J. Nanotechnol. 2012, 2012, 1–18. [Google Scholar] [CrossRef]
- Thomsen, C.; Reich, S. Double Resonant Raman Scattering in Graphite. Phys. Rev. Lett. 2000, 85, 5214–5217. [Google Scholar] [CrossRef] [PubMed]
- Wang, Y.; Alsmeyer, D.C.; McCreery, R.L. Raman Spectroscopy of Carbon Materials: Structural Basis of ObservedSpectra. Chem. Mater. 1990, 2, 557–563. [Google Scholar] [CrossRef]
- Vidano, R.; Fischbach, D.B. New Lines in the Raman Spectra of Carbons and Graphite. J. Am. Ceram. Soc. 1978, 61, 13–17. [Google Scholar] [CrossRef]
- Nemanich, R.J.; Solin, S.A. First- and Second-Order Raman Scattering from Finite-Size Crystals of Graphite. Phys. Rev. B 1979, 20, 392–401. [Google Scholar] [CrossRef]
- Nemanich, R.J.; Solin, S.A. Observation of an Anomolously Sharp Feature in the 2nd Order Raman Spectrum of Graphite. Solid State Commun. 1977, 23, 417–420. [Google Scholar] [CrossRef]
- Tuinstra, F.; Koenig, J.L. Raman Spectrum of Graphite. J. Chem. Phys. 1970, 53, 1126–1130. [Google Scholar] [CrossRef]
- Dresselhaus, M.S.; Dresselhaus, G.; Saito, R.; Jorio, A. Raman Spectroscopy of Carbon Nanotubes. Phys. Rep. 2005, 409, 47–99. [Google Scholar] [CrossRef]
- Sapirstein, V.; Yang, Y.; Zhou, W.L.; Lashmore, D.; Schauer, M. Raman Analysis of Single-Walled Carbon Nanotube (SWCNT) Films. Spectroscopy 2007, 22, 19. [Google Scholar]
- Kim, H.G.; Kim, Y.S.; Kwac, L.K.; Shin, H.K. Characterization of Activated Carbon Paper Electrodes Prepared by Rice Husk-Isolated Cellulose Fibers for Supercapacitor Applications. Molecules 2020, 25, 3951. [Google Scholar] [CrossRef] [PubMed]
- David, S.J.; Supriya, S.K.; Nitesh, M.; Michael, A.V.; Andrew, E.D.; Mark, H.E.; Matthew, R.L. Silicon (100)/SiO2 by XPS. Surf. Sci. Spectra 2013, 20, 36–42. [Google Scholar]
- Yoo, W.S.; Kang, K.T.; Kim, J.G.; Ishigaki, T. Image-Based Dimensional Analysis for Semiconductor and MEMS Structures. In Proceedings of the 2019 International Conference on Frontiers of Characterization and Metrology for Nanoelectronics (FCMN), Monterey, CA, USA, 2–4 April 2019; Volume 2020, pp. 1–3. [Google Scholar]
- Yoo, W.S.; Ishigaki, T.; Kang, K.T. Image Processing Software Assisted Quantitative Analysis of Various Digital Images in Process Monitoring, Process Control and Material Characterization. In Proceedings of the 2017 International Conference on Frontiers of Characterization and Metrology for Nanoelectronics (FCMN), Monterey, CA, USA, 20–23 March 2017; Volume 2020, pp. 1–4. [Google Scholar]
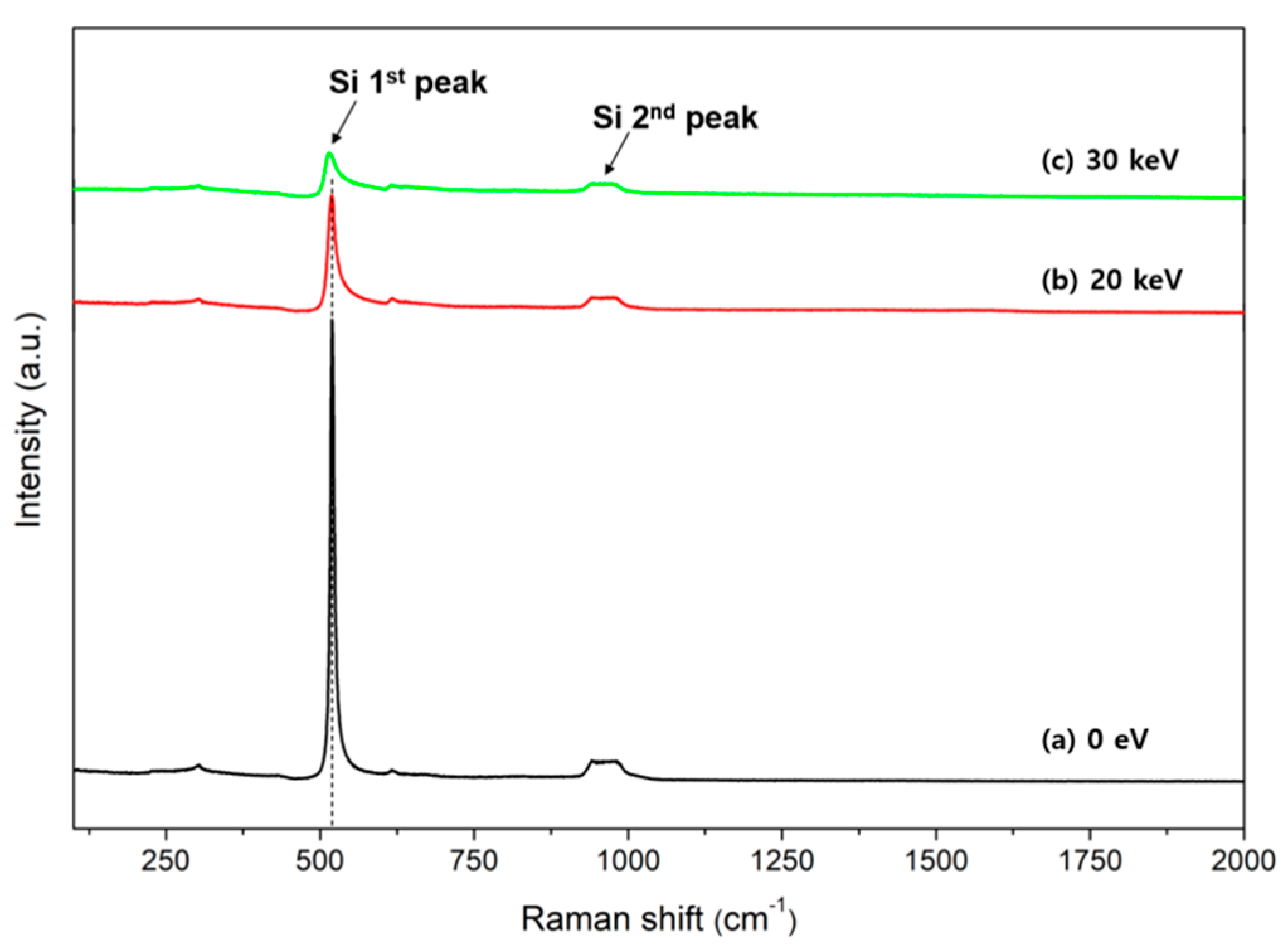
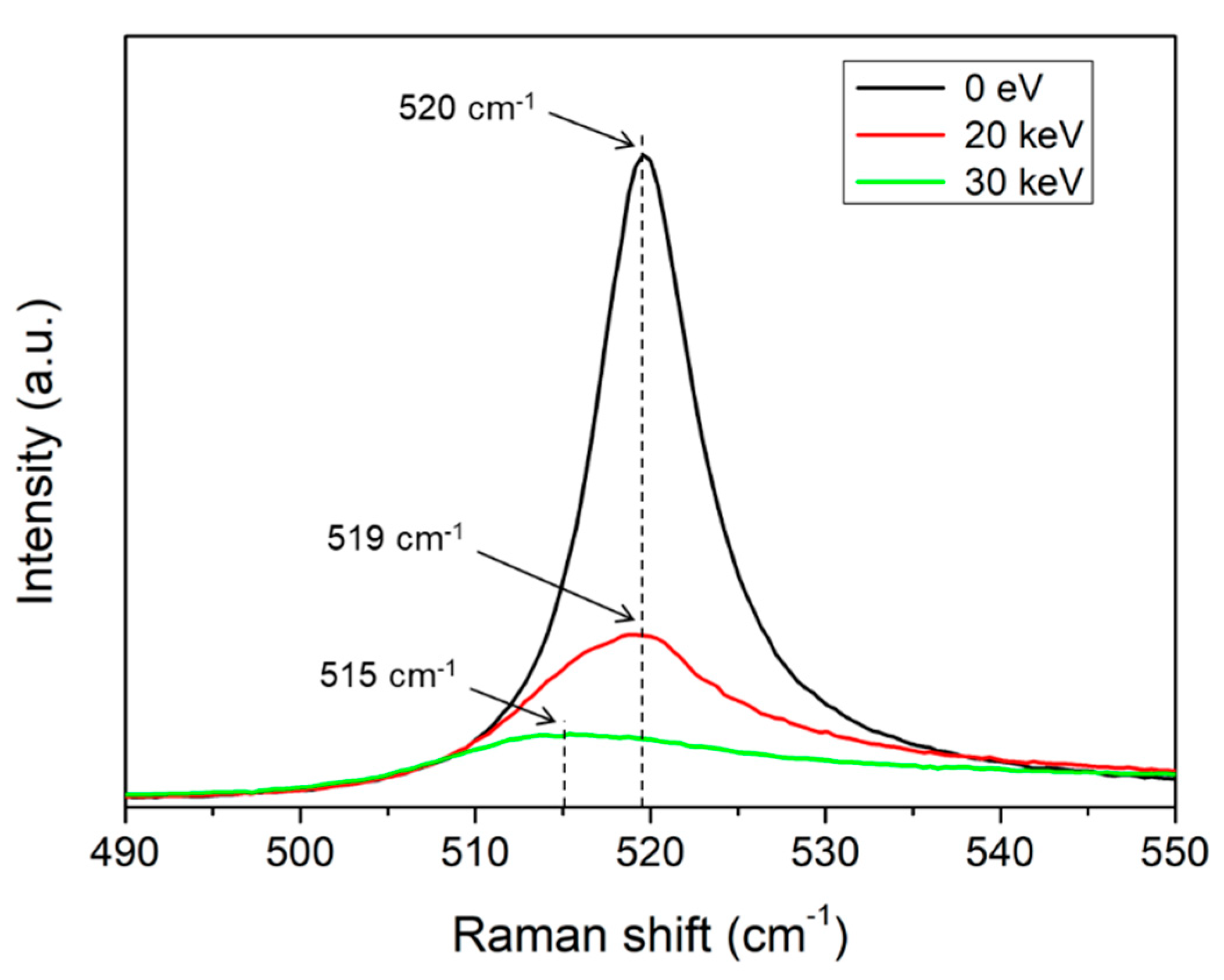

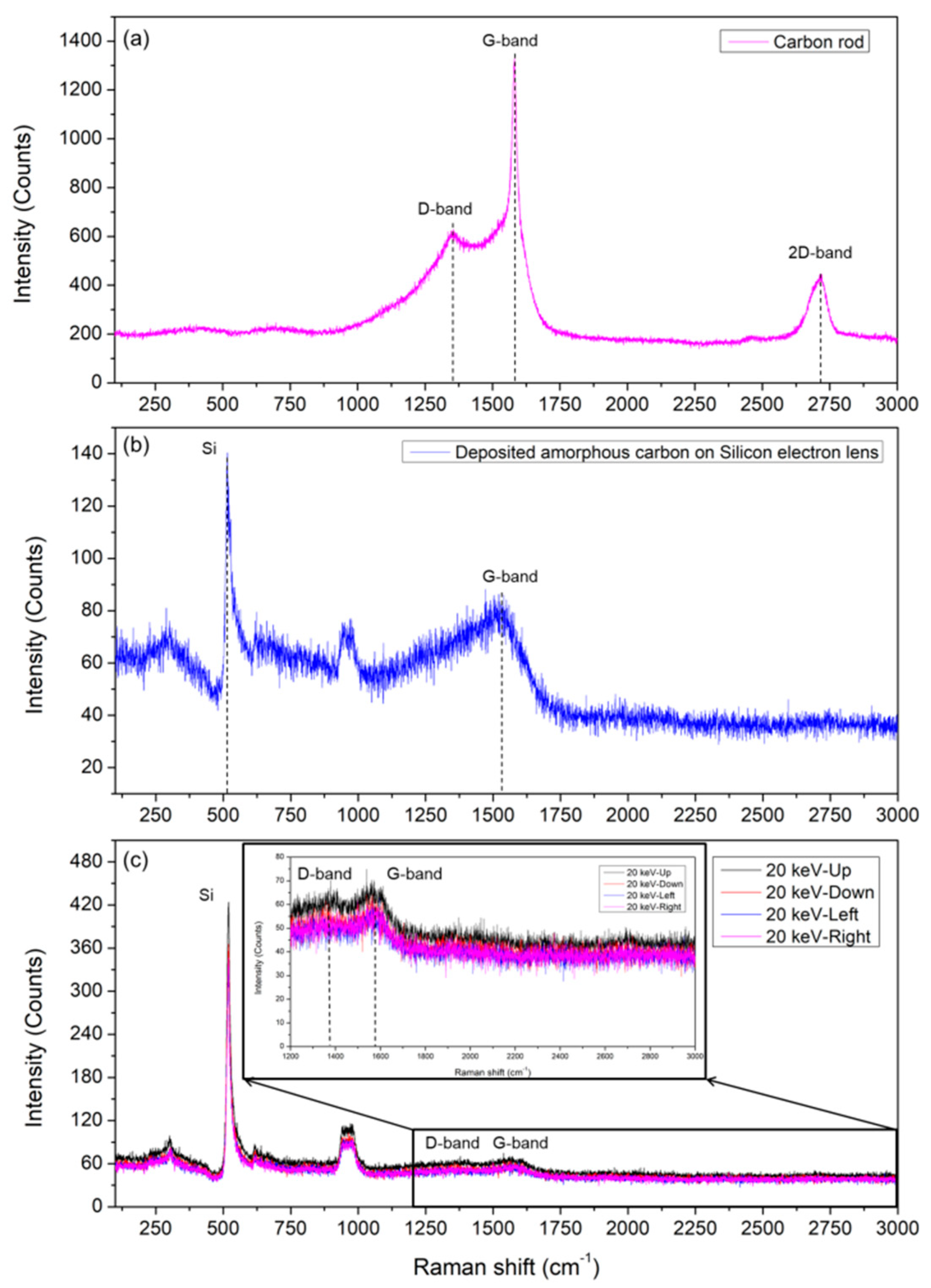

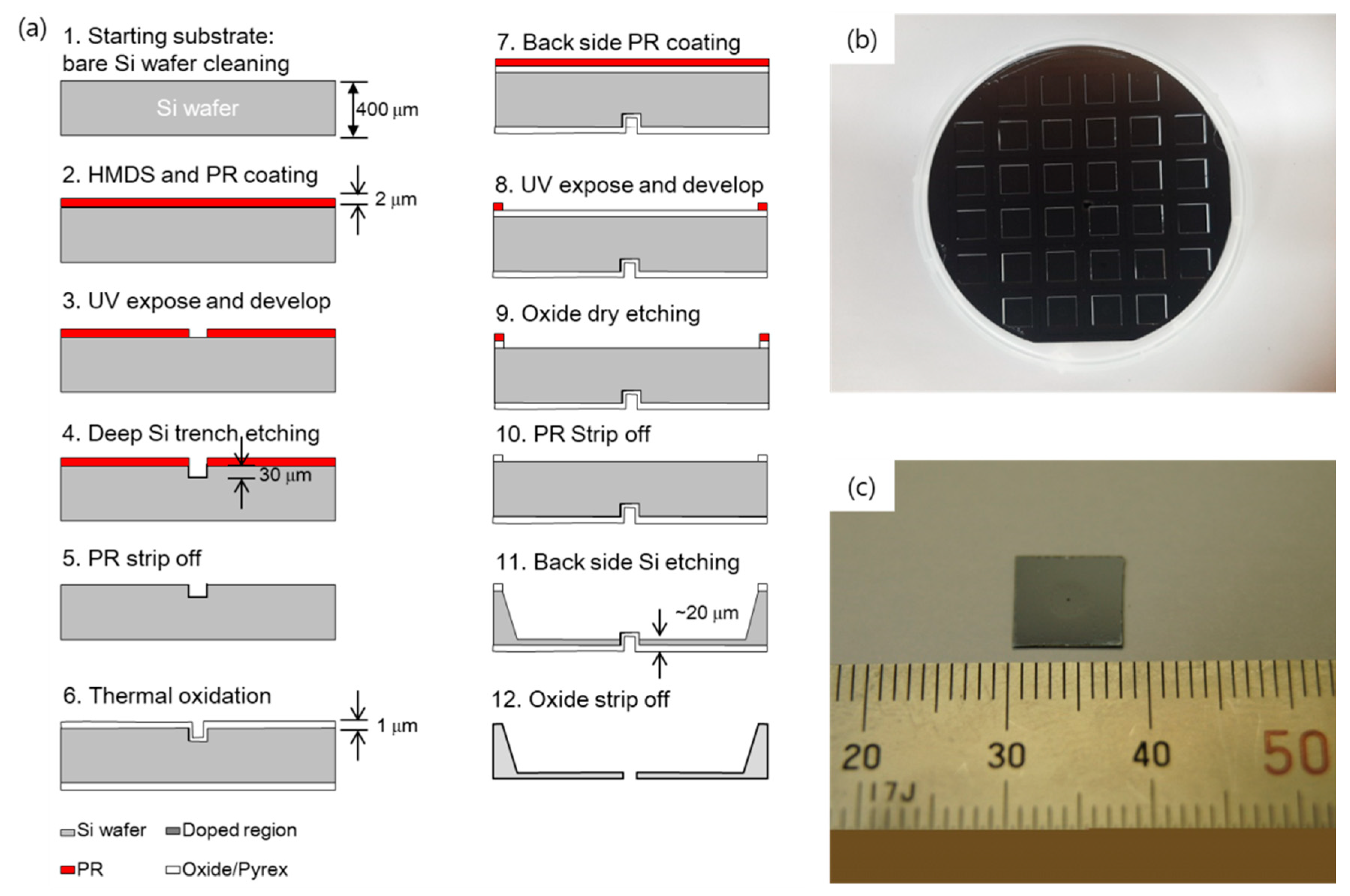
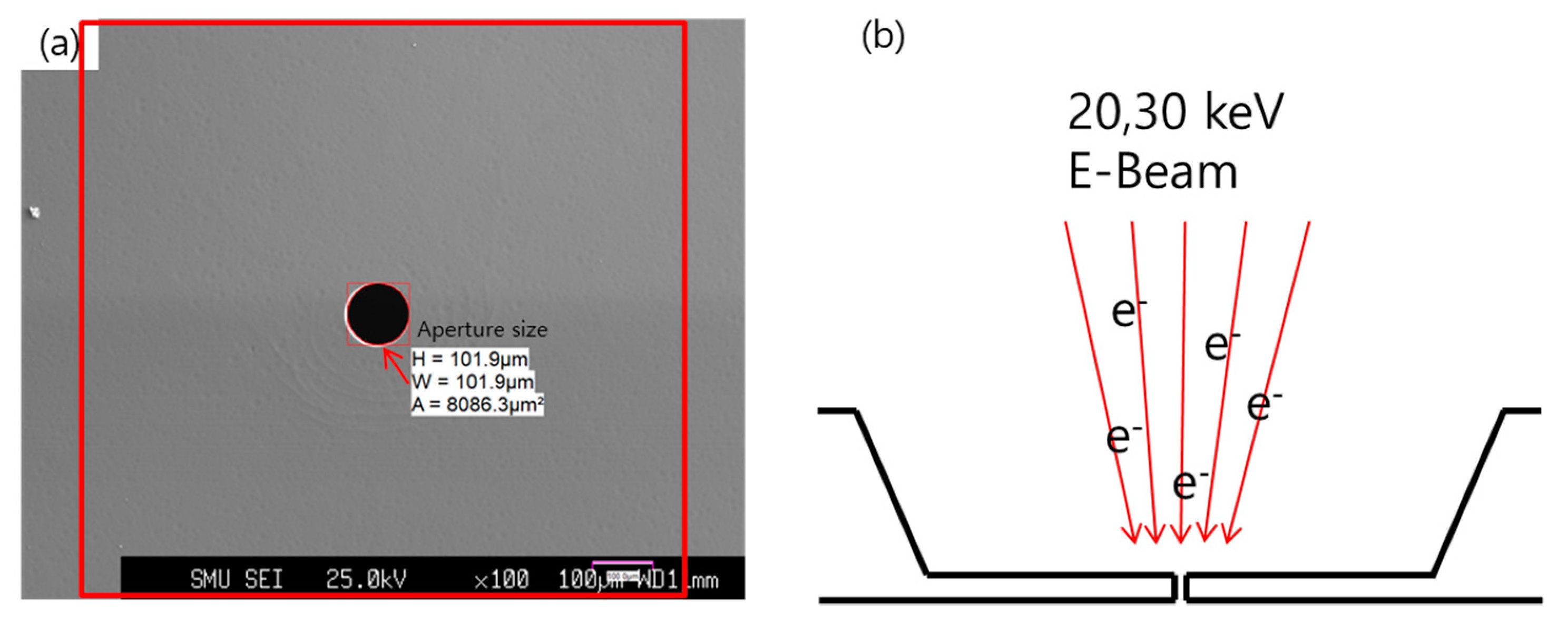
| XPS Sample | Elemental Composition (%) | C 1s | Si 2p | O 1s | Na 1s | |||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Si | C | O | Na | C-C | C-O | C=O | SiO2 | Si 2p1 | Si 2p3 | C-O | C=O | SiO2 | Na 1s | |
| 0 eV | 31.4 | 36.7 | 29.4 | 2.5 | 24.4 | 4.5 | - | 14.3 | 0 | 17.6 | 5.2 | - | 31.6 | 4.1 |
| 20 keV | 1.5 | 88.9 | 9.6 | - | 76.2 | 12.5 | - | 0.9 | 0 | 0.6 | 1.7 | - | 8.1 | - |
| 30 keV | - | 78.0 | 22.0 | - | 52.4 | 17.7 | 7.9 | - | - | - | 11.6 | 10.4 | - | - |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Lee, G.-W.; Lee, Y.-B.; Baek, D.-H.; Kim, J.-G.; Kim, H.-S. Raman Scattering Study on the Influence of E-Beam Bombardment on Si Electron Lens. Molecules 2021, 26, 2766. https://doi.org/10.3390/molecules26092766
Lee G-W, Lee Y-B, Baek D-H, Kim J-G, Kim H-S. Raman Scattering Study on the Influence of E-Beam Bombardment on Si Electron Lens. Molecules. 2021; 26(9):2766. https://doi.org/10.3390/molecules26092766
Chicago/Turabian StyleLee, Geon-Woo, Young-Bok Lee, Dong-Hyun Baek, Jung-Gon Kim, and Ho-Seob Kim. 2021. "Raman Scattering Study on the Influence of E-Beam Bombardment on Si Electron Lens" Molecules 26, no. 9: 2766. https://doi.org/10.3390/molecules26092766
APA StyleLee, G.-W., Lee, Y.-B., Baek, D.-H., Kim, J.-G., & Kim, H.-S. (2021). Raman Scattering Study on the Influence of E-Beam Bombardment on Si Electron Lens. Molecules, 26(9), 2766. https://doi.org/10.3390/molecules26092766






