Plug-and-Play Electronic Unit for MOS and Thermocatalytic Gas Sensors †
Abstract
:1. Introduction and Motivation
2. Results and Discussion
- stabilization of heating element temperature with accuracy ±0.5 K, with a dynamic range from 120 to 500 °C;
- prevention from sensor overheating (not more than 500 °C);
- PWM frequency for temperature stabilization ≥1000 Hz;
- calibration of heating element in automatic mode (by measuring heater resistance—platinum wire or thick film—under normal conditions);
- measurement of semiconductor sensing layer conductivity in a dynamic range of 3 orders of magnitude with accuracy of 0.5% of maximum value;
- linearization, calibration and humidity compensation of sensor gas response;
- connection with external devices using standard, for example UART, interface.
Conflicts of Interest
References
- Vasiliev, A.; Pavelko, R.; Gogish-Klushin, S.; Kharitonov, D.; Gogish-Klushina, O.; Pisliakov, A.; Sokolov, A.; Samotaev, N.; Guarnieri, V.; Zen, M.; et al. Sensors based on technology “nano-on-micro” for wireless instruments preventing ecological and industrial catastrophes. In Sensors for Environment, Health and Security; Baraton, M.-I., Ed.; Springer: Berlin, Germany, 2009; pp. 205–228. [Google Scholar]
- Vasiliev, A.A.; Pisliakov, A.V.; Sokolov, A.V.; Samotaev, N.N.; Soloviev, S.A.; Oblov, K.; Guarnieri, V.; Lorenzelli, L.; Brunelli, J.; Maglione, A.; et al. Non-silicon MEMS platforms for gas sensors. Sens. Actuators B 2016, 224, 700–713. [Google Scholar] [CrossRef]

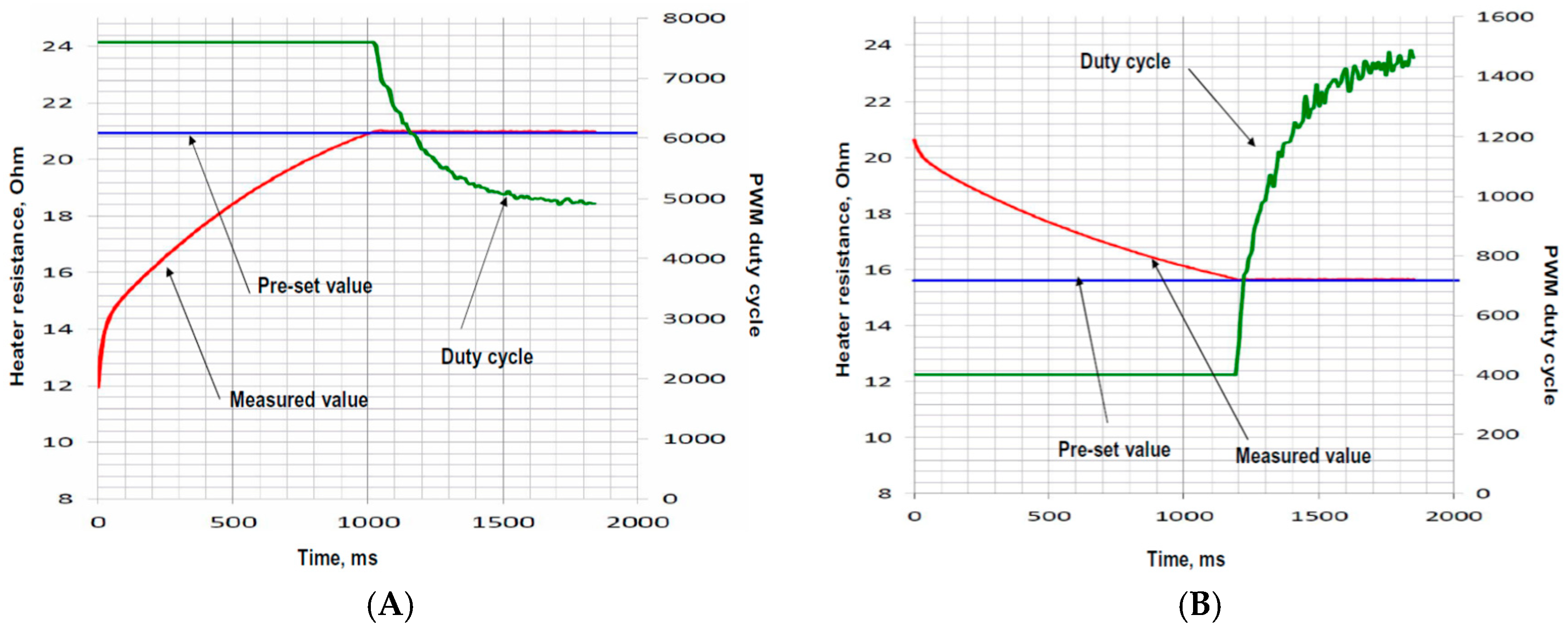

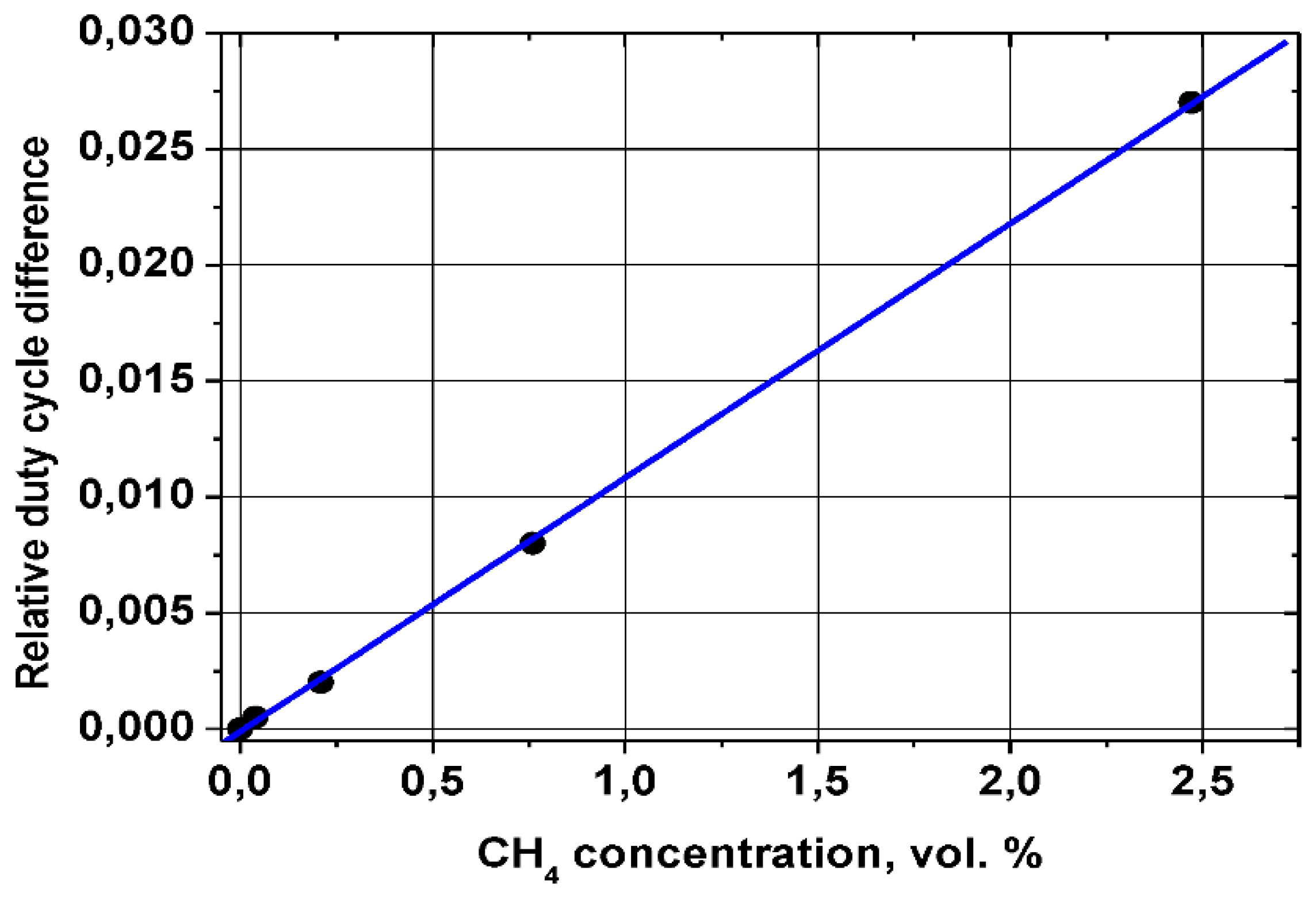
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2017 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Vasiliev, A.; Merzlikin, S.; Shakhnovich, I.; Sokolov, A.; Shulgin, O.; Agafonov, P. Plug-and-Play Electronic Unit for MOS and Thermocatalytic Gas Sensors. Proceedings 2017, 1, 603. https://doi.org/10.3390/proceedings1040603
Vasiliev A, Merzlikin S, Shakhnovich I, Sokolov A, Shulgin O, Agafonov P. Plug-and-Play Electronic Unit for MOS and Thermocatalytic Gas Sensors. Proceedings. 2017; 1(4):603. https://doi.org/10.3390/proceedings1040603
Chicago/Turabian StyleVasiliev, Alexey, Sergey Merzlikin, Ilia Shakhnovich, Andrey Sokolov, Oleg Shulgin, and Pavel Agafonov. 2017. "Plug-and-Play Electronic Unit for MOS and Thermocatalytic Gas Sensors" Proceedings 1, no. 4: 603. https://doi.org/10.3390/proceedings1040603
APA StyleVasiliev, A., Merzlikin, S., Shakhnovich, I., Sokolov, A., Shulgin, O., & Agafonov, P. (2017). Plug-and-Play Electronic Unit for MOS and Thermocatalytic Gas Sensors. Proceedings, 1(4), 603. https://doi.org/10.3390/proceedings1040603




