Unipolar Parity of Ferroelectric-Antiferroelectric Characterized by Junction Current in Crystalline Phase Hf1−xZrxO2 Diodes
Abstract
:1. Introduction
2. Materials and Methods
3. Results
3.1. Junction Current Composition of FeCAPs
3.2. Dipole Switch Characteristics of (A)FeCAPs by Bipolar Bias
3.3. Dipole Switch Characteristics of (A)FeCAPs with Unipolar Bias
3.4. Memory Characteristics of (A)FeCAPs by Program/Erase Pulse Stimulation
3.5. Memory Reliability of (A)FeCAPs
4. Conclusions
Author Contributions
Funding
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Wu, T.-Y.; Huang, H.-H.; Chu, Y.-H.; Chang, C.-C.; Wu, M.-H.; Hsu, C.-H.; Wu, C.-T.; Wu, M.-C.; Wu, W.-W.; Chang, T.-S. Sub-nA low-current HZO ferroelectric tunnel junction for high-performance and accurate deep learning acceleration. In Proceedings of the 2019 IEEE International Electron Devices Meeting (IEDM), San Francisco, CA, USA, 7–11 December 2019. [Google Scholar]
- Jacob, P.; Zia, A.; Erdogan, O.; Belemjian, P.M.; Kim, J.-W.; Chu, M.; Kraft, R.P.; McDonald, J.F.; Bernstein, K. Mitigating memory wall effects in high-clock-rate and multicore CMOS 3-D processor memory stacks. Proc. IEEE 2009, 97, 108–122. [Google Scholar] [CrossRef]
- Sun, G.; Zhao, J.; Poremba, M.; Xu, C.; Xie, Y. Memory that never forgets: Emerging nonvolatile memory and the implication for architecture design. Natl. Sci. Rev. 2018, 5, 577–592. [Google Scholar] [CrossRef]
- Woo, J.; Moon, K.; Song, J.; Lee, S.; Kwak, M.; Park, J.; Hwang, H. Improved synaptic behavior under identical pulses using AlOx/HfO2 bilayer RRAM array for neuromorphic systems. IEEE Electron. Device Lett. 2016, 37, 994–997. [Google Scholar] [CrossRef]
- Yu, S.; Chen, P.-Y.; Cao, Y.; Xia, L.; Wang, Y.; Wu, H. Scaling-up resistive synaptic arrays for neuro-inspired architecture: Challenges and prospect. In Proceedings of the 2015 IEEE International Electron Devices Meeting (IEDM), Washington, DC, USA, 7–9 December 2015. [Google Scholar]
- Burr, G.W.; Shelby, R.M.; Sidler, S.; Di Nolfo, C.; Jang, J.; Boybat, I.; Shenoy, R.S.; Narayanan, P.; Virwani, K.; Giacometti, E.U. Experimental demonstration and tolerancing of a large-scale neural network (165,000 synapses) using phase-change memory as the synaptic weight element. IEEE Trans. Electron. Devices 2015, 62, 3498–3507. [Google Scholar] [CrossRef]
- Jerry, M.; Chen, P.-Y.; Zhang, J.; Sharma, P.; Ni, K.; Yu, S.; Datta, S. Ferroelectric FET analog synapse for acceleration of deep neural network training. In Proceedings of the 2017 IEEE International Electron Devices Meeting (IEDM), San Francisco, CA, USA, 2–6 December 2017. [Google Scholar]
- Seo, M.; Kang, M.-H.; Jeon, S.-B.; Bae, H.; Hur, J.; Jang, B.C.; Yun, S.; Cho, S.; Kim, W.-K.; Kim, M.-S. First demonstration of a logic-process compatible junctionless ferroelectric FinFET synapse for neuromorphic applications. IEEE Electron. Device Lett. 2018, 39, 1445–1448. [Google Scholar] [CrossRef]
- Oh, S.; Kim, T.; Kwak, M.; Song, J.; Woo, J.; Jeon, S.; Yoo, I.K.; Hwang, H. HfZrO x-based ferroelectric synapse device with 32 levels of conductance states for neuromorphic applications. IEEE Electron. Device Lett. 2017, 38, 732–735. [Google Scholar] [CrossRef]
- Hu, V.P.-H.; Lin, H.-H.; Zheng, Z.-A.; Lin, Z.-T.; Lu, Y.-C.; Ho, L.-Y.; Lee, Y.-W.; Su, C.-W.; Su, C.-J. Split-gate FeFET (SG-FeFET) with dynamic memory window modulation for non-volatile memory and neuromorphic applications. In Proceedings of the 2019 Symposium on VLSI Technology, Kyoto, Japan, 9–14 June 2019; pp. T134–T135. [Google Scholar]
- Böscke, T.; Müller, J.; Bräuhaus, D.; Schröder, U.; Böttger, U. Ferroelectricity in hafnium oxide: CMOS compatible ferroelectric field effect transistors. In Proceedings of the 2011 International Electron Devices Meeting, Washington, DC, USA, 5–7 December 2011. [Google Scholar]
- Polakowski, P.; Riedel, S.; Weinreich, W.; Rudolf, M.; Sundqvist, J.; Seidel, K.; Muller, J. Ferroelectric deep trench capacitors based on Al: HfO2 for 3D nonvolatile memory applications. In Proceedings of the 2014 IEEE 6th International Memory Workshop (IMW), Taipei, Taiwan, 18–21 May 2014; pp. 1–4. [Google Scholar]
- Cheng, C.-H.; Chin, A. Low-leakage-current DRAM-like memory using a one-transistor ferroelectric MOSFET with a Hf-based gate dielectric. IEEE Electron. Device Lett. 2013, 35, 138–140. [Google Scholar] [CrossRef]
- Cheng, C.H.; Chin, A. Low-Voltage Steep Turn-On pMOSFET Using Ferroelectric High-k Gate Dielectric. IEEE Electron. Device Lett. 2014, 35, 274–276. [Google Scholar] [CrossRef]
- Park, M.H.; Kim, H.J.; Kim, Y.J.; Moon, T.; Do Kim, K.; Hwang, C.S. Toward a multifunctional monolithic device based on pyroelectricity and the electrocaloric effect of thin antiferroelectric HfxZr1−xO2 films. Nano Energy 2015, 12, 131–140. [Google Scholar] [CrossRef]
- Chiu, Y.-C.; Cheng, C.-H.; Chang, C.-Y.; Lee, M.-H.; Hsu, H.-H.; Yen, S.-S. Low power 1T DRAM/NVM versatile memory featuring steep sub-60-mV/decade operation, fast 20-ns speed, and robust 85 C-extrapolated 1016 endurance. In Proceedings of the 2015 Symposium on VLSI Technology (VLSI Technology), Kyoto, Japan, 16–18 June 2015; pp. T184–T185. [Google Scholar]
- Fujii, S.; Kamimuta, Y.; Ino, T.; Nakasaki, Y.; Takaishi, R.; Saitoh, M. First demonstration and performance improvement of ferroelectric HfO2-based resistive switch with low operation current and intrinsic diode property. In Proceedings of the 2016 IEEE Symposium on VLSI Technology, Honolulu, HI, USA, 14–16 June 2016; pp. 1–2. [Google Scholar]
- Mulaosmanovic, H.; Ocker, J.; Müller, S.; Noack, M.; Müller, J.; Polakowski, P.; Mikolajick, T.; Slesazeck, S. Novel ferroelectric FET based synapse for neuromorphic systems. In Proceedings of the 2017 Symposium on VLSI Technology, Kyoto, Japan, 5–8 June 2017; pp. T176–T177. [Google Scholar]
- Eskandari, R.; Zhang, X.; Malkinski, L.M. Polarization-dependent photovoltaic effect in ferroelectric-semiconductor system. Appl. Phys. Lett. 2017, 110, 121105. [Google Scholar] [CrossRef]
- Dragoman, M.; Aldrigo, M.; Modreanu, M.; Dragoman, D. Extraordinary tunability of high-frequency devices using Hf0.3Zr0.7O2 ferroelectric at very low applied voltages. Appl. Phys. Lett. 2017, 110, 103104. [Google Scholar] [CrossRef] [Green Version]
- Van Houdt, J. Memory technology for the terabit era: From 2D to 3D. In Proceedings of the 2017 Symposium on VLSI Technology, Kyoto, Japan, 5–8 June 2017; pp. T24–T25. [Google Scholar]
- Smith, S.; Kitahara, A.; Rodriguez, M.; Henry, M.; Brumbach, M.; Ihlefeld, J. Pyroelectric response in crystalline hafnium zirconium oxide (Hf1−x Zrx O2) thin films. Appl. Phys. Lett. 2017, 110, 072901. [Google Scholar] [CrossRef]
- Huang, F.; Wang, Y.; Liang, X.; Qin, J.; Zhang, Y.; Yuan, X.; Wang, Z.; Peng, B.; Deng, L.; Liu, Q. HfO2-based highly stable radiation-immune ferroelectric memory. IEEE Electron. Device Lett. 2017, 38, 330–333. [Google Scholar] [CrossRef]
- Chen, Z.; He, L.; Zhang, F.; Jiang, J.; Meng, J.; Zhao, B.; Jiang, A. The conduction mechanism of large on/off ferroelectric diode currents in epitaxial (111) BiFeO3 thin film. J. Appl. Phys. 2013, 113, 184106. [Google Scholar] [CrossRef]
- Bae, H.; Moon, T.; Nam, S.G.; Lee, K.-H.; Kim, S.; Hong, S.; Choe, D.-H.; Jo, S.; Lee, Y.; Heo, J. Ferroelectric Diodes with Sub-ns and Sub-fJ Switching and Its Programmable Network for Logic-in-Memory Applications. In Proceedings of the 2021 Symposium on VLSI Technology, Kyoto, Japan, 13–19 June 2021; p. T6-1. [Google Scholar]
- Luo, Q.; Cheng, Y.; Yang, J.; Cao, R.; Ma, H.; Yang, Y.; Huang, R.; Wei, W.; Zheng, Y.; Gong, T. A highly CMOS compatible hafnia-based ferroelectric diode. Nat. Commun. 2020, 11, 1391. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Kobayashi, M.; Tagawa, Y.; Mo, F.; Saraya, T.; Hiramoto, T. Ferroelectric HfO2 tunnel junction memory with high TER and multi-level operation featuring metal replacement process. IEEE J. Electron. Devices Soc. 2018, 7, 134–139. [Google Scholar] [CrossRef]
- Garcia, V.; Fusil, S.; Bouzehouane, K.; Enouz-Vedrenne, S.; Mathur, N.D.; Barthelemy, A.; Bibes, M. Giant tunnel electroresistance for non-destructive readout of ferroelectric states. Nature 2009, 460, 81–84. [Google Scholar] [CrossRef] [PubMed]
- Boyn, S.; Chanthbouala, A.; Girod, S.; Carrétéro, C.; Barthélémy, A.; Bibes, M.; Grollier, J.; Fusil, S.; Garcia, V. Real-time switching dynamics of ferroelectric tunnel junctions under single-shot voltage pulses. Appl. Phys. Lett. 2018, 113, 232902. [Google Scholar] [CrossRef]
- Hsiang, K.-Y.; Liao, C.-Y.; Chen, K.-T.; Lin, Y.-Y.; Chueh, C.-Y.; Chang, C.; Tseng, Y.-J.; Yang, Y.-J.; Chang, S.; Liao, M.-H. Ferroelectric HfZrO 2 with electrode engineering and stimulation schemes as symmetric analog synaptic weight element for deep neural network training. IEEE Trans. Electron. Devices 2020, 67, 4201–4207. [Google Scholar] [CrossRef]
- Lyu, X.; Si, M.; Sun, X.; Capano, M.; Wang, H.; Ye, P. Ferroelectric and anti-ferroelectric hafnium zirconium oxide: Scaling limit, switching speed and record high polarization density. In Proceedings of the 2019 Symposium on VLSI Technology, Kyoto, Japan, 9–14 June 2019; pp. T44–T45. [Google Scholar]
- Lou, X. Why do antiferroelectrics show higher fatigue resistance than ferroelectrics under bipolar electrical cycling? Appl. Phys. Lett. 2009, 94, 072901. [Google Scholar] [CrossRef]
- Hsiang, K.-Y.; Liao, C.-Y.; Liu, J.-H.; Wang, J.-F.; Chiang, S.-H.; Chang, S.-H.; Hsieh, F.-C.; Liang, H.; Lin, C.-Y.; Lou, Z.-F. Bilayer-based Antiferroelectric HfZrO2 Tunneling Junction with High Tunneling Electroresistance and Multilevel Nonvolatile Memory. IEEE Electron. Device Lett. 2021, 42, 1464–1467. [Google Scholar] [CrossRef]
- Gao, M.; Tang, X.; Leung, C.M.; Dai, S.; Li, J.; Viehland, D.D. Phase transition and energy storage behavior of antiferroelectric PLZT thin films epitaxially deposited on SRO buffered STO single crystal substrates. J. Am. Ceram. Soc. 2019, 102, 5180–5191. [Google Scholar] [CrossRef]
- Apachitei, G.; Peters, J.J.; Sanchez, A.M.; Kim, D.J.; Alexe, M. Antiferroelectric tunnel junctions. Adv. Electron. Mater. 2017, 3, 1700126. [Google Scholar] [CrossRef]
- Pesic, M.; Knebel, S.; Hoffmann, M.; Richter, C.; Mikolajick, T.; Schroeder, U. How to make DRAM non-volatile? Anti-ferroelectrics: A new paradigm for universal memories. In Proceedings of the 2016 IEEE International Electron Devices Meeting (IEDM), San Francisco, CA, USA, 3–7 December 2016. [Google Scholar]
- Kumar, N.; George, B.P.A.; Abrahamse, H.; Parashar, V.; Ray, S.S.; Ngila, J.C. A novel approach to low-temperature synthesis of cubic HfO 2 nanostructures and their cytotoxicity. Sci. Rep. 2017, 7, 9351. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Lee, M.-H.; Wei, Y.-T.; Chu, K.-Y.; Huang, J.-J.; Chen, C.-W.; Cheng, C.-C.; Chen, M.-J.; Lee, H.-Y.; Chen, Y.-S.; Lee, L.-H. Steep slope and near non-hysteresis of FETs with antiferroelectric-like HfZrO for low-power electronics. IEEE Electron. Device Lett. 2015, 36, 294–296. [Google Scholar] [CrossRef]
- Monshi, A.; Foroughi, M.R.; Monshi, M.R. Modified Scherrer equation to estimate more accurately nano-crystallite size using XRD. World J. Nano Sci. Eng. 2012, 2, 154–160. [Google Scholar] [CrossRef] [Green Version]
- Huang, H.-H.; Wu, T.-Y.; Chu, Y.-H.; Wu, M.-H.; Hsu, C.-H.; Lee, H.-Y.; Sheu, S.-S.; Lo, W.-C.; Hou, T.-H. A comprehensive modeling framework for ferroelectric tunnel junctions. In Proceedings of the 2019 IEEE International Electron Devices Meeting (IEDM), San Francisco, CA, USA, 7–11 December 2019. [Google Scholar]
- Yılmaz, K.; Farokhnejad, A.; Criado, F.; Iñíguez, B.; Lime, F.; Kloes, A. Direct source-to-drain tunneling current in ultra-short channel DG MOSFETs by wavelet transform. In Proceedings of the 2020 IEEE Latin America Electron Devices Conference (LAEDC), San Jose, Costa Rica, 25–28 February 2020; pp. 1–4. [Google Scholar]
- Song, T.; Estandía, S.; Tan, H.; Dix, N.; Gàzquez, J.; Fina, I.; Sánchez, F. Positive Effect of Parasitic Monoclinic Phase of Hf0.5Zr0.5O2 on Ferroelectric Endurance. Adv. Electron. Mater. 2021, 2100420. [Google Scholar] [CrossRef]
- Kim, B.S.; Hyun, S.D.; Moon, T.; Do Kim, K.; Lee, Y.H.; Park, H.W.; Lee, Y.B.; Roh, J.; Kim, B.Y.; Kim, H.H. A Comparative Study on the Ferroelectric Performances in Atomic Layer Deposited Hf0.5 Zr0.5 O2 Thin Films Using Tetrakis (ethylmethylamino) and Tetrakis (dimethylamino) Precursors. Nanoscale Res. Lett. 2020, 15, 72. [Google Scholar] [CrossRef] [Green Version]
- Hoffmann, M.; Schroeder, U.; Schenk, T.; Shimizu, T.; Funakubo, H.; Sakata, O.; Pohl, D.; Drescher, M.; Adelmann, C.; Materlik, R. Stabilizing the ferroelectric phase in doped hafnium oxide. J. Appl. Phys. 2015, 118, 072006. [Google Scholar] [CrossRef]
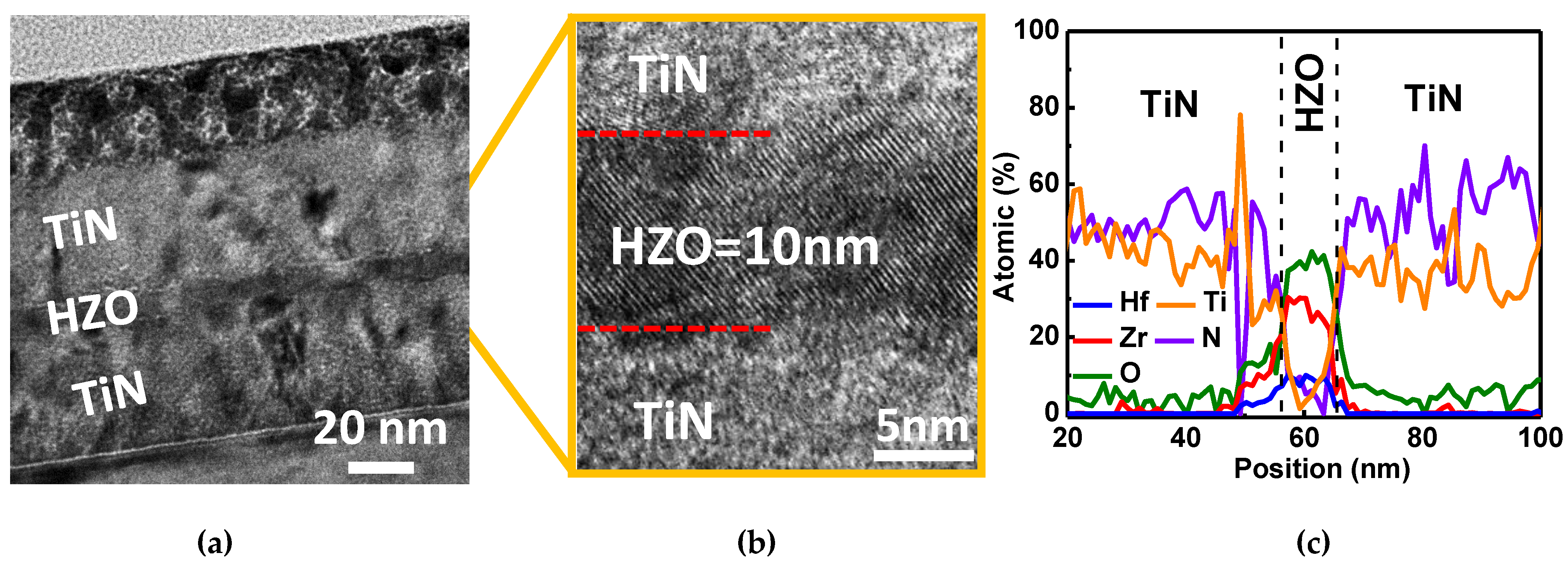
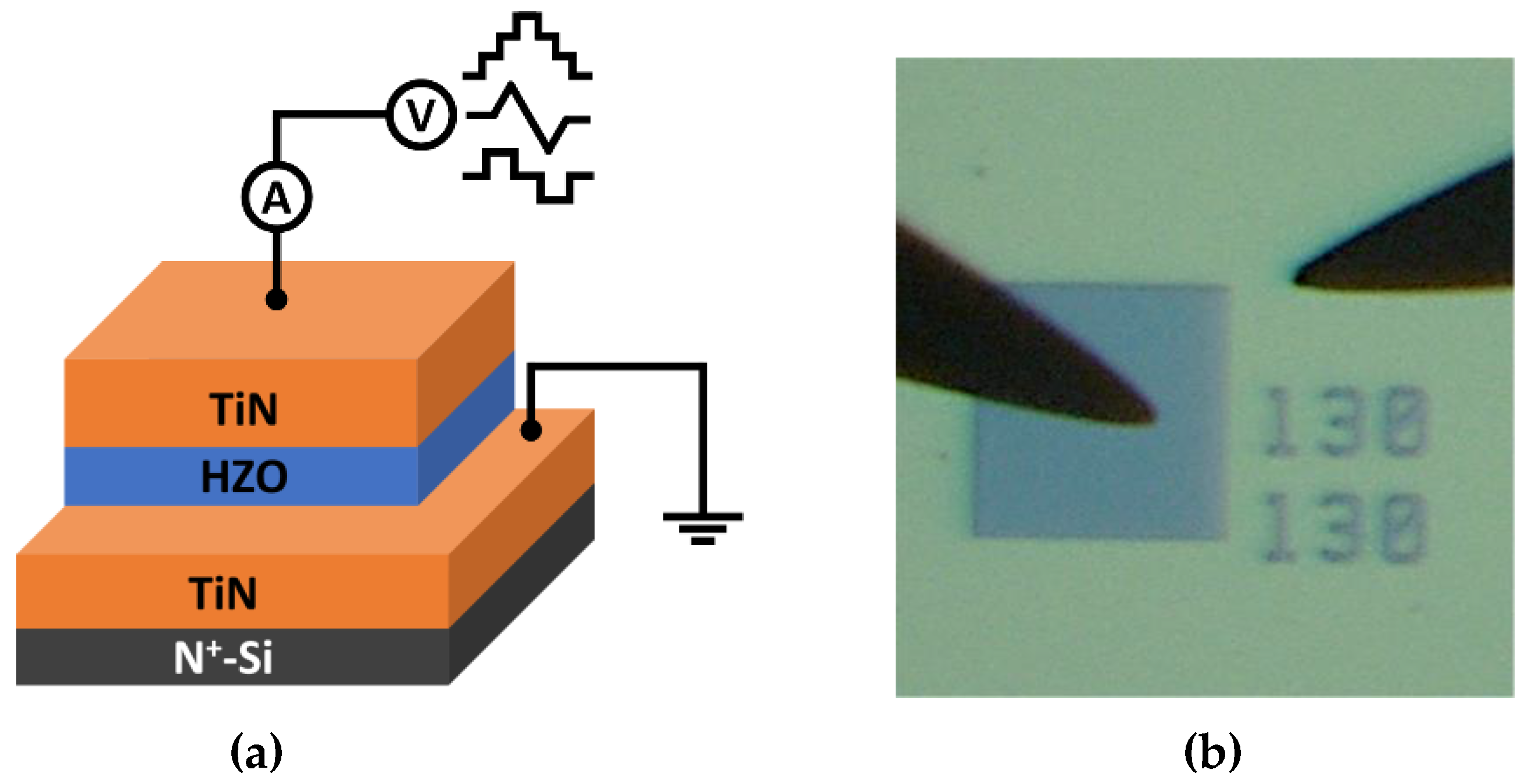
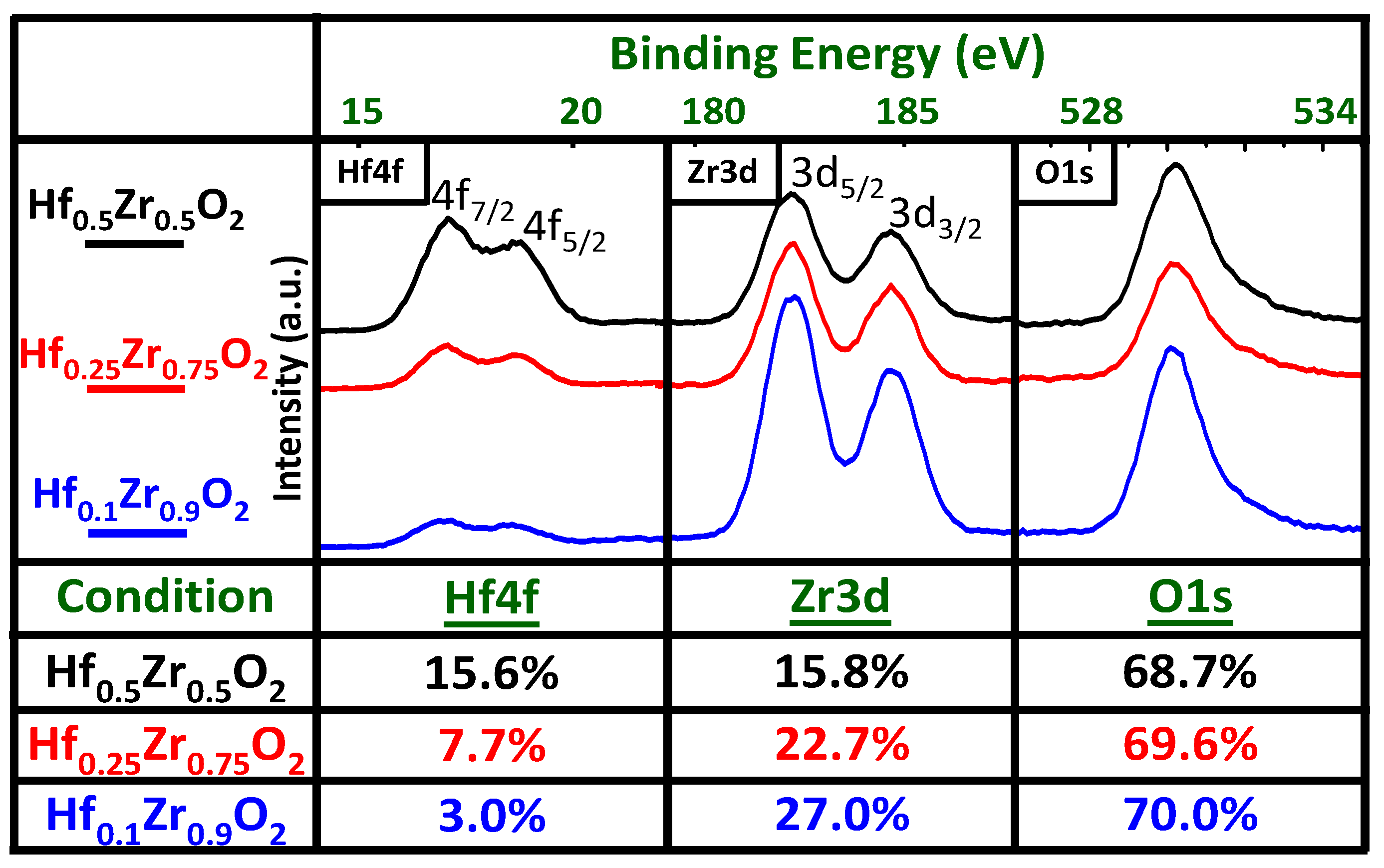

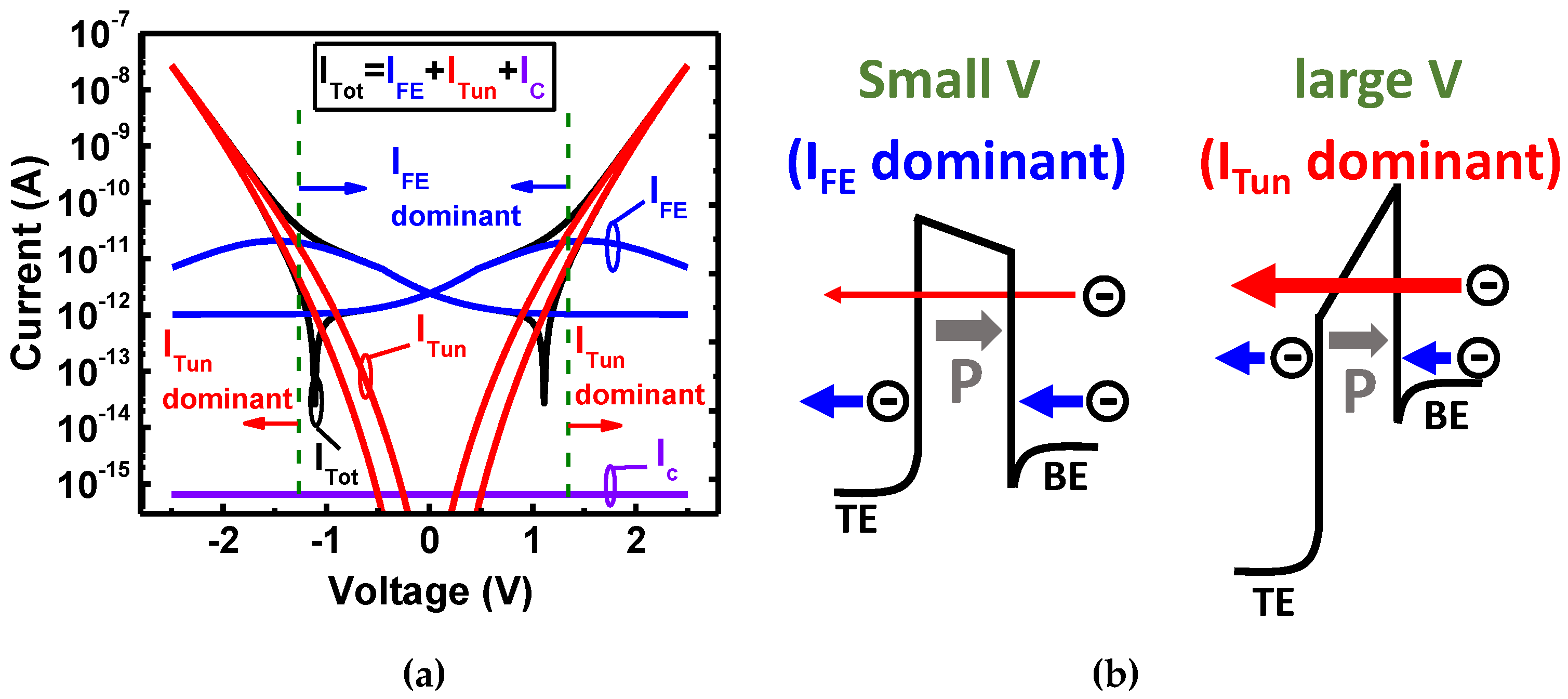
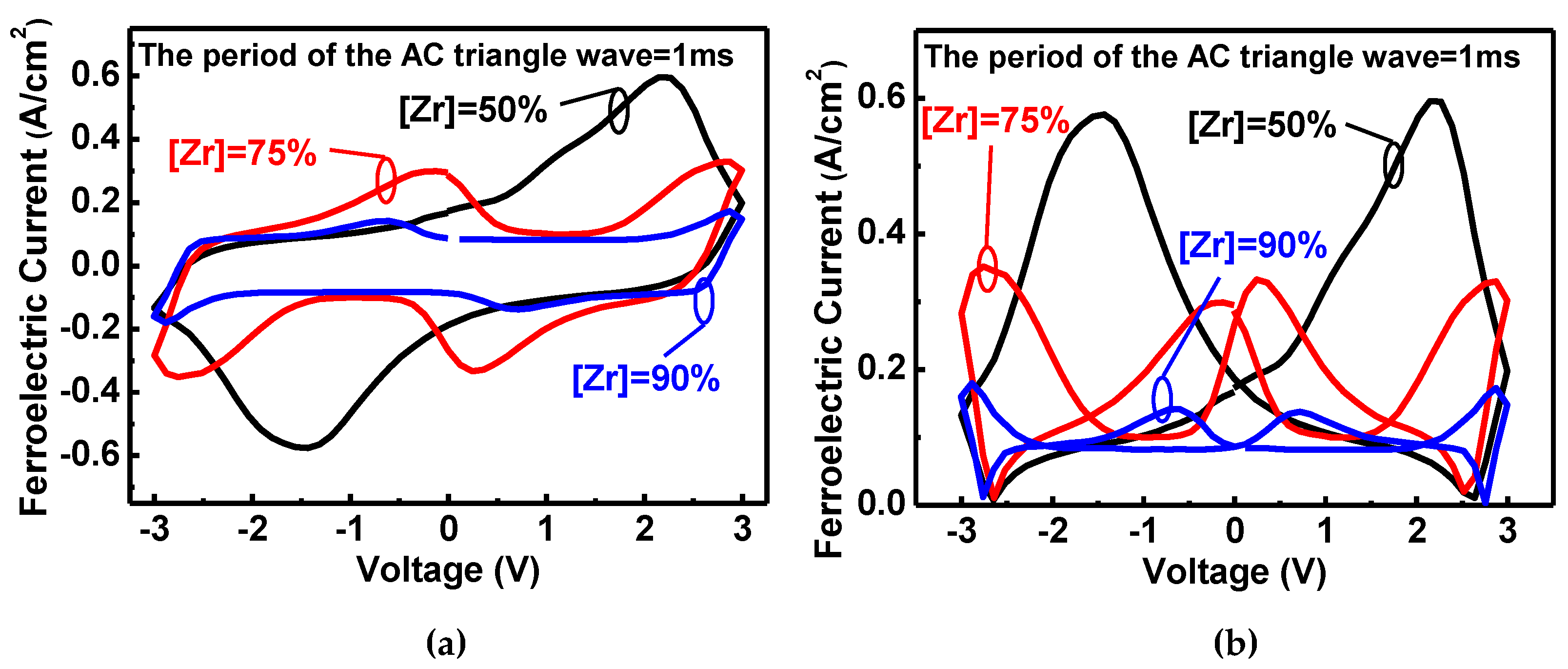
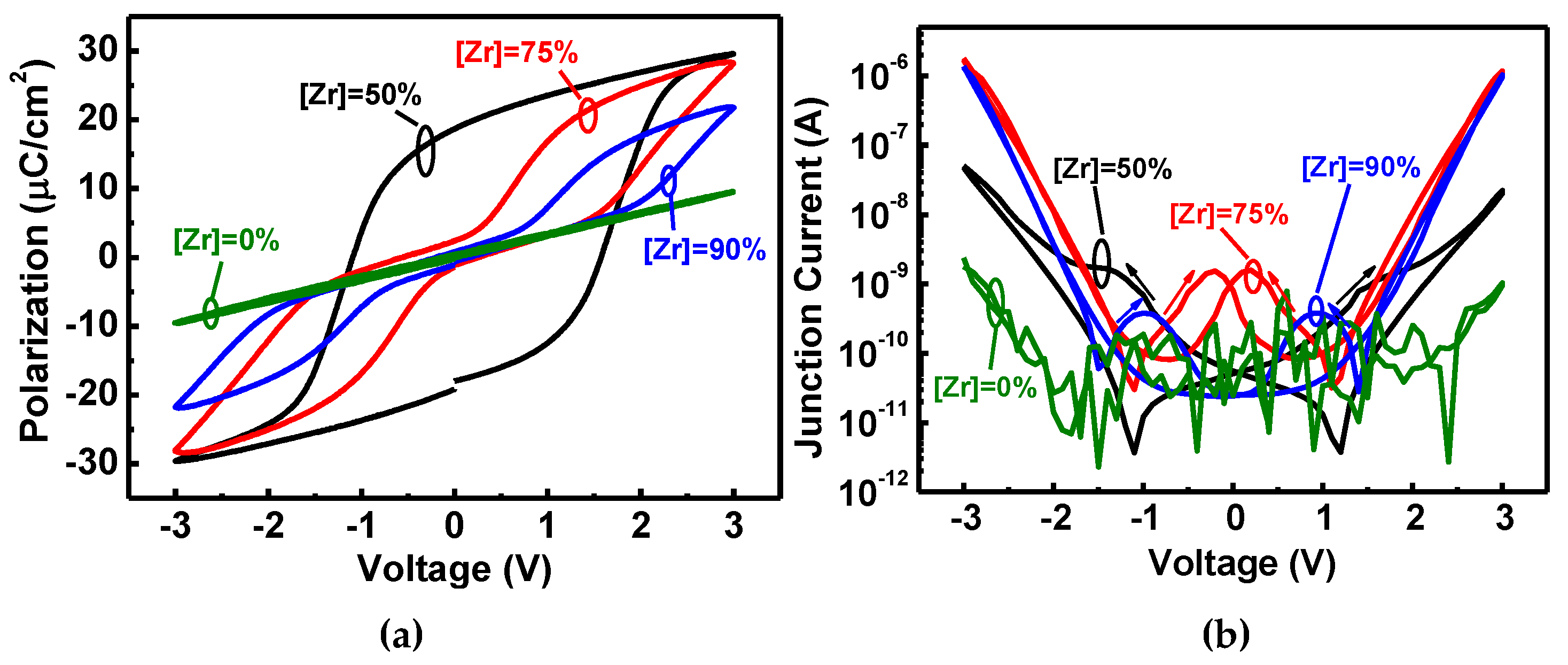
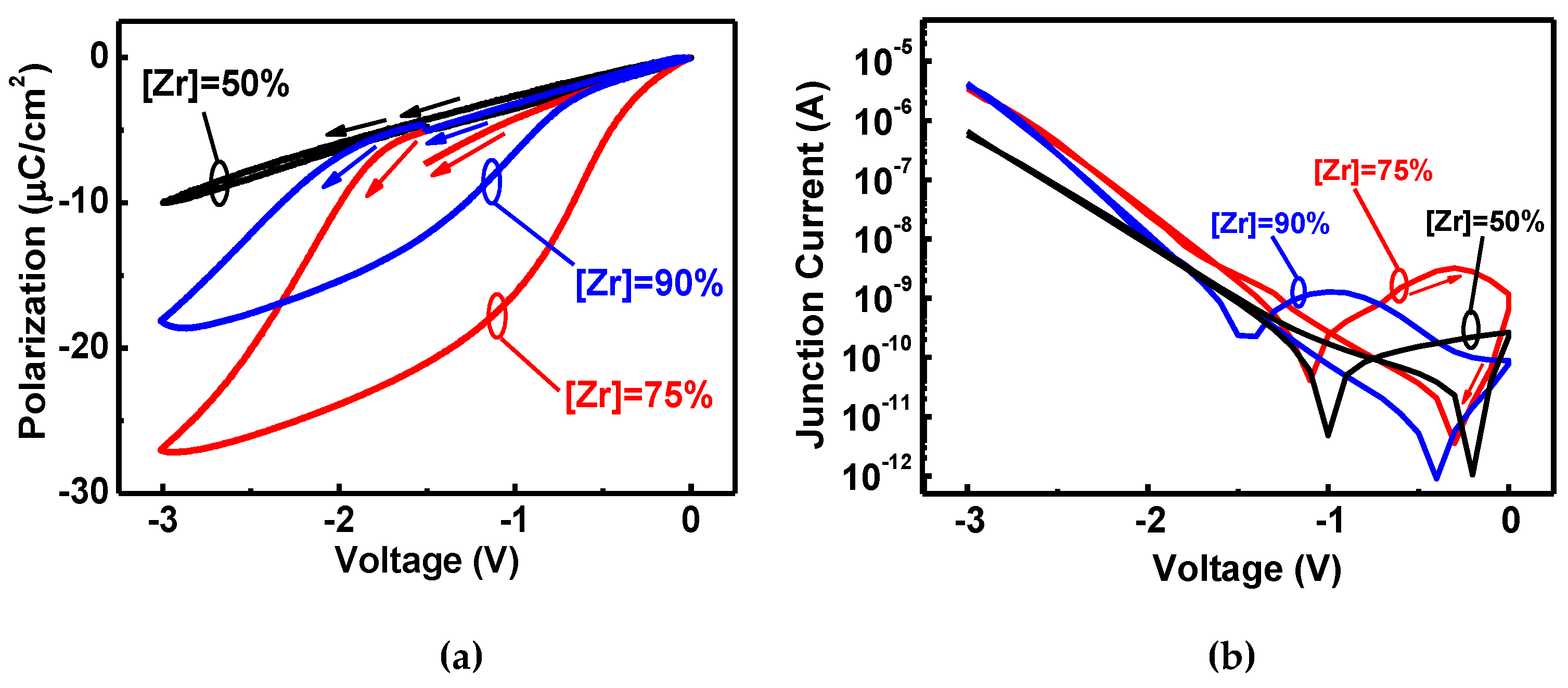

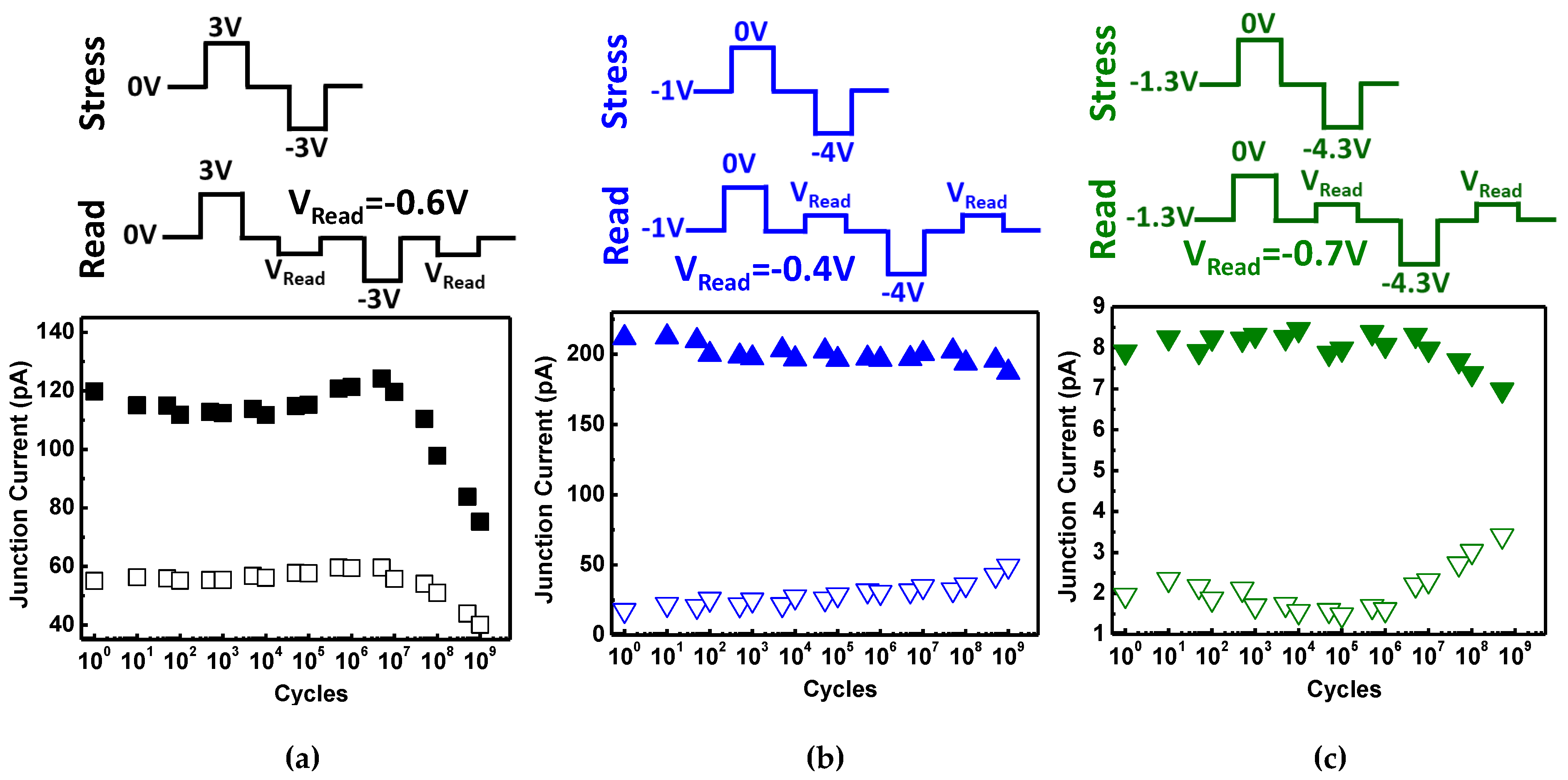
| Reference | This Work | [24] | [25] | [26] |
|---|---|---|---|---|
| Material | FE-AFE HZO | FE-BFO | FE-HZO/IGZO | FE-HZO |
| Thickness (nm) | 10 | 170 | 7/5 | 10 |
| VP/VE | –3 V/0 V | +8 V/–8 V | +3.3 V/–3.2 V | +9.5 V/+5.9 V |
| │Vbase-Vread│ | 0.6 V | 4 V | 2 V | 2 V |
| ION/IOFF | >100 | ~5 | ~3 × 105 | ~10,000 |
| Endurance (cycles) | >109 | NA | ~109 | >109 |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Hsiang, K.-Y.; Liao, C.-Y.; Wang, J.-F.; Lou, Z.-F.; Lin, C.-Y.; Chiang, S.-H.; Liu, C.-W.; Hou, T.-H.; Lee, M.-H. Unipolar Parity of Ferroelectric-Antiferroelectric Characterized by Junction Current in Crystalline Phase Hf1−xZrxO2 Diodes. Nanomaterials 2021, 11, 2685. https://doi.org/10.3390/nano11102685
Hsiang K-Y, Liao C-Y, Wang J-F, Lou Z-F, Lin C-Y, Chiang S-H, Liu C-W, Hou T-H, Lee M-H. Unipolar Parity of Ferroelectric-Antiferroelectric Characterized by Junction Current in Crystalline Phase Hf1−xZrxO2 Diodes. Nanomaterials. 2021; 11(10):2685. https://doi.org/10.3390/nano11102685
Chicago/Turabian StyleHsiang, Kuo-Yu, Chun-Yu Liao, Jer-Fu Wang, Zhao-Feng Lou, Chen-Ying Lin, Shih-Hung Chiang, Chee-Wee Liu, Tuo-Hung Hou, and Min-Hung Lee. 2021. "Unipolar Parity of Ferroelectric-Antiferroelectric Characterized by Junction Current in Crystalline Phase Hf1−xZrxO2 Diodes" Nanomaterials 11, no. 10: 2685. https://doi.org/10.3390/nano11102685
APA StyleHsiang, K.-Y., Liao, C.-Y., Wang, J.-F., Lou, Z.-F., Lin, C.-Y., Chiang, S.-H., Liu, C.-W., Hou, T.-H., & Lee, M.-H. (2021). Unipolar Parity of Ferroelectric-Antiferroelectric Characterized by Junction Current in Crystalline Phase Hf1−xZrxO2 Diodes. Nanomaterials, 11(10), 2685. https://doi.org/10.3390/nano11102685







