Structural, Surface, and Optical Properties of AlN Thin Films Grown on Different Substrates by PEALD
Abstract
1. Introduction
2. Experimental
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Taniyasu, Y.; Kasu, M.; Makimoto, T. An aluminium nitride light-emitting diode with a wavelength of 210 nanometres. Nature 2006, 441, 325–328. [Google Scholar] [CrossRef]
- Lu, J.; Chen, J.-T.; Dahlqvist, M.; Kabouche, R.; Medjdoub, F.; Rosen, J.; Kordina, O.; Hultman, L. Transmorphic epitaxial growth of AlN nucleation layers on SiC substrates for high-breakdown thin GaN transistors. Appl. Phys. Lett. 2019, 115, 221601. [Google Scholar] [CrossRef]
- Zhang, D.; Cheng, X.; Shen, L.; Zheng, L.; Gu, Z.; Zhou, W.; Liu, X.; Yu, Y. Influence of Poly-AlN Passivation on the Performance Improvement of 3-MeV Proton-Irradiated AlGaN/GaN MIS-HEMTs. IEEE Trans. Nucl. Sci. 2019, 66, 2215–2219. [Google Scholar] [CrossRef]
- Ambacher, O. Growth and applications of Group III-nitrides. J. Phys. D Appl. Phys. 1998, 31, 2653. [Google Scholar] [CrossRef]
- Amano, H.; Sawaki, N.; Akasaki, I.; Toyoda, Y. Metalorganic vapor phase epitaxial growth of a high quality GaN film using an AlN buffer layer. Appl. Phys. Lett. 1986, 48, 353–355. [Google Scholar] [CrossRef]
- Liu, S.; Yang, S.; Tang, Z.; Jiang, Q.; Liu, C.; Wang, M.; Shen, B.; Chen, K.J. Interface/border trap characterization of Al2O3/AlN/GaN metal-oxide-semiconductor structures with an AlN interfacial layer. Appl. Phys. Lett. 2015, 106, 051605. [Google Scholar] [CrossRef]
- Pan, L.; Dong, X.; Li, Z.; Luo, W.; Ni, J. Influence of the AlN nucleation layer on the properties of AlGaN/GaN heterostructure on Si (1 1 1) substrates. Appl. Surf. Sci. 2018, 447, 512–517. [Google Scholar] [CrossRef]
- Liudi Mulyo, A.; Rajpalke, M.K.; Vullum, P.E.; Weman, H.; Kishino, K.; Fimland, B.-O. The influence of AlN buffer layer on the growth of self-assembled GaN nanocolumns on graphene. Sci. Rep. 2020, 10, 853. [Google Scholar] [CrossRef]
- Zhan, X.; Liu, J.; Sun, X.; Huang, Y.; Gao, H.; Zhou, Y.; Li, Q.; Sun, Q.; Yang, H. Crack-free 2.2 μm-thick GaN grown on Si with a single-layer AlN buffer for RF device applications. J. Phys. D Appl. Phys. 2023, 56, 015104. [Google Scholar] [CrossRef]
- Yeadon, M.; Marshall, M.T.; Hamdani, F.; Pekin, S.; Morkoç, H.; Gibson, J.M. In situ transmission electron microscopy of AlN growth by nitridation of (0001) α-Al2O3. J. Appl. Phys. 1998, 83, 2847–2850. [Google Scholar] [CrossRef]
- Zscherp, M.F.; Mengel, N.; Hofmann, D.M.; Lider, V.; Ojaghi Dogahe, B.; Becker, C.; Beyer, A.; Volz, K.; Schörmann, J.; Chatterjee, S. AlN Buffer Enhances the Layer Quality of MBE-Grown Cubic GaN on 3C-SiC. Cryst. Growth Des. 2022, 22, 6786–6791. [Google Scholar] [CrossRef]
- Lutsenko, E.V.; Rzheutski, M.V.; Vainilovich, A.G.; Svitsiankou, I.E.; Shulenkova, V.A.; Muravitskaya, E.V.; Alexeev, A.N.; Petrov, S.I.; Yablonskii, G.P. MBE AlGaN/GaN HEMT Heterostructures with Optimized AlN Buffer on Al2O3. Semiconductors 2018, 52, 2107–2110. [Google Scholar] [CrossRef]
- Zamir, S.; Meyler, B.; Zolotoyabko, E.; Salzman, J. The effect of AlN buffer layer on GaN grown on (111)-oriented Si substrates by MOCVD. J. Cryst. Growth 2000, 218, 181–190. [Google Scholar] [CrossRef]
- Yarar, E.; Hrkac, V.; Zamponi, C.; Piorra, A.; Kienle, L.; Quandt, E. Low temperature aluminum nitride thin films for sensory applications. AIP Adv. 2016, 6, 075115. [Google Scholar] [CrossRef]
- George, S.M. Atomic Layer Deposition: An Overview. Chem. Rev. 2010, 110, 111–131. [Google Scholar] [CrossRef] [PubMed]
- Cremers, V.; Puurunen, R.L.; Dendooven, J. Conformality in atomic layer deposition: Current status overview of analysis and modelling. Appl. Phys. Rev. 2019, 6, 021302. [Google Scholar] [CrossRef]
- Vervuurt, R.H.J.; Karasulu, B.; Verheijen, M.A.; Kessels, W.M.M.; Bol, A.A. Uniform Atomic Layer Deposition of Al2O3 on Graphene by Reversible Hydrogen Plasma Functionalization. Chem. Mater. 2017, 29, 2090–2100. [Google Scholar] [CrossRef]
- Puurunen, R.L. Correlation between the growth-per-cycle and the surface hydroxyl group concentration in the atomic layer deposition of aluminum oxide from trimethylaluminum and water. Appl. Surf. Sci. 2005, 245, 6–10. [Google Scholar] [CrossRef]
- Miikkulainen, V.; Leskelä, M.; Ritala, M.; Puurunen, R. ChemInform Abstract: Crystallinity of Inorganic Films Grown by Atomic Layer Deposition: Overview and General Trends. J. Appl. Phys. 2013, 113, 2. [Google Scholar] [CrossRef]
- Profijt, H.B.; Potts, S.E.; van de Sanden, M.C.M.; Kessels, W.M.M. Plasma-Assisted Atomic Layer Deposition: Basics, Opportunities, and Challenges. J. Vac. Sci. Technol. A 2011, 29, 050801. [Google Scholar] [CrossRef]
- Gakis, G.P.; Vahlas, C.; Vergnes, H.; Dourdain, S.; Tison, Y.; Martinez, H.; Bour, J.; Ruch, D.; Boudouvis, A.G.; Caussat, B.; et al. Investigation of the initial deposition steps and the interfacial layer of Atomic Layer Deposited (ALD) Al2O3 on Si. Appl. Surf. Sci. 2019, 492, 245–254. [Google Scholar] [CrossRef]
- Lu, J.; Elam, J.W.; Stair, P.C. Atomic layer deposition—Sequential self-limiting surface reactions for advanced catalyst “bottom-up” synthesis. Surf. Sci. Rep. 2016, 71, 410–472. [Google Scholar] [CrossRef]
- Zaera, F. Mechanisms of surface reactions in thin solid film chemical deposition processes. Coord. Chem. Rev. 2013, 257, 3177–3191. [Google Scholar] [CrossRef]
- Lee, Y.J.; Kang, S.-W. Growth of aluminum nitride thin films prepared by plasma-enhanced atomic layer deposition. Thin Solid Film. 2004, 446, 227–231. [Google Scholar] [CrossRef]
- Ozgit, C.; Donmez, I.; Alevli, M.; Biyikli, N. Self-limiting low-temperature growth of crystalline AlN thin films by plasma-enhanced atomic layer deposition. Thin Solid Film. 2012, 520, 2750–2755. [Google Scholar] [CrossRef]
- Van Bui, H.; Wiggers, F.B.; Gupta, A.; Nguyen, M.D.; Aarnink, A.A.I.; de Jong, M.P.; Kovalgin, A.Y. Initial growth, refractive index, and crystallinity of thermal and plasma-enhanced atomic layer deposition AlN films. J. Vac. Sci. Technol. A 2014, 33, 01A111. [Google Scholar] [CrossRef]
- Banerjee, S.; Aarnink, A.A.I.; van de Kruijs, R.; Kovalgin, A.Y.; Schmitz, J. PEALD AlN: Controlling growth and film crystallinity. Phys. Status Solidi C 2015, 12, 1036–1042. [Google Scholar] [CrossRef]
- Bosund, M.; Sajavaara, T.; Laitinen, M.; Huhtio, T.; Putkonen, M.; Airaksinen, V.-M.; Lipsanen, H. Properties of AlN grown by plasma enhanced atomic layer deposition. Appl. Surf. Sci. 2011, 257, 7827–7830. [Google Scholar] [CrossRef]
- Kim, Y.; Kim, M.S.; Yun, H.J.; Ryu, S.Y.; Choi, B.J. Effect of growth temperature on AlN thin films fabricated by atomic layer deposition. Ceram. Int. 2018, 44, 17447–17452. [Google Scholar] [CrossRef]
- Nguyen, T.; Adjeroud, N.; Glinsek, S.; Fleming, Y.; Guillot, J.; Grysan, P.; Polesel-Maris, J. A film-texture driven piezoelectricity of AlN thin films grown at low temperatures by plasma-enhanced atomic layer deposition. APL Mater. 2020, 8, 071101. [Google Scholar] [CrossRef]
- Liu, X.; Ramanathan, S.; Lee, E.; Seidel, T.E. Atomic Layer Deposition of Aluminum Nitride Thin films from Trimethyl Aluminum (TMA) and Ammonia. MRS Online Proc. Libr. 2003, 811, 158–163. [Google Scholar]
- Tarala, V.; Altakhov, A.; Martens, V.; Lisitsyn, S. Growing aluminum nitride films by Plasma-Enhanced Atomic Layer Deposition at low temperatures. J. Phys. Conf. Ser. 2015, 652, 012034. [Google Scholar] [CrossRef]
- Shih, H.-Y.; Lee, W.-H.; Kao, W.-C.; Chuang, Y.-C.; Lin, R.-M.; Lin, H.-C.; Shiojiri, M.; Chen, M.-J. Low-temperature atomic layer epitaxy of AlN ultrathin films by layer-by-layer, in-situ atomic layer annealing. Sci. Rep. 2017, 7, 39717. [Google Scholar] [CrossRef]
- Legallais, M.; Mehdi, H.; David, S.; Bassani, F.; Labau, S.; Pelissier, B.; Baron, T.; Martinez, E.; Ghibaudo, G.; Salem, B. Improvement of AlN Film Quality Using Plasma Enhanced Atomic Layer Deposition with Substrate Biasing. ACS Appl. Mater. Interfaces 2020, 12, 39870–39880. [Google Scholar] [CrossRef]
- Kim, H.; Kim, N.D.; An, S.C.; Yoon, H.J.; Choi, B.J. Improved interfacial properties of thermal atomic layer deposited AlN on GaN. Vacuum 2019, 159, 379–381. [Google Scholar] [CrossRef]
- Kim, H.; Yun, H.J.; Choi, S.; Choi, B.J. Comparison of electrical and interfacial characteristics between atomic-layer-deposited AlN and AlGaN on a GaN substrate. Appl. Phys. A 2020, 126, 449. [Google Scholar] [CrossRef]
- Van Bui, H.; Nguyen, M.D.; Wiggers, F.B.; Aarnink, A.A.I.; de Jong, M.P.; Kovalgin, A.Y. Self-Limiting Growth and Thickness- and Temperature- Dependence of Optical Constants of ALD AlN Thin Films. ECS J. Solid State Sci. Technol. 2014, 3, P101. [Google Scholar] [CrossRef]
- Schilirò, E.; Giannazzo, F.; Bongiorno, C.; Di Franco, S.; Greco, G.; Roccaforte, F.; Prystawko, P.; Kruszewski, P.; Leszczyński, M.; Krysko, M.; et al. Structural and electrical properties of AlN thin films on GaN substrates grown by plasma enhanced-Atomic Layer Deposition. Mater. Sci. Semicond. Process. 2019, 97, 35–39. [Google Scholar] [CrossRef]
- Liu, S.; Peng, M.; Hou, C.; He, Y.; Li, M.; Zheng, X. PEALD-Grown Crystalline AlN Films on Si (100) with Sharp Interface and Good Uniformity. Nanoscale Res. Lett. 2017, 12, 279. [Google Scholar] [CrossRef]
- Lei, W.; Chen, Q. Crystal AlN deposited at low temperature by magnetic field enhanced plasma assisted atomic layer deposition. J. Vac. Sci. Technol. A 2012, 31, 01A114. [Google Scholar] [CrossRef]
- Alevli, M.; Ozgit, C.; Donmez, I.; Biyikli, N. The influence of N2/H2 and ammonia N source materials on optical and structural properties of AlN films grown by plasma enhanced atomic layer deposition. J. Cryst. Growth 2011, 335, 51–57. [Google Scholar] [CrossRef]
- Iriarte, G.F.; Reyes, D.F.; González, D.; Rodriguez, J.G.; García, R.; Calle, F. Influence of substrate crystallography on the room temperature synthesis of AlN thin films by reactive sputtering. Appl. Surf. Sci. 2011, 257, 9306–9313. [Google Scholar] [CrossRef]
- García-Méndez, M.; Morales-Rodríguez, S.; Shaji, S.; Krishnan, B.; Bartolo-Pérez, P. Structural properties of AlN films with oxygen content deposited by reactive magnetron sputtering: XRD and XPS characterization. Surf. Rev. Lett. 2011, 18, 23–31. [Google Scholar] [CrossRef]
- Moram, M.A.; Vickers, M.E. X-ray diffraction of III-nitrides. Rep. Prog. Phys. 2009, 72, 036502. [Google Scholar] [CrossRef]
- Österlund, E.; Seppänen, H.; Bespalova, K.; Miikkulainen, V.; Paulasto-Kröckel, M. Atomic layer deposition of AlN using atomic layer annealing—Towards high-quality AlN on vertical sidewalls. J. Vac. Sci. Technol. A 2021, 39, 032403. [Google Scholar] [CrossRef]
- Sun, C.J.; Kung, P.; Saxler, A.; Ohsato, H.; Haritos, K.; Razeghi, M. A crystallographic model of (00⋅1) aluminum nitride epitaxial thin film growth on (00⋅1) sapphire substrate. J. Appl. Phys. 1994, 75, 3964–3967. [Google Scholar] [CrossRef]
- Zhou, S.Q.; Vantomme, A.; Zhang, B.S.; Yang, H.; Wu, M.F. Comparison of the properties of GaN grown on complex Si-based structures. Appl. Phys. Lett. 2005, 86, 081912. [Google Scholar] [CrossRef]
- Scherrer, P. Bestimmung der Grösse und der inneren Struktur von Kolloidteilchen mittels Röntgenstrahlen. Nachr. Von Der Ges. Der Wiss. Zu Göttingen Math. Phys. Kl. 1918, 1918, 98–100. [Google Scholar]
- Dovidenko, K.; Oktyabrsky, S.; Narayan, J.; Razeghi, M. Aluminum nitride films on different orientations of sapphire and silicon. J. Appl. Phys. 1996, 79, 2439–2445. [Google Scholar] [CrossRef]
- Chason, E.; Mayer, T.M. Thin film and surface characterization by specular X-ray reflectivity. Crit. Rev. Solid State Mater. Sci. 1997, 22, 1–67. [Google Scholar] [CrossRef]
- Motamedi, P.; Cadien, K. Structural and optical characterization of low-temperature ALD crystalline AlN. J. Cryst. Growth 2015, 421, 45–52. [Google Scholar] [CrossRef]
- Alevli, M.; Ozgit, C.; Donmez, I.; Biyikli, N. Structural properties of AlN films deposited by plasma-enhanced atomic layer deposition at different growth temperatures. Phys. Status Solidi A 2012, 209, 266–271. [Google Scholar] [CrossRef]
- Venkataraj, S.; Severin, D.; Drese, R.; Koerfer, F.; Wuttig, M. Structural, optical and mechanical properties of aluminium nitride films prepared by reactive DC magnetron sputtering. Thin Solid Film. 2006, 502, 235–239. [Google Scholar] [CrossRef]
- Martin, Y.; Williams, C.C.; Wickramasinghe, H.K. Atomic force microscope–force mapping and profiling on a sub 100-Å scale. J. Appl. Phys. 1987, 61, 4723–4729. [Google Scholar] [CrossRef]
- Liu, S.; Zhao, G.; He, Y.; Wei, H.; Li, Y.; Qiu, P.; Song, Y.; An, Y.; Wang, X.; Wang, X.; et al. Interfacial Tailoring for the Suppression of Impurities in GaN by In Situ Plasma Pretreatment via Atomic Layer Deposition. ACS Appl. Mater. Interfaces 2019, 11, 35382–35388. [Google Scholar] [CrossRef]
- Motamedi, P.; Cadien, K. XPS analysis of AlN thin films deposited by plasma enhanced atomic layer deposition. Appl. Surf. Sci. 2014, 315, 104–109. [Google Scholar] [CrossRef]



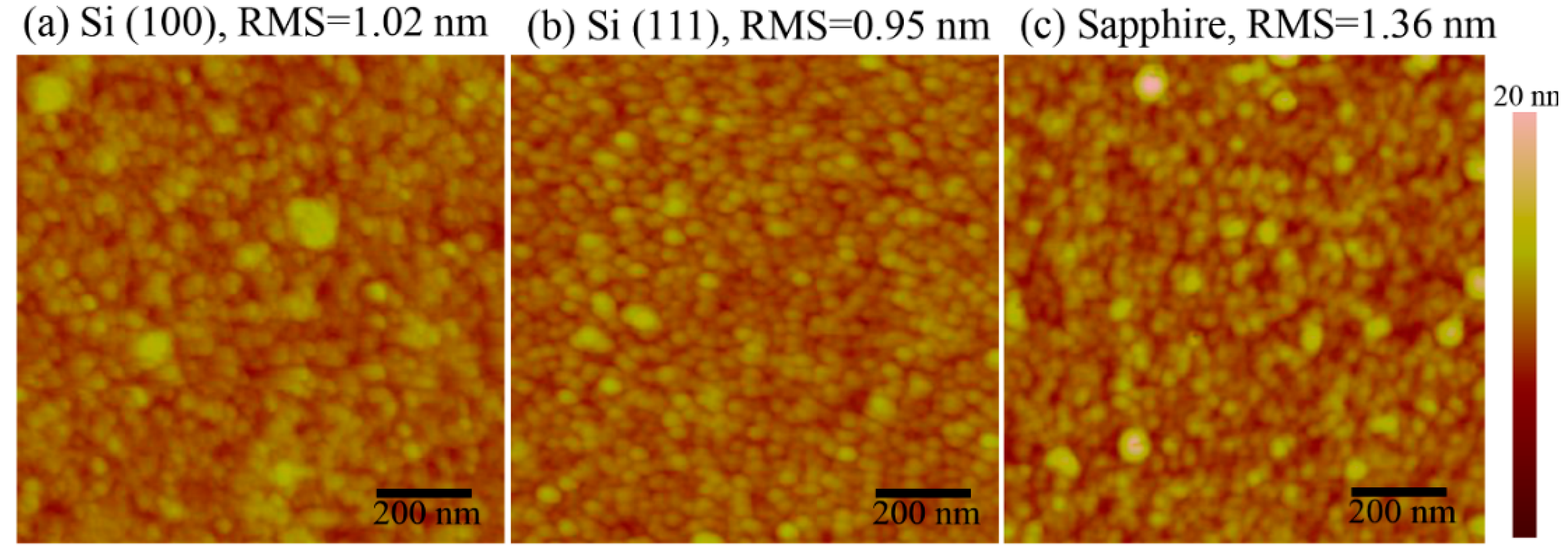
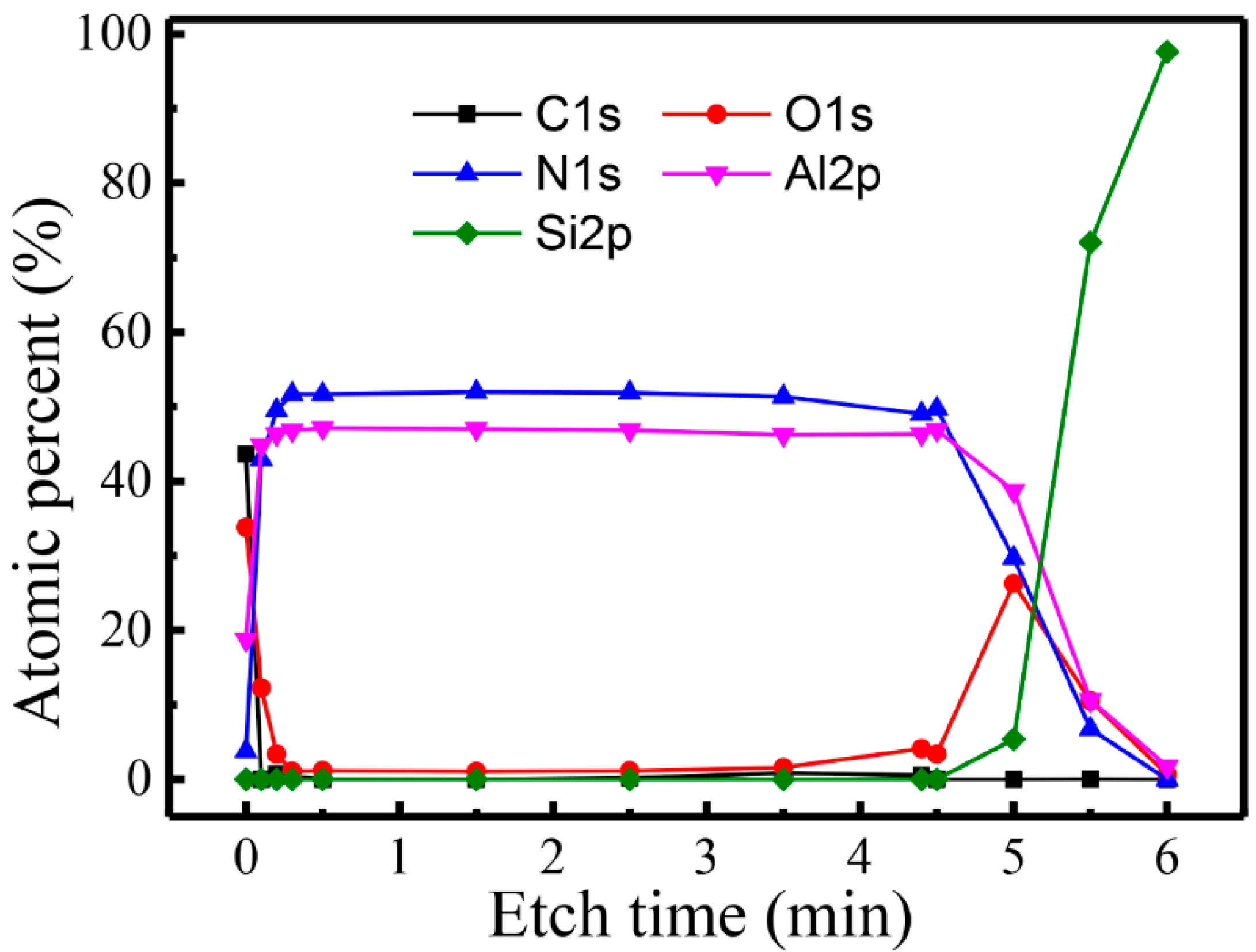

| Substrates | 2θ (°) | FWHM (°) | c (Å) | a (Å) | Grain Size (Å) |
|---|---|---|---|---|---|
| Si (100) | 35.941 | 0.575 | 4.992 | 3.105 | 146.86 |
| Si (111) | 35.755 | 0.554 | 5.018 | 3.100 | 152.35 |
| c-Al2O3 | 35.899 | 0.530 | 4.999 | 3.122 | 159.31 |
| Materials | AlN | Sapphire | Si |
|---|---|---|---|
| Lattice constant (Å) | a = 3.111 b = 4.981 | a = 4.758 b = 12.99 | a = 5.431 |
| Lattice Mismatch (with AlN) | —— | +13.2% | −19.0% |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Liu, S.; Li, Y.; Tao, J.; Tang, R.; Zheng, X. Structural, Surface, and Optical Properties of AlN Thin Films Grown on Different Substrates by PEALD. Crystals 2023, 13, 910. https://doi.org/10.3390/cryst13060910
Liu S, Li Y, Tao J, Tang R, Zheng X. Structural, Surface, and Optical Properties of AlN Thin Films Grown on Different Substrates by PEALD. Crystals. 2023; 13(6):910. https://doi.org/10.3390/cryst13060910
Chicago/Turabian StyleLiu, Sanjie, Yangfeng Li, Jiayou Tao, Ruifan Tang, and Xinhe Zheng. 2023. "Structural, Surface, and Optical Properties of AlN Thin Films Grown on Different Substrates by PEALD" Crystals 13, no. 6: 910. https://doi.org/10.3390/cryst13060910
APA StyleLiu, S., Li, Y., Tao, J., Tang, R., & Zheng, X. (2023). Structural, Surface, and Optical Properties of AlN Thin Films Grown on Different Substrates by PEALD. Crystals, 13(6), 910. https://doi.org/10.3390/cryst13060910







