Influence of Passivation Layers on Positive Gate Bias-Stress Stability of Amorphous InGaZnO Thin-Film Transistors
Abstract
1. Introduction
2. Materials and Methods
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- Nomura, K.; Ohta, H.; Takagi, A.; Kamiya, T.; Hirano, M.; Hosono, H. Room-temperature fabrication of transparent flexible thin-film transistors using amorphous oxide semiconductors. Nature 2004, 432, 488–492. [Google Scholar] [CrossRef] [PubMed]
- Kim, M.K.; Jeong, J.H.; Lee, H.J.; Ahn, T.K.; Shin, H.S.; Park, J.S.; Jeong, J.K.; Mo, Y.G.; Kim, H.D. High mobility bottom gate InGaZnO thin film transistors with SiOx etch stopper. Appl. Phys. Lett. 2007, 90, 212114. [Google Scholar] [CrossRef]
- Suresh, A.; Muth, J.F. Bias stress stability of indium gallium zinc oxide channel based transparent thin film transistors. Appl. Phys. Lett. 2008, 92, 033502. [Google Scholar] [CrossRef]
- Lee, J.M.; Cho, I.T.; Lee, J.H.; Kwon, H.I. Bias-stress-induced stretched-exponential time dependence of threshold voltage shift in InGaZnO thin film transistors. Appl. Phys. Lett. 2008, 93, 093504. [Google Scholar] [CrossRef]
- Chen, T.C.; Chang, T.C.; Hsieh, T.Y.; Lu, W.S.; Jian, F.Y.; Tsai, C.T.; Huang, S.Y.; Lin, C.S. Investigating the degradation behavior caused by charge trapping effect under DC and AC gate-bias stress for InGaZnO thin film transistor. Appl. Phys. Lett. 2011, 99, 022104. [Google Scholar] [CrossRef]
- Kim, S.J.; Lee, S.Y.; Lee, Y.W.; Kuk, S.H.; Kwon, J.Y.; Han, M.K. Effect of Charge Trapping/Detrapping on Threshold Voltage Shift of IGZO TFTs under AC Bias Stress. Electrochem. Solid-State Lett. 2012, 15, H108–H110. [Google Scholar] [CrossRef]
- Sung, S.Y.; Choi, J.H.; Han, U.B.; Lee, K.C.; Lee, J.H.; Kim, J.J.; Lim, W.; Pearton, S.J.; Norton, D.P.; Heo, Y.W. Effects of ambient atmosphere on the transfer characteristics and gate-bias stress stability of amorphous indium-gallium-zinc oxide thin-film transistors. Appl. Phys. Lett. 2010, 96, 102107. [Google Scholar] [CrossRef]
- Jeong, J.K.; Yang, H.W.; Jeong, J.H.; Mo, Y.G.; Kim, H.D. Origin of threshold voltage instability in indium-gallium-zinc oxide thin film transistors. Appl. Phys. Lett. 2008, 93, 123508. [Google Scholar] [CrossRef]
- Liu, P.T.; Chou, Y.T.; Teng, L.F. Environment-dependent metastability of passivation-free indium zinc oxide thin film transistor after gate bias stress. Appl. Phys. Lett. 2009, 95, 233504. [Google Scholar] [CrossRef]
- Chen, Y.C.; Chang, T.C.; Li, H.W.; Chen, S.C.; Lu, J.; Chung, W.F.; Tai, Y.H.; Tseng, T.Y. Bias-induced oxygen adsorption in zinc tin oxide thin film transistors under dynamic stress. Appl. Phys. Lett. 2010, 96, 262104. [Google Scholar] [CrossRef]
- Zhang, J.; Li, X.F.; Lu, J.G.; Zhou, N.J.; Guo, P.J.; Lu, B.; Pan, X.H.; Chen, L.X.; Ye, Z.Z. Water assisted oxygen absorption on the instability of amorphous InAlZnO thin-film transistors. RSC Adv. 2014, 4, 3145–3148. [Google Scholar] [CrossRef]
- Chung, W.F.; Chang, T.C.; Li, H.W.; Chen, S.C.; Chen, Y.C.; Tseng, T.Y.; Tai, Y.H. H2O-Assisted O2 Adsorption in Sol-Gel Derived Amorphous Indium Gallium Zinc Oxide Thin Film Transistors. Electrochem. Solid State Lett. 2011, 14, H235–H237. [Google Scholar] [CrossRef]
- Huang, S.Y.; Chang, T.C.; Chen, M.C.; Chen, S.C.; Tsai, C.T.; Hung, M.C.; Tu, C.H.; Chen, C.H.; Chang, J.J.; Liau, W.L. Effects of Ambient Atmosphere on Electrical Characteristics of Al2O3 Passivated InGaZnO Thin Film Transistors during Positive-Bias-Temperature-Stress Operation. Electrochem. Solid State Lett. 2011, 14, H177–H179. [Google Scholar] [CrossRef]
- Chen, F.H.; Pan, T.M.; Chen, C.H.; Liu, J.H.; Lin, W.H.; Chen, P.H. Two-step Electrical Degradation Behavior in α-InGaZnO Thin-film Transistor Under Gate-bias Stress. IEEE Electron Device Lett. 2013, 34, 635–637. [Google Scholar] [CrossRef]
- Cho, E.N.; Kang, J.H.; Yun, I. Effects of channel thickness variation on bias stress instability of InGaZnO thin-film transistors. Microelectron. Reliab. 2011, 51, 1792–1795. [Google Scholar] [CrossRef]
- Li, J.; Ding, X.W.; Zhang, J.H.; Zhang, H.; Jiang, X.Y.; Zhang, Z.L. Improving electrical performance and bias stability of HfInZnO-TFT with optimizing the channel thickness. AIP Adv. 2013, 3, 102132. [Google Scholar] [CrossRef]
- Lin, W.K.; Liu, K.C.; Chen, J.N.; Hu, S.C.; Chang, S.T. The influence of fabrication process on top-gate thin-film transistors. Thin Solid Films 2011, 519, 5126–5130. [Google Scholar] [CrossRef]
- Lin, W.K.; Liu, K.C.; Chang, S.T.; Li, C.S. Room temperature fabricated transparent amorphous indium zinc oxide based thin film transistor using high-κ HfO2 as gate insulator. Thin Solid Films 2011, 520, 3079–3083. [Google Scholar] [CrossRef]
- Li, G.T.; Yang, B.R.; Liu, C.; Lee, C.Y.; Tseng, C.Y.; Lo, C.C.; Lien, A.; Deng, S.Z.; Shieh, H.P.D.; Xu, N.S. Positive gate bias instability alleviated by self-passivation effect in amorphous InGaZnO thin-film transistors. J. Phys. D Appl. Phys. 2015, 48, 475107. [Google Scholar] [CrossRef]
- Fan, C.L.; Shang, M.C.; Li, B.J.; Lin, Y.Z.; Wang, S.J.; Lee, W.D.; Hung, B.R. Teflon/SiO2 bilayer passivation for improving the electrical reliability of oxide TFTs fabricated using a new two-photomask self-alignment process. Materials 2015, 8, 1704–1713. [Google Scholar] [CrossRef] [PubMed]
- Li, J.; Zhou, F.; Lin, H.P.; Zhu, W.Q.; Zhang, J.H.; Jiang, X.Y.; Zhang, Z.L. Effect of reactive sputtered SiOx passivation layer on the stability of InGaZnO thin film transistors. Vacuum 2012, 86, 1840–1843. [Google Scholar] [CrossRef]
- Zhou, Y.; Xu, J.; Xie, H.; Zhang, L.; Liu, G.; Tong, X.; Dong, C. Moisture Dominant Electrical Degradation of Amorphous InGaZnO Thin Film Transistors under Positive Bias Stress. In Proceedings of the International Display Workshop (IDW)’17, Sendai, Japan, 6–8 December 2017; pp. 424–426. [Google Scholar]
- Wu, J.; Chen, Y.; Zhou, D.; Hu, Z.; Xie, H.; Dong, C. Sputtered oxides used for passivation layers of amorphous InGaZnO thin film transistors. Mater. Sci. Semicond. Process. 2014, 29, 277–282. [Google Scholar] [CrossRef]
- Graff, G.L.; Burrows, P.E.; Williford, R.E.; Praino, R.F. Barrier Layer Technology for Flexible Displays. In Flexible Flat Panel Display, 1st ed.; Crawford, G.P., Ed.; Brown University: Providence, RI, USA, 2005; pp. 57–60. ISBN 0-470-87048-6. [Google Scholar]
- Chen, Y.C.; Chang, T.C.; Li, H.W.; Chen, S.C.; Chung, W.F.; Chen, Y.H.; Tai, Y.H.; Tseng, T.Y.; Yeh, F.S. Surface states related the bias stability of amorphous In–Ga–Zn–O thin film transistors under different ambient gasses. Thin Solid Films 2011, 520, 1432–1436. [Google Scholar] [CrossRef]
- Chen, T.C.; Chang, T.C.; Hsieh, T.Y.; Tsai, C.T.; Chen, S.C.; Lin, C.S.; Hung, M.C.; Tu, C.H.; Chang, J.J.; Chen, P.L. Light-induced instability of an InGaZnO thin film transistor with and without SiOx passivation layer formed by plasma-enhanced-chemical-vapor-deposition. Appl. Phys. Lett. 2010, 97, 192103. [Google Scholar] [CrossRef]
- Ohara, H.; Sasaki, T.; Noda, K.; Ito, S.; Sasaki, M.; Endo, Y.; Yoshitomi, S.; Sakata, J.; Serikawa, T.; Yamazaki, S. 4.0-inch active-matrix organic light-emitting diode display integrated with driver circuits using amorphous In–Ga–Zn-Oxide thin-film transistors with suppressed variation. Jpn. J. Appl. Phys. 2010, 49, 03CD02. [Google Scholar] [CrossRef]

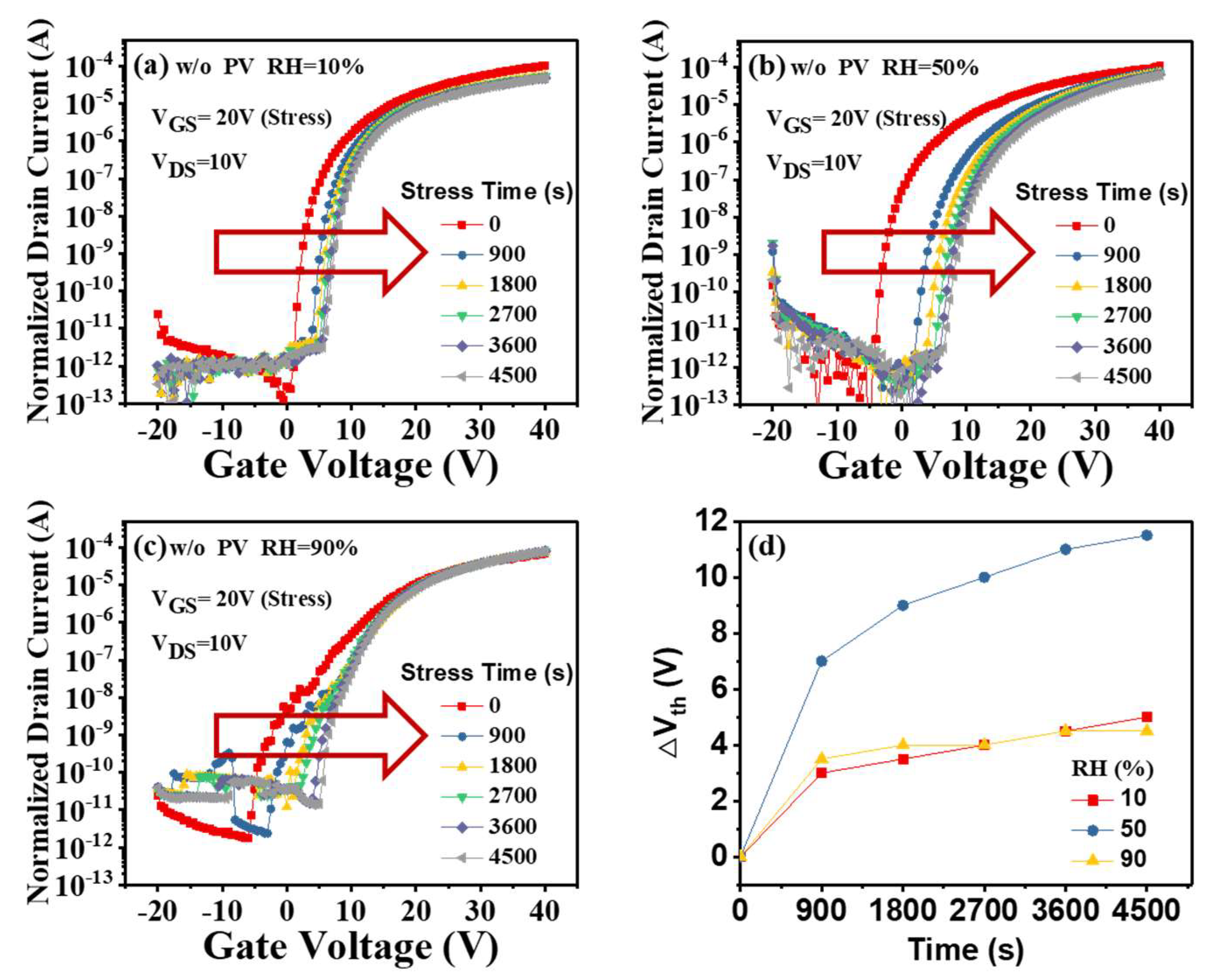
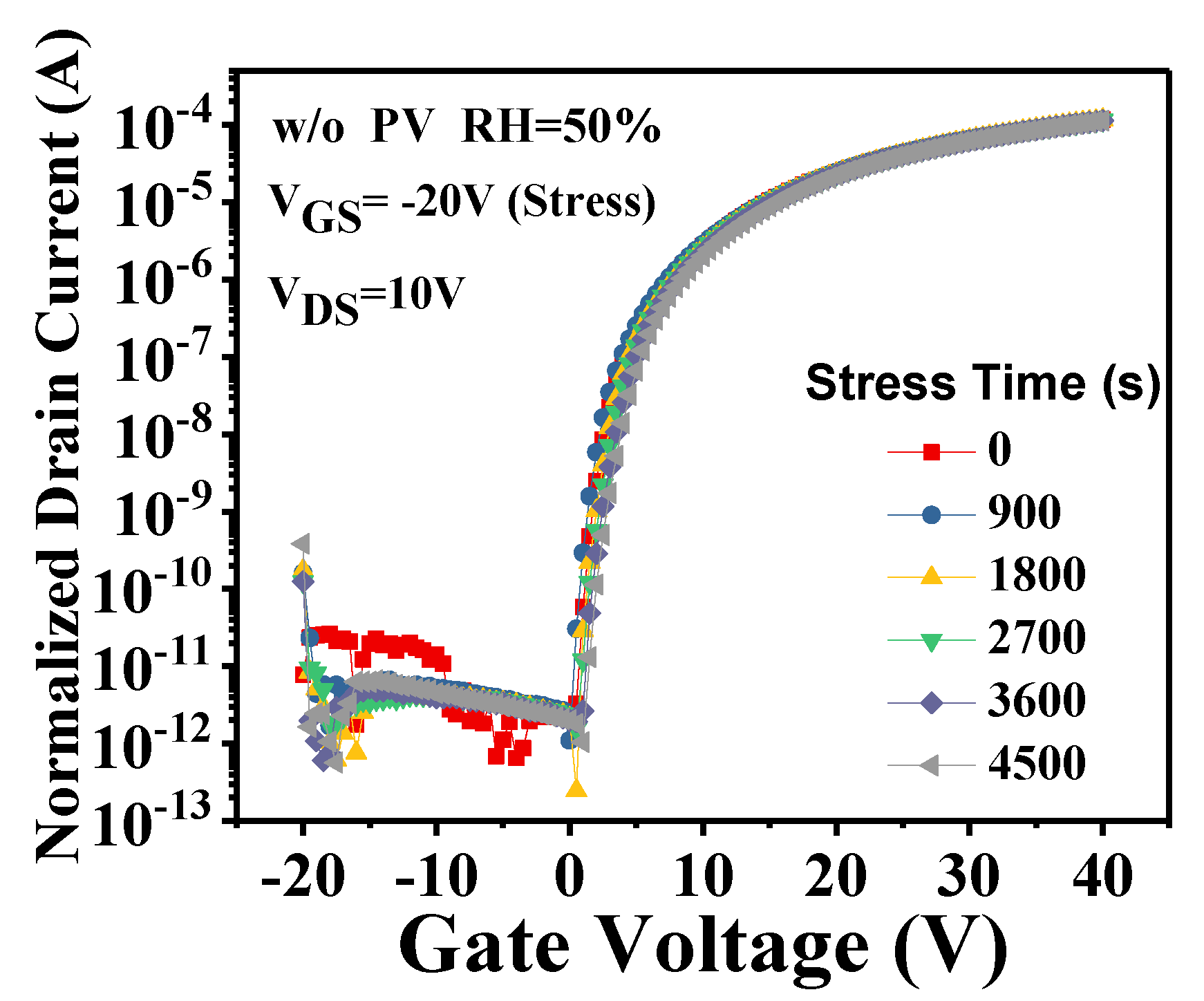
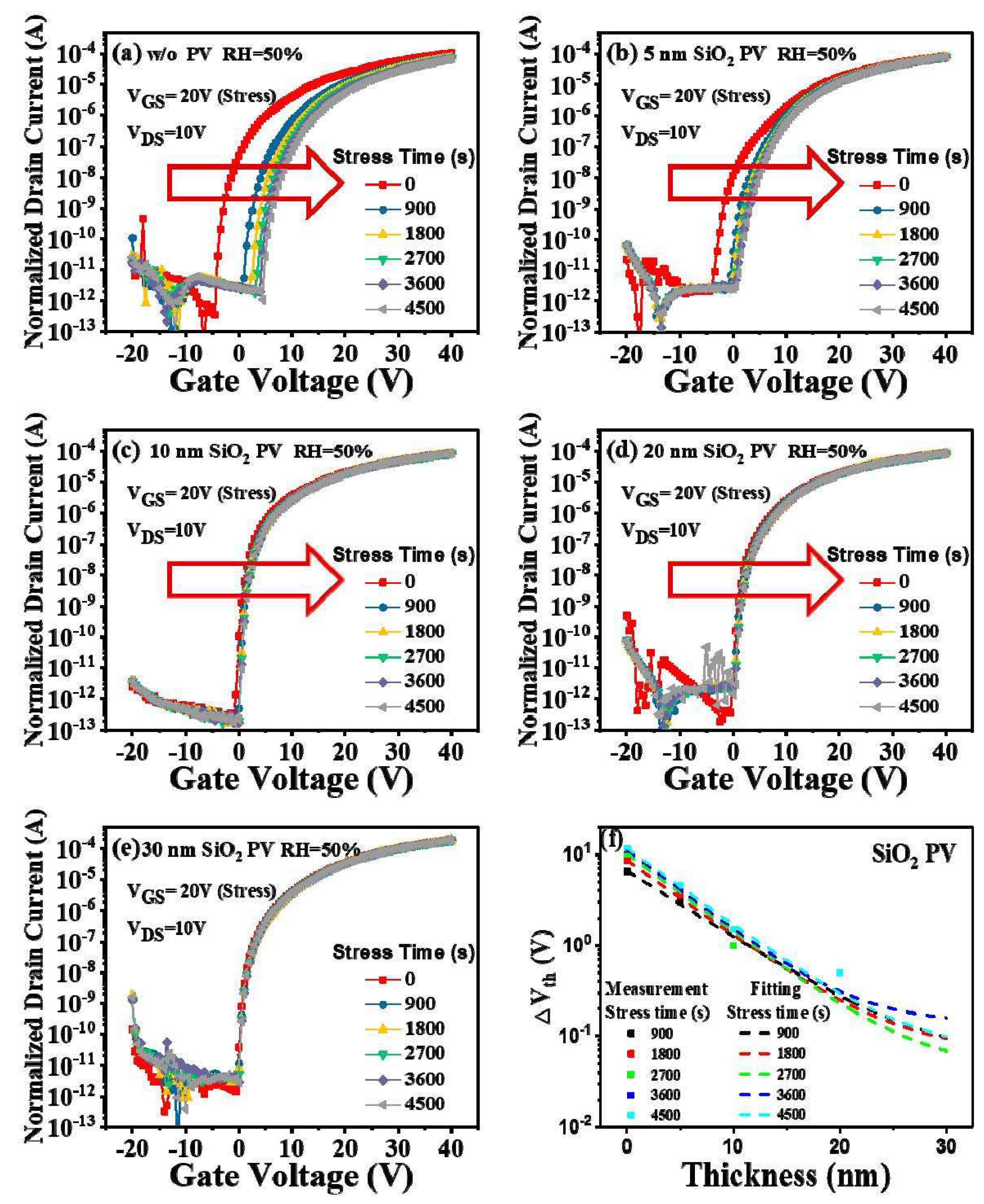
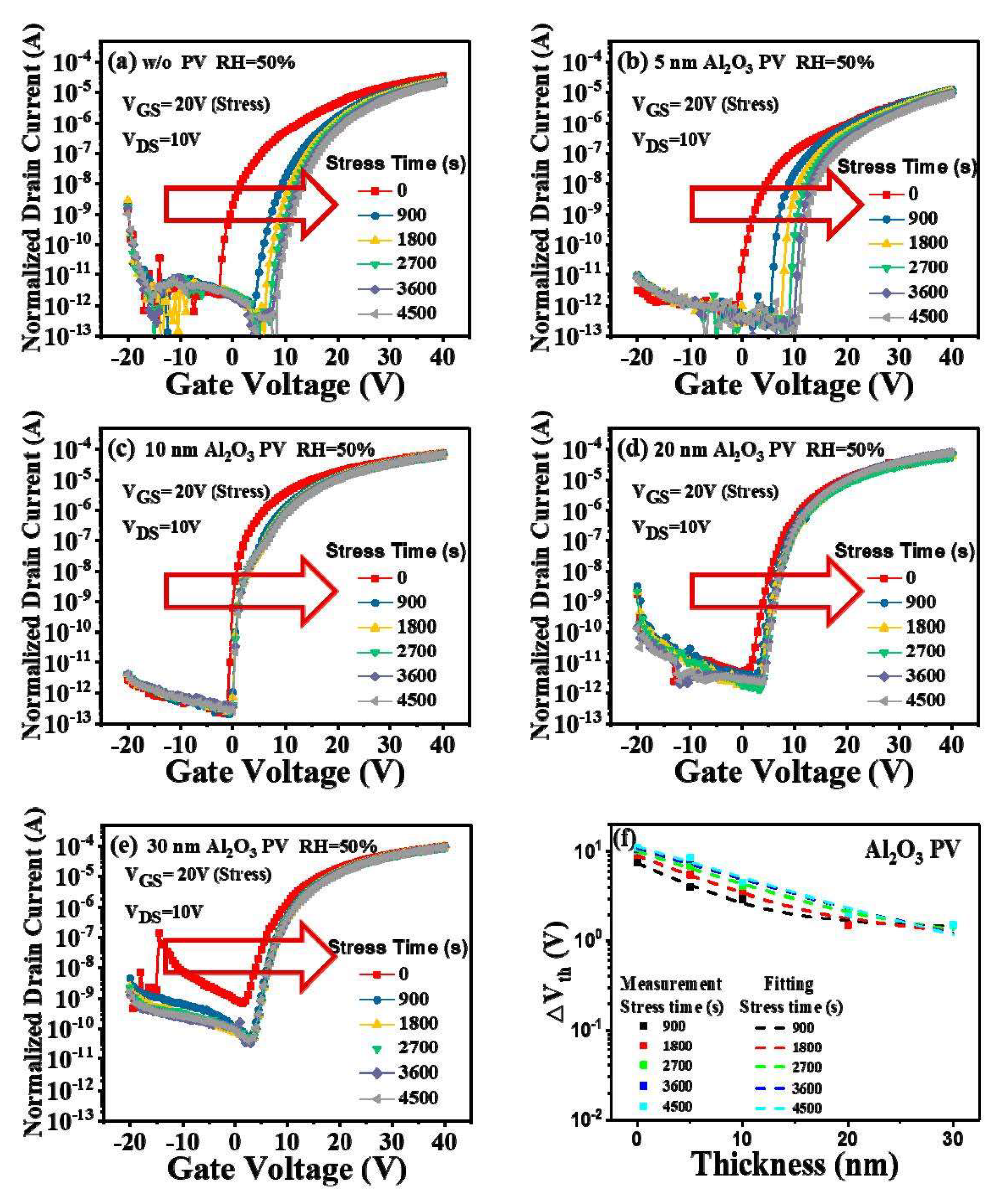
| Materials | Stress Time (s) | α (V) | β (V) | ε (nm) |
|---|---|---|---|---|
| SiO2 | 900 | 6.47 | 0.06 | 5.93 |
| 1800 | 8.46 | 0.07 | 5.22 | |
| 2700 | 10 | 0.04 | 5.03 | |
| 3600 | 10.86 | 0.14 | 4.86 | |
| 4500 | 11.45 | 0.06 | 5.13 | |
| Al2O3 | 900 | 6.07 | 1.39 | 9.24 |
| 1800 | 7.95 | 1.09 | 9.53 | |
| 2700 | 9.31 | 0.84 | 10.21 | |
| 3600 | 10.46 | 0.30 | 11.23 | |
| 4500 | 11.07 | 0.25 | 11.06 |
© 2018 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Zhou, Y.; Dong, C. Influence of Passivation Layers on Positive Gate Bias-Stress Stability of Amorphous InGaZnO Thin-Film Transistors. Micromachines 2018, 9, 603. https://doi.org/10.3390/mi9110603
Zhou Y, Dong C. Influence of Passivation Layers on Positive Gate Bias-Stress Stability of Amorphous InGaZnO Thin-Film Transistors. Micromachines. 2018; 9(11):603. https://doi.org/10.3390/mi9110603
Chicago/Turabian StyleZhou, Yan, and Chengyuan Dong. 2018. "Influence of Passivation Layers on Positive Gate Bias-Stress Stability of Amorphous InGaZnO Thin-Film Transistors" Micromachines 9, no. 11: 603. https://doi.org/10.3390/mi9110603
APA StyleZhou, Y., & Dong, C. (2018). Influence of Passivation Layers on Positive Gate Bias-Stress Stability of Amorphous InGaZnO Thin-Film Transistors. Micromachines, 9(11), 603. https://doi.org/10.3390/mi9110603





