Boron-Related Defects in N-Type 4H-SiC Schottky Barrier Diodes
Abstract
1. Introduction
2. Materials and Methods
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Anikin, M.M.; Lebedev, A.A.; Syrkin, A.L.; Suvorov, A.V. Capacity-spectroscopic study of deep levels in SiC. Fiz. Tekh. Poluprovodn. 1985, 13, 114. [Google Scholar]
- Capan, I.; Brodar, T.; Yamazaki, Y.; Oki, Y.; Ohshima, T.; Chiba, Y.; Hijikata, Y.; Snoj, L.; Radulović, V. Influence of neutron radiation on majority and minority carrier traps in n-type 4H-SiC. Nucl. Instrum. Methods Phys. Res. Sect. B Beam Interact. Mater. Atoms. 2020, 478, 224. [Google Scholar] [CrossRef]
- Suttrop, W.; Pensl, G.; Lanig, P. Boron-related deep centers in 6H-SiC. Appl. Phys. A 1990, 51, 231–237. [Google Scholar] [CrossRef]
- Beyer, F.C.; Hemmingsson, C.G.; Leone, S.; Lin, Y.-C.; Gällström, A.; Henry, A.; Janzén, E. Deep levels in iron doped n- and p-type 4H-SiC. J. Appl. Phys. 2011, 110, 123701. [Google Scholar] [CrossRef]
- Zhang, J.; Storasta, L.; Bergman, J.P.; Son, N.T.; Janzén, E. Electrically active defects in n-type 4H-silicon carbide grown in a vertical hot-wall reactor. J. Appl. Phys. 2003, 93, 4708–4714. [Google Scholar] [CrossRef]
- Yang, A.; Murata, K.; Miyazawa, T.; Tawara, T.; Tsuchida, H. Analysis of carrier lifetimes in N + B-doped n-type 4H-SiC epilayers. J. Appl. Phys. 2019, 126, 055103. [Google Scholar] [CrossRef]
- Storasta, L.; Bergman, J.P.; Hallin, C.; Janzen, E. Electrical Activity of Residual Boron in Silicon Carbide. Mater. Sci. Forum 2002, 389–393, 549–552. [Google Scholar] [CrossRef]
- Ito, M.; Storasta, L.; Tsuchida, H. Development of 4H–SiC Epitaxial Growth Technique Achieving High Growth Rate and Large-Area Uniformity. Appl. Phys. Express 2008, 1, 015001. [Google Scholar] [CrossRef]
- Peaker, A.R.; Markevich, V.P.; Coutinho, J. Tutorial: Junction spectroscopy techniques and deep-level defects in semiconductors. J. Appl. Phys. 2018, 123, 161559. [Google Scholar] [CrossRef]
- Peaker, A.R.; Dobachewski, L. Laplace-transform deep-level spectroscopy: The technique and its applications to the study of point defects in semiconductors. J. Appl. Phys. 2004, 96, 4689–4728. [Google Scholar] [CrossRef]
- Hamilton, B.; Peaker, A.R.; Wight, D.R. Deep-state-controlled minority-carrier lifetime in n-type gallium phosphide. J. Appl. Phys. 1979, 50, 6373–6385. [Google Scholar] [CrossRef]
- Brunwin, R.; Hamilton, B.; Jordan, P.; Peaker, A.R. Detection of minority-carrier traps using transient spectroscopy. Electron. Lett. 1979, 15, 349–350. [Google Scholar] [CrossRef]
- Gora, V.E.; Auret, F.D.; Danga, H.T.; Tunhuma, S.M.; Nyamhere, C.; Igumbor, E.; Chawanda, A. Barrier height inhomogeneities on Pd/n-4H-SiC Schottky diodes in a wide temperature range. Mater. Sci. Eng. B 2019, 247, 114370. [Google Scholar] [CrossRef]
- Mourya, S.K.; Malik, G.; Alisha, A.; Kumar, B.; Chandra, R. The role of non-homogeneous barrier on the electrical performance of 15R–SiC Schottky diodes grown by in-situ RF sputtering. Mater. Sci. Semicond. Process. 2022, 149, 106855. [Google Scholar] [CrossRef]
- Im, H.-J.; Ding, Y.; Pelz, J.P.; Choyke, W.J. Nanometer-scale test of the Tung model of Schottky-barrier height inhomogeneity. Phys. Rev. B 2001, 64, 075310. [Google Scholar] [CrossRef]
- Son, N.T.; Trinh, X.T.; Løvlie, L.S.; Svensson, B.G.; Kawahara, K.; Suda, J.; Kimoto, T.; Umeda, T.; Isoya, J.; Makino, T.; et al. Negative-U System of Carbon Vacancy in 4H-SiC. Phys. Rev. Lett. 2012, 109, 187603. [Google Scholar] [CrossRef] [PubMed]
- Hemmingsson, C.G.; Son, N.T.; Ellison, A.; Zhang, J.; Janzén, E. Negative- U centers in 4 H silicon carbide. Phys. Rev. B 1998, 58, R10119–R10122. [Google Scholar] [CrossRef]
- Kimoto, T.; Danno, K.; Suda, J. Lifetime-killing defects in 4H-SiC epilayers and lifetime control by low-energy electron irradiation. Phys. Stat. Sol. B 2008, 245, 1327. [Google Scholar] [CrossRef]
- Kawahara, K.; Thang Trinh, X.; Tien Son, N.; Janzén, E.; Suda, J.; Kimoto, T. Quantitative comparison between Z 1/2 center and carbon vacancy in 4H-SiC. J. Appl. Phys. 2014, 115, 143705. [Google Scholar] [CrossRef]
- Hazdra, P.; Popelka, S.; Schöner, A. Local Lifetime Control in 4H-SiC by Proton Irradiation. Mater. Sci. Forum 2018, 924, 436–439. [Google Scholar] [CrossRef]
- Galeckas, A.; Ayedh, H.M.; Bergman, J.P.; Svensson, B.G. Depth-Resolved Carrier Lifetime Measurements in 4H-SiC Epilayers Monitoring Carbon Vacancy Elimination. Mater. Sci. Forum 2017, 897, 258–261. [Google Scholar] [CrossRef]
- Capan, I.; Brodar, T.; Bernat, R.; Pastuović, Ž.; Makino, T.; Ohshima, T.; Gouveia, J.D.; Coutinho, J. M-center in 4H-SiC: Isothermal DLTS and first principles modeling studies. J. Appl. Phys. 2021, 130, 125703. [Google Scholar] [CrossRef]
- Knežević, T.; Brodar, T.; Radulović, V.; Snoj, L.; Makino, T.; Capan, I. Distinguishing the EH1 and S1 defects in n-type 4H-SiC by Laplace DLTS. Appl. Phys. Express 2022, 15, 101002. [Google Scholar] [CrossRef]
- Torres, V.J.B.; Capan, I.; Coutinho, J. Theory of shallow and deep boron defects in 4H-SiC. Phys. Rev. B 2022, 106, 224112. [Google Scholar] [CrossRef]
- Für, N.; Belanche, M.; Martinella, C.; Kumar, P.; Bathen, M.E.; Grossner, U. Investigation of electrically active defects in SiC power diodes caused by heavy ion irradiation. IEEE Trans. Nucl. Sci. 2023. [Google Scholar] [CrossRef]
- Bockstedte, M.; Mattausch, A.; Pankratov, O. Boron in SiC: Structure and kinetics. Mater. Sci. Forum 2001, 353–356, 447. [Google Scholar] [CrossRef]
- Ghezellou, M.; Kumar, P.; Bathen, M.E.; Karsthof, R.; Sveinbjörnsson, E.Ö.; Grossner, U.; Bergman, J.P.; Vines, L.; Ul-Hassan, J. The role of boron related defects in limiting charge carrier lifetime in 4H-SiC epitaxial layers. APL Mater. 2023, 11, 031107. [Google Scholar] [CrossRef]
- Deák, P.; Aradi, B.; Gali, A.; Gerstmann, U. Theory and shallow states in other materials-Some like. Phys. Status Solidi Basic Res. 2003, 235, 139. [Google Scholar] [CrossRef]
- Ruschenschmidt, K.; Bracht, H.; Laube, M.; Stolwijk, N.A.; Pensl, G. Diffusion of boron in silicon carbide. Phys. B 2001, 308–310, 734–737. [Google Scholar] [CrossRef]
- Bockstedte, M.; Mattausch, A.; Pankratov, O. Different roles of carbon and silicon interstitials in the interstitial-mediated boron diffusion in SiC. Phys. Rev. B 2004, 70, 115203. [Google Scholar] [CrossRef]
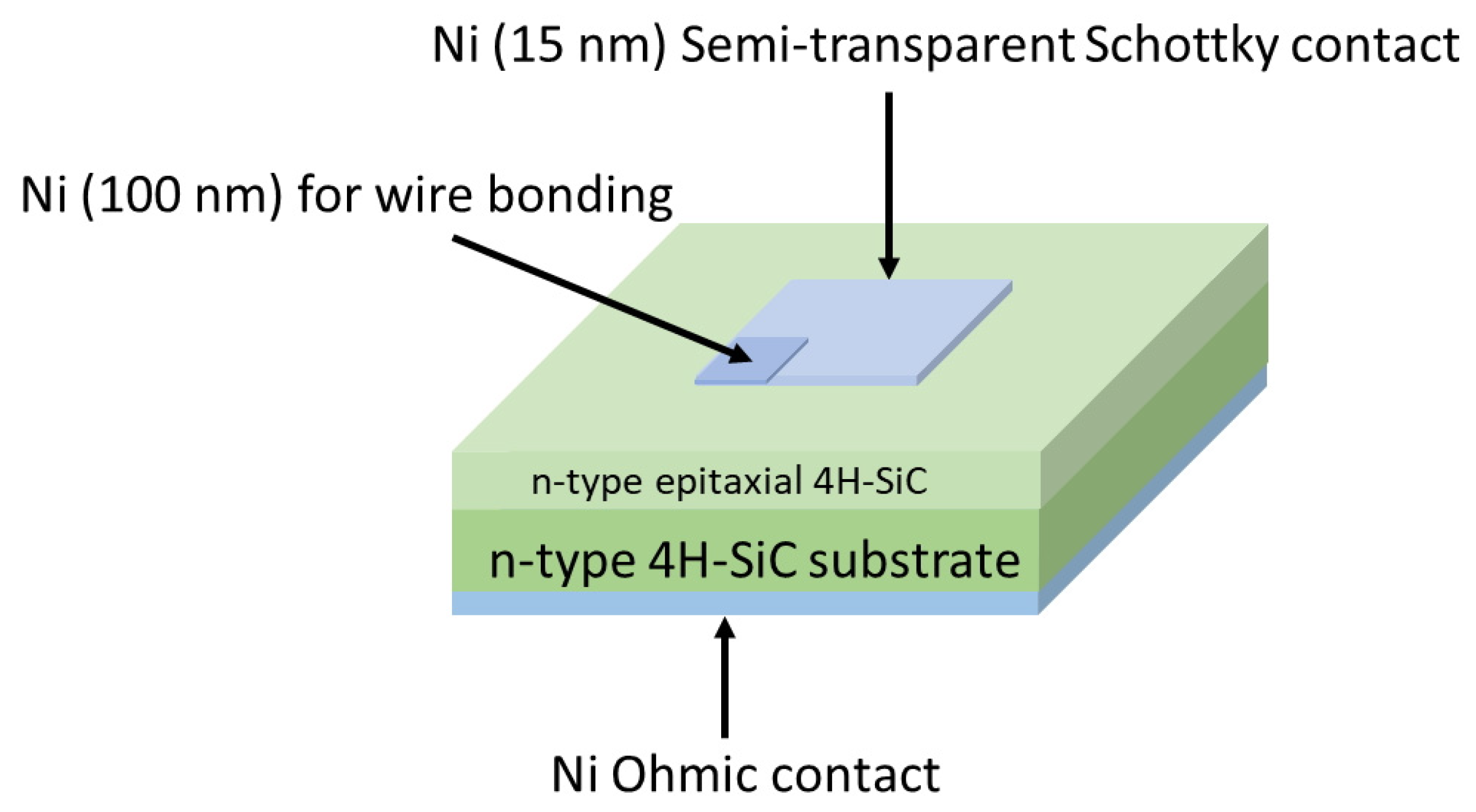
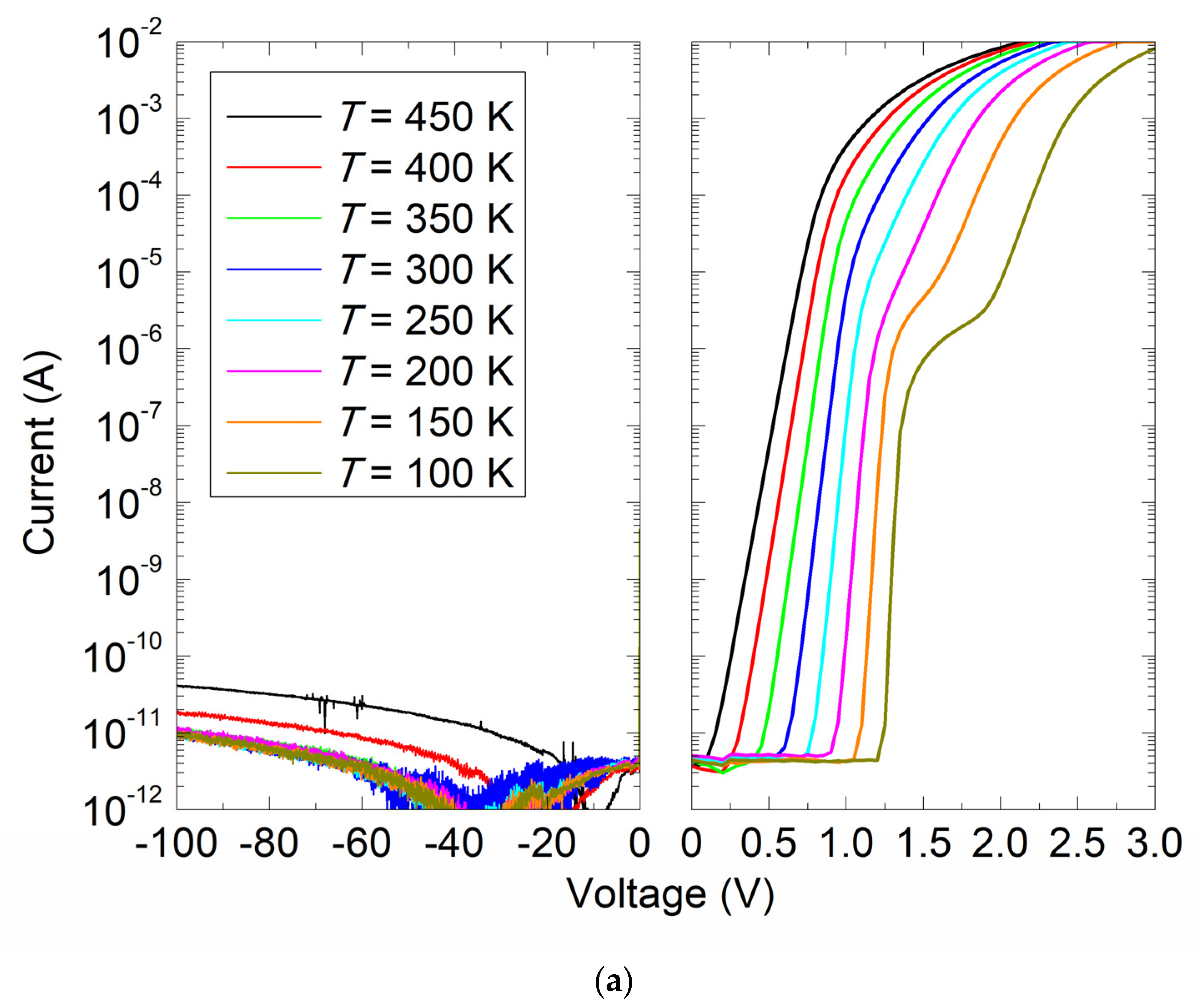
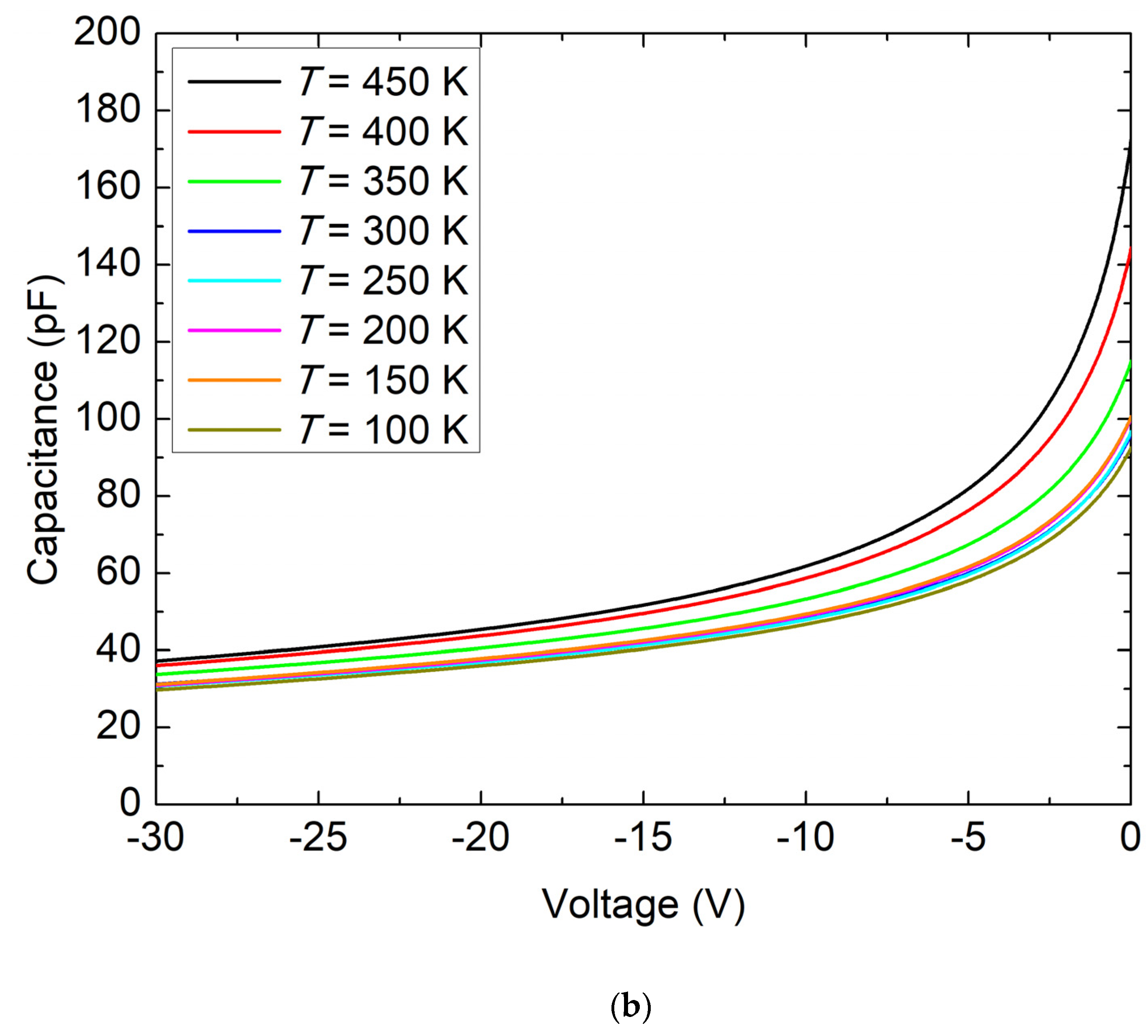

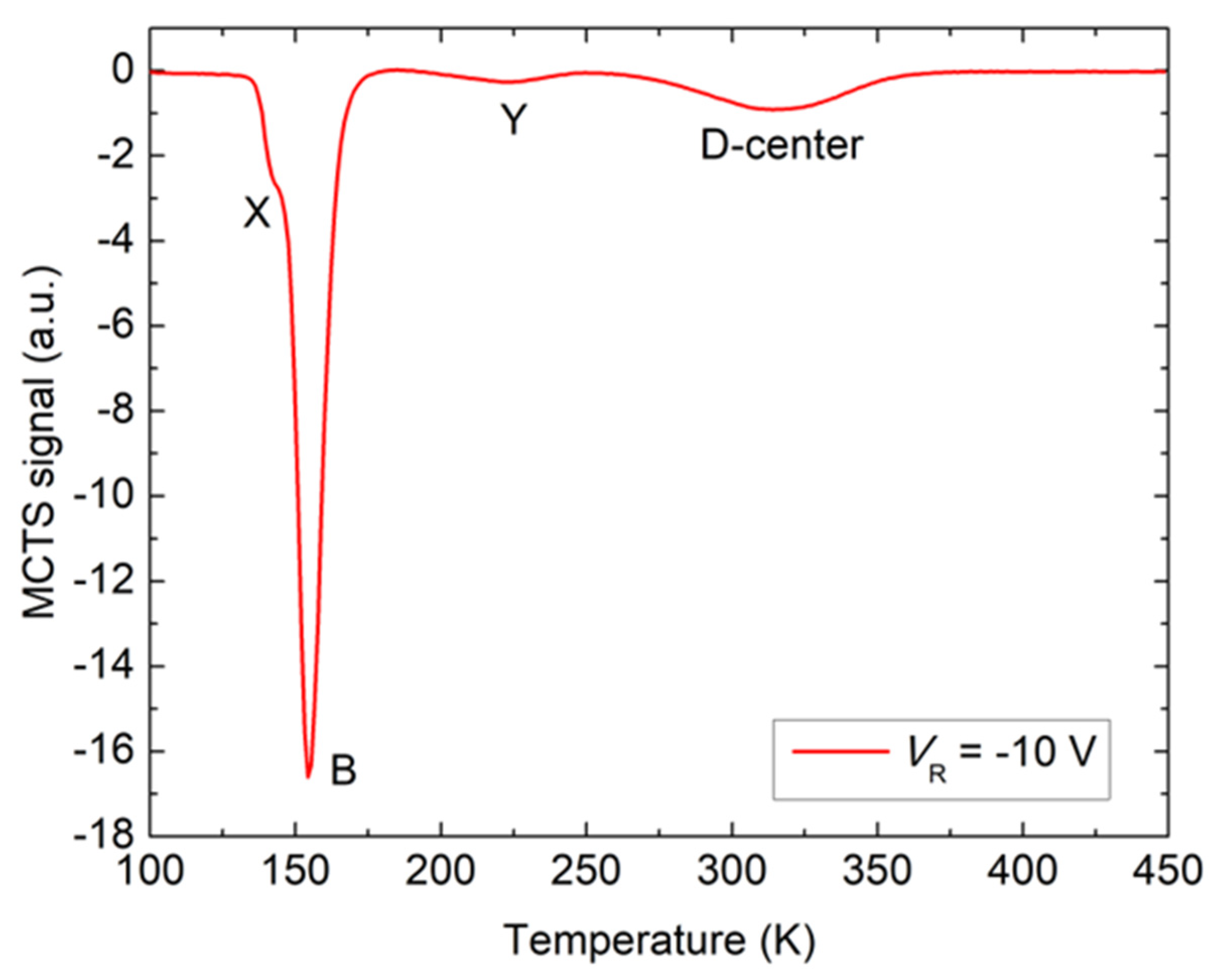

Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Knezevic, T.; Jelavić, E.; Yamazaki, Y.; Ohshima, T.; Makino, T.; Capan, I. Boron-Related Defects in N-Type 4H-SiC Schottky Barrier Diodes. Materials 2023, 16, 3347. https://doi.org/10.3390/ma16093347
Knezevic T, Jelavić E, Yamazaki Y, Ohshima T, Makino T, Capan I. Boron-Related Defects in N-Type 4H-SiC Schottky Barrier Diodes. Materials. 2023; 16(9):3347. https://doi.org/10.3390/ma16093347
Chicago/Turabian StyleKnezevic, Tihomir, Eva Jelavić, Yuichi Yamazaki, Takeshi Ohshima, Takahiro Makino, and Ivana Capan. 2023. "Boron-Related Defects in N-Type 4H-SiC Schottky Barrier Diodes" Materials 16, no. 9: 3347. https://doi.org/10.3390/ma16093347
APA StyleKnezevic, T., Jelavić, E., Yamazaki, Y., Ohshima, T., Makino, T., & Capan, I. (2023). Boron-Related Defects in N-Type 4H-SiC Schottky Barrier Diodes. Materials, 16(9), 3347. https://doi.org/10.3390/ma16093347







