Interfacial Characterization of Low-Temperature Cu-to-Cu Direct Bonding with Chemical Mechanical Planarized Nanotwinned Cu Films
Abstract
:1. Introduction
2. Materials and Methods
3. Results
3.1. Microstructure of nt-Cu Films
3.2. Microstructure of Bonding Interface
4. Discussion
5. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Chang, Y.-W.; Hu, C.-C.; Peng, H.-Y.; Liang, Y.-C.; Chen, C.; Chang, T.-C.; Zhan, C.-J.; Juang, J.-Y. A new failure mechanism of electromigration by surface diffusion of Sn on Ni and Cu metallization in microbumps. Sci. Rep. 2018, 8, 5935. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Liu, Y.; Chu, Y.-C.; Tu, K.-N. Scaling effect of interfacial reaction on intermetallic compound formation in Sn/Cu pillar down to 1 μm diameter. Acta Mater. 2016, 117, 146–152. [Google Scholar] [CrossRef]
- Shen, Y.-A.; Ouyang, F.-Y.; Chen, C. Effect of Sn grain orientation on growth of Cu-Sn intermetallic compounds during thermomigration in Cu-Sn2.3Ag-Ni microbumps. Mater. Lett. 2019, 236, 190–193. [Google Scholar] [CrossRef]
- Wang, J.; Wang, Q.; Wang, D.; Cai, J. Study on Ar (5% H2) plasma pretreatment for Cu/Sn/Cu solid-state-diffusion bonding in 3D interconnection. In Proceedings of the 2016 IEEE 66th Electronic Components and Technology Conference (ECTC), Piscataway, NJ, USA, 31 May–3 June 2016; pp. 1765–1771. [Google Scholar] [CrossRef]
- Shen, Y.-A.; Lin, C.-M.; Li, J.; He, S.; Nishikawa, H. Effect of FeCoNiCrCu0.5 High-entropy-alloy Substrate on Sn Grain Size in Sn-3.0Ag-0.5Cu Solder. Sci. Rep. 2019, 9, 3658. [Google Scholar] [CrossRef] [PubMed]
- Liang, Y.; Lin, H.; Chen, H.; Chen, C.; Tu, K.-N.; Lai, Y. Anisotropic grain growth and crack propagation in eutectic microstructure under cyclic temperature annealing in flip-chip SnPb composite solder joints. Scr. Mater. 2013, 69, 25–28. [Google Scholar] [CrossRef]
- Mo, C.C.; Tran, D.P.; Juang, J.Y.; Chen, C. Effect of Intermetallic Compound Bridging on the Cracking Resistance of Sn2.3Ag Microbumps with Different UBM Structures under Thermal Cycling. Metals 2021, 11, 1065. [Google Scholar] [CrossRef]
- Kim, T.; Howlader, M.; Itoh, T.; Suga, T. Room temperature Cu–Cu direct bonding using surface activated bonding method. J. Vac. Sci. Technol. A 2003, 21, 449–453. [Google Scholar] [CrossRef] [Green Version]
- Tang, Y.-S.; Chang, Y.-J.; Chen, K.-N. Wafer-level Cu–Cu bonding technology. Microelectron. Reliab. 2012, 52, 312–320. [Google Scholar] [CrossRef]
- Chen, K.N.; Fan, A.; Tan, C.S.; Reif, R.; Wen, C.Y. Microstructure evolution and abnormal grain growth during copper wafer bonding. Appl. Phys. Lett. 2002, 81, 3774–3776. [Google Scholar] [CrossRef]
- Juang, J.-Y.; Lu, C.-L.; Li, Y.-J.; Tu, K.-N.; Chen, C. Correlation between the microstructures of bonding interfaces and the shear strength of Cu-to-Cu joints using (111)-oriented and nanotwinned Cu. Materials 2018, 11, 2368. [Google Scholar] [CrossRef] [Green Version]
- Liu, C.-M.; Lin, H.-W.; Huang, Y.-S.; Chu, Y.-C.; Chen, C.; Lyu, D.-R.; Chen, K.-N.; Tu, K.-N. Low-temperature direct copper-to-copper bonding enabled by creep on (111) surfaces of nanotwinned Cu. Sci. Rep. 2015, 5, 9734. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Hsiao, H.-Y.; Liu, C.-M.; Lin, H.-w.; Liu, T.-C.; Lu, C.-L.; Huang, Y.-S.; Chen, C.; Tu, K.-N. Unidirectional growth of microbumps on (111)-oriented and nanotwinned copper. Science 2012, 336, 1007–1010. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Li, Y.-J.; Tu, K.-N.; Chen, C. Tensile properties of <111>-Oriented nanotwinned Cu with different columnar grain structures. Materials 2020, 13, 1310. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Cheng, H.-Y.; Tran, D.-P.; Tu, K.; Chen, C. Effect of deposition temperature on mechanical properties of nanotwinned Cu fabricated by rotary electroplating. Mater. Sci. Eng. A 2021, 811, 141065. [Google Scholar] [CrossRef]
- Tseng, C.-H.; Tseng, I.-H.; Huang, Y.-P.; Hsu, Y.-T.; Leu, J.; Tu, K.-N.; Chen, C. Kinetic study of grain growth in highly (111)-preferred nanotwinned copper films. Mater. Charact. 2020, 168, 110545. [Google Scholar] [CrossRef]
- Anderoglu, O.; Misra, A.; Wang, H.; Ronning, F.; Hundley, M.; Zhang, X. Epitaxial nanotwinned Cu films with high strength and high conductivity. Appl. Phys. Lett. 2008, 93, 083108. [Google Scholar] [CrossRef]
- Hodge, A.; Wang, Y.; Barbee Jr, T. Mechanical deformation of high-purity sputter-deposited nano-twinned copper. Scr. Mater. 2008, 59, 163–166. [Google Scholar] [CrossRef]
- Zhang, X.; Wang, H.; Chen, X.; Lu, L.; Lu, K.; Hoagland, R.; Misra, A. High-strength sputter-deposited Cu foils with preferred orientation of nanoscale growth twins. Appl. Phys. Lett. 2006, 88, 173116. [Google Scholar] [CrossRef] [Green Version]
- Heckman, N.M.; Berwind, M.F.; Eberl, C.; Hodge, A.M. Microstructural deformation in fatigued nanotwinned copper alloys. Acta Mater. 2018, 144, 138–144. [Google Scholar] [CrossRef]
- Zhao, Y.; Cheng, I.; Kassner, M.; Hodge, A. The effect of nanotwins on the corrosion behavior of copper. Acta Mater. 2014, 67, 181–188. [Google Scholar] [CrossRef]
- Shute, C.J.; Myers, B.; Xie, S.; Li, S.-Y.; Barbee, T., Jr.; Hodge, A.; Weertman, J. Detwinning, damage and crack initiation during cyclic loading of Cu samples containing aligned nanotwins. Acta Mater. 2011, 59, 4569–4577. [Google Scholar] [CrossRef]
- Liu, C.-M.; Lin, H.-w.; Chu, Y.-C.; Chen, C.; Lyu, D.-R.; Chen, K.-N.; Tu, K. Low-temperature direct copper-to-copper bonding enabled by creep on highly (111)-oriented Cu surfaces. Scr. Mater. 2014, 78, 65–68. [Google Scholar] [CrossRef]
- Tan, C.; Reif, R.; Theodore, N.; Pozder, S. Observation of interfacial void formation in bonded copper layers. App. Phys. Lett. 2005, 87, 201909. [Google Scholar] [CrossRef]
- Liu, H.-C.; Gusak, A.; Tu, K.; Chen, C. Interfacial void ripening in CuCu joints. Mater. Character. 2021, 181, 111459. [Google Scholar] [CrossRef]
- Rebhan, B.; Hingerl, K. Physical mechanisms of copper-copper wafer bonding. J. Appl. Phys. 2015, 118, 135301. [Google Scholar] [CrossRef]
- Lai, Y.-C.; Wu, P.-C.; Chuang, T.-H. Characterization of interfacial structure for low-temperature direct bonding of Si substrates sputtered with Ag nanotwinned films. Mater. Charact. 2021, 175, 111060. [Google Scholar] [CrossRef]
- Han, H.; Lee, C.; Kim, Y.; Lee, J.; Kim, R.; Kim, J.; Yoo, B. Cu to Cu direct bonding at low temperature with high density defect in electrodeposited Cu. Appl. Surf. Sci. 2021, 550, 149337. [Google Scholar] [CrossRef]
- Gondcharton, P.; Imbert, B.; Benaissa, L.; Carron, V.; Verdier, M. Kinetics of low temperature direct copper–copper bonding. Microsyst. Technol. 2015, 21, 995–1001. [Google Scholar] [CrossRef]
- Tadepalli, R.; Thompson, C.V. Formation of Cu–Cu interfaces with ideal adhesive strengths via room temperature pressure bonding in ultrahigh vacuum. Appl. Phys. Lett. 2007, 90, 151919. [Google Scholar] [CrossRef]
- Huang, Y.-S.; Liu, C.-M.; Chiu, W.-L.; Chen, C. Grain growth in electroplated (111)-oriented nanotwinned Cu. Scr. Mater. 2014, 89, 5–8. [Google Scholar] [CrossRef]
- Li, Y.-J.; Hsu, C.-W.; Ting, Y.-H.; Tsou, N.-T.; Lo, Y.-C.; Wu, W.-W.; Tu, K.-N.; Chen, C. Deformation induced columnar grain rotation in nanotwinned metals. Mater. Sci. Eng. A 2020, 797, 140045. [Google Scholar] [CrossRef]
- Tran, D.-P.; Chen, K.-J.; Tu, K.; Chen, C.; Chen, Y.-T.; Chung, S.J.E.A. Electrodeposition of slanted nanotwinned Cu foils with high strength and ductility. Electrochim. Acta 2021, 389, 138640. [Google Scholar] [CrossRef]
- Hung, Y.-W.; Tran, D.-P.; Chen, C. Effect of Cu Ion Concentration on Microstructures and Mechanical Properties of Nanotwinned Cu Foils Fabricated by Rotary Electroplating. Nanomaterials 2021, 11, 2135. [Google Scholar] [CrossRef] [PubMed]
- Tseng, I.-H.; Hsu, Y.-T.; Leu, J.; Tu, K.-N.; Chen, C. Effect of thermal stress on anisotropic grain growth in nano-twinned and un-twinned copper films. Acta Mater. 2021, 206, 116637. [Google Scholar] [CrossRef]
- Tseng, I.H.; Hsu, P.N.; Lu, T.L.; Tu, K.N.; Chen, C. Electromigration failure mechanisms of <111>-oriented nanotwinned Cu redistribution lines with polyimide capping. Results Phys. 2021, 24, 104154. [Google Scholar] [CrossRef]
- Tran, D.P.; Li, H.H.; Tseng, I.H.; Chen, C. Enhancement of electromigration lifetime of copper lines by eliminating nanoscale grains in highly <111>-oriented nanotwinned structures. J. Mater. Res. Technol. 2021, 15, 6690–6699. [Google Scholar] [CrossRef]
- Tseng, I.H.; Hsu, P.N.; Hsu, W.Y.; Tran, D.P.; Lin, B.T.; Chang, C.C.; Tu, K.N.; Chen, C. Effect of oxidation on electromigration in 2-µm Cu redistribution lines capped with polyimide. Results Phys. 2021, 31, 105048. [Google Scholar] [CrossRef]
- Agrawal, P.M.; Rice, B.M.; Thompson, D.L. Predicting trends in rate parameters for self-diffusion on FCC metal surfaces. Surf. Sci. 2002, 515, 21–35. [Google Scholar] [CrossRef]
- Mohamed, F.; Murty, K.; Morris, J. Harper-dorn creep in Al, Pb, and Sn. Metall. Trans. 1973, 4, 935–940. [Google Scholar] [CrossRef]
- Shie, K.-C.; Gusak, A.; Tu, K.; Chen, C. A kinetic model of copper-to-copper direct bonding under thermal compression. J. Mater. Res. Technol. 2021, 15, 2332–2344. [Google Scholar] [CrossRef]
- Juang, J.-Y.; Lu, C.-L.; Chen, K.-J.; Chen, C.-C.A.; Hsu, P.-N.; Chen, C.; Tu, K.-N. Copper-to-copper direct bonding on highly (111)-oriented nanotwinned copper in no-vacuum ambient. Sci. Rep. 2018, 8, 13910. [Google Scholar] [CrossRef]
- Shie, K.C.; Hsu, P.N.; Li, Y.J.; Tu, K.N.; Chen, C. Effect of bonding strength on electromigration failure in Cu–Cu bumps. Materials 2021, 14, 6394. [Google Scholar] [CrossRef] [PubMed]
- Tseng, C.-H.; Tu, K.-N.; Chen, C. Comparison of oxidation in uni-directionally and randomly oriented Cu films for low temperature Cu-to-Cu direct bonding. Sci. Rep. 2018, 8, 10671. [Google Scholar] [CrossRef] [PubMed]
- Huang, J.; Shie, K.; Liu, H.; Li, Y.; Cheng, H.; Chen, C. Copper-to-copper direct bonding using different (111) surface ratios of nanotwinned copper films. In Proceedings of the 2019 International Conference on Electronics Packaging (ICEP), Niigata, Japan, 17–20 April 2019; pp. 52–55. [Google Scholar] [CrossRef]
- Liu, D.; Chen, P.-C.; Liu, Y.-W.; Hu, H.-W.; Chen, K.-N. Low-Temperature (70 °C) Cu-to-Cu Direct Bonding by Capping Metal Layers. IEEE Electron Device Lett. 2021, 42, 1524–1527. [Google Scholar] [CrossRef]
- Liu, D.; Chen, P.-C.; Chen, K.-N. A Novel Low-Temperature Cu-Cu Direct Bonding with Cr Wetting Layer and Au Passivation Layer. In Proceedings of the 2020 IEEE 70th Electronic Components and Technology Conference (ECTC), Orlando, FL, USA, 3–30 June 2020; pp. 1322–1327. [Google Scholar]
- Chang, S.-Y.; Chu, Y.-C.; Tu, K.; Chen, C. Effect of anisotropic grain growth on improving the bonding strength of <111>-oriented nanotwinned copper films. Mater. Sci. Eng. A 2021, 804, 140754. [Google Scholar] [CrossRef]
- Wu, Y.-T.; Chen, C. Low Temperature Cu-to-Cu Bonding in Non-vacuum Atmosphere with Thin Gold Capping on Highly (111) Oriented Nanotwinned Copper. J. Electron. Mater. 2020, 49, 13–17. [Google Scholar] [CrossRef]
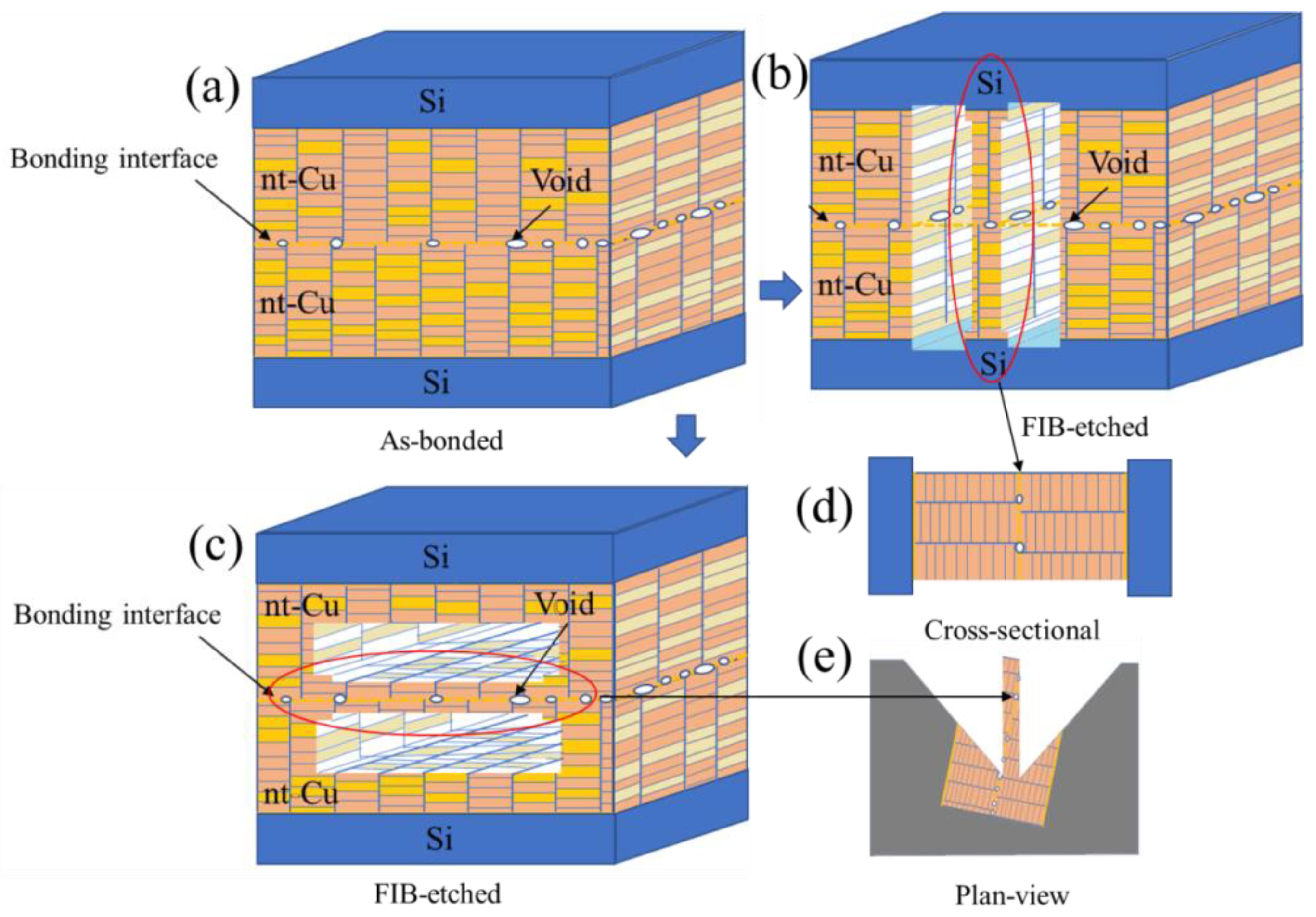
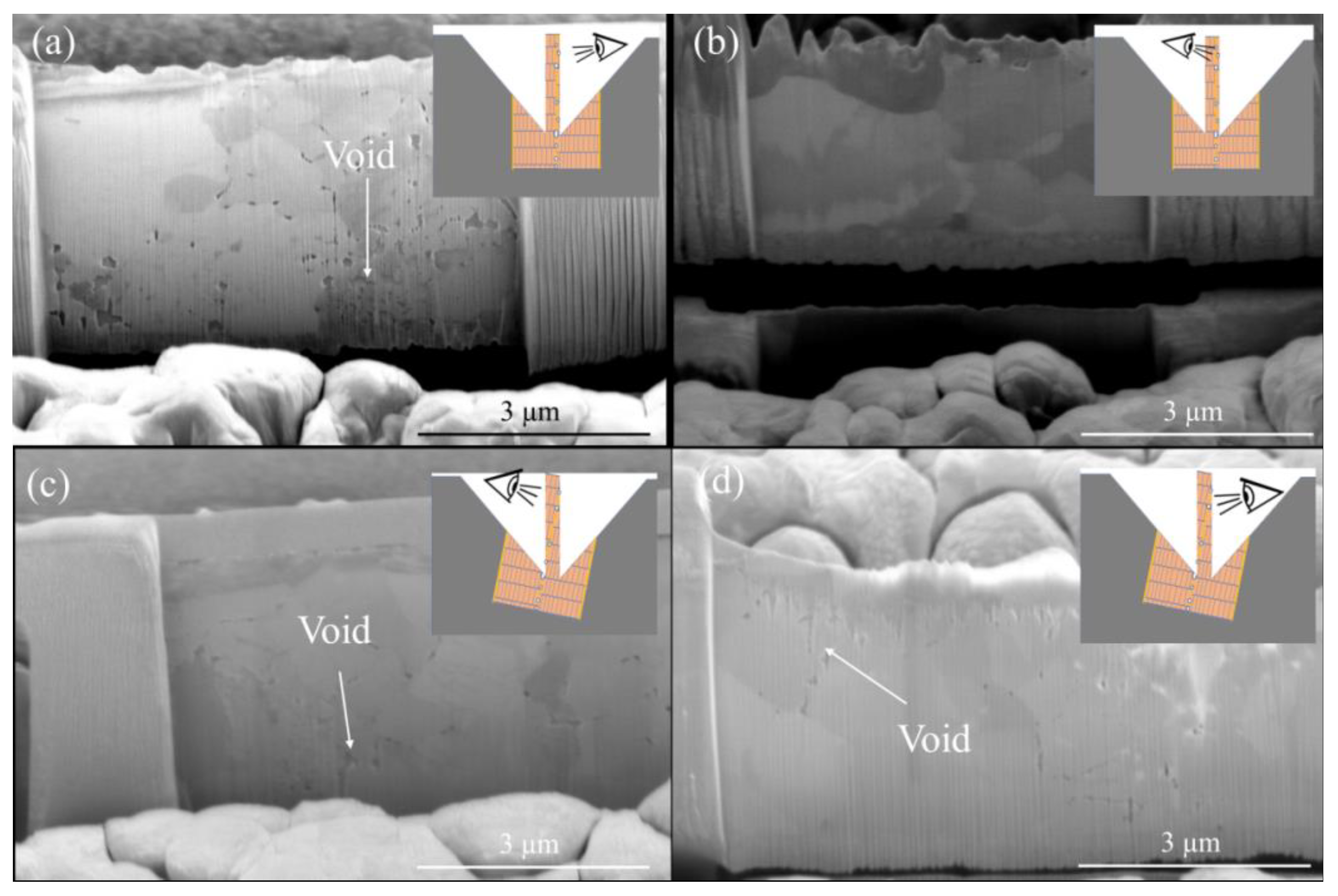


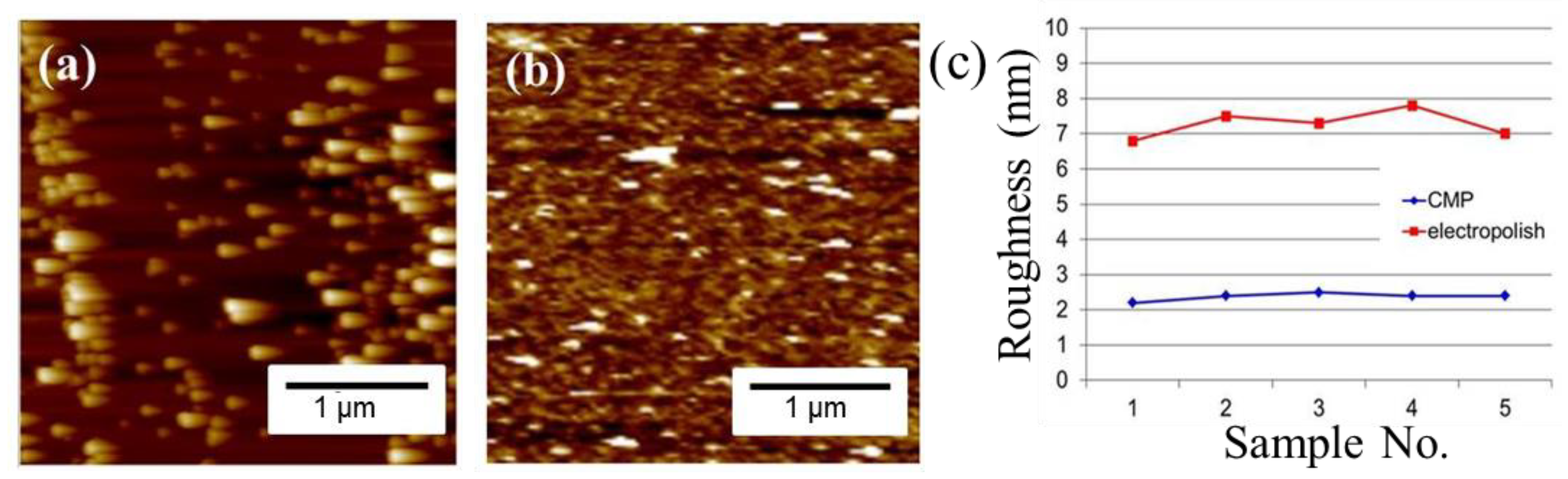

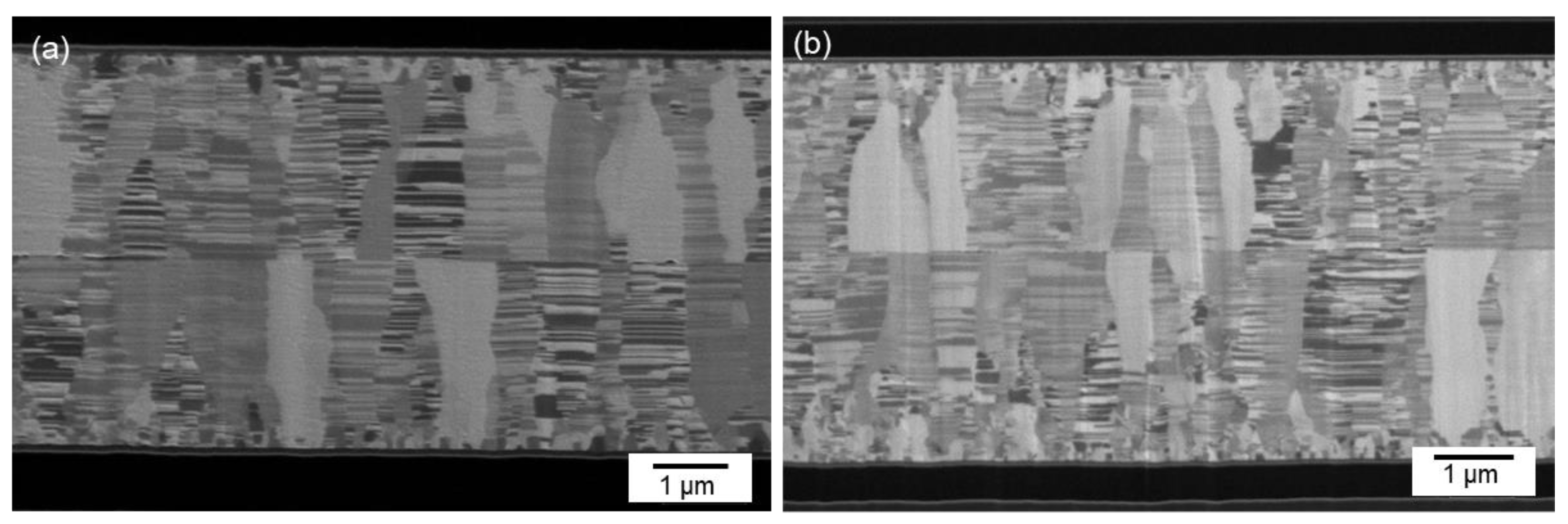
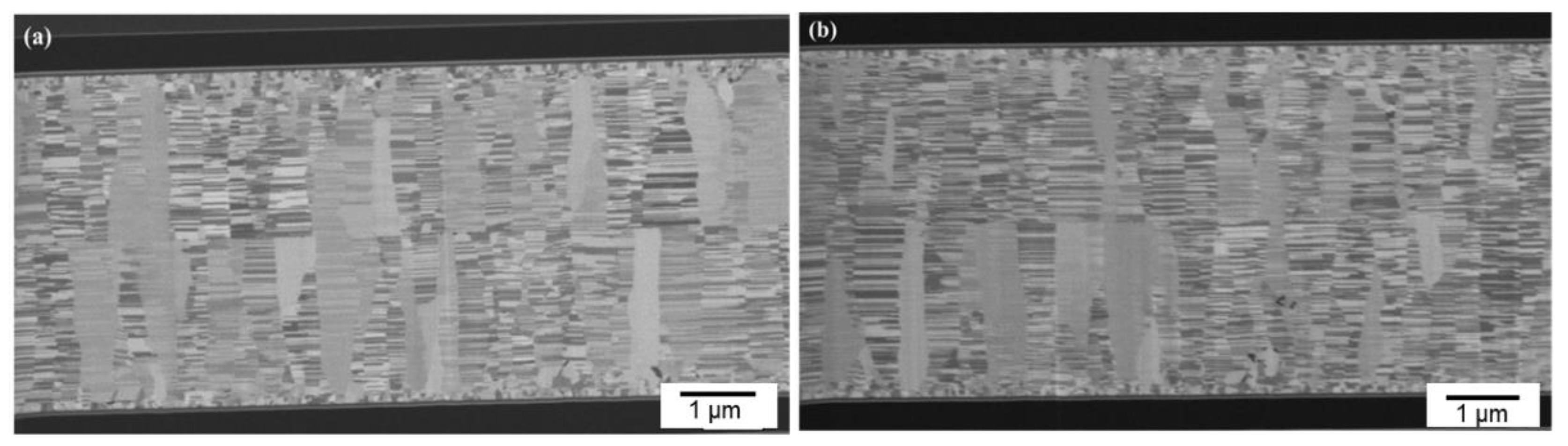

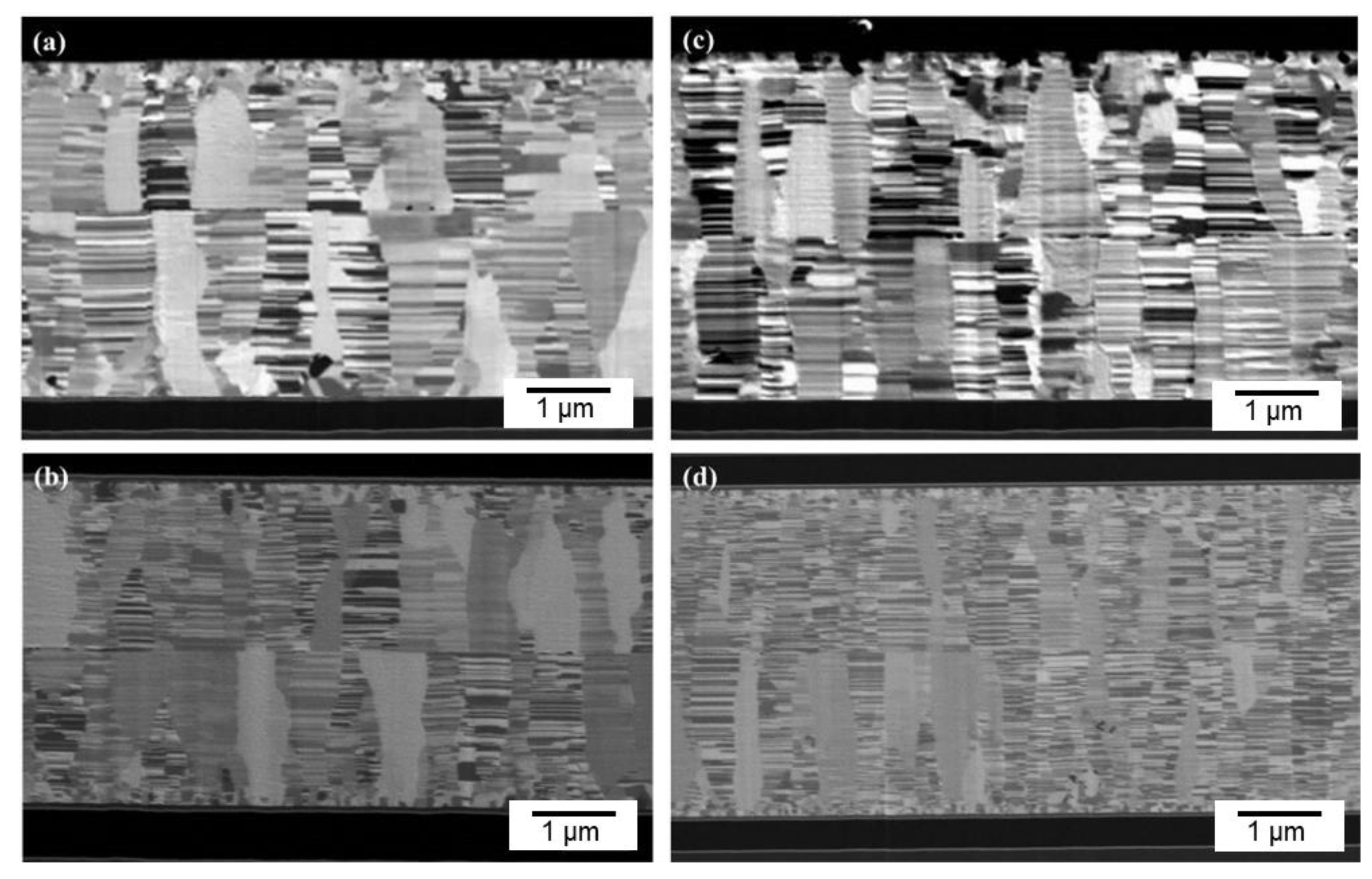
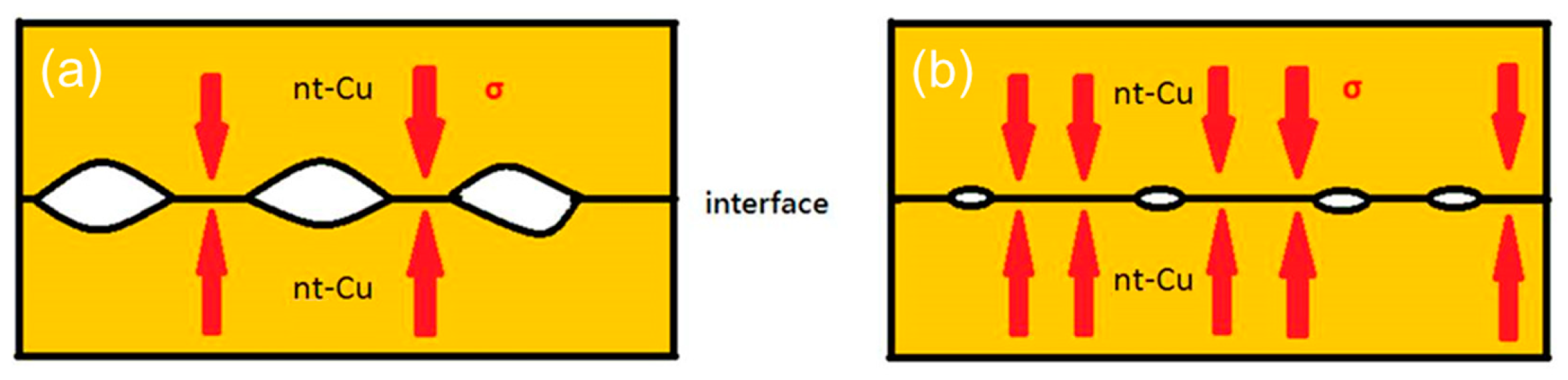
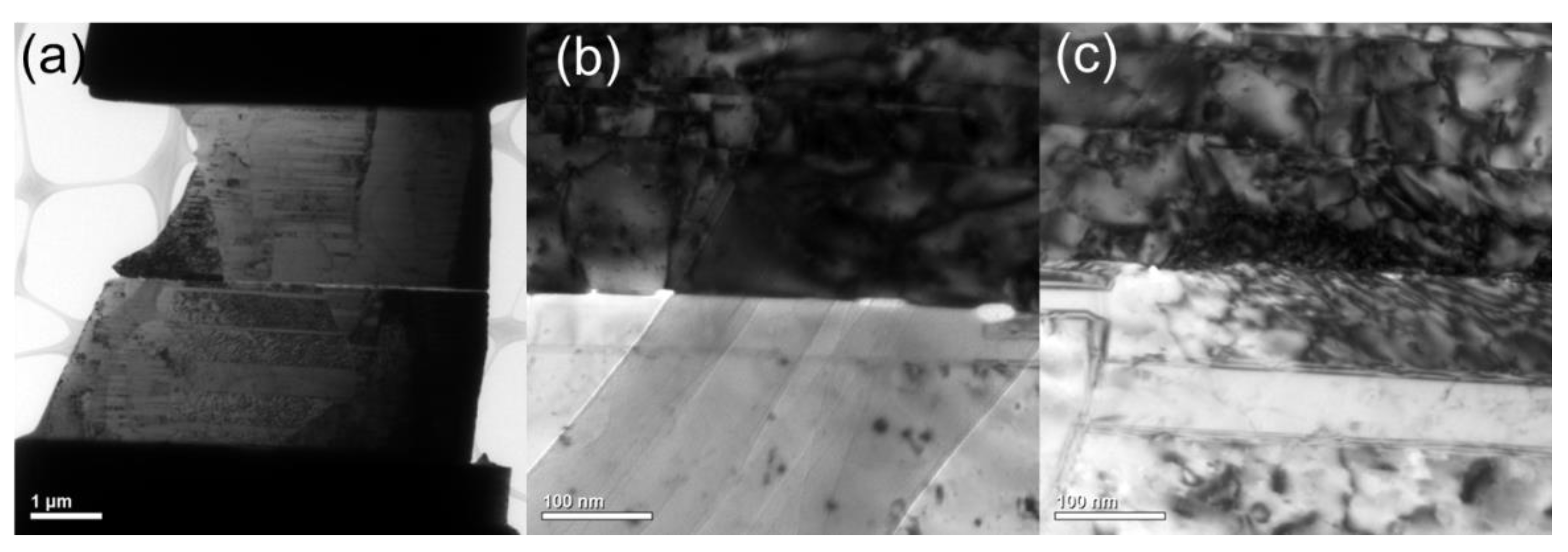
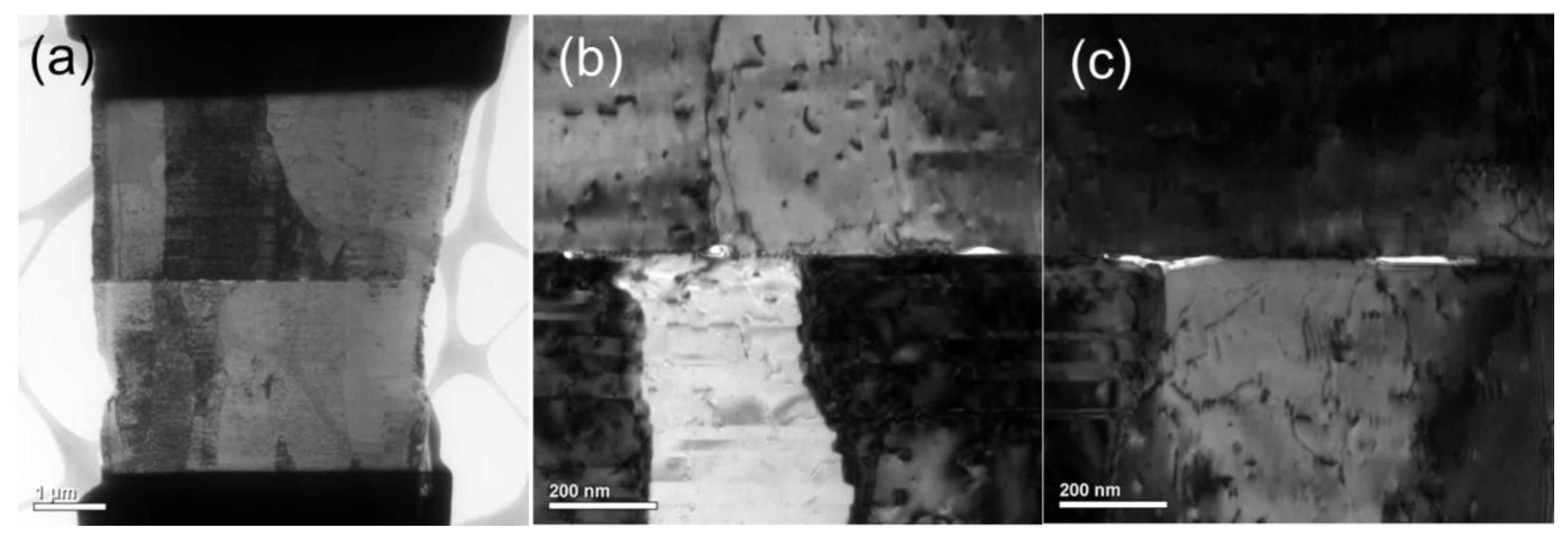
| Surface Treatment | Bonding Temp. (°C) | Bonding Strength | Surface Roughness (nm) | Duration (min) | |
|---|---|---|---|---|---|
| This work | CMP | 150–200 | High | 2.4 | 5–60 |
| Tseng et al. [44] | Electropolishing | 120–400 | High | 5.8 | 30–240 |
| Liu et al. [12] | Chemical cleaning | 200–250 | High | N/a | 10–60 |
| Liu et al. [23] | Electropolishing | 150–250 | High | 6.5 | 30–60 |
| Huang et al. [45] | Electropolishing | 300 | High | 22 | 30 |
| Liu et al. [46] | Passivation | 70–150 | Low | 2.5 | 15 |
| Liu et al. [47] | Passivation | 70–200 | Low | 5 | 15 |
| Chang et al. [48] | Electropolishing | 250–350 | High | 6.6 | 5–90 |
| Wu et al. [49] | Passivation | 200–300 | Low | 1.0 | 20 |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2022 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Lin, P.-F.; Tran, D.-P.; Liu, H.-C.; Li, Y.-Y.; Chen, C. Interfacial Characterization of Low-Temperature Cu-to-Cu Direct Bonding with Chemical Mechanical Planarized Nanotwinned Cu Films. Materials 2022, 15, 937. https://doi.org/10.3390/ma15030937
Lin P-F, Tran D-P, Liu H-C, Li Y-Y, Chen C. Interfacial Characterization of Low-Temperature Cu-to-Cu Direct Bonding with Chemical Mechanical Planarized Nanotwinned Cu Films. Materials. 2022; 15(3):937. https://doi.org/10.3390/ma15030937
Chicago/Turabian StyleLin, Po-Fan, Dinh-Phuc Tran, Hung-Che Liu, Yi-Yi Li, and Chih Chen. 2022. "Interfacial Characterization of Low-Temperature Cu-to-Cu Direct Bonding with Chemical Mechanical Planarized Nanotwinned Cu Films" Materials 15, no. 3: 937. https://doi.org/10.3390/ma15030937
APA StyleLin, P.-F., Tran, D.-P., Liu, H.-C., Li, Y.-Y., & Chen, C. (2022). Interfacial Characterization of Low-Temperature Cu-to-Cu Direct Bonding with Chemical Mechanical Planarized Nanotwinned Cu Films. Materials, 15(3), 937. https://doi.org/10.3390/ma15030937







