Through Silicon MEMS Inspection with a Near-Infrared Laser Scanning Setup
Abstract
1. Introduction
2. Optical Inspection System and Methods
3. Experimental Results
3.1. Resolving Performance Using Standard Test Target
3.2. Inspection of an Encapsulated MEMS Latching Device
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Miki, N.; Zhang, X.; Khanna, R.; Ayón, A.A.; Ward, D.; Spearing, S.M. Multi-stack silicon-direct wafer bonding for 3D MEMS manufacturing. Sens. Actuators A Phys. 2003, 103, 194–201. [Google Scholar] [CrossRef]
- Lee, S.H.; Chen, K.N.; Lu, J.J.Q. Wafer-to-Wafer Alignment for Three-Dimensional Integration: A Review. J. Microelectromechanical Syst. 2011, 20, 885–898. [Google Scholar] [CrossRef]
- Garcia, I.S.; Santos, D.E.; Queiroz, J.B.; Encarnação, J.T.; Hormigo, T.; Cabral, J.; Alves, F.S.; Dias, R.A. Ultra-high Sensitivity Pull-in Time MEMS Accelerometer For Satellite Gravimetry. In Proceedings of the 22nd International Conference on Solid-State Sensors, Actuators and Microsystems, Kyoto, Japan, 25–29 June 2023; pp. 64–67. [Google Scholar]
- Song, C.; Ha, B.; Lee, S. Micromachined inertial sensors. In Proceedings of the 1999 IEEE/RSJ International Conference on Intelligent Robots and Systems. Human and Environment Friendly Robots with High Intelligence and Emotional Quotients (Cat. No.99CH36289), Kyongju, Republic of Korea, 17–21 October 1999; Volume 2, pp. 1049–1056. [Google Scholar] [CrossRef]
- Lee, Y.C.; Ramadoss, R.; Hoivik, N. Introduction to MEMS Packaging; World Scientific: Singapore, 2018; Volume 5, pp. 1–29. [Google Scholar]
- Wang, X.; Bleiker, S.J.; Edinger, P.; Errando-Herranz, C.; Roxhed, N.; Stemme, G.; Gylfason, K.B.; Niklaus, F. Wafer-Level Vacuum Sealing by Transfer Bonding of Silicon Caps for Small Footprint and Ultra-Thin MEMS Packages. J. Microelectromechanical Syst. 2019, 28, 460–471. [Google Scholar] [CrossRef]
- Torunbalci, M.M.; Gavcar, H.D.; Yesil, F.; Alper, S.E.; Akin, T. An All-Silicon Process Platform for Wafer-Level Vacuum Packaged MEMS Devices. IEEE Sens. J. 2021, 21, 13958–13964. [Google Scholar] [CrossRef]
- Turner, K.; Hartwell, P. Experimental Characterization Techniques for Micro/Nanoscale Devices; Springer: Berlin/Heidelberg, Germany, 2007; pp. 1639–1662. [Google Scholar] [CrossRef]
- Chong, A.; Feng, G.; Kanfoud, J.; Gan, T.H. An outline of a complementary inspection system for micro-electro-mechanical system (Mems) devices based on radiography and plenoptic camera. Adv. Transdiscipl. Eng. 2018, 8, 33–38. [Google Scholar] [CrossRef]
- Dai, H.; Zhao, S.P.; Keong, L.M.; Saraswatula, J.; Rauscher, M. Non-Destructive High-Resolution Tomographic Cross-Sectional Imaging on Suspended Structures Inside a Mems Package. In Proceedings of the 2021 China Semiconductor Technology International Conference (CSTIC), Shanghai, China, 14–15 March 2021; pp. 1–3. [Google Scholar] [CrossRef]
- de Veen, P.; Bos, C.; Hoogstede, D.; Revenberg, C.; Liljeholm, J.; Ebefors, T. High-resolution X-ray computed tomography of through silicon vias for RF MEMS integrated passive device applications. Microelectron. Reliab. 2015, 55, 1644–1648. [Google Scholar] [CrossRef]
- Bentley, E.L.; Prabhu, S.; Singh, S.; Cho, J.Y.; Najafi, K. Non-Destructive Characterization of High Aspect-Ratio Structures Using 3D X-Ray Microscopy. In Proceedings of the 2023 IEEE International Symposium on Inertial Sensors and Systems (INERTIAL), Lihue, HI, USA, 28–31 March 2023; pp. 1–4. [Google Scholar] [CrossRef]
- Zschech, E. Nano NDE with X-Rays. In Handbook of Nondestructive Evaluation 4.0; Springer Nature: Cham, Switzerland, 2025; pp. 1377–1400. [Google Scholar] [CrossRef]
- Trigg, A. Applications of infrared microscopy to IC and MEMS packaging. IEEE Trans. Electron. Packag. Manuf. 2003, 26, 232–238. [Google Scholar] [CrossRef]
- Wolfer, M.; Giesen, M.; Heilig, M.; Seyfried, V.; Winter, M. Characterization of the dynamics of encapsulated silicon MEMS devices using low-coherence heterodyne LDV technology. Micro Nano Eng. 2023, 19, 100191. [Google Scholar] [CrossRef]
- Abroug, S.; Saadallah, F.; Yacoubi, N. Optical and thermal properties of doped semiconductor. Eur. Phys. J. Spec. Top. 2008, 153, 29–32. [Google Scholar] [CrossRef]
- Krauter, J.; Osten, W. Nondestructive surface profiling of hidden MEMS using an infrared low-coherence interferometric microscope. Surf. Topogr. Metrol. Prop. 2018, 6, 015005. [Google Scholar] [CrossRef]
- Ma, J.; Yuan, Q.; Gao, Z.; Huo, X.; Xu, Z.; Zhang, J.; Fan, X.; Zhu, D.; Guo, Z.; Lei, L.; et al. Three-Dimensional Topography of High-Aspect Ratio Trenches byso Sample-Induced Aberration-Compensable Coherence Scanning Interferometry. ACS Photonics 2024, 11, 1068–1077. [Google Scholar] [CrossRef]
- Pierce, D.T.; Spicer, W.E. Electronic Structure of Amorphous Si from Photoemission and Optical Studies. Phys. Rev. B 1972, 5, 3017–3029. [Google Scholar] [CrossRef]
- Degallaix, J.; Komma, J.; Forest, D.; Hofmann, G.; Granata, M.; Heinert, D.; Schwarz, C.; Nawrodt, R.; Pinard, L.; Michel, C.; et al. Measurement of the optical absorption of bulk silicon at cryogenic temperature and the implication for the Einstein Telescope. Class. Quantum Gravity 2014, 31, 185010. [Google Scholar] [CrossRef]
- Danielsson, P.E.; Seger, O. Generalized and Separable Sobel Operators. In Machine Vision for Three-Dimensional Scenes; Freeman, H., Ed.; Academic Press: Cambridge, MA, USA, 1990. [Google Scholar]
- Garcia, I.S.; Fernandes, J.; Queiroz, J.B.; Calaza, C.; Moreira, J.; Dias, R.A.; Alves, F.S. Microfabrication of double proof-mass SOI-based matryoshka-like structures for 3-axis MEMS accelerometers. Micro Nano Eng. 2023, 19, 100204. [Google Scholar] [CrossRef]
- Saleh, B.E.A.; Teich, M.C.; Saleh, B.E. Fundamentals of Photonics; Wiley: New York, NY, USA, 1991; Volume 22. [Google Scholar]
- Pedrotti, F.L.; Pedrotti, L.M.; Pedrotti, L.S. Introduction to Optics, 3rd ed.; Cambridge University Press: Cambridge, UK, 2017. [Google Scholar] [CrossRef]
- Byrnes, S.J. Multilayer optical calculations. arXiv 2016, arXiv:1603.02720. [Google Scholar]
- Luce, A.; Mahdavi, A.; Marquardt, F.; Wankerl, H. TMM-Fast, a transfer matrix computation package for multilayer thin-film optimization: Tutorial. J. Opt. Soc. Am. A 2022, 39, 1007–1013. [Google Scholar] [CrossRef] [PubMed]
- Franta, D.; Nečas, D.; Ohlídal, I.; Giglia, A. Optical characterization of SiO2 thin films using universal dispersion model over wide spectral range. In Proceedings of the Optical Micro- and Nanometrology VI, Brussels, Belgium, 3–7 April 2016; Gorecki, C., Asundi, A.K., Osten, W., Eds.; International Society for Optics and Photonics, SPIE: Bellingham, WA, USA, 2016; Volume 9890, p. 989014. [Google Scholar] [CrossRef]
- Wu, Y.; Han, X.; Su, Y.; Glidewell, M.; Daniels, J.S.; Liu, J.; Sengupta, T.; Rey-suarez, I.; Fischer, R.; Patel, A.; et al. Multiview confocal super-resolution microscopy. Nature 2021, 600, 279–284. [Google Scholar] [CrossRef] [PubMed]
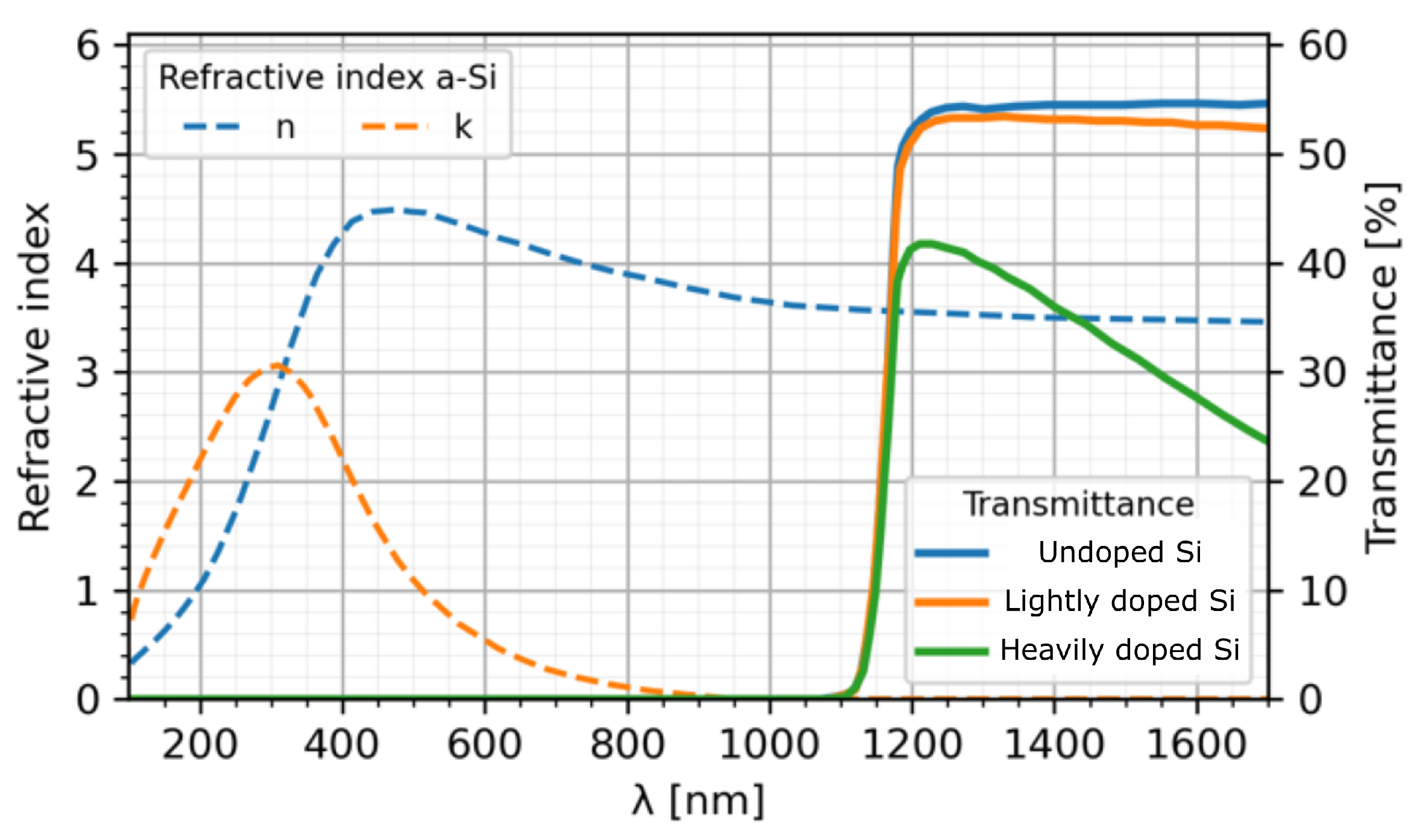
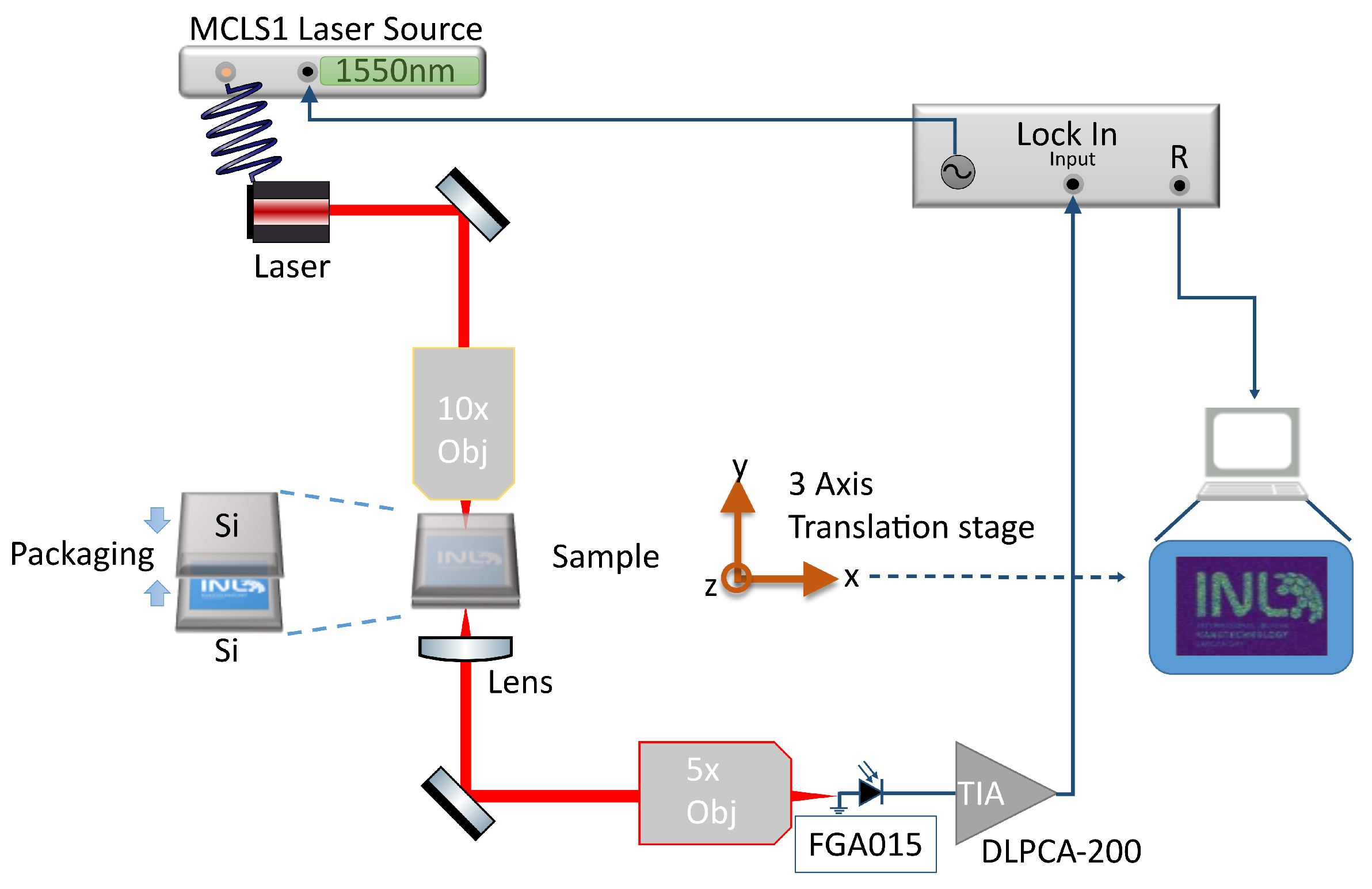



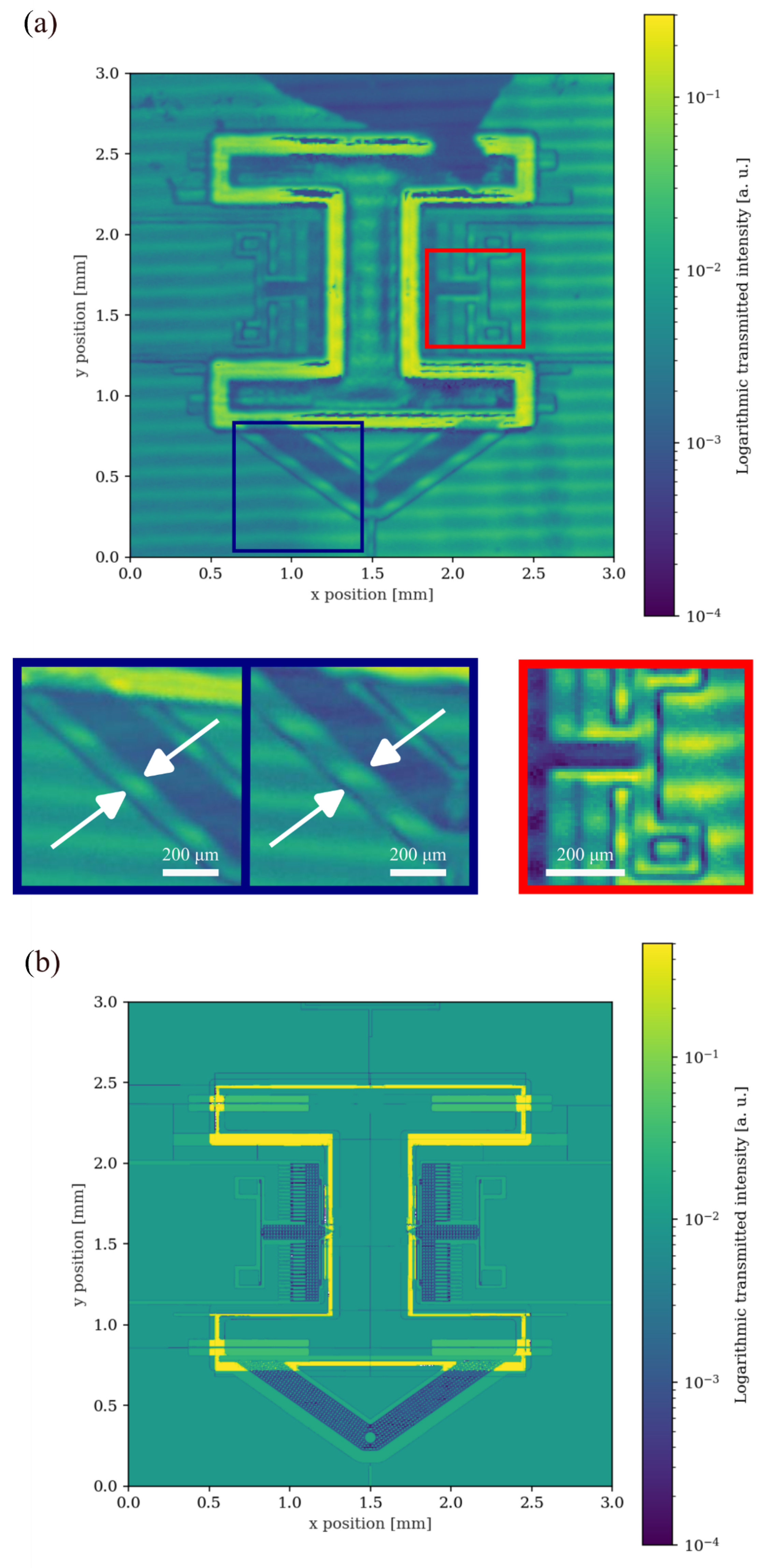


Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2025 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Rodrigues, M.J.L.F.; Garcia, I.S.; Santos, J.D.; Mota, F.C.; Alves, F.S.; Aguiam, D.E. Through Silicon MEMS Inspection with a Near-Infrared Laser Scanning Setup. Sensors 2025, 25, 4627. https://doi.org/10.3390/s25154627
Rodrigues MJLF, Garcia IS, Santos JD, Mota FC, Alves FS, Aguiam DE. Through Silicon MEMS Inspection with a Near-Infrared Laser Scanning Setup. Sensors. 2025; 25(15):4627. https://doi.org/10.3390/s25154627
Chicago/Turabian StyleRodrigues, Manuel J. L. F., Inês S. Garcia, Joana D. Santos, Filipa C. Mota, Filipe S. Alves, and Diogo E. Aguiam. 2025. "Through Silicon MEMS Inspection with a Near-Infrared Laser Scanning Setup" Sensors 25, no. 15: 4627. https://doi.org/10.3390/s25154627
APA StyleRodrigues, M. J. L. F., Garcia, I. S., Santos, J. D., Mota, F. C., Alves, F. S., & Aguiam, D. E. (2025). Through Silicon MEMS Inspection with a Near-Infrared Laser Scanning Setup. Sensors, 25(15), 4627. https://doi.org/10.3390/s25154627







