CMOS Image Sensors and Plasma Processes: How PMD Nitride Charging Acts on the Dark Current
Abstract
1. Introduction
2. Dark Current Degradation by Plasma Strip Process
2.1. Experimental
2.2. Pixel Dark Current Results
2.3. Degradation Mechanism Hypothesis
3. Study of the Plasma Impact on the Pixel Dielectric Properties
3.1. Experimental Set-Up
3.2. Pre-Metal Dielectrics (PMD) Properties Measurement
3.2.1. Surface Potential Voltage Evolution
3.2.2. Silicon Surface Barrier Potential Evolution
3.2.3. Total Charge Measurement
3.2.4. Silicon Photo Luminescence Signal
3.2.5. Interface States Density Measurement
4. Discussion
4.1. Interaction Plasma versus Dielectrics
4.2. Relation between the PMD Dielectrics Properties and the Pixel Dark Current
- First, the p+ pinning implant in the pinned photodiode, which was not present on the COCOS characterization wafers, usually accumulates on the surface and moves the depletion edge deeper into the silicon. But the strong positive charges above the Si surface will move it to depletion, or move the depletion edge closer to the surface. This means that the same positive electric field causing an inversion at the silicon interface on the COCOS wafer may cause a silicon depletion touching the interface on the wafer with the CMOS image sensors. Even if the silicon depletion does not reach the interface, it can be close enough to the surface so that the diffusion length of carriers is longer than the distance from surface to depletion edge as reported in [14]. This strongly enhances the minority carrier diffusion and increases the electron generation from the interface.
- Finally, even if the interface above the photodiode is inverted, there is always a lateral frontier region close to the photodiode periphery where the inversion will change to depletion, before reaching the accumulation: either close to the STI interface, or under the spacer of the transfer gate. This is illustrated on the pixel TCAD cross section of the Figure 17b,c. Moreover, high electric fields are created by the negative voltage applied on the transfer gate: this can also enhance the dark current generated in the spacer interface area.
4.3. Ways to Prevent Plasma Damage on CMOS Image Sensor
5. Conclusions
Author Contributions
Funding
Acknowledgments
Conflicts of Interest
References
- Tokashiki, K.; Bai, K.H.; Baek, K.H.; Kim, Y.; Min, G.; Kang, C.; Cho, H.; Moon, J. Study of plasma charging-induced white pixel defect increase in CMOS active pixel sensor. Thin Solid Film. 2007, 515, 4864–4868. [Google Scholar] [CrossRef]
- Carrère, J.-P.; Oddou, J.P.; Place, S.; Richard, C.; Benoit, D.; Jenny, C.; Gatefait, M.; Aumont, C.; Tournier, A.; Roy, F. New mechanism of plasma induced damage on CMOS image sensor: Analysis and process optimization. Solid State Electron. 2011, 65–66, 51–56. [Google Scholar]
- Wilson, M. COCOS (corona oxide characterization of semiconductor) non-contact metrology for gate dielectrics. AIP Conf. Proc. 2001, 550, 220–225. [Google Scholar]
- Cheung, K.P.; Chang, C.P. Plasma-Charging Damage: A Physical Model. J. Appl. Phys. 1994, 75, 4415. [Google Scholar] [CrossRef]
- Sacchettini, Y.; Carrère, J.-P.; Goiffon, V.; Magnan, P. Plasma Antenna Charging in CMOS Image Sensors. In Proceedings of the 2019 IEEE International Reliability Physics Symposium (IRPS), Monterey, CA, USA, 31 March–4 April 2019. [Google Scholar]
- Sinha, H.; Lauer, J.L.; Antonelli, G.A.; Nishi, Y.; Shohet, J.L. Charging response of back-end-of-the-line barrier dielectrics to VUV radiation. Thin Solid Film. 2012, 520, 5300–5303. [Google Scholar] [CrossRef]
- Powell, R.J.; Derbenwick, G.F. Vacuum ultraviolet radiation effects in SiO2(Vacuum UV irradiation of silicon dioxide, discussing positive charging for photon energies above threshold for electron-hole pair creation). IEEE Trans. Nucl. Sci. 1971, 18, 99–105. [Google Scholar] [CrossRef]
- Cismaru, C.; Shohet, J.L. In situ electrical characterization of dielectric thin films directly exposed to plasma vacuum-ultraviolet radiation. J. Appl. Phys. 2000, 88, 1742–1746. [Google Scholar] [CrossRef][Green Version]
- Trupke, T.; Bardos, R.A. Photoluminescence imaging of silicon wafers. Appl. Phys. Lett. 2006, 89, 044107. [Google Scholar] [CrossRef]
- Haug, H.; Olibet, S.; Nordseth, Ø.; Marstein, E.S. Modulating the field-effect passivation at the SiO2/c-Si interface: Analysis and verification of the photoluminescence imaging under applied bias method. J. Appl. Phys. 2013, 114, 174502. [Google Scholar] [CrossRef]
- Sharma, V.; Tracy, C.; Schroder, D.; Flores, M.; Dauksher, B.; Bowden, S. Study and manipulation of charges present in silicon nitride films. In Proceedings of the 2013 IEEE 39th Photovoltaic Specialists Conference (PVSC), Tampa, FL, USA, 16–21 June 2013; pp. 1288–1293. [Google Scholar]
- Takahashi, Y.; Ohnishil, K.; Fujimakil, T.; Yoshikawaz, M. Radiation-induced trapped charge in metal-nitride-oxide-semiconductor structure. IEEE Trans. Nucl. Sci. 1999, 46, 1578–1585. [Google Scholar] [CrossRef]
- Shockley, W.; Read, W.T. Statistics of the Recombination of Holes and Electrons. Phys. Rev. 1952, 87, 835–842. [Google Scholar] [CrossRef]
- Teranishi, N. Effect and Limitation of Pinned Photodiode. IEEE Trans. Electron Devices 2016, 63, 10–15. [Google Scholar] [CrossRef]
- Regolini, J.L.; Benoit, D.; Morin, P. Passivation issues in active pixel CMOS image sensors. Microelectron. Reliab. 2007, 47, 739–742. [Google Scholar] [CrossRef]
- Carrère, J.-P.; Place, S.; Oddou, J.-P.; Benoit, D.; Roy, F. CMOS Image Sensor: Process impact on Dark current. In Proceedings of the 2014 IEEE International Reliability Physics Symposium (IRPS), Waikoloa, HI, USA, 1–5 June 2014. [Google Scholar]
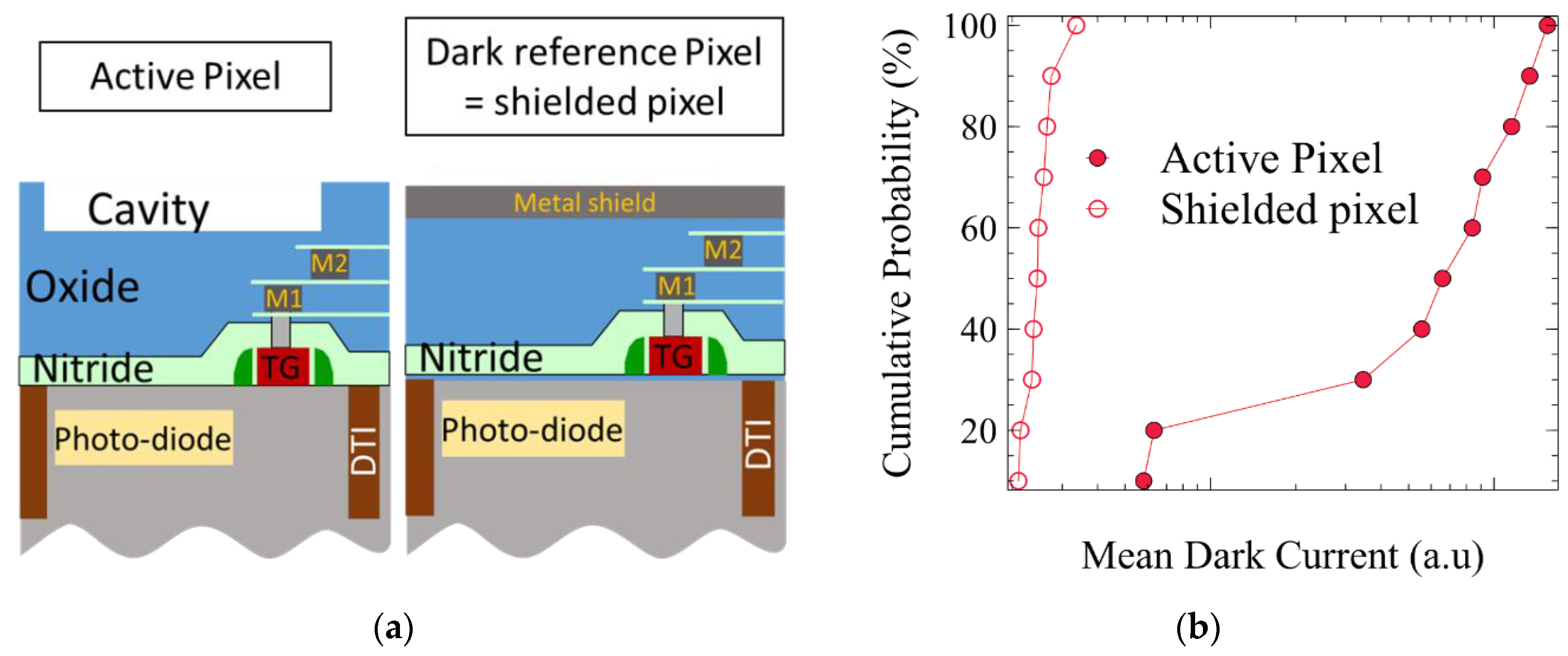



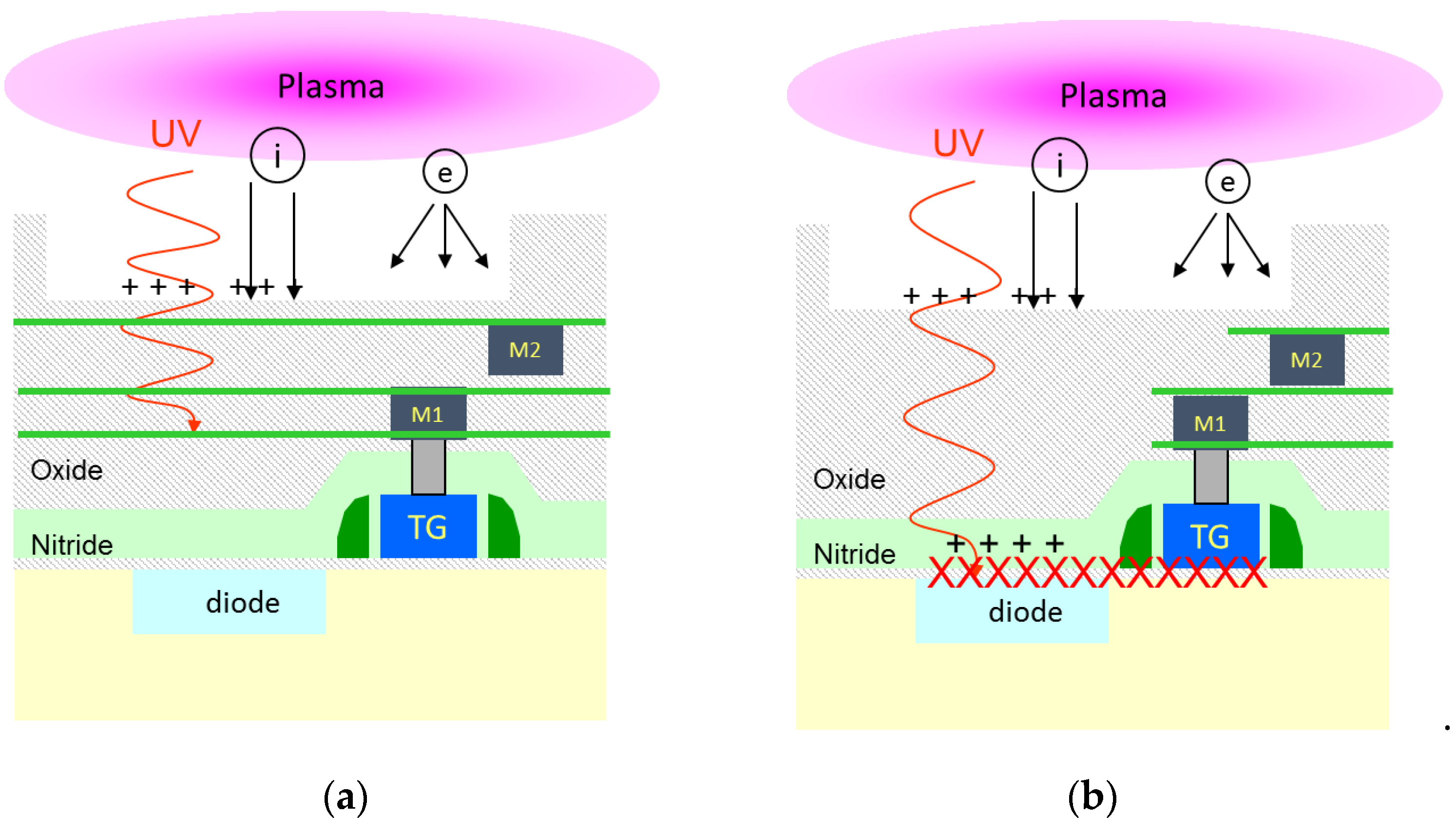

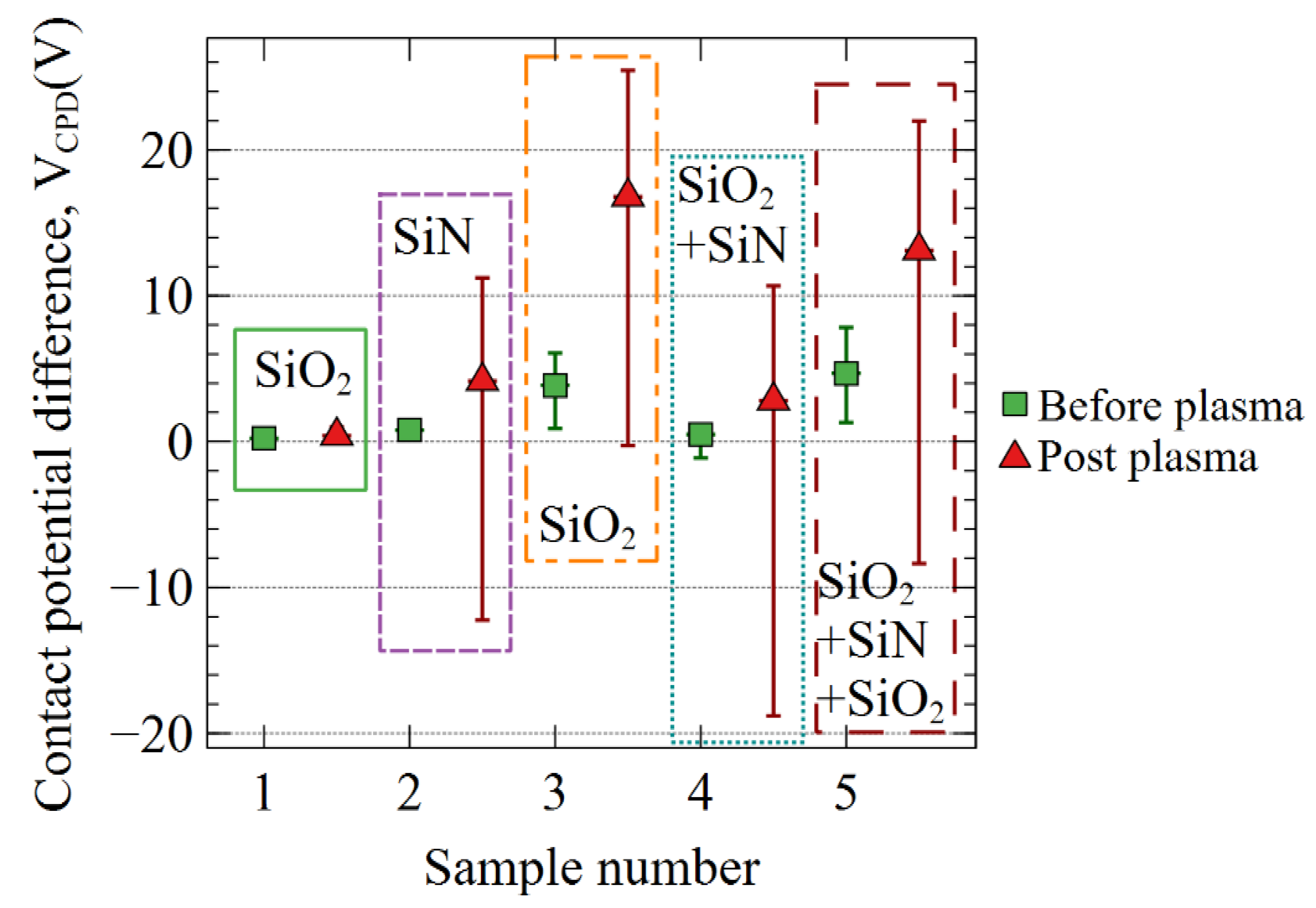
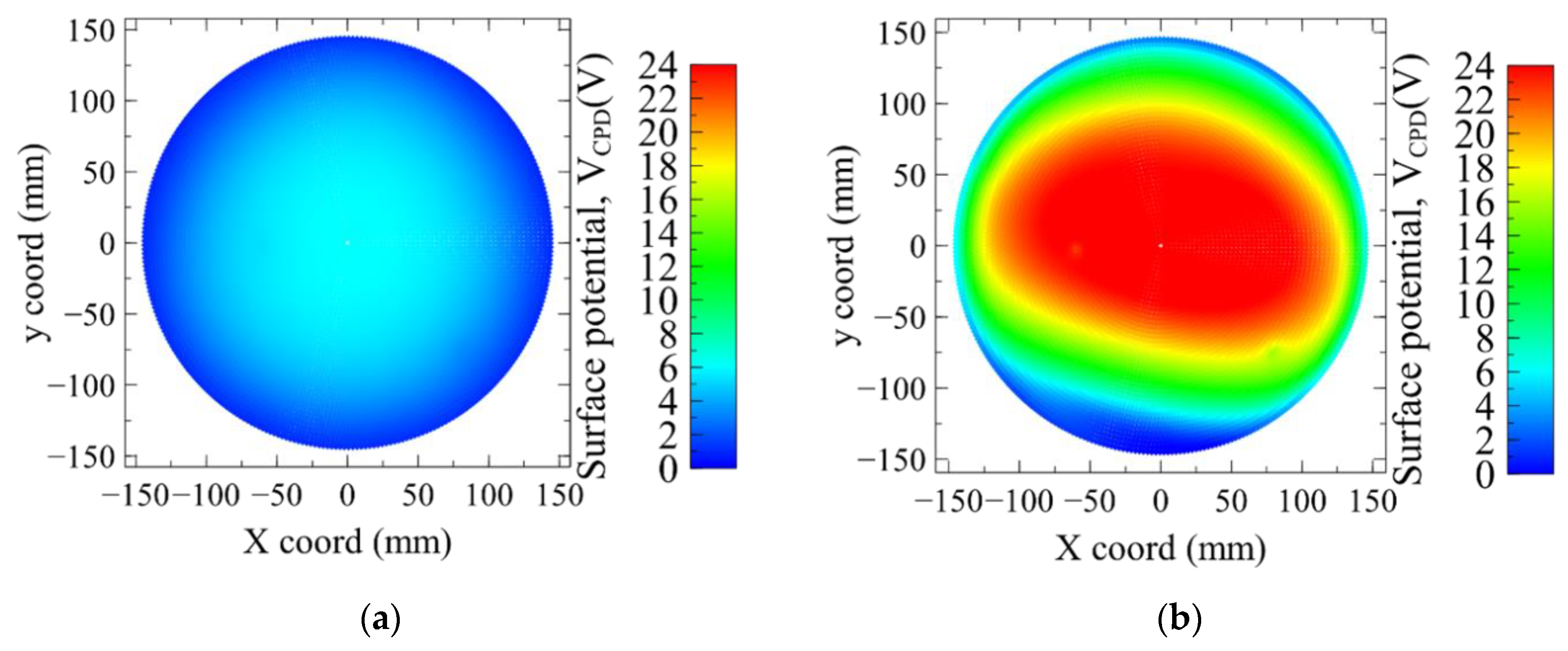

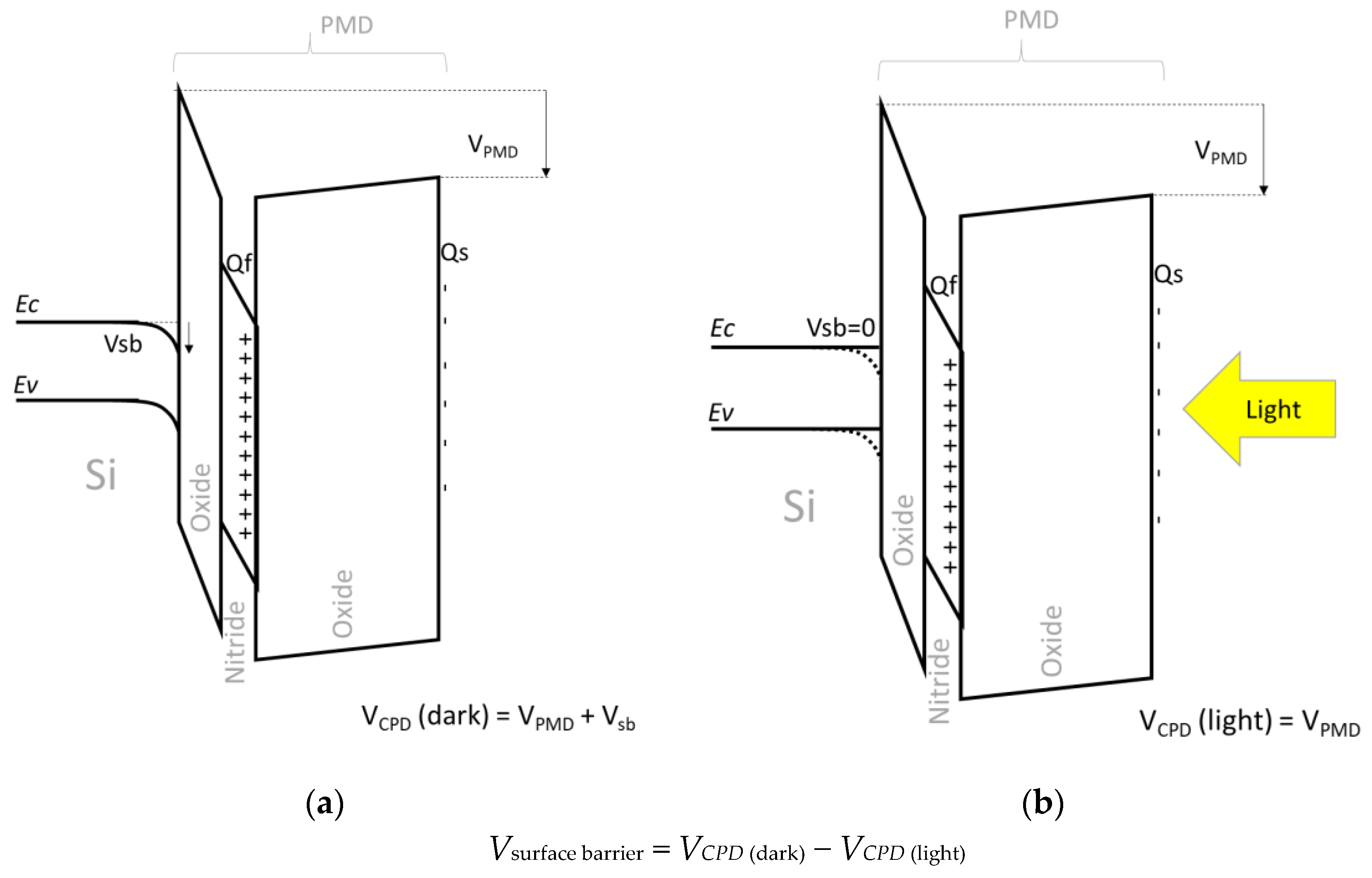

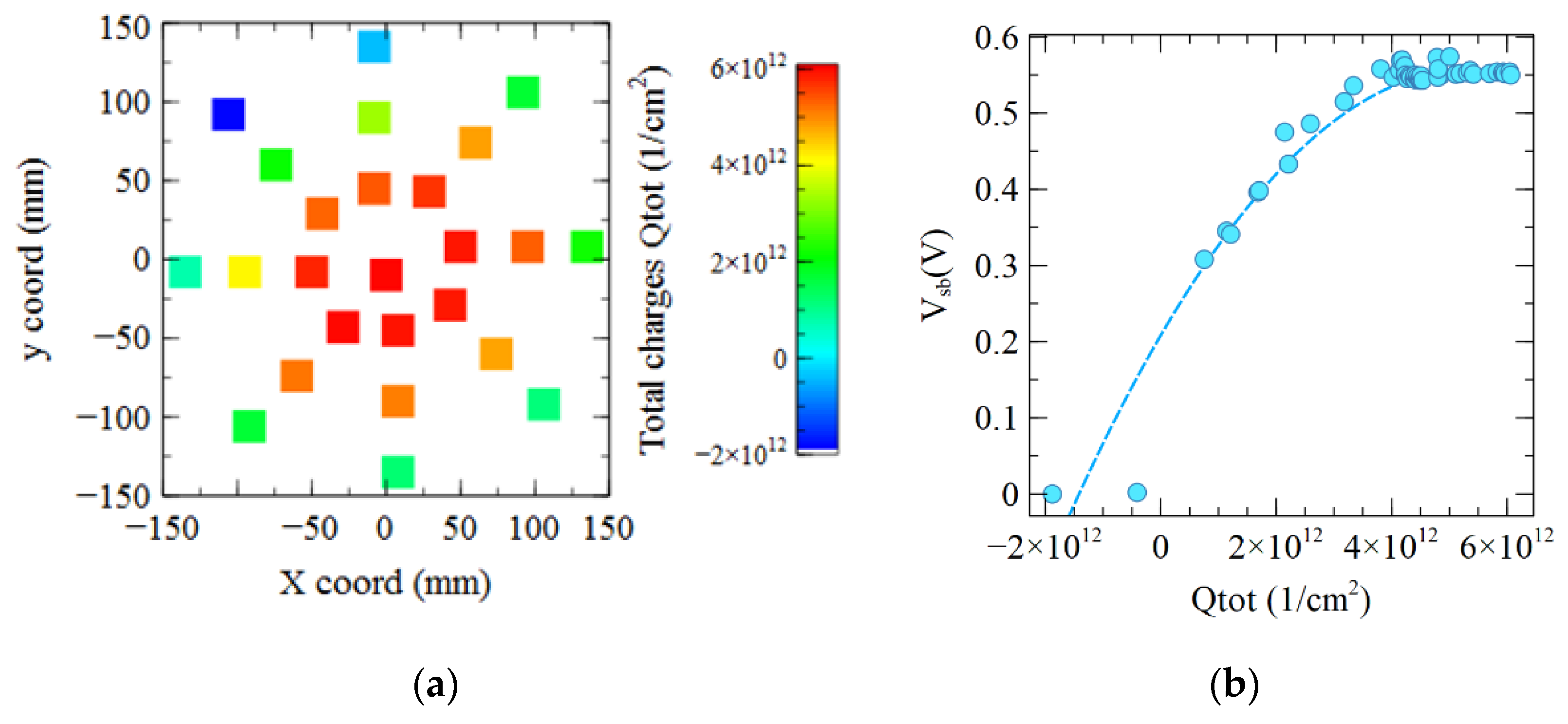




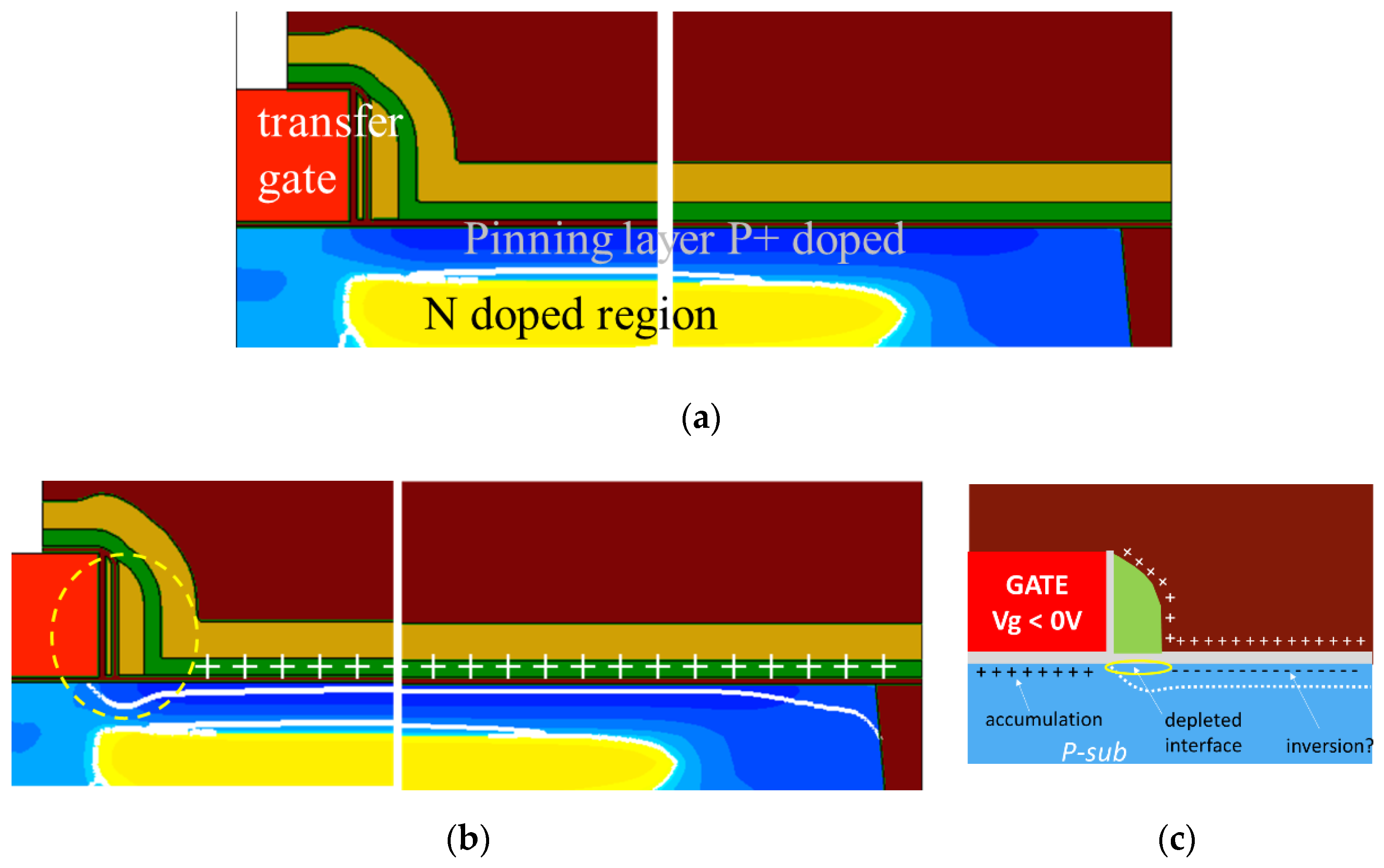
| Sample Number | Dielectric Stack |
|---|---|
| 1 | Thin Bottom Oxide: about 10–50 nm |
| 2 | Anti-Reflective Nitride 50 nm |
| 3 | Top Oxide 500 nm |
| 4 | Bottom oxide + Nitride 50 nm |
| 5 | Oxide + Nitride + Oxide |
© 2019 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Sacchettini, Y.; Carrère, J.-P.; Duru, R.; Oddou, J.-P.; Goiffon, V.; Magnan, P. CMOS Image Sensors and Plasma Processes: How PMD Nitride Charging Acts on the Dark Current. Sensors 2019, 19, 5534. https://doi.org/10.3390/s19245534
Sacchettini Y, Carrère J-P, Duru R, Oddou J-P, Goiffon V, Magnan P. CMOS Image Sensors and Plasma Processes: How PMD Nitride Charging Acts on the Dark Current. Sensors. 2019; 19(24):5534. https://doi.org/10.3390/s19245534
Chicago/Turabian StyleSacchettini, Yolène, Jean-Pierre Carrère, Romain Duru, Jean-Pierre Oddou, Vincent Goiffon, and Pierre Magnan. 2019. "CMOS Image Sensors and Plasma Processes: How PMD Nitride Charging Acts on the Dark Current" Sensors 19, no. 24: 5534. https://doi.org/10.3390/s19245534
APA StyleSacchettini, Y., Carrère, J.-P., Duru, R., Oddou, J.-P., Goiffon, V., & Magnan, P. (2019). CMOS Image Sensors and Plasma Processes: How PMD Nitride Charging Acts on the Dark Current. Sensors, 19(24), 5534. https://doi.org/10.3390/s19245534





