Research Progress in Breakdown Enhancement for GaN-Based High-Electron-Mobility Transistors
Abstract
1. Introduction
2. Breakdown Mechanisms
2.1. Electric Field Concentration
2.2. Buffer Leakage Current
2.3. Gate Leakage Current
2.4. Vertical Breakdown
3. Related Research Progress
3.1. Modulating Electric Field
3.2. Reducing Buffer Leakage Current
3.3. Reducing Gate Leakage Current
3.4. Improving Vertical Breakdown Voltage
3.5. Improving the Withstand Voltage of Material
4. Conclusions
Author Contributions
Funding
Data Availability Statement
Conflicts of Interest
References
- Hwang, I.; Choi, H.; Lee, J.W.; Choi, H.S.; Kim, J.; Ha, J.; Um, C.Y.; Hwang, S.K.; Oh, J.; Kim, J.Y.; et al. 1.6 kV, 2.9 mΩ cm2 normally-off p-GaN HEMT device. In Proceedings of the 2012 24th International Symposium on Power Semiconductor Devices and ICs, Bruges, Belgium, 3–7 June 2012; pp. 41–44. [Google Scholar]
- Zhao, S.; Zhang, J.; Feng, Q.; Du, L.; Zhang, W.; Ji, S.; Song, X.; Wu, F.; Zhang, W.; Bian, Z.; et al. Parameter Shift of Quasi-Vertical GaN-on-Si Schottky Barrier Diodes under On-State Forward-Current (2–4 kA/cm2) Stress. IEEE Trans. Electron Devices 2023, 70, 959–962. [Google Scholar]
- Wu, Y.; Zhang, W.; Zhang, J.; Zhao, S.; Luo, J.; Tan, X.; Mao, W.; Zhang, C.; Zhang, Y.; Cheng, K.; et al. Au-Free Al0.4Ga0.6N/Al0.1Ga0.9N HEMTs on Silicon Substrate with High Reverse Blocking Voltage of 2 kV. IEEE Trans. Electron Devices 2021, 68, 4543–4549. [Google Scholar]
- Wu, Y.; Liu, S.; Zhang, J.; Zhao, S.; Li, X.; Zhang, K.; Ai, Y.; Zhang, W.; Chen, T.; Hao, Y. Novel In-Situ AlN/p-GaN Gate HEMTs with Threshold Voltage of 3.9 V and Maximum Applicable Gate Voltage of 12.1 V. IEEE Trans. Electron Devices 2023, 70, 424–428. [Google Scholar]
- Asif Khan, M.; Bhattarai, A.; Kuznia, J.N.; Olson, D.T. High electron mobility transistor based on a GaN-AlxGa1−xN heterojunction. Appl. Phys. Lett. 1993, 63, 1214–1215. [Google Scholar]
- Wu, Y.; Zhang, J.; Zhao, S.; Wu, Z.; Wang, Z.; Mei, B.; Duan, C.; Zhao, D.; Zhang, W.; Liu, Z.; et al. Investigation of heavy ion irradiation effects on 650-V p-GaN normally-off HEMTs. Sci. China Inf. Sci. 2022, 65, 182404. [Google Scholar]
- Liu, S.; Li, S.; Zhang, C.; Li, N.; Tao, X.; Ge, C.; Qian, L.; Xin, S.; Sun, W. Single Pulse Unclamped-Inductive-Switching Induced Failure and Analysis for 650 V p-GaN HEMT. IEEE Trans. Power Electron. 2020, 35, 11328–11331. [Google Scholar] [CrossRef]
- Wei, Y.; Hossain, M.M.; Sweeting, R.; Mantooth, H.A. Cryogenic Temperature Characterizations of State-of-the-art Cascode 900 V GaN FET. In Proceedings of the 2021 AIAA/IEEE Electric Aircraft Technologies Symposium (EATS), Virtual, 11–13 August 2021; pp. 1–11. [Google Scholar]
- Kyle, E.C.; Kaun, S.W.; Burke, P.G.; Wu, F.; Wu, Y.R.; Speck, J.S. High-electron-mobility GaN grown on free-standing GaN templates by ammonia-based molecular beam epitaxy. J. Appl. Phys. 2014, 115, 193702. [Google Scholar]
- Reshchikov, M.A.; Vorobiov, M.; Andrieiev, O.; Ding, K.; Izyumskaya, N.; Avrutin, V.; Usikov, A.; Helava, H.; Makarov, Y. Determination of the concentration of impurities in GaN from photoluminescence and secondary-ion mass spectrometry. Sci. Rep. 2020, 10, 2223. [Google Scholar]
- Zhang, G.Y.; Tong, Y.Z.; Yang, Z.J.; Jin, S.X.; Li, J.; Gan, Z.Z. Relationship of background carrier concentration and defects in GaN grown by metalorganic vapor phase epitaxy. Appl. Phys. Lett. 1997, 71, 3376–3378. [Google Scholar]
- Zambrano-Serrano, M.A.; Hernández, C.A.; de Melo, O.; Behar, M.; Gallardo-Hernández, S.; Casallas-Moreno, Y.L.; Ponce, A.; Hernandez-Robles, A.; Bahena-Uribe, D.; Yee-Rendón, C.M.; et al. Effects of heavy Si doping on the structural and optical properties of n-GaN/AlN/Si(111) heterostructures. Mater. Res. Express 2022, 9, 065903. [Google Scholar] [CrossRef]
- Tang, Z.; Jiang, Q.; Lu, Y.; Huang, S.; Yang, S.; Tang, X.; Chen, K.J. 600-V Normally off SiNx/AlGaN/GaN MIS-HEMT with Large Gate Swing and Low Current Collapse. IEEE Electron Device Lett. 2013, 34, 1373–1375. [Google Scholar] [CrossRef]
- Hua, M.; Liu, C.; Yang, S.; Liu, S.; Fu, K.; Dong, Z.; Cai, Y.; Zhang, B.; Chen, K.J. GaN-based metal-insulator-semiconductor high-electron-mobility transistors using low-pressure chemical vapor deposition SiNx as gate dielectric. IEEE Electron Device Lett. 2015, 36, 448–450. [Google Scholar] [CrossRef]
- Saito, W.; Takada, Y.; Kuraguchi, M.; Tsuda, K.; Omura, I.; Ogura, T.; Ohashi, H. High Breakdwon Votage AlGaN-GaN Power-HEMT Design and High Current Density Switiching Behavior. IEEE Trans. Electron Devices 2003, 50, 2528–2531. [Google Scholar] [CrossRef]
- Xie, G.; Xu, E.; Lee, J.; Hashemi, N.; Zhang, B.; Fu, F.Y.; Ng, W.T. Breakdown-Voltage-Enhancement Technique for RF-Based Al Ga N/Ga N HEMTs with a Source-Connected Air-Bridge Field Plate. IEEE Electron Device Lett. 2012, 33, 670–672. [Google Scholar] [CrossRef]
- Xing, H.; Dora, Y.; Chini, A.; Heikman, S.; Keller, S.; Mishra, U.K. High Breakdown Voltage Al Ga N–Ga N HEMTs Achieved by Multiple Field Plates. IEEE Electron Device Lett. 2004, 25, 161–163. [Google Scholar] [CrossRef]
- Uemoto, Y.; Shibata, D.; Yanagihara, M.; Ishida, H.; Matsuo, H.; Nagai, S.; Batta, N.; Li, M.; Ueda, T.; Tanaka, T.; et al. 8300V blocking voltage AlGaN/GaN power HFET with thick poly-AlN passivation. In Proceedings of the 2007 IEEE International Electron Devices Meeting, Washington, DC, USA, 10–12 December 2007; pp. 861–864. [Google Scholar]
- Bahat-Treidel, E.; Hilt, O.; Brunner, F.; Sidorov, V.; Würfl, J.; Tränkle, G. AlGaN/Ga N/AlGaN DH-HEMTs Breakdown Voltage Enhancement Using Multiple Grating Field Plates (MGFPs). IEEE Trans. Electron Devices 2010, 57, 1208–1216. [Google Scholar] [CrossRef]
- Zhao, Z.; Zhao, Z.; Luo, Q.; Du, J. High-voltage RESURF AlGaN/GaN high electron mobility transistor with back electrode. Electron. Lett. 2013, 49, 1638–1640. [Google Scholar] [CrossRef]
- Xiao, M.; Ma, Y.; Du, Z.; Pathirana, V.; Cheng, K.; Xie, A.; Beam, E.; Cao, Y.; Udrea, F.; Wang, H.; et al. Multi-channel monolithic-cascode HEMT (MC2-HEMT): A new GaN power switch up to 10 kV. In Proceedings of the IEEE International Electron Devices Meeting (IEDM), San Francisco, CA, USA, 13–15 December 2021; pp. 5.5.1–5.5.4. [Google Scholar]
- Xiong, J.; Yang, C.; Wei, J.; Wu, J.; Zhang, B.; Luo, X. Novel high voltage RESURF AlGaN/GaN HEMT with charged buffer layer. Sci. China 2016, 59, 042410. [Google Scholar] [CrossRef]
- Nakajima, A.; Sumida, Y.; Dhyani, M.H.; Kawai, H.; Narayanan, E.M. Ga N-Based Super Heterojunction Field Effect Transistors Using the Polarization Junction Concept. IEEE Electron Device Lett. 2011, 32, 542–544. [Google Scholar] [CrossRef]
- Dora, Y.; Chakraborty, A.; Mccarthy, L.; Keller, S.; DenBaars, S.P.; Mishra, U.K. High breakdown voltage achieved on AlGaN/GaN HEMTs with integrated slant field plates. IEEE Electron Device Lett. 2006, 27, 713–715. [Google Scholar] [CrossRef]
- Yanagihara, M.; Uemoto, Y.; Ueda, T.; Tanaka, T.; Ueda, D. Recent advances in GaN transistors for future emerging applications. Phys. Status Solidi 2009, 206, 1221–1227. [Google Scholar] [CrossRef]
- Liu, J.; Zhang, J.; Yao, J.; Li, M.; Chen, J.; Zhang, M.; Huang, X.; Huang, C.; Tang, W.; Guo, Y. The Drift Region Width Modulation Technique for Breakdown Performance Enhancement of AlGaN/GaN HEMT. Electron Devices Soc. 2022, 10, 983–988. [Google Scholar] [CrossRef]
- Deng, S.; Luo, X.; Wei, J.; Jia, Y.; Sun, T.; Xi, L.; Jiang, Z.; Yang, K.; Jiang, Q.; Zhang, B. High Breakdown Voltage AlGaN/GaN HEMT with Graded Fluorine Ion Implantation Terminal in Thick Passivation Layer. In Proceedings of the 2021 IEEE Workshop on Wide Bandgap Power Devices and Applications in Asia (WiPDA Asia), Online, 25–27 August 2021; pp. 403–406. [Google Scholar]
- Tsai, Y.L.; Chang, T.C.; Tsao, Y.C.; Tai, M.C.; Tu, H.Y.; Chien, Y.T.; Jin, F.Y.; Zheng, H.X.; Lin, Y.S.; Ciou, F.M.; et al. Improving Breakdown Voltage in AlGaN/GaN Metal-Insulator-Semiconductor HEMTs through Electric-Field Dispersion Layer Material Selection. IEEE Trans. Device Mater. Reliab. 2021, 21, 320–323. [Google Scholar] [CrossRef]
- Bahat-Treidel, E.; Brunner, F.; Hilt, O.; Cho, E.; Wurfl, J.; Trankle, G. AlGaN/GaN/GaN:C Back-Barrier HFETs with Breakdown Voltage of Over 1 kV and Low RON × A. IEEE Trans. Electron Devices 2010, 57, 3050–3058. [Google Scholar] [CrossRef]
- Ma, J.; Zhang, J.; Xue, J.; Lin, Z.; Liu, Z.; Xue, X.; Ma, X.; Hao, Y. Characteristics of AlGaN/GaN/AlGaN double heterojunction HEMTs with an improved breakdown voltage. J. Semicond. 2012, 33, 014002. [Google Scholar] [CrossRef]
- Cho, E.; Brunner, F.; Zhytnytska, R.; Kotara, P.; Würfl, J.; Weyers, M. Enhancement of channel conductivity in AlGaN/GaN heterostructure field effect transistors by AlGaN:Si back barrier. Appl. Phys. Lett. 2011, 99, 103505. [Google Scholar]
- Nakajima, A.; Hirai, H.; Miura, Y.; Harada, S. 1.2 kV GaN/SiC-based Hybrid High Electron Mobility Transistor with Non-destructive Breakdown. In Proceedings of the 2021 IEEE International Electron Devices Meeting (IEDM), San Francisco, CA, USA, 13–15 December 2021; pp. 36.5.1–36.5.4. [Google Scholar]
- Ng, J.H.; Tone, K.; Asubar, J.T.; Tokuda, H.; Kuzuhara, M. High breakdown voltage AlGaN/GaN HEMTs on free-standing GaN substrate. In Proceedings of the 2015 IEEE International Meeting for Future of Electron Devices, Kansai (IMFEDK), Kyoto, Japan, 4–5 June 2015; pp. 54–55. [Google Scholar]
- Liu, X.; Zhan, C.; Chan, K.W.; Liu, W.; Tan, L.S.; Teo, K.L.; Chen, K.J.; Yeo, Y.C. AlGaN/GaN-on-Silicon MOS-HEMTs with breakdown voltage of 800 V and on-state resistance of 3 mΩ cm2 using a CMOS-compatible gold-free process. In Proceedings of the Technical Program of 2012 VLSI Technology, System and Application, Hsinchu, Taiwan, 23–25 April 2012; pp. 1–2. [Google Scholar]
- Lee, H.-S.; Piedra, D.; Sun, M.; Gao, X.; Guo, S.; Palacios, T. 3000-V 4.3-mΩ·cm2 InAlN/GaN MOSHEMTs with AlGaN Back Barrier. IEEE Electron Device Lett. 2012, 33, 982–984. [Google Scholar]
- Li, X.; Zhang, W.; Fu, M.; Zhang, J.; Jiang, H.; Guo, Z.; Zou, Y.; Jiang, R.; Shi, Z.; Hao, Y. AlGaN channel MIS-HEMTs with a very high breakdown electric field and excellent high-temperature performance. IEICE Electron. Express 2015, 12, 20150694. [Google Scholar] [CrossRef][Green Version]
- Wu, J.S.; Liao, P.H.; Chang, S.J.; Yang, T.Y.; Teng, C.Y.; Liang, Y.K.; Panda, D.; Luc, Q.H.; Chang, E.Y. Superior Breakdown, Retention, and TDDB Lifetime for Ferroelectric Engineered Charge Trap Gate E-mode GaN MIS-HEMT. In Proceedings of the 2022 International Electron Devices Meeting (IEDM), San Francisco, CA, USA, 3–7 December 2022; pp. 847–850. [Google Scholar]
- Ma, J.; Matioli, E. High performance tri-gate GaN power MOSHEMTs on silicon substrate. IEEE Electron Device Lett. 2017, 38, 367–370. [Google Scholar] [CrossRef]
- Lu, B.; Palacios, T. High Breakdown (>1500 V) AlGaN/GaN HEMTs by Substrate-Transfer Technology. IEEE Electron Device Lett. 2010, 31, 951–953. [Google Scholar] [CrossRef]
- Dogmus, E.; Zegaoui, M.; Medjdoub, F. GaN-on-silicon high-electron-mobility transistor technology with ultra-low leakage up to 3000 V using local substrate removal and AlN ultra-wide bandgap. Appl. Phys. Express 2018, 11, 034102. [Google Scholar] [CrossRef]
- Zhao, S.; Zhang, J.; Zhang, Y.; Feng, L.; Liu, S.; Song, X.; Yao, Y.; Luo, J.; Liu, Z.; Xu, S.; et al. 1.7 kV normally-off p-GaN gate high-electron-mobility transistors on a semi-insulating SiC substrate. Sci. China Inf. 2023, 66, 122407. [Google Scholar] [CrossRef]
- Nanjo, T.; Takeuchi, M.; Suita, M.; Oishi, T.; Abe, Y.; Tokuda, Y.; Aoyagi, Y. Remarkable breakdown voltage enhancement in AlGaN channel high electron mobility transistors. Appl. Phys. Lett. 2008, 92, 263502. [Google Scholar] [CrossRef]
- Wu, Y.; Zhang, J.; Zhao, S.; Zhang, W.; Zhang, Y.; Duan, X.; Chen, J.; Hao, Y. More than 3000 V reverse blocking Schottky-drain AlGaN-channel HEMTs with >230 MW/cm2 power figure-of-merit. IEEE Electron Device Lett. 2019, 40, 1724–1727. [Google Scholar] [CrossRef]
- Mehta, J.; Abid, I.; Bassaler, J.; Pernot, J.; Ferrandis, P.; Rennesson, S.; Ngo, T.H.; Nemoz, M.; Tamariz, S.; Cordier, Y.; et al. Towards high buffer breakdown field and high temperature stability AlGaN channel HEMTs on silicon substrate. In Proceedings of the 2022 Compound Semiconductor Week (CSW), Ann Arbor, MI, USA, 1–3 June 2022; pp. 1–2. [Google Scholar]
- Liu, S.; Zhang, W.; Zhang, J.; Song, X.; Wu, Y.; Chen, D.; Xu, S.; Zhao, S.; Hao, Y. AlN/GaN superlattice channel HEMTs on silicon substrate. IEEE Trans. Electron Devices 2021, 68, 3296–3301. [Google Scholar] [CrossRef]
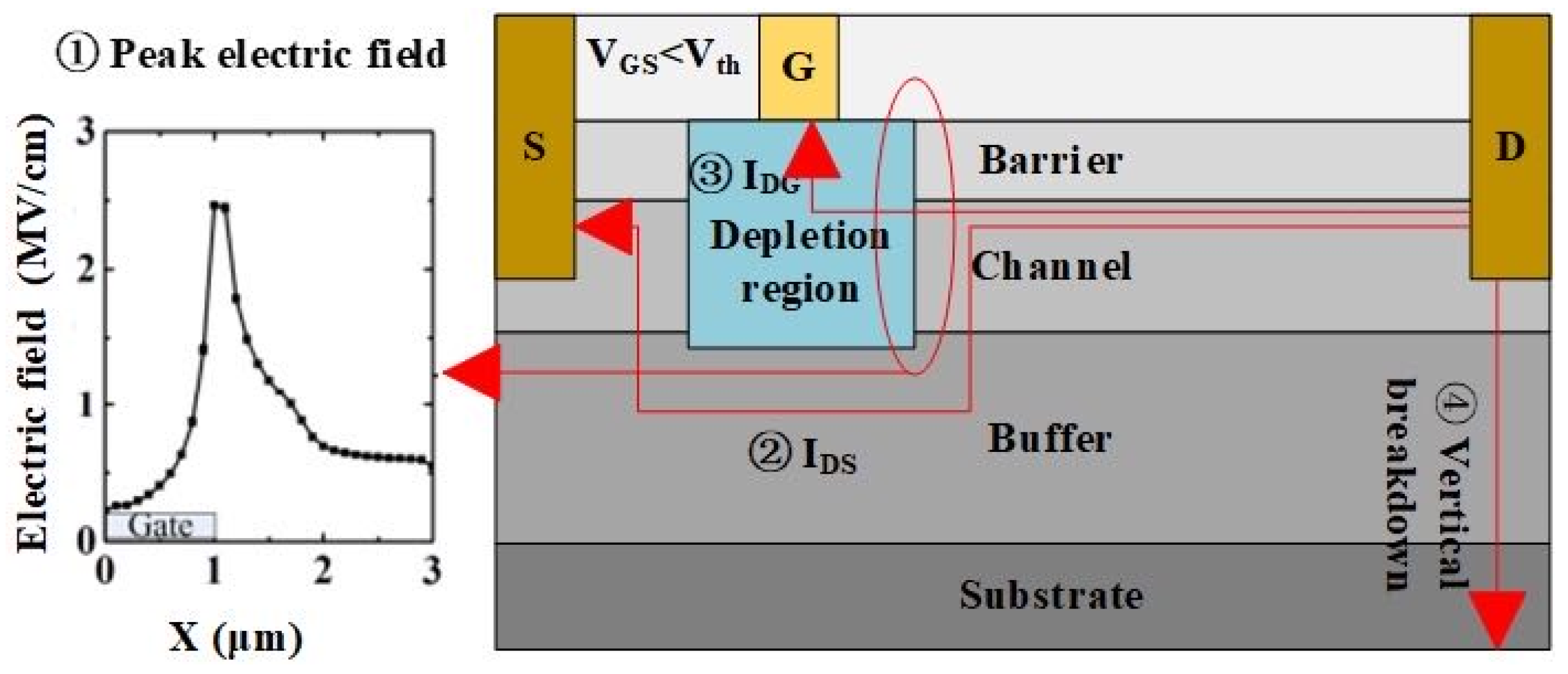
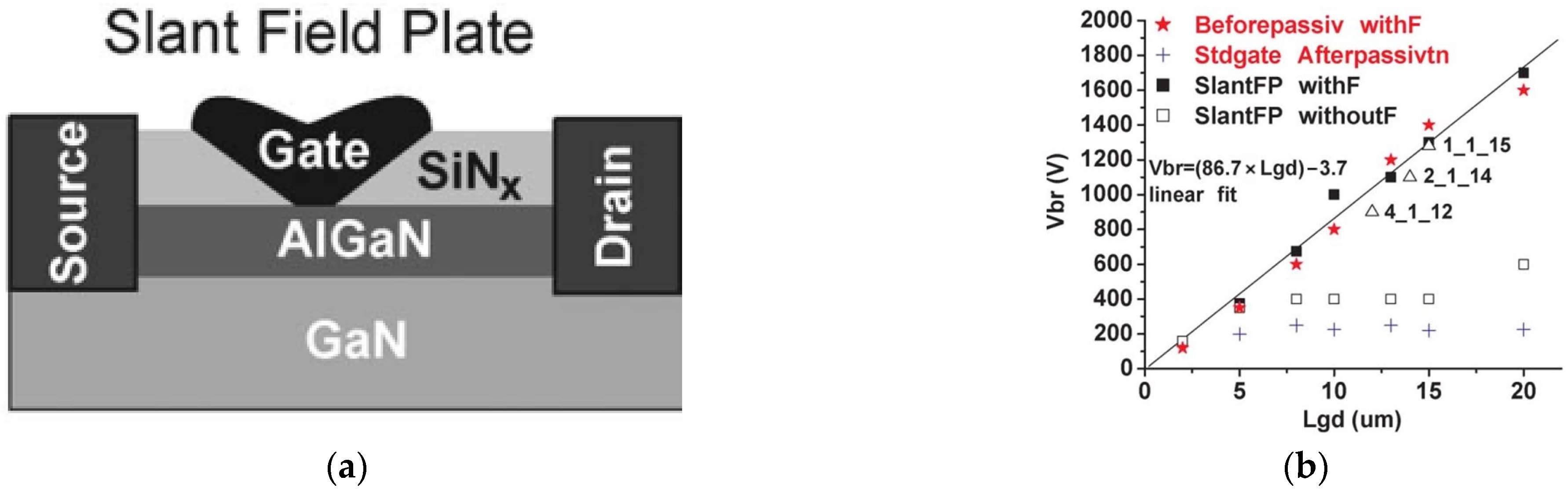
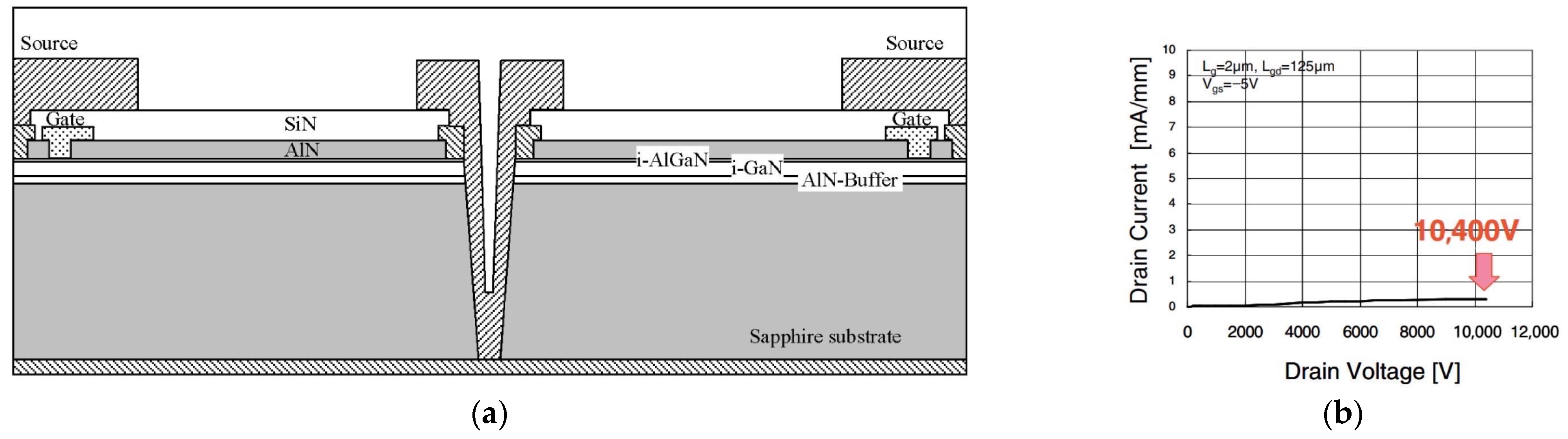
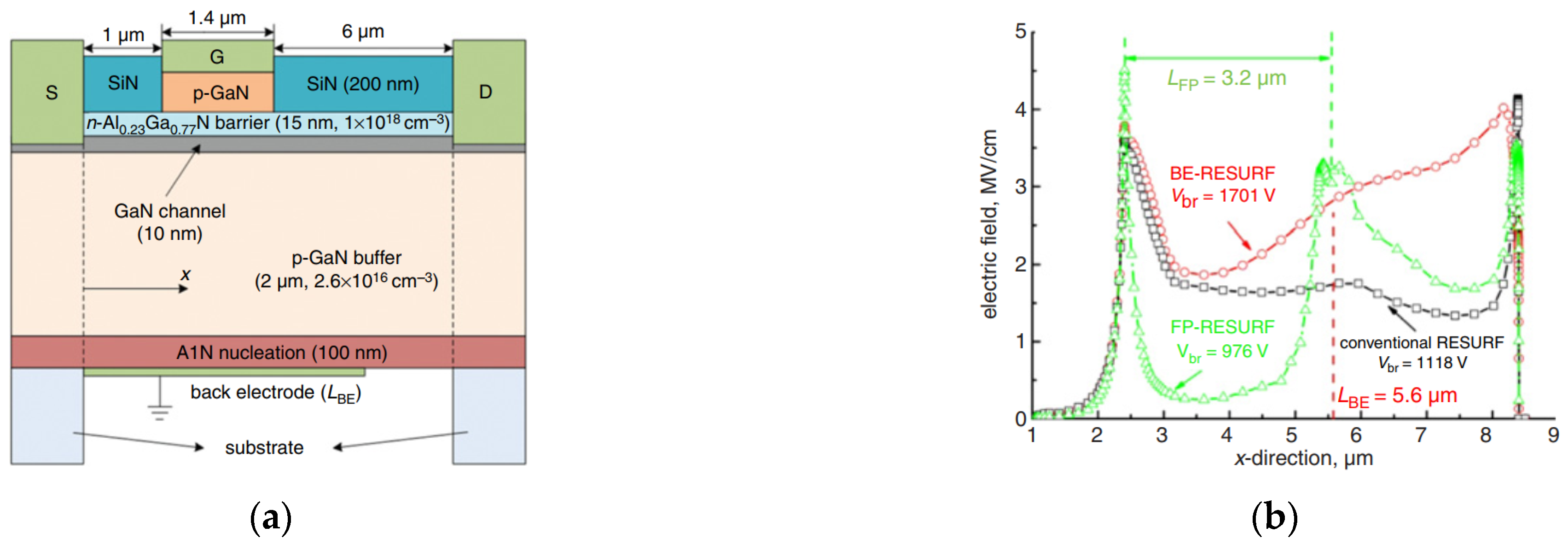
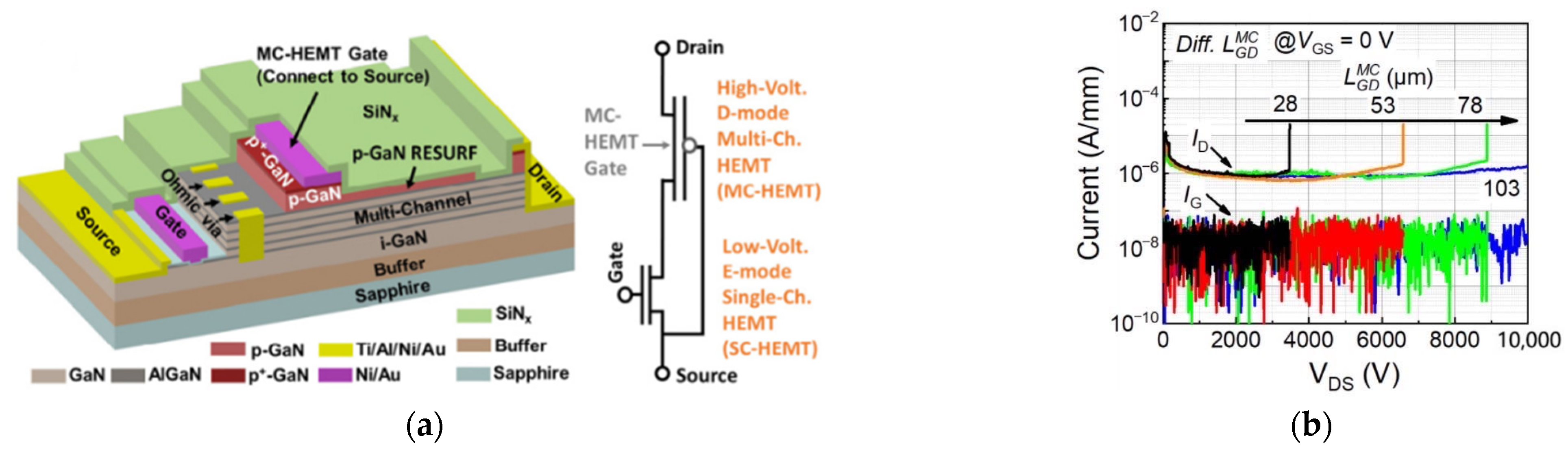



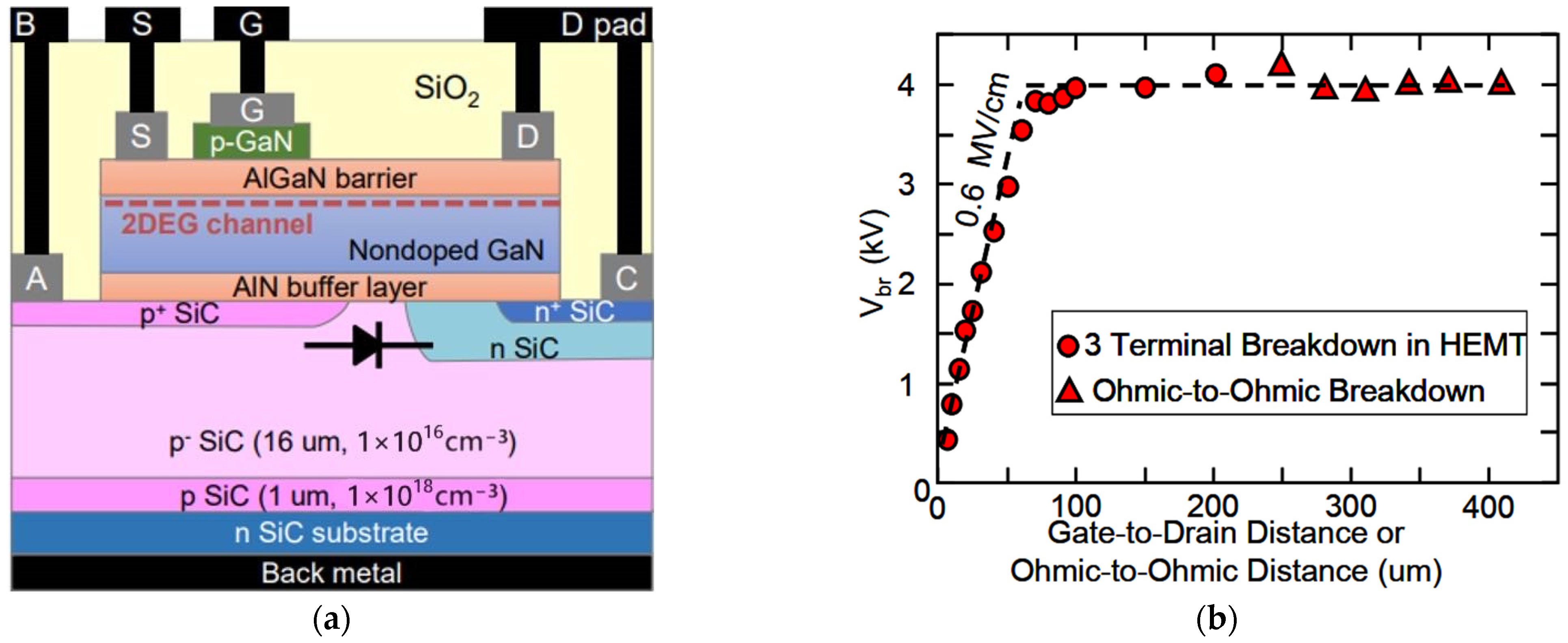
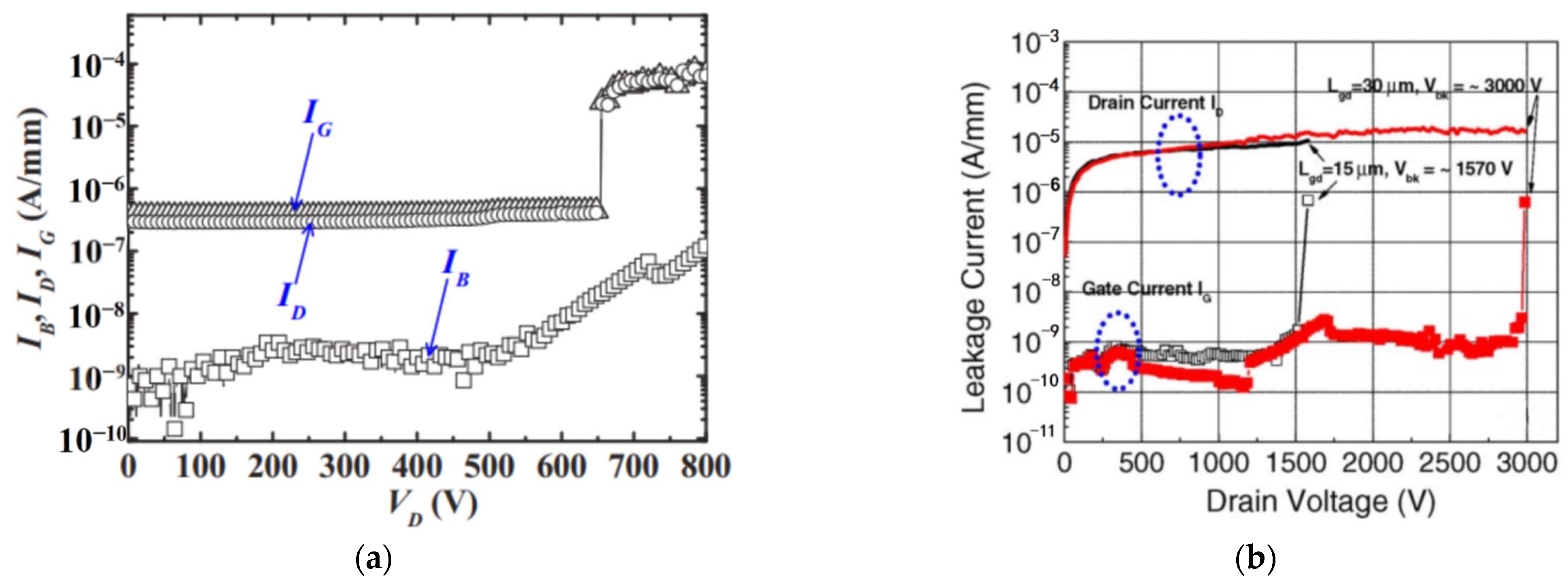

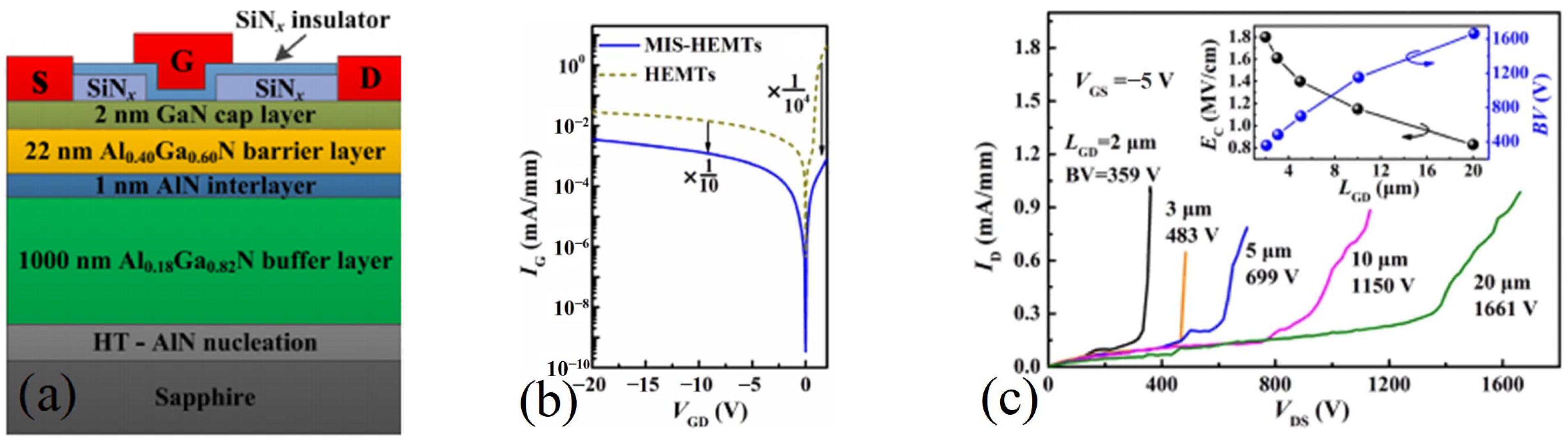
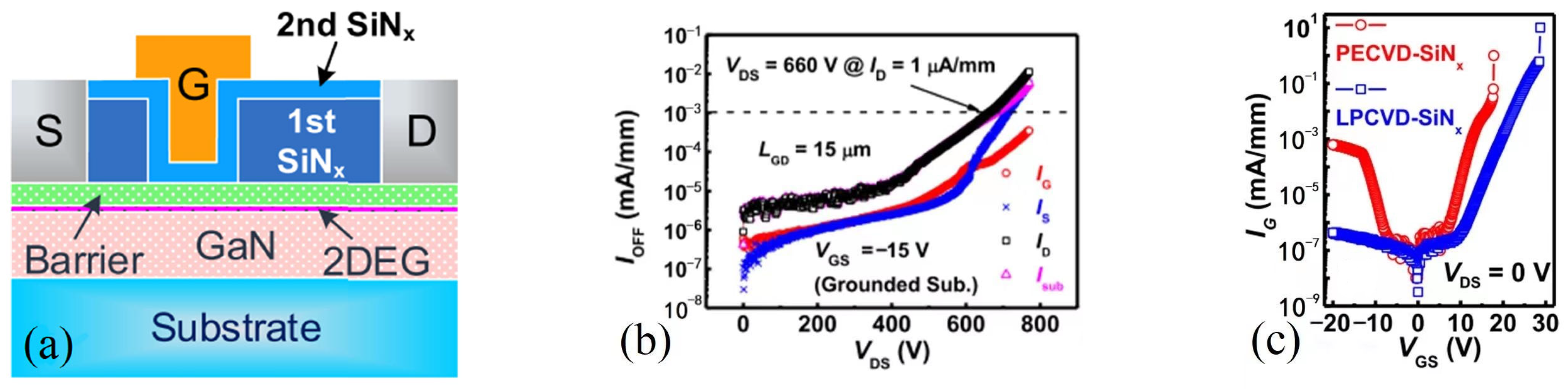
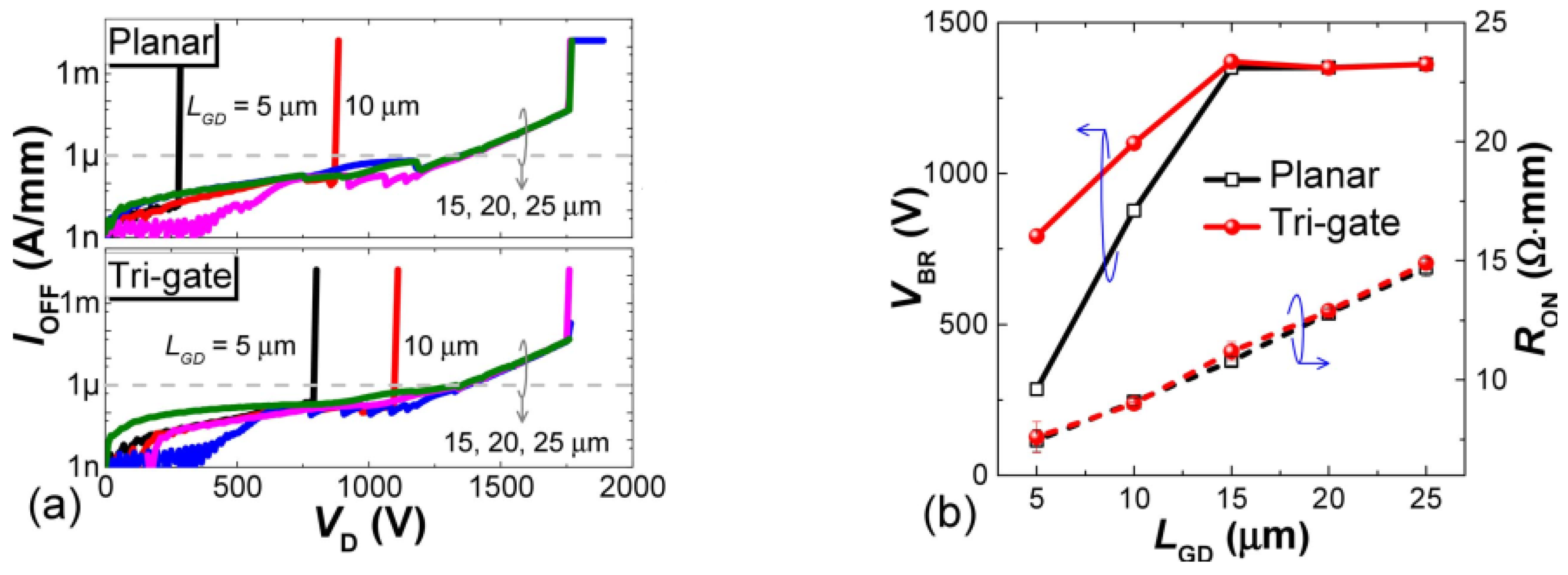
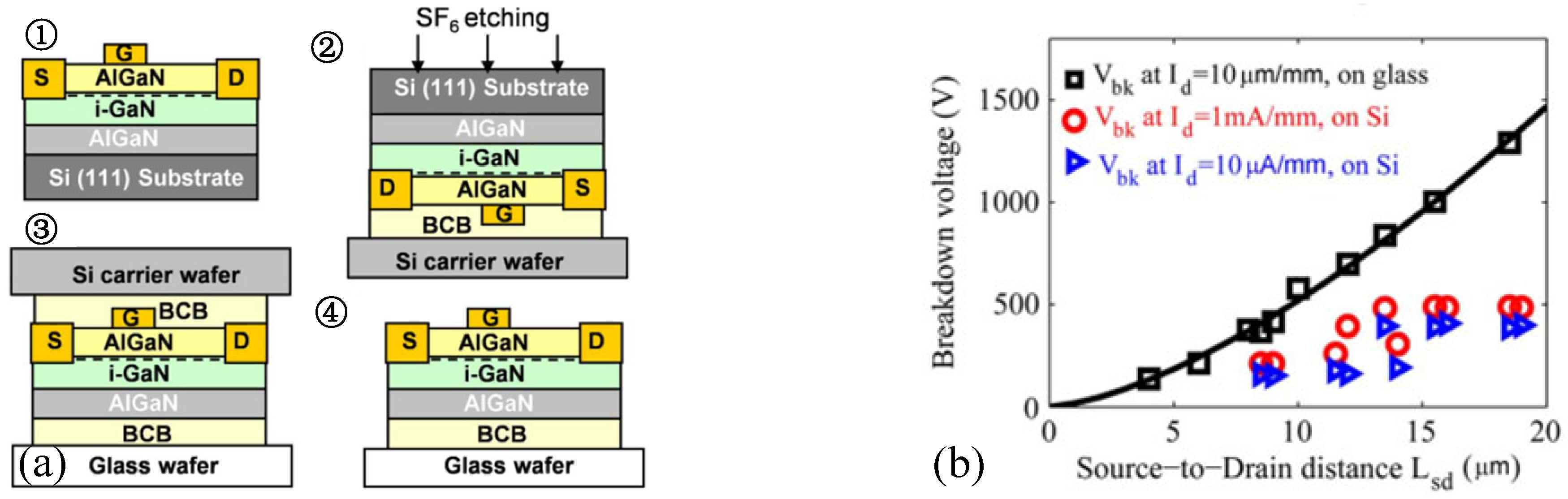

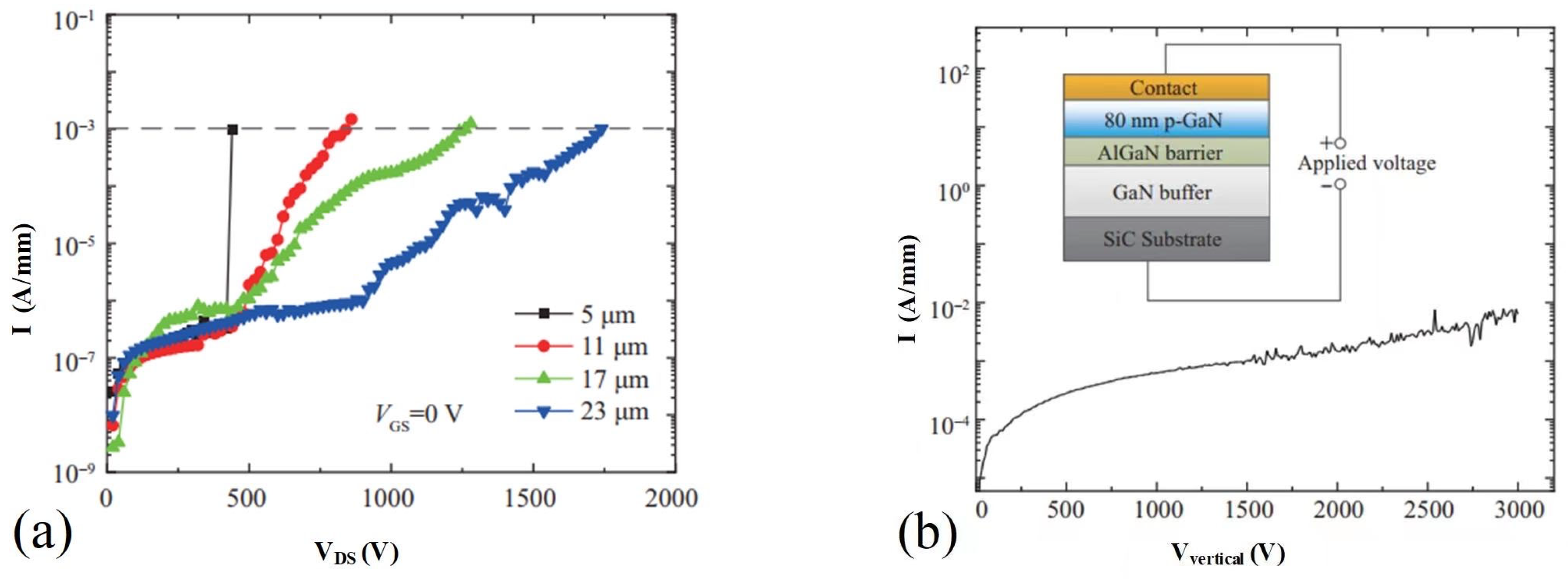
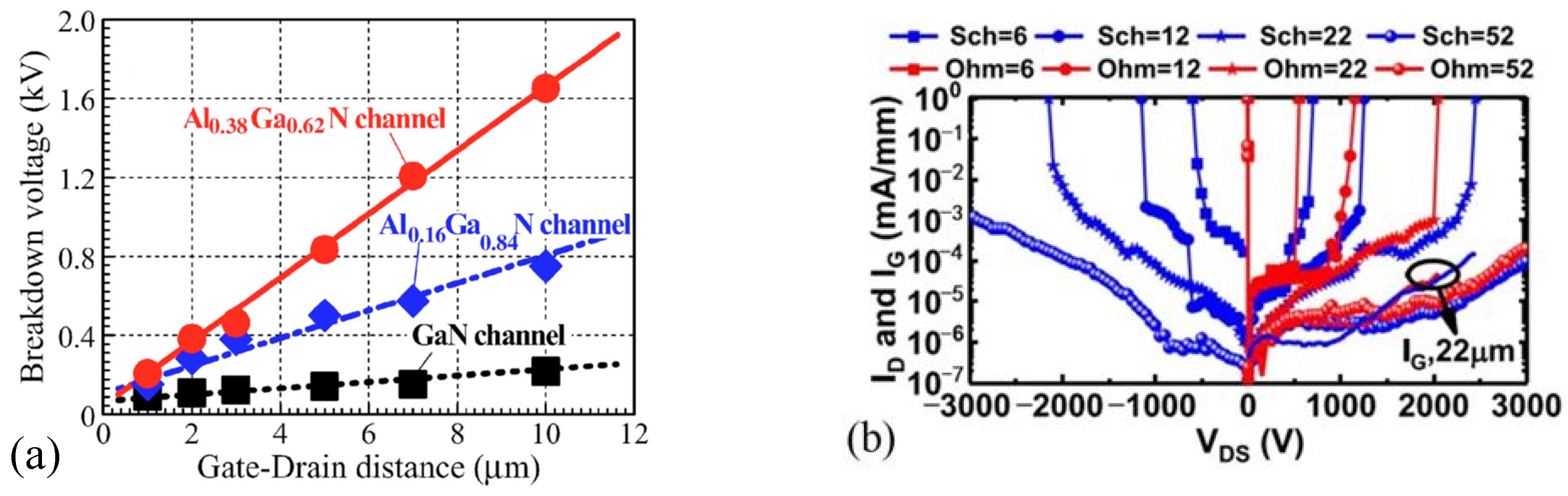

| Adopted Technology | Solved Problem | Breakdown Voltage (V) | Average Electric Field (MV/cm) | FOM (MV2/Ωcm2) | Reference |
|---|---|---|---|---|---|
| Field plate, RESURF | Modulated electric field | 1900 | 0.95 | - | Ref [24] |
| 10,000 | 1.2 | 2840 | Ref [21] | ||
| Carbon doping, Back barrier | Reduce buffer leakage | 942 | 1.87 | 2300 | Ref [29] |
| 1000 | 1.0 | - | Ref [31] | ||
| MIS-HEMT | Reduce gate leakage | 3000 | 1.0 | 2100 | Ref [35] |
| Substrate transfer, SiC substrate | Improving vertical breakdown | 3000 | 0.8 | 682 | Ref [40] |
| 1740 | 0.8 | - | Ref [41] | ||
| AlGaN channel, superlattice | Improving material breakdown | 3000 | 0.9 | 447 | Ref [43] |
| 1700 | 0.8 | - | Ref [45] |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Tian, Z.; Ji, X.; Yang, D.; Liu, P. Research Progress in Breakdown Enhancement for GaN-Based High-Electron-Mobility Transistors. Electronics 2023, 12, 4435. https://doi.org/10.3390/electronics12214435
Tian Z, Ji X, Yang D, Liu P. Research Progress in Breakdown Enhancement for GaN-Based High-Electron-Mobility Transistors. Electronics. 2023; 12(21):4435. https://doi.org/10.3390/electronics12214435
Chicago/Turabian StyleTian, Zhiwen, Xuan Ji, Dongwei Yang, and Pei Liu. 2023. "Research Progress in Breakdown Enhancement for GaN-Based High-Electron-Mobility Transistors" Electronics 12, no. 21: 4435. https://doi.org/10.3390/electronics12214435
APA StyleTian, Z., Ji, X., Yang, D., & Liu, P. (2023). Research Progress in Breakdown Enhancement for GaN-Based High-Electron-Mobility Transistors. Electronics, 12(21), 4435. https://doi.org/10.3390/electronics12214435





