Low-Frequency 1/f Noise Characteristics of Ultra-Thin AlOx-Based Resistive Switching Memory Devices with Magneto-Resistive Responses
Abstract
:1. Introduction
2. Materials and Methods
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Acknowledgments
Conflicts of Interest
References
- Slesazeck, S.; Mikolajick, T. Nanoscale resistive switching memory devices: A review. Nanotechnology 2019, 30, 352003. [Google Scholar] [CrossRef] [PubMed]
- Waser, R.; Aono, M. Nanoscience and Technology: A Collection of Reviews from Nature Journals. World Sci. 2010, 158–165. [Google Scholar]
- Kwon, D.H.; Kim, K.M.; Jang, J.H.; Jeon, J.M.; Lee, M.H.; Kim, G.H.; Li, X.S.; Park, G.S.; Lee, B.; Han, S.; et al. Atomic structure of conducting nanofilaments in TiO2 resistive switching memory. Nat. Nanotechnol. 2010, 5, 148. [Google Scholar] [CrossRef] [PubMed]
- Ielmini, D. Resistive switching memories based on metal oxides: Mechanisms, reliability and scaling. Semicond. Sci. Technol. 2016, 31, 063002. [Google Scholar] [CrossRef]
- Yang, J.J.; Strukov, D.B.; Stewart, D.R. Memristive devices for computing. Nat. Nanotechnol. 2013, 8, 13–24. [Google Scholar] [CrossRef] [PubMed]
- Gao, S.; Yi, X.; Shang, J.; Liu, G.; Li, R.W. Organic and hybrid resistive switching materials and devices. Chem. Soc. Rev. 2019, 48, 1531–1565. [Google Scholar] [CrossRef] [PubMed]
- Panda, D.; Tseng, T.Y. Perovskite oxides as resistive switching memories: A review. Ferroelectrics 2014, 471, 23–64. [Google Scholar] [CrossRef]
- Sawa, A. Resistive switching in transition metal oxides. Mater. Today 2008, 11, 28–36. [Google Scholar] [CrossRef]
- Lee, J.S.; Lee, S.; Noh, T.W. Resistive switching phenomena: A review of statistical physics approaches. Appl. Phys. Rev. 2015, 2, 031303. [Google Scholar] [CrossRef] [Green Version]
- Sarkar, B.; Lee, B.; Misra, V. Understanding the gradual reset in Pt/Al2O3/Ni RRAM for synaptic applications. Semicond. Sci. Technol. 2015, 30, 105014. [Google Scholar] [CrossRef]
- Jang, J.; Choi, H.H.; Paik, S.H.; Kim, J.K.; Chung, S.; Park, J.H. Highly improved switching properties in flexible aluminum oxide resistive memories based on a multilayer device structure. Adv. Electron. Mater. 2018, 4, 1800355. [Google Scholar] [CrossRef]
- Tran, X.A.; Zhu, W.; Liu, W.J.; Yeo, Y.C.; Nguyen, B.Y.; Yu, H.Y. A Self-Rectifying AlOy Bipolar RRAM with Sub-50-μA Set/Reset current for cross-bar architecture. IEEE Electron Device Lett. 2012, 33, 1402–1404. [Google Scholar] [CrossRef]
- Miyazaki, T.; Tezuka, N. Spin polarized tunneling in ferromagnet/insulator/ferromagnet junctions. J. Magn. Magn. Mater. 1995, 151, 403–410. [Google Scholar] [CrossRef]
- Moodera, J.S.; Kinder, L.R. Ferromagnetic–insulator–ferromagnetic tunneling: Spin-dependent tunneling and large magnetoresistance in trilayer junctions. J. Appl. Phys. 1996, 79, 4724–4729. [Google Scholar] [CrossRef]
- Teixeira, J.M.; Ventura, J.; Fermento, R.; Araujo, J.P.; Sousa, J.B.; Wisniowski, P.; Freitas, P.P. Electroforming, magnetic and resistive switching in MgO-based tunnel junctions. J. Phys. D Appl. Phys. 2009, 42, 105407. [Google Scholar] [CrossRef]
- Yoshida, C.; Kurasawa, M.; Lee, Y.M.; Aoki, M.; Sugiyama, Y. Unipolar resistive switching in CoFeB/MgO/CoFeB magnetic tunnel junction. Appl. Phys. Lett. 2008, 92, 113508. [Google Scholar] [CrossRef]
- Krzysteczko, P.; Reiss, G.; Thomas, A. Memristive switching of MgO based magnetic tunnel junctions. Appl. Phys. Lett. 2009, 95, 112508. [Google Scholar] [CrossRef] [Green Version]
- Hong, J.Y.; Hung, C.F.; Yang, K.H.O.; Chiu, K.C.; Ling, D.C.; Chiang, W.C.; Lin, M.T. Electrically programmable magnetoresistance in AlOx-based magnetic tunnel junctions. Sci. Rep. 2021, 11, 6027. [Google Scholar] [CrossRef]
- Persson, K.M.; Ram, M.S.; Wernersson, L.E. Ultra-Scaled AlOx Diffusion Barriers for Multibit HfOx RRAM Operation. IEEE J. Electron Devices Soc. 2021, 9, 564–569. [Google Scholar] [CrossRef]
- Cho, S.; Jung, J.; Kim, S.; Pak, J.J. Conduction mechanism and synaptic behaviour of interfacial switching AlOσ-based RRAM. Semicond. Sci. Technol. 2020, 35, 085006. [Google Scholar] [CrossRef]
- Yu, S.; Jeyasingh, R.; Wu, Y.; Wong, H.S.P. Characterization of low-frequency noise in the resistive switching of transition metal oxide HfO2. Phys. Rev. B 2012, 85, 045324. [Google Scholar] [CrossRef] [Green Version]
- Kim, Y.; Song, H.; Kim, D.; Lee, T.; Jeong, H. Noise characteristics of charge tunneling via localized states in metal- molecule- metal Junctions. ACS Nano 2010, 4, 4426–4430. [Google Scholar] [CrossRef] [PubMed]
- Hooge, F.N.; Kleinpenning, T.G.M.; Vandamme, L.K.J. Experimental studies on 1/f noise. Rep. Prog. Phys. 1981, 44, 479. [Google Scholar] [CrossRef]
- Hooge, F.N.; Kleinpenning, T.G.M.; Vandamme, L.K.J. 1/f Noise Sources. IEEE Trans. Electron. Devices 1994, 41, 1926–1935. [Google Scholar] [CrossRef] [Green Version]
- Aliev, F.; Cascales, J.P. Experimental Methods. Noise in Spintronics: From Understanding to Manipulation; CRC Press: Boca Raton, FL, USA, 2018. [Google Scholar]
- Lentz, F.; Roesgen, B.; Rana, V.; Wouters, D.J.; Waser, R. Current Compliance-Dependent Nonlinearity in TiO2 ReRAM. IEEE Electron. Device Lett. 2013, 34, 996–998. [Google Scholar] [CrossRef]
- Sassine, G.; La Barbera, S.; Najjari, N.; Minvielle, M.; Dubourdieu, C.; Alibart, F. Interfacial versus filamentary resistive switching in TiO2 and HfO2 devices. J. Vac. Sci. Technol. B Nanotechnol. Microelectron. Mater. Process. Meas. Phenom. 2016, 34, 012202. [Google Scholar] [CrossRef]
- Bagdzevicius, S.; Maas, K.; Boudard, M.; Burriel, M. Interface-type resistive switching in perovskite materials. J. Electroceram. 2017, 39, 157–184. [Google Scholar] [CrossRef]
- Shaibo, J.; Yang, R.; Wang, Z.; Huang, H.M.; Xiong, J.; Guo, X. Electric field control of resistive switching and magnetization in epitaxial LaBaCo2O5+δ thin films. Phys. Chem. Chem. Phys. 2019, 21, 8843–8848. [Google Scholar] [CrossRef]
- Huang, Q.; Dong, Y.; Zhao, X.; Wang, J.; Chen, Y.; Bai, L.; Dai, Y.; Dai, Y.; Yan, S.; Tian, Y. Electrical Control of Perpendicular Magnetic Anisotropy and Spin-Orbit Torque-Induced Magnetization Switching. Adv. Electron. Mater. 2020, 6, 1900782. [Google Scholar] [CrossRef]
- Song, Y.; Jeong, H.; Jang, J.; Kim, T.Y.; Yoo, D.; Kim, Y.; Jeong, H.; Lee, T. 1/f Noise scaling analysis in unipolar-type organic nanocomposite resistive memory. ACS Nano 2015, 9, 7697–7703. [Google Scholar] [CrossRef]
- Song, Y.; Lee, T. Electronic noise analyses on organic electronic devices. J. Mater. Chem. C 2017, 5, 7123–7141. [Google Scholar] [CrossRef]
- Rocha, P.R.; Gomes, H.L.; Vandamme, L.K.; Chen, Q.; Kiazadeh, A.; De Leeuw, D.M.; Meskers, S.C. Low-frequency diffusion noise in resistive-switching memories based on metal–oxide polymer structure. IEEE Trans. Electron. Devices 2012, 59, 2483–2487. [Google Scholar] [CrossRef] [Green Version]
- Almeida, J.M.; Wisniowski, P.; Freitas, P.P. Low-frequency noise in MgO magnetic tunnel junctions: Hooge’s parameter dependence on bias voltage. IEEE Trans. Magn. 2008, 44, 2569–2572. [Google Scholar] [CrossRef]
- Huang, X.D.; Li, Y.; Li, H.Y.; Xue, K.H.; Wang, X.; Miao, X.S. Forming-free, fast, uniform, and high endurance resistive switching from cryogenic to high temperatures in W/AlOx/Al2O3/Pt bilayer memristor. IEEE Electron. Device Lett. 2020, 41, 549–552. [Google Scholar] [CrossRef]
- Wang, Z.; Sun, B.; Ye, H.; Liu, Z.; Liao, G.; Shi, T. Annealed AlOx film with enhanced performance for bipolar resistive switching memory. Appl. Surf. Sci. 2021, 546, 149094. [Google Scholar] [CrossRef]
- Momida, H.; Nigo, S.; Kido, G.; Ohno, T. Effect of vacancy-type oxygen deficiency on electronic structure in amorphous alumina. Appl. Phys. Lett. 2011, 98, 042102. [Google Scholar] [CrossRef]
- Kubota, M.; Nigo, S.; Kato, S.; Amemiya, K. Conduction band caused by oxygen vacancies in aluminum oxide for resistance random access memory. J. Appl. Phys. 2012, 112, 033711. [Google Scholar]
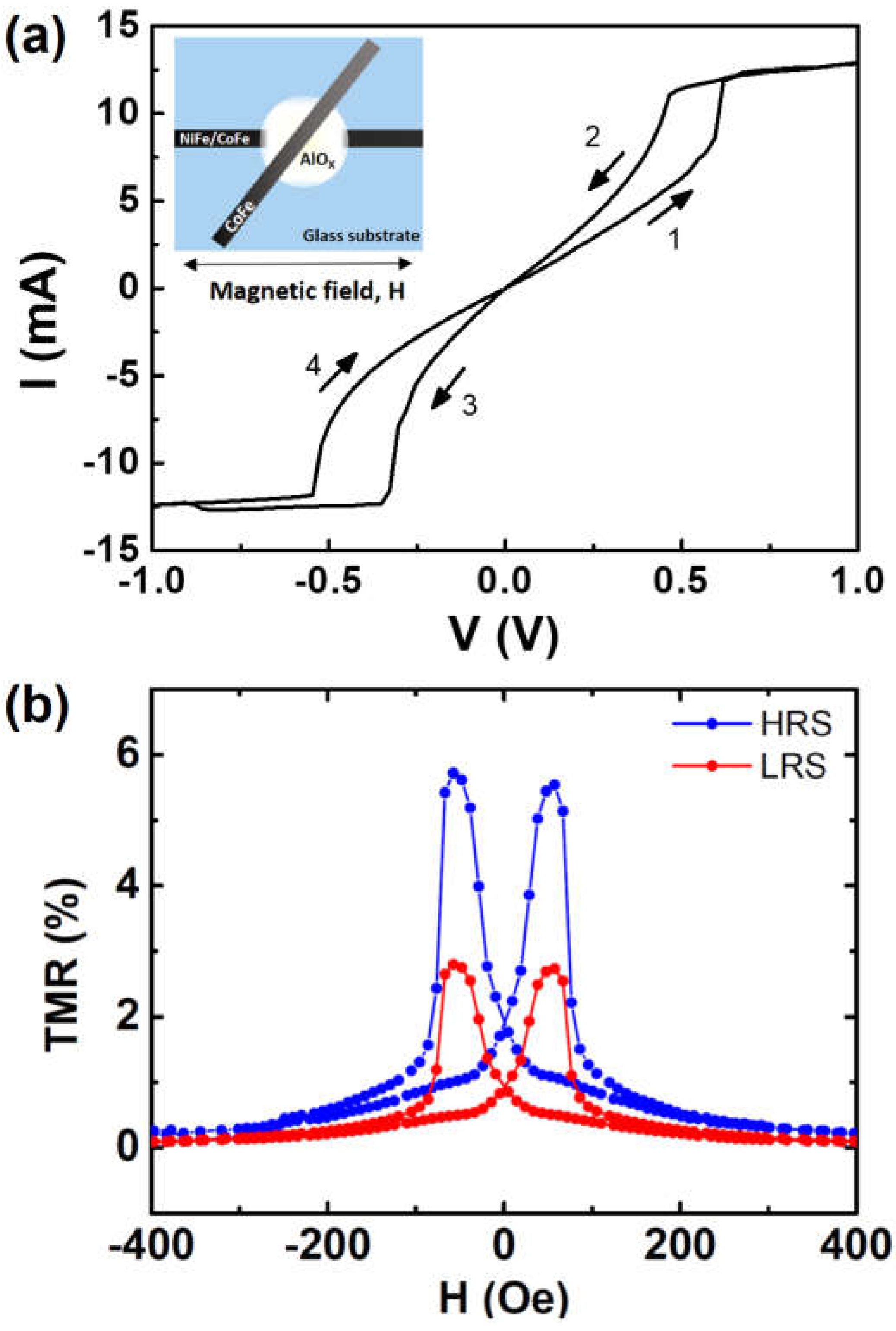

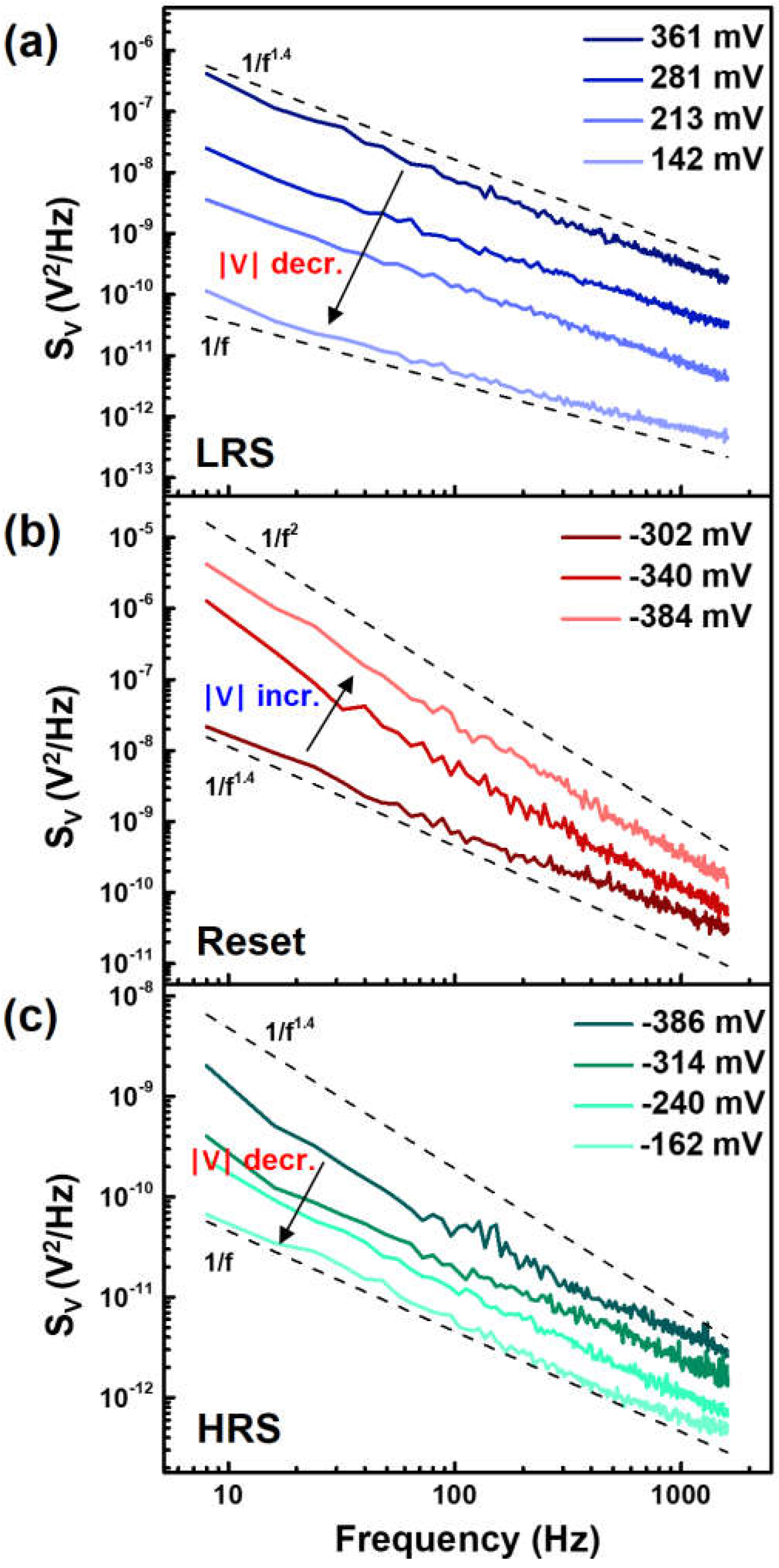

Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Hong, J.-Y.; Chen, C.-Y.; Ling, D.-C.; Martínez, I.; González-Ruano, C.; Aliev, F.G. Low-Frequency 1/f Noise Characteristics of Ultra-Thin AlOx-Based Resistive Switching Memory Devices with Magneto-Resistive Responses. Electronics 2021, 10, 2525. https://doi.org/10.3390/electronics10202525
Hong J-Y, Chen C-Y, Ling D-C, Martínez I, González-Ruano C, Aliev FG. Low-Frequency 1/f Noise Characteristics of Ultra-Thin AlOx-Based Resistive Switching Memory Devices with Magneto-Resistive Responses. Electronics. 2021; 10(20):2525. https://doi.org/10.3390/electronics10202525
Chicago/Turabian StyleHong, Jhen-Yong, Chun-Yen Chen, Dah-Chin Ling, Isidoro Martínez, César González-Ruano, and Farkhad G. Aliev. 2021. "Low-Frequency 1/f Noise Characteristics of Ultra-Thin AlOx-Based Resistive Switching Memory Devices with Magneto-Resistive Responses" Electronics 10, no. 20: 2525. https://doi.org/10.3390/electronics10202525
APA StyleHong, J.-Y., Chen, C.-Y., Ling, D.-C., Martínez, I., González-Ruano, C., & Aliev, F. G. (2021). Low-Frequency 1/f Noise Characteristics of Ultra-Thin AlOx-Based Resistive Switching Memory Devices with Magneto-Resistive Responses. Electronics, 10(20), 2525. https://doi.org/10.3390/electronics10202525





