Structure and Chemical Composition of Ion-Synthesized Gallium Oxide Nanocrystals in Dielectric Matrices
Abstract
1. Introduction
2. Materials and Methods
3. Results and Discussion
3.1. Composition of as-Implanted SiO2/Si and Al2O3/Si Samples
3.2. Composition of Implanted SiO2/Si and Al2O3/Si Samples after Annealing
3.3. Structural Properties of Implanted SiO2/Si Samples after Annealing in the Oxygen Atmosphere
4. Conclusions
Author Contributions
Funding
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Zhang, J.; Shi, J.; Qi, D.C.; Chen, L.; Zhang, K.H.L. Recent Progress on the Electronic Structure, Defect, and Doping Properties of Ga2O3. APL Mater. 2020, 8, 020906. [Google Scholar] [CrossRef]
- Pearton, S.J.; Yang, J.; Cary, P.H.; Ren, F.; Kim, J.; Tadjer, M.J.; Mastro, M.A. A Review of Ga2O3 Materials, Processing, and Devices. Appl. Phys. Rev. 2018, 5, 011301. [Google Scholar] [CrossRef]
- Wang, C.; Zhang, J.; Xu, S.; Zhang, C.; Feng, Q.; Zhang, Y.; Ning, J.; Zhao, S.; Zhou, H.; Hao, Y. Progress in State-of-the-Art Technologies of Ga2O3 devices. J. Phys. D Appl. Phys. 2021, 54, 243001. [Google Scholar] [CrossRef]
- Bosi, M.; Mazzolini, P.; Seravalli, L.; Fornari, R. Ga2O3 polymorphs: Tailoring the Epitaxial Growth Conditions. J. Mater. Chem. C 2020, 8, 10975–10992. [Google Scholar] [CrossRef]
- Guo, D.; Guo, Q.; Chen, Z.; Wu, Z.; Li, P.; Tang, W. Review of Ga2O3-Based Optoelectronic Devices. Mater. Today Phys. 2019, 11, 100157. [Google Scholar] [CrossRef]
- Sharma, A.; Varshney, M.; Saraswat, H.; Chaudhary, S.; Parkash, J.; Shin, H.-J.; Chae, K.-H.; Won, S.-O. Nano-Structured Phases of Gallium Oxide (GaOOH, α-Ga2O3, β-Ga2O3, γ-Ga2O3, δ-Ga2O3, and ε-Ga2O3): Fabrication, Structural, and Electronic Structure Investigations. Int. Nano Lett. 2020, 10, 71–79. [Google Scholar] [CrossRef]
- Gottschalch, V.; Merker, S.; Blaurock, S.; Kneiß, M.; Teschner, U.; Grundmann, M.; Krautscheid, H. Heteroepitaxial Growth of α-, β-, γ- and κ-Ga2O3 Phases by Metalorganic Vapor Phase Epitaxy. J. Cryst. Growth 2019, 510, 76–84. [Google Scholar] [CrossRef]
- Safieddine, F.; Hassan, F.E.H.; Kazan, M. Comparative Study of the Fundamental Properties of Ga2O3 Polymorphs. J. Solid State Chem. 2022, 312, 123272. [Google Scholar] [CrossRef]
- García-Fernández, J.; Kjeldby, S.B.; Nguyen, P.D.; Karlsen, O.B.; Vines, L.; Prytz, Ø. Formation of γ-Ga2O3 by Ion Implantation: Polymorphic Phase Transformation of β-Ga2O3. Appl. Phys. Lett. 2022, 121, 191601. [Google Scholar] [CrossRef]
- Penner, S.; Zhuo, C.; Thalinger, R.; Grünbacher, M.; Hejny, C.; Vanicek, S.; Noisternig, M. Physico-Chemical Properties of Unusual Ga2O3 Polymorphs. Monatshefte Chem. 2016, 147, 289–300. [Google Scholar] [CrossRef]
- Bosi, M.; Fornari, R. Gallium Oxide: A Rising Star in the Semiconductor Realm. Gazi Univ. J. Sci. 2019, 32, 1092–1095. [Google Scholar] [CrossRef]
- Deshmane, C.A.; Jasinski, J.B.; Carreon, M.A. Thermally Stable Nanocrystalline Mesoporous Gallium Oxide Phases. Eur. J. Inorg. Chem. 2009, 22, 3275–3281. [Google Scholar] [CrossRef]
- Wang, T.; Farvid, S.S.; Abulikemu, M.; Radovanovic, P.V. Size-Tunable Phosphorescence in Colloidal Metastable γ-Ga2O3 Nanocrystals. J. Am. Chem. Soc. 2010, 132, 9250–9252. [Google Scholar] [CrossRef]
- Jamwal, N.S.; Kiani, A. Gallium Oxide Nanostructures: A Review of Synthesis, Properties and Applications. Nanomaterials 2022, 12, 2061. [Google Scholar] [CrossRef] [PubMed]
- Nikolskaya, A.; Okulich, E.; Korolev, D.; Stepanov, A.; Nikolichev, D.; Mikhaylov, A.; Tetelbaum, D.; Almaev, A.; Bolzan, C.A.; Buaczik, A.; et al. Ion Implantation in β-Ga2O3: Physics and Technology. J. Vac. Sci. Technol. A 2021, 39, 030802. [Google Scholar] [CrossRef]
- Mikhaylov, A.N.; Belov, A.I.; Kostyuk, A.B.; Zhavoronkov, I.Y.; Korolev, D.S.; Nezhdanov, A.V.; Ershov, A.V.; Guseinov, D.V.; Gracheva, T.A.; Malygin, N.D.; et al. Peculiarities of the Formation and Properties of Light-Emitting Structures Based on Ion-Synthesized Silicon Nanocrystals in SiO2 and Al2O3 Matrices. Phys. Solid State 2012, 54, 368–382. [Google Scholar] [CrossRef]
- Garrido, B.; López, M.; Ferré, S.; Romano-Rodríguez, A.; Pérez-Rodríguez, A.; Ruterana, P.; Morante, J.R. Visible Photoluminescence of SiO2 Implanted with Carbon and Silicon. Nucl. Instrum. Methods Phys. Res. Sect. B Beam Interact. Mater. At. 1996, 120, 101–105. [Google Scholar] [CrossRef]
- Parkhomenko, I.; Vlasukova, L.; Komarov, F.; Makhavikou, M.; Milchanin, O.; Wendler, E.; Zapf, M.; Ronning, C. Luminescence of ZnO Nanocrystals in Silica Synthesized by Dual (Zn, O) Implantation and Thermal Annealing. J. Phys. D Appl. Phys. 2021, 54, 265104. [Google Scholar] [CrossRef]
- Borsella, E.; Garcia, M.A.; Mattei, G.; Maurizio, C.; Mazzoldi, P.; Cattaruzza, E.; Gonella, F.; Battaglin, G.; Quaranta, A.; D’Acapito, F. Synthesis of GaN Quantum Dots by Ion Implantation in Dielectrics. J. Appl. Phys. 2001, 90, 4467–4473. [Google Scholar] [CrossRef]
- Rajamani, S.; Arora, K.; Konakov, A.; Belov, A.; Korolev, D.; Nikolskaya, A.; Mikhaylov, A.; Surodin, S.; Kryukov, R.; Nikolitchev, D.; et al. Deep UV Narrow-Band Photodetector Based on Ion Beam Synthesized Indium Oxide Quantum Dots in Al2O3 Matrix. Nanotechnology 2018, 29, 305603. [Google Scholar] [CrossRef]
- Rajamani, S.; Arora, K.; Belov, A.; Korolev, D.; Nikolskaya, A.; Usov, Y.; Pavlov, D.; Mikhaylov, A.; Tetelbaum, D.; Kumar, M. Enhanced Solar-Blind Photodetection Performance of Encapsulated Ga2O3 Nanocrystals in Al2O3 Matrix. IEEE Sens. J. 2018, 18, 4046. [Google Scholar] [CrossRef]
- Korolev, D.S.; Matyunina, K.S.; Nikolskaya, A.A.; Kriukov, R.N.; Nezhdanov, A.V.; Belov, A.I.; Mikhaylov, A.N.; Sushkov, A.A.; Pavlov, D.A.; Yunin, P.A.; et al. Ion-Beam Synthesis of Gallium Oxide Nanocrystals in a SiO2/Si Dielectric Matrix. Nanomaterials 2022, 12, 1840. [Google Scholar] [CrossRef] [PubMed]
- Boryakov, A.V.; Surodin, S.I.; Kryukov, R.N.; Nikolichev, D.E.; Zubkov, S.Y. Spectral Fit Refinement in XPS Analysis Technique and Its Practical Applications. J. Electron Spectros. Relat. Phenom. 2018, 229, 132–140. [Google Scholar] [CrossRef]
- Thompson, D.A. High density cascade effects. Radiat. Eff. 1981, 56, 105–150. [Google Scholar] [CrossRef]
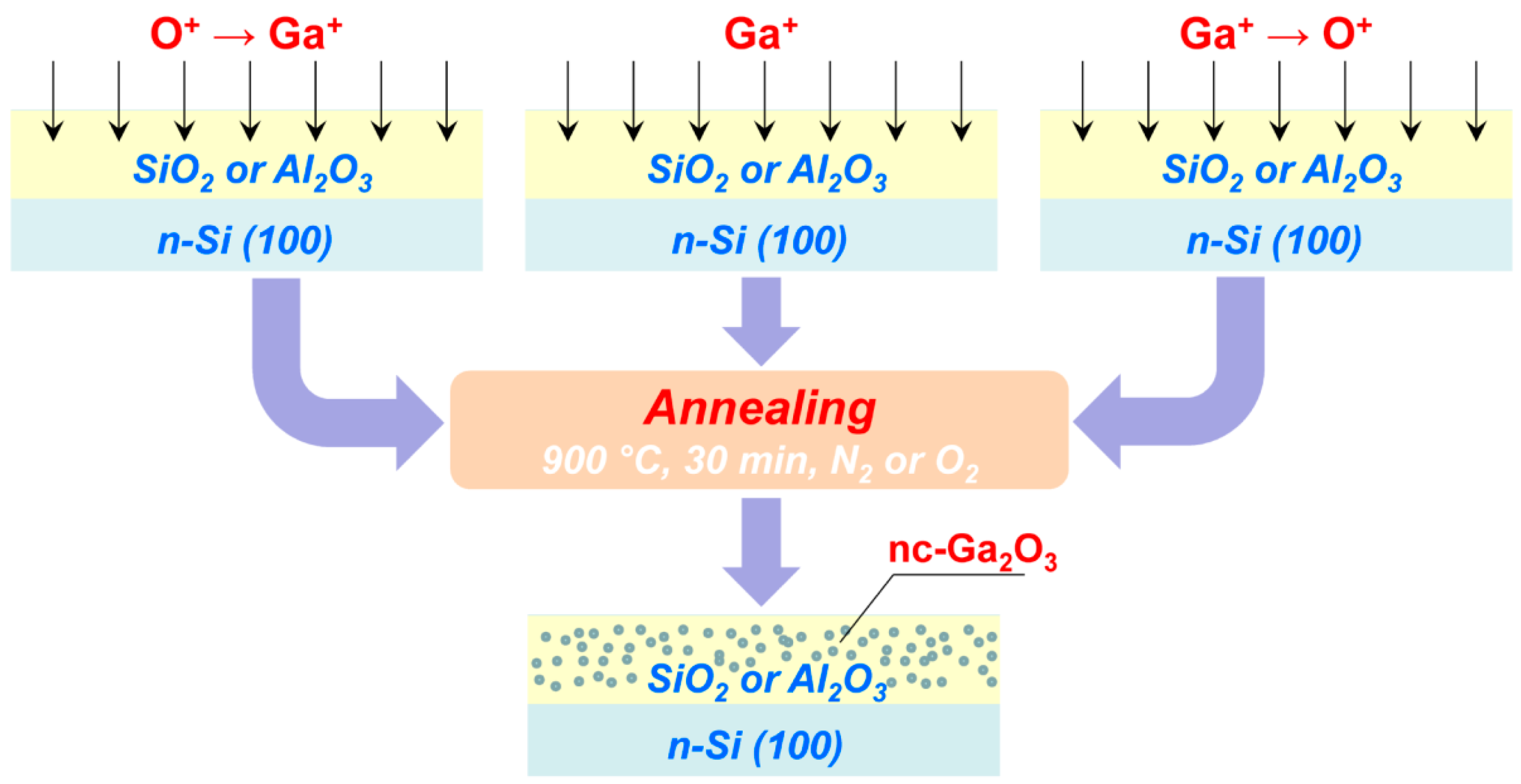




Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Korolev, D.S.; Kriukov, R.N.; Matyunina, K.S.; Nikolskaya, A.A.; Belov, A.I.; Mikhaylov, A.N.; Sushkov, A.A.; Pavlov, D.A.; Tetelbaum, D.I. Structure and Chemical Composition of Ion-Synthesized Gallium Oxide Nanocrystals in Dielectric Matrices. Nanomaterials 2023, 13, 1658. https://doi.org/10.3390/nano13101658
Korolev DS, Kriukov RN, Matyunina KS, Nikolskaya AA, Belov AI, Mikhaylov AN, Sushkov AA, Pavlov DA, Tetelbaum DI. Structure and Chemical Composition of Ion-Synthesized Gallium Oxide Nanocrystals in Dielectric Matrices. Nanomaterials. 2023; 13(10):1658. https://doi.org/10.3390/nano13101658
Chicago/Turabian StyleKorolev, Dmitry S., Ruslan N. Kriukov, Kristina S. Matyunina, Alena A. Nikolskaya, Alexey I. Belov, Alexey N. Mikhaylov, Artem A. Sushkov, Dmitry A. Pavlov, and David I. Tetelbaum. 2023. "Structure and Chemical Composition of Ion-Synthesized Gallium Oxide Nanocrystals in Dielectric Matrices" Nanomaterials 13, no. 10: 1658. https://doi.org/10.3390/nano13101658
APA StyleKorolev, D. S., Kriukov, R. N., Matyunina, K. S., Nikolskaya, A. A., Belov, A. I., Mikhaylov, A. N., Sushkov, A. A., Pavlov, D. A., & Tetelbaum, D. I. (2023). Structure and Chemical Composition of Ion-Synthesized Gallium Oxide Nanocrystals in Dielectric Matrices. Nanomaterials, 13(10), 1658. https://doi.org/10.3390/nano13101658







