Advantages of InGaN–GaN–InGaN Delta Barriers for InGaN-Based Laser Diodes
Abstract
:1. Introduction
2. Structures and Parameters
3. Results
4. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- Bergh, A.A. Blue laser diode (LD) and light emitting diode (LED) applications. Phys. Status Solidi A 2004, 201, 2740. [Google Scholar]
- Zhao, H.P.; Arif, R.A.; Tansu, N. Self-consistent gain analysis of type-II ‘W’ InGaN–GaNAs quantum well lasers. J. Appl. Phys. 2008, 104, L1332. [Google Scholar] [CrossRef] [Green Version]
- Buckley, E. Laser wavelength choices for pico-projector applications. J. Disp. Technol. 2011, 7, 402. [Google Scholar] [CrossRef]
- Goldberg, G.R.; Boldin, A.; Andersson, S.M.L.; Ivanov, P.; Ozaki, N.; Taylor, R.J.E.; Childs, D.T.D.; Groom, K.; Kennedy, K.L.; Hogg, R.A. Gallium nitride superluminescent light emitting diodes for optical coherence tomography applications. IEEE J. Sel. Top. Quantum Electron. 2017, 23, 2000511. [Google Scholar] [CrossRef]
- Masui, S.; Nakatsu, Y.; Kasahara, D.; Nagahama, S.-I. Recent improvement in nitride lasers. Proc. SPIE 2017, 10104, 101041H. [Google Scholar] [CrossRef]
- Meneghini, M.; Trivellin, N.; Orita, K.; Yuri, M.; Ueda, D.; Zanoni, E.; Meneghesso, G. Analysis of the role of current, temperature, and optical power in the degradation of InGaN-Based Laser Diodes. IEEE Trans. Electron Devices 2009, 56, 222. [Google Scholar] [CrossRef]
- Paliwal, A.; Singh, K.; Mathew, M. Effects of electron blocking layer configuration on the dynamics of laser diodes emitting at 450 nm. Laser Phys. 2020, 30, 016210. [Google Scholar] [CrossRef]
- Yang, W.; Li, D.; Liu, Y.N.; Chen, Z.; Wang, L.; Liu, L.; Li, L.; Wan, C.H.; Chen, W.H.; Hu, X.D.; et al. Improvement of hole injection and electron overflow by a tapered AlGaN electron blocking layer in InGaN-based blue laser diodes. Appl. Phys. Lett. 2012, 100, 031105. [Google Scholar] [CrossRef]
- Lan, T.; Zhou, G.Z.; Li, Y.; Wang, C.C.; Wang, Z.Y. Mitigation of efficiency droop in an asymmetric GaN-based high-power Laser Diode with sandwiched GaN/InAlN/GaN lower quantum barrier. IEEE Photonics J. 2018, 10, 1504708. [Google Scholar] [CrossRef]
- Chen, P.; Feng, M.X.; Jiang, D.S.; Zhao, D.G.; Liu, Z.S.; Li, L.; Wu, L.L.; Le, L.C.; Zhu, J.J.; Wang, H.; et al. Improvement of characteristics of InGaN-based laser diodes with undoped InGaN upper waveguide layer. J. Appl. Phys. 2012, 112, 113105. [Google Scholar] [CrossRef]
- Kim-Chauveau, H.; Frayssinet, E.; Damilano, B.; De Mierry, P.; Bodiou, L.; Nguyen, L.; Vennegues, P.; Chauveau, J.M.; Cordier, Y.; Duboz, J.Y.; et al. Growth optimization and characterization of lattice-matched Al0.82In0.18N optical confinement layer for edge emitting nitride laser diodes. J. Cryst. Growth. 2012, 338, 20. [Google Scholar] [CrossRef]
- Stolz, A.; Cho, E.; Dogheche, E.; Androussi, Y.; Troadec, D.; Pavlidis, D.; Decoster, D. Optical waveguide loss minimized into gallium nitride based structures grown by metal organic vapor phase epitaxy. Appl. Phys. Lett. 2011, 98, 161903. [Google Scholar] [CrossRef]
- Yang, J.; Zhao, D.G.; Liu, Z.S.; Jiang, D.S.; Zhu, J.J.; Chen, P.; Liang, F.; Liu, S.T.; Liu, W.; Xing, Y.; et al. Suppression the leakage of optical field and carriers in GaN-based laser diodes by using InGaN barrier layers. IEEE Photonics J. 2018, 10, 1503107. [Google Scholar] [CrossRef]
- Kuo, Y.-K.; Chang, J.-Y.; Tsai, M.-C.; Yen, S.-H. Advantages of blue InGaN multiple-quantum well light-emitting diodes with InGaN barriers. Appl. Phys. Lett. 2009, 95, 011116. [Google Scholar] [CrossRef]
- LASTIP by Crosslight Software Inc Burnaby Canada. Available online: http://crosslight.com (accessed on 1 June 2021).
- Liang, F.; Zhao, D.G.; Jiang, D.S.; Liu, Z.S.; Zhu, J.J.; Chen, P.; Yang, J.; Liu, W.; Liu, S.T.; Xing, Y.; et al. Performance enhancement of the GaN-based laser diode by using an unintentionally doped GaN upper waveguide. Jpn. J. Appl. Phys. 2018, 57, 070307. [Google Scholar] [CrossRef]
- Yang, J.; Zhao, D.G.; Jiang, D.S.; Li, X.; Liang, F.; Chen, P.; Zhu, J.J.; Liu, Z.S.; Liu, S.T.; Zhang, L.Q. Performance of InGaN based green laser diodes improved by using an asymmetric InGaN/InGaN multi-quantum well active region. Opt. Express 2017, 25, 9595. [Google Scholar] [CrossRef] [PubMed]
- Zhou, M.; Liang, F.; Zhao, D.G. Effects of quantum well thickness and aluminum content of electron blocking layer on InGaN-based laser diodes. J. Mater. Sci. Mater. Electron 2020, 31, 5814. [Google Scholar] [CrossRef]
- Fiorentini, V.; Bernardini, F.; Ambacher, O. Evidence for nonlinear macroscopic polarization in III-V nitride alloy heterostructures. Appl. Phys. Lett. 2002, 80, 1204. [Google Scholar] [CrossRef]
- Bernardini, F.; Fiorentini, V. Nonlinear macroscopic polarization in III-V nitride alloys. Phys. Rev. B 2001, 64, 085207. [Google Scholar] [CrossRef] [Green Version]
- Chen, P.; Zhao, D.G.; Jiang, D.S.; Zhu, J.J.; Liu, Z.S.; Yang, J.; Li, X.; Le, L.C.; He, X.G.; Liu, W.; et al. The thickness design of unintentionally doped GaN interlayer matched with background doping level for InGaN-based laser diodes. AIP Adv. 2016, 6, 035124. [Google Scholar] [CrossRef] [Green Version]
- Vurgaftman, I.; Meyer, J.R. Band parameters for nitrogen-containing semiconductors. J. Appl. Phys. 2003, 94, 3675. [Google Scholar] [CrossRef]
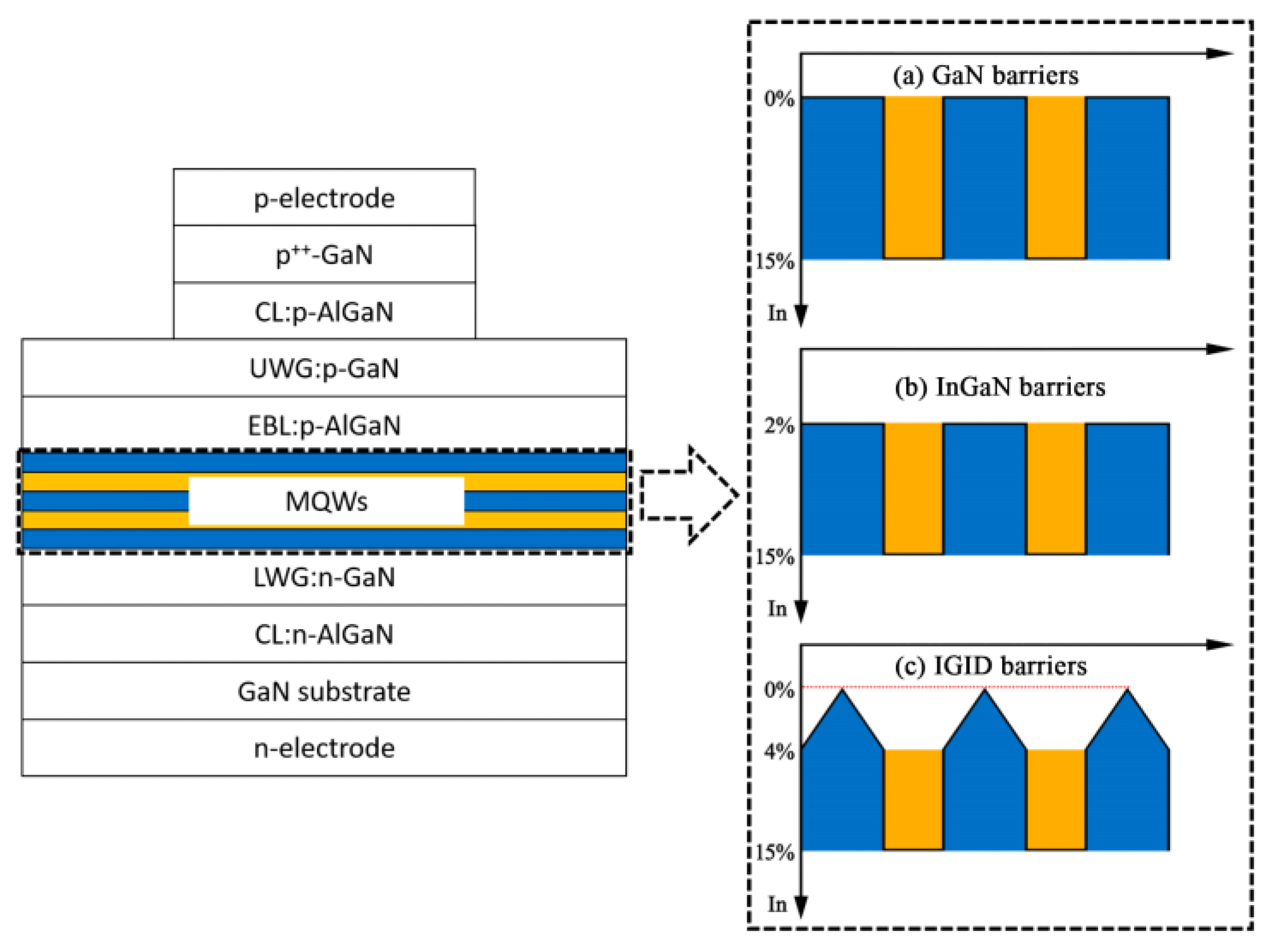
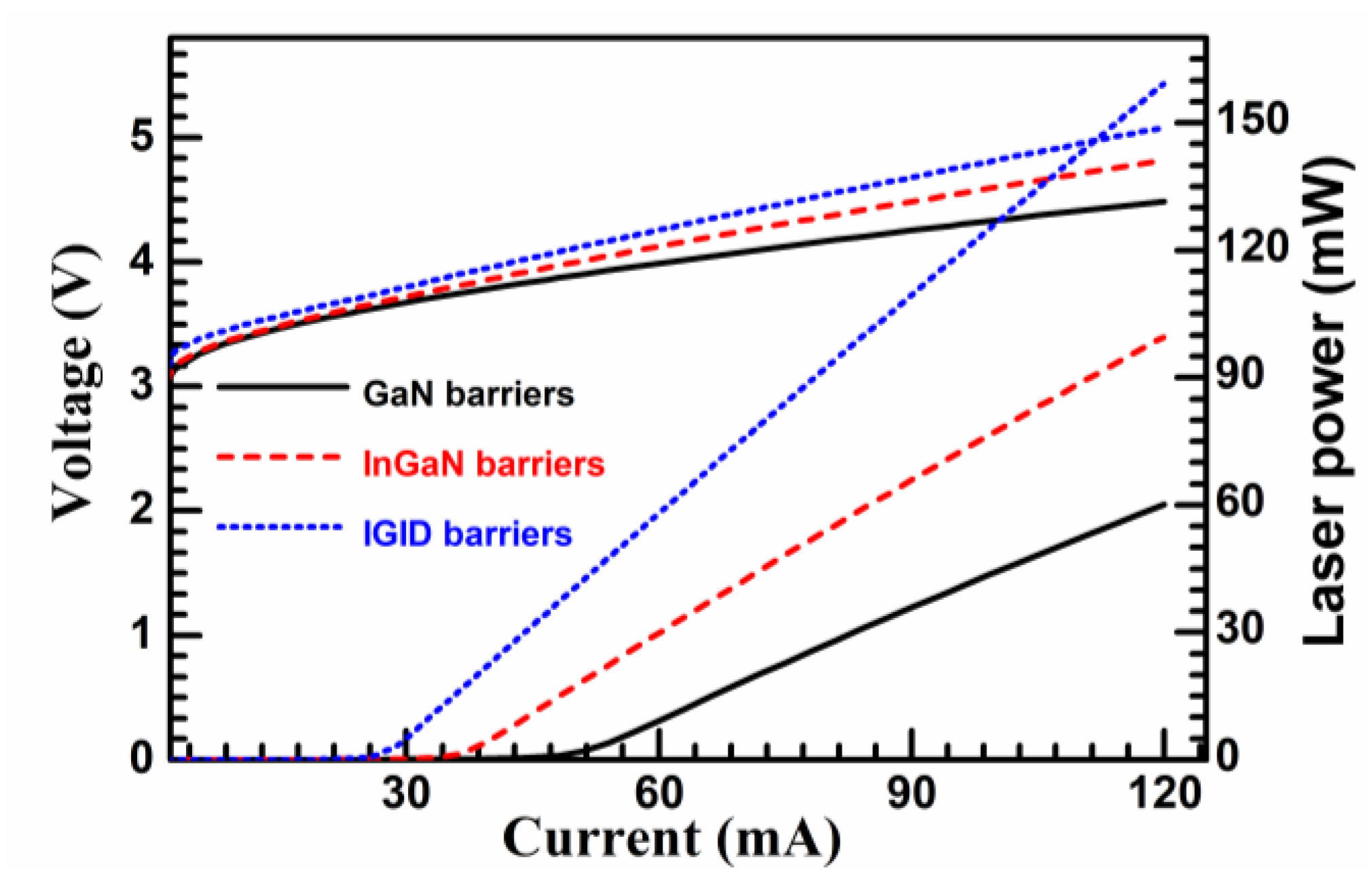
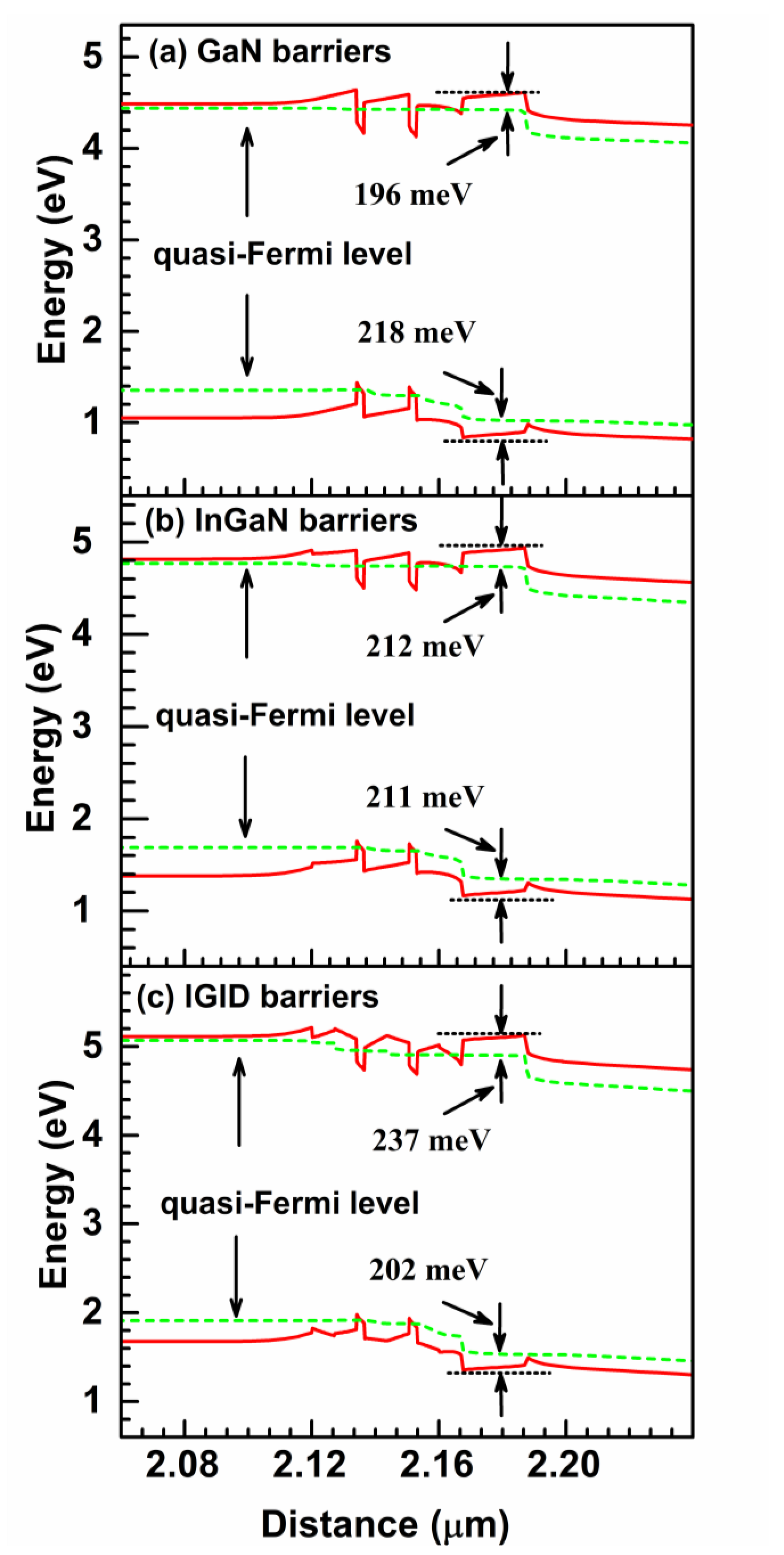
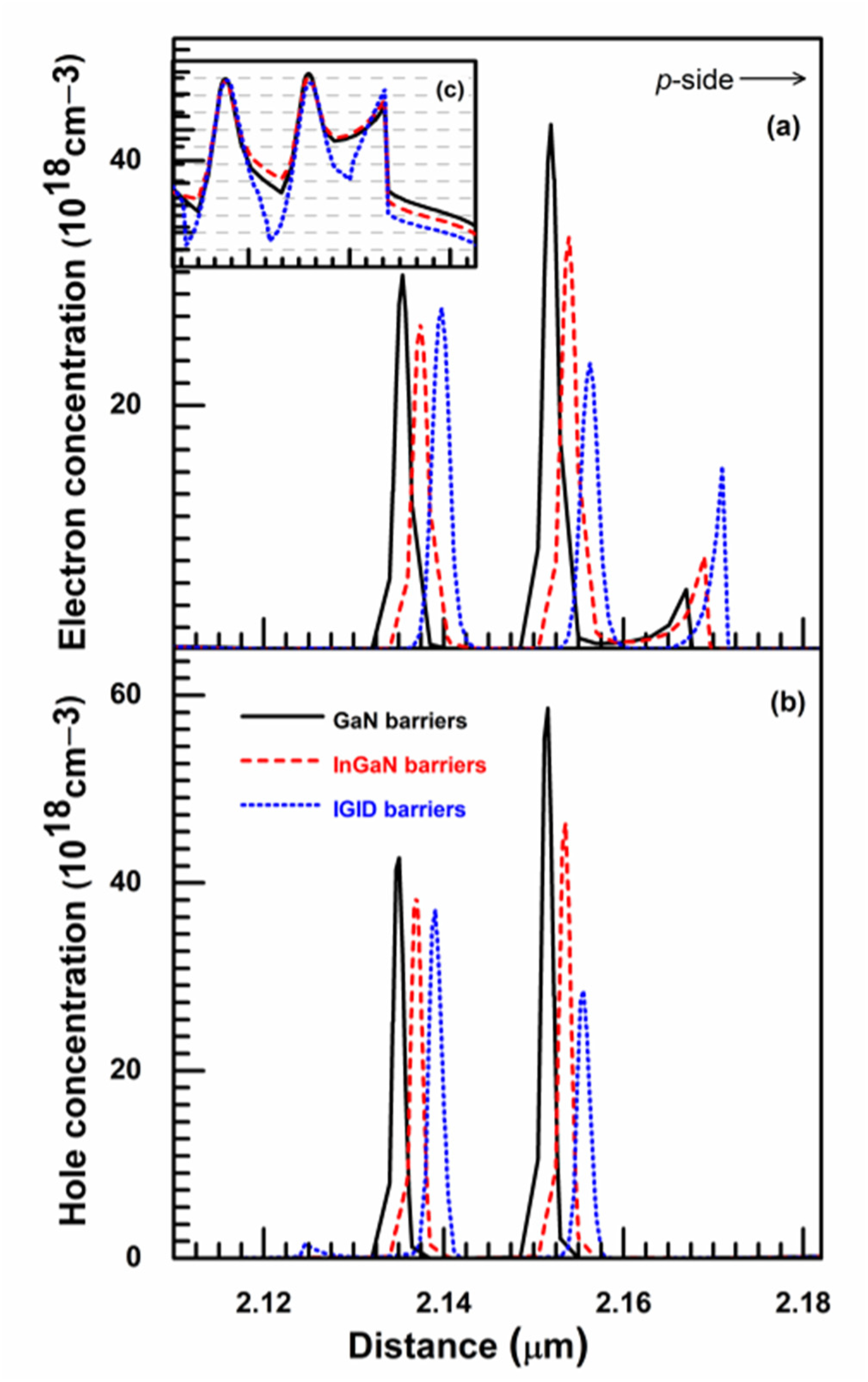
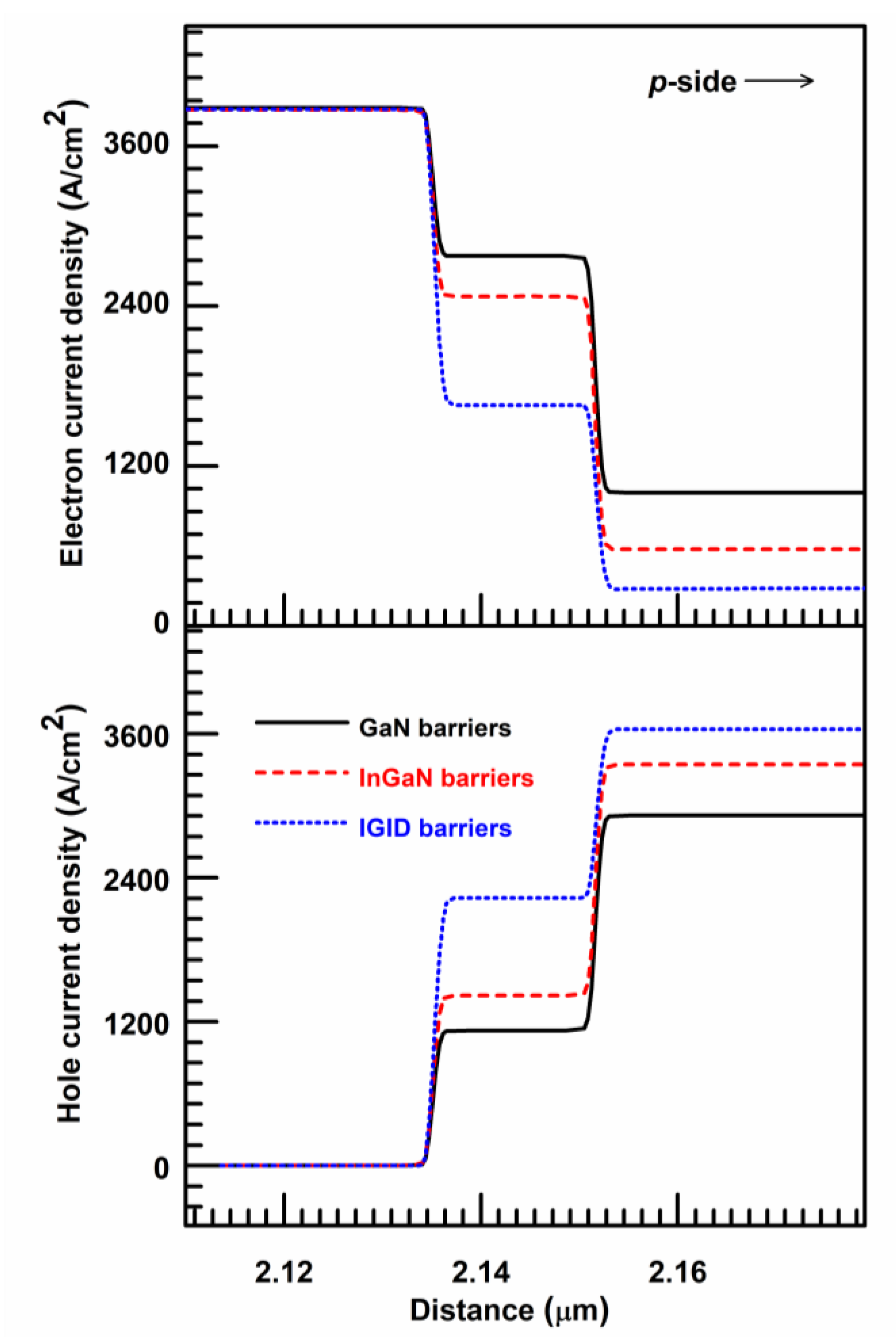
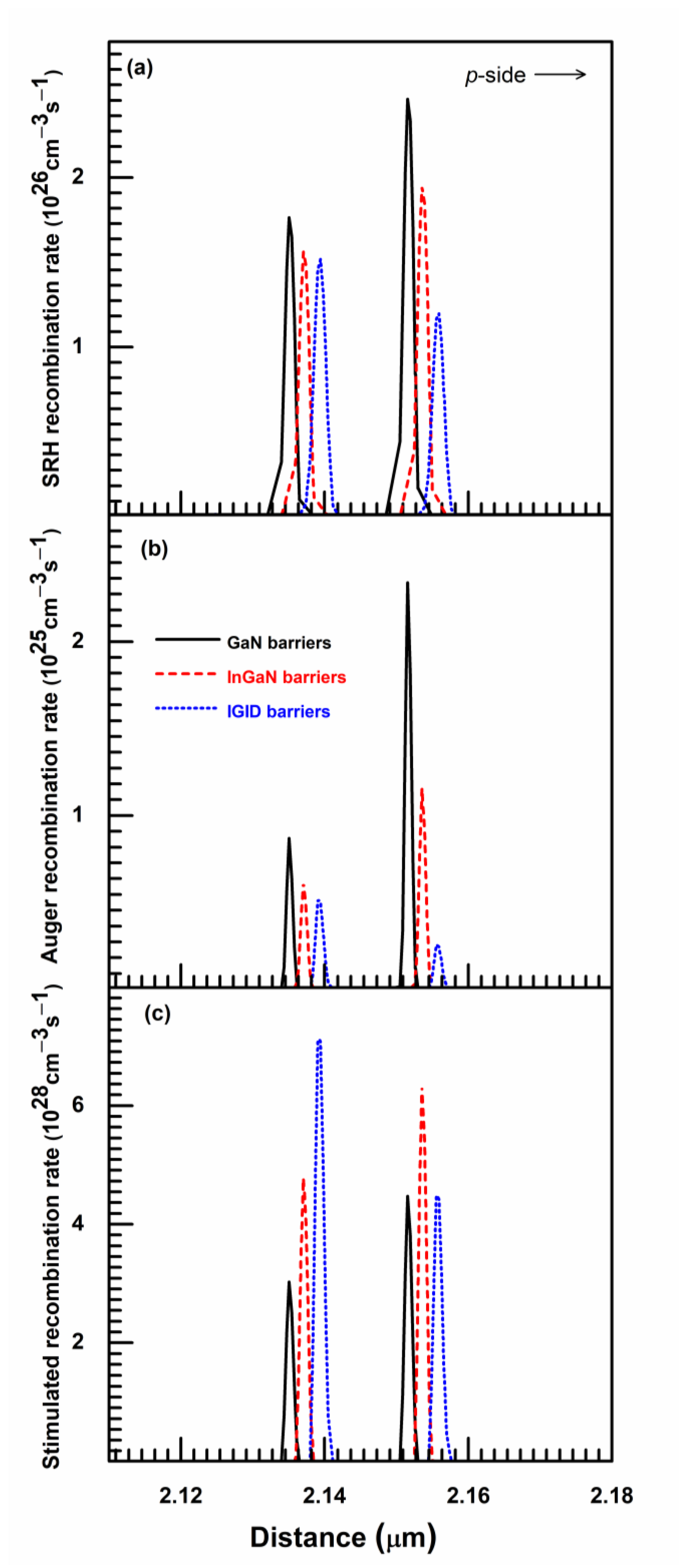
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Cheng, L.; Li, Z.; Zhang, J.; Lin, X.; Yang, D.; Chen, H.; Wu, S.; Yao, S. Advantages of InGaN–GaN–InGaN Delta Barriers for InGaN-Based Laser Diodes. Nanomaterials 2021, 11, 2070. https://doi.org/10.3390/nano11082070
Cheng L, Li Z, Zhang J, Lin X, Yang D, Chen H, Wu S, Yao S. Advantages of InGaN–GaN–InGaN Delta Barriers for InGaN-Based Laser Diodes. Nanomaterials. 2021; 11(8):2070. https://doi.org/10.3390/nano11082070
Chicago/Turabian StyleCheng, Liwen, Zhenwei Li, Jiayi Zhang, Xingyu Lin, Da Yang, Haitao Chen, Shudong Wu, and Shun Yao. 2021. "Advantages of InGaN–GaN–InGaN Delta Barriers for InGaN-Based Laser Diodes" Nanomaterials 11, no. 8: 2070. https://doi.org/10.3390/nano11082070
APA StyleCheng, L., Li, Z., Zhang, J., Lin, X., Yang, D., Chen, H., Wu, S., & Yao, S. (2021). Advantages of InGaN–GaN–InGaN Delta Barriers for InGaN-Based Laser Diodes. Nanomaterials, 11(8), 2070. https://doi.org/10.3390/nano11082070





