Investigation on Key Parameters in the Fabrication of Stamps for Transfer Printing of Micro Devices
Abstract
1. Introduction
2. Materials and Methods
2.1. Stamps Fabrication
2.2. Characterization
3. Results and Discussion
3.1. Size Measurement
3.2. Development Effect under Different Conditions
3.3. Elastic Modulus Measurement
4. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- Katsumi, R.; Ota, Y.; Osada, A.; Yamaguchi, T.; Tajiri, T.; Kakuda, M.; Iwamoto, S.; Akiyama, H.; Arakawa, Y. Quantum-dot single-photon source on a CMOS silicon photonic chip integrated using transfer printing. APL Phontonics 2019, 4, 1–7. [Google Scholar] [CrossRef]
- Shen, L.; Li, H.X.; Meng, X.W.; Li, F. Transfer printing of fully formed microscale InGaP/GaAs/InGaNAsSb cell on Ge cell in mechanically-stacked quadruple-junction architecture. Sol. Energy 2020, 195, 6–13. [Google Scholar] [CrossRef]
- Corbett, B.; Loi, R.; Zhou, W.; Liu, D.; Ma, Z. Transfer print techniques for heterogeneous integration of photonic components. Prog. Quant. Electron. 2017, 52, 1–17. [Google Scholar] [CrossRef]
- Sheng, X.; Bower, C.A.; Bonafede, S.; Wilson, J.W.; Fisher, B.; Meitl, M.; Yuen, H.; Wang, S.; Shen, L.; Banks, A.R.; et al. Printing-based assembly of quadruple-junction four-terminal microscale solar cells and their use in high-efficiency modules. Nat. Mater. 2014, 13, 593–598. [Google Scholar]
- Corbett, B.; Rodgers, K.; Stam, F.A.; O’Connell, D.; Kelly, P.V.; Crean, G.M. Low-stress hybridisation of emitters, detectors and driver circuitry on a silicon motherboard for optoelectronic interconnect architecture. Mat. Sci. Semicon. Proc. 2000, 3, 449–453. [Google Scholar] [CrossRef]
- Justice, J.; Bower, C.; Meitl, M.; Mooney, M.B.; Gubbins, M.A.; Corbett, B. Wafer-scale integration of group III-V lasers on silicon using transfer printing of epitaxial layers. Nat. Photonics 2012, 6, 612–616. [Google Scholar] [CrossRef]
- Bower, C.A.; Menard, E.; Bonafede, S.; Hamer, J.W.; Cok, R.S. Transfer-printed microscale integrated circuits for high performance display backplanes. IEEE Trans. Compon. Packag. Manuf. 2011, 1, 1916–1922. [Google Scholar] [CrossRef]
- Kim, H.S.; Brueckner, E.; Song, J.Z.; Li, Y.H.; Kim, S.; Lu, C.F.; Sulkin, J.; Choquette, K.; Huang, Y.G.; Nuzzo, R.G.; et al. Unusual strategies for using indium gallium nitride grown on silicon (111) for solid-state lighting. Proc. Natl. Acad. Sci. USA 2011, 108, 10072–10077. [Google Scholar] [CrossRef]
- Seo, J.H.; Oh, T.Y.; Park, J.; Zhou, W.; Ju, B.K.; Ma, Z. A multifunction heterojunction formed between pentacene and a single-crystal silicon nanomembrane. Adv. Funct. Mater. 2013, 23, 3398–3403. [Google Scholar] [CrossRef]
- Kim, T.H.; Cho, K.S.; Lee, E.K.; Lee, S.J.; Chae, J.; Kim, J.W.; Kim, D.H.; Kwon, J.Y.; Amaratunga, G.; Lee, S.Y.; et al. Full-colour quantum dot displays fabricated by transfer printing. Nat. Photonics 2011, 5, 176–182. [Google Scholar] [CrossRef]
- Meitl, M.A.; Zhu, Z.T.; Kumar, V.; Lee, K.J.; Feng, X.; Huang, Y.Y.; Adesida, I.; Nuzzo, R.G.; Rogers, J.A. Transfer printing by kinetic control of adhesion to an elastomeric stamp. Nat. Mater. 2006, 5, 33–38. [Google Scholar] [CrossRef]
- Gomez, D.; Ghosal, K.; Meitl, M.A.; Bonafede, S.; Prevatte, C.; Moore, T.; Raymond, B.; Kneeburg, D.; Fecioru, A.; Trindade, A.J.; et al. Process capability and elastomer stamp lifetime in micro transfer printing. In Proceedings of the IEEE 66th Electronic Components and Technology Conference (ECTC), Las Vegas, NV, USA, 31 May–3 June 2016; IEEE Computer Soc.: Los Alamitos, CA, USA, 2016. [Google Scholar]
- Bower, C.; Meitl, M.; Bonafede, S.; Gomez, D.; Fecioru, A.; Kneeburg, D. Heterogeneous integration of microscale compound semiconductor devices by micro-transfer-printing. In Proceedings of the IEEE 65th Electronic Components and Technology Conference (ECTC), San Diego, CA, USA, 26–29 May 2015; IEEE: New York, NY, USA, 2015. [Google Scholar]
- Yoon, J.; Lee, S.; Kang, D.; Meitl, M.; Bower, C.; Rogers, J. Heterogeneously integrated optoelectronic devices enabled by micro-transfer printing. Adv. Opt. Mater. 2015, 3, 1313–1335. [Google Scholar] [CrossRef]
- Li, R.; Li, Y.; Lu, C.; Song, J.; Saeidpouraza, R.; Fang, B.; Zhong, Y.; Ferreira, P.M.; Rogers, J.A.; Huang, Y. Thermo-mechanical modeling of laser-driven non-contact transfer printing: Two-dimensional analysis. Soft Matter 2012, 8, 12134. [Google Scholar] [CrossRef]
- Nam, J.; Lee, Y.; Choi, W.; Kim, C.S.; Kim, H.; Kim, J.; Kim, D.H.; Jo, S. Transfer printed flexible and stretchable thin film solar cells using a water-soluble sacrificial layer. Adv. Energy Mater. 2016, 6, 1–8. [Google Scholar] [CrossRef]
- Bao, C.; Wang, Z.; Liu, Y.; Zhang, Y.; Nie, H.Y.; Lau, W.M.; Mei, J. Mechanics of surface cross-linked polydimethylsiloxane microstructure used for microcontact transfer printing. J. Appl. Polymer Sci. 2017, 134, 1–7. [Google Scholar] [CrossRef]
- Kim, S.; Wu, J.; Carlson, A.; Jin, S.H.; Kovalsky, A.; Glass, P.; Liu, Z.; Ahmed, N.; Elgan, S.L.; Chen, W.; et al. Microstructured elastomeric surfaces with reversible adhesion and examples of their use in deterministic assembly by transfer printing. Proc. Natl. Acad. Sci. USA 2010, 107, 17095–17100. [Google Scholar] [CrossRef]
- Chen, H.; Feng, X.; Huang, Y.; Rogers, J.A. Experiments and viscoelastic analysis of peel test with patterned strips for applications to transfer printing. J. Mech. Phys. Solids 2013, 61, 1737–1752. [Google Scholar] [CrossRef]
- Carlson, A.; Wang, S.; Elvikis, P.; Ferreira, P.M.; Huang, Y.; Rogers, J. Active, programmable elastomeric surfaces with tunable adhesion for deterministic assembly by transfer printing. Adv. Funct. Mater. 2012, 22, 4476–4484. [Google Scholar] [CrossRef]
- Saeidpourazar, R.; Li, R.; Li, Y.; Sangid, M.D.; Lu, C.; Huang, Y.; Rogers, J.A.; Ferreira, P.M. Laser-driven micro transfer placement of prefabricated microstructures. J. Microelectromech. Syst. 2012, 21, 1049–1058. [Google Scholar] [CrossRef]
- Bian, J.; Zhou, L.; Wan, X.; Zhu, C.; Yang, B.; Huang, Y.A. Laser Transfer, Printing, and Assembly Techniques for Flexible Electronics. Adv. Electron. Mater. 2019, 5, 1–33. [Google Scholar] [CrossRef]
- Eisenhaure, J.D.; Xie, T.; Varghese, S.; Kim, S. Microstructured shape memory polymer surfaces with reversible dry adhesion. ACS Appl. Mater. Interfaces 2013, 5, 7714–7717. [Google Scholar] [CrossRef]
- Choi, M.; Jang, B.; Lee, W.; Lee, S.; Kim, T.W.; Lee, H.J.; Kim, J.H.; Ahn, J.H. Stretchable displays: Stretchable active matrix inorganic light-emitting diode display enabled by overlay-aligned roll-transfer printing. Adv. Funct. Mater. 2017, 27, 1–10. [Google Scholar] [CrossRef]
- Sun, L.; Jiang, X.; Zhou, Y. Efficient nonfullerene organic solar cells with active layers fabricated by water transfer printing. J. Energy Chem. 2019, 37, 220–224. [Google Scholar] [CrossRef]
- Linghu, C.; Zhu, H.; Zhu, J.; Li, C.; Song, J. Mechanics of magnet-controlled transfer printing. Extreme Mech. Lett. 2019, 27, 76–82. [Google Scholar] [CrossRef]
- Chen, C.J.; Chen, H.C.; Liao, J.H.; Yu, C.J.; Wu, M.C. Fabrication and Characterization of Active-Matrix 960 × 540 Blue GaN-Based Micro-LED Display. IEEE J. Quantum Elect. 2019, 55, 1–6. [Google Scholar] [CrossRef]
- Zhang, X.; Li, P.; Zou, X.B.; Jiang, J.M.; Yuen, S.H.; Tang, C.W.; Lau, K.M. Active Matrix Monolithic LED Micro-Display Using GaN-on-Si Epilayers. IEEE Photonic Technol. Lett. 2019, 31, 865–868. [Google Scholar] [CrossRef]
- Um, J.G.; Jeong, D.Y.; Jung, Y.H.; Moon, J.K.; Jung, Y.H.; Kim, S.; Kim, S.H.; Lee, J.S.; Jang, J. Active-Matrix GaN μ-LED Display Using Oxide Thin-Film Transistor Backplane and Flip Chip LED Bonding. Adv. Electron. Mater. 2019, 5, 1–8. [Google Scholar] [CrossRef]
- Soh, M.Y.; Ng, W.X.; Teo, T.H.; Selvaraj, S.L.; Peng, L.L.; Disney, D.; Zou, Q.; Yeo, K.S. Design and Characterization of Micro-LED Matrix Display With Heterogeneous Integration of GaN and BCD Technologies. IEEE Trans. Electron Devices 2019, 66, 4221–4227. [Google Scholar] [CrossRef]
- Geum, D.M.; Kim, S.K.; Kang, C.M.; Moon, S.H.; Kyhm, J.H.; Han, J.H.; Lee, D.S.; Kim, S.H. Strategy toward the fabrication of ultrahigh-resolution micro-LED displays by bonding-interface-engineered vertical stacking and surface passivation. Nanoscale 2019, 11, 23139–23148. [Google Scholar] [CrossRef]
- Guo, W.L.; Tai, J.P.; Liu, J.P.; Sun, J. Process Optimization of Passive Matrix GaN-Based Micro-LED Arrays for Display Applications. J. Electron. Mater. 2019, 48, 5195–5201. [Google Scholar] [CrossRef]
- Zhang, J.W.; Lin, C.G.; Wang, L.; Zheng, J.Y.; Peng, Y.L.; Duan, D.X. The influence of elastic modulus on the adhesion of fouling organism to poly(dimethylsiloxane) (PDMS). Adv. Mater. Res. 2010, 152–153, 1466–1470. [Google Scholar] [CrossRef]
- Lee, S.; Kang, B.; Keum, H.; Ahmed, N.; Rogers, J.A.; Ferreira, P.M.; Kim, S.; Min, B. Heterogeneously assembled metamaterials and metadevices via 3D modular transfer printing. Sci. Rep. 2016, 6, 27621. [Google Scholar] [CrossRef] [PubMed]
- Ahmed, N.; Rogers, J.A.; Ferreira, P.M. Microfabricated instrumented composite stamps for transfer printing. J. Micro Nano-Manuf. 2015, 3, 021007. [Google Scholar] [CrossRef]
- Ahmed, N.; Carlson, A.; Rogers, J.A.; Ferreira, P.M. Automated micro-transfer printing with cantilevered stamps. J. Mamuf. Processes 2012, 14, 90–97. [Google Scholar] [CrossRef]
- Yang, S.Y.; Carlson, A.; Cheng, H.; Yu, Q.; Ahmed, N.; Wu, J.; Kim, S.; Sitti, M.; Ferreira, P.M.; Huang, Y.; et al. Elastomer surfaces with directionally dependent adhesion strength and their use in transfer printing with continuous roll-to-roll applications. Adv. Mater. 2012, 24, 2117–2122. [Google Scholar] [CrossRef]
- Lee, H.; Koh, D.; Xu, L.; Row, S.; Andreadis, S.T.; Oh, K.W. A simple method for fabrication of microstructures using a PDMS stamp. Micromachines 2016, 7, 173. [Google Scholar] [CrossRef]
- Filipponi, L.; Livingston, P.; Kaspar, O.; Tokarova, V.; Nicolau, D.V. Protein patterning by microcontact printing using pyramidal PDMS stamps. Biomed. Microdevices 2016, 18, 9.1–9.7. [Google Scholar] [CrossRef]
- Wu, J.D.; Dan, Q.; Liu, S. Effect of viscoelasticity of PDMS on transfer printing. In Proceedings of the 16th International Conference on Electronic Packaging Technology, Changsha, China, 11–14 August 2015; IEEE: New York, NY, USA, 2015. [Google Scholar]
- Lu, H.; Guo, W.J.; Su, C.W.; Li, X.L.; Lu, Y.J.; Chen, Z.; Zhu, L.H. Optimization on adhesive stamp mass-transfer of micro-LEDs with support vector machine model. IEEE J. Electron Devices Soc. 2020. [Google Scholar] [CrossRef]
- Choi, M.K.; Yang, J.; Kang, K.; Kim, D.C.; Choi, C.; Park, C.; Kim, S.J.; Chae, S.I.; Kim, T.H.; Kim, J.H.; et al. Wearable red-green-blue quantum dot light-emitting diode array using high-resolution intaglio transfer printing. Nat. Commun. 2015, 6, 7149. [Google Scholar] [CrossRef]

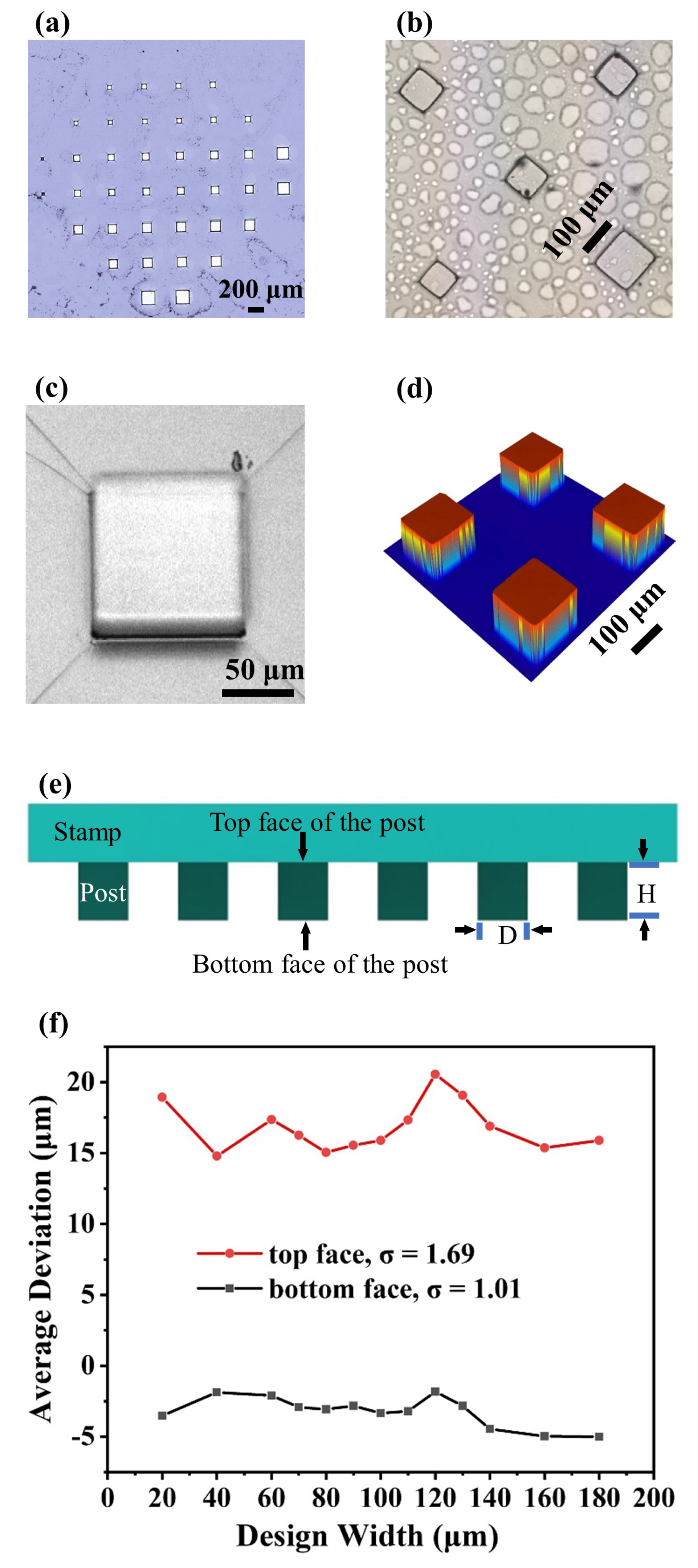

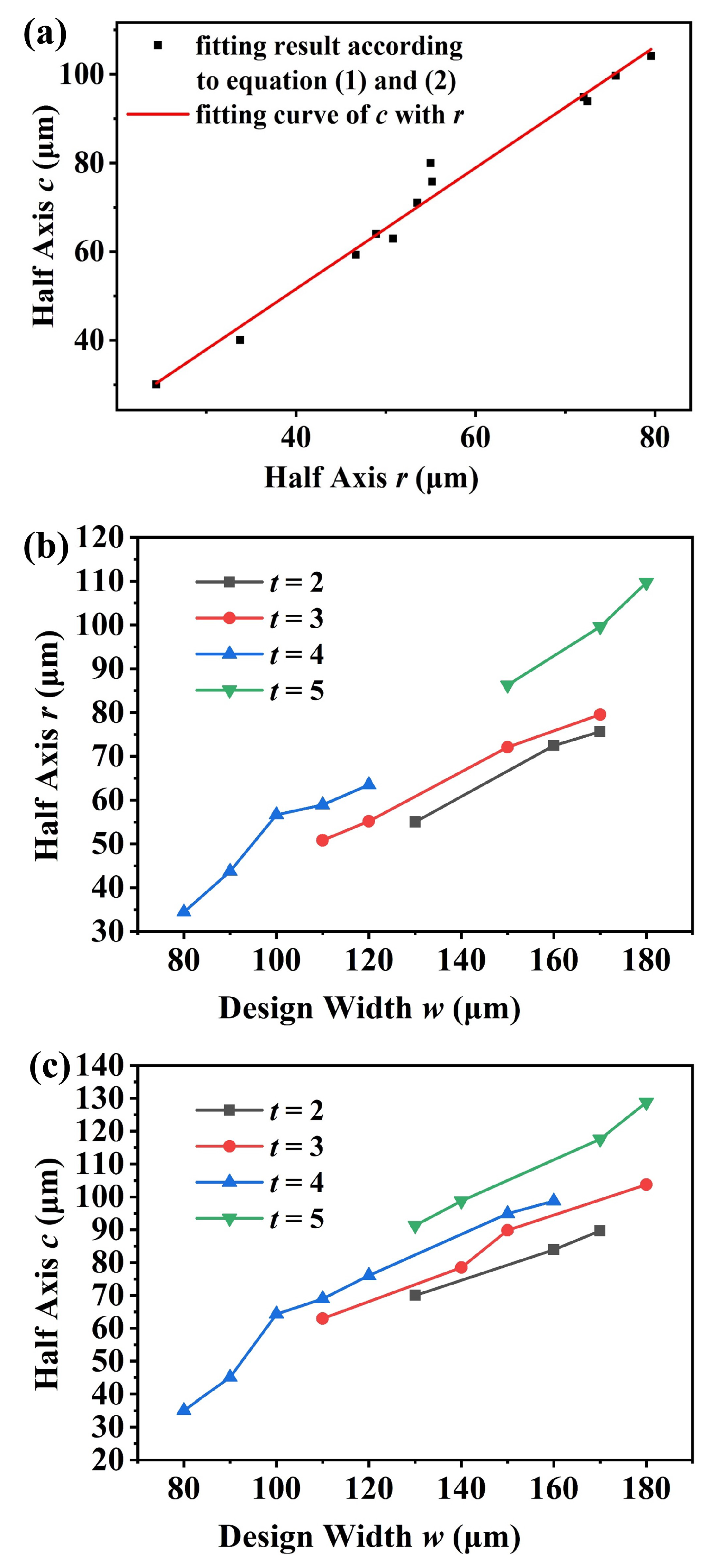

© 2020 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Su, C.; Lin, Y.; Shih, T.-M.; Lu, H.; Gao, Y.; Huang, J.-E.; Lu, Y.-J.; Wu, T.; Chen, Z.; Guo, W. Investigation on Key Parameters in the Fabrication of Stamps for Transfer Printing of Micro Devices. Appl. Sci. 2020, 10, 4604. https://doi.org/10.3390/app10134604
Su C, Lin Y, Shih T-M, Lu H, Gao Y, Huang J-E, Lu Y-J, Wu T, Chen Z, Guo W. Investigation on Key Parameters in the Fabrication of Stamps for Transfer Printing of Micro Devices. Applied Sciences. 2020; 10(13):4604. https://doi.org/10.3390/app10134604
Chicago/Turabian StyleSu, Changwen, Yue Lin, Tien-Mo Shih, Hao Lu, Yang Gao, Jia-En Huang, Yi-Jun Lu, Tingzhu Wu, Zhong Chen, and Weijie Guo. 2020. "Investigation on Key Parameters in the Fabrication of Stamps for Transfer Printing of Micro Devices" Applied Sciences 10, no. 13: 4604. https://doi.org/10.3390/app10134604
APA StyleSu, C., Lin, Y., Shih, T.-M., Lu, H., Gao, Y., Huang, J.-E., Lu, Y.-J., Wu, T., Chen, Z., & Guo, W. (2020). Investigation on Key Parameters in the Fabrication of Stamps for Transfer Printing of Micro Devices. Applied Sciences, 10(13), 4604. https://doi.org/10.3390/app10134604





