Nano-Ridge Engineering of GaSb for the Integration of InAs/GaSb Heterostructures on 300 mm (001) Si
Abstract
1. Introduction
2. Materials and Methods
3. Results and Discussion
3.1. Defect Density in GaAs Nano-Ridges
3.2. Defect Density in GaSb Nano-Ridges
3.3. Integration of an InAs/GaSb Heterostructure
4. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- Wang, R.; Vasiliev, A.; Muneeb, M.; Malik, A.; Sprengel, S.; Boehm, G.; Amann, M.-C.; Šimonytė, I.; Vizbaras, A.; Vizbaras, K.; et al. III–V-on-silicon photonic integrated circuits for spectroscopic sensing in the 2–4 µm wavelength range. Sensors 2017, 17, 1788. [Google Scholar] [CrossRef] [PubMed]
- Singh, V.; Lin, P.T.; Patel, N.; Lin, H.; Li, L.; Zou, Y.; Deng, F.; Ni, C.; Hu, J.; Giammarco, J.; et al. Mid-infrared materials and devices on a Si platform for optical sensing. Sci. Technol. Adv. Mater. 2014, 15, 014603–014618. [Google Scholar] [CrossRef] [PubMed]
- Tournié, E.; Baranov, A.N. Mid-infrared semiconductor lasers: A review. In Advances in Semiconductor Lasers, 1st ed.; Coleman, J.J., Bryce, A.C., Jagadish, A., Eds.; Elsevier: Amsterdam, The Netherlands, 2012; Volume 86, pp. 183–226. [Google Scholar] [CrossRef]
- Tournié, E.; Cerutti, L.; Rodriguez, J.-B.; Liu, H.; Wu, J.; Chen, S. Metamorphic III–V semiconductor lasers grown on silicon. MRS Bull. 2016, 41, 218–223. [Google Scholar] [CrossRef]
- Rogalski, A.; Martyniuk, P.; Kopytko, M. InAs/GaSb type-II superlattice infrared detectors: Future prospect. Appl. Phys. Rev. 2017, 4, 031304. [Google Scholar] [CrossRef]
- Rogalski, A.; Kopytko, M.; Martyniuk, P. InAs/GaSb type-II superlattice infrared detectors: Three decades of development. In Proceedings of the SPIE Defence + Security, Anaheim, CA, USA, 10–13 April 2017; p. 1017715. [Google Scholar] [CrossRef]
- Hoang, A.M.; Dehzangi, A.; Adhikary, S.; Razeghi, M. High performance bias-selectable three-color Short-wave/Mid-wave/Long-wave infrared photodetectors based on type-II InAs/GaSb/AlSb superlattices. Sci. Rep. 2016, 6, 24144–24151. [Google Scholar] [CrossRef]
- Müller, R.; Gramich, V.; Wauro, M.; Niemasz, J.; Kirste, L.; Daumer, V.; Janaszek, A.; Jureńczyk, J.; Rehm, R. High operating temperature InAs/GaSb type-II superlattice detectors on GaAs substrate for the long wavelength infrared. Infrared Phys. Technol. 2019, 96, 141–144. [Google Scholar] [CrossRef]
- Durlin, Q.; Perez, J.P.; Cerutti, L.; Rodriguez, J.B.; Cerba, T.; Baron, T.; Tournié, E.; Christol, P. Midwave infrared barrier detector based on Ga-free InAs/InAsSb type-II superlattice grown by molecular beam epitaxy on Si substrate. Infrared Phys. Technol. 2019, 96, 39–43. [Google Scholar] [CrossRef]
- Ramirez, J.M.; Elfaiki, H.; Verolet, T.; Besancon, C.; Gallet, A.; Néel, D.; Hassan, K.; Olivier, S.; Jany, C.; Malhouitre, S.; et al. III-V-on-Silicon integration: From hybrid devices to heterogeneous photonic integrated circuits. IEEE J. Sel. Top. Quantum Electron. 2020, 26, 1–13. [Google Scholar] [CrossRef]
- Zhang, J.; Muliuk, G.; Juvert, J.; Kumari, S.; Goyvaerts, J.; Haq, B.; Op de Beeck, C.; Kuyken, B.; Morthier, G.; Van Thourhout, D.; et al. III-V-on-Si photonic integrated circuits realized using micro-transfer-printing. APL Photon. 2019, 4, 110803. [Google Scholar] [CrossRef]
- Kunert, B.; Mols, Y.; Baryshniskova, M.; Waldron, N.; Schulze, A.; Langer, R. How to control defect formation in monolithic III/V hetero-epitaxy on (100) Si? A critical review on current approaches. Semicond. Sci. Technol. 2018, 33, 093002–0930021. [Google Scholar] [CrossRef]
- Li, Q.; Lau, K.M. Epitaxial growth of highly mismatched III-V materials on (001) silicon for electronics and optoelectronics. Prog. Cryst. Growth Charact. Mater. 2017, 63, 105–120. [Google Scholar] [CrossRef]
- Qian, W.; Skowronski, M.; Kaspi, R. Dislocation density reduction in GaSb films grown on GaAs substrates by molecular beam epitaxy. J. Electrochern. Soc. 1997, 144, 1430–1434. [Google Scholar] [CrossRef]
- Gilman, J.J. Electronic basis of hardness and phase transformations (covalent crystals). J. Phys. D Appl. Phys. 2008, 41, 074020. [Google Scholar] [CrossRef]
- Yonenaga, I. Hardness, yield strength, and dislocation velocity in elemental and compound semiconductors. Mater. Trans. 2005, 46, 1979–1985. [Google Scholar] [CrossRef]
- Vasil’ev, V.P.; Gachon, J.-C. Thermodynamic properties of III-V compounds. Inorg. Mater. 2006, 42, 1176–1187. [Google Scholar] [CrossRef]
- Marina, L.I.; Nashel’skii, A.Y. Thermochemical constants of AIIIBV compound semiconductors, and approximate methods of calculation. Russ. Chem. Rev. 1971, 40, 608–621. [Google Scholar] [CrossRef]
- Huang, S.H.; Balakrishnan, G.; Khoshakhlagh, A.; Dawson, L.R.; Huffaker, D.L. Simultaneous interfacial misfit array formation and antiphase domain suppression on miscut silicon substrate. Appl. Phys. Lett. 2008, 93, 071102. [Google Scholar] [CrossRef]
- Kim, Y.H.; Noh, Y.K.; Kim, M.D.; Oh, J.E.; Chung, K.S. Transmission electron microscopy study of the initial growth stage of GaSb grown on Si (001) substrate by molecular beam epitaxy method. Thin Solid Films 2010, 518, 2280–2284. [Google Scholar] [CrossRef]
- Cerba, T.; Martin, M.; Moeyaert, J.; David, S.; Rouviere, J.L.; Cerutti, L.; Alcotte, R.; Rodriguez, J.B.; Bawedin, M.; Boutry, H.; et al. Anti phase boundary free GaSb layer grown on 300 mm (001)-Si substrate by metal organic chemical vapor deposition. Thin Solid Films 2018, 645, 5–9. [Google Scholar] [CrossRef]
- Balakrishnan, G.; Huang, S.H.; Khoshakhlagh, A.; Jallipalli, A.; Rotella, P.; Amtout, A.; Krishna, S.; Haines, C.P.; Dawson, L.R.; Huffaker, D.L. Room-temperature optically-pumped GaSb quantum well based VCSEL monolithically grown on Si (100) substrate. Electron. Lett. 2006, 42, 350–351. [Google Scholar] [CrossRef]
- Huang, S.H.; Balakrishnan, G.; Khoshakhlagh, A.; Jallipalli, A.; Dawson, L.R.; Huffaker, D.L. Strain relief by periodic misfit arrays for low defect density GaSb on GaAs. Appl. Phys. Lett. 2006, 88, 131911. [Google Scholar] [CrossRef]
- Fitzgerald, E.A.; Chand, N. Epitaxial necking in GaAs grown on pre-patterned Si substrates. J. Electron. Mater. 1991, 20, 839–853. [Google Scholar] [CrossRef]
- Li, J.Z.; Bai, J.; Park, J.-S.; Adekore, B.; Fox, K.; Carroll, M.; Lochtefeld, A. Defect reduction of GaAs epitaxy on Si (001) using selective aspect ratio trapping. Appl. Phys. Lett. 2007, 91, 021114. [Google Scholar] [CrossRef]
- Borg, M.; Schmid, H.; Gooth, J.; Rossell, M.D.; Cutaia, D.; Knoedler, M.; Bologna, N.; Wirths, S.; Moselund, K.E.; Riel, H. High-mobility GaSb nanostructures cointegrated with InAs on Si. ACS Nano 2017, 11, 2554–2560. [Google Scholar] [CrossRef] [PubMed]
- Ng, W.K.; Han, Y.; Lau, K.M.; Wong, K.S. Broadband telecom emission from InP/InGaAs nano-ridge lasers on silicon-on-insulator substrate. OSA Contin. 2019, 2, 3037–3043. [Google Scholar] [CrossRef]
- Megalini, L.; Bonef, B.; Cabinian, B.C.; Zhao, H.; Taylor, A.; Speck, J.S.; Bowers, J.E.; Klamkin, J. 1550-nm InGaAsP multi-quantum-well structures selectively grown on v-groove-patterned SOI substrates. Appl. Phys. Lett. 2017, 111, 032105. [Google Scholar] [CrossRef]
- Li, Y.; Wang, M.; Zhou, X.; Wang, P.; Yang, W.; Meng, F.; Luo, G.; Yu, H.; Pan, J.; Wang, W. InGaAs/InP multi-quantum-well nanowires with a lower optical leakage loss on v-groove patterned SOI substrates. Opt. Express 2019, 27, 494–503. [Google Scholar] [CrossRef]
- Shi, Y.; Kunert, B.; De Koninck, Y.; Pantouvaki, M.; Van Campenhout, J.; Van Thourhout, D. Novel adiabatic coupler for III-V nano-ridge laser grown on a Si photonics platform. Opt. Express 2019, 27, 37781–37794. [Google Scholar] [CrossRef]
- Krost, A.; Grundmann, M.; Bimberg, D.; Cerva, H. InP on patterned Si(001): Defect reduction by application of the necking mechanism. J. Cryst. Growth 1992, 124, 207–212. [Google Scholar] [CrossRef]
- Paladugu, M.; Merckling, C.; Loo, R.; Richard, O.; Bender, H.; Dekoster, J.; Vandervorst, W.; Caymax, M.; Heyns, M. Site selective integration of III−V materials on Si for nanoscale logic and photonic devices. Cryst. Growth Des. 2012, 12, 4696–4702. [Google Scholar] [CrossRef]
- Orzali, T.; Vert, A.; O’Brian, B.; Herman, J.L.; Vivekanand, S.; Papa Rao, S.S.; Oktyabrsky, S.R. Epitaxial growth of GaSb and InAs fins on 300 mm Si (001) by aspect ratio trapping. J. Appl. Phys. 2016, 120, 085308. [Google Scholar] [CrossRef]
- Li, Q.; Lai, B.; Lau, K.M. Epitaxial growth of GaSb on V-grooved Si (001) substrates with an ultrathin GaAs stress relaxing layer. Appl. Phys. Lett. 2017, 111, 172103. [Google Scholar] [CrossRef]
- Li, Q.; Ng, K.W.; Lau, K.M. Growing antiphase-domain-free GaAs thin films out of highly ordered planar nanowire arrays on exact (001) silicon. Appl. Phys. Lett. 2015, 106, 072105. [Google Scholar] [CrossRef]
- Krost, A.; Heinrichsdorff, F.; Bimberg, D.; Cerva, H. InP on Si(111): Accommodation of lattice mismatch and structural properties. Appl. Phys. Lett. 1994, 64, 769–771. [Google Scholar] [CrossRef]
- Xu, H.Y.; Guo, Y.N.; Wang, Y.; Zou, J.; Kang, J.H.; Gao, Q.; Tan, H.H.; Jagadish, C. Effects of annealing and substrate orientation on epitaxial growth of GaAs on Si. J. Appl. Phys. 2009, 106, 083514. [Google Scholar] [CrossRef]
- Mols, Y.; Bogdanowicz, J.; Favia, P.; Lagrain, P.; Guo, W.; Bender, H.; Kunert, B. Structural analysis and resistivity measurements of InAs and GaSb fins on 300 mm Si for vertical (T)FET. J. Appl. Phys. 2019, 125, 245107. [Google Scholar] [CrossRef]
- Kunert, B.; Guo, W.; Mols, Y.; Langer, R.; Barla, K. Integration of III/V hetero-structures by selective area growth on Si for nano- and optoelectronics. ECS Trans. 2016, 75, 409–419. [Google Scholar] [CrossRef]
- Kunert, B.; Langer, R.; Pantouvaki, M.; Van Campenhout, J.; Van Thourhout, D. Gaining an edge with nano-ridges. Compd. Semicond. 2018, 24, 36–41. [Google Scholar]
- Chang, C.-P. Shallow Trench Isolation. In Encyclopedia of Materials: Science and Technology, 2nd ed.; Buschow, J.K.H., Cahn, R.W., Flemings, M.C., Ilschner, B., Kramer, E.J., Mahajan, S., Veyssière, P., Eds.; Elsevier: Amsterdam, The Netherlands, 2001; pp. 8437–8444. [Google Scholar] [CrossRef]
- Nishino, H.; Hayasaka, N.; Okano, H. Damage-free selective etching of Si native oxides using NH3/NF3 and SF6/H2O. J. Appl. Phys. 1993, 74, 1345–1348. [Google Scholar] [CrossRef]
- Kunert, B.; Guo, W.; Mols, Y.; Tian, B.; Wang, Z.; Shi, Y.; Van Thourhout, D.; Pantouvaki, M.; Van Campenhout, J.; Langer, R.; et al. III/V nano ridge structures for optical applications on patterned 300 mm silicon substrate. Appl. Phys. Lett. 2016, 109, 091101. [Google Scholar] [CrossRef]
- Guo, W.; Mols, Y.; Belz, J.; Beyer, A.; Volz, K.; Schulze, A.; Langer, R.; Kunert, B. Anisotropic relaxation behavior of InGaAs/GaAs selectively grown in narrow trenches on (001) Si substrates. J. Appl. Phys. 2017, 122, 025303. [Google Scholar] [CrossRef]
- Han, H.; Hantschel, T.; Strakos, L.; Vystavel, T.; Baryshnikova, M.; Mols, Y.; Kunert, B.; Langer, R.; Vandervorst, W.; Caymax, M. Application of electron channeling contrast imaging to 3D semiconductor structures through proper detector configurations. Ultramicroscopy 2020, 210, 112928. [Google Scholar] [CrossRef] [PubMed]
- Schulze, A.; Strakos, L.; Vystavel, T.; Loo, R.; Pacco, A.; Collaert, N.; Vandervorst, W.; Caymax, M. Non-destructive characterization of extended crystalline defects in confined semiconductor device structures. Nanoscale 2018, 10, 7058–7066. [Google Scholar] [CrossRef] [PubMed]
- Shi, Y.; Wang, Z.; Van Campenhout, J.; Pantouvaki, M.; Guo, W.; Kunert, B.; Van Thourhout, D. Optical pumped InGaAs/GaAs nano-ridge laser epitaxially grown on a standard 300-mm Si wafer. Optica 2017, 4, 1468–1473. [Google Scholar] [CrossRef]
- Vais, A.; Witters, L.; Mols, Y.; Hernandez, A.S.; Walke, A.; Yu, H.; Baryshnikova, M.; Deshpande, V.; Alcotte, R.; Parvais, B.; et al. First demonstration of III-V HBTs on 300 mm Si substrates using nano-ridge engineering. In Proceedings of the IEEE International Electron Devices Meeting (IEDM), San Francisco, CA, USA, 7–11 December 2019; pp. 9.1.1–9.1.4. [Google Scholar] [CrossRef]
- Shi, Y.; Kreuzer, L.C.; Gerhardt, N.C.; Pantouvaki, M.; Van Campenhout, J.; Baryshnikova, M.; Langer, R.; Van Thourhout, D.; Kunert, B. Time-resolved photoluminescence characterization of InGaAs/GaAs nano-ridges monolithically grown on 300mm Si substrates. J. Appl. Phys. 2020, 127, 103104. [Google Scholar] [CrossRef]
- Hosseini Vajargah, S.; Ghanad-Tavakoli, S.; Preston, J.S.; Kleiman, R.N.; Botton, G.A. Growth mechanisms of GaSb heteroepitaxial films on Si with an AlSb buffer layer. J. Appl. Phys. 2013, 114, 1131001. [Google Scholar] [CrossRef]
- Balakrishnan, G.; Huang, S.; Khoshakhlagh, A.; Dawson, L.R.; Xin, Y.-C.; Conlin, P.; Huffaker, D.L. High quality AlSb bulk material on Si substrates using a monolithic self-assembled quantum dot nucleation layer. J. Vac. Sci. Technol. 2005, 23, 1010–1012. [Google Scholar] [CrossRef]
- Werner, K.; Beyer, A.; Oelerich, J.O.; Baranovskii, S.D.; Stolz, W.; Volz, K. Structural characteristics of gallium metal deposited on si (001) by MOCVD. J. Cryst. Growth 2014, 405, 102–109. [Google Scholar] [CrossRef]
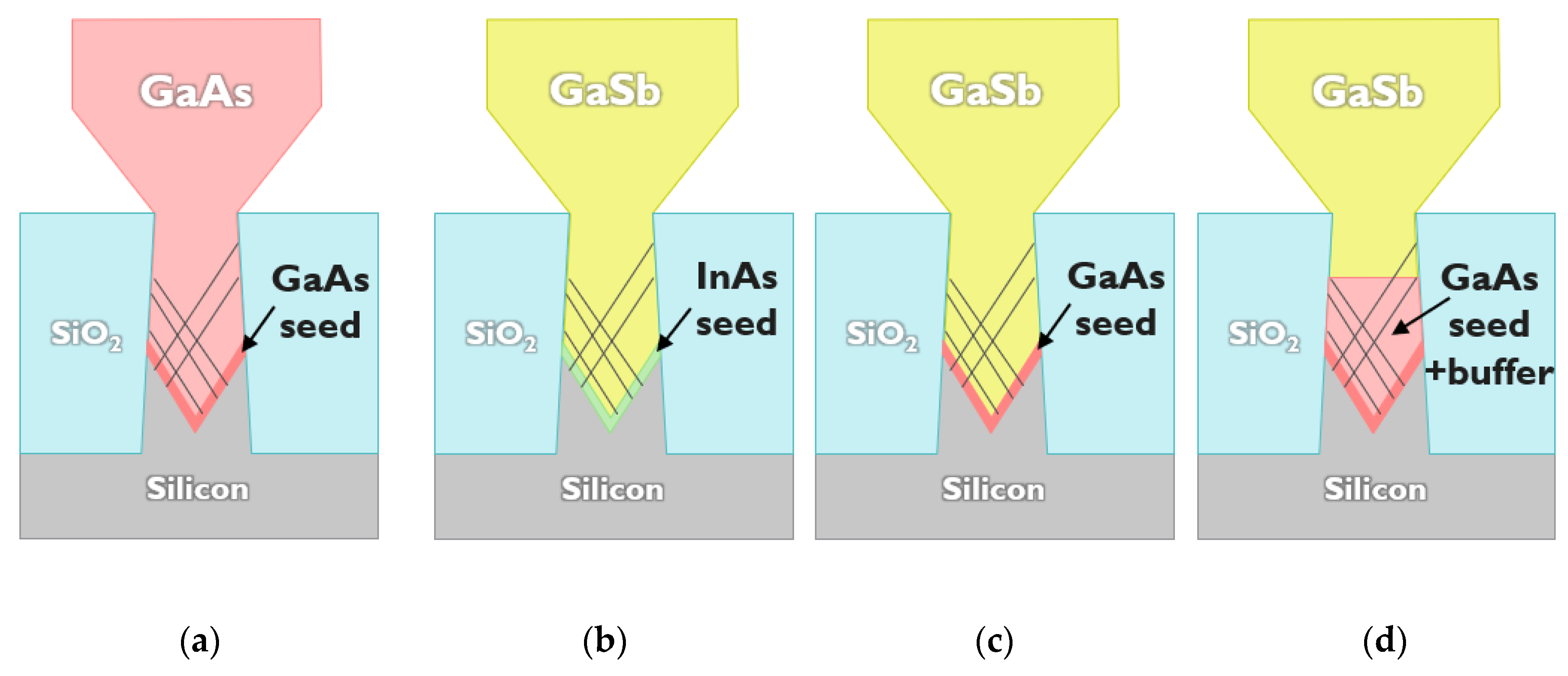
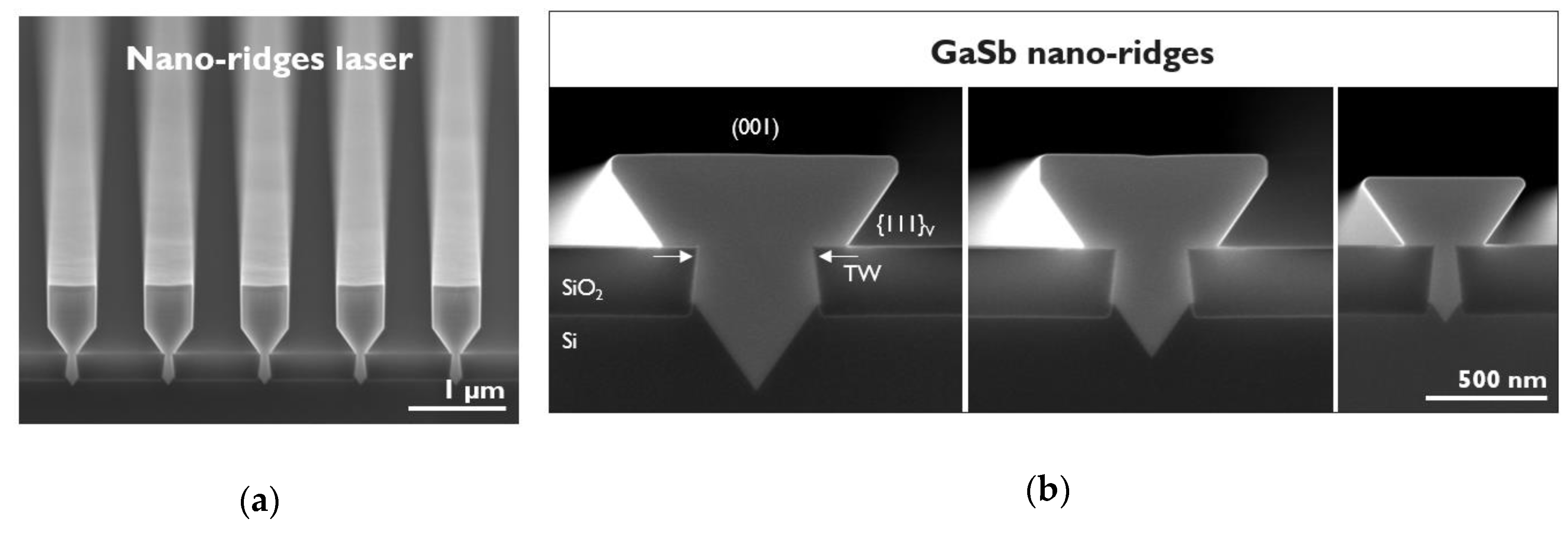
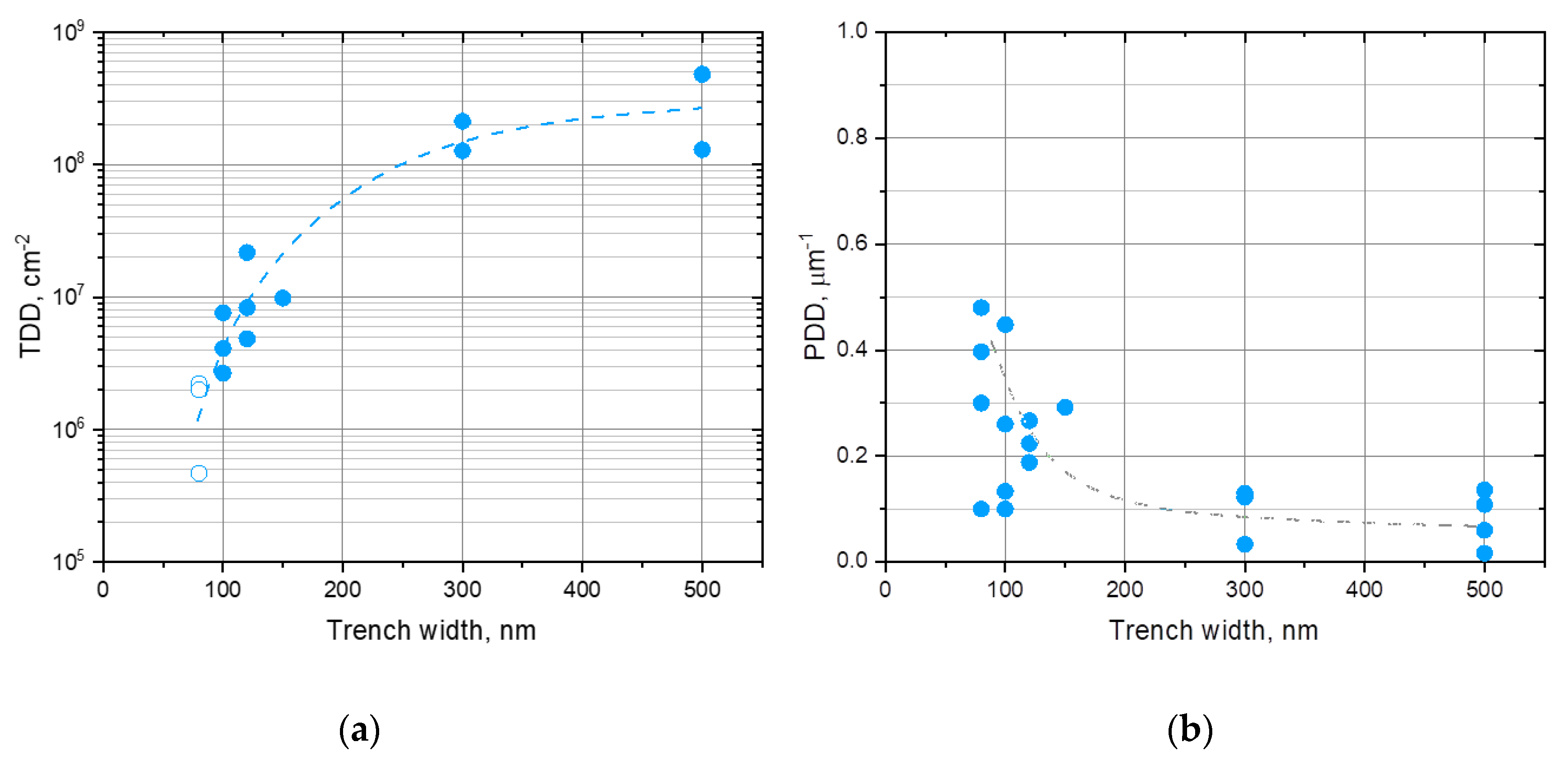
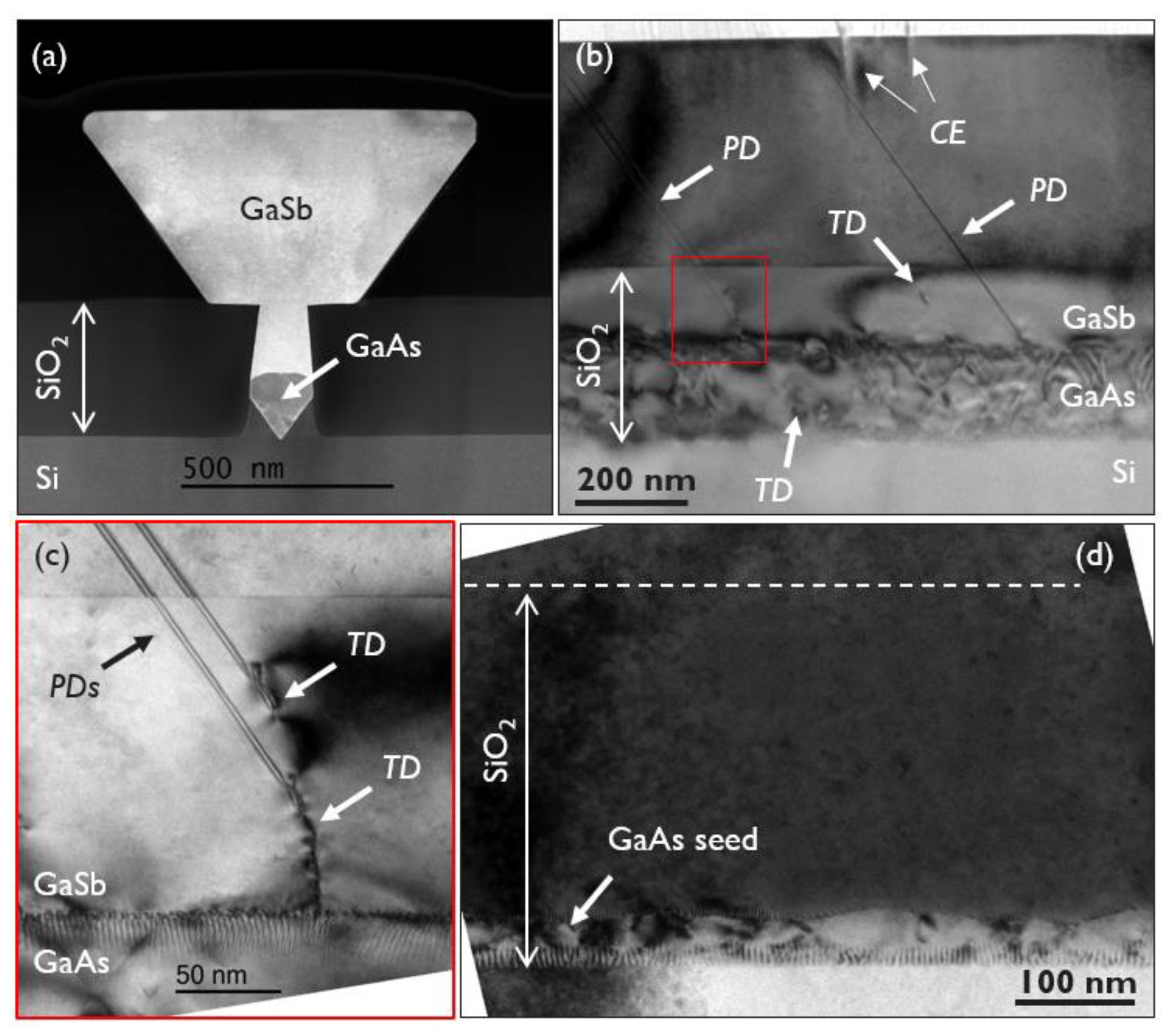
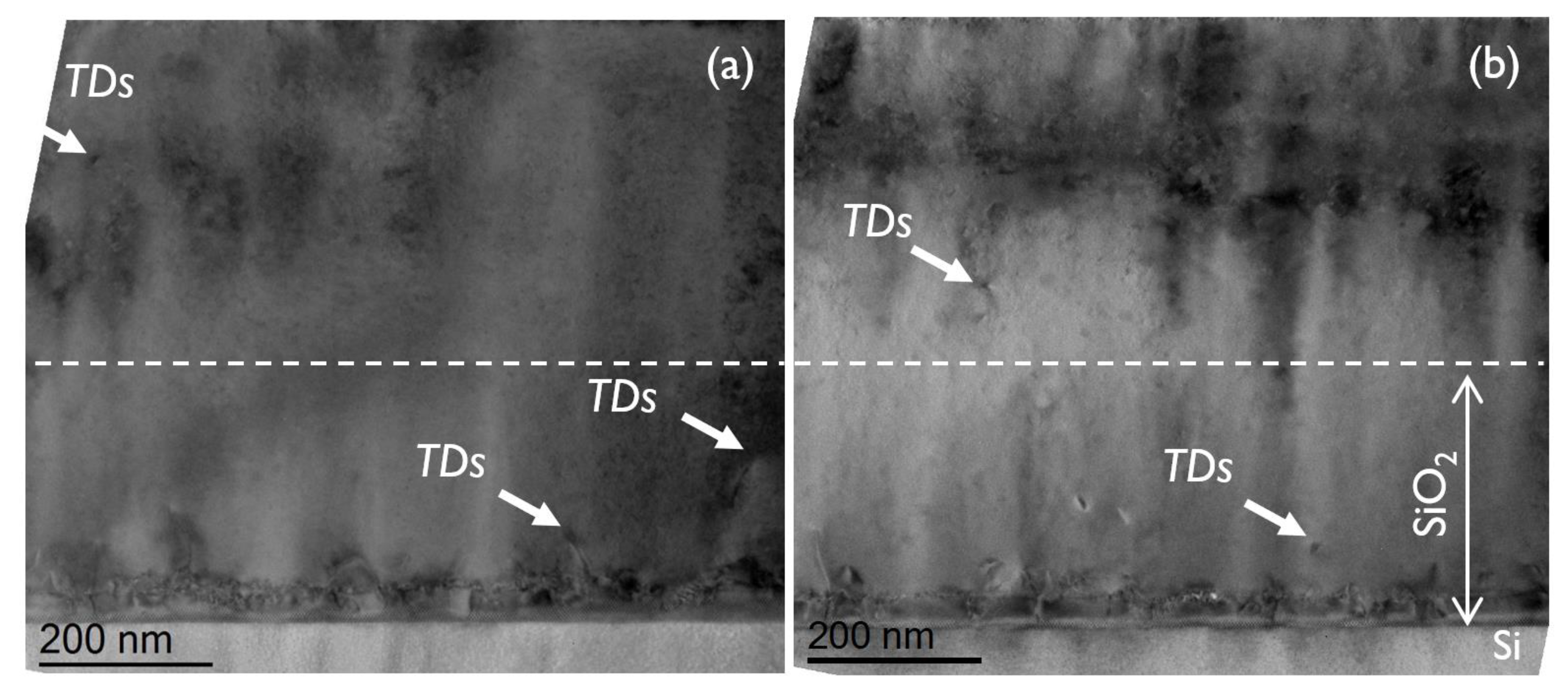
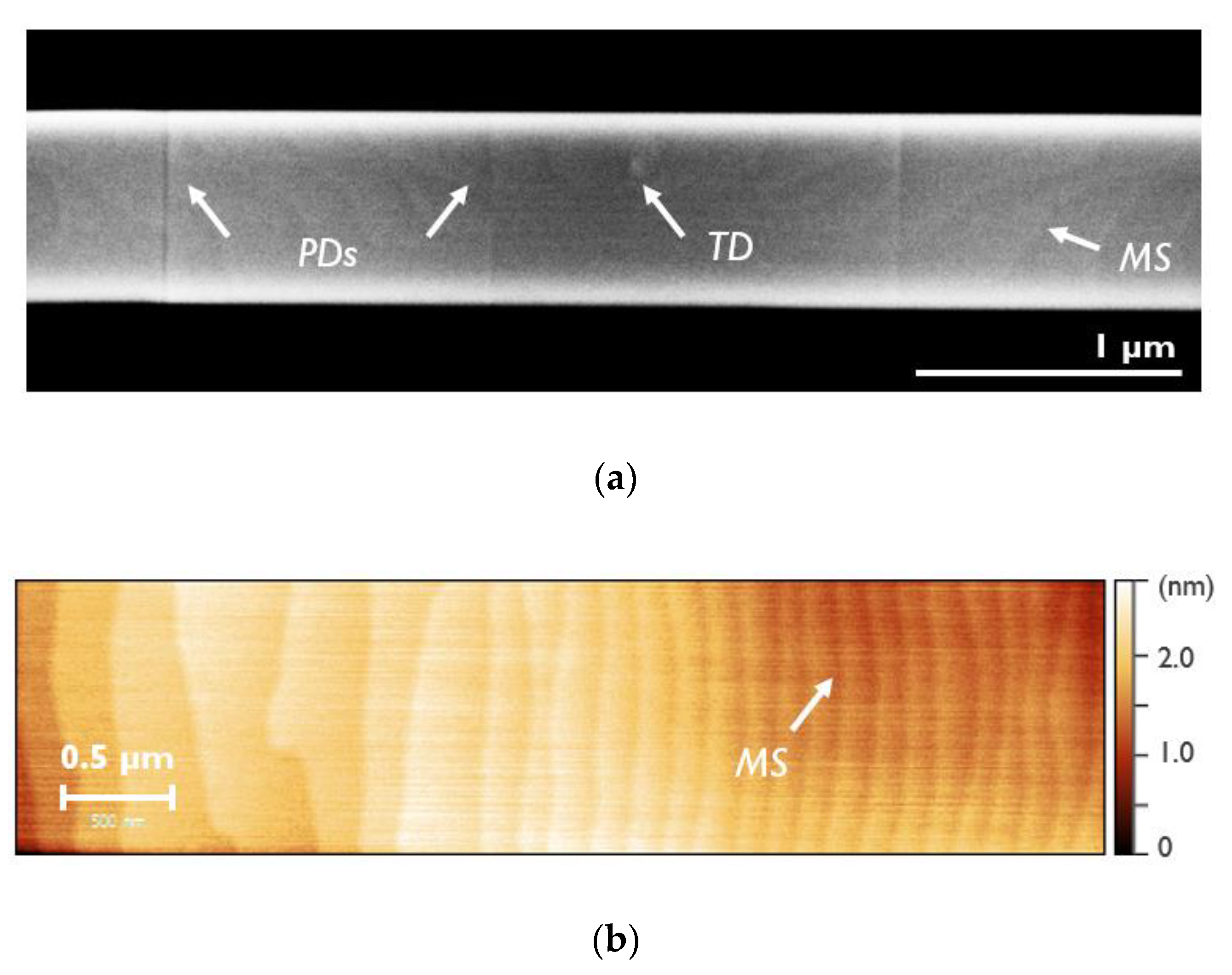
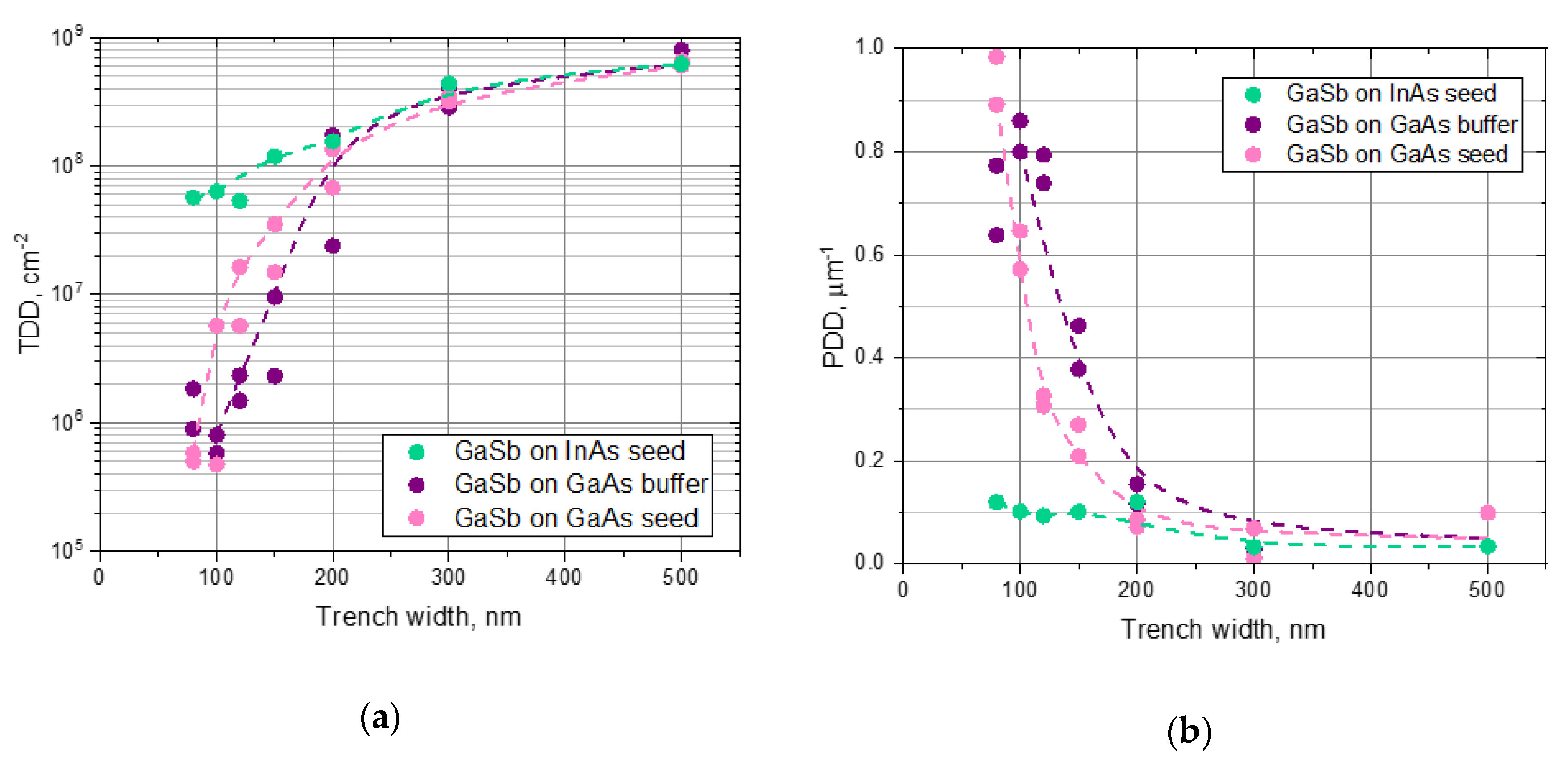
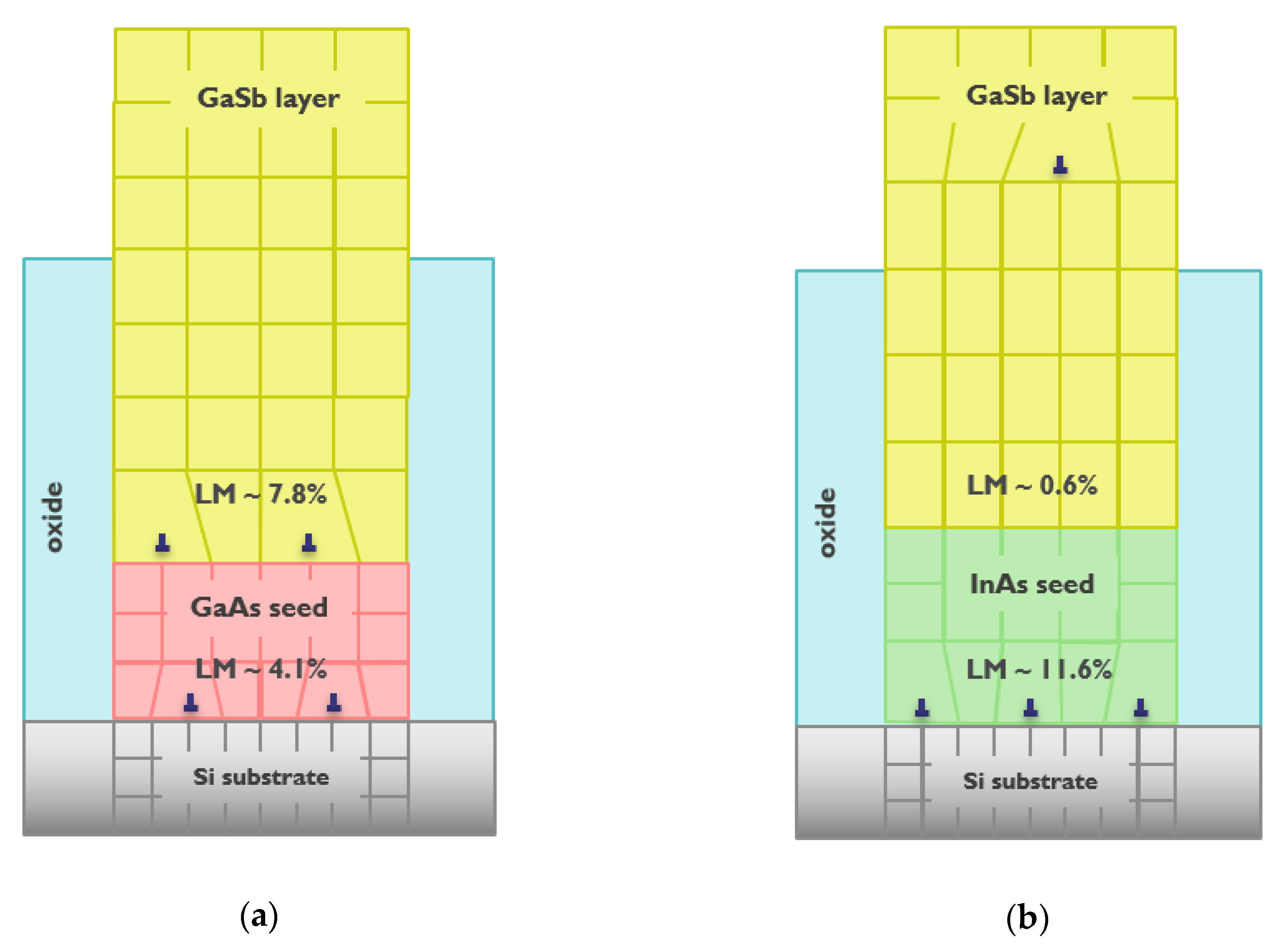
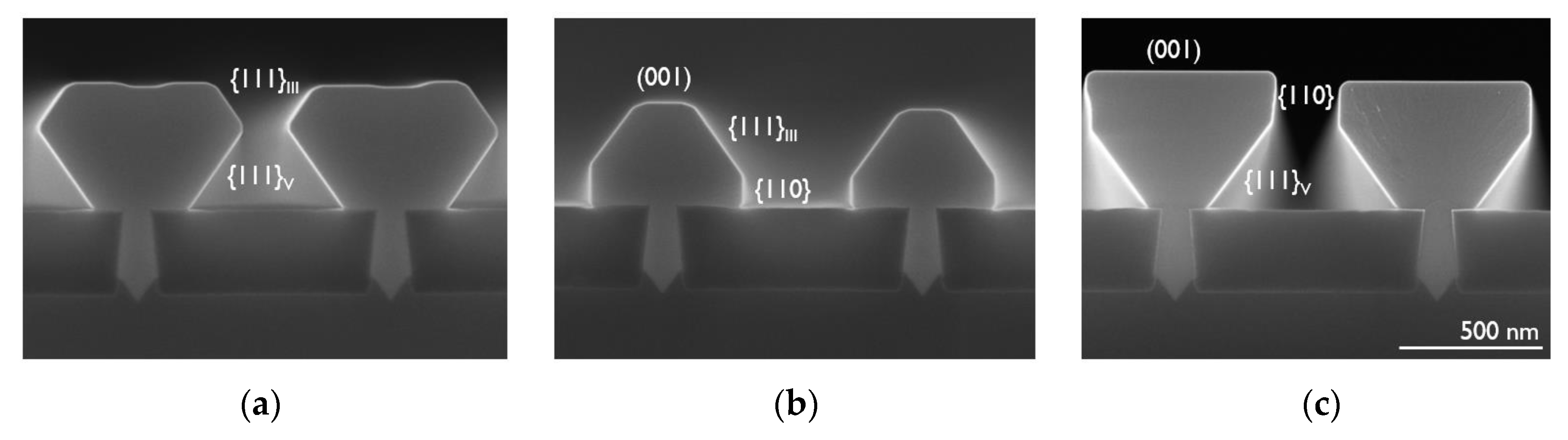
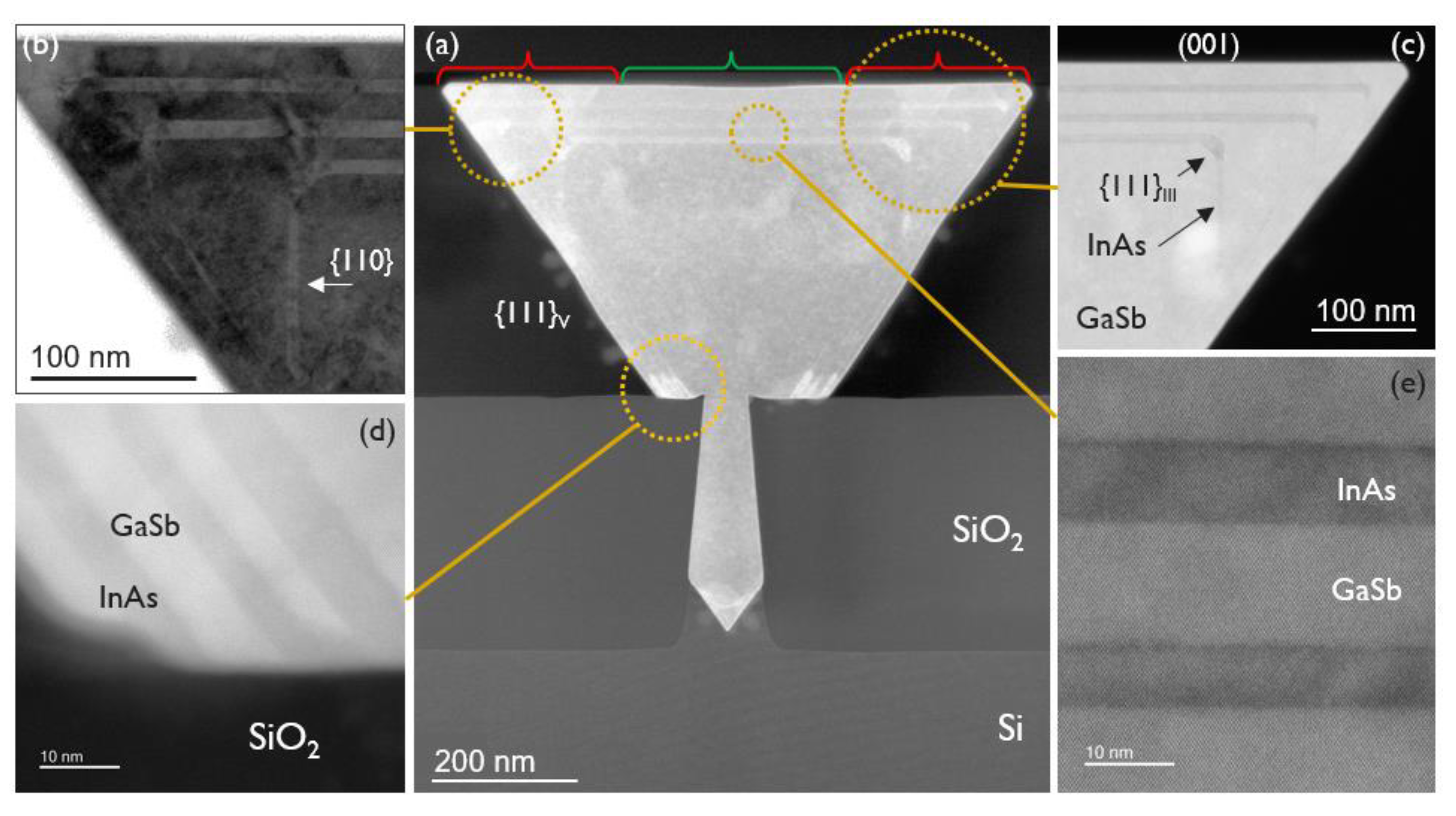
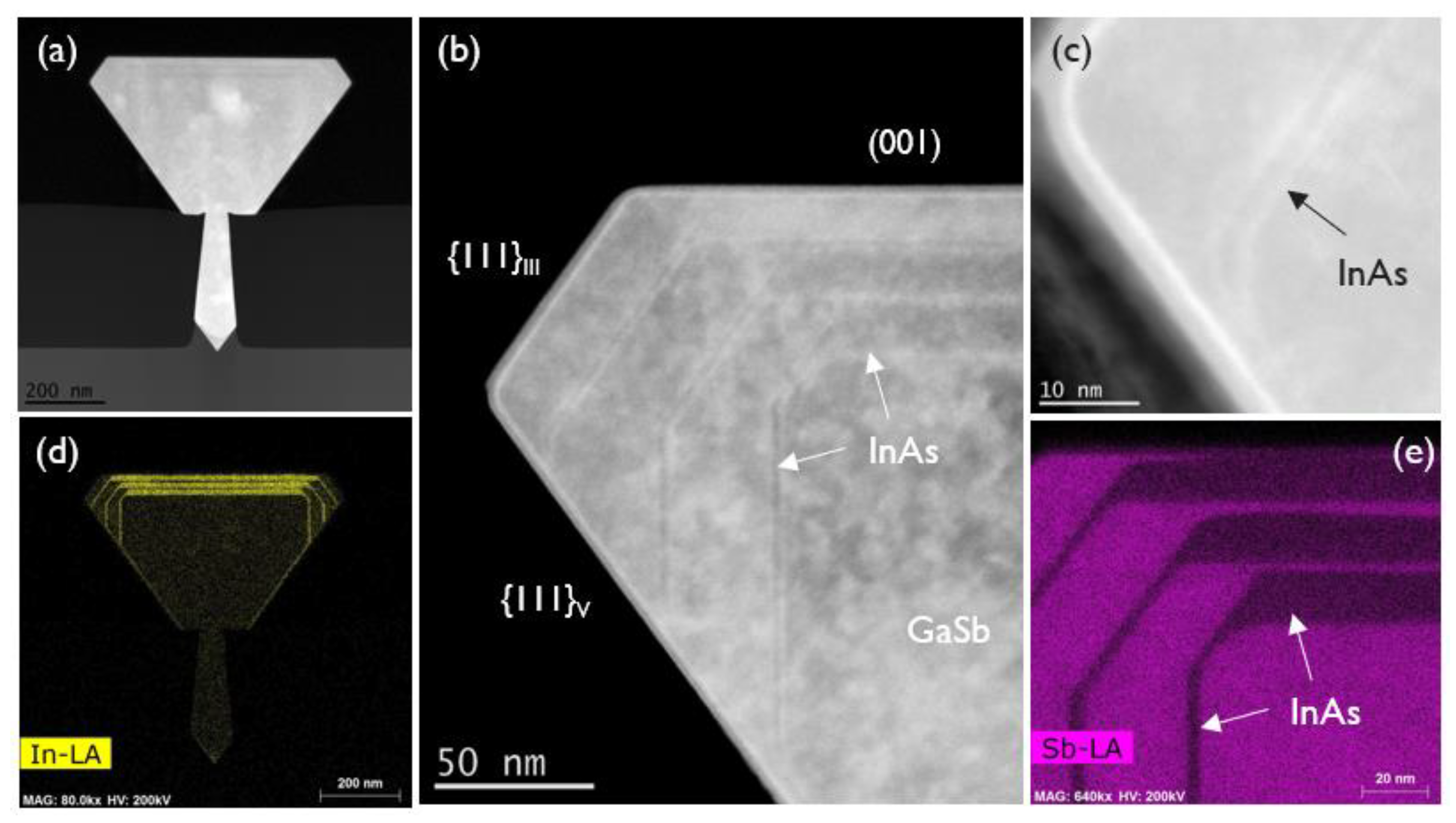
© 2020 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Baryshnikova, M.; Mols, Y.; Ishii, Y.; Alcotte, R.; Han, H.; Hantschel, T.; Richard, O.; Pantouvaki, M.; Van Campenhout, J.; Van Thourhout, D.; et al. Nano-Ridge Engineering of GaSb for the Integration of InAs/GaSb Heterostructures on 300 mm (001) Si. Crystals 2020, 10, 330. https://doi.org/10.3390/cryst10040330
Baryshnikova M, Mols Y, Ishii Y, Alcotte R, Han H, Hantschel T, Richard O, Pantouvaki M, Van Campenhout J, Van Thourhout D, et al. Nano-Ridge Engineering of GaSb for the Integration of InAs/GaSb Heterostructures on 300 mm (001) Si. Crystals. 2020; 10(4):330. https://doi.org/10.3390/cryst10040330
Chicago/Turabian StyleBaryshnikova, Marina, Yves Mols, Yoshiyuki Ishii, Reynald Alcotte, Han Han, Thomas Hantschel, Olivier Richard, Marianna Pantouvaki, Joris Van Campenhout, Dries Van Thourhout, and et al. 2020. "Nano-Ridge Engineering of GaSb for the Integration of InAs/GaSb Heterostructures on 300 mm (001) Si" Crystals 10, no. 4: 330. https://doi.org/10.3390/cryst10040330
APA StyleBaryshnikova, M., Mols, Y., Ishii, Y., Alcotte, R., Han, H., Hantschel, T., Richard, O., Pantouvaki, M., Van Campenhout, J., Van Thourhout, D., Langer, R., & Kunert, B. (2020). Nano-Ridge Engineering of GaSb for the Integration of InAs/GaSb Heterostructures on 300 mm (001) Si. Crystals, 10(4), 330. https://doi.org/10.3390/cryst10040330



