Structure-Dependent Parameter Trade-Off Optimization on RonCoff and Power Compression of AlGaN/GaN HEMTs for RF Switch Application
Abstract
1. Introduction
2. Device Structure and Fabrication
3. Measurement Results and Analysis
3.1. Source-Drain Spacing
3.2. Gate Foot Length
3.3. Gate Cap Length
3.4. Gate Width
3.5. Gate Bias Resistance
3.6. Gate Metal Work Function
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Liu, Y.; Bey, Y.; Liu, X. High-Power High-Isolation RF-MEMS Switches With Enhanced Hot-Switching Reliability Using a Shunt Protection Technique. IEEE Trans. Microw. Theory Tech. 2017, 65, 3188–3199. [Google Scholar] [CrossRef]
- Yang, J.G.; Yang, K. High-Linearity K-Band Absorptive-Type MMIC Switch Using GaN PIN-Diodes. IEEE Microw. Wirel. Compon. Lett. 2013, 23, 37–39. [Google Scholar] [CrossRef]
- Mei, P.-I.; Wu, G.-W.; Hsu, H.-S.; Huang, T.-J.; Tsao, Y.-F.; Chiang, C.-Y.; Hsu, H.-T. Single-Pole Double-Throw Switch Using Stacked-FET Configuration at Millimeter Wave Frequencies. In Proceedings of the 2018 Asia-Pacific Microwave Conference (APMC), Kyoto, Japan, 6–9 November 2018; pp. 791–793. [Google Scholar]
- Campbell, C.F.; Dumka, D.C. Wideband High Power GaN on SiC SPDT Switch MMICs. In Proceedings of the 2010 IEEE MTT-S International Microwave Symposium, Anaheim, CA, USA, 23–28 May 2010; pp. 145–148. [Google Scholar]
- Thome, F.; Bruckner, P.; Quay, R.; Ambacher, O. Millimeter-Wave Single-Pole Double-Throw Switches Based on a 100-Nm Gate-Length AlGaN/GaN-HEMT Technology. In Proceedings of the 2019 IEEE MTT-S International Microwave Symposium (IMS), Boston, MA, USA, 2–7 June 2019; pp. 1403–1406. [Google Scholar]
- Thome, F.; Leuther, A.; Ambacher, O. Low-Loss Millimeter-Wave SPDT Switch MMICs in a Metamorphic HEMT Technology. IEEE Microw. Wirel. Compon. Lett. 2020, 30, 197–200. [Google Scholar] [CrossRef]
- Erturk, V.; Gurdal, A.; Ozbay, E. A High-Power and Broadband GaN SPDT MMIC Switch Using Gate-Optimized HEMTs. IEEE Microw. Wirel. Technol. Lett. 2023, 33, 1207–1210. [Google Scholar] [CrossRef]
- Lucci, L.; Charlet, I.; Gobil, Y.; Morisot, F.; Delprato, J.; Ruel, S.; Benotmane, C.; Laulagnet, F.; Dezest, P.; Bon, R.; et al. CMOS Compatible 200 Mm GaN-on-Si HEMTs for RF Switch Applications with 36 dBm CW Power Handling and 200 FS RonCoff. In Proceedings of the 2024 IEEE International Electron Devices Meeting (IEDM), San Francisco, CA, USA, 7–11 December 2024; pp. 1–4. [Google Scholar]
- Wang, L.; Fan, Y.; Cheng, Y.J. Design of Low Loss Ka-Band SPDT Switch Based on AlGaN/GaN HEMT Technology. In Proceedings of the 2022 IEEE MTT-S International Microwave Workshop Series on Advanced Materials and Processes for RF and THz Applications (IMWS-AMP), Guangzhou, China, 27–29 November 2022; pp. 1–3. [Google Scholar]
- Teppati, V.; Ferrero, A.; Pisani, U. Recent Advances in Real-Time Load-Pull Systems. IEEE Trans. Instrum. Meas. 2008, 57, 2640–2646. [Google Scholar] [CrossRef]
- Caverly, R. Microwave and RF Semiconductor Control Device Modeling; Artech House microwave library; Artech House: Boston, MA, USA; London, UK, 2016; ISBN 978-1-63081-021-4. [Google Scholar]
- Tao, Y.; Hu, Z.F.; Fan, Y.; Liu, Y.N.; He, M.L.; Cheng, Y.J.; Zhang, B. Direct Extraction Method of HEMT Switch Small-signal Model with Multiparasitic Capacitive Current Path. Int. J. RF Microw. Comput.-Aided Eng. 2019, 29, e21690. [Google Scholar] [CrossRef]
- Lin, D.; Xiaofeng, Y.; Yang, L.; Jincheng, Z.; Yue, H. Small-Signal Switch Model of GaN HEMTs for MMIC Applications. J. China Univ. Posts Telecommun. 2016, 23, 56–60. [Google Scholar] [CrossRef]
- Abdul Alim, M.; Rezazadeh, A.A. Temperature-Dependent DC and Small-Signal Analysis of AlGaAs/InGaAs pHEMT for High-Frequency Applications. IEEE Trans. Electron Devices 2016, 63, 1005–1012. [Google Scholar] [CrossRef]
- Zhang, A.; Zhang, L.; Tang, Z.; Cheng, X.; Wang, Y.; Chen, K.J.; Chan, M. Analytical Modeling of Capacitances for GaN HEMTs, Including Parasitic Components. IEEE Trans. Electron Devices 2014, 61, 755–761. [Google Scholar] [CrossRef]
- Hu, Z.; Zhang, Q.; Ma, K.; He, R.; Feng, F. An Improved Compact Large-Signal GaN HEMT Model for Switch Application. IEEE Trans. Electron Devices 2022, 69, 3061–3067. [Google Scholar] [CrossRef]
- Chang, S.; Jeong, H.; Jung, H.; Choi, S.; Choi, I.; Noh, Y.; Kim, S.; Lee, S.; Ahn, H.; Kang, D.M.; et al. Effects of Parasitic Gate Capacitance and Gate Resistance on Radiofrequency Performance in LG = 0.15 Μm GaN High-electron-mobility Transistors for X-band Applications. ETRI J. 2024, 46, 1090–1102. [Google Scholar] [CrossRef]
- Yang, Z.; Williford, P.R.; Jones, E.A.; Chen, J.; Wang, F.; Bala, S.; Xu, J. Factors and Considerations for Modeling Loss of a GaN-Based Inverter. IEEE Trans. Power Electron. 2021, 36, 3042–3052. [Google Scholar] [CrossRef]
- Bansal, K.; Chander, S. GaN HEMT Non Linear Model for RF Switch Applications. In Proceedings of the 2024 7th International Conference on Devices, Circuits and Systems (ICDCS), Coimbatore, India, 23–24 April 2024; pp. 142–145. [Google Scholar]
- Dambrine, G.; Cappy, A.; Heliodore, F.; Playez, E. A New Method for Determining the FET Small-Signal Equivalent Circuit. IEEE Trans. Microw. Theory Tech. 1988, 36, 1151–1159. [Google Scholar] [CrossRef]
- Caddemi, A.; Crupi, G.; Donato, N. A Robust and Fast Procedure for the Determination of the Small Signal Equivalent Circuit of HEMTs. Microelectron. J. 2004, 35, 431–436. [Google Scholar] [CrossRef]
- Gutierrez, A.; Said, N.; Marcault, E.; Gavelle, M. Verification of GaN-HEMT Spice Models Using an S-Parameters Approach. In Proceedings of the 2022 24th European Conference on Power Electronics and Applications (EPE’22 ECCE Europe), Hanover, Germany, 5–9 September 2022. [Google Scholar]
- Li, X.; Sun, Y.; Liu, Z.; Li, X.; Shi, Y.; Wang, T.; Xu, J. Analysis of Metal Work-Function Modulation Effect in Reconfigurable Field-Effect Transistor. IEEE Trans. Electron Devices 2020, 67, 3745–3752. [Google Scholar] [CrossRef]
- Ehteshamuddin, M.; Loan, S.A.; Rafat, M. Insights into the Buried-Metal-Layer Impact on GIDL and ON-State Characteristics in Junctionless Transistor. In Proceedings of the 2019 International Conference on Electrical, Electronics and Computer Engineering (UPCON), Aligarh, India, 8–10 November 2019; pp. 1–4. [Google Scholar]
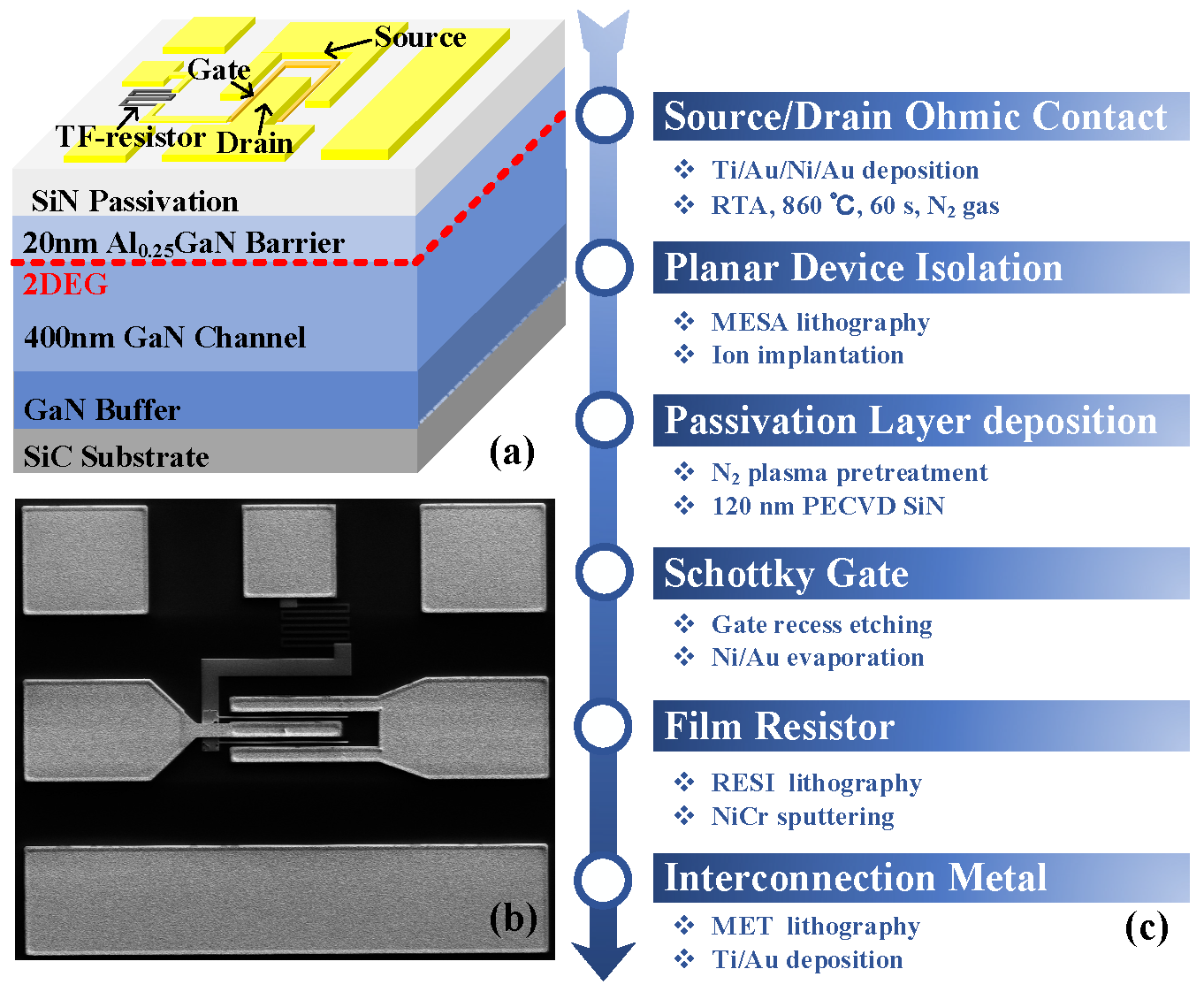
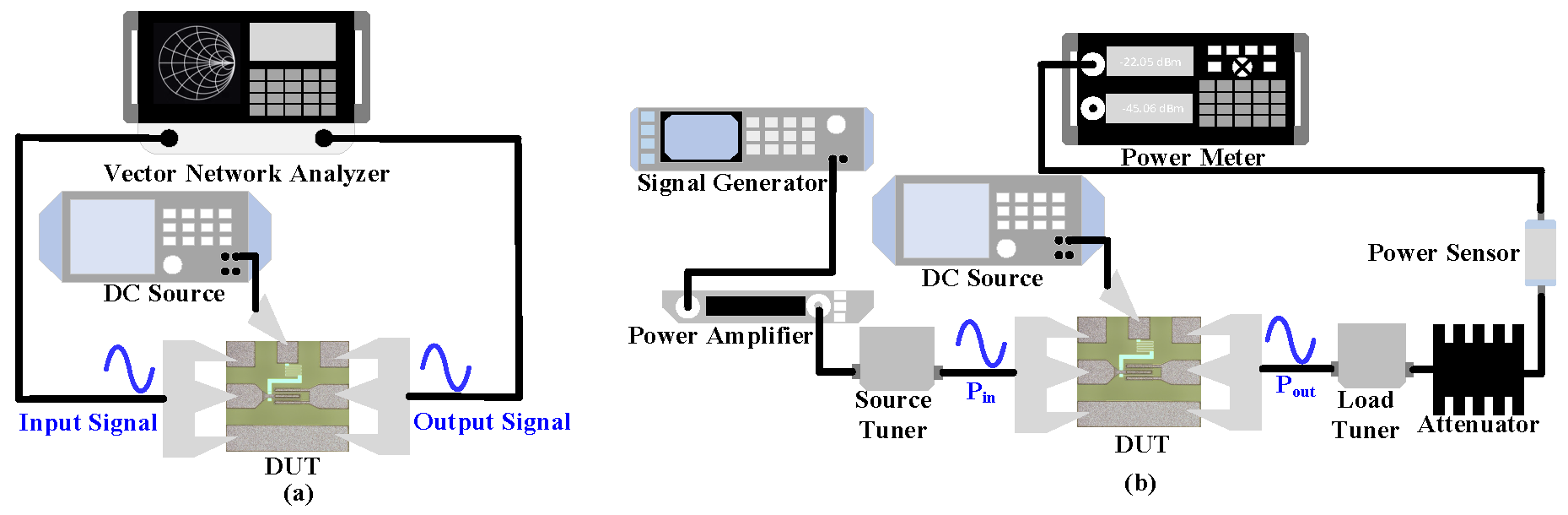
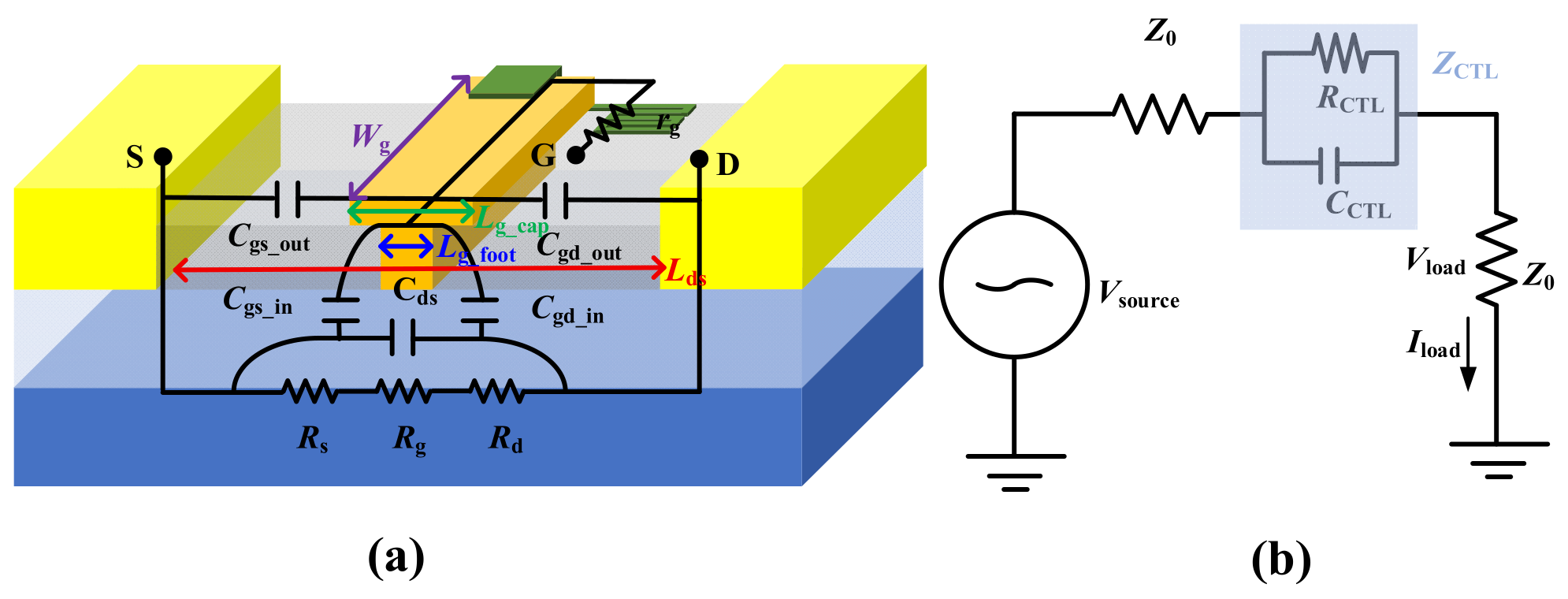



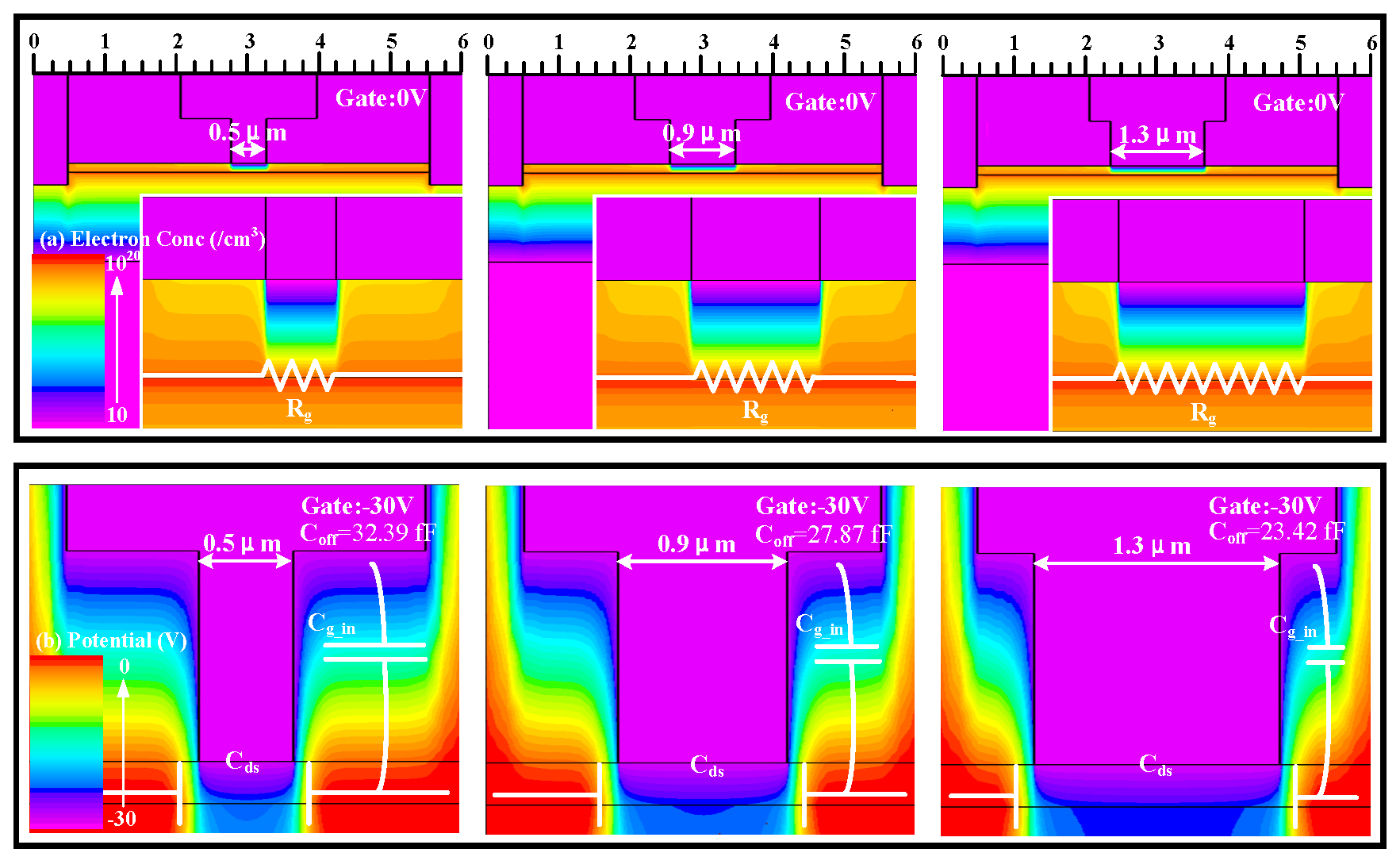
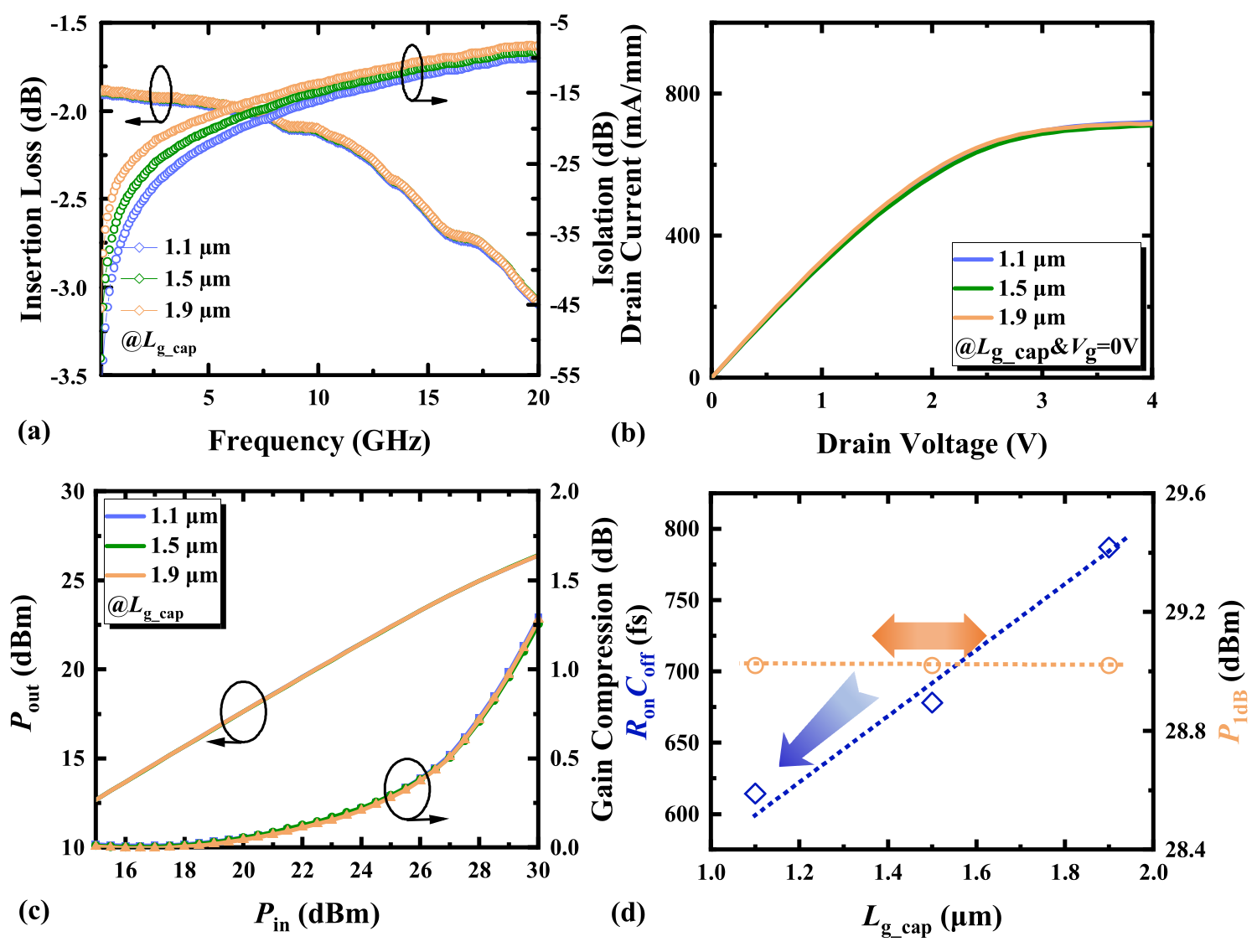

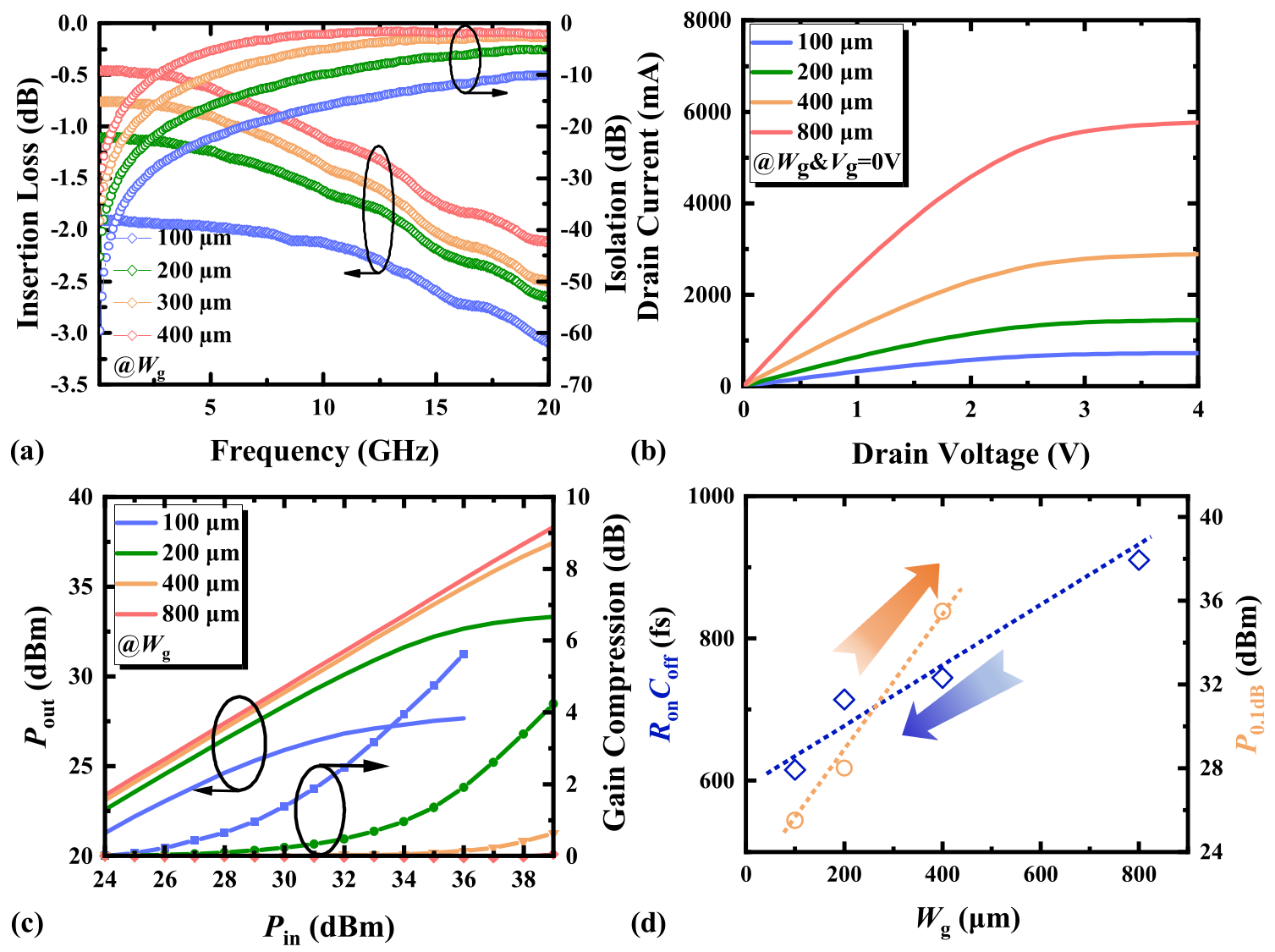
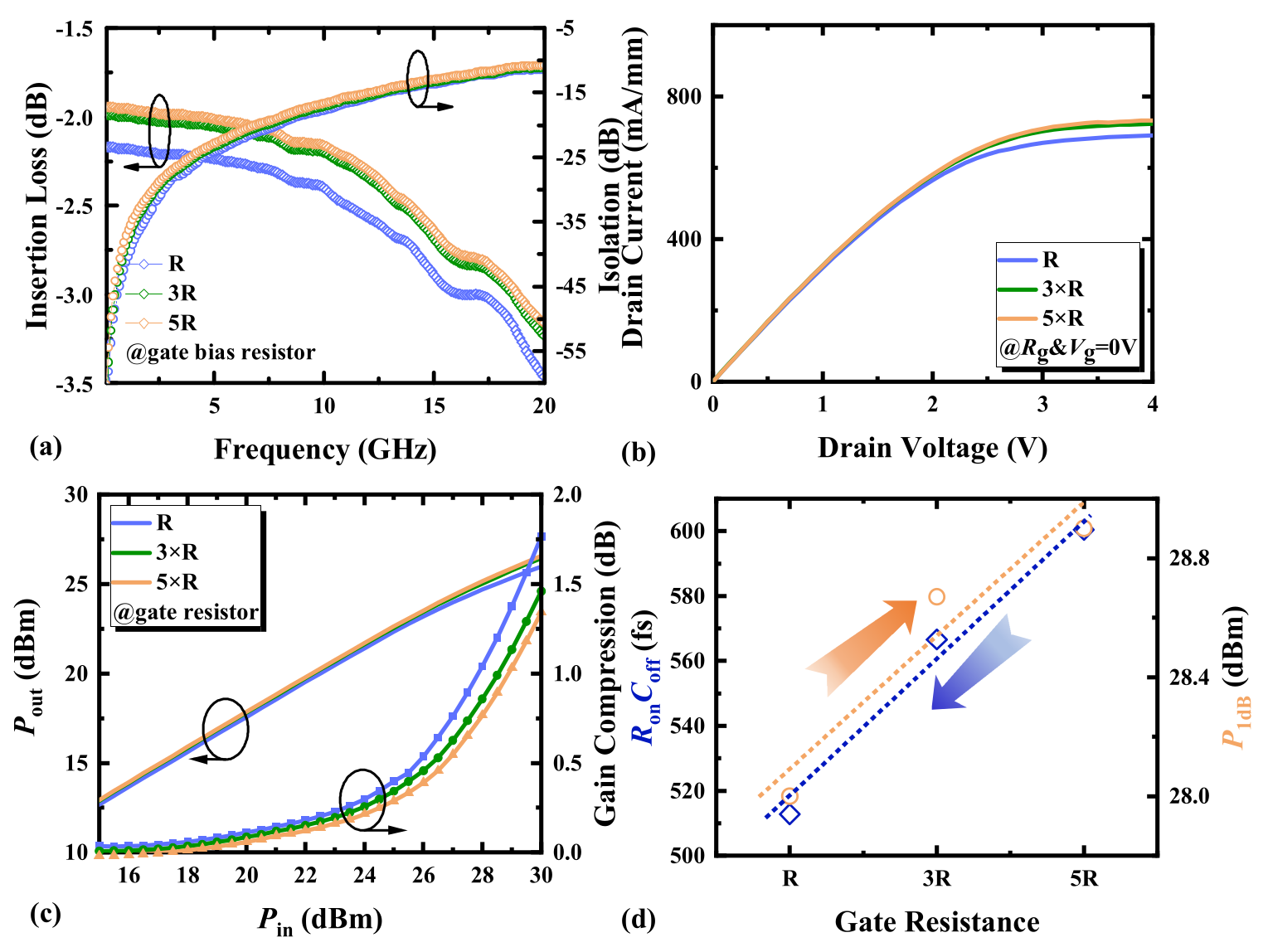

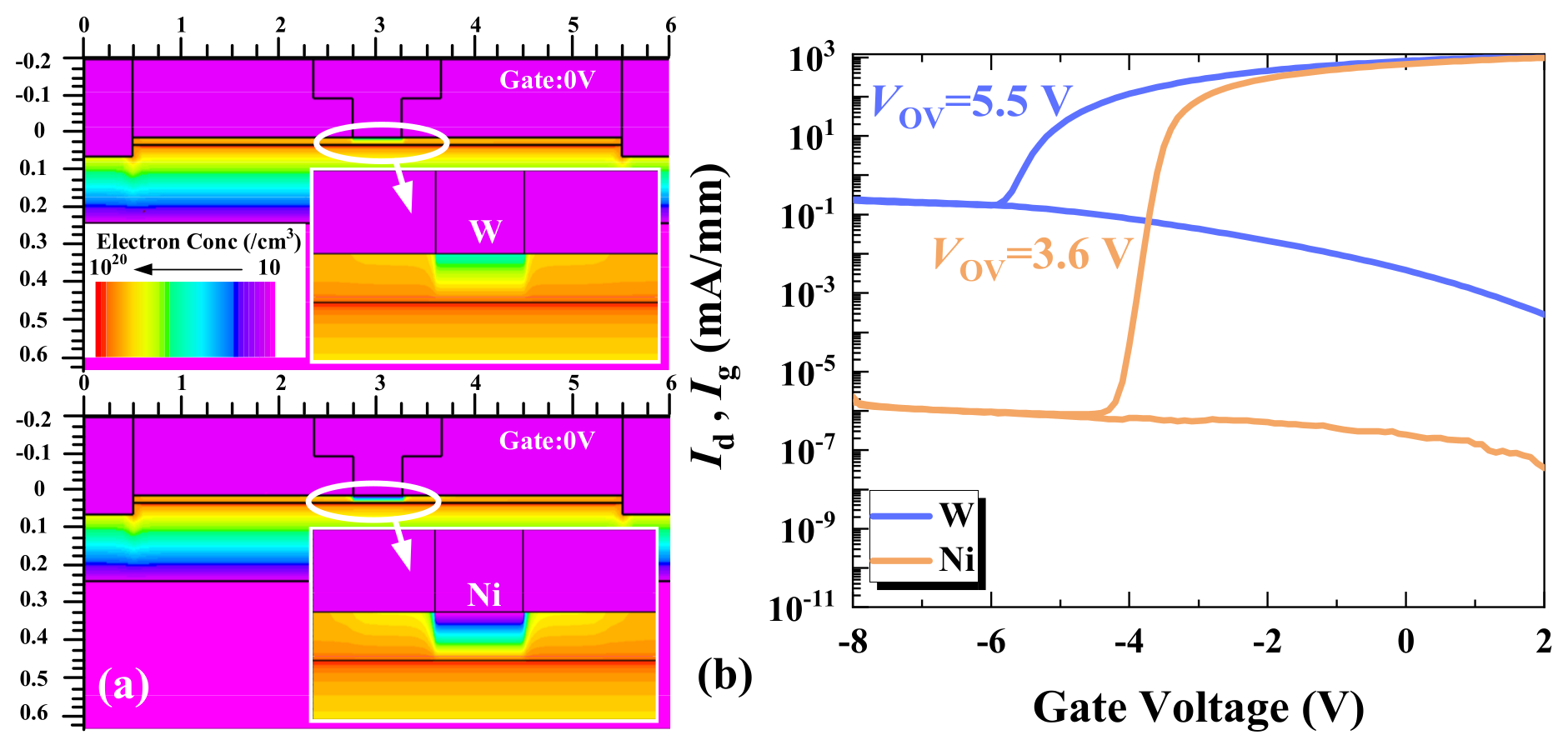

| No. | Lds/μm | Lg_foot/μm | Lg_cap/μm | Wg/μm | rg | Schottky Contact Gate Metal |
|---|---|---|---|---|---|---|
| A | 2/3/4 | 0.5 | 1.1 | 100 | 7 × R | Ni |
| B | 5 | 0.5/0.9/1.3 | 1.9 | 100 | 7 × R | Ni |
| C | 5 | 0.5 | 1.1/1.5/1.9 | 100 | 7 × R | Ni |
| D | 5 | 0.5 | 1.1 | 100/200/400/800 | 7 × R | Ni |
| E | 5 | 0.5 | 1.1 | 100 | R/3 × R/5 × R | Ni |
| F | 5 | 0.5 | 1.3 | 100 | 7 × R | Ni/W |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2026 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license.
Share and Cite
Zou, X.; Zhang, M.; Yang, L.; Hou, B.; Wu, M.; Yi, C.; Lu, H.; Jia, M.; Yu, Q.; Jiang, Y.; et al. Structure-Dependent Parameter Trade-Off Optimization on RonCoff and Power Compression of AlGaN/GaN HEMTs for RF Switch Application. Micromachines 2026, 17, 163. https://doi.org/10.3390/mi17020163
Zou X, Zhang M, Yang L, Hou B, Wu M, Yi C, Lu H, Jia M, Yu Q, Jiang Y, et al. Structure-Dependent Parameter Trade-Off Optimization on RonCoff and Power Compression of AlGaN/GaN HEMTs for RF Switch Application. Micromachines. 2026; 17(2):163. https://doi.org/10.3390/mi17020163
Chicago/Turabian StyleZou, Xu, Meng Zhang, Ling Yang, Bin Hou, Mei Wu, Chupeng Yi, Hao Lu, Mao Jia, Qian Yu, Yutong Jiang, and et al. 2026. "Structure-Dependent Parameter Trade-Off Optimization on RonCoff and Power Compression of AlGaN/GaN HEMTs for RF Switch Application" Micromachines 17, no. 2: 163. https://doi.org/10.3390/mi17020163
APA StyleZou, X., Zhang, M., Yang, L., Hou, B., Wu, M., Yi, C., Lu, H., Jia, M., Yu, Q., Jiang, Y., Ma, X., & Hao, Y. (2026). Structure-Dependent Parameter Trade-Off Optimization on RonCoff and Power Compression of AlGaN/GaN HEMTs for RF Switch Application. Micromachines, 17(2), 163. https://doi.org/10.3390/mi17020163







