A Near-Infrared CMOS Silicon Avalanche Photodetector with Ultra-Low Temperature Coefficient of Breakdown Voltage
Abstract
:1. Introduction
2. Device Design and Fabrication
3. Device Characterization and Analysis
3.1. Dark Current and Photocurrent
3.2. Terminal Capacitance
3.3. Responsivity and Gain
4. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- Takai, I.; Matsubara, H.; Soga, M.; Ohta, M.; Ogawa, M.; Yamashita, T. Single-Photon Avalanche Diode with Enhanced NIR-Sensitivity for Automotive LIDAR Systems. Sensors 2016, 16, 459. [Google Scholar] [CrossRef] [PubMed]
- Li, Y.; Luo, X.; Liang, G.; Lo, G.-Q. Demonstration of Ge/Si avalanche photodetector arrays for lidar application. In Proceedings of the Optical Fiber Communication Conference, San Diego, CA, USA, 3–7 March 2019. [Google Scholar]
- Kuzmenko, K.; Vines, P.; Halimi, A.; Collins, R.J.; Maccarone, A.; McCarthy, A.; Greener, Z.M.; Kirdoda, J.; Dumas, D.C.S.; Llin, L.F.; et al. 3D LIDAR imaging using Ge-on-Si single-photon avalanche diode detectors. Opt. Express 2020, 28, 1330–1344. [Google Scholar] [CrossRef] [PubMed]
- Villa, F.; Severini, F.; Madonini, F.; Zappa, F. SPADs and SiPMs Arrays for Long-Range High-Speed Light Detection and Ranging (LiDAR). Sensors 2021, 21, 3839. [Google Scholar] [CrossRef] [PubMed]
- Royo, S.; Ballesta-Garcia, M. An Overview of Lidar Imaging Systems for Autonomous Vehicles. Appl. Sci. 2019, 9, 4093. [Google Scholar] [CrossRef] [Green Version]
- Reinhardt, A.D.; Bradley, C.P.; McManamon, P.F. Characterization and mitigation of electronic crosstalk on InGaAs PIN 3D flash LiDAR imagers. Opt. Express 2021, 29, 28481–28502. [Google Scholar] [CrossRef] [PubMed]
- Bartolo-Perez, C.; Ghandiparsi, S.; Mayet, A.S.; Cansizoglu, H.; Gao, Y.; Devine, E.P.; Dhar, N.; Wang, S.Y.; Islam, M.S. Photodetectors with Photon-trapping Surface Nanostructures for Short Range LIDAR Systems. In Proceedings of the 2019 IEEE Photonics Society Summer Topical Meeting Series (SUM), Ft. Lauderdale, FL, USA, 8–10 July 2019; pp. 1–2. [Google Scholar] [CrossRef]
- Cheng, Z.; Xu, H.; Chen, Y.; Itzler, M.A.; McIntosh, K.A.; Bienfang, J.C. Design of low noise avalanche photodiode single element detectors and linear arrays through CMOS process. In Proceedings of the Advanced Photon Counting Techniques XIII, Baltimore, MD, USA, 13 May 2019. [Google Scholar] [CrossRef]
- Sun, X.; Abshire, J.B.; Beck, J.D.; Mitra, P.; Reiff, K.; Yang, G. HgCdTe avalanche photodiode detectors for airborne and spaceborne lidar at infrared wavelengths. Opt. Express 2017, 25, 16589–16602. [Google Scholar] [CrossRef] [PubMed]
- Vines, P.; Kuzmenko, K.; Kirdoda, J.; Dumas, D.C.S.; Mirza, M.M.; Millar, R.W.; Paul, D.J.; Buller, G.S. High performance planar germanium-on-silicon single-photon avalanche diode detectors. Nat. Commun. 2019, 10, 1086. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Adamo, G.; Busacca, A. Time Of Flight measurements via two LiDAR systems with SiPM and APD. In Proceedings of the 2016 AEIT International Annual Conference (AEIT), Capri, Italy, 5–7 October 2016; pp. 1–5. [Google Scholar] [CrossRef]
- Yuan, Y.; Huang, Z.; Wang, B.; Sorin, W.V.; Zeng, X.; Liang, D.; Fiorentino, M.; Campbell, J.C.; Beausoleil, R.G. 64 Gbps PAM4 Si-Ge Waveguide Avalanche Photodiodes With Excellent Temperature Stability. J. Lightwave Technol. 2020, 38, 4857–4866. [Google Scholar] [CrossRef]
- Abdullah, S.; Tan, C.H.; Zhou, X.; Zhang, S.; Pinel, L.; Ng, J.S. Investigation of temperature and temporal stability of AlGaAsSb avalanche photodiodes. Opt. Express 2017, 25, 33610–33616. [Google Scholar] [CrossRef]
- Jin, X.; Xie, S.; Liang, B.; Yi, X.; Lewis, H.; Lim, L.W.; Liu, Y.; Ng, B.K.; Huffaker, D.L.; Tan, C.H.; et al. Temperature Dependence of the Impact Ionization Coefficients in AlAsSb Lattice Matched to InP. IEEE J. Sel. Top. Quantum Electron. 2022, 28, 1–8. [Google Scholar] [CrossRef]
- Mcintyre, R.J. Recent developments in silicon avalanche photodiodes. Measurement 1985, 3, 146–152. [Google Scholar] [CrossRef]
- Romaniuk, R.S.; Wegrzecka, I.; Wegrzecki, M.; Bar, J.; Grynglas, M.; Uszynski, A.; Grodecki, R.; Grabiec, P.B.; Krzeminski, S.; Budzynski, T. Silicon Avalanche Photodiodes Developed at the Institute of Electron Technology. In Proceedings of Photonics Applications in Astronomy, Communications, Industry, and High-Energy Physics Experiments II, Wilga, Poland, 21–25 May 2003; pp. 503–514. [Google Scholar] [CrossRef] [Green Version]
- Węgrzecka, I.; Węgrzecki, M.; Grynglas, M.; Bar, J.; Uszyński, A.; Grodecki, R.; Grabiec, P.; Krzemiński, S.; Budzyński, T. Design and properties of silicon avalanche photodiodes. Opto-Electron. Rev. 2004, 12, 95–104. [Google Scholar]
- Nishi, H.; Inada, T.; Sakurai, T.; Kaneda, T.; Hisatsugu, T.; Furuya, T. Uniform doping of channeled-ion implantation. J. Appl. Phys. 1978, 49, 608–613. [Google Scholar] [CrossRef]
- Simon, M.S.; Kwok, K.N. Physics and Properties of Semiconductors-A Review. In Physics of Semiconductor Devices, 3rd ed.; 1–Wiley-Interscience: Hoboken, NJ, USA, 2006; pp. 19–21. [Google Scholar]
- Simon, M.S.; Kwok, K.N. p-n Junctions. In Physics of Semiconductor Devices, 3rd ed.; Wiley-Interscience: Hoboken, NJ, USA, 2006; pp. 111–112. [Google Scholar]
- Massey, D.J.; David, J.P.R.; Rees, G.J. Temperature Dependence of Impact Ionization in Submicrometer Silicon Devices. IEEE Trans. Electron Devices 2006, 53, 2328–2334. [Google Scholar] [CrossRef]
- Harrison, C.N.; David, J.P.R.; Hopkinson, M.; Rees, G.J. Temperature dependence of avalanche multiplication in submicron Al0.6Ga0.4As diodes. J. Appl. Phys. 2002, 92, 7684–7686. [Google Scholar] [CrossRef]
- Takao, K. Silicon and Germanium Avalanche Photodiodes. In Semiconductors and Semimetals, Lightwave Communications Technology. Part D, Photodetectors; Academic Press: Orlando, FL, USA, 1985; Volume 22, pp. 276–277. [Google Scholar]
- Cova, S.; Ghioni, M.; Lacaita, A.; Samori, C.; Zappa, F. Avalanche photodiodes and quenching circuits for single-photon detection. Appl. Opt. 1996, 35, 1956–1976. [Google Scholar] [CrossRef] [PubMed]
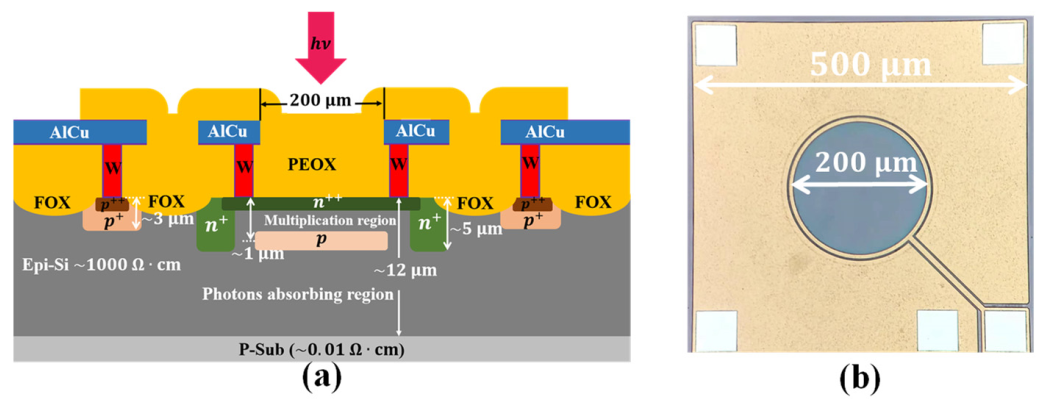
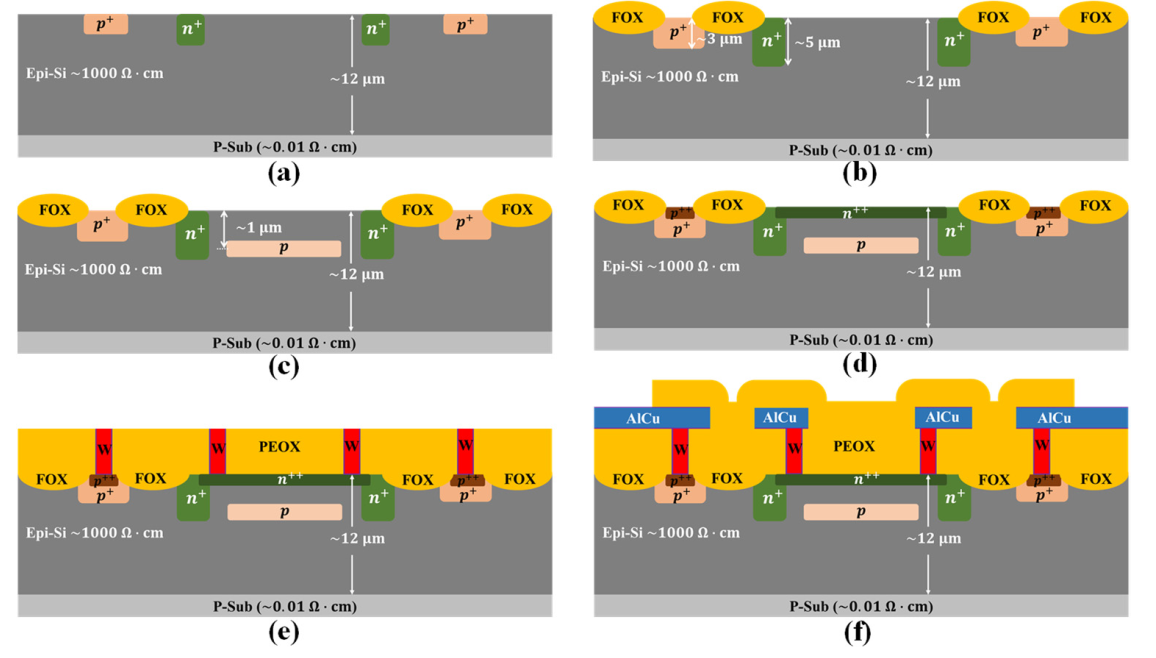

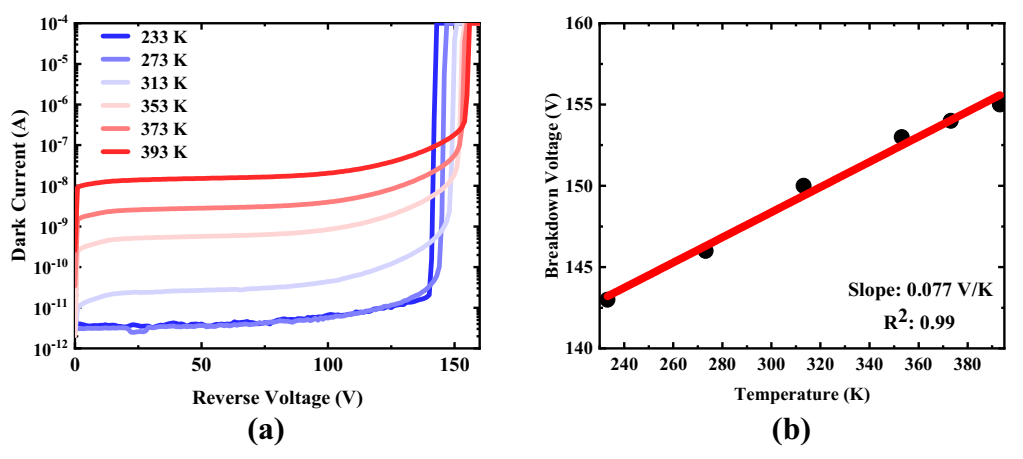
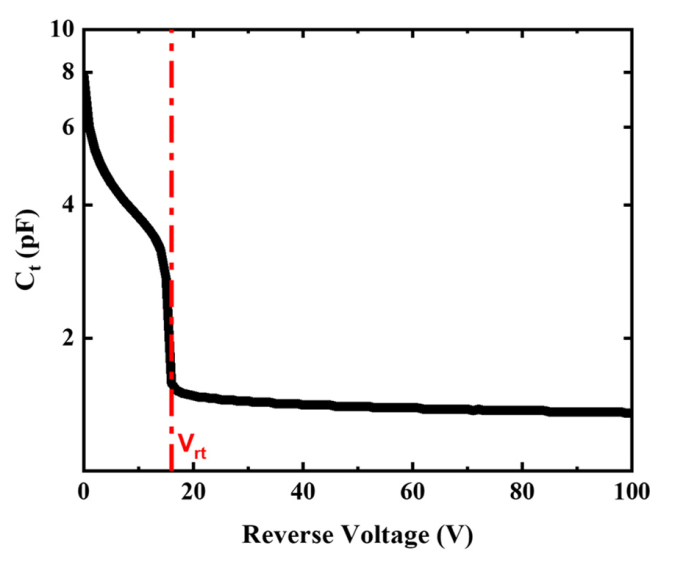
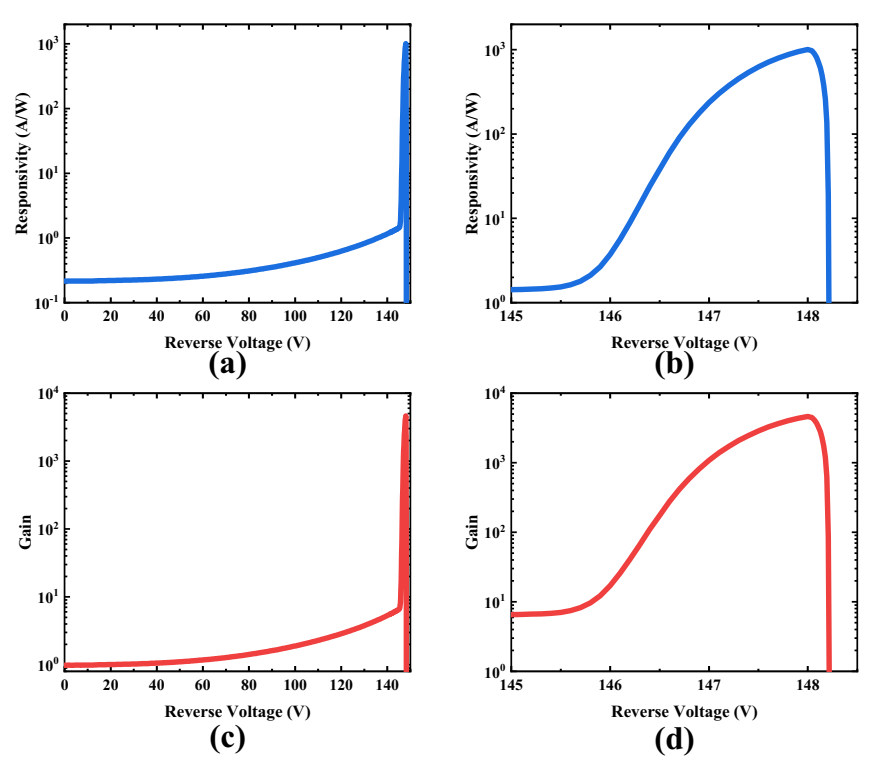
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Liu, D.; Li, T.; Tang, B.; Zhang, P.; Wang, W.; Liu, M.; Li, Z. A Near-Infrared CMOS Silicon Avalanche Photodetector with Ultra-Low Temperature Coefficient of Breakdown Voltage. Micromachines 2022, 13, 47. https://doi.org/10.3390/mi13010047
Liu D, Li T, Tang B, Zhang P, Wang W, Liu M, Li Z. A Near-Infrared CMOS Silicon Avalanche Photodetector with Ultra-Low Temperature Coefficient of Breakdown Voltage. Micromachines. 2022; 13(1):47. https://doi.org/10.3390/mi13010047
Chicago/Turabian StyleLiu, Daoqun, Tingting Li, Bo Tang, Peng Zhang, Wenwu Wang, Manwen Liu, and Zhihua Li. 2022. "A Near-Infrared CMOS Silicon Avalanche Photodetector with Ultra-Low Temperature Coefficient of Breakdown Voltage" Micromachines 13, no. 1: 47. https://doi.org/10.3390/mi13010047
APA StyleLiu, D., Li, T., Tang, B., Zhang, P., Wang, W., Liu, M., & Li, Z. (2022). A Near-Infrared CMOS Silicon Avalanche Photodetector with Ultra-Low Temperature Coefficient of Breakdown Voltage. Micromachines, 13(1), 47. https://doi.org/10.3390/mi13010047





