Effect of Electron Blocking Layer Doping and Composition on the Performance of 310 nm Light Emitting Diodes
Abstract
:1. Introduction
2. Experimental
3. Results and Discussion
3.1. Temporal CpMg Carrier Gas Flow Profile
3.2. Aluminum Composition Profile
4. Conclusions
Acknowledgments
Author Contributions
Conflicts of Interest
Abbreviations
| II/III-ratio | group II to group III ratio |
| AlGaN | aluminum gallium nitride |
| AlN | aluminum nitride |
| CpMg | biscyclopentadienylmagnesium |
| EBL | electron blocking layer |
| H | hydrogen |
| InAlGaN | indium aluminum gallium nitride |
| IQE | internal quantum efficiency |
| LED | light emitting diode |
| Mg | magnesium |
| MOVPE | metal organic vapor phase epitaxy |
| QW | quantum well |
| QWB | quantum well barrier |
| SL | super lattice |
| UV | ultraviolet |
| UV-B | ultraviolet B |
References
- Davitt, K.; Song, Y.; Patterson, W.R.; Nurmikko, A.; Gherasimova, M.; Han, J.; Pan, Y.; Chang, R.K. 290 and 340 nm UV LED arrays for fluorescence detection from single airborne particles. Opt. Express 2005, 13, 9548–9555. [Google Scholar] [CrossRef] [PubMed]
- Kneissl, M.; Rass, J. III-Nitride ultraviolet emitters. In Springer Series in Materials Science; Springer: Basel, Switzerland, 2016. [Google Scholar]
- Shatalov, M.; Sun, W.; Jain, R.; Lunev, A.; Hu, X.; Dobrinsky, A.; Bilenko, Y.; Yang, J.; Garrett, G.A.; Rodak, L.E.; et al. High power AlGaN ultraviolet light emitters. Semicond. Sci. Technol. 2014, 29, 084007. [Google Scholar] [CrossRef]
- Shur, M.S.; Gaska, R. Deep-Ultraviolet light-emitting diodes. IEEE Trans. Electron Devices 2010, 57, 12–25. [Google Scholar] [CrossRef]
- Kneissl, M.; Kolbe, T.; Chua, C.; Küller, V.; Lobo, N.; Stellmach, J.; Knauer, A.; Rodriguez, H.; Einfeldt, S.; Yang, Z.; et al. Advances in group III-nitride-based deep UV light-emitting diode technology. Semicond. Sci. Technol. 2011, 26, 014036. [Google Scholar] [CrossRef]
- TU Berlin, Institute of Solid State Physics. Available online: http://www.ifkp.tu-berlin.de/fileadmin/i1/Kneissl/UV_LED_Efficiency_2017.pdf (accessed on 27 October 2017).
- Knauer, A.; Wenzel, H.; Kolbe, T.; Einfeldt, S.; Weyers, M.; Kneissl, M.; Tränkle, G. Effect of the barrier composition on the polarization felds in near UV InGaN light emitting diodes. Appl. Phys. Lett. 2008, 92, 191912. [Google Scholar] [CrossRef]
- Kolbe, T.; Sembdner, T.; Knauer, A.; Küller, V.; Rodriguez, H.; Einfeldt, S.; Vogt, P.; Weyers, M.; Kneissl, M. Carrier injection in InAlGaN single and multi-quantum-well ultraviolet light emitting diodes. Phys. Status Solidi C 2010, 7, 2196–2198. [Google Scholar] [CrossRef]
- Kolbe, T.; Sembdner, T.; Knauer, A.; Küller, V.; Rodriguez, H.; Einfeldt, S.; Vogt, P.; Weyers, M.; Kneissl, M. (In)AlGaN deep ultraviolet light emitting diodes with optimized quantum well width. Phys. Status Solidi A 2010, 207, 2198–2200. [Google Scholar] [CrossRef]
- Kneissl, M.; Yang, Z.; Teepe, M.; Knollenberg, C.; Johnson, N.M.; Usikov, A.; Dmitriev, V. Ultraviolet InAlGaN light emitting diodes grown on hydride vapor phase epitaxy AlGaN/sapphire templates. Jpn. J. Appl. Phys. 2006, 45, 3905. [Google Scholar] [CrossRef]
- Kawasaki, K.; Koide, C.; Aoyagi, Y.; Takeuchi, M. Vertical AlGaN deep ultraviolet light emitting diode emitting at 322 nm fabricated by the laser lift-off technique. Appl. Phys. Lett. 2006, 89, 261114. [Google Scholar] [CrossRef]
- Chitnis, A.; Su, J.; Mandavilli, V.; Pachipulusu, R.; Wu, S.; Gaevski, M.; Adivarahn, V.; Zhang, J.P.; Khan, M.A. Self-heating effects at high pump currents in deep ultraviolet light-emitting diodes at 324 nm. Appl. Phys. Lett. 2002, 81, 3491. [Google Scholar] [CrossRef]
- Chitnis, A.; Zhang, J.P.; Adivarahn, V.; Shatalov, M.; Wu, S.; Pachipulusi, R.; Mandavilli, V. Improved performance of 325-nm emission AlGaN ultraviolet light-emitting diodes. Appl. Phys. Lett. 2003, 82, 2565. [Google Scholar] [CrossRef]
- Lee, K.B.; Parbrook, P.J.; Wang, T.; Bai, J.; Ranalli, F.; Airey, R.J.; Hill, G. Effect of the AlGaN electron blocking layer thickness on the performance of AlGaN-based ultraviolet light-emitting diodes. J. Cryst. Growth 2009, 311, 2857–2859. [Google Scholar] [CrossRef]
- Kolbe, T.; Stellmach, J.; Mehnke, F.; Rothe, M.-A.; Küller, V.; Knauer, A.; Einfeldt, S.; Wernicke, T.; Weyers, M.; Kneissl, M. Effcient carrier-injection and electron-confinement in UV-B light-emitting diodes. Phys. Status Solidi A 2016, 213, 210–214. [Google Scholar] [CrossRef]
- Fan, X.; Sun, H.; Li, X.; Sun, H.; Zhang, C.; Zhang, Z.; Guo, Z. Efficiency improvements in AlGaN-based deep ultraviolet light-emitting diodes using inverted-V-shaped graded Al composition electron blocking layer. Superlattices Microstruct. 2015, 88, 467–473. [Google Scholar] [CrossRef]
- Yang, G.; Chang, J.; Wang, J.; Zhang, Q.; Xie, F.; Xue, J.; Yan, D.; Wang, F.; Chen, P.; Zhang, R.; et al. Performance enhancement of AlGaN-based ultraviolet light-emitting diodes by tailoring polarization in electron blocking layer. Superlattices Microstruct. 2015, 83, 1–8. [Google Scholar] [CrossRef]
- Zhang, Y.; Yu, L.; Li, K.; Pi, H.; Diao, J.; Wang, X.; Shen, Y.; Zhang, C.; Hu, W.; Song, W.; et al. The improvement of deep-ultraviolet light-emitting diodes with gradually decreasing Al content in AlGaN electron blocking layers. Superlattices Microstruct. 2015, 82, 151–157. [Google Scholar] [CrossRef]
- [-25]Kolbe, T.; Mehnke, F.; Guttmann, M.; Kuhn, C.; Rass, J.; Wernicke, T.; Kneissl, M. Improved injection efficiency in 290 nm light emitting diodes with Al(Ga)N electron blocking heterostructure. Appl. Phys. Lett. 2013, 103, 031109. [Google Scholar]
- Hirayama, H.; Tsukada, Y.; Maeda, T.; Kamata, N. Marked enhancement in the efficiency of deep-ultraviolet alGaN light-emitting diodes by using a multiquantum-barrier electron blocking layer. Appl. Phys. Express 2010, 3, 031002. [Google Scholar] [CrossRef]
- Tu, R.-C.; Tun, C.-J.; Pan, S.-M.; Chuo, C.-C.; Sheu, J.K.; Tsai, C.-E.; Wang, T.-C.; Chi, G.-C. Improvement of near-ultraviolet InGaN-GaN light-emitting diodes with an AlGaN electron-blocking layer grown at low temperature. IEEE Photonics Technol. Lett. 2003, 15, 1342–1344. [Google Scholar]
- SiLENSe Version 5.4 Laser Edition; STR Group, Inc.: Petersburg, Russia, 2013.
- Kaufmann, U.; Schlotter, P.; Obloh, H.; Köhler, K.; Maier, M. Hole conductivity and compensation in epitaxial GaN:Mg layers. Phys. Rev. B 2000, 62, 10867. [Google Scholar] [CrossRef]
- Leroux, M.; Vennegues, P.; Dalmasso, S.; Benaissa, M.; Feltin, E.; de Mierry, P.; Beaumont, B.; Damilano, B.; Grandjean, N.; Gibart, P. Structural defects and relation with optoelectronic properties in highly Mg-doped GaN. Phys. Status Solidi A 2002, 192, 394–400. [Google Scholar] [CrossRef]
- Zhang, J.C.; Zhu, Y.H.; Egawa, T.; Sumiya, S.; Miyoshi, M.; Tanaka, M. Suppression of the subband parasitic peak by 1 nm i-AlN interlayer in AlGaN deep ultraviolet light-emitting diodes. Appl. Phys. Lett. 2008, 93, 131117. [Google Scholar] [CrossRef]


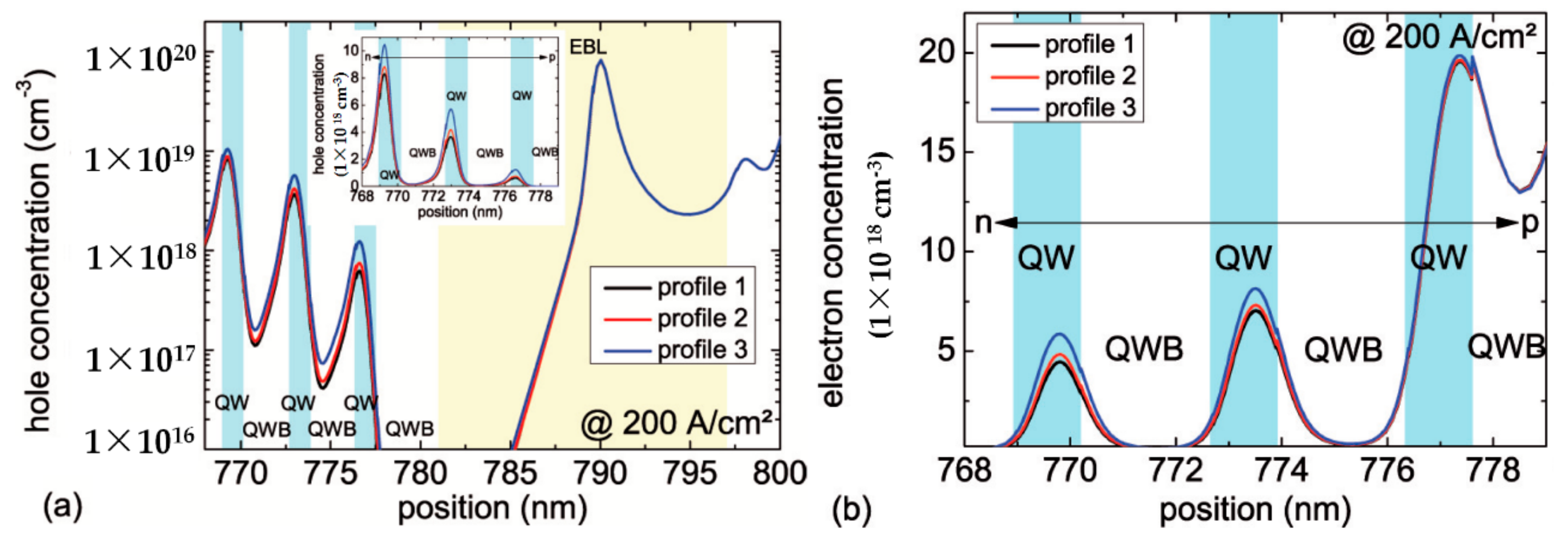

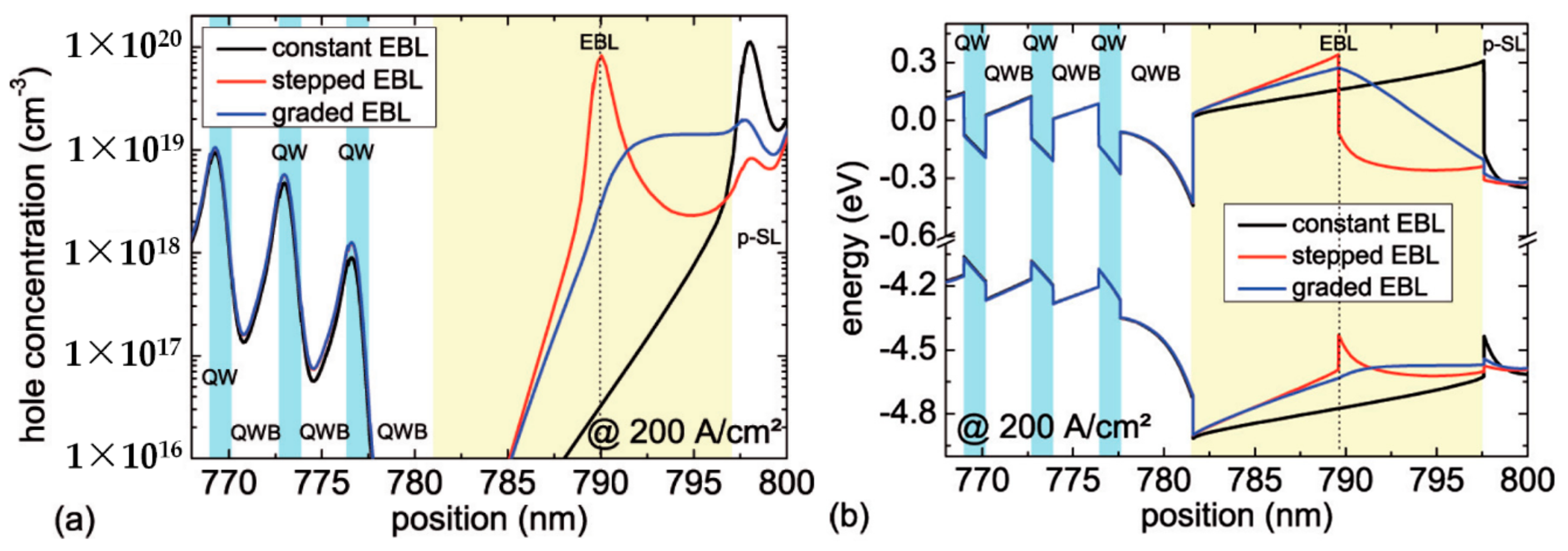
© 2017 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Kolbe, T.; Knauer, A.; Rass, J.; Cho, H.K.; Hagedorn, S.; Einfeldt, S.; Kneissl, M.; Weyers, M. Effect of Electron Blocking Layer Doping and Composition on the Performance of 310 nm Light Emitting Diodes. Materials 2017, 10, 1396. https://doi.org/10.3390/ma10121396
Kolbe T, Knauer A, Rass J, Cho HK, Hagedorn S, Einfeldt S, Kneissl M, Weyers M. Effect of Electron Blocking Layer Doping and Composition on the Performance of 310 nm Light Emitting Diodes. Materials. 2017; 10(12):1396. https://doi.org/10.3390/ma10121396
Chicago/Turabian StyleKolbe, Tim, Arne Knauer, Jens Rass, Hyun Kyong Cho, Sylvia Hagedorn, Sven Einfeldt, Michael Kneissl, and Markus Weyers. 2017. "Effect of Electron Blocking Layer Doping and Composition on the Performance of 310 nm Light Emitting Diodes" Materials 10, no. 12: 1396. https://doi.org/10.3390/ma10121396
APA StyleKolbe, T., Knauer, A., Rass, J., Cho, H. K., Hagedorn, S., Einfeldt, S., Kneissl, M., & Weyers, M. (2017). Effect of Electron Blocking Layer Doping and Composition on the Performance of 310 nm Light Emitting Diodes. Materials, 10(12), 1396. https://doi.org/10.3390/ma10121396



