Expanding the TM01-Mode MPCVD Reactor Based on Electromagnetic Mode Amplification for Potential 4-Inch Diamond Deposition
Abstract
1. Introduction
2. Electromagnetic Design and Optimization
2.1. Mode Analysis of the MPCVD Reaction Chamber
2.2. Mode Amplification and Design Optimization Criteria
3. Plasma Modeling and Numerical Implementation
3.1. Geometrical Model and Computational Domain
3.2. Mathematical Model and Numerical Implementation
4. Results and Analysis
4.1. Validity of the Plasma Modeling
4.2. Performance of the MPCVD Reactor in the Presence of Plasma
5. Conclusions
- The designed reactor can generate a 4-inch diameter plasma sphere, demonstrating significant potential for the deposition of 4-inch diamond films;
- Increasing the diameter of the reactor chamber improves the uniformity of the plasma sphere;
- The microwave in the proposed MPCVD reactor can maintain TM01 single-mode transmission with or without plasma;
- Slightly changing the diameter of the reactor chamber or the substrate height has no significant effect on plasma size, demonstrating that the proposed MPCVD reactor has good robustness.
Author Contributions
Funding
Data Availability Statement
Conflicts of Interest
References
- Inyushkin, A.V.; Taldenkov, A.N.; Ralchenko, V.G.; Bolshakov, A.P.; Koliadin, A.V.; Katrusha, A.N. Thermal conductivity of high purity synthetic single crystal diamonds. Phys. Rev. B 2018, 97, 144305. [Google Scholar] [CrossRef]
- Osipov, A.S.; Klimczyk, P.; Rutkowski, P.; Melniychuk, Y.A.; Romanko, L.O.; Podsiadlo, M.; Petrusha, I.A.; Jaworska, L. Diamond composites of high thermal conductivity and low dielectric loss tangent. Mater. Sci. Eng. B 2021, 269, 115171. [Google Scholar] [CrossRef]
- Zhang, Z.D.; Schneider, H.; Tounsi, P. A promising solution using CVD diamond for efficient cooling of power devices. Mater. Sci. Eng. B 2012, 177, 1358–1361. [Google Scholar] [CrossRef]
- Dang, C.Q.; Lu, A.L.; Wang, H.Y.; Zhang, H.T.; Lu, Y. Diamond Semiconductor and Elastic Strain Engineering. Int. J. Semicond. 2022, 43, 021801. [Google Scholar] [CrossRef]
- Lin, W.; Lv, X.Y.; Wang, Q.L.; Li, L.; Zou, G.T. Effect of growth rate on the incorporation of silicon impurity in single crystal diamond. Mater. Sci. Semicond. Process. 2024, 180, 108554. [Google Scholar] [CrossRef]
- Zhang, R. Diamond Based Materials and Nanostructures for Advanced Functional Applications. Ph.D. Thesis, University of Leicester, Leicester, UK, 2023. [Google Scholar]
- Arnault, J.C.; Saada, S.; Ralchenko, V. Chemical vapor deposition single-crystal diamond: A review. Phys. Status Solidi RRL 2022, 16, 2100354. [Google Scholar] [CrossRef]
- Donato, N.; Rouger, N.; Pernot, J.; Longobardi, G.; Udrea, F. Diamond power devices: State of the art, modelling, figures of merit and future perspective. J. Phys. D Appl. Phys. 2019, 53, 493001. [Google Scholar] [CrossRef]
- Mokuno, Y.; Chayahara, A.; Soda, Y.; Yamada, H.; Horino, Y.; Fujimori, N. High rate homoepitaxial growth of diamond by microwave plasma CVD with nitrogen addition. Diam. Relat. Mater. 2006, 15, 455–459. [Google Scholar] [CrossRef]
- Wang, Q.J.; Wu, G.; Liu, S.; Gan, Z.Y.; Yang, B.; Pan, J.H. Simulation-based development of a new cylindrical-cavity microwave plasma reactor for diamond film synthesis. Crystals 2019, 9, 320. [Google Scholar] [CrossRef]
- Ren, Y.; Li, X.G.; Lv, W.; Dong, H.Y.; Cheng, Q.H.; Yue, F.; Wöhrl, N.; Mendes, J.C.; Yang, X.; Li, Z.X. Recent progress in homoepitaxial single-crystal diamond growth via MPCVD. J. Mater. Sci. Mater. Electron. 2024, 35, 525. [Google Scholar] [CrossRef]
- Yamada, H.; Chayahara, A.; Mokuno, Y.; Shikata, S. Simulation with an improved plasma model utilized to design a new structure of microwave plasma discharge for chemical vapor deposition of diamond crystals. Diam. Relat. Mater. 2008, 17, 494–497. [Google Scholar] [CrossRef]
- Zhang, J.B.; Wang, J.P.; Zhang, G.Q.; Huo, Z.X.; Huang, Z.J. A review of diamond synthesis, modification technology, and cutting tool application in ultra-precision machining. Mater. Des. 2024, 237, 112577. [Google Scholar] [CrossRef]
- Misra, D.S. Nitrogen centers in single crystal diamond grown by chemical vapor deposition. J. Vac. Sci. Technol. A 2023, 41, 042703. [Google Scholar] [CrossRef]
- Liang, Q.; Yan, C.S.; Meng, Y.; Lai, J.; Krasnicki, S.; Mao, H.K.; Hemley, R.J. Recent advances in high-growth rate single-crystal CVD diamond. Diamond Relat. Mater. 2009, 18, 698–703. [Google Scholar] [CrossRef]
- Schwander, M.; Partes, K. A review of diamond synthesis by CVD processes. Diam. Relat. Mater. 2011, 20, 1287–1301. [Google Scholar] [CrossRef]
- Hemawan, K.W.; Hemley, R.J. Optical emission diagnostics of plasmas in chemical vapor deposition of single-crystal diamond. J. Vac. Sci. Technol. A 2015, 33, 061302. [Google Scholar] [CrossRef]
- An, K.; Yu, S.W.; Li, X.J.; Shen, Y.Y.; Zhou, B.; Zhang, G.J.; Liu, X.P. Microwave plasma reactor with conical-reflector for diamond deposition. Vacuum 2015, 117, 112–120. [Google Scholar] [CrossRef]
- Li, Y.F.; Su, J.J.; Liu, Y.Q.; Ding, M.H.; Li, X.L.; Wang, G.; Yao, P.L.; Tang, W.Z. Design of a new TM021 mode cavity type MPCVD reactor for diamond film deposition. Diam. Relat. Mater. 2014, 44, 88–94. [Google Scholar] [CrossRef]
- Sevillano, E.; Dischler, B.; Wild, C. Microwave-Plasma Deposition of Diamond; Springer: Berlin/Heidelberg, Germany, 1998. [Google Scholar]
- Silva, F.; Hassouni, K.; Bonnin, X.; Gicquel, A. Microwave engineering of plasma-assisted CVD reactors for diamond deposition. J. Phys. Condens. Matter 2009, 21, 364202. [Google Scholar] [CrossRef]
- Wang, B.S.; Yang, D.; Zhu, X.M.; Zhao, Y.; Wang, S.; Zhu, J.Q.; Zhai, M. Effect of positive bias and pressure on plasma flow characteristics in a chemical vapor deposition chamber. Processes 2022, 10, 2665. [Google Scholar] [CrossRef]
- Bachmann, P.K.; Messier, R. Emerging technology of diamond thin films. Chem. Eng. News 1989, 67, 24–39. [Google Scholar] [CrossRef]
- Füner, M.; Wild, C.; Koidl, P. Simulation and development of optimized microwave plasma reactors for diamond deposition. Surf. Coat. Technol. 1999, 116–119, 853–862. [Google Scholar] [CrossRef]
- Su, J.J.; Li, Y.F.; Ding, M.H.; Li, X.L.; Liu, Y.Q.; Wang, G.; Tang, W.Z. A dome-shaped cavity type microwave plasma chemical vapor deposition reactor for diamond films deposition. Vacuum 2014, 107, 51–55. [Google Scholar] [CrossRef]
- Su, J.J.; Li, Y.F.; Li, X.L.; Yao, P.L.; Liu, Y.Q.; Ding, M.H.; Tang, W.Z. A novel microwave plasma reactor with a unique structure for chemical vapor deposition of diamond films. Diam. Relat. Mater. 2014, 42, 28–32. [Google Scholar] [CrossRef]
- An, K.; Zhang, S.; Shao, S.W.; Liu, L.J.; Wei, J.J.; Chen, L.X.; Zheng, Y.T.; Liu, Q.; Li, C.M. Effects of the electric field at the edge of a substrate to deposit a Ø100 mm uniform diamond film in a 2.45 GHz MPCVD system. Plasma Sci. Technol. 2022, 24, 045502. [Google Scholar] [CrossRef]
- Weng, J.; Xiong, L.W.; Wang, J.H.; Dai, S.Y.; Man, W.D.; Liu, F. Investigation of depositing large area uniform diamond films in multi-mode MPCVD chamber. Diam. Relat. Mater. 2012, 30, 15–19. [Google Scholar] [CrossRef]
- Vikharev, A.L.; Gorbachev, A.M.; Lobaev, M.A.; Radishev, D.B. Multimode cavity type MPACVD reactor for large area diamond film deposition. Diam. Relat. Mater. 2018, 83, 8–14. [Google Scholar] [CrossRef]
- Gu, Y.; Lu, J.; Grotjohn, T.; Schuelke, T.; Asmussen, J. Microwave plasma reactor design for high pressure and high power density diamond synthesis. Diam. Relat. Mater. 2012, 24, 210–214. [Google Scholar] [CrossRef]
- Shao, J.; Cao, B.; Wu, X.; Sun, G.; Zhao, J.; Xu, S. The 4-inch free-standing diamond film prepared by MPCVD at 10kW. Funct. Diam. 2024, 4, 2356570. [Google Scholar] [CrossRef]
- Ma, T.; Fan, W.; Sang, H.; Zhang, Y. Study on the uniformity of diamond growth using a dual-substrate MPCVD reactor. Vacuum 2025, 237, 114141. [Google Scholar] [CrossRef]
- Liu, X.; Mu, C.; Wang, Q.; Liu, W.; Lv, X.; Li, L.; Zou, G. Demonstration of a novel high-power MPCVD reactor using combined TM01 and TM02 modes for efficient diamond growth. Vacuum 2025, 234, 114761. [Google Scholar] [CrossRef]
- Zhang, W.C.; Wu, L.; Zhou, Y.P.; Xu, Y.C.; Deng, J.; Yang, Z.Y.; Sun, H.R. Design of a capacity-enhanced single-mode reactor for microwave chemistry researches. Chem. Eng. J. 2022, 427, 131898. [Google Scholar] [CrossRef]
- Li, M.; Wu, X.; Han, D.X.; Peng, R.Y.; Yang, Y.; Wu, L.; Zhang, W.C. A high-efficiency single-mode traveling wave reactor for continuous flow processing. Processes 2022, 10, 1261. [Google Scholar] [CrossRef]
- Pozar, D.M. Microwave Engineering, 4th ed.; Wiley: Hoboken, NJ, USA, 2012. [Google Scholar]
- José, M.; Catalá, C.; Antoni, J.C.; Pedro, P.P.; José, D.G.; Beatriz, B.G.; Felipe, L.P.F. Measurement of dielectric properties of materials at high temperature during microwave heating in a dual mode cylindrical cavity. IEEE Trans. Microw. Theory Tech. 2015, 63, 2905–2914. [Google Scholar] [CrossRef]
- Hassouni, K.; Silva, F.; Gicquel, A. Modelling of diamond deposition microwave cavity generated plasmas. J. Phys. D Appl. Phys. 2010, 43, 153001. [Google Scholar] [CrossRef]
- Hjartarson, A.T.; Thorsteinsson, E.G.; Gudmundsson, J.T. Low pressure hydrogen discharges diluted with argon explored using a global model. Plasma Sources Sci. Technol. 2010, 19, 065008. [Google Scholar] [CrossRef]
- Obrusník, A.; Bonaventura, Z. Studying a low-pressure microwave coaxial discharge in hydrogen using a mixed 2D/3D fluid model. J. Phys. D Appl. Phys. 2015, 48, 065201. [Google Scholar] [CrossRef]
- Marques, L.; Jolly, J.; Alves, L.L. Capacitively coupled radio-frequency hydrogen discharges: The role of kinetics. J. Appl. Phys. 2007, 102, 063305. [Google Scholar] [CrossRef]
- IST-Lisbon Database. Available online: https://nl.lxcat.net/data/set_databases.php (accessed on 1 June 2024).
- Capitelli, M.; Ferreira, C.M.; Gordiets, B.F.; Osipov, A.I. Plasma Kinetics in Atmospheric Gases; Springer: Berlin/Heidelberg, Germany, 2000. [Google Scholar]
- Janev, R.K.; Langer, W.D.; Evans, K., Jr.; Post, D.E., Jr. Elementary Processes in Hydrogen-Helium Plasmas; Springer: Berlin/Heidelberg, Germany, 1987. [Google Scholar]
- Zhang, W.; Yang, Y.; Zhu, H.; Peng, X.; Tian, H.; Han, D.; Peng, R.; Wu, L.; Tian, W.; Tao, J. Design and optimization of a high-efficiency MPCVD reactor for 4-inch diamond film deposition based on steady-state multiphysics modeling. Diam. Relat. Mater. 2025, 157, 112446. [Google Scholar] [CrossRef]
- Yoon, J.S.; Song, M.Y.; Han, J.M.; Hwang, S.H.; Chang, W.S.; Lee, B.J.; Itikawa, Y. Cross sections for electron collisions with hydrogen molecules. J. Phys. Chem. Ref. Data 2008, 37, 913–931. [Google Scholar] [CrossRef]
- Available online: https://www.lxcat.net (accessed on 1 June 2024).
- Shi, N.K. Theory of Low-Temperature Plasma Physics; Springer: Cham, Switzerland, 2017. [Google Scholar]
- Gordon, S.; McBride, B.J. Computer Program for Calculation of Complex Chemical Equilibrium Compositions and Applications, Part 1: Analysis; NASA Lewis Research Center: Cleveland, OH, USA, 1994.
- Muehle, M.; Asmussen, J.; Becker, M.F.; Schuelke, T. Extending microwave plasma assisted CVD SCD growth to pressures of 400 Torr. Diam. Relat. Mater. 2017, 79, 150–163. [Google Scholar] [CrossRef]
- Yang, D.; Guo, L.; Wang, B.S.; Jin, S.; Zhu, J.Q.; Zhai, M. Hydrogen plasma characteristics in a microwave chemical vapor deposition chamber. Mater. Sci. Eng. B 2023, 292, 116422. [Google Scholar] [CrossRef]
- Butler, J.E.; Mankelevich, Y.A.; Cheesman, A.; Ma, J.; Ashfold, M.N.R. Understanding the chemical vapor deposition of diamond: Recent progress. J. Phys. Condens. Matter 2009, 21, 364201. [Google Scholar] [CrossRef]
- Zhongwen, H.E.; Zhibin, M.A. Preparation of polycrystalline diamond films by MPCVD at high plasma power density. Diam. Abras. Eng. 2022, 42, 156–161. [Google Scholar] [CrossRef]
- Li, Y.C.; Hao, X.B.; Dai, B.; Wen, D.Y.; Zhu, J.Q.; Geng, F.J.; Yue, W.P.; Lin, W.Q. Optimization design of MPCVD single crystal diamond growth based on plasma diagnostics. J. Inorg. Mater. 2023, 38, 1405–1412. [Google Scholar] [CrossRef]
- Bushuev, E.V.; Yurov, V.Y.; Bolshakov, A.P.; Ralchenko, V.G.; Khomich, A.A.; Antonova, I.A.; Ashkinazi, E.E.; Shershulin, V.A.; Pashinin, V.P.; Konov, V.I. Express in situ measurement of epitaxial CVD diamond film growth kinetics. Diam. Relat. Mater. 2017, 72, 61–70. [Google Scholar] [CrossRef]
- Mallika, K.; Komanduri, R. Low pressure microwave plasma assisted chemical vapor deposition (MPCVD) of diamond coatings on silicon nitride cutting tools. Thin Solid Film. 2001, 396, 146–166. [Google Scholar] [CrossRef]
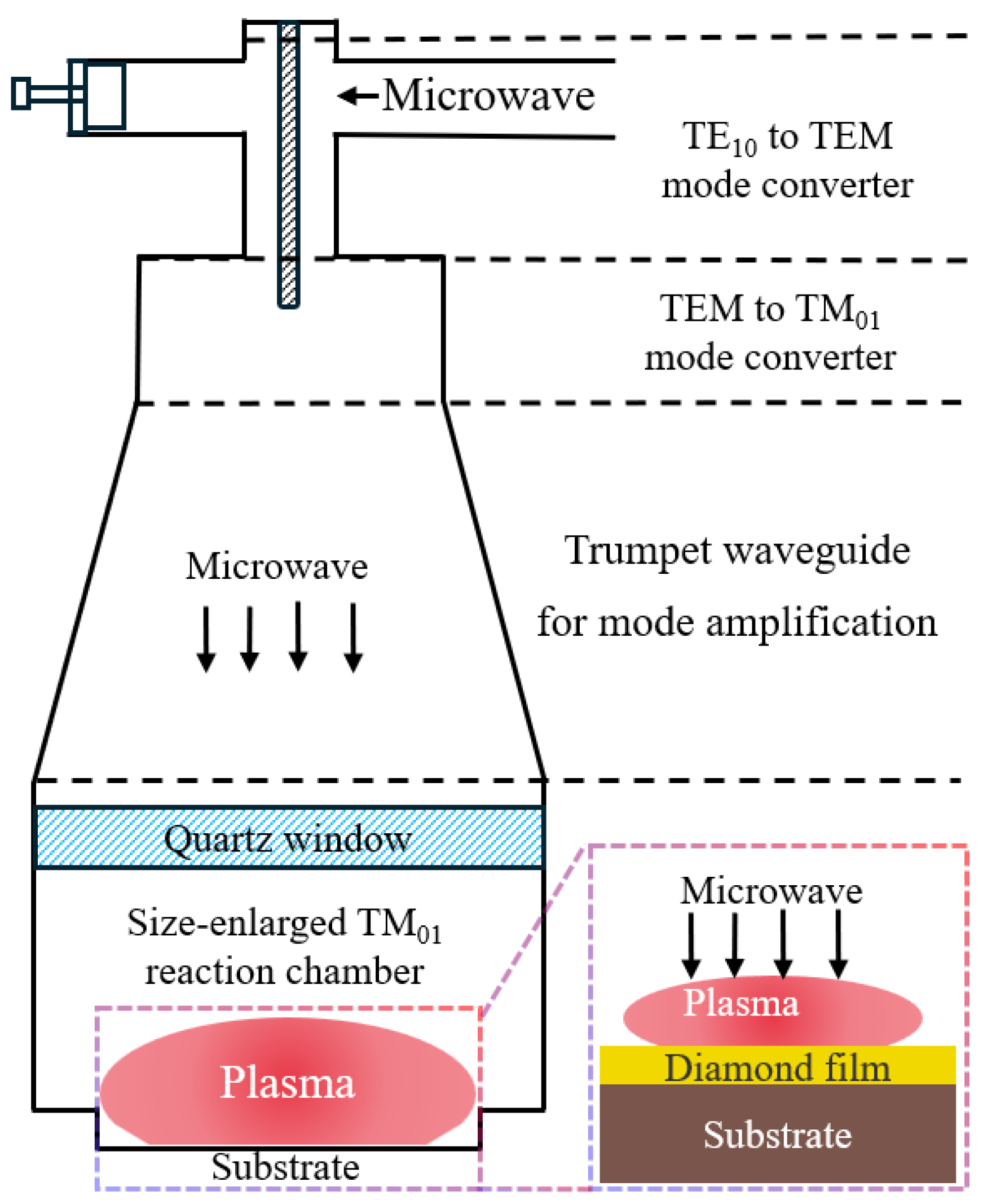


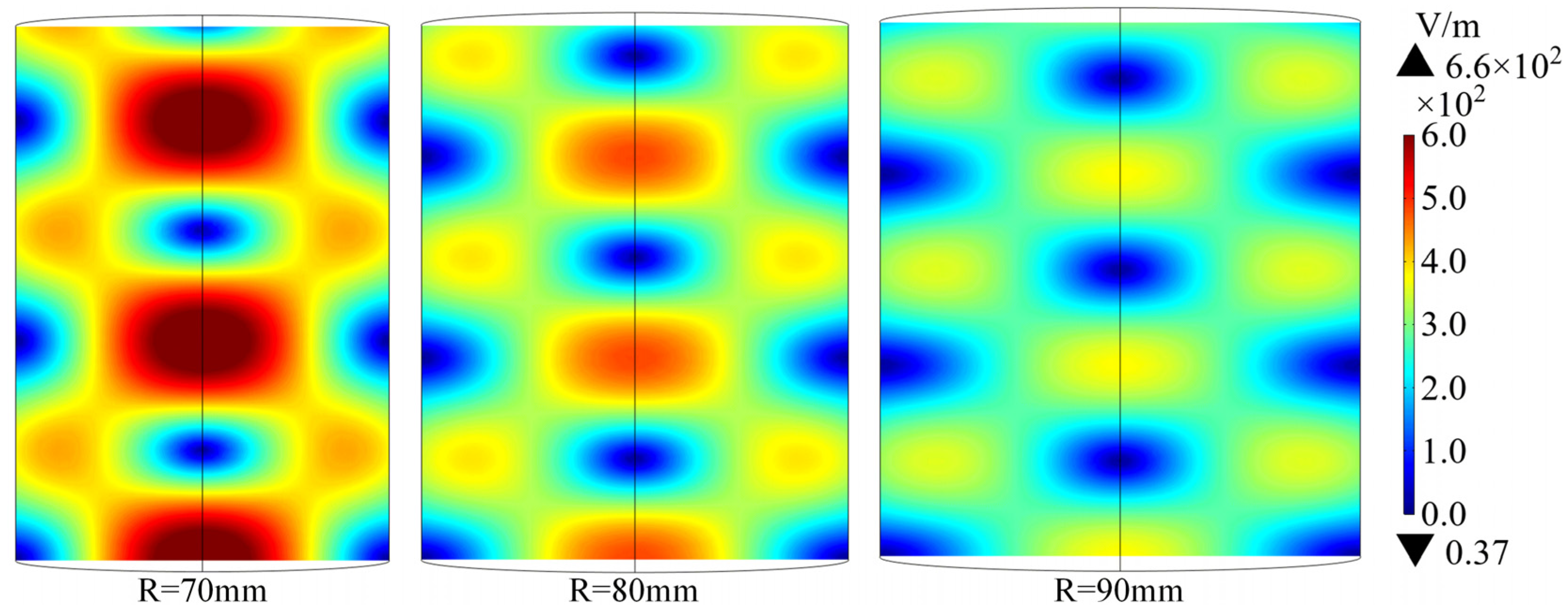




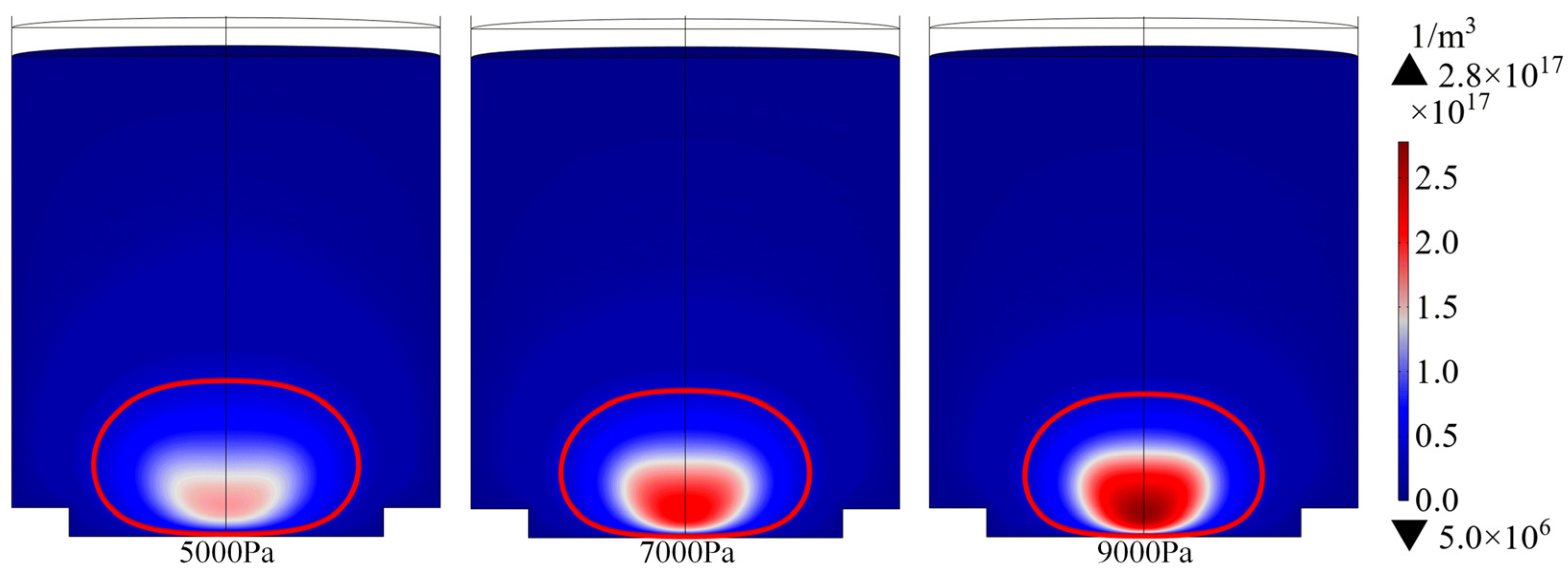




| Num | Electron-Impact Reaction | Reaction Type |
|---|---|---|
| 1 | e + H2 =>e + H2 | Elastic |
| 2 | e + H2 => e + H2 | Vibrational excitation |
| 3 | e + H2 => e + H2 | Vibrational excitation |
| 4 | E + H2=> e + H2 | Vibrational excitation |
| 5 | e + H2 => e + H + H | Dissociation |
| 6 | e + H2 => e + H + H | Dissociation |
| 7 | e + H2=> e + H + H | Dissociation |
| 8 | e + H2 =>e + H + H | Dissociation |
| 9 | e + H2=> e + H2 | Excitation |
| 10 | e + H2 => e + H2 | Excitation |
| 11 | e + H2 => e + H2 | Excitation |
| 12 | e + H2 => e + H2 | Excitation |
| 13 | e + H2 => e + H2 | Excitation |
| 14 | e + H2 => e + H2 | Excitation |
| 15 | e + H2 => e + H2 | Excitation |
| 16 | e + H2=> e + H + H(n = 2) | Dissociative excitation |
| 17 | e + H2 =>e + H + H(n = 2) | Dissociative excitation |
| 18 | e + H2=> e + H + H(n = 3) | Dissociative excitation |
| 19 | e + H2 => e + H + H | Ionization |
| 20 | e + H2 => e + H + H | Ionization |
| 21 | e + H2=> 2e + H2+ | Ionization |
| 22 | e + H2 => 2e + H + H+ | Ionization |
| 23 | e + H => e + H | Elastic |
| 24 | e + H => e + H(n = 2) | Excitation |
| 25 | e + H => e + H(n = 2) | Excitation |
| 26 | e + H => e + H(n = 3) | Charge transfer |
| 27 | e + H => e + H | Excitation |
| 28 | e + H => e + H | Excitation |
| 29 | e + H => 2e + H+ | Ionization |
| 30 | e + H3+ => 3H | Recombination |
| 31 | e + H3+ => H2 + H(n = 2) | Recombination |
| 32 | e + H2 + =>H + H(n = 2) | Recombination |
| 33 | e + H2 + =>H + H(n = 3) | Recombination |
| 34 | e + H+ => H(n = 2) | Recombination |
| 35 | e + H+ => H(n = 3) | Recombination |
| 36 | H(n = 2) + H2 => H3 + +e | Ionization |
| 37 | H(n = 3) + H2 => H3 + +e | Ionization |
| 38 | H2 + H2 + =>H3 + +H | Ionization |
| 39 | H2 + H2 => 2H + H2 | Dissociation |
| 40 | 2H + H2 => H2 + H2 | Association |
| 41 | H2 + H=>3H | Dissociation |
| 42 | 3H => H2 + H | Association |
| Num | Reaction | Sticking Coefficient |
|---|---|---|
| 1 | H => 0.5H2 | 0.02 |
| 2 | H(n = 2) => H | 1 |
| 3 | H(n = 3) => H | 1 |
| 4 | H+ => H | 1 |
| 5 | H2+ => H2 | 1 |
| 6 | H3+ => H2 + H | 1 |
| Num | Boundary Conditions | Equations | Boundary |
|---|---|---|---|
| 1 | Perfect conductor | B-C-D-E-O | |
| 2 | Wall | F-C-D-E-O | |
| 3 | Electric ground | F-C-D-E-O | |
| 4 | Dirichlet | F-C-D-E | |
| 5 | Dirichlet | E-O |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2026 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license.
Share and Cite
Yang, J.; Yang, Y.; Tang, P.; Shen, C.; Peng, X.; Tian, H.; Zhu, H.; Huang, Y.; Zhang, W. Expanding the TM01-Mode MPCVD Reactor Based on Electromagnetic Mode Amplification for Potential 4-Inch Diamond Deposition. Processes 2026, 14, 645. https://doi.org/10.3390/pr14040645
Yang J, Yang Y, Tang P, Shen C, Peng X, Tian H, Zhu H, Huang Y, Zhang W. Expanding the TM01-Mode MPCVD Reactor Based on Electromagnetic Mode Amplification for Potential 4-Inch Diamond Deposition. Processes. 2026; 14(4):645. https://doi.org/10.3390/pr14040645
Chicago/Turabian StyleYang, Jialiang, Yong Yang, Pan Tang, Chengshu Shen, Xiaoshan Peng, Hongxing Tian, Huacheng Zhu, Yuqing Huang, and Wencong Zhang. 2026. "Expanding the TM01-Mode MPCVD Reactor Based on Electromagnetic Mode Amplification for Potential 4-Inch Diamond Deposition" Processes 14, no. 4: 645. https://doi.org/10.3390/pr14040645
APA StyleYang, J., Yang, Y., Tang, P., Shen, C., Peng, X., Tian, H., Zhu, H., Huang, Y., & Zhang, W. (2026). Expanding the TM01-Mode MPCVD Reactor Based on Electromagnetic Mode Amplification for Potential 4-Inch Diamond Deposition. Processes, 14(4), 645. https://doi.org/10.3390/pr14040645








