Bonding Processing and 3D Integration of High-Performance Silicon PIN Detector for ΔE-E telescope
Abstract
1. Introduction
2. Silicon PIN Radiation Detector
ΔE-E telescope Structure
3. From Metal Bonding to Metal Aluminum Bonding
3.1. Native Oxide
3.2. Surface Roughness
3.3. Optimization of Intermediate Layer Materials
4. Fabrication of the Integrated Detector
5. Conclusions
Author Contributions
Funding
Data Availability Statement
Conflicts of Interest
References
- Shi, W.; Chen, H.; Zou, H.; Zou, J.; Tian, D.; Ning, B.; Zhang, L. The PIN detector parallel application. Nucl. Electron. Detect. Technol. 2007, 27, 908–910. [Google Scholar]
- Yu, B.; Zhao, K.; Yang, T.; Jiang, Y.; Fan, X.; Lu, M.; Han, J. Process effects on leakage current of Si-PIN neutron detectors with porous microstructure. Phys. Status Solidi (A) 2017, 214, 1600900. [Google Scholar] [CrossRef]
- Li, H.X.; Li, Z.K.; Wang, F.C.; Li, R.-H.; Chen, C.H.; Wang, X.H.; Rong, X.J.; Liu, F.Q.; Wang, Z.S.; Li, C.Y.; et al. Application of stratified implantation for silicon micro-strip detectors. Chin. Phys. C 2015, 39, 066005. [Google Scholar] [CrossRef]
- Abdel, N.S.; Pallon, J.; Ros, L.; Borysiuk, M.; Elfman, M.; Kristiansson, P.; Nilsson, E.C. Characterizations of new ΔE detectors for single-ion hit facility. Nucl. Instrum. Methods Phys. Res. Sect. B Beam Interact. Mater. At. 2014, 318, 281–286. [Google Scholar] [CrossRef]
- McClintock, R.; Yasan, A.; Mayes, K.; Shiell, D.; Darvish, S.R.; Kung, P.; Razeghi, M. High quantum efficiency AlGaN solar-blind pin photodiodes. Appl. Phys. Lett. 2004, 84, 1248–1250. [Google Scholar] [CrossRef]
- Wang, H.; Liu, J.; Niu, N.; Shen, G.; Zhang, S. Enhanced performance of p-GaN by Mg δ doping. J. Cryst. Growth 2007, 304, 7–10. [Google Scholar] [CrossRef]
- Zhu, Z.; Yu, M.; Jin, Y. Fabrication of integrated silicon PIN detector based on Al-Sn-Al bonding for ΔE-E telescope application. Microelectron. Eng. 2021, 247, 111599. [Google Scholar] [CrossRef]
- Tran, L.T.; Bolst, D.; Guatelli, S.; Biasi, G.; Fazzi, A.; Sagia, E.; Prokopovich, D.A.; Reinhard, M.I.; Keat, Y.C.; Petasecca, M.; et al. High spatial resolution microdosimetry with monolithic ΔE-E detector on 12C beam: Monte Carlo simulations and experiment. Nucl. Instrum. Methods Phys. Res. Sect. A Accel. Spectrometers Detect. Assoc. Equip. 2018, 887, 70–80. [Google Scholar] [CrossRef]
- Tudisco, S.; Amorini, F.; Cabibbo, M.; Cardella, G.; De Geronimo, G.; Di Pietro, A.; Fallica, G.; Figuera, P.; Musumarra, A.; Papa, M.; et al. A new large area monolithic silicon telescope. Nucl. Instrum. Methods Phys. Res. Sect. A Accel. Spectrometers Detect. Assoc. Equip. 1999, 426, 436–445. [Google Scholar] [CrossRef]
- Kostka, A.; Kalbitzer, S. Ion Implanted Buried Layers Applied for Nuclear Detector Telescopes. In Ion Implantation in Semiconductors; Springer: Boston, MA, USA, 1975; pp. 689–694. [Google Scholar]
- Thungström, G.; van Veldhuizen, E.J.; Westerberg, L.; Norlin, L.-O.; Petersson, C. Fabrication of an integrated ΔE-E-silicon detector by wafer bonding using cobalt disilicide. Nucl. Instrum. Methods Phys. Res. Sect. A Accel. Spectrometers Detect. Assoc. Equip. 1997, 391, 315–328. [Google Scholar] [CrossRef]
- Evensen, L.; Westgaard, T. Thin Detectors for the CHICSi {Delta} EE Telescope; IEEE Service Center: Piscataway, NJ, USA, 1996. [Google Scholar]
- Wang, S.; Yu, M.; Tian, D.; Liu, H.; Wang, P.; Shi, B.; Hu, A.; Du, H.; Wang, J.; Jin, Y. Fabrication and characterization of thin silicon PIN detectors. ECS Trans. 2014, 60, 1165. [Google Scholar] [CrossRef]
- Dong, X.; Yu, M.; Tian, D.; Wang, J.; Xiang, H.; Jin, Y. Fabrication of thin silicon PIN detector based on wafer bonding technology. ECS Trans. 2012, 44, 1413. [Google Scholar] [CrossRef]
- Fan, C.; Yu, M.; Yang, F.; Tian, D.; Wang, J.; Jin, Y. Research on Silicon PIN Neutron Dose Detector. ECS Trans. 2012, 44, 1401. [Google Scholar] [CrossRef]
- Zhang, Z.; Yu, M.; Zhu, Z.; Wang, H.; Huang, Y.; Jin, Y. Fabrication of 1.5 mm thickness silicon pin fast neutron detector with guard ring structure. In Proceedings of the 2016 China Semiconductor Technology International Conference (CSTIC), Shanghai, China, 13–14 March 2016; IEEE: Piscataway, NJ, USA, 2016; pp. 1–3. [Google Scholar]
- Hu, A.Q.; Yu, M.; Zhou, C.Z.; Fan, C.; Liu, C.C.; Wang, S.N.; Shi, B.H.; Qi, L.; Wang, J.Y.; Jin, Y.F. Bilateral PIN diode for fast neutron dose measurement. IEEE Trans. Nucl. Sci. 2014, 61, 1311–1315. [Google Scholar] [CrossRef]
- Topkar, A.; Singh, A.; Santra, S.; Mukhopadhyay, P.; Chatterjee, A.; Choudhury, R.; Pithawa, C. Development of integrated ΔE–E silicon detector telescope using silicon planar technology. Nucl. Instrum. Methods Phys. Res. Sect. A Accel. Spectrometers Detect. Assoc. Equip. 2011, 654, 330–335. [Google Scholar] [CrossRef]
- Kordyasz, A.J.; Kulczycka, E. Double sided strip monolithic silicon E–ΔE telescope produced by Quasi-Selective Epitaxy. Nucl. Instrum. Methods Phys. Res. Sect. A Accel. Spectrometers Detect. Assoc. Equip. 2008, 596, 131–133. [Google Scholar] [CrossRef]
- Xie, Z.; Wu, H.; Lao, Y.; Liu, C.; Cao, M. Metallic bonding technique and applications to optoelectronic devices. Laser & Optoelectronics Progress. 2007, 44, 31–37. [Google Scholar]
- Xu, C.; Xu, Y.; Yang, Y.; Yang, Z. Application of the Au/Sn Eutectic Bonding Technology in the Packaging of MEMS. Micronanoelectronic Technology. 2014, 51, 131–135. [Google Scholar] [CrossRef]
- Jaklevic, J.M.; Walton, J.T.; McMurray Jr, R.E.; Madden, N.W.; Goulding, F.S. Semiconductor detector performance for low-energy x-rays. Nucl. Instrum. Methods Phys. Res. Sect. A Accel. Spectrometers Detect. Assoc. Equip. 1988, 266, 598–601. [Google Scholar] [CrossRef]
- Cheng, C.; Xu, Y.; Liu, H. Reliability Analysis of Au-Al Bimetallic Bonding. Semicond. Technol. 2011, 36, 562–565. [Google Scholar]
- Yue, A.; Peng, K.; Zhou, L.; Zhu, J.; Li, D. The formation rule and controlling method of intermetallic compounds in Al/Cu bonding system. Materials Reports. 2013, 27, 117–120. [Google Scholar]
- Greenwood, J.S.; Williamson, J.B.P. Contact of nominally flat surfaces. Proc. R. Soc. London. Ser. A. Math. Phys. Sci. 1966, 295, 300–319. [Google Scholar]
- Froemel, J.; Baum, M.; Wiemer, M.; Roscher, F.; Haubold, M.; Jia, C.; Gessner, T. Investigations of thermocompression bonding with thin metal layers. In Proceedings of the 2011 16th International Solid-State Sensors, Actuators and Microsystems Conference, Beijing, China, 5–9 June 2011; IEEE: Piscataway, NJ, USA, 2011; pp. 990–993. [Google Scholar]
- Malik, N.; Schjølberg-Henriksen, K.; Poppe, E.U.; Taklo, M.M.V.; Finstad, T. Impact of SiO2 on Al–Al thermocompression wafer bonding. J. Micromechanics Microengineering 2015, 25, 035025. [Google Scholar] [CrossRef]
- Tong, Q.Y. Room temperature metal direct bonding. Appl. Phys. Lett. 2006, 89, 182101. [Google Scholar] [CrossRef]
- Kurashima, Y.; Maeda, A.; Takigawa, R.; Takagi, H. Room temperature wafer bonding of metal films using flattening by thermal imprint process. Microelectron. Eng. 2013, 112, 52–56. [Google Scholar] [CrossRef]
- Higurashi, E.; Imamura, T.; Suga, T.; Sawada, R. Low-temperature bonding of laser diode chips on silicon substrates using plasma activation of Au films. IEEE Photonics Technol. Lett. 2007, 19, 1994–1996. [Google Scholar] [CrossRef]
- Martin, J. Wafer capping of MEMS with fab-friendly metals. Reliab. Packag. Test. Charact. MEMS/MOEMS VI 2007, 6463, 204–209. [Google Scholar]
- Yun, C.H.; Martin, J.R.; Tarvin, E.B.; Winbigler, J.T. Al to Al wafer bonding for MEMS encapsulation and 3-D interconnect. In Proceedings of the 2008 IEEE 21st International Conference on Micro Electro Mechanical Systems, Tucson, AZ, USA, 13–17 January 2008; IEEE: Piscataway, NJ, USA, 2008; pp. 810–813. [Google Scholar]
- Dragoi, V.; Mittendorfer, G.; Burggraf, J.; Wimplinger, M. Metal thermocompression wafer bonding for 3D integration and MEMS applications. ECS Trans. 2010, 33, 27. [Google Scholar] [CrossRef]
- Malik, N.; Schjølberg-Henriksen, K.; Poppe, E.; Finstad, T.G. Al-Al thermocompression bonding for wafer-level MEMS packaging. In Proceedings of the 2013 Transducers & Eurosensors XXVII: The 17th international Conference on Solid-State Sensors, Actuators and Microsystems (TRANSDUCERS & EUROSENSORS XXVII), Barcelona, Spain, 16–20 June 2013; IEEE: Piscataway, NJ, USA, 2013; pp. 1067–1070. [Google Scholar]
- Malik, N.; Schjølberg-Henriksen, K.; Poppe, E.; Taklo, M.; Finstad, T. AlAl thermocompression bonding for wafer-level MEMS sealing. Sens. Actuators A Phys. 2014, 211, 115–120. [Google Scholar] [CrossRef]
- Rebhan, B.; Hinterreiter, A.; Malik, N.; Schjølberg-Henriksen, K.; Dragoi, V.; Hingerl, K. Low-temperature aluminum-aluminum wafer bonding. ECS Trans. 2016, 75, 15. [Google Scholar] [CrossRef]
- Schulze, S.; Vob, T.; Kruger, P.; Fraschke, M.; Kulse, P.; Wietstruck, M. Influence of Process Parameters on Surface Activated Aluminum-to-Aluminum Wafer Bonding. IEEE Trans. Compon. Packag. Manuf. Technol. 2022, 12, 578–586. [Google Scholar] [CrossRef]
- Hinterreiter, A.P.; Rebhan, B.; Flötgen, C.; Dragoi, V.; Hingerl, K. Surface pretreated low-temperature aluminum–aluminum wafer bonding. Microsyst. Technol. 2018, 24, 773–777. [Google Scholar] [CrossRef]
- Rebhan, B.; Wimplinger, M.; Hingerl, K. Impact factors on low temperature Cu-Cu wafer bonding. ECS Trans. 2014, 64, 369. [Google Scholar] [CrossRef]
- Panigrahi, A.K.; Bonam, S.; Ghosh, T.; Vanjari SR, K.; Singh, S.G. Low temperature, low pressure CMOS compatible Cu-Cu thermo-compression bonding with Ti passivation for 3D IC integration. In 2015 IEEE 65th Electronic Components and Technology Conference (ECTC); IEEE: Piscataway, NJ, USA, 2015; pp. 2205–2210. [Google Scholar]
- Rebhan, B.; Hingerl, K. Physical mechanisms of copper-copper wafer bonding. J. Appl. Phys. 2015, 118, 135301. [Google Scholar] [CrossRef]
- Leong, H.L.; Gan, C.L.; Thompson, C.V.; Pey, K.L.; Li, H.Y. Application of contact theory to metal-metal bonding of silicon wafers. J. Appl. Phys. 2007, 102, 103510. [Google Scholar] [CrossRef]
- Schulze, S.; Wietstruck, M.; Fraschke, M.; Kerepesi, P.; Kurz, H.; Rebhan, B.; Kaynak, M. Optimization of a BEOL aluminum deposition process enabling wafer level al-al thermo-compression bonding. In 2019 IEEE 69th Electronic Components and Technology Conference (ECTC); IEEE: Piscataway, NJ, USA, 2019; pp. 218–224. [Google Scholar]
- Taklo, M.V.; Schjolberg-Henriksen, K.; Malik, N.; Poppe, E.; Moe, S.T.; Finstad, T.G. Al-Al wafer-level thermocompression bonding applied for MEMS. In Proceedings of the 2017 5th International Workshop on Low Temperature Bonding for 3D Integration (LTB-3D), Tokyo, Japan, 16–18 May 2017; IEEE: Piscataway, NJ, USA, 2017; p. 11. [Google Scholar]
- Zhu, Z.; Xia, K.; Fu, J.; Du, C.; Zhang, H.; Lou, H.; Xu, Z. Bonding of aluminum coated silicon wafers based on polypropylene carbonate and as a multi-functional sensor. Org. Electron. 2018, 63, 296–299. [Google Scholar] [CrossRef]
- Lin, H.; Stevenson JT, M.; Gundlach, A.M.; Dunare, C.C.; Walton, A.J. Direct Al–Al contact using low temperature wafer bonding for integrating MEMS and CMOS devices. Microelectron. Eng. 2008, 85, 1059–1061. [Google Scholar] [CrossRef]
- Chang, J.; Lin, L. MEMS packaging technologies & applications. In Proceedings of the 2010 International Symposium on VLSI Design, Automation and Test, Hsinchu, Taiwan, 26–29 April 2010; IEEE: Piscataway, NJ, USA, 2010; pp. 126–129. [Google Scholar]
- Zhu, Z.; Yu, M.; Jin, Y. Investigations of silicon wafer bonding utilizing sputtered Al and Sn films. Microsyst. Technol. 2017, 23, 929–933. [Google Scholar] [CrossRef]
- Satoh, S.; Fukushi, H.; Esashi, M.; Tanaka, S. Role of Thin Sn Layer for Low Temperature Al-Al Thermo-compression Bonding of Wafer-Level Hermetic Sealing. Electron. Commun. Jpn. 2018, 101, 33–40. [Google Scholar] [CrossRef]
- Zhu, Z.; Yu, M.; Tian, D.; Zhu, Y.; Wang, P.; Liu, C.; Wang, W.; Miao, M.; Chen, J.; Jin, Y. Aluminum-coated silicon wafer bonding with tin intermediate layer. J. Micro/Nanolithography MEMS MOEMS 2013, 12, 013012. [Google Scholar] [CrossRef]
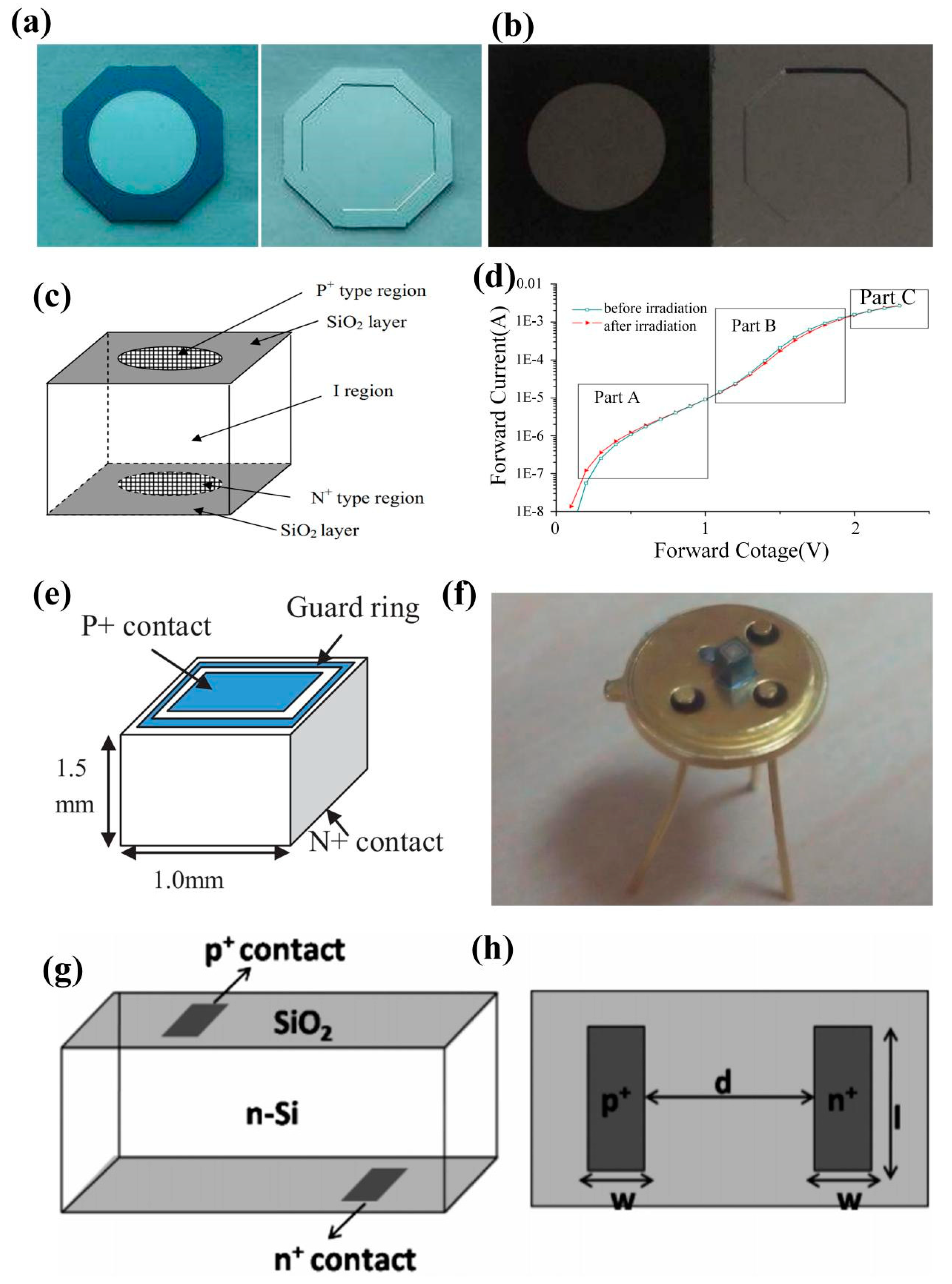






Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Zhu, Z.; Pu, M.; Jiang, M.; Zhang, S.; Yu, M. Bonding Processing and 3D Integration of High-Performance Silicon PIN Detector for ΔE-E telescope. Processes 2023, 11, 627. https://doi.org/10.3390/pr11020627
Zhu Z, Pu M, Jiang M, Zhang S, Yu M. Bonding Processing and 3D Integration of High-Performance Silicon PIN Detector for ΔE-E telescope. Processes. 2023; 11(2):627. https://doi.org/10.3390/pr11020627
Chicago/Turabian StyleZhu, Zhiyuan, Maoqiu Pu, Min Jiang, Sixiang Zhang, and Min Yu. 2023. "Bonding Processing and 3D Integration of High-Performance Silicon PIN Detector for ΔE-E telescope" Processes 11, no. 2: 627. https://doi.org/10.3390/pr11020627
APA StyleZhu, Z., Pu, M., Jiang, M., Zhang, S., & Yu, M. (2023). Bonding Processing and 3D Integration of High-Performance Silicon PIN Detector for ΔE-E telescope. Processes, 11(2), 627. https://doi.org/10.3390/pr11020627





