Simulation of a Steep-Slope p- and n-Type HfS2/MoTe2 Field-Effect Transistor with the Hybrid Transport Mechanism
Abstract
1. Introduction
2. Computational Methods
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Data Availability Statement
Conflicts of Interest
References
- International Roadmap for Devices and Systems (IRDSTM) 2020 Edition. 2020. Available online: https://irds.ieee.org/editions/2020 (accessed on 9 September 2021).
- Roy, K.; Mukhopadhyay, S.; Mahmoodi-Meimand, H. Leakage current mechanisms and leakage reduction techniques in deep-submicrometer CMOS circuits. Proc. IEEE 2003, 91, 305–327. [Google Scholar] [CrossRef]
- Skotnicki, T.; Hutchby, J.A.; King, T.J.; Wong, H.S.P.; Boeuf, F. The end of CMOS scaling: Toward the introduction of new materials and structural changes to improve MOSFET performance. IEEE Circuits Devices Mag. 2005, 21, 16. [Google Scholar]
- Novoselov, K.S.; Geim, A.K.; Morozov, S.V.; Jiang, D.; Zhang, Y.; Dubonos, S.V.; Grigorieva, I.V.; Firsov, A.A. Electric field effect in atomically thin carbon films. Science 2004, 306, 666–669. [Google Scholar] [CrossRef] [PubMed]
- Tan, C.L.; Cao, X.H.; Wu, X.J.; He, Q.Y.; Yang, J.; Zhang, X.; Chen, J.Z.; Zhao, W.; Han, S.K.; Nam, G.H. Recent Advances in Ultrathin Two-Dimensional Nanomaterials. Chem. Rev. 2017, 117, 6225–6331. [Google Scholar] [CrossRef]
- Zhou, W.H.; Qu, H.; Guo, S.; Cai, B.; Chen, H.; Wu, Z.; Zeng, H.; Zhang, S. Dependence of Tunneling Mechanism on Two-Dimensional Material Parameters: A High-Throughput Study. Phys. Rev. Appl. 2022, 17, 046053. [Google Scholar] [CrossRef]
- Novoselov, K.S.; Mishchenko, A.; Carvalho, A.; Neto, A.H.C. 2D materials and van der Waals heterostructures. Science 2016, 353, aac9439. [Google Scholar] [CrossRef] [PubMed]
- Jariwala, D.; Marks, T.J.; Hersam, M.C. Mixed-dimensional van der Waals heterostructures. Nat. Mater. 2017, 16, 170–181. [Google Scholar] [CrossRef]
- Liu, Y.; Duan, X.D.; Shin, H.J.; Park, S.; Huang, Y.; Duan, X.F. Promises and prospects of two-dimensional transistors. Nature 2021, 591, 43–53. [Google Scholar] [CrossRef]
- Liu, Y.; Guo, J.; Zhu, E.B.; Liao, L.; Lee, S.J.; Ding, M.N.; Shakir, I.; Gambin, V.; Huang, Y.; Duan, X.F. Approaching the Schottky-Mott limit in van der Waals metal-semiconductor junctions. Nature 2018, 557, 696–700. [Google Scholar] [PubMed]
- Liu, Y.; Weiss, N.O.; Duan, X.D.; Cheng, H.C.; Huang, Y.; Duan, X.F. Van der Waals heterostructures and devices. Nat. Rev. Mater. 2016, 1, 17. [Google Scholar] [CrossRef]
- Fiori, G.; Bonaccorso, F.; Iannaccone, G.; Palacios, T.; Neumaier, D.; Seabaugh, A.; Banerjee, S.K.; Colombo, L. Electronics based on two-dimensional materials. Nat. Nanotechnol. 2014, 9, 779. [Google Scholar] [CrossRef]
- Lyu, J.; Pei, J.; Guo, Y.Z.; Gong, J.; Li, H.L. A New Opportunity for 2D van der Waals Heterostructures: Making Steep—Slope Transistors. Adv. Mater. 2020, 32, 1906000. [Google Scholar] [CrossRef] [PubMed]
- Qiu, C.G.; Liu, F.; Xu, L.; Deng, B.; Xiao, M.M.; Si, J.; Li, L.; Zhang, Z.Y.; Wang, J.; Guo, H.; et al. Dirac-source field-effect transistors as energy-efficient, high-performance electronic switches. Science 2018, 361, 387. [Google Scholar] [CrossRef] [PubMed]
- Lin, Y.F.; Xu, Y.; Wang, S.T.; Li, S.L.; Yamamoto, M.; Aparecido-Ferreira, A.; Li, W.W.; Sun, H.B.; Nakaharai, S.; Jian, W.B.; et al. Ambipolar MoTe2 Transistors and Their Applications in Logic Circuits. Adv. Mater. 2014, 26, 3263–3269. [Google Scholar] [CrossRef] [PubMed]
- Sirota, B.; Glavin, N.; Krylyuk, S.; Davydov, A.V.; Voevodin, A.A. Hexagonal MoTe2 with amorphous BN passivation layer for improved oxidation resistance and endurance of 2D field effect transistors. Sci. Rep. 2018, 8, 8668. [Google Scholar] [CrossRef]
- Li, Q.; Yang, J.; Li, Q.H.; Liu, S.Q.; Xu, L.Q.; Yang, C.; Xu, L.; Li, Y.; Sun, X.T.; Yang, J.B.; et al. Sub-5 nm Gate Length Monolayer MoTe2 Transistors. J. Phys. Chem. C 2021, 125, 19394. [Google Scholar] [CrossRef]
- Xu, X.; Pan, Y.; Liu, S.; Han, B.; Gu, P.; Li, S.; Xu, W.; Peng, Y.; Han, Z.; Chen, J.; et al. Seeded 2D epitaxy of large-area single-crystal films of the van der Waals semiconductor 2H MoTe2. Science 2021, 372, 195. [Google Scholar] [CrossRef] [PubMed]
- Liu, F.; Wang, J.; Guo, H. Atomistic simulations of device physics in monolayer transition metal dichalcogenide tunneling transistors. IEEE Trans. Electron Devices 2016, 63, 311–317. [Google Scholar] [CrossRef]
- Chang, J.; Register, L.F.; Banerjee, S.K. Ballistic performance comparison of monolayer transition metal dichalcogenide MX2 (M = Mo, W; X = S, Se, Te) metal-oxide-semiconductor field effect transistors. J. Appl. Phys. 2014, 115, 084506. [Google Scholar] [CrossRef]
- Gong, C.; Zhang, H.J.; Wang, W.H.; Colombo, L.; Wallace, R.M.; Cho, K.J. Band alignment of two-dimensional transition metal dichalcogenides: Application in tunnel field effect transistors. Appl. Phys. Lett. 2013, 103, 053513. [Google Scholar] [CrossRef]
- Lam, K.T.; Cao, X.; Guo, J. Device performance of heterojunction tunneling field-effect transistors based on transition metal dichalcogenide monolayer. IEEE Electron Device Lett. 2013, 34, 1331–1333. [Google Scholar] [CrossRef]
- Larentis, S.; Fallahazad, B.; Movva, H.C.P.; Kim, K.; Rai, A.; Taniguchi, T.; Watanabe, K.; Banerjee, S.K.; Tutuc, E. Reconfigurable complementary monolayer MoTe2 field-effect transistors for integrated circuits. ACS Nano 2017, 11, 4832. [Google Scholar] [CrossRef] [PubMed]
- Brandbyge, M.; Mozos, J.L.; Ordejon, P.; Taylor, J.; Stokbro, K. Density-functional method for nonequilibrium electron transport. Phys. Rev. B 2002, 65, 165401. [Google Scholar] [CrossRef]
- Atomistix ToolKit Version 2021, QuantumWise A/S. Available online: www.quantumwise.com (accessed on 1 January 2020).
- Burke, K.; Ernzerhof, M. Generalized Gradient Approximation Made Simple. Phys. Rev. Lett. 1996, 77, 3865. [Google Scholar]
- Kresse, G.; Joubert, D. From ultrasoft pseudopotentials to the projector augmented-wave method. Phys. Rev. B 1999, 59, 1758–1775. [Google Scholar] [CrossRef]
- Kresse, G.; Furthmiiller, J. Efficiency of ab-initio total energy calculations for metals and semiconductors using a plane-wave basis set. Comp. Mater. Sci. 1996, 6, 15. [Google Scholar] [CrossRef]
- Blochl, P.E. Projector augmented-wave method. Phys. Rev. B 1994, 50, 17953–17979. [Google Scholar] [CrossRef]
- Bardeen, J.; Shockley, W. Deformation potentials and mobilities in non-polar crystals. Phys. Rev. 1950, 80, 72–80. [Google Scholar] [CrossRef]
- Chen, J.; Xi, J.; Wang, D.; Shuai, Z. Carrier mobility in graphyne should be even larger than that in graphene: A theoretical prediction. J. Phys. Chem. lett. 2013, 4, 1443–1448. [Google Scholar] [CrossRef]
- Dai, J.; Zeng, X.C. Titanium trisulfide monolayer: Theoretical prediction of a new directgap semiconductor with high and anisotropic carrier mobility. Angew. Chem. Int. Edit. 2015, 54, 7572–7576. [Google Scholar] [CrossRef]
- Zhang, S.L.; Xie, M.Q.; Li, F.Y.; Yan, Z.; Li, Y.F.; Kan, E.J.; Liu, W.; Chen, Z.F.; Zeng, H. Semiconducting group 15 monolayers: A broad range of band gaps and high carrier mobilities. Angew. Chem. Int. Edit. 2016, 55, 1666–1669. [Google Scholar] [CrossRef] [PubMed]
- Hai, F.L.; Shu, Q.Z.; Zhi, R.L. Mobility anisotropy of two-dimensional semiconductors. Phys. Rev. B 2016, 94, 235306. [Google Scholar]
- Ashima, R.; Nityasagar, J.; Dimple Abir, D.S. A comprehensive study in carrier mobility and artificial photosynthetic properties in Group VI B transition metal dichalcogenide monolayers. J. Mater. Chem. A 2018, 6, 8693. [Google Scholar]
- Datta, S. Electronic Transport in Mesoscopic Systems; Cambridge University Press: Cambridge, UK, 1995. [Google Scholar]
- Kim, W.Y.; Kim, K.S. Carbon nanotube, graphene, nanowire, and molecule-based electron and spin transport phenomena using the nonequilibrium Green’s function method at the level of first principles theory. J. Comput. Chem. 2008, 29, 1073. [Google Scholar] [CrossRef]
- Sanvito, S.; Lambert, C.J.; Jefferson, J.H.; Bratkovsky, A.M. General Green’s-function formalism for transport calculations with spd Hamiltonians and giant magnetoresistance in Co- and Ni-based magnetic multilayers. Phys. Rev. B 1999, 59, 11936. [Google Scholar] [CrossRef]


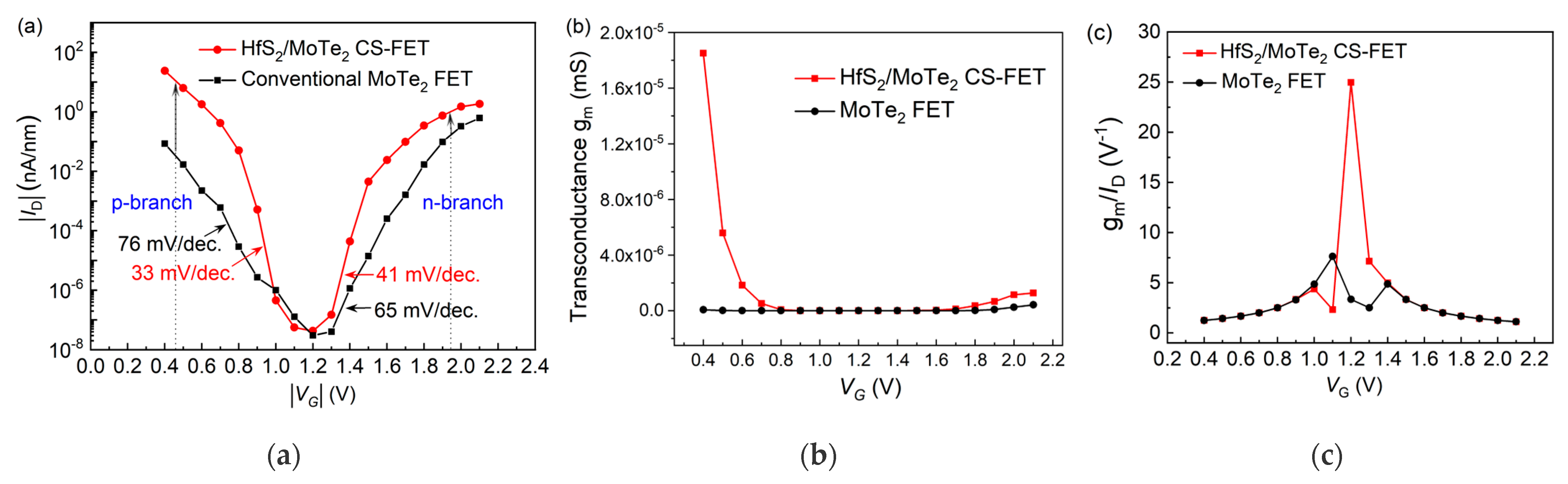

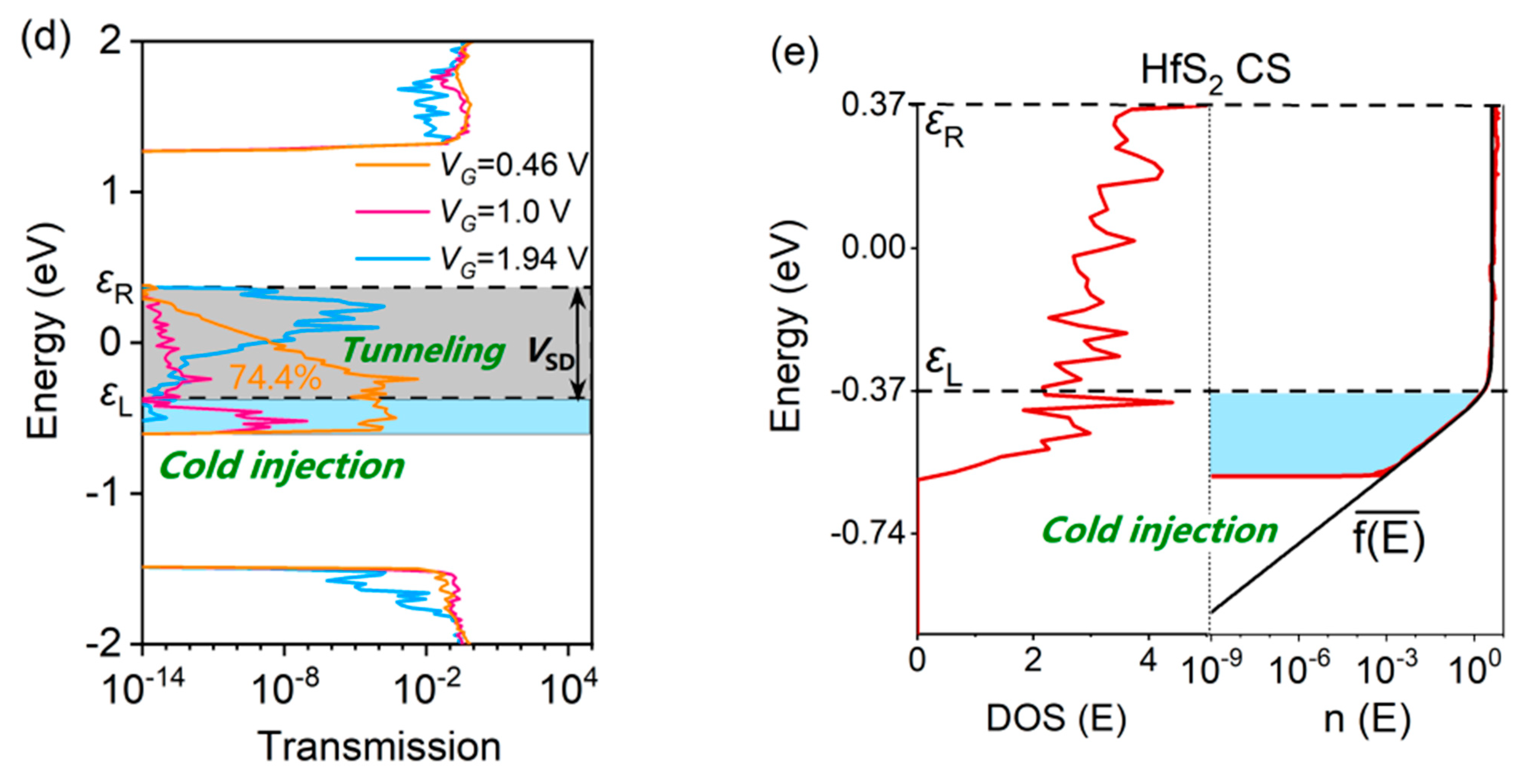
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Lyu, J.; Gong, J. Simulation of a Steep-Slope p- and n-Type HfS2/MoTe2 Field-Effect Transistor with the Hybrid Transport Mechanism. Nanomaterials 2023, 13, 649. https://doi.org/10.3390/nano13040649
Lyu J, Gong J. Simulation of a Steep-Slope p- and n-Type HfS2/MoTe2 Field-Effect Transistor with the Hybrid Transport Mechanism. Nanomaterials. 2023; 13(4):649. https://doi.org/10.3390/nano13040649
Chicago/Turabian StyleLyu, Juan, and Jian Gong. 2023. "Simulation of a Steep-Slope p- and n-Type HfS2/MoTe2 Field-Effect Transistor with the Hybrid Transport Mechanism" Nanomaterials 13, no. 4: 649. https://doi.org/10.3390/nano13040649
APA StyleLyu, J., & Gong, J. (2023). Simulation of a Steep-Slope p- and n-Type HfS2/MoTe2 Field-Effect Transistor with the Hybrid Transport Mechanism. Nanomaterials, 13(4), 649. https://doi.org/10.3390/nano13040649




