Investigation into SiO2 Etching Characteristics Using Fluorocarbon Capacitively Coupled Plasmas: Etching with Radical/Ion Flux-Controlled
Abstract
1. Introduction
2. Materials and Methods
3. Results and Discussion
3.1. Fluorocarbon to Argon Gas Ratio Variations
3.2. Effects of Extended Pulse-Off Time in the Neutral-Rare Condition
3.3. Effects of Enhanced Neutral to Ion Flux Ratio in the Neutral-Rich Condition
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Kim, Y.; Lee, S.; Jung, T.; Lee, B.; Kwak, N.; Park, S. Challenges in High-Aspect Ratio Contact (HARC) Etching for DRAM Capacitor Formation. Adv. Etch Technol. Nanopatterning IV 2015, 9428, 942806. [Google Scholar] [CrossRef]
- Ishikawa, K.; Karahashi, K.; Ishijima, T.; Cho, S.I.; Elliott, S.; Hausmann, D.; Mocuta, D.; Wilson, A.; Kinoshita, K. Progress in Nanoscale Dry Processes for Fabrication of High-Aspect-Ratio Features: How Can We Control Critical Dimension Uniformity at the Bottom? Jpn. J. Appl. Phys. 2018, 57, 06JA01. [Google Scholar] [CrossRef]
- Lee, J.-K.; Jang, I.-Y.; Lee, S.-H.; Kim, C.-K.; Moon, S.H. Mechanism of Sidewall Necking and Bowing in the Plasma Etching of High Aspect-Ratio Contact Holes. J. Electrochem. Soc. 2010, 157, D142. [Google Scholar] [CrossRef]
- Wang, M.; Kushner, M.J. High Energy Electron Fluxes in Dc-Augmented Capacitively Coupled Plasmas. II. Effects on Twisting in High Aspect Ratio Etching of Dielectrics. J. Appl. Phys. 2010, 107, 023309. [Google Scholar] [CrossRef]
- Daniel, L.; Traub, L.W. Effect of Aspect Ratio on Gurney-Flap Performance. J. Aircr. 2013, 50, 1217–1225. [Google Scholar] [CrossRef]
- Matsui, J.; Nakano, N.; Petrović, Z.L.; Makabe, T. The Effect of Topographical Local Charging on the Etching of Deep-Submicron Structures in SiO2 as a Function of Aspect Ratio. Appl. Phys. Lett. 2001, 78, 883–885. [Google Scholar] [CrossRef]
- Samukawa, S.; Ohtake, H.; Mieno, T. Pulse-Time-Modulated ECR Plasma Discharge for Highly Selective, Highly Anisotropic and Charge-Free Etching. NEC Res. Dev. 1996, 37, 179–190. [Google Scholar]
- Gottscho, R.A. Microscopic Uniformity in Plasma Etching. J. Vac. Sci. Technol. B Microelectron. Nanometer Struct. 1992, 10, 2133. [Google Scholar] [CrossRef]
- Bates, R.L.; Goeckner, M.J.; Overzet, L.J. Correction of Aspect Ratio Dependent Etch Disparities. J. Vac. Sci. Technol. A Vac. Surf. Film. 2014, 32, 051302. [Google Scholar] [CrossRef]
- Wu, B.; Kumar, A.; Pamarthy, S. High Aspect Ratio Silicon Etch: A Review. J. Appl. Phys. 2010, 108, 051101. [Google Scholar] [CrossRef]
- Rangelow, I.W. Critical Tasks in High Aspect Ratio Silicon Dry Etching for Microelectromechanical Systems. J. Vac. Sci. Technol. A Vac. Surf. Film. 2003, 21, 1550–1562. [Google Scholar] [CrossRef]
- Huard, C.M.; Zhang, Y.; Sriraman, S.; Paterson, A.; Kushner, M.J. Role of Neutral Transport in Aspect Ratio Dependent Plasma Etching of Three-Dimensional Features. J. Vac. Sci. Technol. A Vac. Surf. Film. 2017, 35, 05C301. [Google Scholar] [CrossRef]
- Huang, S.; Huard, C.; Shim, S.; Nam, S.K.; Song, I.-C.; Lu, S.; Kushner, M.J. Plasma Etching of High Aspect Ratio Features in SiO2 Using Ar/C4F8/O2 Mixtures: A Computational Investigation. J. Vac. Sci. Technol. A 2019, 37, 031304. [Google Scholar] [CrossRef]
- Cho, C.; You, K.; Kim, S.; Lee, Y.; Lee, J.; You, S. Characterization of SiO2 Etching Profiles in Pulse-Modulated Capacitively Coupled Plasmas. Materials 2021, 14, 5036. [Google Scholar] [CrossRef] [PubMed]
- Ono, K.; Tuda, M. Dynamics of Plasma-Surface Interactions and Feature Profile Evolution during Pulsed Plasma Etching. Thin Solid Films 2000, 374, 208–216. [Google Scholar] [CrossRef]
- Cho, C.; Kim, S.; Lee, Y.; Jeong, W.; Seong, I.; Lee, J.; Choi, M.; You, Y.; Lee, S.; Lee, J.; et al. Refined Appearance Potential Mass Spectrometry for High Precision Radical Density Quantification in Plasma. Sensors 2022, 22, 6589. [Google Scholar] [CrossRef]
- Kim, J.H.; Seong, D.J.; Lim, J.Y.; Chung, K.H. Plasma Frequency Measurements for Absolute Plasma Density by Means of Wave Cutoff Method. Appl. Phys. Lett. 2003, 83, 4725–4727. [Google Scholar] [CrossRef]
- Kim, J.H.; Choi, S.C.; Shin, Y.H.; Chung, K.H. Wave Cutoff Method to Measure Absolute Electron Density in Cold Plasma. Rev. Sci. Instrum. 2004, 75, 2706–2710. [Google Scholar] [CrossRef]
- Kim, D.W.; You, S.J.; Na, B.K.; Kim, J.H.; Chang, H.Y. An Analysis on Transmission Microwave Frequency Spectrum of Cut-off Probe. Appl. Phys. Lett. 2011, 99, 131502. [Google Scholar] [CrossRef]
- Kim, S.J.; Lee, J.J.; Lee, Y.S.; Kim, D.W.; You, S.J. Effect of an Inhomogeneous Electron Density Profile on the Transmission Microwave Frequency Spectrum of the Cutoff Probe. Plasma Sources Sci. Technol. 2020, 29, 125014. [Google Scholar] [CrossRef]
- Lieberman, M.A.; Lichtenberg, A.J. Principles of Plasma Discharges and Materials; John Wiley & Sons: Hoboken, NJ, USA, 1994; ISBN 9786468600. [Google Scholar]
- Schaepkens, M.; Oehrlein, G.S. A Review of SiO2 Etching Studies in Inductively Coupled Fluorocarbon Plasmas. J. Electrochem. Soc. 2001, 148, C211. [Google Scholar] [CrossRef]
- Chang, W.S.; Yook, Y.G.; You, H.S.; Park, J.H.; Kwon, D.C.; Song, M.Y.; Yoon, J.S.; Kim, D.W.; You, S.J.; Yu, D.H.; et al. A Unified Semi-Global Surface Reaction Model of Polymer Deposition and SiO2 Etching in Fluorocarbon Plasma. Appl. Surf. Sci. 2020, 515, 145975. [Google Scholar] [CrossRef]
- Hebner, G.A.; Fleddermann, C.B. Characterization of Pulse-Modulated Inductively Coupled Plasmas in Argon and Chlorine. J. Appl. Phys. 1997, 82, 2814–2821. [Google Scholar] [CrossRef]
- Economou, D.J. Pulsed Plasma Etching for Semiconductor Manufacturing. J. Phys. D Appl. Phys. 2014, 47, 303001. [Google Scholar] [CrossRef]
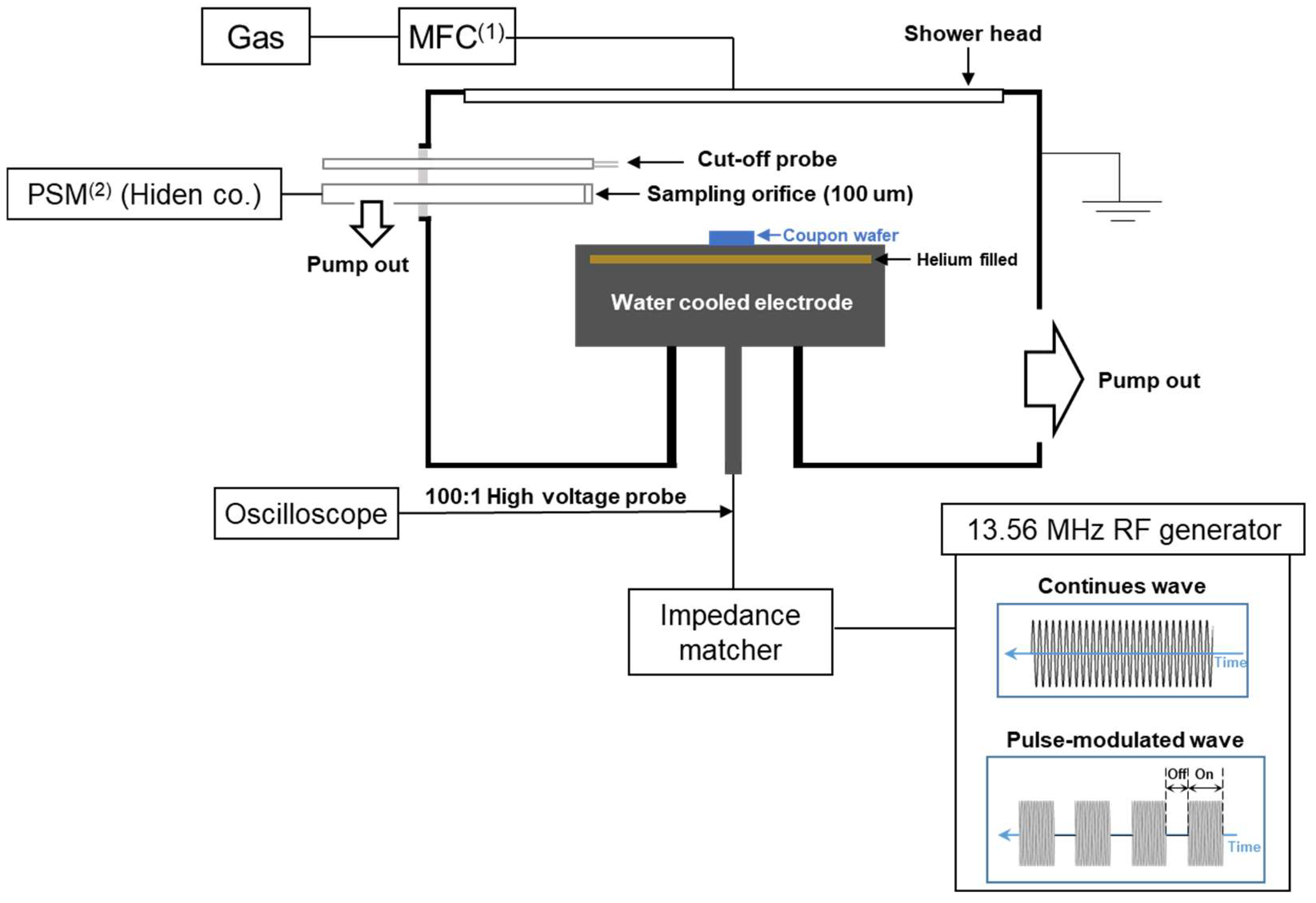
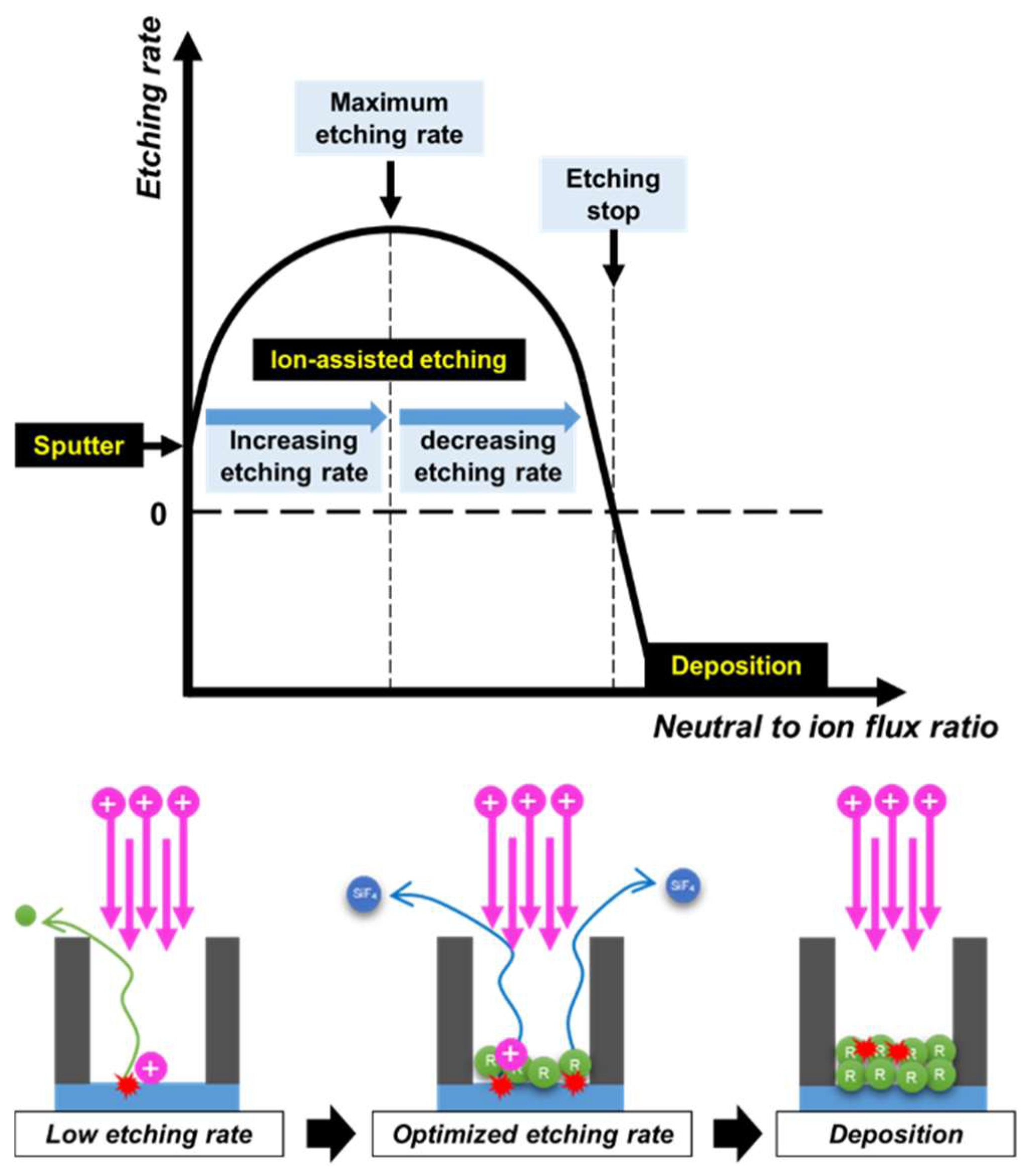


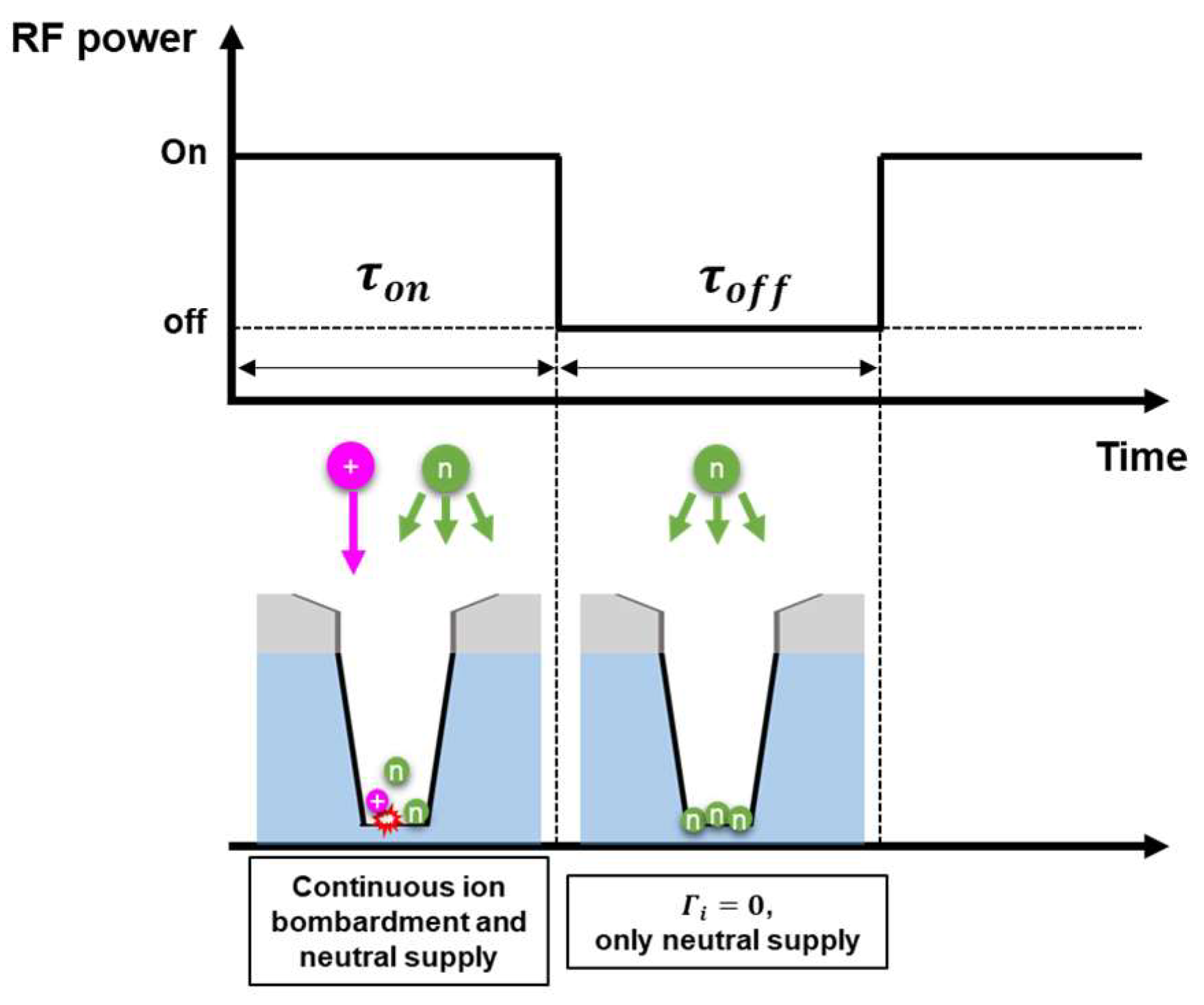
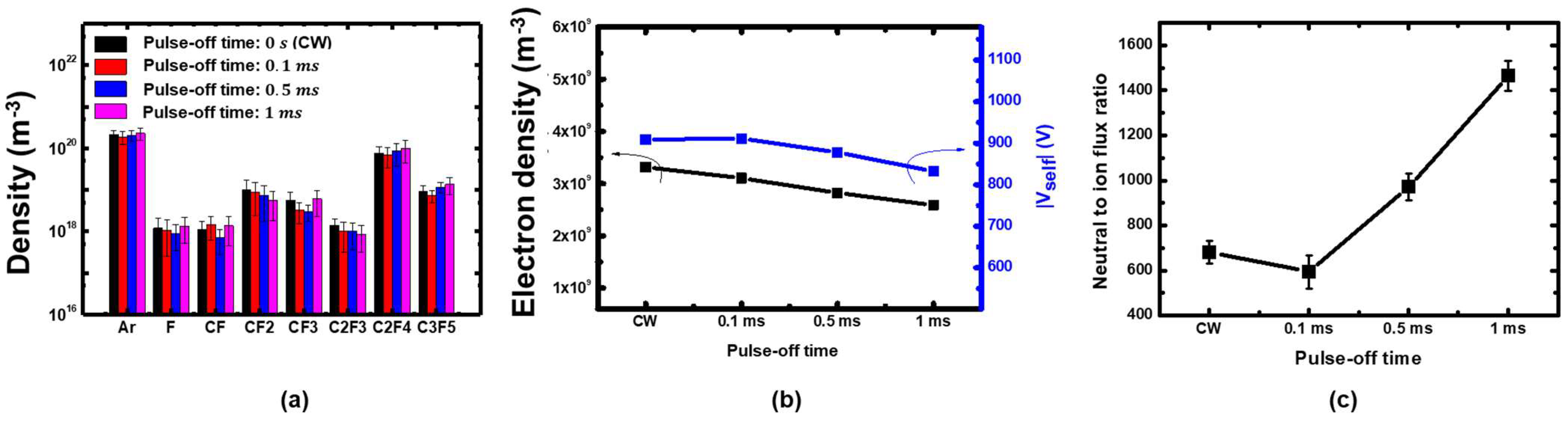



Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2022 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Jeong, W.-n.; Lee, Y.-s.; Cho, C.-h.; Seong, I.-h.; You, S.-j. Investigation into SiO2 Etching Characteristics Using Fluorocarbon Capacitively Coupled Plasmas: Etching with Radical/Ion Flux-Controlled. Nanomaterials 2022, 12, 4457. https://doi.org/10.3390/nano12244457
Jeong W-n, Lee Y-s, Cho C-h, Seong I-h, You S-j. Investigation into SiO2 Etching Characteristics Using Fluorocarbon Capacitively Coupled Plasmas: Etching with Radical/Ion Flux-Controlled. Nanomaterials. 2022; 12(24):4457. https://doi.org/10.3390/nano12244457
Chicago/Turabian StyleJeong, Won-nyoung, Young-seok Lee, Chul-hee Cho, In-ho Seong, and Shin-jae You. 2022. "Investigation into SiO2 Etching Characteristics Using Fluorocarbon Capacitively Coupled Plasmas: Etching with Radical/Ion Flux-Controlled" Nanomaterials 12, no. 24: 4457. https://doi.org/10.3390/nano12244457
APA StyleJeong, W.-n., Lee, Y.-s., Cho, C.-h., Seong, I.-h., & You, S.-j. (2022). Investigation into SiO2 Etching Characteristics Using Fluorocarbon Capacitively Coupled Plasmas: Etching with Radical/Ion Flux-Controlled. Nanomaterials, 12(24), 4457. https://doi.org/10.3390/nano12244457






