Efficiency Droop and Effective Active Volume in GaN-Based Light-Emitting Diodes Grown on Sapphire and Silicon Substrates
Abstract
1. Introduction
2. Experiments
2.1. Sample Growth and Fabrication
2.2. Electroluminescence Efficiency Measurement
3. Results
3.1. Rate Equation Modeling and Effective Active Volume
3.2. Simulation of Carrier and Recombination Rate Distribution
4. Discussion
5. Conclusions
Author Contributions
Funding
Acknowledgments
Conflicts of Interest
References
- Akasaki, I. Nobel lecture: Fascinated journeys into blue light. Rev. Mod. Phys. 2015, 87, 1119–1131. [Google Scholar] [CrossRef]
- Nakamura, S. Nobel lecture: Background story of the invention of efficient blue InGaN light emitting diodes. Rev. Mod. Phys. 2015, 87, 1139. [Google Scholar] [CrossRef]
- Pust, P.; Schmidt, P.J.; Schnick, W.A. Revolution in lighting. Nat. Mater. 2015, 14, 454–458. [Google Scholar] [CrossRef] [PubMed]
- Weisbuch, C. The efficiency challenge of nitride light-emitting diodes for lighting. Phys. Status Solidi A 2015, 212, 899–913. [Google Scholar] [CrossRef]
- Cho, J.; Park, J.H.; Kim, J.K.; Schubert, E.F. White light-emitting diodes: History, progress, and future. Laser Photonics Rev. 2017, 11, 1600147. [Google Scholar] [CrossRef]
- Zhao, Y.; Fu, H.; Wang, G.T.; Nakamura, S. Toward ultimate efficiency: progress and prospects on planar and 3D nanostructured nonpolar and semipolar InGaN light-emitting diodes. Adv. Opt. Photonics 2018, 10, 246–308. [Google Scholar] [CrossRef]
- Kim, J.Y.; Tak, Y.; Hong, H.G.; Chae, S.; Lee, J.W.; Choi, H.; Kim, J.K.; Min, B.; Park, Y.; Chung, U.I.; et al. Highly efficiency InGaN/GaN blue LEDs on large diameter Si(111) substrates comparable to those on sapphire. Proc. SPIE 2011, 8123, 81230A. [Google Scholar]
- Li, Z.Y.; Lee, C.Y.; Lin, D.W.; Lin, B.C.; Shen, K.C.; Chiu, C.H.; Tu, P.M.; Kuo, H.C.; Uen, W.Y.; Horng, R.H.; et al. High-efficiency and crack-free InGaN-based LEDs on a 6-inch Si(111) substrate with a composite buffer layer structure and quaternary superlattices electron-blocking layers. IEEE J. Quantum Electron. 2014, 50, 354–363. [Google Scholar]
- Zhang, L.; Tan, W.S.; Westwater, S.; Pujol, A.; Pinos, A.; Mezouari, S.; Stribley, K.; Whiteman, J.; Shannon, J.; Strickland, K. High brightness GaN-on-Si based blue LEDs grown on 150 mm Si substrates using thin buffer layer technology. J. Electron Dev. Soc. 2015, 3, 457–462. [Google Scholar] [CrossRef]
- Wang, W.; Lin, Y.; Li, Y.; Li, X.; Huang, L.; Zheng, Y.; Lin, Z.; Wang, H.; Li, G. High-efficiency vertical-structure GaN-based light-emitting diodes on Si substrates. J. Mater. Chem. C 2018, 6, 1642–1650. [Google Scholar] [CrossRef]
- Lin, T.; Zhou, Z.Y.; Huang, Y.M.; Yang, K.; Zhang, B.J.; Feng, Z.C. Strain-controlled recombination in InGaN/GaN multiple quantum wells on silicon substrates. Nanoscale Res. Lett. 2018, 13, 243. [Google Scholar] [CrossRef] [PubMed]
- Ryu, H.Y.; Jeon, K.S.; Kang, M.G.; Yuh, H.K.; Choi, Y.H.; Lee, J.S. A comparative study of efficiency droop and internal electric field for InGaN blue light-emitting diodes on silicon and sapphire substrates. Sci. Rep. 2017, 7, 44814. [Google Scholar] [CrossRef] [PubMed]
- Kim, M.H.; Schubert, M.F.; Dai, Q.; Kim, J.K.; Schubert, E.F.; Piprek, J.; Park, Y. Origin of efficiency droop in GaN-based light-emitting diodes. Appl. Phys. Lett. 2007, 91, 183507. [Google Scholar] [CrossRef]
- Rozhansky, I.V.; Zakheim, D.A. Analysis of processes limiting quantum efficiency of AlGaInN LEDs at high pumping. Phys. Status Solidi A 2007, 204, 227–230. [Google Scholar] [CrossRef]
- Piprek, J. Efficiency droop in nitride-based light-emitting diodes. Phys. Status Solidi A 2010, 207, 2217–2225. [Google Scholar] [CrossRef]
- Shim, J.H.; Kim, H.; Shin, D.S.; Ryu, H.Y. An explanation of efficiency droop in InGaN-based light emitting diodes: Saturated radiative recombination rate at randomly distributed In-rich active area. J. Korean Phys. Soc. 2011, 58, 503–508. [Google Scholar] [CrossRef]
- Ryu, H.Y.; Shin, D.S.; Shim, J.I. Analysis of efficiency droop in nitride light-emitting diodes by the reduced effective volume of InGaN active material. Appl. Phys. Lett. 2012, 100, 131109. [Google Scholar] [CrossRef]
- Li, H.; Li, P.; Kang, J.; Li, Z.; Zhang, Y.; Liang, M.; Li, Z.; Li, J.; Yi, Z.; Wang, G. Analysis model for efficiency droop of InGaN light-emitting diodes based on reduced effective volume of active region by carrier localization. Appl. Phys. Express 2013, 6, 092101. [Google Scholar] [CrossRef]
- Ryu, H.Y.; Ryu, G.H.; Choi, Y.H.; Ma, B. Modeling and simulation of efficiency droop in GaN-based blue light-emitting diodes incorporating the effect of reduced active volume of InGaN quantum wells. Curr. Appl. Phys. 2017, 17, 1298–1302. [Google Scholar] [CrossRef]
- Li, P.; Zhao, Y.; Yi, X.; Li, H. Effects of a reduced effective active region volume on wavelength-dependent efficiency droop of InGaN-based light-emitting diodes. Appl. Sci. 2018, 8, 2138. [Google Scholar] [CrossRef]
- Kaplar, R.J.; Kurtz, S.R.; Koleske, D.D.; Fischer, A.J. Electroreflectance studies of Stark shifts and polarization-induced electric fields in InGaN/GaN single quantum wells. J. Appl. Phys. 2004, 95, 4905–4913. [Google Scholar] [CrossRef]
- Shen, H.; Wraback, M.; Zhong, H.; Tyagi, A.; DenBaars, S.P.; Nakamura, S.; Speck, J.S. Determination of polarization field in a semipolar (1122) InGaN/GaN single quantum well using Franz-Keldysh oscillations in electroreflectance. Appl. Phys. Lett. 2009, 94, 241906. [Google Scholar] [CrossRef]
- Park, S.I.; Lee, J.I.; Jang, D.H.; Kim, H.S.; Shin, D.S.; Ryu, H.Y.; Shim, J.I. Measurement of internal electric field in GaN-based light-emitting diodes. IEEE J. Quantum Electron. 2012, 48, 500–506. [Google Scholar] [CrossRef]
- Jeon, K.S.; Sung, J.H.; Lee, M.W.; Song, H.Y.; Lee, E.A.; Kim, S.O.; Choi, H.J.; Shin, H.Y.; Park, W.H.; Jang, Y.I.; et al. Comparison of strain in GaN-based blue light-emitting diode grown on silicon(111) and sapphire substrates. J. Nanosci. Nanotechnol. 2015, 15, 5264–5266. [Google Scholar] [CrossRef] [PubMed]
- Ryu, H.Y.; Kim, H.S.; Shim, J.I. Rate equation analysis of efficiency droop in InGaN light-emitting diode. Appl. Phys. Lett. 2009, 95, 081114. [Google Scholar] [CrossRef]
- Dai, Q.; Shan, Q.; Wang, J.; Chhajed, S.; Cho, J.; Schubert, E.F.; Crawford, M.H.; Koleske, D.D.; Kim, M.H.; Park, Y.J. Carrier recombination mechanisms and efficiency droop in GaInN/GaN light-emitting diodes. Appl. Phys. Lett. 2010, 97, 133507. [Google Scholar] [CrossRef]
- Avrutin, V.; Hafiz, S.A.; Zhang, F.; Özgür, Ü.; Morkoc, H.; Matulionis, A. InGaN light-emitting diodes: Efficiency-limiting processes at high injection. J. Vac. Sci. Technol. A 2013, 31, 050809. [Google Scholar] [CrossRef]
- Kioupakis, E.; Yan, Q.; Steiauf, D.; Van de Walle, C.G. Temperature and carrier-density dependence of Auger and radiative recombination in nitride optoelectronic devices. New J. Phys. 2013, 15, 125006. [Google Scholar] [CrossRef]
- Wang, L.; Meng, X.; Song, J.H.; Kim, T.S.; Lim, S.Y.; Hao, Z.B.; Sun, C.Z.; Han, Y.J.; Xiong, B.; Wang, J.; et al. A method to obtain Auger recombination coefficient in an InGaN-based blue lgiht-emitting diode. Chin. Phys. Lett. 2017, 34, 017301. [Google Scholar] [CrossRef]
- Reklaitis, I.; Krencius, L.; Malinauskas, T.; Karpov, S.Y.; Lugauer, H.J.; Pietzonka, I.; Strassburg, M.; Vitta, P.; Tomasiunas, R. Time of carrier escape and recombination coefficients in InGaN quantum-well active regions of blue, cyan, and green light-emitting diodes. Semicond. Sci. Technol. 2019, 34, 015007. [Google Scholar] [CrossRef]
- Pham, Q.U.; Chen, J.C.; Nguyen, H.B. Three-dimensional numerical study on the efficiency droop in InGaN/GaN light-emitting diodes. IEEE Photonisc J. 2019, 11, 8200417. [Google Scholar] [CrossRef]
- APSYS by Crosslight Software, Burnaby, Canada. Available online: http://www.crosslight.com/products/apsys.shtml (accessed on 3 October 2019).
- David, A.; Grundmann, M.J.; Kaeding, J.F.; Gardner, N.F.; Mihopoulos, T.G.; Krames, M.R. Carrier distribution in (0001) InGaN/GaN multiple quantum well light-emitting diodes. Appl. Phys. Lett. 2008, 92, 053502. [Google Scholar] [CrossRef]
- Cheng, L.; Chen, H.; Wu, S. Improving hole injection and carrier distribution in InGaN light-emitting diodes by removing the electron blocking layer and including a unique last quantum barrier. J. Appl. Phys. 2015, 118, 083104. [Google Scholar] [CrossRef]
- Rouet-Leduc, B.; Barros, K.; Lookman, T.; Humphreys, C.J. Optimisation of GaN LEDs and the reduction of efficiency droop using active machine learning. Sci. Rep. 2016, 6, 24862. [Google Scholar] [CrossRef] [PubMed]
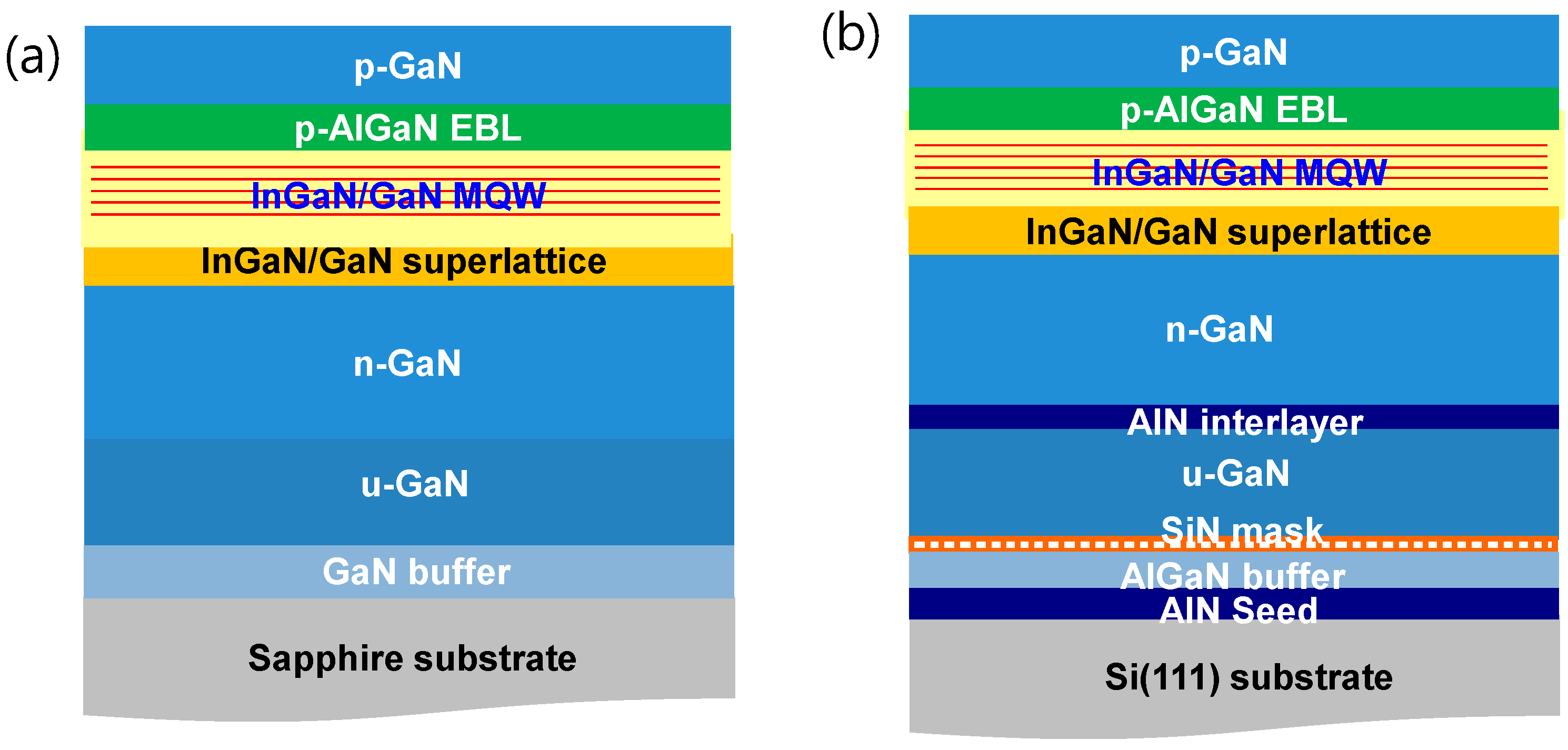
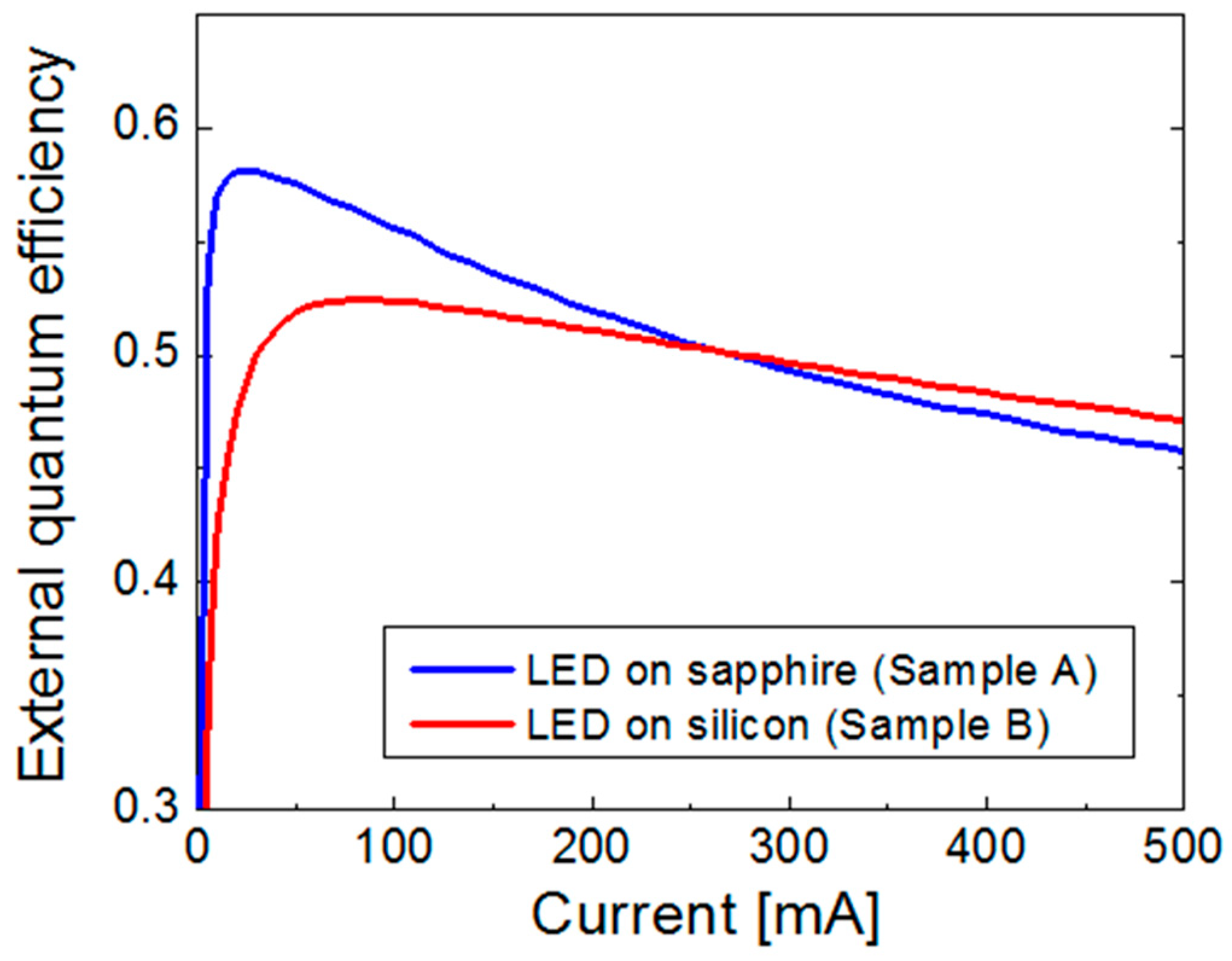

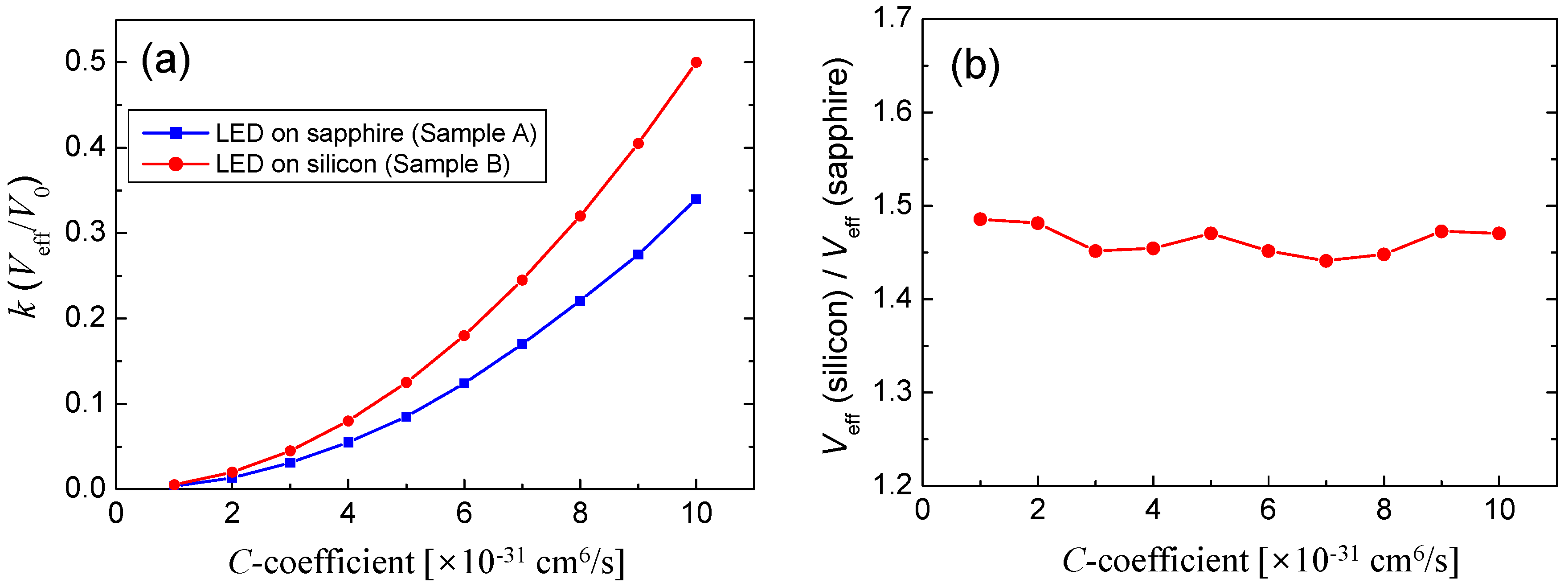

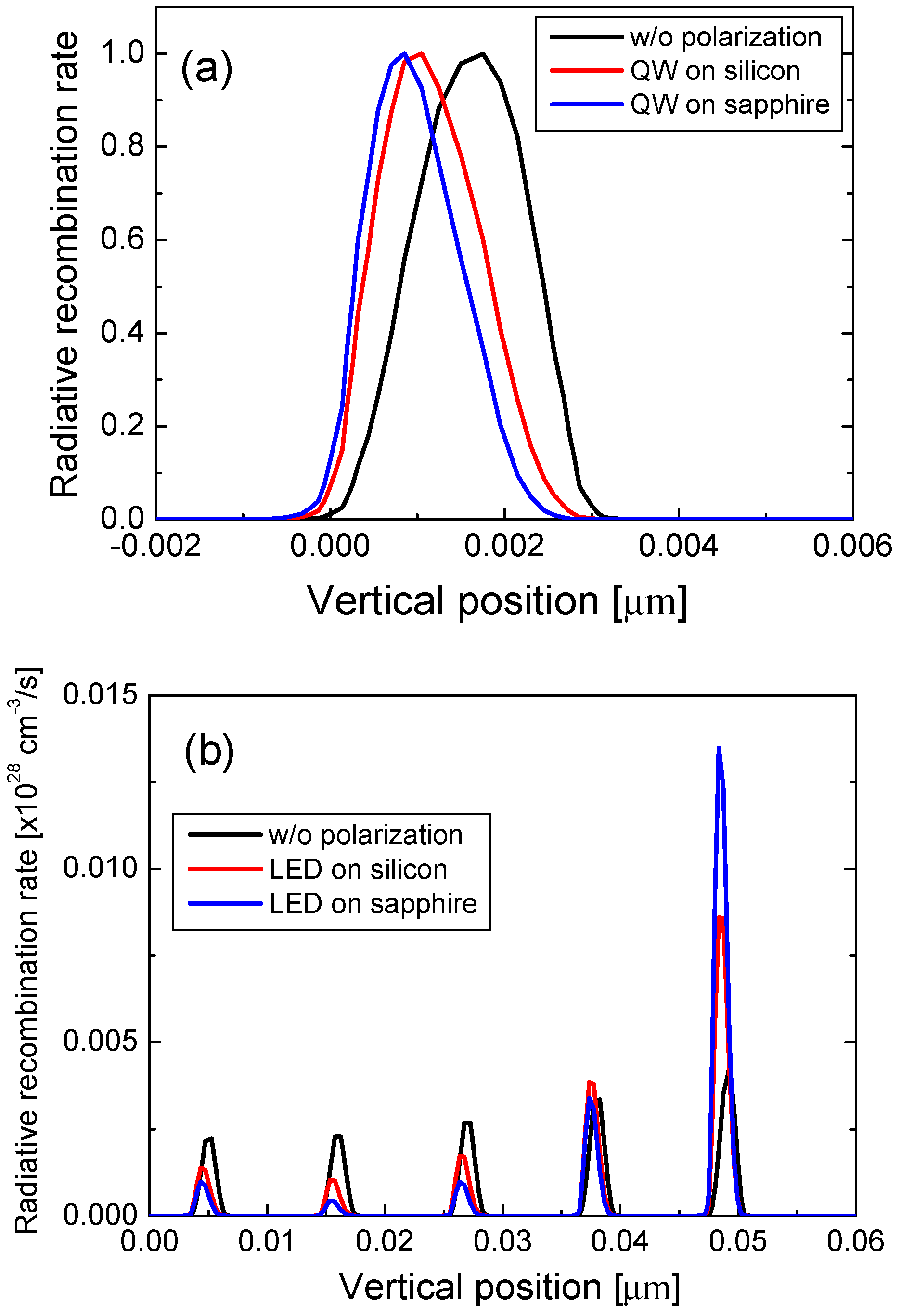
© 2019 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Ryu, H.-Y.; Ryu, G.-H.; Onwukaeme, C. Efficiency Droop and Effective Active Volume in GaN-Based Light-Emitting Diodes Grown on Sapphire and Silicon Substrates. Appl. Sci. 2019, 9, 4160. https://doi.org/10.3390/app9194160
Ryu H-Y, Ryu G-H, Onwukaeme C. Efficiency Droop and Effective Active Volume in GaN-Based Light-Emitting Diodes Grown on Sapphire and Silicon Substrates. Applied Sciences. 2019; 9(19):4160. https://doi.org/10.3390/app9194160
Chicago/Turabian StyleRyu, Han-Youl, Geun-Hwan Ryu, and Chibuzo Onwukaeme. 2019. "Efficiency Droop and Effective Active Volume in GaN-Based Light-Emitting Diodes Grown on Sapphire and Silicon Substrates" Applied Sciences 9, no. 19: 4160. https://doi.org/10.3390/app9194160
APA StyleRyu, H.-Y., Ryu, G.-H., & Onwukaeme, C. (2019). Efficiency Droop and Effective Active Volume in GaN-Based Light-Emitting Diodes Grown on Sapphire and Silicon Substrates. Applied Sciences, 9(19), 4160. https://doi.org/10.3390/app9194160




