Two-Dimensional Octuple-Atomic-Layer M2Si2N4 (M = Al, Ga and In) with Long Carrier Lifetime
Abstract
1. Introduction
2. Computational Methods
3. Results and Discussion
4. Conclusions
Supplementary Materials
Author Contributions
Funding
Data Availability Statement
Conflicts of Interest
References
- Brunner, D.; Angerer, H.; Bustarret, E.; Freudenberg, F.; Höpler, R.; Dimitrov, R.; Ambacher, O.; Stutzmann, M. Optical constants of epitaxial AlGaN films and their temperature dependence. J. Appl. Phys. 1997, 82, 5090–5096. [Google Scholar] [CrossRef]
- Narukawa, Y.; Ichikawa, M.; Sanga, D.; Sano, M.; Mukai, T. White light emitting diodes with super-high luminous efficacy. J. Phys. D Appl. Phys. 2010, 43, 354002. [Google Scholar] [CrossRef]
- Hurni, C.A.; David, A.; Cich, M.J.; Aldaz, R.I.; Ellis, B.; Huang, K.; Tyagi, A.; DeLille, R.A.; Craven, M.D.; Steranka, F.M.; et al. Bulk GaN flip-chip violet light-emitting diodes with optimized efficiency for high-power operation. Appl. Phys. Lett. 2015, 106, 031101. [Google Scholar] [CrossRef]
- Geng, C.; Wei, T.; Wang, X.; Shen, D.; Hao, Z.; Yan, Q. Enhancement of light output power from LEDs based on monolayer colloidal crystal. Small 2014, 10, 1668–1686. [Google Scholar] [CrossRef] [PubMed]
- Spies, M.; Den Hertog, M.I.; Hille, P.; Schörmann, J.; Polaczynski, J.; Gayral, B.; Eickhoff, M.; Monroy, E.; Lähnemann, J. Bias-controlled spectral response in GaN/AlN single-nanowire ultraviolet photodetectors. Nano Lett. 2017, 17, 4231–4239. [Google Scholar] [CrossRef]
- Prete, M.S.; Grassano, D.; Pulci, O.; Kupchak, I.; Olevano, V.; Bechstedt, F. Giant excitonic absorption and emission in two-dimensional group-III nitrides. Sci. Rep. 2020, 10, 1–9. [Google Scholar] [CrossRef]
- Camacho-Mojica, D.C.; López-Urías, F. GaN haeckelite single-layered nanostructures: Monolayer and nanotubes. Sci. Rep. 2015, 5, 1–11. [Google Scholar] [CrossRef]
- Zhang, H.; Meng, F.S.; Wu, Y.B. Two single-layer porous gallium nitride nanosheets: A first-principles study. Solid State Commun. 2017, 250, 18–22. [Google Scholar] [CrossRef]
- Behnam Kazempour, E.K.S.; Rostami, R. Theoretical prediction of novel two-dimensional planar aluminum nitride allotropes: First principles calculations. Indian J. Phys. 2018, 92, 343–348. [Google Scholar] [CrossRef]
- Ben, J.; Liu, X.; Wang, C.; Zhang, Y.; Shi, Z.; Jia, Y.; Zhang, S.; Zhang, H.; Yu, W.; Li, D.; et al. 2D III-Nitride Materials: Properties, Growth, and Applications. Adv. Mater. 2021, 33, 2006761. [Google Scholar] [CrossRef]
- Wang, W.; Jiang, H.; Li, L.; Li, G. Two-dimensional group-III nitrides and devices: A critical review. Rep. Prog. Phys. 2021, 84, 086501. [Google Scholar] [CrossRef]
- Mansurov, V.; Malin, T.; Galitsyn, Y.; Zhuravlev, K. Graphene-like AlN layer formation on (111) Si surface by ammonia molecular beam epitaxy. J. Cryst. Growth 2015, 428, 93–97. [Google Scholar] [CrossRef]
- Syed, N.; Zavabeti, A.; Messalea, K.A.; Della Gaspera, E.; Elbourne, A.; Jannat, A.; Mohiuddin, M.; Zhang, B.Y.; Zheng, G.; Wang, L.; et al. Wafer-sized ultrathin gallium and indium nitride nanosheets through the ammonolysis of liquid metal derived oxides. J. Am. Chem. Soc. 2019, 141, 104–108. [Google Scholar] [CrossRef]
- Al Balushi, Z.Y.; Wang, K.; Ghosh, R.K.; Vilá, R.A.; Eichfeld, S.M.; Caldwell, J.D.; Qin, X.; Lin, Y.C.; DeSario, P.A.; Stone, G.; et al. Two-dimensional gallium nitride realized via graphene encapsulation. Nat. Mater. 2016, 15, 1166–1171. [Google Scholar] [CrossRef]
- Kakanakova-Georgieva, A.; Gueorguiev, G.K.; Sangiovanni, D.G.; Suwannaharn, N.; Ivanov, I.G.; Cora, I.; Pécz, B.; Nicotra, G.; Giannazzo, F. Nanoscale phenomena ruling deposition and intercalation of AlN at the graphene/SiC interface. Nanoscale 2020, 12, 19470–19476. [Google Scholar] [CrossRef]
- Pécz, B.; Nicotra, G.; Giannazzo, F.; Yakimova, R.; Koos, A.; Kakanakova-Georgieva, A. Indium nitride at the 2D limit. Adv. Mater. 2021, 33, 2006660. [Google Scholar] [CrossRef]
- Hong, Y.L.; Liu, Z.; Wang, L.; Zhou, T.; Ma, W.; Xu, C.; Feng, S.; Chen, L.; Chen, M.L.; Sun, D.M.; et al. Chemical vapor deposition of layered two-dimensional MoSi2N4 materials. Science 2020, 369, 670–674. [Google Scholar] [CrossRef]
- Wang, L.; Shi, Y.; Liu, M.; Zhang, A.; Hong, Y.L.; Li, R.; Gao, Q.; Chen, M.; Ren, W.; Cheng, H.M.; et al. Intercalated architecture of MA2Z4 family layered van der Waals materials with emerging topological, magnetic and superconducting properties. Nat. Commun. 2021, 12, 1–10. [Google Scholar] [CrossRef]
- Lin, C.; Feng, X.; Legut, D.; Liu, X.; Seh, Z.W.; Zhang, R.; Zhang, Q. Discovery of Efficient Visible-light Driven Oxygen Evolution Photocatalysts: Automated High-Throughput Computational Screening of MA2Z4. Adv. Funct. Mater. 2022, 32, 2207415. [Google Scholar] [CrossRef]
- Kohn, W.; Becke, A.D.; Parr, R.G. Density functional theory of electronic structure. J. Phys. Chem. 1996, 100, 12974–12980. [Google Scholar] [CrossRef]
- Kresse, G.; Furthmüller, J. Efficient iterative schemes for ab initio total-energy calculations using a plane-wave basis set. Phys. Rev. B 1996, 54, 11169. [Google Scholar] [CrossRef] [PubMed]
- Kresse, G.; Joubert, D. From ultrasoft pseudopotentials to the projector augmented-wave method. Phys. Rev. B 1999, 59, 1758. [Google Scholar] [CrossRef]
- Perdew, J.P.; Chevary, J.A.; Vosko, S.H.; Jackson, K.A.; Pederson, M.R.; Singh, D.J.; Fiolhais, C. Atoms, molecules, solids, and surfaces: Applications of the generalized gradient approximation for exchange and correlation. Phys. Rev. B 1992, 46, 6671. [Google Scholar] [CrossRef] [PubMed]
- Perdew, J.P.; Burke, K.; Ernzerhof, M. Generalized gradient approximation made simple. Phys. Rev. Lett. 1996, 77, 3865. [Google Scholar] [CrossRef]
- Blöchl, P.E. Projector augmented-wave method. Phys. Rev. B 1994, 50, 17953. [Google Scholar] [CrossRef]
- Monkhorst, H.J.; Pack, J.D. Special points for Brillouin-zone integrations. Phys. Rev. B 1976, 13, 5188. [Google Scholar] [CrossRef]
- Blöchl, P.E.; Jepsen, O.; Andersen, O.K. Improved tetrahedron method for Brillouin-zone integrations. Phys. Rev. B 1994, 49, 16223. [Google Scholar] [CrossRef]
- Togo, A.; Tanaka, I. First principles phonon calculations in materials science. Scr. Mater. 2015, 108, 1–5. [Google Scholar] [CrossRef]
- Wang, V.; Xu, N.; Liu, J.C.; Tang, G.; Geng, W.T. VASPKIT: A user-friendly interface facilitating high-throughput computing and analysis using VASP code. Comput. Phys. Commun. 2021, 267, 108033. [Google Scholar] [CrossRef]
- Zheng, Q.; Chu, W.; Zhao, C.; Zhang, L.; Guo, H.; Wang, Y.; Jiang, X.; Zhao, J. Ab initio nonadiabatic molecular dynamics investigations on the excited carriers in condensed matter systems. Wiley Interdiscip. Rev. Comput. Mol. Sci. 2019, 9, e1411. [Google Scholar] [CrossRef]
- Marini, A.; Hogan, C.; Grüning, M.; Varsano, D. Yambo: An ab initio tool for excited state calculations. Comput. Phys. Commun. 2009, 180, 1392–1403. [Google Scholar] [CrossRef]
- Sangalli, D.; Ferretti, A.; Miranda, H.; Attaccalite, C.; Marri, I.; Cannuccia, E.; Melo, P.; Marsili, M.; Paleari, F.; Marrazzo, A.; et al. Many-body perturbation theory calculations using the yambo code. J. Phys. Condens. Matter 2019, 31, 325902. [Google Scholar] [CrossRef]
- Giannozzi, P.; Baroni, S.; Bonini, N.; Calandra, M.; Car, R.; Cavazzoni, C.; Ceresoli, D.; Chiarotti, G.L.; Cococcioni, M.; Dabo, I.; et al. QUANTUM ESPRESSO: A modular and open-source software project for quantum simulations of materials. J. Phys. Condens. Mat. 2009, 21, 395502. [Google Scholar] [CrossRef]
- Giannozzi, P.; Andreussi, O.; Brumme, T.; Bunau, O.; Nardelli, M.B.; Calandra, M.; Car, R.; Cavazzoni, C.; Ceresoli, D.; Cococcioni, M.; et al. Advanced capabilities for materials modelling with Quantum ESPRESSO. J. Phys. Condens. Mat. 2017, 29, 465901. [Google Scholar] [CrossRef]
- Hamann, D. Optimized norm-conserving Vanderbilt pseudopotentials. Phys. Rev. B 2013, 88, 085117. [Google Scholar] [CrossRef]
- Strinati, G. Application of the Green’s functions method to the study of the optical properties of semiconductors. La Riv. Del Nuovo Cimento (1978–1999) 1988, 11, 1–86. [Google Scholar] [CrossRef]
- Maździarz, M. Comment on “The Computational 2D Materials Database: High-throughput modeling and discovery of atomically thin crystals”. 2D Mater. 2019, 6, 048001. [Google Scholar] [CrossRef]
- Lee, C.; Wei, X.; Kysar, J.W.; Hone, J. Measurement of the elastic properties and intrinsic strength of monolayer graphene. Science 2008, 321, 385–388. [Google Scholar] [CrossRef]
- Henkelman, G.; Arnaldsson, A.; Jónsson, H. A fast and robust algorithm for Bader decomposition of charge density. Comput. Mater. Sci. 2006, 36, 354–360. [Google Scholar] [CrossRef]
- Yuan, L.D.; Deng, H.X.; Li, S.S.; Wei, S.H.; Luo, J.W. Unified theory of direct or indirect band-gap nature of conventional semiconductors. Phys. Rev. B 2018, 98, 245203. [Google Scholar] [CrossRef]
- Qiu, D.Y.; Felipe, H.; Louie, S.G. Screening and many-body effects in two-dimensional crystals: Monolayer MoS2. Phys. Rev. B 2016, 93, 235435. [Google Scholar] [CrossRef]
- Attaccalite, C.; Palummo, M.; Cannuccia, E.; Grüning, M. Second-harmonic generation in single-layer monochalcogenides: A response from first-principles real-time simulations. Phys. Rev. Mater. 2019, 3, 074003. [Google Scholar] [CrossRef]
- Marcus, R.A.; Sutin, N. Electron transfers in chemistry and biology. Biochim. Biophys. Acta (BBA)-Rev. Bioenerg. 1985, 811, 265–322. [Google Scholar] [CrossRef]
- Hyeon-Deuk, K.; Madrid, A.B.; Prezhdo, O.V. Symmetric band structures and asymmetric ultrafast electron and hole relaxations in silicon and germanium quantum dots: Time-domain ab initio simulation. Dalton Trans. 2009, 10069–10077. [Google Scholar] [CrossRef]
- Jankowska, J.; Long, R.; Prezhdo, O.V. Quantum dynamics of photogenerated charge carriers in hybrid perovskites: Dopants, grain boundaries, electric order, and other realistic aspects. ACS Energy Lett. 2017, 2, 1588–1597. [Google Scholar] [CrossRef]
- Wang, L.; Long, R.; Prezhdo, O.V. Time-domain ab initio modeling of photoinduced dynamics at nanoscale interfaces. Annu. Rev. Phys. Chem. 2015, 66, 549–579. [Google Scholar] [CrossRef]
- Li, L.; Long, R.; Bertolini, T.; Prezhdo, O.V. Sulfur adatom and vacancy accelerate charge recombination in MoS2 but by different mechanisms: Time-domain ab initio analysis. Nano Lett. 2017, 17, 7962–7967. [Google Scholar] [CrossRef]
- Yan, L.; Zhu, J.; Wang, B.T.; He, J.; Song, H.Z.; Chu, W.; Tretiak, S.; Zhou, L. Two Dimensional MOene: From Superconductors to Direct Semiconductors and Weyl Fermions. Nano Lett. 2022, 22, 5592–5599. [Google Scholar] [CrossRef]
- Li, W.; Tang, J.; Casanova, D.; Prezhdo, O.V. Time-domain ab initio analysis rationalizes the unusual temperature dependence of charge carrier relaxation in lead halide perovskite. ACS Energy Lett. 2018, 3, 2713–2720. [Google Scholar] [CrossRef]
- Ščajev, P.; Jarašiiūnas, K.; Okur, S.; Özgür, Ü.; Morkoç, H. Carrier dynamics in bulk GaN. J. Appl. Phys. 2012, 111, 023702. [Google Scholar] [CrossRef]
- Chen, F.; Cartwright, A.; Lu, H.; Schaff, W.J. Hole transport and carrier lifetime in InN epilayers. Appl. Phys. Lett. 2005, 87, 212104. [Google Scholar] [CrossRef]


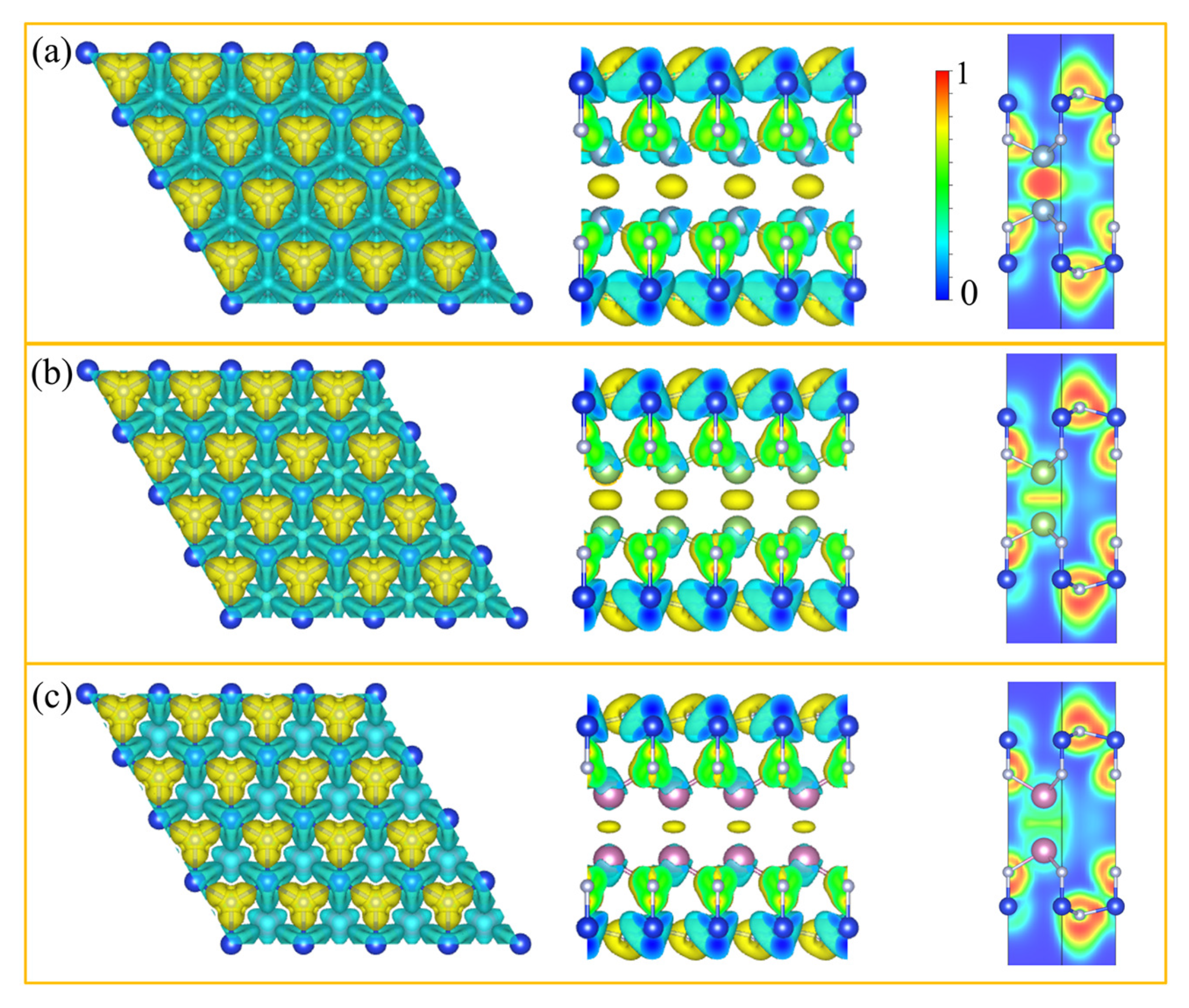
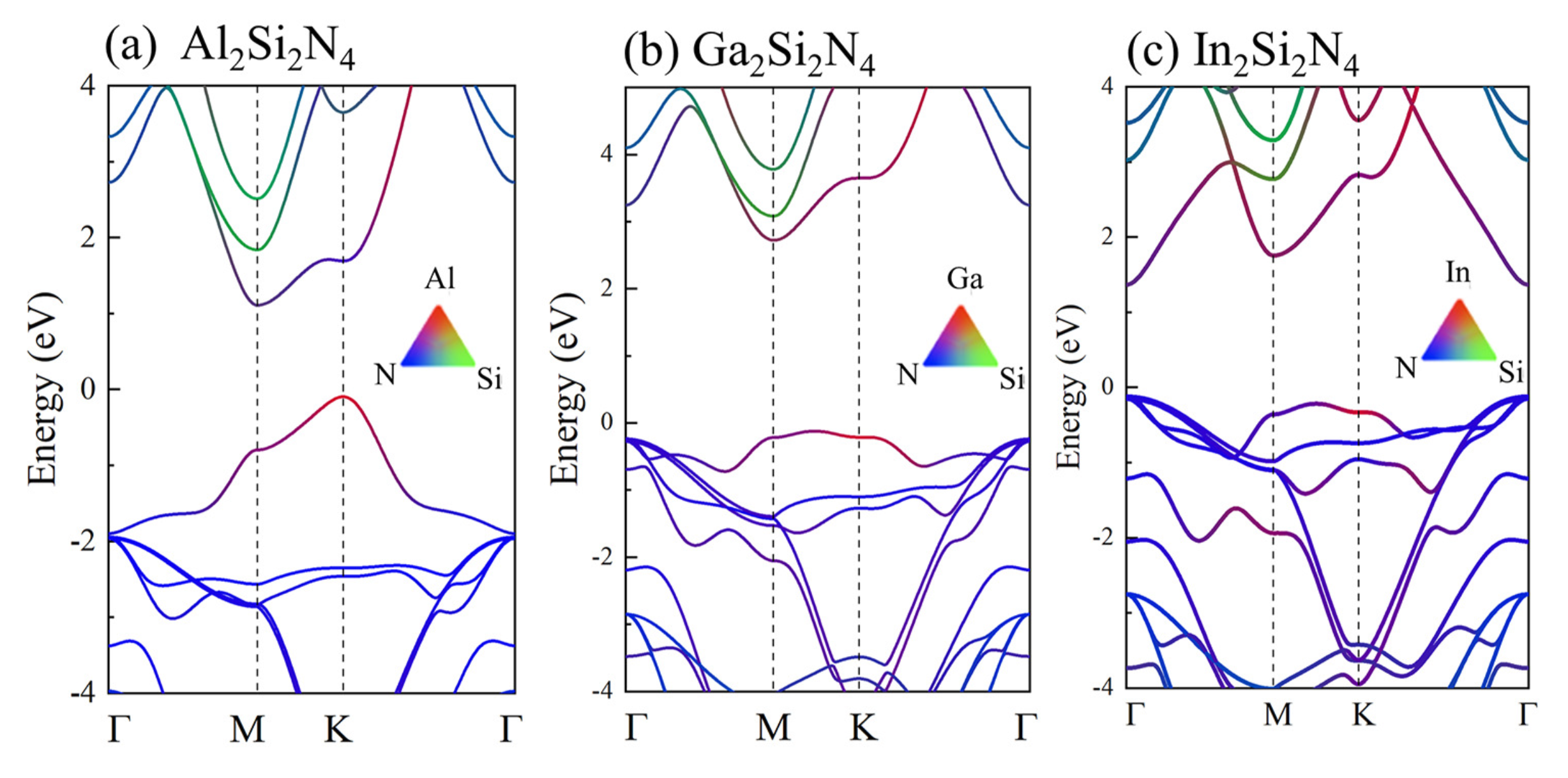


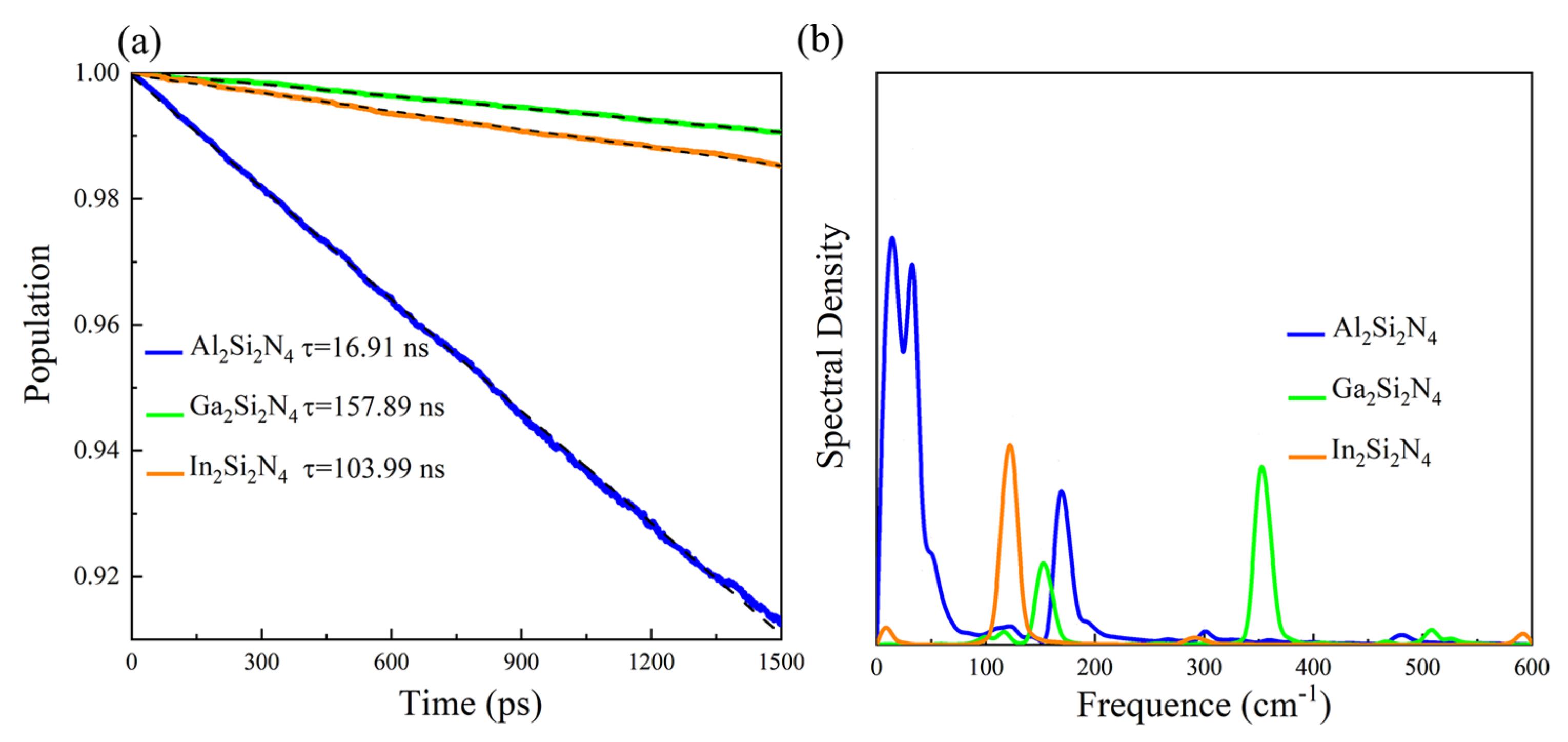
| a (Å) | d (Å) | C/C (N/m) | E (eV) | E (eV) | E (eV) | |
|---|---|---|---|---|---|---|
| AlSiN | 2.97 | 8.8 | 571.8/124.5 | 2.62 (K) | 2.18 | 0.44 |
| GaSiN | 3.01 | 8.7 | 541.5/128.3 | 4.49 (M) | 3.95 | 0.54 |
| InSiN | 3.14 | 9.3 | 458.7/119.6 | 2.11 () | 1.73 | 0.38 |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Ding, Y.; Xue, K.; Zhang, J.; Yan, L.; Li, Q.; Yao, Y.; Zhou, L. Two-Dimensional Octuple-Atomic-Layer M2Si2N4 (M = Al, Ga and In) with Long Carrier Lifetime. Micromachines 2023, 14, 405. https://doi.org/10.3390/mi14020405
Ding Y, Xue K, Zhang J, Yan L, Li Q, Yao Y, Zhou L. Two-Dimensional Octuple-Atomic-Layer M2Si2N4 (M = Al, Ga and In) with Long Carrier Lifetime. Micromachines. 2023; 14(2):405. https://doi.org/10.3390/mi14020405
Chicago/Turabian StyleDing, Yimin, Kui Xue, Jing Zhang, Luo Yan, Qiaoqiao Li, Yisen Yao, and Liujiang Zhou. 2023. "Two-Dimensional Octuple-Atomic-Layer M2Si2N4 (M = Al, Ga and In) with Long Carrier Lifetime" Micromachines 14, no. 2: 405. https://doi.org/10.3390/mi14020405
APA StyleDing, Y., Xue, K., Zhang, J., Yan, L., Li, Q., Yao, Y., & Zhou, L. (2023). Two-Dimensional Octuple-Atomic-Layer M2Si2N4 (M = Al, Ga and In) with Long Carrier Lifetime. Micromachines, 14(2), 405. https://doi.org/10.3390/mi14020405







