Micromask Lithography for Cheap and Fast 2D Materials Microstructures Fabrication
Abstract
:1. Introduction
2. Materials and Methods
2.1. Description of the Installation
2.2. Mask Fabrication
2.3. Lithography Procedure
2.4. Sample Characterization Methods
3. Results
4. Discussion
5. Conclusions
Supplementary Materials
Author Contributions
Funding
Acknowledgments
Conflicts of Interest
Abbreviations
| PMMA | poly (methyl methacrylate) |
| UV | ultraviolet |
| XYZR stage | a platform, that is controllably positioned along 3 axes and rotated |
| Z stage | vertical component of XYZR stage |
| XY stage | horizontal plane of XYZR stage |
| 2D | two dimensional |
| LED | light-emitting diode |
| CVD | chemical vapor deposition |
| LCD | liquid crystal display |
| PCR | polymerase chain reaction |
| AFM | atomic-force microscope |
| LLE | Layer-engineered large-area exfoliation |
| CFMS | Cryogen Free Measurement System |
References
- Wang, Q.; Kalantar-Zadeh, K.; Kis, A.; Coleman, J.N.; Strano, M.S. Electronics and optoelectronics of two-dimensional transition metal dichalcogenides. Nat. Nanotechnol. 2012, 7, 699–712. [Google Scholar] [CrossRef]
- Gibertini, M.; Koperski, M.; Morpurgo, A.F.; Novoselov, K.S. Magnetic 2D materials and heterostructures. Nat. Nanotechnol. 2019, 14, 408–419. [Google Scholar] [CrossRef] [Green Version]
- Qiu, D.; Gong, C.; Wang, S.; Zhang, M.; Yang, C.; Wang, X.; Xiong, J. Recent Advances in 2D Superconductors. Adv. Mater. 2021, 33, 2006124. [Google Scholar] [CrossRef]
- Lee, C.W.; Suh, J.M.; Jang, H.W. Chemical Sensors Based on Two-Dimensional (2D) Materials for Selective Detection of Ions and Molecules in Liquid. Front. Chem. 2019, 7, 708. [Google Scholar] [CrossRef]
- Zhang, K.; Zhang, L.; Han, L.; Wang, L.; Chen, Z.; Xing, H.; Chen, X. Recent progress and challenges based on two-dimensional material photodetectors. Nano Express 2021, 2, 012001. [Google Scholar] [CrossRef]
- Briggs, N.; Shruti, S.; Lin, Z.; Li, X.; Zhang, X.; Zhang, K.; Xiao, K.; Geohegan, D.B.; Wallace, R.M.; Chen, L.; et al. A roadmap for electronic grade 2D materials. 2D Mater. 2019, 6, 022001. [Google Scholar] [CrossRef]
- Joel, I.-J.; Wang, J.I.-J.; Rodan-Legrain, D.; Bretheau, L.; Campbell, D.L.; Kannan, B.; Kim, D.; Kjaergaard, M.; Krantz, P.; Samach, G.O.; et al. Coherent control of a hybrid superconducting circuit made with graphene-based van der Waals heterostructures. Nat. Nanotechnol. 2019, 14, 120–125. [Google Scholar]
- Geim, A.K.; Grigorieva, I.V.T. Van der Waals heterostructures. Nature 2013, 499, 419–425. [Google Scholar] [CrossRef]
- Novoselov, K.S.; Jiang, D.; Schedin, F.; Booth, T.J.; Khotkevich, V.V.; Morozov, S.V.; Geim, A.K.T. Two-dimensional atomic crystals. Natl. Acad. Sci. 2005, 102, 10451–10453. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Xu, M.S.; Liang, T.; Shi, M.M.; Chen, H.Z. Graphene-Like Two-Dimensional Materials. Chem. Rev. 2013, 113, 3766–3798. [Google Scholar] [CrossRef] [PubMed]
- Nicolosi, V.; Chhowalla, M.; Kanatzidis, M.G.; Strano, M.S.; Coleman, J.N. Liquid Exfoliation of Layered Materials. Science 2013, 340, 1226419. [Google Scholar] [CrossRef] [Green Version]
- Cai, Z.; Liu, B.; Zou, X.; Cheng, H.-M. Chemical Vapor Deposition Growth and Applications of Two-Dimensional Materials and Their Heterostructures. Chem. Rev. 2018, 118, 6091–6133. [Google Scholar] [CrossRef] [PubMed]
- Garcia, R.; Martinez, R.V.; Martinez, J. Nano-chemistry and scanning probe nanolithographies. Chem. Soc. Rev. 2006, 35, 29–38. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Guo, L.J. Nanoimprint Lithography: Methods and Material Requirements. Adv. Mater. 2007, 19, 495–513. [Google Scholar] [CrossRef] [Green Version]
- Xia, D.; Ku, Z.; Lee, S.C.; Brueck, S.R.J. Nanostructures and Functional Materials Fabricated by Interferometric Lithography. Adv. Mater. 2007, 17, 3027–3041. [Google Scholar] [CrossRef] [PubMed]
- Du, K.; Ding, J.; Liu, Y.; Wathuthanthri, I.; Choi, C.-H. Stencil Lithography for Scalable Micro- and Nanomanufacturing. Micromachines 2017, 8, 131. [Google Scholar] [CrossRef]
- Suss MJB4 Mask Aligner. Available online: https://www.suss.com/en/products-solutions/mask-aligner/mjb4 (accessed on 20 July 2021).
- Midas System MDA-400LJ Mask Aligner. Available online: http://www.midas-system.com/en/product/menu_01.html (accessed on 20 July 2021).
- Koenig, S.P.; Doganov, R.A.; Schmidt, H.; Castro Neto, A.H.; Özyilmaz, B. Electric field effect in ultrathin black phosphorus. Appl. Phys. Lett. 2014, 104, 103106. [Google Scholar] [CrossRef] [Green Version]
- Cao, Y.; Mishchenko, A.; Yu, G.L.; Khestanova, E.; Rooney, A.P.; Prestat, E.; Kretinin, A.V.; Blake, P.; Shalom, M.B.; Woods, C.; et al. Quality Heterostructures from Two-Dimensional Crystals Unstable in Air by Their Assembly in Inert Atmosphere. Nano Lett. 2015, 15, 4914–4921. [Google Scholar] [CrossRef] [Green Version]
- Gant, P.; Carrascoso, F.; Zhao, Q.; Ryu, Y.K.; Seitz, M.; Prins, F.; Frisenda, R.; Castellanos-Gomez, A. A system for the deterministic transfer of 2D materials under inert environmental conditions. 2D Mater. 2020, 7, 025034. [Google Scholar] [CrossRef]
- Masubuchi, S.; Morimoto, M.; Morikawa, S.; Onodera, M.; Asakawa, Y.; Watanabe, K.; Taniguchi, T.; Machida, T. Autonomous robotic searching and assembly of two-dimensional crystals to build van der Waals superlattices. Nat. Commun. 2018, 9, 1413. [Google Scholar] [CrossRef] [PubMed]
- Gray, M.J.; Kumar, N.; O’Connor, R.; Hoek, M.; Sheridan, E.; Doyle, M.C.; Romanelli, M.L.; Osterhoudt, G.B.; Wang, Y.; Plisson, V.; et al. A cleanroom in a glovebox. Rev. Sci. Instrum. 2020, 91, 073909. [Google Scholar] [CrossRef] [PubMed]
- Chae, S.H.; Jin, Y.; Kim, T.S.; Chung, D.S.; Na, H.; Nam, H.; Kim, H.; Perello, D.J.; Jeong, H.Y.; Ly, T.H.; et al. Oxidation Effect in Octahedral Hafnium Disulfide Thin Film. ACS Nano 2016, 10, 1309–1316. [Google Scholar] [CrossRef]
- Li, X.; Zhu, X.; Zhou, Q.; Wang, H.; Ni, K. Low-cost lithography for fabrication of one-dimensional diffraction gratings by using laser diodes. Proc. SPIE 2015, 9624, 962408. [Google Scholar]
- Fucetola, C.P.; Korre, H.; Berggren, K.K. Low-cost interference lithography. J. Vac. Sci. Technol. B 2009, 27, 2958–2961. [Google Scholar] [CrossRef] [Green Version]
- Khan, M.S.; Lachmayr, R.; Roth, B. Maskless lithography for versatile and low cost fabrication of polymer based micro optical structures. OSA Contin. 2020, 3, 2808–2816. [Google Scholar] [CrossRef]
- Haldar, S.; Vashisht, G.; Ghosh, U.K.; Jaiswal, A.K.; Porwal, S.; Khakha, A.; Sharma, T.K.; Dixit, V.K. Development of a simple cost-effective maskless-photolithography system. AIP Conf. Proc. 2019, 2115, 030219. [Google Scholar]
- Chromium Etching. Available online: https://www.microchemicals.eu/technical_information/chromium_etching.pdf (accessed on 20 July 2021).
- Zhang, R.; Chen, T.; Bunting, A.; Cheung, R. Optical lithography technique for the fabrication of devices from mechanically exfoliated two-dimensional materials. Microelectron. Eng. 2016, 154, 62–68. [Google Scholar] [CrossRef]
- Moon, J.; Kim, M.; Kim, S.; Xu, S.; Choi, J.; Whang, D.; Watanabe, K.; Taniguchi, T.; Park, D.S.; Seo, J.; et al. Layer-engineered large-area exfoliation of graphene. Sci. Adv. 2020, 6. [Google Scholar] [CrossRef] [PubMed]
- Doped Oxidized Si Wafers. Available online: https://graphene-supermarket.com/Silicon-Silicon-dioxide-wafer-4-Diameter-SKU175402.html (accessed on 20 July 2021).
- Shein, K.V.; Emelyanova, V.O.; Logunova, M.A.; Zarudneva, A.A.; Zavyalov, V.V.; Arutyunov, K. Kinetic Inductance in Superconducting Microstructures. J. Supercond. Nov. Magn. 2020, 33, 2325–2327. [Google Scholar] [CrossRef]
- Shein, K.V.; Zarudneva, A.A.; Emel’yanova, V.O.; Logunova, M.A.; Chichkov, V.I.; Sobolev, A.S.; Zav’yalov, V.V.; Lehtinen, J.S.; Smirnov, E.O.; Korneeva, P.; et al. Superconducting Microstructures with High Impedance. Phys. Solid State 2020, 62, 1539–1542. [Google Scholar] [CrossRef]
- Wang, Z.; Lehtinen, J.S.; Arutyunov, K.Y. Towards quantum phase slip based standard of electric current. Appl. Phys. Lett. 2019, 114, 242601. [Google Scholar] [CrossRef]
- Pham, Q.L.; Tong, N.A.N.; Mathew, A.; Basuray, S.; Voronov, R.S. A compact low-cost low-maintenance open architecture mask aligner for fabrication of multilayer microfluidics devices. Biomicrofluidics 2018, 12, 044119. [Google Scholar] [CrossRef]
- Love, J.C.; Wolfe, D.B.; Jacobs, H.O.; Whitesides, G.M. Microscope Projection Photolithography for Rapid Prototyping of Masters with Micron-Scale Features for Use in Soft Lithography. Langmuir 2001, 17, 6005–6012. [Google Scholar] [CrossRef]
- AmScope Microscope Supplier. Available online: https://www.amscope.com/compound-microscopes/40x-800x-trinocular-polarizing-metallurgical-microscope-with-top-and-bottom-lights-1.html (accessed on 20 July 2021).
- HTA Photomask. Available online: https://htaphotomask.com/index.php (accessed on 20 July 2021).
- Xiamen Powerway Advanced Material Co., Ltd. Available online: https://www.powerwaywafer.com/wafer-fabrication/photo-mask (accessed on 20 July 2021).
- Toppan Photomasks Inc. Available online: https://www.photomask.com/ (accessed on 20 July 2021).
- Elhami Nik, F.; Matthiesen, I.; Herland, A.; Winkler, T.E. Low-Cost PVD Shadow Masks with Submillimeter Resolution from Laser-Cut Paper. Micromachines 2020, 11, 676. [Google Scholar] [CrossRef]
- Yun, J.; Kim, J.; Yang, M.; Kang, B. Low-cost laser printable photomask: One-step, photoresist-free, fully solution processed high-grade photolithography mask. Appl. Surf. Sci. 2017, 394, 466–471. [Google Scholar] [CrossRef]
- Park, W.; Rhie, J.; Kim, N.Y.; Hong, S.; Kim, D.-S. Sub = 10 nm feature chromium photomasks for contact lithography patterning of square metal ring arrays. Sci. Rep. 2016, 6, 23823. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Blaikie, R.J.; Alkaisi, M.M.; McNab, S.J.; Cumming, D.R.S.; Cheung, R.; Hasko, D.G. Nanolithography using optical contact exposure in the evanescent near field. Microelectron. Eng. 1999, 46, 85–88. [Google Scholar] [CrossRef]
- Wakafuji, Y.; Moriya, R.; Masubuchi, S.; Watanabe, K.; Taniguchi, T.; Machida, T. 3D Manipulation of 2D Materials Using Microdome Polymer. Nano Lett. 2020, 20, 2486–2492. [Google Scholar] [CrossRef] [PubMed]
- Fan, S.; Vu, Q.A.; Tran, M.D.; Adhikari, S. Transfer assembly for two-dimensional van der Waals heterostructures. 2D Mater. 2020, 7, 022005. [Google Scholar] [CrossRef]
- Zhao, Q.; Wang, T.; Ryu, Y.K.; Frisenda, R.; Castellanos-Gomez, A. An inexpensive system for the deterministic transfer of 2D materials. J. Phys. Mater. 2020, 3, 016001. [Google Scholar] [CrossRef]
- Martanov, S.G.; Zhurbina, N.K.; Pugachev, M.V.; Duleba, A.I.; Akmaev, M.A.; Belykh, V.V.; Kuntsevich, A.Y. Making van derWaals Heterostructures Assembly Accessible to Everyone. Nanomaterials 2020, 10, 2305. [Google Scholar] [CrossRef] [PubMed]
- Gerasimenko, Y.; Vaskivskyi, I.; Ravnik, J.; Vodeb, J.; Kabanov, V.V.; Mihailovic, D. Ultrafast jamming of electrons into an amorphous entangled state. Nat. Mater. 2019, 18, 1078. [Google Scholar] [CrossRef] [PubMed]
- Vaskivskyi, I.; Mihailovic, I.A.; Brazovskii, S.; Gospodaric, J.; Mertelj, T.; Svetin, D.; Sutar, P.; Mihailovic, D. Fast non-thermal switching between macroscopic charge-ordered quantum states induced by charge injection. Nat. Commun. 2014, 7, 11442. [Google Scholar] [CrossRef] [PubMed]
- Mraz, A.; Venturini, R.; Diego, M.; Kranjec, A.; Svetin, D.; Gerasimenko, Y.; Sever, V.; Mihailovic, I.A.; Ravnik, J.; Vaskivskyi, I.; et al. Energy efficient manipulation of topologically protected states in non-volatile ultrafast charge configuration memory devices. arXiv 2020, arXiv:2103.04622. [Google Scholar]
- Akmaev, M.A.; Kochiev, M.V.; Duleba, A.I.; Pugachev, M.V.; Kuntsevich, A.; Belykh, V.V. Nonexponential Photoluminescence Dynamics in an Inhomogeneous Ensemble of Excitons in WSe2 Monolayers. JETP Lett. 2020, 112, 607–614. [Google Scholar] [CrossRef]
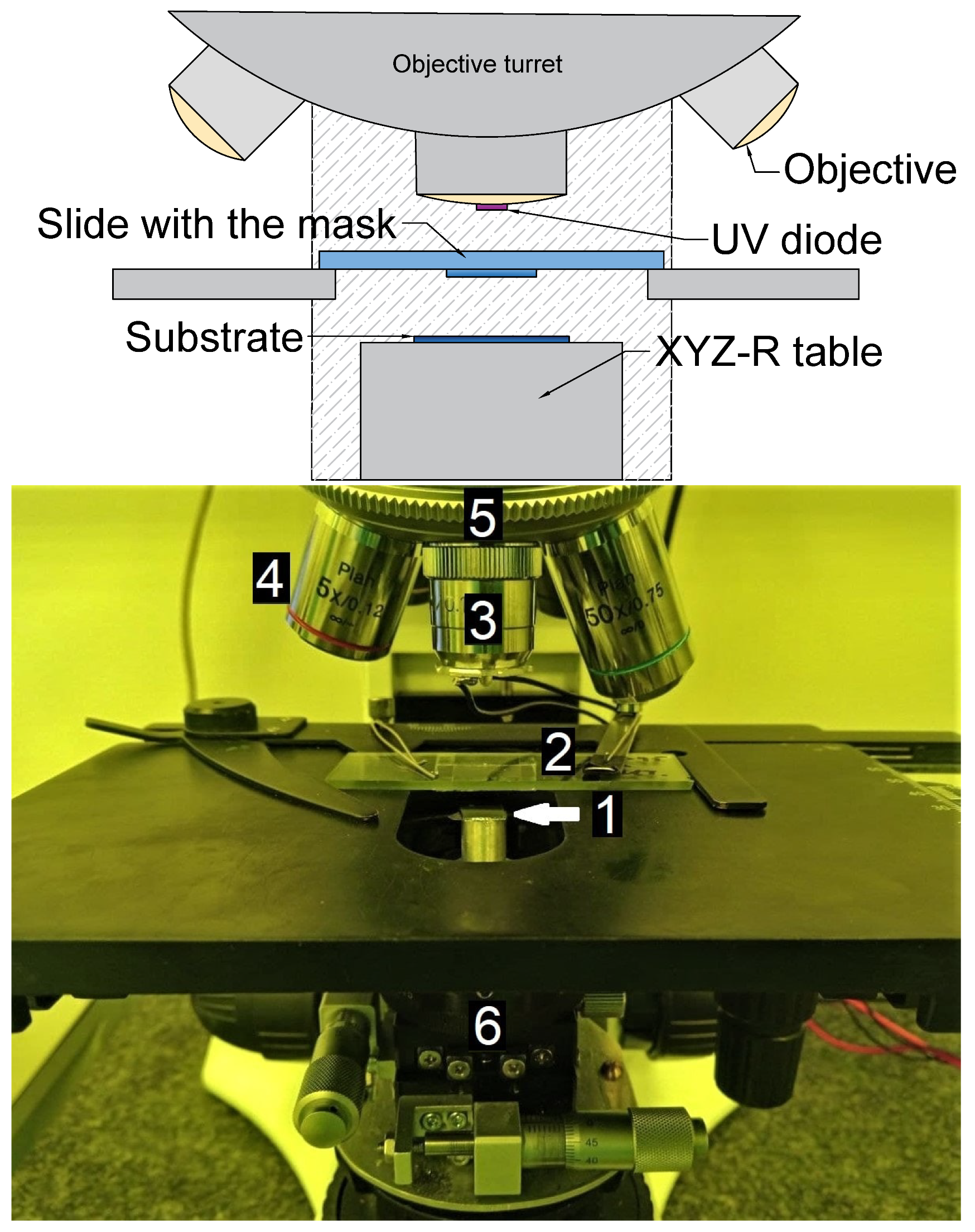
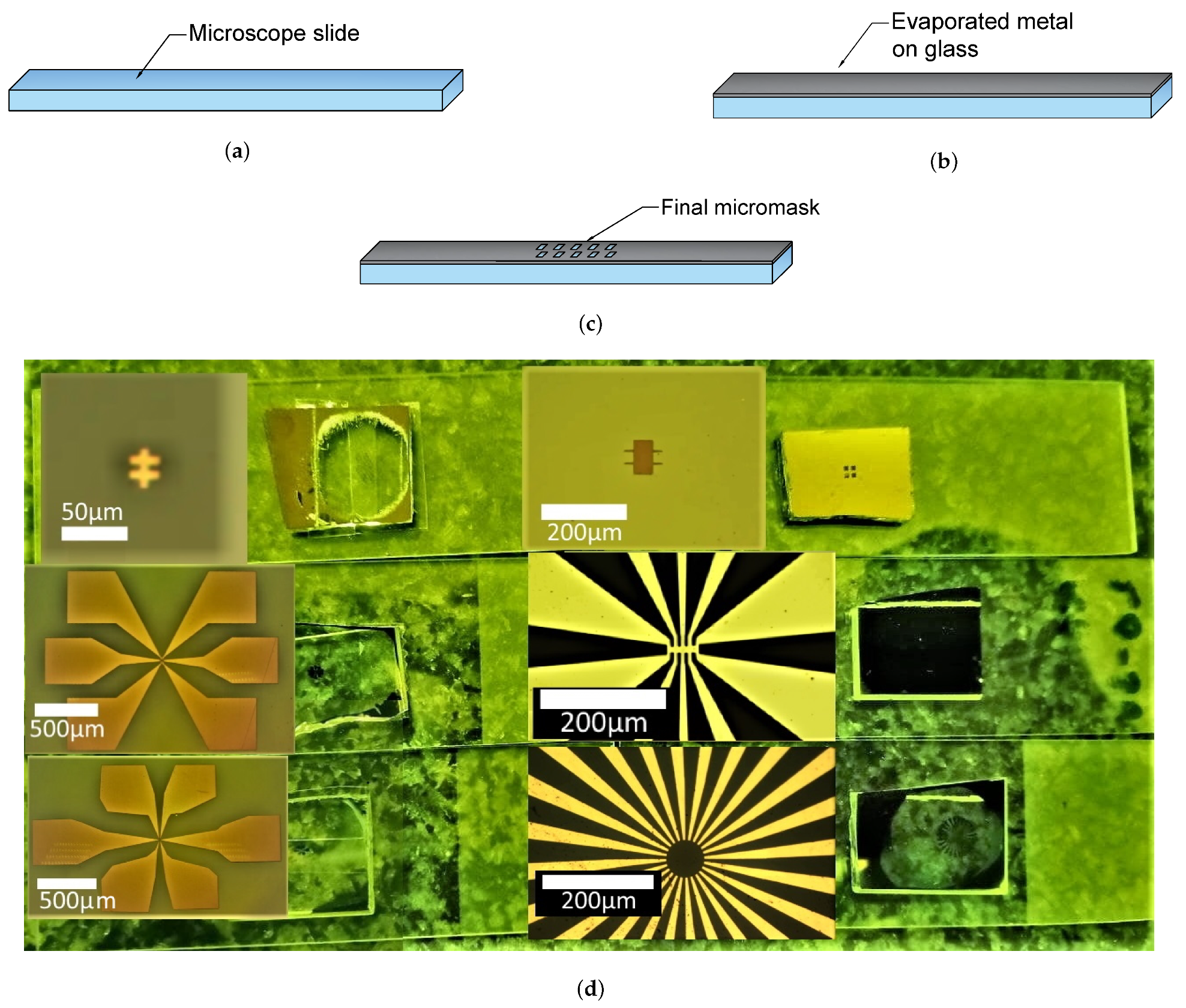
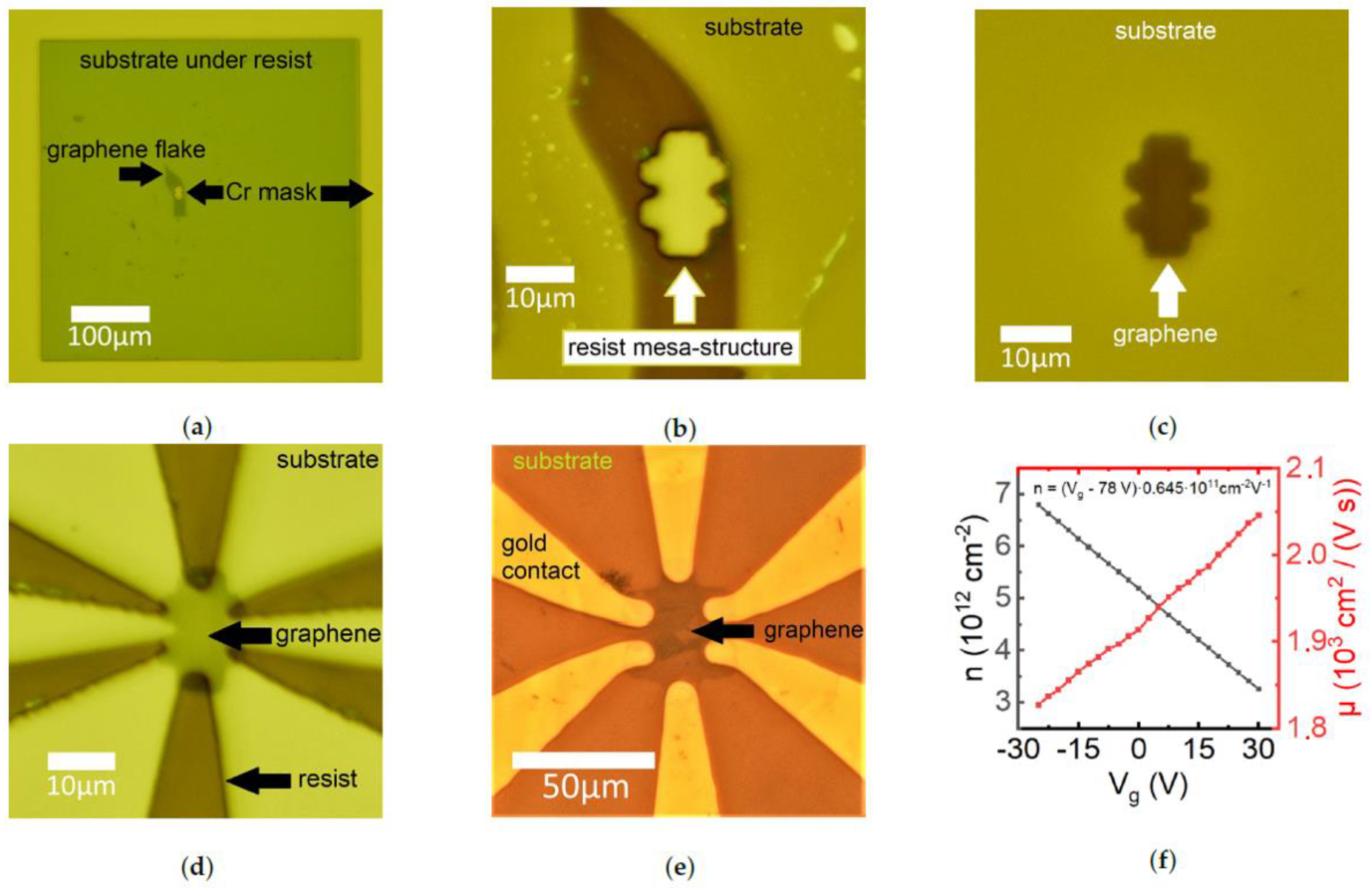
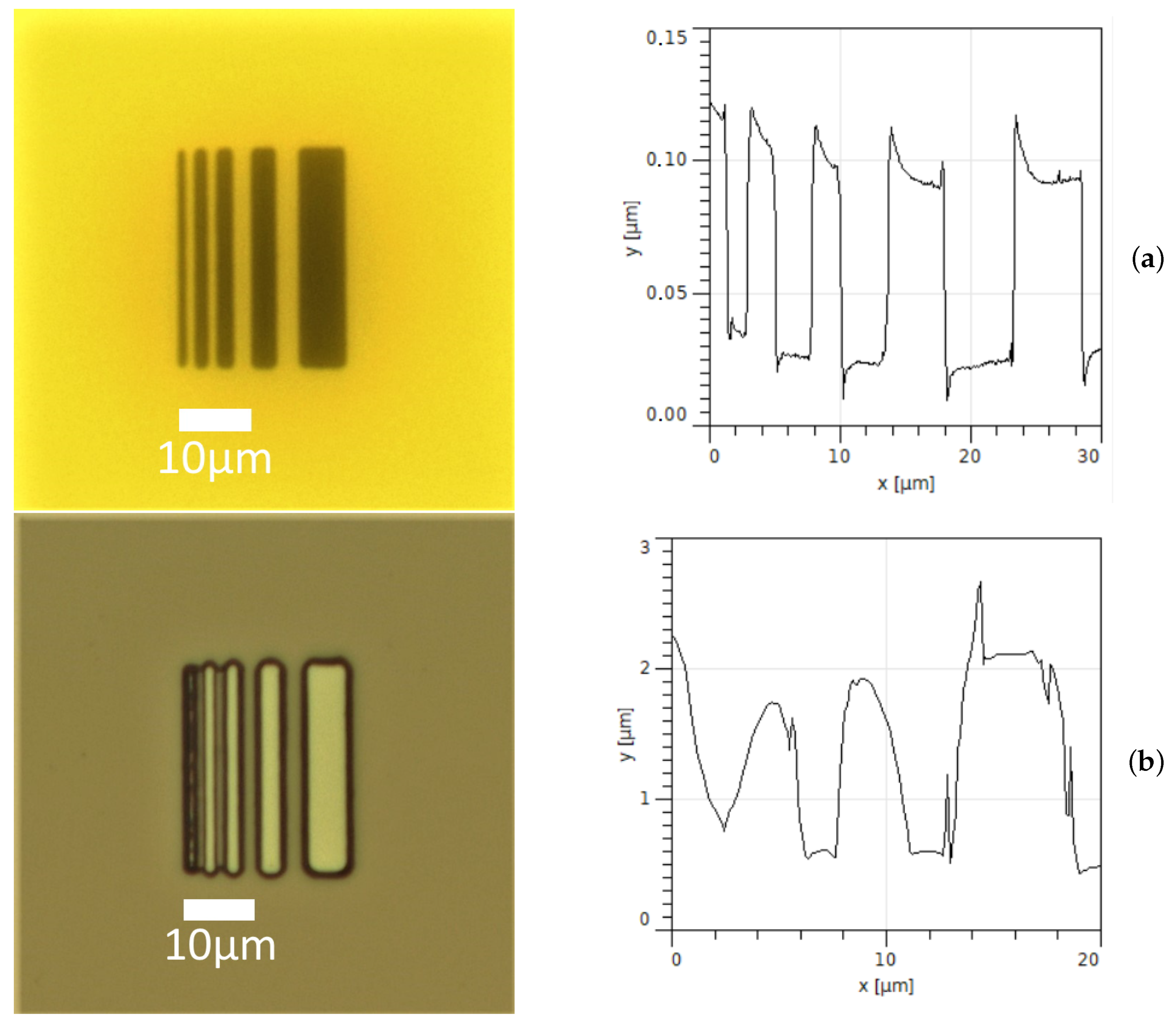
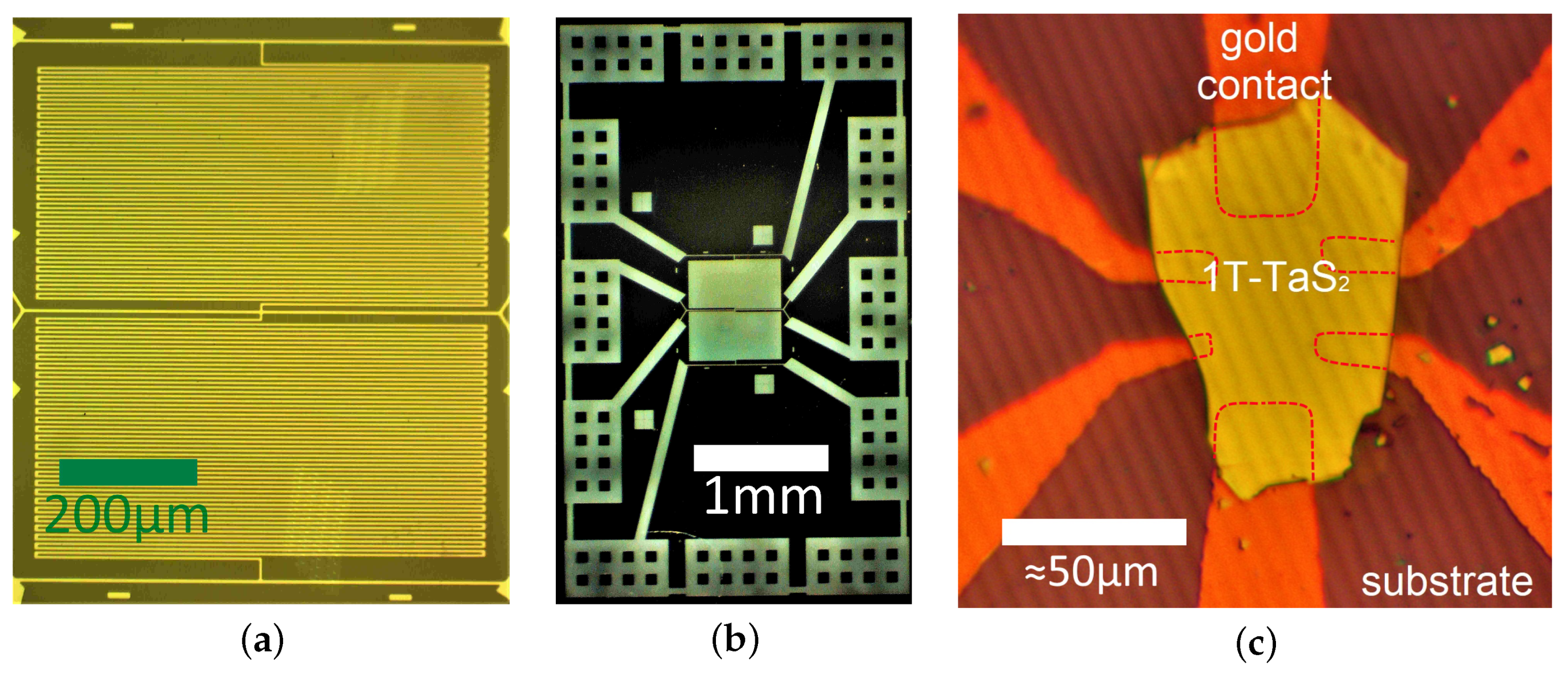
| Component | Price, USD | Website (Accessed on 20 July 2021) |
|---|---|---|
| 3 W 405 nm LED (10 pcs) | 3 | Aliexpress |
| Power supply Gophert NPS1601 | 47 | Aliexpress |
| XYZR platform | 111 | Aliexpress |
| Chromium-coated tungsten rods | 17 | Aliexpress |
| Laboratory glass slides, 150 pcs | 6 | Aliexpress |
| 1000–7000 rpm centrifuge | 180 | Aliexpress |
| 300 W LCD repair hot plate | 40 | Aliexpress |
| Photoresist FP-09-M, 0.5 l | 70 | frast.ru |
| Developer UPF-1B, 5 l | 20 | frast.ru |
| Parameter | This Work | Projection Lithographer [37] | Mask Aligner [36] | Mask Aligner [30] |
|---|---|---|---|---|
| Exposure area | 1 × 1 cm | 0.1 × 0.1 mm | 10 × 10 cm | 10 × 10 cm |
| Resolution | ∼1.5 m | 0.6 m | 3 m | ∼1 m |
| Cost of the machine | USD 200+ microscope USD 1500 | UV lamp USD 500+ microscope USD 1500 | USD 7500 | ∼USD 100,000 |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Pugachev, M.V.; Duleba, A.I.; Galiullin, A.A.; Kuntsevich, A.Y. Micromask Lithography for Cheap and Fast 2D Materials Microstructures Fabrication. Micromachines 2021, 12, 850. https://doi.org/10.3390/mi12080850
Pugachev MV, Duleba AI, Galiullin AA, Kuntsevich AY. Micromask Lithography for Cheap and Fast 2D Materials Microstructures Fabrication. Micromachines. 2021; 12(8):850. https://doi.org/10.3390/mi12080850
Chicago/Turabian StylePugachev, Mikhail V., Aliaksandr I. Duleba, Arslan A. Galiullin, and Aleksandr Y. Kuntsevich. 2021. "Micromask Lithography for Cheap and Fast 2D Materials Microstructures Fabrication" Micromachines 12, no. 8: 850. https://doi.org/10.3390/mi12080850
APA StylePugachev, M. V., Duleba, A. I., Galiullin, A. A., & Kuntsevich, A. Y. (2021). Micromask Lithography for Cheap and Fast 2D Materials Microstructures Fabrication. Micromachines, 12(8), 850. https://doi.org/10.3390/mi12080850








