Recent Progress on Extended Wavelength and Split-Off Band Heterostructure Infrared Detectors
Abstract
1. Introduction
1.1. Heterostructure IR Detectors
1.2. Performances of IR Detectors and Acceptable Figures of Merits
1.3. Spin-Orbit Split-Off Band Heterostructures Infrared Detectors
1.4. Effect of a Current Blocking Barrier on Heterojunction Infrared Detector
1.5. Threshold Wavelength Extension Mechanism
2. Conclusions
Author Contributions
Funding
Acknowledgments
Conflicts of Interest
References
- Weisbuch, C.; Vinter, B. Quantum Semiconductor Structures: Fundamentals and Applications; Elsevier: Amsterdam, The Netherlands, 2014. [Google Scholar]
- Bhimanapati, G.R.; Lin, Z.; Meunier, V.; Jung, Y.; Cha, J.; Das, S.; Xiao, D.; Son, Y.; Strano, M.S.; Cooper, V.R.; et al. Recent Advances in Two-Dimensional Materials beyond Graphene. ACS Nano 2015, 9, 11509–11539. [Google Scholar] [CrossRef]
- Petroff, P.; DenBaars, S. MBE and MOCVD growth and properties of self-assembling quantum dot arrays in III-V semiconductor structures. Superlattices Microstruct. 1994, 15, 15. [Google Scholar] [CrossRef]
- Neamen, D.A. Semiconductor Physics and Devices: Basic Principles; McGraw-Hill: New York, NY, USA, 2012. [Google Scholar]
- Nguyen, B.-M.; Hoffman, D.; Delaunay, P.-Y.; Razeghi, M. Dark current suppression in type II InAs/GaSb superlattice long wavelength infrared photodiodes with M-structure barrier. Appl. Phys. Lett. 2007, 91, 163511. [Google Scholar] [CrossRef]
- Krishna, S. Quantum dots-in-a-well infrared photodetectors. J. Phys. D Appl. Phys. 2005, 38, 2142. [Google Scholar] [CrossRef]
- Karunasiri, R.; Park, J.; Wang, K. Si1−x Ge x/Si multiple quantum well infrared detector. Appl. Phys. Lett. 1991, 59, 2588–2590. [Google Scholar] [CrossRef]
- Gunapala, S.D.; Bandara, S.V.; Singh, A.; Liu, J.K.; Rafol, B.; Luong, E.; Mumolo, J.M.; Tran, N.Q.; Ting, D.Z.-Y.; Vincent, J.D.; et al. 640/spl times/486 long-wavelength two-color GaAs/AlGaAs quantum well infrared photodetector (QWIP) focal plane array camera. IEEE Trans. Electron Devices 2000, 47, 963–971. [Google Scholar] [CrossRef]
- Chang, K.H.; Bhattacharya, P.K.; Gibala, R. Characteristics of dislocations at strained heteroepitaxial InGaAs/GaAs interfaces. J. Appl. Phys. 1989, 66, 2993–2998. [Google Scholar] [CrossRef][Green Version]
- Aziziyan, M.R.; Hassen, W.M. Electrically biased GaAs/AlGaAs heterostructures for enhanced detection of bacteria. Synth. Photonics Nanoscale Mater. Xiii 2016, 9737, 97370. [Google Scholar] [CrossRef]
- Dingle, R.; Wiegmann, W.; Henry, C.H. Quantum states of confined carriers in very thin Al x Ga 1− x As-GaAs-Al x Ga 1− x As heterostructures. Phys. Rev. Lett. 1974, 33, 827. [Google Scholar] [CrossRef]
- Adachi, S. GaAs, AlAs, and Al x Ga1− x As: Material parameters for use in research and device applications. J. Appl. Phys. 1985, 58, R1–R29. [Google Scholar] [CrossRef]
- Yablonovitch, E.; Kapon, E.; Gmitter, T.; Yun, C.; Bhat, R. Double heterostructure GaAs/AlGaAs thin film diode lasers on glass substrates. IEEE Photon Technol. Lett. 1989, 1, 41–42. [Google Scholar] [CrossRef]
- Tomioka, K.; Motohisa, J.; Hara, S.; Hiruma, K.; Fukui, T. GaAs/AlGaAs Core Multishell Nanowire-Based Light-Emitting Diodes on Si. Nano Lett. 2010, 10, 1639–1644. [Google Scholar] [CrossRef]
- Lade, S.J.; Zahedi, A. A revised ideal model for AlGaAs/GaAs quantum well solar cells. Microelectron. J. 2004, 35, 401–410. [Google Scholar] [CrossRef]
- Chauhan, D.; Perera, A.; Li, L.; Chen, L.; Linfield, E. Effect of a current blocking barrier on a 2–6 μ m p-GaAs/AlGaAs heterojunction infrared detector. Appl. Phys. Lett. 2016, 108, 201105. [Google Scholar] [CrossRef]
- Gunapala, S.D.; Bundara, S.; Liu, J.K.; Hong, W.; Sundaram, M.; Maker, P.D.; Muller, R.E.; Shott, C.A.; Carralejo, R. Long-wavelength 640/spl times/486 GaAs-AlGaAs quantum well infrared photodetector snap-shot camera. IEEE Trans. Electron. Devices 1998, 45, 1890–1895. [Google Scholar] [CrossRef]
- Gunapala, S.D.; Bandara, S.V.; Liu, J.K.; Luong, E.; Stetson, N.; Shott, C.A.; Bock, J.J.; Rafol, S.B.; Mumolo, J.M.; McKelvey, M.J. Long-wavelength 256/spl times/256 GaAs/AlGaAs quantum well infrared photodetector (QWIP) palm-size camera. IEEE Trans. Electron. Devices 2000, 47, 326–332. [Google Scholar] [CrossRef]
- Weerasekara, A.; Rinzan, M.; Matsik, S.; Perera, A.G.; Buchanan, M.; Liu, H.C.; Von Winckel, G.; Stintz, A.; Krishna, S. n-Type GaAs/AlGaAs heterostructure detector with a 32 THz threshold frequency. Opt. Lett. 2007, 32, 1335–1337. [Google Scholar] [CrossRef]
- Dai, X.; Zhang, S.; Wang, Z.; Adamo, G.; Liu, H.; Huang, Y.; Couteau, C.; Soci, C. GaAs/AlGaAs Nanowire Photodetector. Nano Lett. 2014, 14, 2688–2693. [Google Scholar] [CrossRef]
- Casey, H.C.; Panish, M.B. Heterostructure Lasers: Materials and Operating Characteristics; Academic Pr: Cambridge, MA, USA, 1978. [Google Scholar]
- Chang, K.H.; Lee, C.P.; Wu, J.S.; Liu, D.G.; Liou, D.C.; Wang, M.H.; Chen, L.J.; Marais, M.A. Precise determination of aluminum content in AlGaAs. J. Appl. Phys. 1991, 70, 4877–4882. [Google Scholar] [CrossRef]
- Esaev, D.; Rinzan, M.; Matsik, S.; Perera, A. Design and optimization of GaAs/AlGaAs heterojunction infrared detectors. J. Appl. Phys. 2004, 96, 4588–4597. [Google Scholar] [CrossRef]
- Rogalski, A.; Chrzanowski, K. 18 Infrared devices and techniques. In Nanophotonics and Plasmonics; Informa UK Ltd.: Colchester, UK, 2017; pp. 633–686. [Google Scholar]
- Rogalski, A. Infrared and Terahertz Detectors; CRC Press: Boca Raton, FL, USA, 2019. [Google Scholar]
- Coon, D.D.; Karunasiri, R.P.G. New mode of IR detection using quantum wells. Appl. Phys. Lett. 1984, 45, 649. [Google Scholar] [CrossRef]
- Rogalski, A. Heterostructure infrared photovoltaic detectors. Infrared Phys. Technol. 2000, 41, 213–238. [Google Scholar] [CrossRef]
- Ariyawansa, G.; Rinzan, M.B.M.; Alevli, M.; Strassburg, M.; Dietz, N.; Perera, A.G.U.; Matsik, S.G.; Asghar, A.; Ferguson, I.T.; Luo, H.; et al. GaN/AlGaN ultraviolet/infrared dual-band detector. Appl. Phys. Lett. 2006, 89, 091113. [Google Scholar] [CrossRef]
- Perera, A.G.U. Heterojunction and superlattice detectors for infrared to ultraviolet. Prog. Quantum Electron. 2016, 48, 1–56. [Google Scholar] [CrossRef]
- Tong, J.; Tobing, L.Y.; Qiu, S.; Zhang, D.H.; Perera, A.U. Room temperature Plasmon-enhanced InAs0. 91Sb0. 09-based heterojunction nip mid-wave infrared photodetector. Appl. Phys. Lett. 2018, 113, 011110. [Google Scholar] [CrossRef]
- Kouvetakis, J.; Chizmeshya, A.V.G. New classes of Si-based photonic materials and device architectures via designer molecular routes. J. Mater. Chem. 2007, 17, 1649. [Google Scholar] [CrossRef]
- Lin, Y.; Donetsky, D.; Wang, D.; Westerfeld, D.; Kipshidze, G.; Shterengas, L.; Sarney, W.L.; Svensson, S.P.; Belenky, G. Development of Bulk InAsSb Alloys and Barrier Heterostructures for Long-Wave Infrared Detectors. J. Electron. Mater. 2015, 44, 3360–3366. [Google Scholar] [CrossRef]
- Tsaur, B.-Y.; Chen, C.; Marino, S. Long-wavelength Ge/sub x/Si/sub 1-x//Si heterojunction infrared detectors and 400*400-element imager arrays. IEEE Electron. Device Lett. 1991, 12, 293–296. [Google Scholar] [CrossRef]
- Harris, D.C. Durable 3–5 μm transmitting infrared window materials. Infrared Phys. Technol. 1998, 39, 185–201. [Google Scholar] [CrossRef]
- Salisbury, J.W.; D’Aria, D.M. Emissivity of terrestrial materials in the 8–14 μm atmospheric window. Remote Sens. Environ. 1992, 42, 83–106. [Google Scholar] [CrossRef]
- Bastard, G.; Schulman, J. Wave Mechanics Applied to Semiconductor Heterostructures. Phys. Today 1992, 45, 103. [Google Scholar] [CrossRef]
- Moreau, W.M. Semiconductor Lithography: Principles, Practices, and Materials; Springer Science & Business Media: Berlin, Germany, 2012. [Google Scholar]
- Pelzel, R. A comparison of MOVPE and MBE growth technologies for III-V epitaxial structures. In Proceedings of the CS MANTECH Conference, New Orleans, LA, USA, 13–16 May 2013; pp. 105–108. [Google Scholar]
- Tobin, S.; Vernon, S.; Bajgar, C.; Wojtczuk, S.; Melloch, M.; Keshavarzi, A.; Stellwag, T.; Venkatensan, S.; Lundström, M.; Emery, K. Assessment of MOCVD- and MBE-growth GaAs for high-efficiency solar cell applications. IEEE Trans. Electron. Devices 1990, 37, 469–477. [Google Scholar] [CrossRef]
- Horikoshi, Y.; Kawashima, M.; Yamaguchi, H. Migration-Enhanced Epitaxy of GaAs and AlGaAs. Jpn. J. Appl. Phys. 1988, 27, 169–179. [Google Scholar] [CrossRef]
- Lundstrom, M.; Schuelke, R. Numerical analysis of heterostructure semiconductor devices. IEEE Trans. Electron. Devices 1983, 30, 1151–1159. [Google Scholar] [CrossRef]
- Tersoff, J. Theory of semiconductor heterojunctions: The role of quantum dipoles. Phys. Rev. B 1984, 30, 4874–4877. [Google Scholar] [CrossRef]
- Capasso, F.; Cho, A.Y. Bandgap engineering of semiconductor heterostructures by molecular beam epitaxy: Physics and applications. Surf. Sci. 1994, 299, 878–891. [Google Scholar] [CrossRef]
- Liu, Q.; Zhang, X.; Abdalla, L.B.; Zunger, A. Transforming Common III-V and II-VI Semiconductor Compounds into Topological Heterostructures: The Case of CdTe/InSb Superlattices. Adv. Funct. Mater. 2016, 26, 3259–3267. [Google Scholar] [CrossRef]
- Chang, K.H.; Gilbala, R.; Srolovitz, D.J.; Bhattacharya, P.K.; Mansfield, J.F. Crosshatched surface morphology in strained III-V semiconductor films. J. Appl. Phys. 1990, 67, 4093–4098. [Google Scholar] [CrossRef]
- Ting, D.Z.; Soibel, A.; Hill, C.; Nguyen, J.; Keo, S.; Rafol, S.B.; Yang, B.; Lee, M.C.; Mumolo, J.; Liu, J.; et al. Antimonide superlattice complementary barrier infrared detector (CBIRD). Infrared Phys. Technol. 2011, 54, 267–272. [Google Scholar] [CrossRef]
- Lin, T.; Maserjian, J. Novel Si1− x Ge x/Si heterojunction internal photoemission long-wavelength infrared detectors. Appl. Phys. Lett. 1990, 57, 1422–1424. [Google Scholar] [CrossRef]
- Yu, J.S.; Ko, Y.H.; Nagaraju, G. Low-dimensional II-VI oxide-based semiconductor nanostructure photodetectors for light sensing. Quantum Sens. Nanophotonic Devices Xii 2015, 9370, 93702. [Google Scholar] [CrossRef]
- Piotrowski, J.; Rogalski, A. New generation of infrared photodetectors. Sens. Actuators A Phys. 1998, 67, 146–152. [Google Scholar] [CrossRef]
- Rogalski, A. Recent progress in infrared detector technologies. Infrared Phys. Technol. 2011, 54, 136–154. [Google Scholar] [CrossRef]
- Rogalski, A.; Adamiec, K.; Rutkowski, J. Narrow-Gap Semiconductor Photodiodes; SPIE Press: Bellingham, WA, USA, 2000; Volume 77. [Google Scholar]
- Bratt, P.R. Potential barriers in HgCdTe heterojunctions. J. Vac. Sci. Technol. A 1985, 3, 238–245. [Google Scholar] [CrossRef]
- Rogalski, A. Infrared detectors: Status and trends. Prog. Quantum Electron. 2003, 27, 59–210. [Google Scholar] [CrossRef]
- Levine, B.F. Quantum-well infrared photodetectors. J. Appl. Phys. 1993, 74, 1. [Google Scholar] [CrossRef]
- Krishna, S.; Gunapala, S.; Bandara, S.; Hill, C.; Ting, D. Quantum Dot Based Infrared Focal Plane Arrays. Proc. IEEE 2007, 95, 1838–1852. [Google Scholar] [CrossRef]
- Jones, R.C. Performance of Detectors for Visible and Infrared Radiation. In Advances in Electronics and Electron Physics; Elsevier B.V.: Danvers, MA, USA, 1953; Volume 5, pp. 1–96. [Google Scholar]
- Paschotta, R. Avalanche photodiodes. Encycl. Laser Phys. Technol. 2008. Available online: https://www.rp-photonics.com/avalanche_photodiodes.html (accessed on 21 April 2020).
- Field, H. UV-VIS-IR spectral responsivity measurements system for solar cells. In Proceedings of the National Center for photovoltaics (NCPV) 15th Program Review Meeting, Denver, CO, USA, 9–11 September 1998; pp. 629–635. [Google Scholar] [CrossRef]
- Andersson, J.Y.; Lundqvist, L. Near?unity quantum efficiency of AlGaAs/GaAs quantum well infrared detectors using a waveguide with a doubly periodic grating coupler. Appl. Phys. Lett. 1991, 59, 857–859. [Google Scholar] [CrossRef]
- Dereniak, E.L.; Boreman, G.D. Infrared Detectors and Systems; Wiley: New York, NY, USA, 1996; Volume 306. [Google Scholar]
- Cervera, C.; Baier, N.; Gravrand, O.; Mollard, L.; Lobre, C.; Destéfanis, G.; Zanatta, J.P.; Boulade, O.; Moreau, V. Low-dark current p-on-n MCT detector in long and very long-wavelength infrared. Infrared Technol. Appl. Xli 2015, 9451, 945129. [Google Scholar] [CrossRef]
- Chauhan, D.; Perera, A.G.U.; Li, L.; Chen, L.; Linfield, E.H. Dark current and photoresponse characteristics of extended wavelength infrared photodetectors. J. Appl. Phys. 2017, 122, 024501. [Google Scholar] [CrossRef]
- Weber, E.R.; Willardson, R.K.; Liu, H.; Capasso, F. Intersubband Transitions in Quantum Wells: Physics and Device Applications; Academic press: San Diego, CA, USA, 1999. [Google Scholar]
- Bie, Y.-Q.; Liao, Z.-M.; Zhang, H.; Li, G.-R.; Ye, Y.; Zhou, Y.; Xu, J.; Qin, Z.-X.; Dai, L.; Yu, D. Self-Powered, Ultrafast, Visible-Blind UV Detection and Optical Logical Operation based on ZnO/GaN Nanoscale p-n Junctions. Adv. Mater. 2010, 23, 649–653. [Google Scholar] [CrossRef] [PubMed]
- Vasko, F.T.; Kuznetsov, A.V. Electronic States and Optical Transitions in Semiconductor Heterostructures; Springer Science and Business Media LLC: Berlin, Germany, 1999. [Google Scholar]
- Souri, D.; Tahan, Z.E. A new method for the determination of optical band gap and the nature of optical transitions in semiconductors. Appl. Phys. A 2015, 119, 273–279. [Google Scholar] [CrossRef]
- Zhuravlev, K.S.; A Kolosanov, V.; Milekhin, A.G.; Polovinkin, V.; Shamirzaev, T.S.; Rakov, Y.N.; Myakishev, Y.B.; Fryar, J.; McGlynn, E.; O Henry, M. Infrared light emission from GaAs MESFETs operating at avalanche breakdown conditions. Semicond. Sci. Technol. 2004, 19, S94–S95. [Google Scholar] [CrossRef]
- Hoff, J.; Razeghi, M.; Brown, G.J. Effect of the spin split-off band on optical absorption in p-type Ga 1− x In x As y P 1− y quantum-well infrared detectors. Phys. Rev. B 1996, 54, 10773. [Google Scholar] [CrossRef] [PubMed]
- Lao, Y.F.; Perera, A.G.U.; Wang, H.L.; Zhao, J.; Jin, Y.; Zhang, D.H. Optical characteristics of p-type GaAs-based semiconductors towards applications in photoemission infrared detectors. J. Appl. Phys. 2016, 119, 105304. [Google Scholar] [CrossRef]
- Perera, A.G.U.; Matsik, S.; Jayaweera, P.V.V.; Tennakone, K.; Liu, H.C.; Buchanan, M.; Von Winckel, G.; Stintz, A.; Krishna, S. High operating temperature split-off band infrared detectors. Appl. Phys. Lett. 2006, 89, 131118. [Google Scholar] [CrossRef]
- Jayaweera, P.; Matsik, S.; Tennakone, K.; Perera, A.G.U.; Liu, H.; Krishna, S. Spin split-off transition based IR detectors operating at high temperatures. Infrared Phys. Technol. 2007, 50, 279–283. [Google Scholar] [CrossRef]
- Perera, A.G.U.; Jayaweera, P.; Matsik, S.; Liu, H.; Buchanan, M.; Wasilewski, Z. Operating temperature and the responsivity of split-off band detectors. Infrared Phys. Technol. 2009, 52, 241–246. [Google Scholar] [CrossRef]
- Esaev, D.G.; Rinzan, M.B.M.; Matsik, S.; Perera, A.G.U.; Liu, H.C.; Zvonkov, B.N.; Gavrilenko, V.I.; Belyanin, A.A. High performance single emitter homojunction interfacial work function far infrared detectors. J. Appl. Phys. 2004, 95, 512–519. [Google Scholar] [CrossRef]
- Perera, A.G.U.; Shen, W.; Liu, H.; Buchanan, M.; Schaff, W. GaAs homojunction interfacial workfunction internal photoemission (HIWIP) far-infrared detectors. Mater. Sci. Eng. B 2000, 74, 56–60. [Google Scholar] [CrossRef]
- Jayaweera, P.V.V.; Matsik, S.G.; Perera, A.G.U.; Liu, H.C.; Buchanan, M.; Wasilewski, Z.R. Uncooled infrared detectors for 3–5μm and beyond. Appl. Phys. Lette. 2008, 93, 021105. [Google Scholar] [CrossRef]
- Lao, Y.; Pitigala, P.K.D.D.; Perera, A.G.U.; Liu, H.C.; Buchanan, M.; Wasilewski, Z.R.; Choi, K.; Wijewarnasuriya, P. Light-hole and heavy-hole transitions for high-temperature long-wavelength infrared detection. Appl. Phys. Lett. 2010, 97, 091104. [Google Scholar] [CrossRef]
- Matsik, S.; Jayaweera, P.V.V.; Perera, A.G.U.; Choi, K.; Wijewarnasuriya, P. Device modeling for split-off band detectors. J. Appl. Phys. 2009, 106, 064503. [Google Scholar] [CrossRef]
- Perera, A.G.U.; Jayaweera, P.; Ariyawansa, G.; Matsik, S.; Tennakone, K.; Buchanan, M.; Liu, H.; Su, X.; Bhattacharya, P. Room temperature nano- and microstructure photon detectors. Microelectron. J. 2009, 40, 507–511. [Google Scholar] [CrossRef]
- Pitigala, P.K.D.D.; Matsik, S.; Perera, A.G.U.; Khanna, S.; Li, L.; Linfield, E.H.; Wasilewski, Z.R.; Buchanan, M.; Liu, H.C. Photovoltaic infrared detection with p-type graded barrier heterostructures. J. Appl. Phys. 2012, 111, 084505. [Google Scholar] [CrossRef]
- Perera, A.G.U.; Matsik, S.G.; Yaldiz, B.; Liu, H.C.; Shen, A.; Gao, M.; Wasilewski, Z.R.; Buchanan, M. Heterojunction wavelength-tailorable far-infrared photodetectors with response out to 70 µm. Appl. Phys. Lett. 2001, 78, 2241–2243. [Google Scholar] [CrossRef]
- Wang, S.Y.; Lin, S.D.; Wu, H.W.; Lee, C.P. Low dark current quantum-dot infrared photodetectors with an AlGaAs current blocking layer. Appl. Phys. Lett. 2001, 78, 1023–1025. [Google Scholar] [CrossRef]
- Rotella, P.; Raghavan, S.; Stintz, A.; Fuchs, B.; Krishna, S.; Morath, C.; Le, D.; Kennerly, S. Normal incidence InAs/InGaAs dots-in-well detectors with current blocking AlGaAs layer. J. Cryst. Growth 2003, 251, 787–793. [Google Scholar] [CrossRef]
- Wang, S.; Lin, S.; Wu, H.; Lee, C. High performance InAs/GaAs quantum dot infrared photodetectors with AlGaAs current blocking layer. Infrared Phys. Technol. 2001, 42, 473–477. [Google Scholar] [CrossRef]
- Lin, S.-Y.; Tsai, Y.-R.; Lee, S.-C. High-performance InAs/GaAs quantum-dot infrared photodetectors with a single-sided Al0.3Ga0.7As blocking layer. Appl. Phys. Lett. 2001, 78, 2784–2786. [Google Scholar] [CrossRef]
- Pal, D.; Towe, E. Uniformly doped InAs/GaAs quantum-dot infrared photodetectors with AlGaAs current blocking layer. In Proceedings of the 5th IEEE Conference on Nanotechnology, Nagoya, Japan, 15 July 2005; Institute of Electrical and Electronics Engineers (IEEE): Piscataway, NJ, USA, 2005; pp. 418–421. [Google Scholar]
- Nevou, L.; Liverini, V.; Castellano, F.; Bismuto, A.; Faist, J. Asymmetric heterostructure for photovoltaic InAs quantum dot infrared photodetector. Appl. Phys. Lett. 2010, 97, 23505. [Google Scholar] [CrossRef]
- Stiff, A.; Krishna, S.; Bhattacharya, P.; Kennerly, S. Normal-incidence, high-temperature, mid-infrared, InAs-GaAs vertical quantum-dot infrared photodetector. IEEE J. Quantum Electron. 2001, 37, 1412–1419. [Google Scholar] [CrossRef]
- Tang, S.-F.; Lin, S.-Y.; Lee, S.-C. Near-room-temperature operation of an InAs/GaAs quantum-dot infrared photodetector. Appl. Phys. Lett. 2001, 78, 2428–2430. [Google Scholar] [CrossRef]
- Chakrabarti, S.; Stiff-Roberts, A.; Bhattacharya, P.; Gunapala, S.; Bandara, S.; Rafol, S.; Kennerly, S. High-Temperature Operation of InAs–GaAs Quantum-Dot Infrared Photodetectors With Large Responsivity and Detectivity. IEEE Photon Technol. Lett. 2004, 16, 1361–1363. [Google Scholar] [CrossRef]
- Nguyen, B.-M.; Bogdanov, S.; Pour, S.A.; Razeghi, M. Minority electron unipolar photodetectors based on type II InAs/GaSb/AlSb superlattices for very long wavelength infrared detection. Appl. Phys. Lett. 2009, 95, 183502. [Google Scholar] [CrossRef]
- Ting, D.Z.; Hill, C.; Soibel, A.; Keo, S.; Mumolo, J.; Nguyen, J.; Gunapala, S.D. A high-performance long wavelength superlattice complementary barrier infrared detector. Appl. Phys. Lett. 2009, 95, 023508. [Google Scholar] [CrossRef]
- Gautam, N.; Kim, H.S.; Kutty, M.N.; Plis, E.; Dawson, L.R.; Krishna, S. Performance improvement of longwave infrared photodetector based on type-II InAs/GaSb superlattices using unipolar current blocking layers. Appl. Phys. Lett. 2010, 96, 231107. [Google Scholar] [CrossRef]
- Somvanshi, D.; Chauhan, D.; Lao, Y.-F.; Perera, A.G.U.; Li, L.; Khanna, S.; Linfield, E.H. Analysis of Extended Threshold Wavelength Photoresponse in Nonsymmetrical p-GaAs/AlGaAs Heterostructure Photodetectors. IEEE J. Sel. Top. Quantum Electron. 2018, 24, 1–7. [Google Scholar] [CrossRef]
- Shah, J. Hot electrons and phonons under high intensity photoexcitation of semiconductors. Solid-State Electron. 1978, 21, 43–50. [Google Scholar] [CrossRef]
- Ulbrich, R. Low density photoexcitation phenomena in semiconductors: Aspects of theory and experiment. Solid-State Electron. 1978, 21, 51–59. [Google Scholar] [CrossRef]
- Shah, J. Investigation of hot carrier relaxation with picosecond laser pulses. Le J. De Phys. Colloq. 1981, 42, 7. [Google Scholar] [CrossRef]
- Hayes, J.R.; Levi, A.F.J.; Wiegmann, W. Hot-Electron Spectroscopy of GaAs. Phys. Rev. Lett. 1985, 54, 1570–1572. [Google Scholar] [CrossRef] [PubMed]
- Shah, J. Hot carriers in quasi-2-D polar semiconductors. IEEE J. Quantum Electron. 1986, 22, 1728–1743. [Google Scholar] [CrossRef]
- Chauhan, D.; Perera, A.U.; Li, L.; Chen, L.; Khanna, S.; Linfield, E.H. Extended wavelength infrared photodetectors. Opt. Eng. 2017, 56, 091605. [Google Scholar] [CrossRef]
- Chauhan, D.; Perera, A.G.U.; Li, L.; Chen, L.; Linfield, E. Study of infrared photodetectors with wavelength extension mechanism. Infrared Phys. Technol. 2018, 95, 148–151. [Google Scholar] [CrossRef]
- Chauhan, D.; Perera, A.G.U.; Li, L.; Chen, L.; Linfield, E.H. Effects of Barrier Energy Offset and Gradient in Extended Wavelength Infrared Detectors. IEEE Sens. Lett. 2018, 2, 1–4. [Google Scholar] [CrossRef]
- Somvanshi, D.; Chauhan, D.; Perera, A.G.U.; Li, L.; Chen, L.; Linfield, E.H. Reduced Dark Current With a Specific Detectivity Advantage in Extended Threshold Wavelength Infrared Detector. IEEE Sens. Lett. 2019, 3, 1–4. [Google Scholar] [CrossRef]
- Somvanshi, D.; Chauhan, D.; Perera, A.G.U.; Li, L.; Chen, L.; Linfield, E.H. Analysis of Barrier Parameters on the Extended Threshold Wavelength of Infrared Detectors. IEEE Photon Technol. Lett. 2018, 30, 1617–1620. [Google Scholar] [CrossRef]
- Norton, P. Infrared detectors in the next millennium. Aerosense ’99 1999, 3698, 652–665. [Google Scholar] [CrossRef]
- Rogalski, A. Infrared detectors: An overview. Infrared Phys. Technol. 2002, 43, 187–210. [Google Scholar] [CrossRef]
- Szakmany, G.P.; Krenz, P.M.; Orlov, A.O.; Bernstein, G.H.; Porod, W. Antenna-coupled nanowire thermocouples for infrared detection. IEEE Trans. Nanotechnol. 2012, 12, 163–167. [Google Scholar] [CrossRef]
- Rogalski, A. Infrared Detectors; CRC Press: Boca Raton, FL, USA, 2010. [Google Scholar]
- Fernandes, L.O.T.; Kaufmann, P.; Marcon, R.; Kudaka, A.S.; Marun, A.; Godoy, R.; Bortolucci, E.C.; Zakia, M.B.; Diniz, J.A. Photometry of THz radiation using Golay cell detector. 2011 XXXth URSI Gen. Assem. Sci. Symp. 2011, 1–4. [Google Scholar] [CrossRef]
- Shankar, M.; Burchett, J.; Hao, Q.; Guenther, B.D.; Brady, D.J. Human-tracking systems using pyroelectric infrared detectors. Opt. Eng. 2006, 45, 106401. [Google Scholar] [CrossRef]
- Gallop, J.C. SQUIDs, the Josephson Effects and Superconducting Electronics; Informa UK Ltd.: Colchester, UK, 2017. [Google Scholar]
- Raissi, F.; Far, M. Highly sensitive PtSi/porous Si Schottky detectors. IEEE Sens. J. 2002, 2, 476–481. [Google Scholar] [CrossRef]
- Urich, A.; Unterrainer, K.; Mueller, T. Intrinsic Response Time of Graphene Photodetectors. Nano Lett. 2011, 11, 2804–2808. [Google Scholar] [CrossRef] [PubMed]
- Ellis, A.R.; Reno, J.L.; Tsui, D.C.; Majumdar, A.; Choi, K. Binary superlattice quantum-well infrared photodetectors for long-wavelength broadband detection. Appl. Phys. Lett. 2004, 84, 5127. [Google Scholar] [CrossRef]
- Lewis, E.N.; Treado, P.J.; Reeder, R.C.; Story, G.M.; Dowrey, A.E.; Marcott, C.; Levin, I.W. Fourier Transform Spectroscopic Imaging Using an Infrared Focal-Plane Array Detector. Anal. Chem. 1995, 67, 3377–3381. [Google Scholar] [CrossRef]


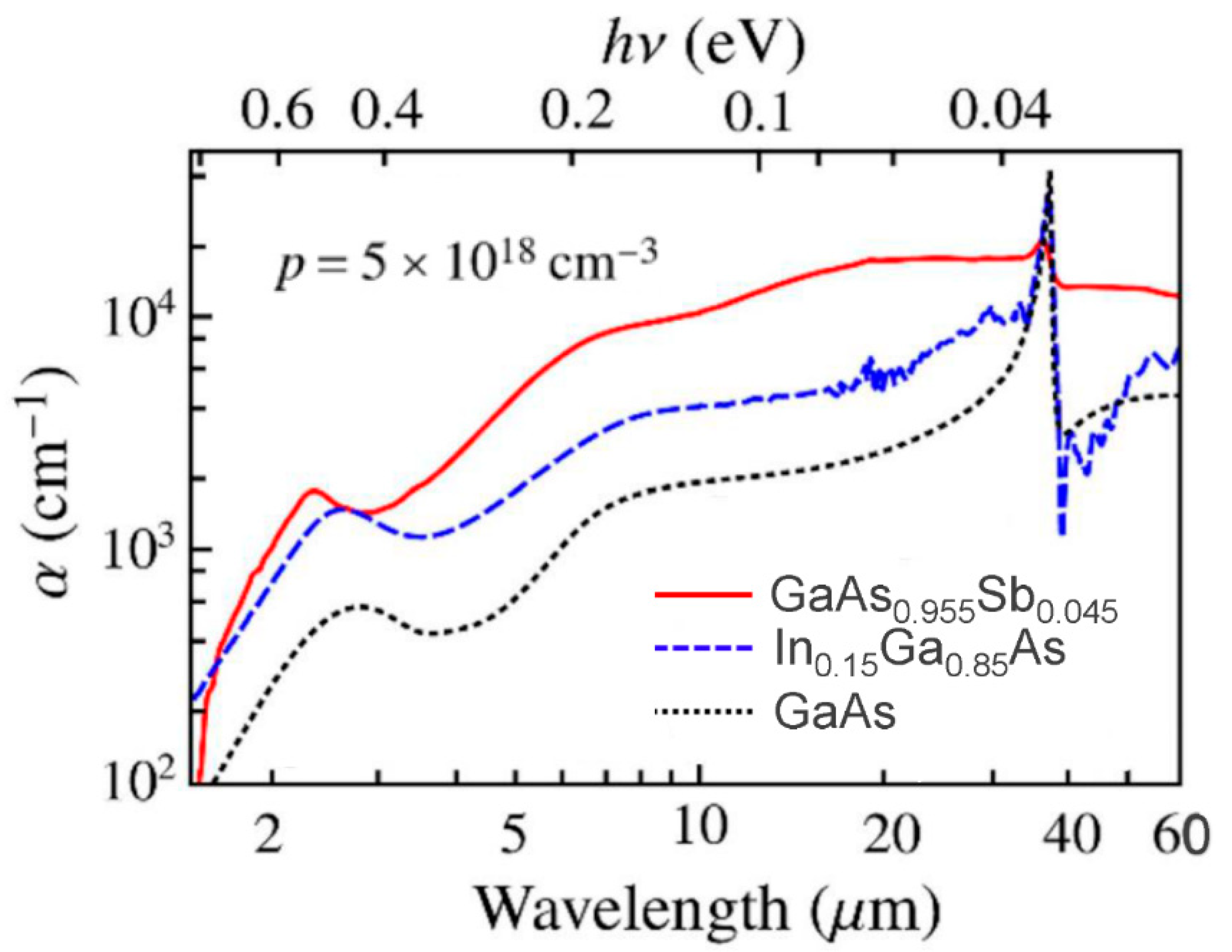


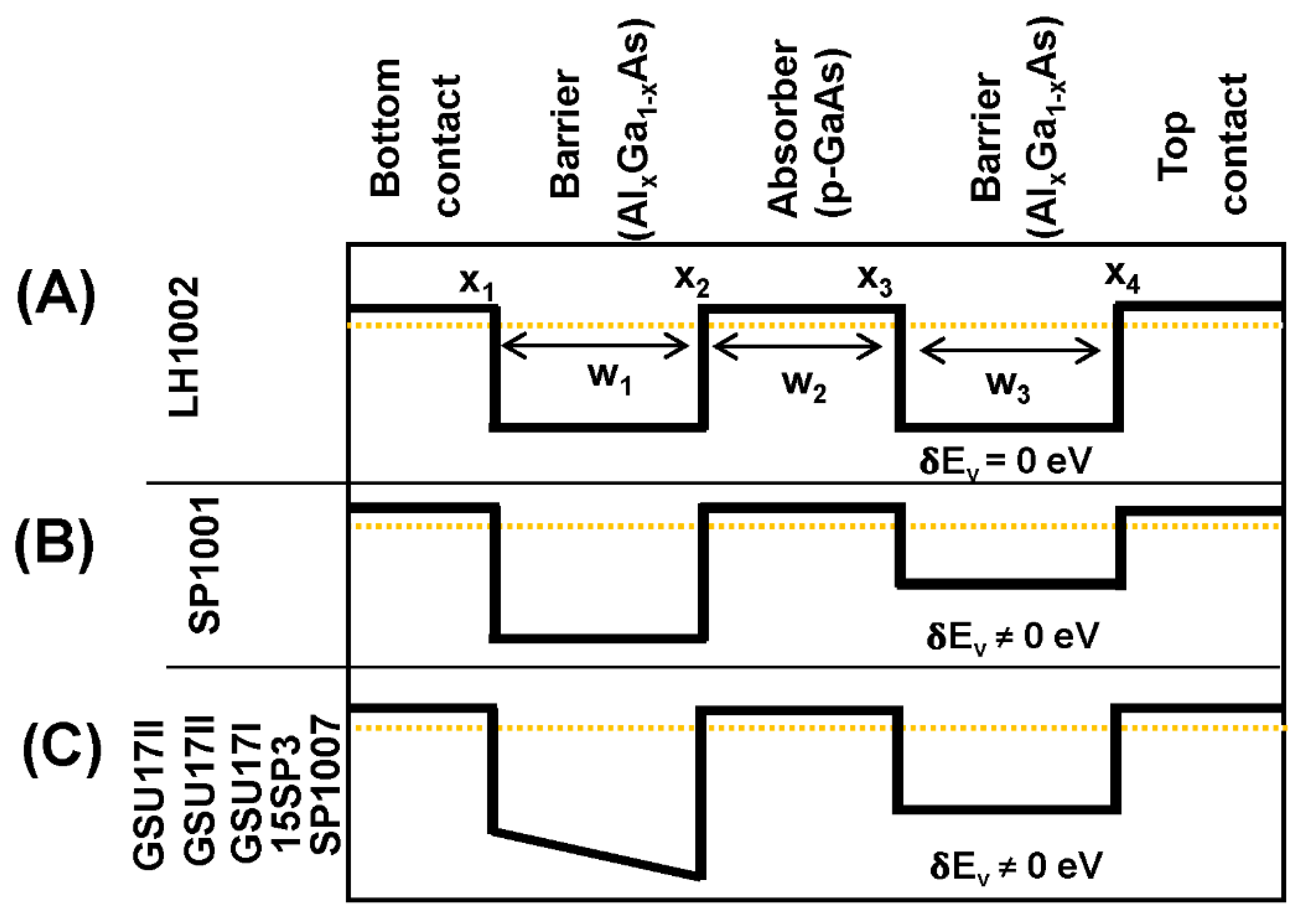
| Device | Δ (eV) | δE (eV) | Al Fraction | Thickness (nm) | Gradient (kV/cm) | ΔTDIPS (eV) | λt (μm) | ||||
|---|---|---|---|---|---|---|---|---|---|---|---|
| x1 | x2 | x3 = x4 | We | W1 | W2 | [ΔEv(x2) − ΔEv(x1)]/w1 | |||||
| LH1002 | 0.3 | 0 | 0.57 | 0.57 | 0.57 | 20 | 20 | 60 | 0 | 0.2781 ± 0.0006 | 4.50 ± 0.01 |
| SP1001 | 0.4 | 0.1 | 0.75 | 0.75 | 0.57 | 80 | 80 | 400 | 0 | 0.0248 ± 0.0001 | 50.0 ± 0.3 |
| SP1007 | 0.4 | 0.1 | 0.45 | 0.75 | 0.57 | 80 | 80 | 400 | 20.6 | 0.0223 ± 0.000 | 56.0 ± 0.5 |
| 15SP3 | 0.4 | 0.19 | 0.45 | 0.75 | 0.39 | 80 | 80 | 400 | 20.6 | 0.0207 ± 0.0001 | 60.0 ± 0.3 |
| GSU17I | 0.4 | 0.23 | 0.45 | 0.75 | 0.3 | 80 | 80 | 400 | 20.6 | 0.0203 ± 0.0003 | 61.0 ± 0.8 |
| GSU17II | 0.4 | 0.19 | 0.33 | 0.75 | 0.39 | 80 | 80 | 400 | 28.9 | 0.0217 ± 0.0001 | 57.0 ± 0.3 |
| GSU17III | 0.4 | 0.19 | 0.21 | 0.75 | 0.39 | 80 | 80 | 400 | 37.1 | 0.0214 ± 0.0001 | 58.0 ± 0.3 |
© 2020 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Ghimire, H.; Jayaweera, P.V.V.; Somvanshi, D.; Lao, Y.; Perera, A.G.U. Recent Progress on Extended Wavelength and Split-Off Band Heterostructure Infrared Detectors. Micromachines 2020, 11, 547. https://doi.org/10.3390/mi11060547
Ghimire H, Jayaweera PVV, Somvanshi D, Lao Y, Perera AGU. Recent Progress on Extended Wavelength and Split-Off Band Heterostructure Infrared Detectors. Micromachines. 2020; 11(6):547. https://doi.org/10.3390/mi11060547
Chicago/Turabian StyleGhimire, Hemendra, P. V. V. Jayaweera, Divya Somvanshi, Yanfeng Lao, and A. G. Unil Perera. 2020. "Recent Progress on Extended Wavelength and Split-Off Band Heterostructure Infrared Detectors" Micromachines 11, no. 6: 547. https://doi.org/10.3390/mi11060547
APA StyleGhimire, H., Jayaweera, P. V. V., Somvanshi, D., Lao, Y., & Perera, A. G. U. (2020). Recent Progress on Extended Wavelength and Split-Off Band Heterostructure Infrared Detectors. Micromachines, 11(6), 547. https://doi.org/10.3390/mi11060547






