Lapping and Polishing of Crystalline KY(WO4)2: Toward High Refractive Index Contrast Slab Waveguides
Abstract
1. Introduction
2. Preparation of KY(WO4)2-on-Glass Assemblies
2.1. Three-Grade Beveled KY(WO4)2 Edges
2.2. Preparation of KY(WO4)2 Assemblies
3. Lapping and Polishing Equipment and Consumables
3.1. Lapping and Polishing Machine
3.2. Lapping and Polishing Materials
3.3. Conditioning of Cast Iron and Polyurethane Disks
3.4. Overall Lapping and Polishing Process Description
4. Lapping and Polishing Process for KY(WO4)2
4.1. Lapping Process for KY(WO4)2 Layers
4.2. Polishing Process for KY(WO4)2 Layers
4.2.1. Polishing with SiO2 Suspension
4.2.2. Extended Polishing Time
4.2.3. Pre-Polishing with CeO2 Suspension
5. Lapping Toward Thin Layers
6. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- Cong, Z.; Liu, Z.; Qin, Z.; Zhang, X.; Zhang, H.; Li, J.; Yu, H.; Wang, W. LD-pumped actively Q-switched Nd:KLu(WO4)2 self-Raman laser at 1185 nm. Opt. Laser Technol. 2015, 73, 50–53. [Google Scholar] [CrossRef]
- Batay, L.E.; Kuzmin, A.N.; Grabtchikov, A.S.; Lisinetskii, V.A.; Orlovich, V.A.; Demidovich, A.A.; Titov, A.N.; Badikov, V.V.; Sheina, S.G.; Panyutin, V.L.; et al. Efficient diode-pumped passively Q-switched laser operation around 1.9 μm and self-frequency Raman conversion of Tm-doped KY(WO4)2. Appl. Phys. Lett. 2002, 81, 2926–2928. [Google Scholar] [CrossRef]
- Chang, M.T.; Zhuang, W.Z.; Su, K.W.; Yu, Y.T.; Chen, Y.F. Efficient continuous-wave self-Raman Yb:KGW laser with a shift of 89 cm−1. Opt. Express 2013, 21, 24590. [Google Scholar] [CrossRef] [PubMed][Green Version]
- Brunner, F.; Spühler, G.J.; Aus der Au, J.; Krainer, L.; Morier-Genoud, F.; Paschotta, R.; Lichtenstein, N.; Weiss, S.; Harder, C.; Lagatsky, A.A.; et al. Diode-pumped femtosecond Yb:KGd(WO4)2 laser with 1.1-W average power. Opt. Lett. 2000, 25, 1119. [Google Scholar] [CrossRef] [PubMed]
- Kovalyov, A.A.; Preobrazhenskii, V.V.; Putyato, M.A.; Pchelyakov, O.P.; Rubtsova, N.N.; Semyagin, B.R.; Kisel’, V.E.; Kuril’chik, S.V.; Kuleshov, N.V. 115 fs pulses from Yb3+:KY(WO4)2 laser with low loss nanostructured saturable absorber. Laser Phys. Lett. 2011, 8, 431–435. [Google Scholar] [CrossRef]
- Erhard, S.; Gao, J.; Giesen, A.; Contag, K.; Lagatsky, A.A.; Abdolvand, A.; Kuleshov, N.V.; Aus der Au, J.; Spuhler, G.J.; Brunner, F.; et al. High power Yb:KGW and Yb:KYW thin disk laser operation. In Proceedings of the Technical Digest. Summaries of papers presented at the Conference on Lasers and Electro-Optics. Postconference Technical Digest, Baltimore, MD, USA, 6–11 May 2001; pp. 333–334. [Google Scholar]
- Mateos, X.; Loiko, P.; Lamrini, S.; Scholle, K.; Fuhrberg, P.; Vatnik, S.; Vedin, I.; Aguiló, M.; Díaz, F.; Griebner, U.; et al. Thermo-optic effects in Ho:KY(WO4)2 thin-disk lasers. Opt. Mater. Express 2018, 8, 684. [Google Scholar] [CrossRef]
- Krygin, I.M.; Prokhorov, A.D.; D’yakonov, V.P.; Borowiec, M.T.; Szymczak, H. Spin-spin interaction of Dy3+ ions in KY(WO4)2. Phys. Solid State 2002, 44, 1587–1596. [Google Scholar] [CrossRef]
- Dhanaraj, G.; Byrappa, K.; Prasad, V.; Dudley, M. Springer Handbook of Crystal Growth; Springer: Berlin/Heidelberg, Germany, 2010; ISBN 9783540747611. [Google Scholar]
- Geskus, D.; Aravazhi, S.; García-Blanco, S.M.; Pollnau, M. Giant optical gain in a rare-earth-ion-doped microstructure. Adv. Mater. 2012, 24, 22–25. [Google Scholar] [CrossRef] [PubMed]
- Yong, Y.-S.; Aravazhi, S.; Vázquez-Córdova, S.A.; Carjaval, J.J.; Díaz, F.; Herek, J.L.; García-Blanco, S.M.; Pollnau, M. Temperature-dependent absorption and emission of potassium double tungstates with high ytterbium content. Opt. Express 2016, 24, 26825–26837. [Google Scholar] [CrossRef] [PubMed]
- Kaminskii, A.A.; Konstantinova, A.F.; Orekhova, V.P.; Butashin, A.V.; Klevtsova, R.F.; Pavlyuk, A.A. Optical and nonlinear laser properties of the χ(3)-active monoclinic α-KY(WO4)2 crystals. Crystallogr. Rep. 2001, 46, 665–672. [Google Scholar] [CrossRef]
- Van Dalfsen, K.; Aravazhi, S.; Grivas, C.; García-Blanco, S.M.; Pollnau, M. Thulium channel waveguide laser with 1.6 W of output power and ∼80% slope efficiency. Opt. Lett. 2014, 39, 4380. [Google Scholar] [CrossRef] [PubMed]
- Geskus, D.; Aravazhi, S.; Wörhoff, K.; Pollnau, M. High-power, broadly tunable, and low-quantum-defect KGd1-xLux(WO4)2:Yb3+ channel waveguide lasers. Opt. Express 2010, 18, 26107–26112. [Google Scholar] [CrossRef] [PubMed]
- Geskus, D.; Aravazhi, S.; Grivas, C.; Wörhoff, K.; Pollnau, M. Microstructured KY(WO4)2:Gd3+, Lu3+, Yb3+ channel waveguide laser. Opt. Express 2010, 18, 22417–22422. [Google Scholar] [CrossRef] [PubMed]
- Aravazhi, S.; Geskus, D.; van Dalfsen, K.; Vázquez-Córdova, S.A.; Grivas, C.; Griebner, U.; García-Blanco, S.M.; Pollnau, M. Engineering lattice matching, doping level, and optical properties of KY(WO4)2:Gd, Lu, Yb layers for a cladding-side-pumped channel waveguide laser. Appl. Phys. B 2013, 111, 433–446. [Google Scholar] [CrossRef]
- Romanyuk, Y. Liquid-phase Epitaxy of Doped KY(WO4)2 Layers for Waveguide Lasers; Fédérale de Lausanne: Lausanne, Switzerland, 2005. [Google Scholar]
- Yong, Y.-S.; Aravazhi, S.; Vázquez-Córdova, S.A.; Herek, J.L.; García-Blanco, S.M.; Pollnau, M. Gain dynamics in a highly ytterbium-doped potassium double tungstate epitaxial layer. J. Opt. Soc. Am. B 2018, 35, 2176. [Google Scholar] [CrossRef]
- Frentrop, R.; Olivares, J.; Tormo-Márquez, V.; García-Blanco, S.M. High-contrast slab waveguide fabrication in KY(WO4)2 by swift heavy ion irradiation. In Proceedings of the Integrated Optics: Devices Materials, and Technologies XXII, San Francisco, CA, USA, 27 January–1 February 2018; p. 105350. [Google Scholar]
- Sefunc, M.A.; Segerink, F.B.; García-Blanco, S.M. High index contrast passive potassium double tungstate waveguides. Opt. Mater. Express 2018, 8, 629. [Google Scholar] [CrossRef]
- Van Emmerik, C.I.; Frentrop, R.; Dijkstra, M.; Segerink, F.; Kooijman, R.; Muneeb, M.; Roelkens, G.; Ghibaudo, E.; Broquin, J.-E.; Garcia-Blanco, S.M. Heterogeneous integration of KY(WO4)2-on-glass: a bonding study. OSA Contin. 2019, 2, 2065–2076. [Google Scholar] [CrossRef]
- Denker, B.; Shklovsky, E. Handbook of Solid-State Lasers: Materials, Systems and Applications; Woodhead Publishing: Cambridgeshire, UK, 2013; ISBN 9780857097507. [Google Scholar]
- Edmund Optics Understanding Optical Specifications. Available online: https://www.edmundoptics.com/resources/application-notes/optics/understanding-optical-specifications/ (accessed on 29 April 2019).
- Geskus, D. Channel Waveguide Lasers and Amplifiers in Single-Crystalline Ytterbium-Doped Tungstates. Ph.D. Thesis, University of Twente, Enschede, The Netherlands, November 2011. [Google Scholar]
- Cook, L.M. Chemical processes in glass polishing. J. Non. Cryst. Solids 1990, 120, 152–171. [Google Scholar] [CrossRef]
- Hoshino, T.; Kurata, Y.; Terasaki, Y.; Susa, K. Mechanism of polishing of SiO2 films by CeO2 particles. J. Non. Cryst. Solids 2001, 283, 129–136. [Google Scholar] [CrossRef]
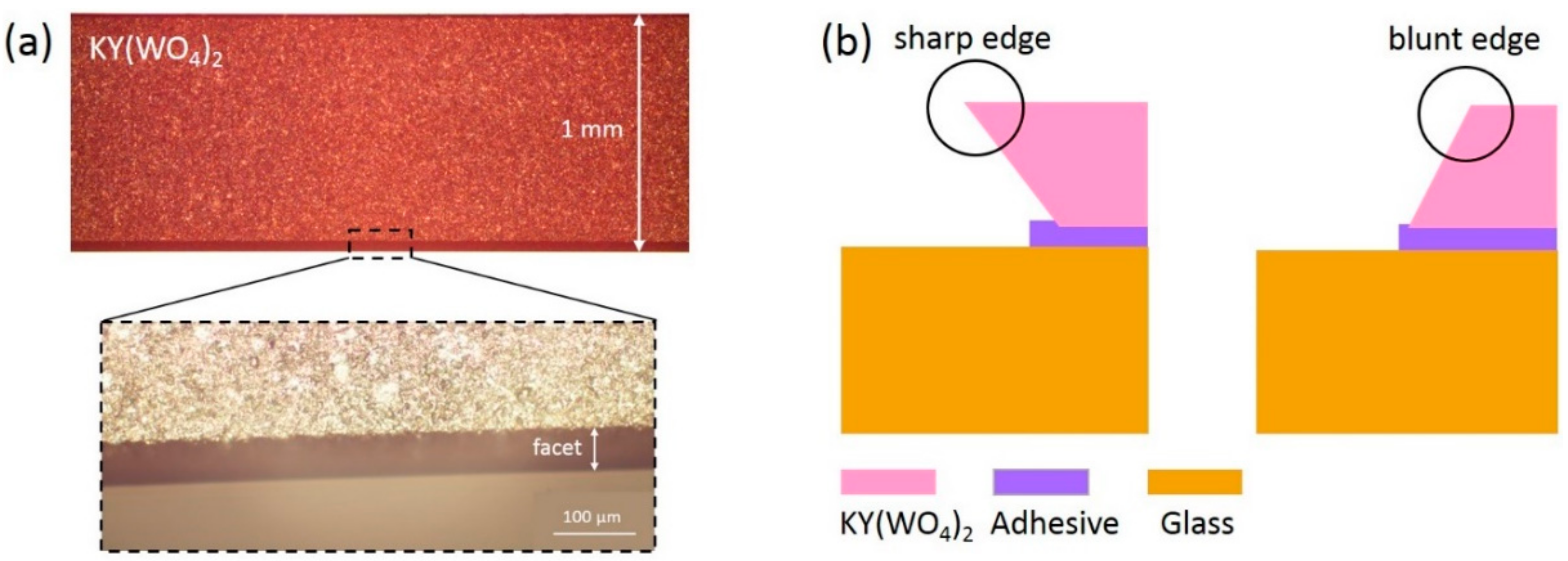

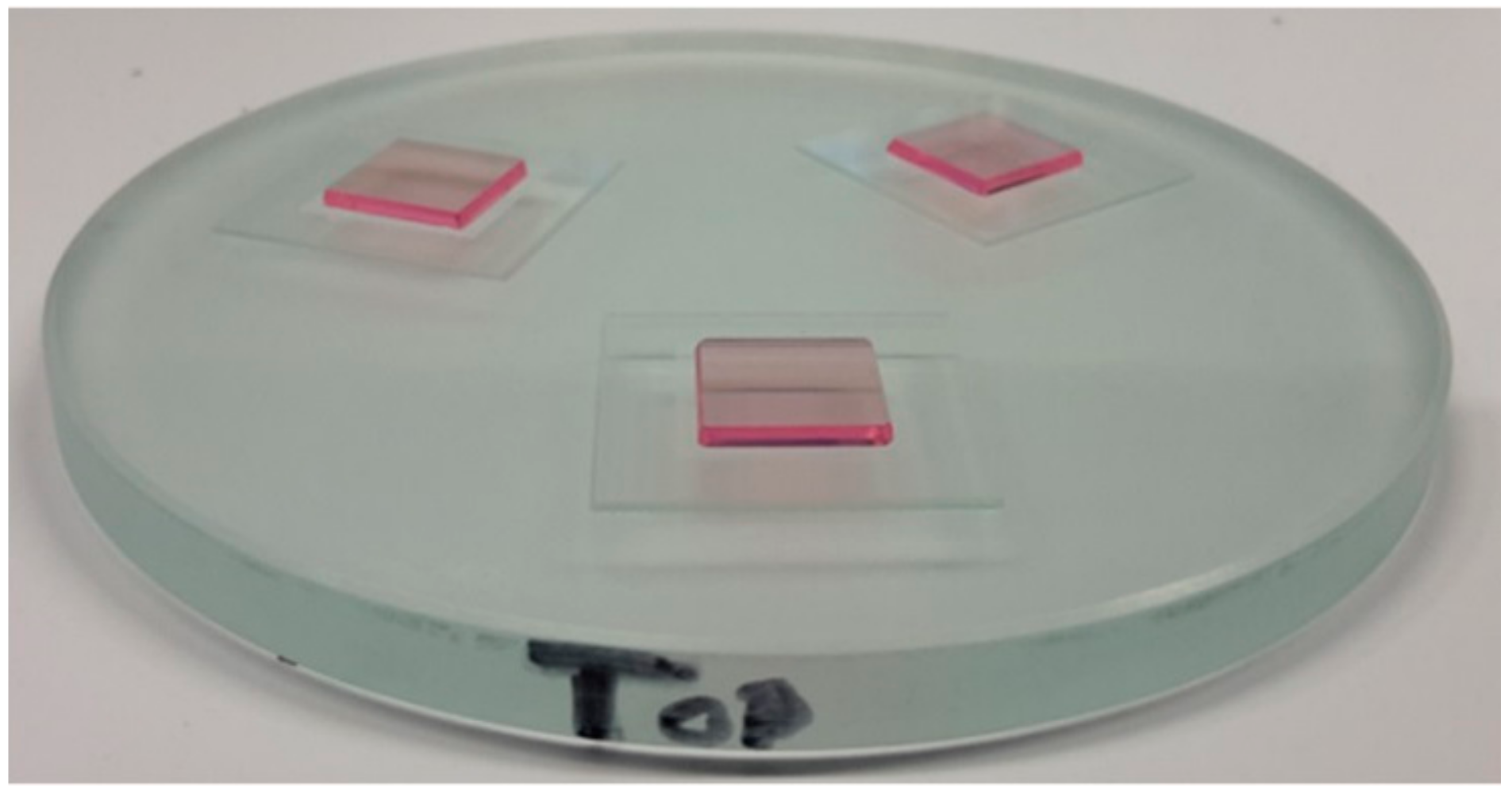
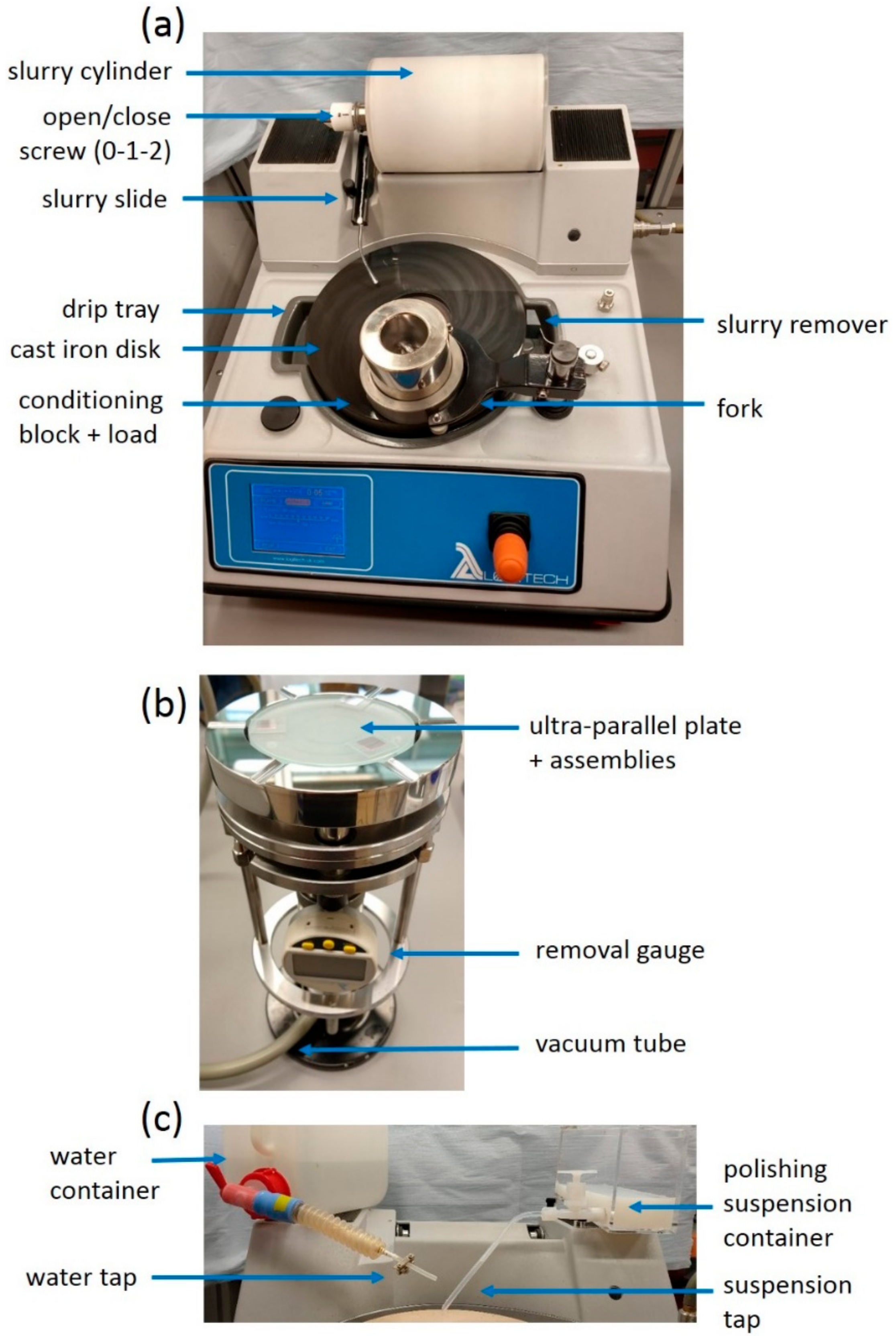
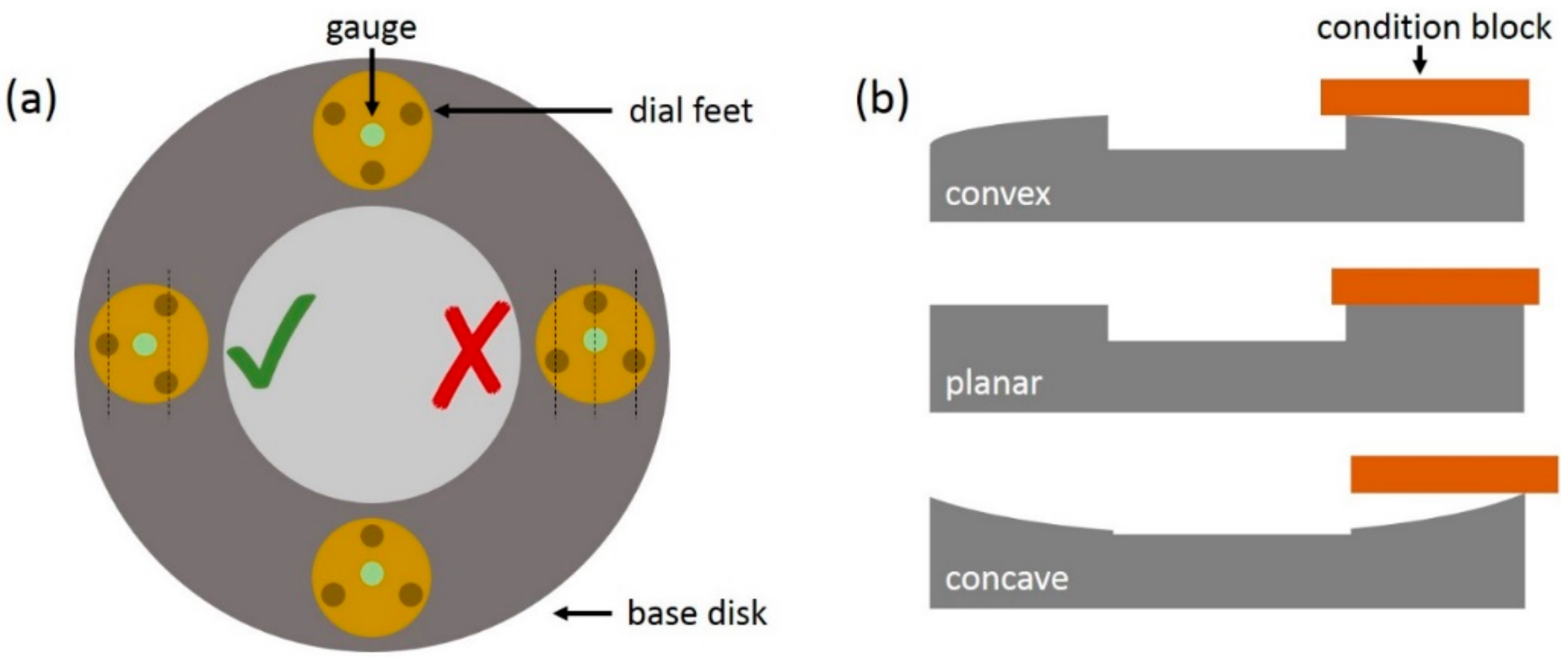

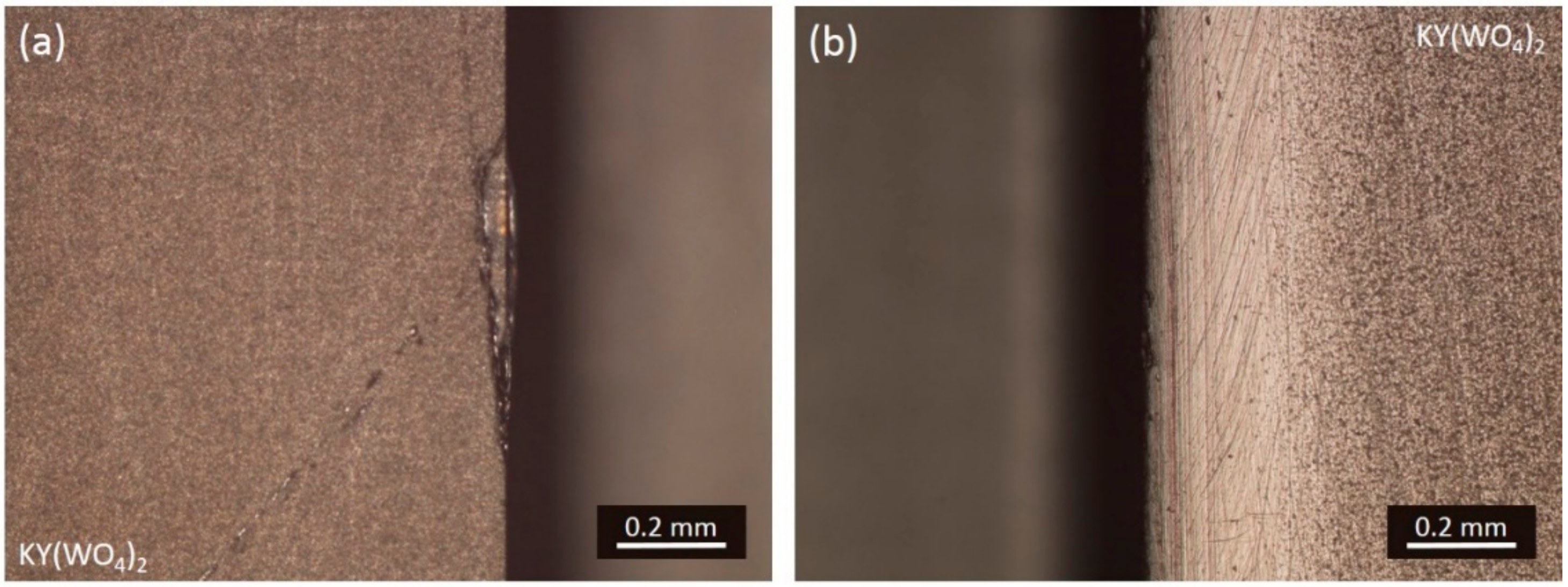
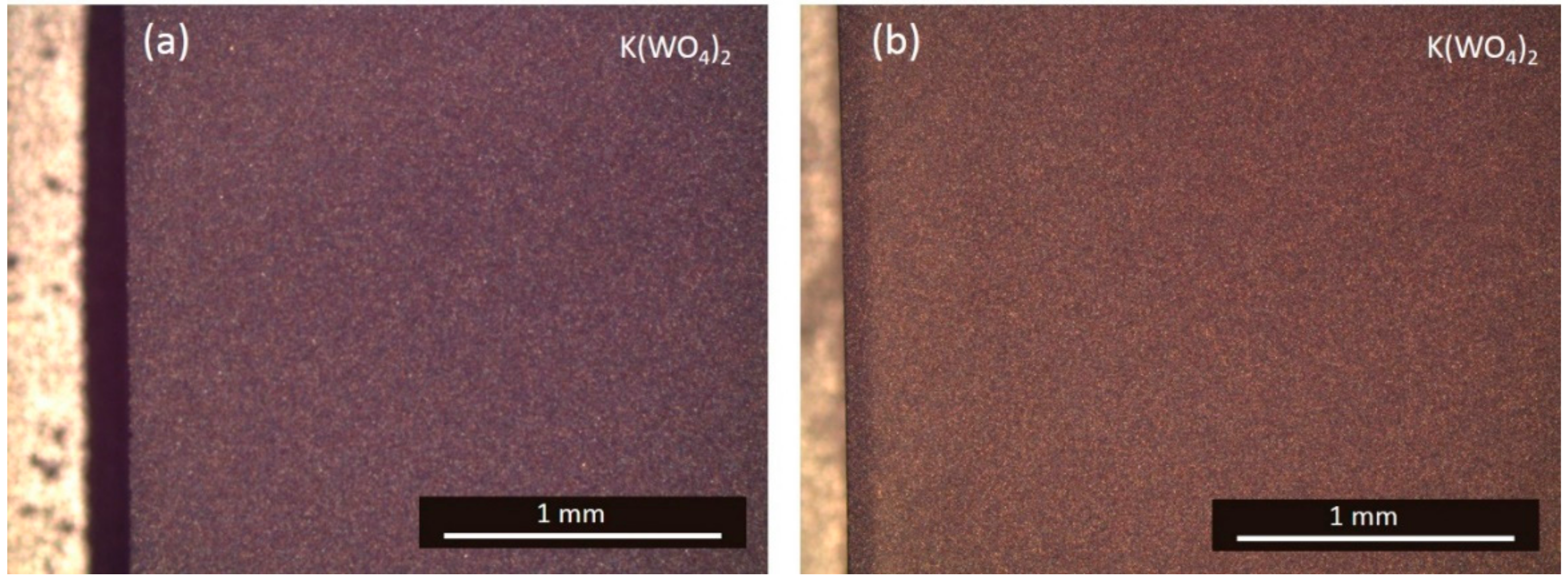
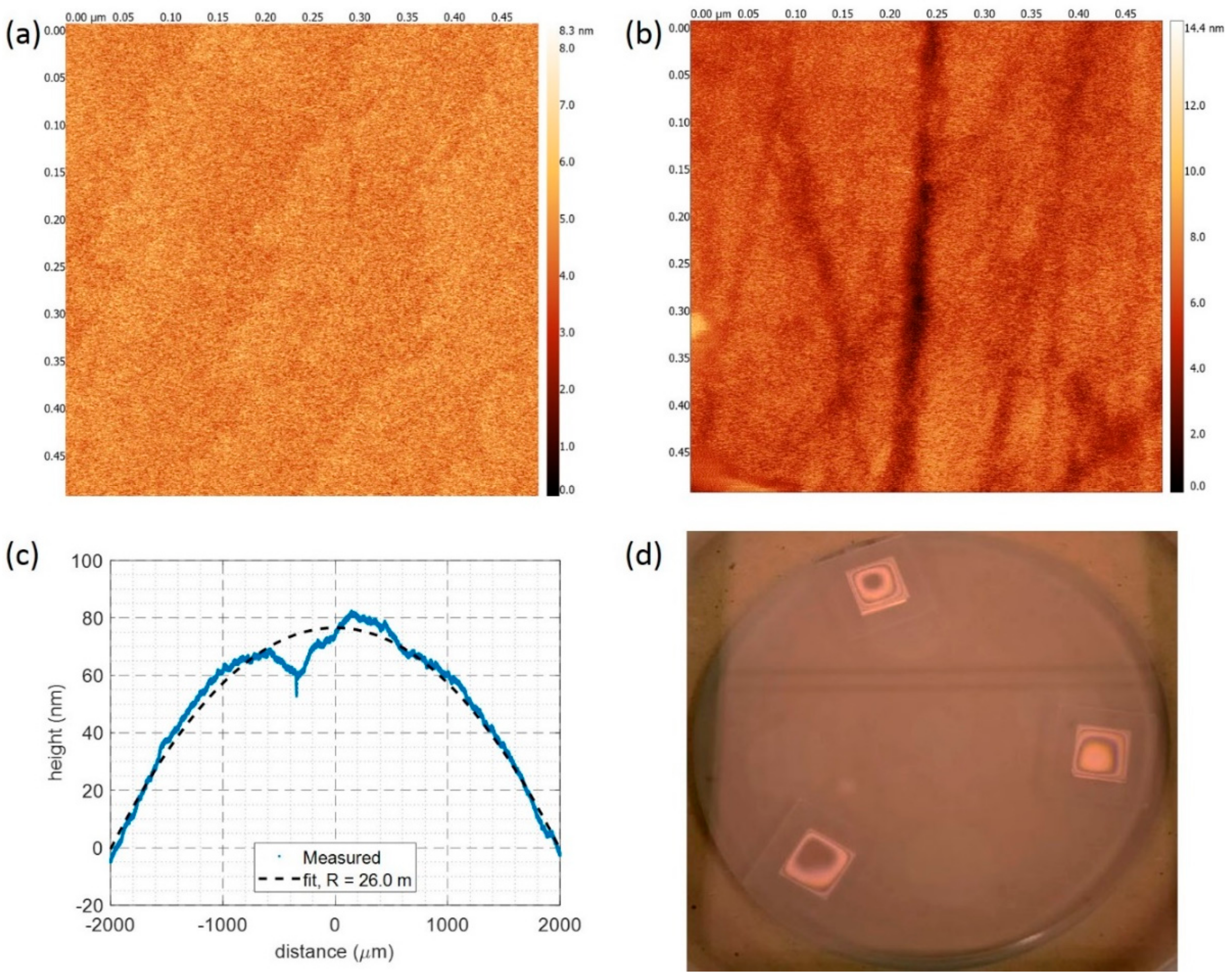
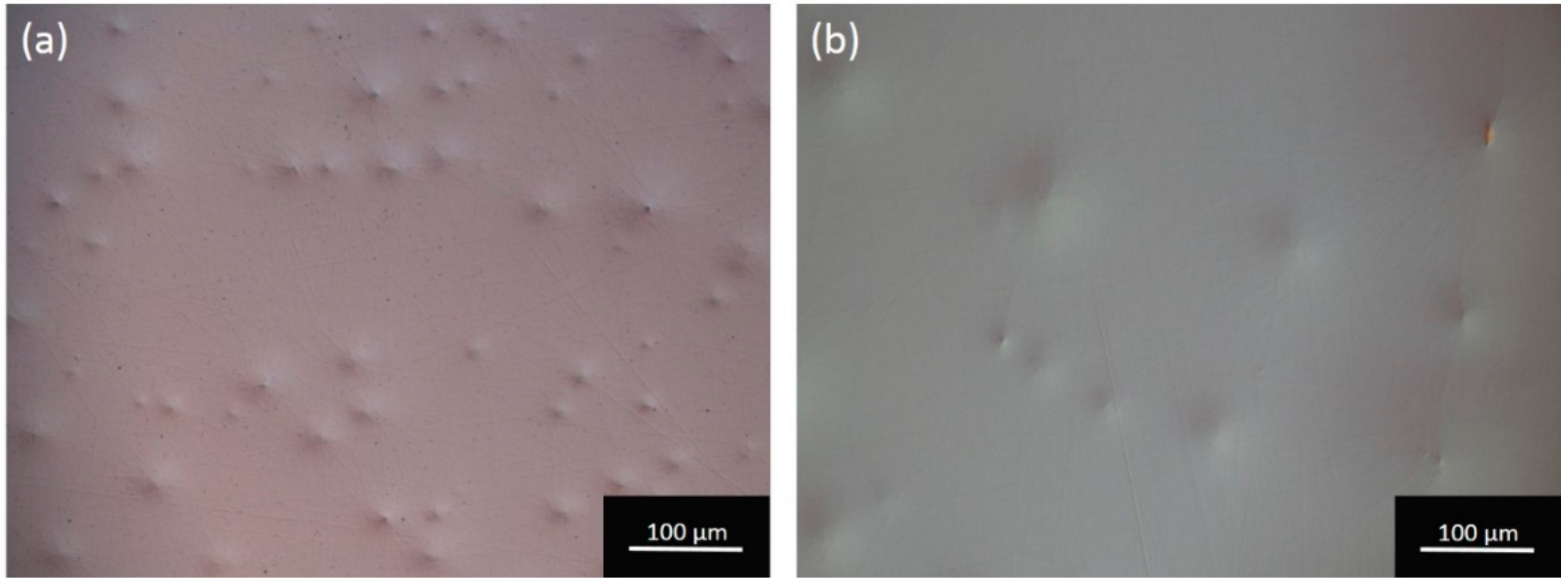
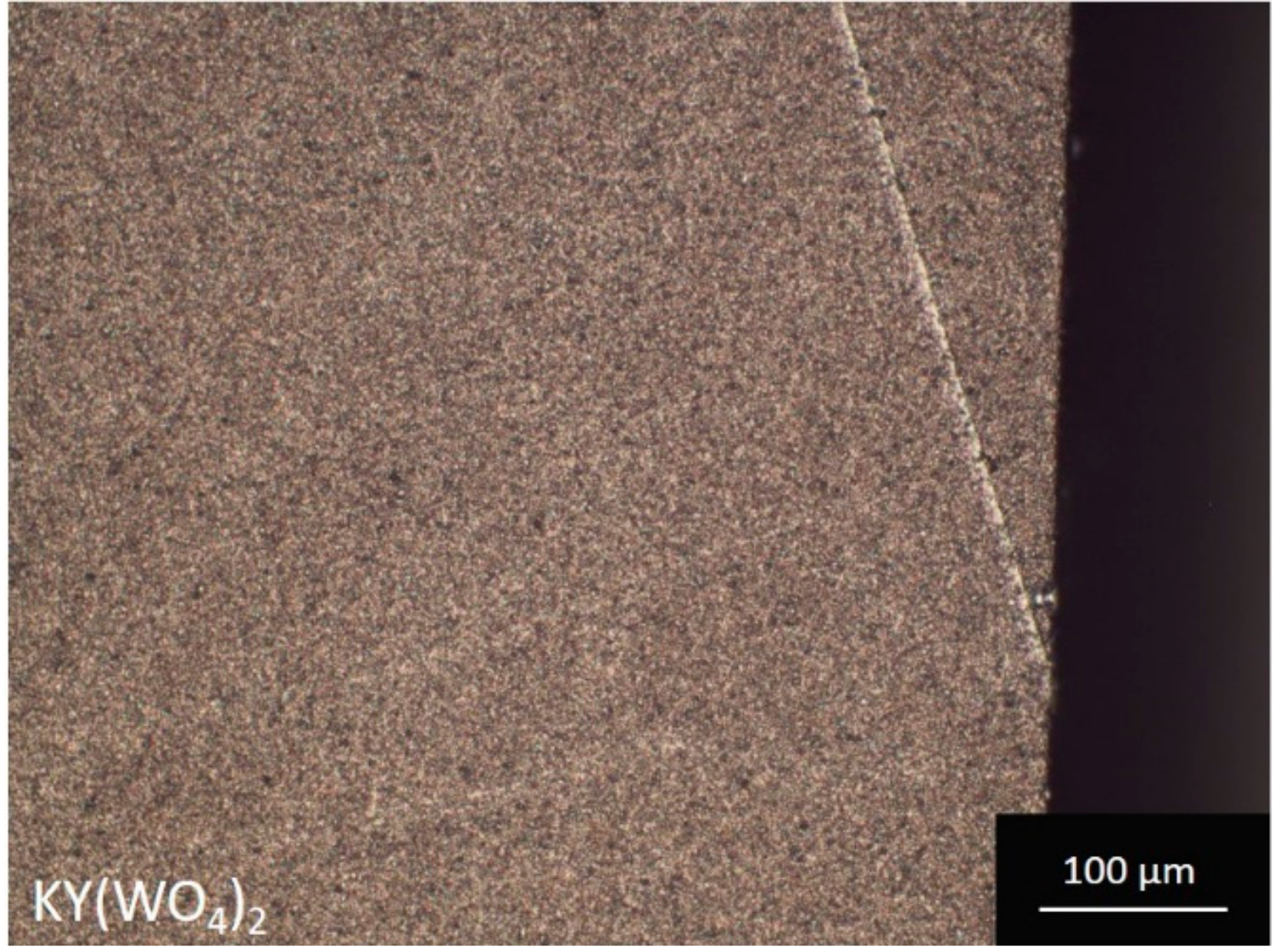
| Lapping Stage | Particles | Concentration (g/L) | Load (g/cm2) | Speed Disk (rpm) | Removal Rate (µm/min) | Logitech, UK Product nr. |
|---|---|---|---|---|---|---|
| Coarse | 9 µm Al2O3 | 250.0 | 200 | 35 | 10–15 | 0CON-009 |
| Medium | 3 µm Al2O3 | 208.3 | 167 | 30 | 5–7 | 0CON-008 |
| Fine | 1 µm Al2O3 | 187.5 | 133 | 25 | 1–2 | 0CON-007 |
© 2019 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
van Emmerik, C.I.; Kooijman, R.; Dijkstra, M.; Garcia-Blanco, S.M. Lapping and Polishing of Crystalline KY(WO4)2: Toward High Refractive Index Contrast Slab Waveguides. Micromachines 2019, 10, 674. https://doi.org/10.3390/mi10100674
van Emmerik CI, Kooijman R, Dijkstra M, Garcia-Blanco SM. Lapping and Polishing of Crystalline KY(WO4)2: Toward High Refractive Index Contrast Slab Waveguides. Micromachines. 2019; 10(10):674. https://doi.org/10.3390/mi10100674
Chicago/Turabian Stylevan Emmerik, Carlijn I., Roy Kooijman, Meindert Dijkstra, and Sonia M. Garcia-Blanco. 2019. "Lapping and Polishing of Crystalline KY(WO4)2: Toward High Refractive Index Contrast Slab Waveguides" Micromachines 10, no. 10: 674. https://doi.org/10.3390/mi10100674
APA Stylevan Emmerik, C. I., Kooijman, R., Dijkstra, M., & Garcia-Blanco, S. M. (2019). Lapping and Polishing of Crystalline KY(WO4)2: Toward High Refractive Index Contrast Slab Waveguides. Micromachines, 10(10), 674. https://doi.org/10.3390/mi10100674






