A Comprehensive Study on the Effect of TiN Top and Bottom Electrodes on Atomic Layer Deposited Ferroelectric Hf0.5Zr0.5O2 Thin Films
Abstract
1. Introduction
2. Materials and Methods
2.1. Sample Preparation
2.2. Physical, Chemical, and Electrical Analysis
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Acknowledgments
Conflicts of Interest
References
- Böscke, T.S.; Müller, J.; Bräuhaus, D.; Schröder, U.; Böttger, U. Ferroelectricity in hafnium oxide thin films. Appl. Phys. Lett. 2011, 99, 102903. [Google Scholar] [CrossRef]
- Kim, S.J.; Narayan, D.; Lee, J.-G.; Mohan, J.; Lee, J.S.; Lee, J.; Kim, H.S.; Byun, Y.-C.; Lucero, A.T.; Summerfelt, S.R.; et al. Large ferroelectric polarization of TiN/Hf0.5Zr0.5O2/TiN capacitors due to stress-induced crystallization at low thermal budget. Appl. Phys. Lett. 2017, 111, 242901. [Google Scholar] [CrossRef]
- Kim, S.J.; Narayan, D.; Lee, J.-G.; Mohan, J.; Lee, J.S.; Lee, J.; Young, C.D.; Kim, J.; Summerfelt, S.R.; San, T.; et al. Low temperature (400 °C) ferroelectric Hf0.5Zr0.5O2 capacitors for next-generation FRAM applications. In Proceedings of the 9th IEEE International Memory Workshop (IMW), Monterey, CA, USA, 14–17 May 2017. [Google Scholar]
- Kim, S.J.; Mohan, J.; Kim, H.S.; Lee, J.; Young, C.D.; Colombo, L.; Summerfelt, S.R.; San, T.; Kim, J. Low-voltage operation and high endurance of 5-nm ferroelectric Hf0.5Zr0.5O2 capacitors. Appl. Phys. Lett. 2018, 113, 182903. [Google Scholar] [CrossRef]
- Kim, S.J.; Mohan, J.; Young, C.D.; Colombo, L.; Kim, J.; Summerfelt, S.R.; San, T. Ferroelectric TiN/Hf0.5Zr0.5O2/TiN capacitors with low-voltage operation and high reliability for next-generation FRAM applications. In Proceedings of the 10th IEEE International Memory Workshop (IMW), Kyoto, Japan, 13–16 May 2018. [Google Scholar]
- Park, M.H.; Lee, Y.H.; Kim, H.J.; Kim, Y.J.; Moon, T.; Kim, K.D.; Müller, J.; Kersch, A.; Schroeder, U.; Mikolajick, T.; et al. Ferroelectricity and antiferroelectricity of doped thin HfO2-base films. Adv. Mater. 2015, 27, 1811–1831. [Google Scholar] [CrossRef] [PubMed]
- Kim, S.J.; Mohan, J.; Summerfelt, S.R.; Kim, J. Ferroelectric thin Hf0.5Zr0.5O2 films: A review of recent advances. JOM 2019, 71, 246–255. [Google Scholar] [CrossRef]
- Schroeder, U.; Materano, M.; Mittmann, T.; Lomenzo, P.D.; Mikolajick, T.; Toriumi, A. Recent progress for obtaining the ferroelectric phase in hafnium oxide based films impact of oxygen and zirconium. Jpn. J. Appl. Phys. 2019, 58, SL0801. [Google Scholar] [CrossRef]
- Materlik, R.; Künneth, C.; Kersch, A. The origin of ferroelectricity in Hf1-xZrxO2: A computational investigation and a surface energy model. J. Appl. Phys. 2015, 117, 134109. [Google Scholar] [CrossRef]
- Park, M.H.; Kim, H.J.; Kim, Y.J.; Moon, T.; Hwang, C.S. The effects of crystallographic orientation and strain of thin Hf0.5Zr0.5O2 film on its ferroelectricity. Appl. Phys. Lett. 2014, 104, 072901. [Google Scholar] [CrossRef]
- Shiraishi, T.; Katayama, K.; Yokouchi, T.; Shimizu, T.; Oikawa, T.; Sakata, O.; Uchida, H.; Imai, Y.; Kiguchi, T.; Konno, T.J.; et al. Impact of mechanical stress on ferroelectricity in (Hf0.5Zr0.5)O2 thin films. Appl. Phys. Lett. 2016, 108, 262904. [Google Scholar] [CrossRef]
- Park, M.H.; Kim, H.J.; Kim, Y.J.; Lee, W.; Moon, T.; Kim, K.D.; Hwang, C.S. Study on the degradation mechanism of the ferroelectric properties of thin Hf0.5Zr0.5O2 films on TiN and Ir electrodes. Appl. Phys. Lett. 2014, 105, 072902. [Google Scholar] [CrossRef]
- Cao, R.; Song, B.; Shang, D.; Yang, Y.; Luo, Q.; Wu, S.; Li, Y.; Wang, Y.; Lv, H.; Liu, Q.; et al. Improvement of endurance in HZO-based ferroelectric capacitor using Ru electrode. IEEE Electron Dev. Lett. 2019, 40, 1744. [Google Scholar] [CrossRef]
- Kim, S.J.; Mohan, J.; Kim, H.S.; Lee, J.; Hwang, S.M.; Narayan, D.; Lee, J.-G.; Young, C.D.; Colombo, L.; Goodman, G.; et al. Effect of hydrogen derived from oxygen source on low-temperature ferroelectric TiN/Hf0.5Zr0.5O2/TiN capacitors. Appl. Phys. Lett. 2019, 115, 182901. [Google Scholar] [CrossRef]
- Kim, S.J.; Mohan, J.; Lee, J.S.; Kim, H.S.; Lee, J.; Young, C.D.; Colombo, L.; Summerfelt, S.R.; San, T.; Kim, J. Stress-induced crystallization of thin Hf1-XZrXO2 films: The origin of enhanced energy density with minimized energy loss for lead-free electrostatic energy storage applications. ACS Appl. Mater. Interfaces 2019, 11, 5208–5214. [Google Scholar] [CrossRef]
- Kim, S.J.; Mohan, J.; Lee, J.; Lee, J.S.; Lucero, A.T.; Young, C.D.; Colombo, L.; Summerfelt, S.R.; San, T.; Kim, J. Effect of film thickness on the ferroelectric and dielectric properties of low-temperature (400 °C) Hf0.5Zr0.5O2 films. Appl. Phys. Lett. 2018, 112, 172902. [Google Scholar] [CrossRef]
- Chen, K.-S.; Chen, T.Y.-F.; Chuang, C.-C.; Lin, I.-K. Full-field wafer level thin film stress measurement by phase-stepping shadow moiré. IEEE Trans. Comp. Packag. Technol. 2004, 27, 594–601. [Google Scholar] [CrossRef]
- Feng, X.; Huang, Y.; Rosakis, A.J. Stresses in a multilayer thin film/substrate system subjected to nonuniform temperature. J. Appl. Mech.-Trans. ASME 2008, 75, 021022. [Google Scholar] [CrossRef]
- Spaepen, F. Interfaces and stresses in thin films. Acta Mater. 2000, 48, 31–42. [Google Scholar] [CrossRef]
- Onaya, T.; Nabatame, T.; Sawamoto, N.; Ohi, A.; Ikeda, N.; Chikyow, T.; Ogura, A. Improvement in ferroelectricity of HfXZr1-XO2 thin films using ZrO2 seed layer. Appl. Phys. Express 2017, 10, 081501. [Google Scholar] [CrossRef]
- Hoffmann, M.; Schroeder, U.; Schenk, T.; Shimizu, T.; Funakubo, H.; Sakata, O.; Pohl, D.; Drescher, M.; Adelmann, C.; Materlik, R.; et al. Stabilizing the ferroelectric phase in doped hafnium oxide. J. Appl. Phys. 2015, 118, 072006. [Google Scholar] [CrossRef]
- Fengler, F.P.G.; Nigon, R.; Muralt, P.; Grimley, E.D.; Sang, X.; Sessi, V.; Hentschel, R.; Lebeau, J.M.; Mikolajick, T.; Schroeder, U. Analysis of performance instabilities of hafnia-based ferroelectrics using modulus spectroscopy and thermally stimulated depolarization currents. Adv. Electron. Mater. 2018, 4, 1700547. [Google Scholar] [CrossRef]
- Islamov, D.R.; Gritsenko, V.A.; Perevalov, T.V.; Pustovarov, V.A.; Orlov, O.M.; Chernikova, A.G.; Markeev, A.M.; Slesazeck, S.; Schroeder, U.; Mikolajick, T.; et al. Identification of the nature of traps involved in the field cycling of Hf0.5Zr0.5O2-based ferroelectric thin films. Acta Mater. 2019, 166, 47–55. [Google Scholar] [CrossRef]
- Han, J.-P.; Ma, T.P. Electrode dependence of hydrogen-induced degradation in ferroelectric Pb(Zr,Ti)O3 and SrBi2Ta2O9 thin films. Appl. Phys. Lett. 1997, 71, 1267. [Google Scholar] [CrossRef]
- Aggarwal, S.; Perusse, S.R.; Tipton, C.W.; Ramesh, R. Effect of hydrogen on Pb(Zr,Ti)O3-based ferroelectric capacitors. Appl. Phys. Lett. 1998, 73, 1973. [Google Scholar] [CrossRef]
- Park, M.H.; Kim, H.J.; Kim, Y.J.; Lee, W.; Kim, H.K.; Hwang, C.S. Effect of forming gas annealing on the ferroelectric properties of Hf0.5Zr0.5O2 thin films with and without Pt electrodes. Appl. Phys. Lett. 2013, 102, 112914. [Google Scholar] [CrossRef]
- Shekhawat, A.; Walters, G.; Chung, C.-C.; Garcia, R.; Liu, Y.; Jones, J.; Nishida, T.; Moghaddam, S. Effect of forming gas furnace annealing on the ferroelectricity and wake-up effect of Hf0.5Zr0.5O2 thin films. ECS J. Solid State Sci. Technol. 2020, 9, 024011. [Google Scholar] [CrossRef]
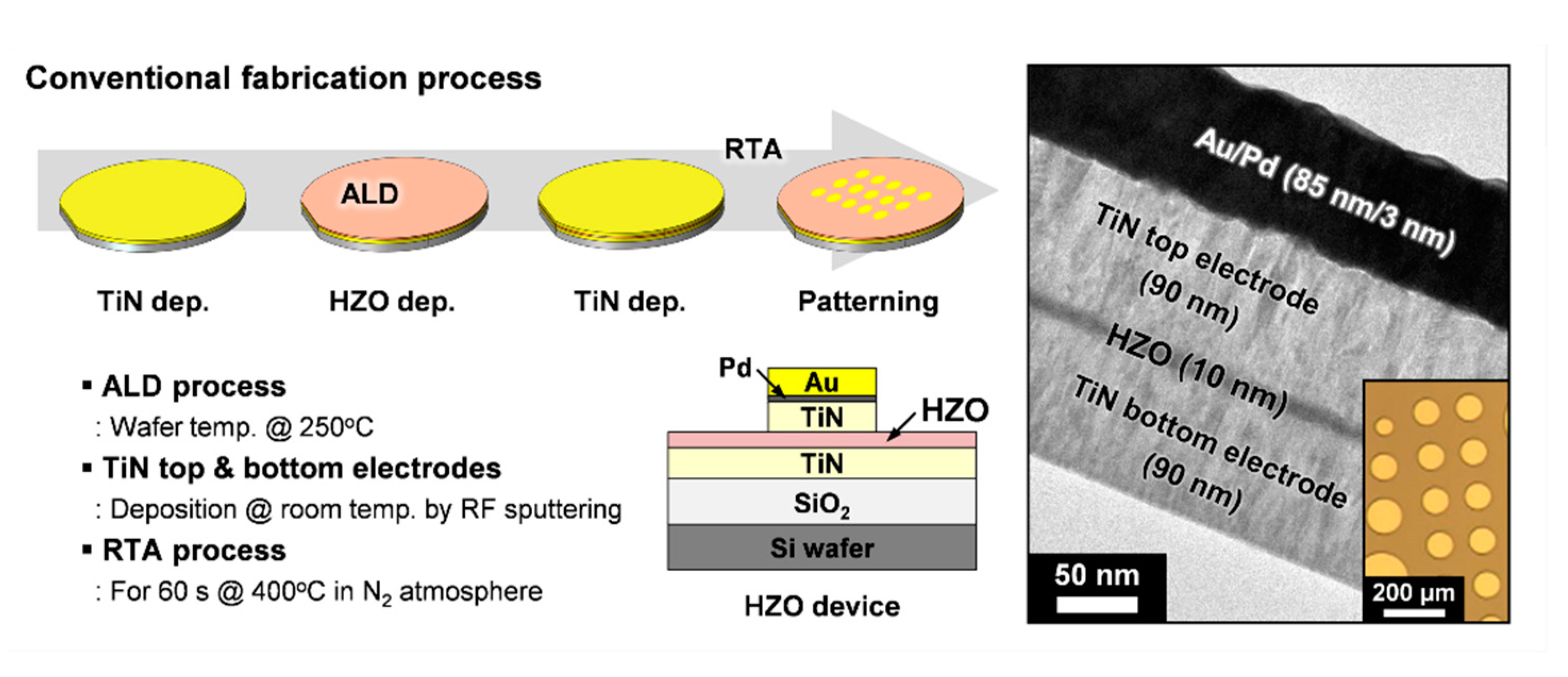

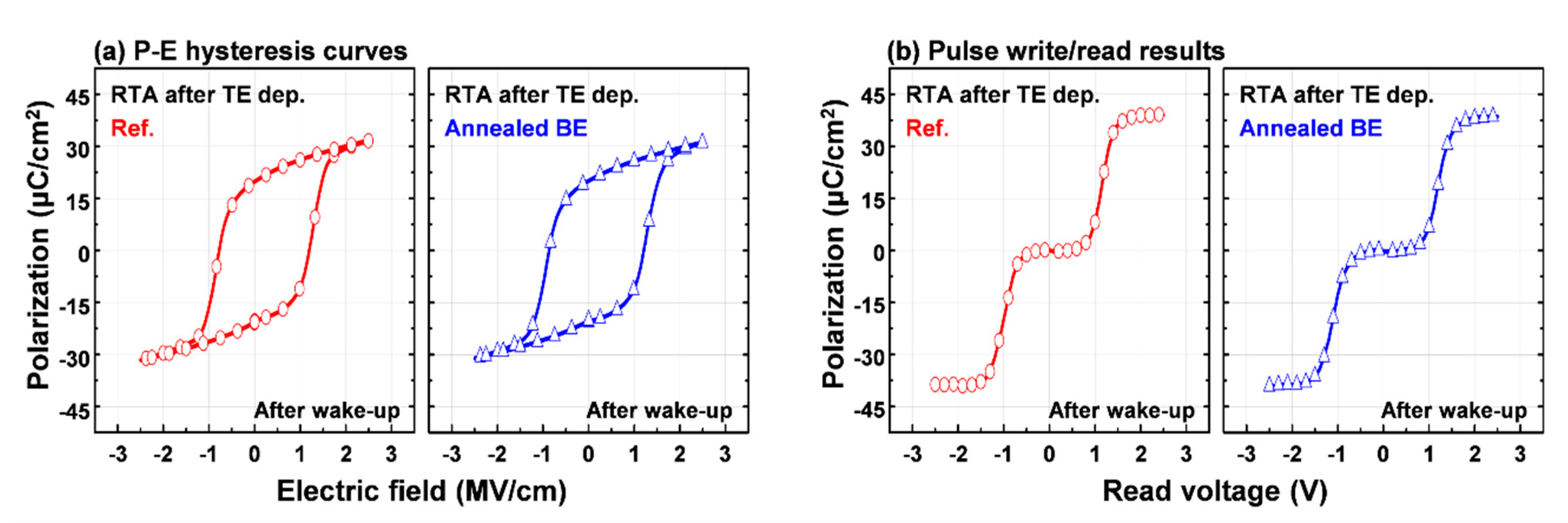


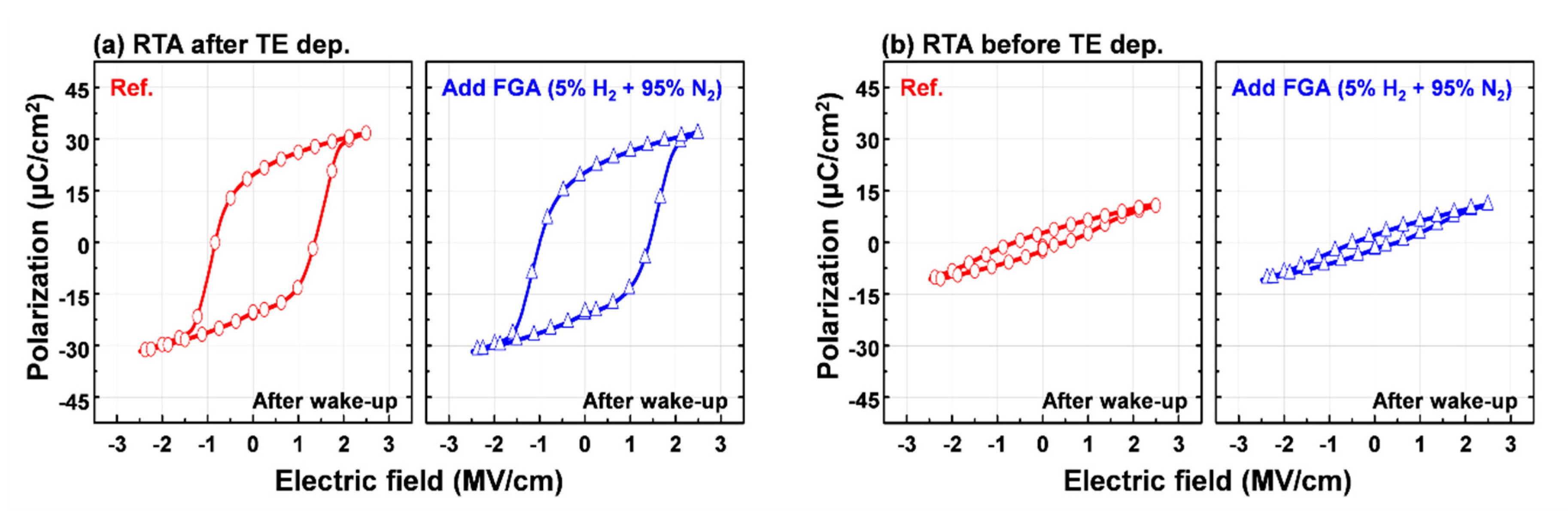
© 2020 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Kim, S.J.; Mohan, J.; Kim, H.S.; Hwang, S.M.; Kim, N.; Jung, Y.C.; Sahota, A.; Kim, K.; Yu, H.-Y.; Cha, P.-R.; et al. A Comprehensive Study on the Effect of TiN Top and Bottom Electrodes on Atomic Layer Deposited Ferroelectric Hf0.5Zr0.5O2 Thin Films. Materials 2020, 13, 2968. https://doi.org/10.3390/ma13132968
Kim SJ, Mohan J, Kim HS, Hwang SM, Kim N, Jung YC, Sahota A, Kim K, Yu H-Y, Cha P-R, et al. A Comprehensive Study on the Effect of TiN Top and Bottom Electrodes on Atomic Layer Deposited Ferroelectric Hf0.5Zr0.5O2 Thin Films. Materials. 2020; 13(13):2968. https://doi.org/10.3390/ma13132968
Chicago/Turabian StyleKim, Si Joon, Jaidah Mohan, Harrison Sejoon Kim, Su Min Hwang, Namhun Kim, Yong Chan Jung, Akshay Sahota, Kihyun Kim, Hyun-Yong Yu, Pil-Ryung Cha, and et al. 2020. "A Comprehensive Study on the Effect of TiN Top and Bottom Electrodes on Atomic Layer Deposited Ferroelectric Hf0.5Zr0.5O2 Thin Films" Materials 13, no. 13: 2968. https://doi.org/10.3390/ma13132968
APA StyleKim, S. J., Mohan, J., Kim, H. S., Hwang, S. M., Kim, N., Jung, Y. C., Sahota, A., Kim, K., Yu, H.-Y., Cha, P.-R., Young, C. D., Choi, R., Ahn, J., & Kim, J. (2020). A Comprehensive Study on the Effect of TiN Top and Bottom Electrodes on Atomic Layer Deposited Ferroelectric Hf0.5Zr0.5O2 Thin Films. Materials, 13(13), 2968. https://doi.org/10.3390/ma13132968







