Anomaly Detection Using Signal Segmentation and One-Class Classification in Diffusion Process of Semiconductor Manufacturing
Abstract
1. Introduction
- The proposed method outperformed the existing methods and had the highest accuracy and F1-score.
- Because modeling is possible under extreme conditions of class imbalance, it can be applied to various manufacturing fields.
2. Application Problem
3. Proposed Method
3.1. Phase I—Step 1: Signal Segmentation
3.2. Phase I—Step 2: LOF Score Calculation
3.3. Phase I—Step 3: Isolation Forest Modeling
3.4. Phase II
4. Experiments
4.1. Data Description
4.2. Comparison of Experimental Results with Other State-of-the-Art Methods
5. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Chien, C.-F.; Hsu, C.-Y.; Chen, P.-N. Semiconductor fault detection and classification for yield enhancement and manufacturing intelligence. Flex. Serv. Manuf. J. 2012, 25, 367–388. [Google Scholar] [CrossRef]
- Kate, R.J. Using dynamic time warping distances as features for improved time series classification. Data Min. Knowl. Discov. 2015, 30, 283–312. [Google Scholar] [CrossRef]
- Schäfer, P. The BOSS is concerned with time series classification in the presence of noise. Data Min. Knowl. Discov. 2015, 29, 1505–1530. [Google Scholar] [CrossRef]
- Lines, J.; Davis, L.M.; Hills, J.; Bagnall, A. A shapelet transform for time series classification. In Proceedings of the 18th ACM SIGKDD International Conference on Knowledge Discovery and Data Mining, Beijing, China, 12–16 August 2012. [Google Scholar] [CrossRef]
- Lines, J.; Taylor, S.; Bagnall, A. Time series classification with HIVE-COTE: The hierarchical vote collective of transformation-based ensembles. ACM Trans. Knowl. Discov. Data 2018, 12. [Google Scholar] [CrossRef]
- Breunig, M.M.; Kriegel, H.-P.; Ng, R.T.; Sander, J. LOF: Identifying density-based local outliers. In Proceedings of the 2000 ACM SIGMOD International Conference on Management of Data, Dallas, TX, USA, 16–18 May 2000; pp. 93–104. [Google Scholar] [CrossRef]
- Liu, F.T.; Ting, K.M.; Zhou, Z.-H. Isolation Forest. In Proceedings of the 2008 Eighth IEEE International Conference on Data Mining, Pisa, Italy, 15–19 December 2008; IEEE: New York, NY, USA, 2008; pp. 413–422. [Google Scholar]
- Chen, Y.; Zhou, X.S.; Huang, T. One-class SVM for learning in image retrieval. In Proceedings of the 2001 International Conference on Image Processing, (Cat. No. 01CH37205), Thessaloniki, Greece, 7–10 October 2001; IEEE: New York, NY, USA, 2001; Volume 1, pp. 34–37. [Google Scholar] [CrossRef]
- Lu, X.S. Control chart for multivariate attribute processes. Int. J. Prod. Res. 1998, 36, 3477–3489. [Google Scholar] [CrossRef]
- Charikar, M.; Chekuri, C.; Feder, T.; Motwani, R. Incremental clustering and dynamic information retrieval. SIAM J. Comput. 2004, 33, 1417–1440. [Google Scholar] [CrossRef]
- Wise, B.M.; Gallagher, N.B.; Butler, S.W.; White, D.D.; Barna, G.G. A comparison of principal component analysis, mul-tiway principal component analysis, trilinear decomposition and parallel factor analysis for fault detection in a semicon-ductor etch process. J. Chemom. 1999, 13, 379–396. [Google Scholar] [CrossRef]
- He, Q.P.; Wang, J. Principal component based k-nearest-neighbor rule for semiconductor process fault detection. In Proceedings of the 2008 American Control Conference, Seattle, WA, USA, 11–13 June 2008; IEEE: New York, NY, USA, 2008; pp. 1606–1611. [Google Scholar] [CrossRef]
- Lee, K.B.; Cheon, S.; Kim, C.O. A Convolutional Neural Network for Fault Classification and Diagnosis in Semiconductor Manufacturing Processes. IEEE Trans. Semicond. Manuf. 2017, 30, 135–142. [Google Scholar] [CrossRef]
- Mauceri, S.; Sweeney, J.; McDermott, J. Dissimilarity-based representations for one-class classification on time series. Pattern Recognit. 2020, 100, 107122. [Google Scholar] [CrossRef]
- Truong, C.; Oudre, L.; Vayatis, N. Ruptures: Change point detection in Python. arXiv 2018, arXiv:1801.00826. [Google Scholar]
- Truong, C.; Oudre, L.; Vayatis, N. Selective review of offline change point detection methods. Signal Process. 2020, 167, 107299. [Google Scholar] [CrossRef]
- Xu, X.; Lei, Y.; Zhou, X. A lof-based method for abnormal segment detection in machinery condition monitoring. In Proceedings of the 2018 Prognostics and System Health Management Conference (PHM-Chongqing), Chongqing, China, 26–28 October 2018; IEEE: New York, NY, USA; pp. 125–128. [Google Scholar] [CrossRef]
- Kakizawa, Y.; Shumway, R.H.; Taniguchi, M. Discrimination and Clustering for Multivariate Time Series. J. Am. Stat. Assoc. 1998, 93, 328–340. [Google Scholar] [CrossRef]
- Lotfy, K. A novel model of magneto photothermal diffusion (MPD) on polymer nano-composite semiconductor with initial stress. Waves Random Complex Media 2021, 31, 83–100. [Google Scholar] [CrossRef]
- D’Hondt, J.; Vertommen, J.; Verhaegen, P.-A.; Cattrysse, D.; Duflou, J.R. Pairwise-adaptive dissimilarity measure for document clustering. Inf. Sci. 2010, 180, 2341–2358. [Google Scholar] [CrossRef]
- Rakthanmanon, T.; Campana, B.; Mueen, A.; Batista, G.; Westover, B.; Zhu, Q.; Zakaria, J.; Keogh, E. Addressing big data time series: Mining trillions of time series subsequences under dynamic time warping. ACM Trans. Knowl. Discov. Data 2013, 7, 1–31. [Google Scholar] [CrossRef]
- Peña, D.; Galeano, P. Multivariate Analysis in Vector Time Series (No. ws012415); Universidad Carlos III de Madrid, Departamento de Estadística: Madrid, Spain, 2001. [Google Scholar]
- Guillaume, P.; Schoukens, J.; Pintelon, R.; Kollar, I. Crest-factor minimization using nonlinear Chebyshev approximation methods. IEEE Trans. Instrum. Meas. 1991, 40, 982–989. [Google Scholar] [CrossRef]
- Ciaschini, M.; Pretaroli, R.; Socci, C. Balance, Manhattan norm and Euclidean distance of industrial policies for the US. Struct. Chang. Econ. Dyn. 2011, 22, 204–226. [Google Scholar] [CrossRef][Green Version]
- Wang, W.; Xu, Z.; Lu, W.; Zhang, X. Determination of the spread parameter in the Gaussian kernel for classification and regression. Neurocomputing 2003, 55, 643–663. [Google Scholar] [CrossRef]
- Vallender, S.S. Addendum: Calculation of the wasserstein distance between probability distributions on the line. Theory Probab. Its Appl. 1982, 26, 435. [Google Scholar] [CrossRef]

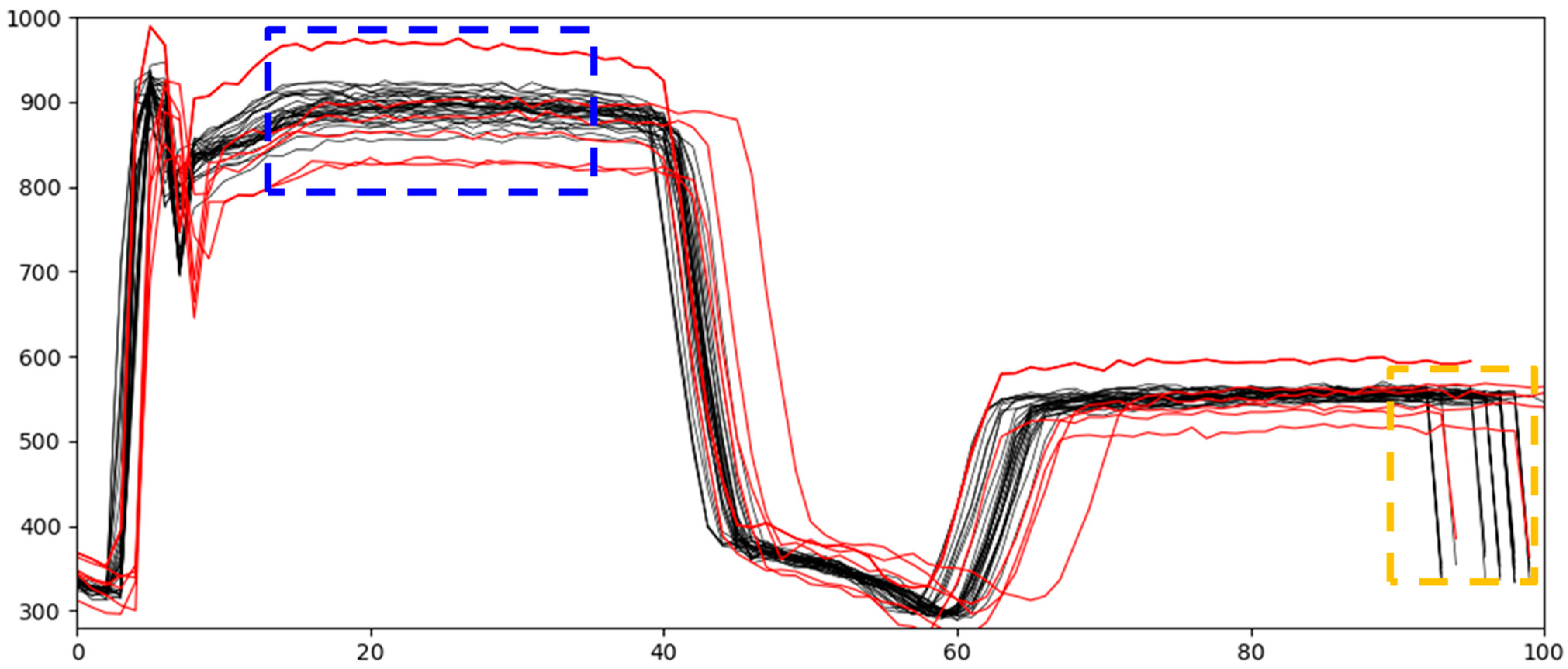



| Proposed Method | LOF | OC- SVM | iF | Mauceri et al. [14] | Rank | |||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Raw | KL | Cos | DTW | AC | Ch. | Ma. | Eu. | Gk | Sk. | Wa. | ||||||
| data#1 | 0.960 | 0.857 | 0.736 | 0.868 | 0.817 | 0.770 | 0.817 | 0.756 | 0.776 | 0.680 | 0.764 | 0.774 | 0.762 | 0.729 | 0.756 | 1 |
| data#2 | 0.908 | 0.897 | 0.707 | 0.771 | 0.790 | 0.692 | 0.750 | 0.743 | 0.742 | 0.644 | 0.750 | 0.761 | 0.750 | 0.679 | 0.741 | 1 |
| data#3 | 0.963 | 0.931 | 0.685 | 0.807 | 0.825 | 0.680 | 0.756 | 0.748 | 0.706 | 0.727 | 0.781 | 0.761 | 0.739 | 0.682 | 0.731 | 1 |
| data#4 | 0.961 | 0.884 | 0.690 | 0.925 | 0.826 | 0.619 | 0.767 | 0.692 | 0.807 | 0.677 | 0.698 | 0.745 | 0.677 | 0.653 | 0.702 | 1 |
| data#5 | 0.957 | 0.756 | 0.671 | 0.725 | 0.745 | 0.668 | 0.767 | 0.709 | 0.716 | 0.627 | 0.696 | 0.705 | 0.679 | 0.617 | 0.706 | 1 |
| data#6 | 0.908 | 0.771 | 0.694 | 0.731 | 0.692 | 0.689 | 0.760 | 0.690 | 0.732 | 0.730 | 0.690 | 0.689 | 0.684 | 0.690 | 0.690 | 1 |
| data#7 | 0.861 | 0.892 | 0.753 | 0.733 | 0.731 | 0.678 | 0.731 | 0.728 | 0.752 | 0.721 | 0.748 | 0.731 | 0.731 | 0.720 | 0.739 | 2 |
| data#8 | 0.875 | 0.818 | 0.726 | 0.654 | 0.712 | 0.698 | 0.682 | 0.682 | 0.677 | 0.716 | 0.684 | 0.692 | 0.681 | 0.698 | 0.689 | 1 |
| data#9 | 0.891 | 0.883 | 0.674 | 0.688 | 0.671 | 0.695 | 0.662 | 0.672 | 0.782 | 0.714 | 0.670 | 0.670 | 0.661 | 0.660 | 0.669 | 1 |
| data#10 | 0.861 | 0.750 | 0.655 | 0.657 | 0.721 | 0.671 | 0.645 | 0.662 | 0.678 | 0.688 | 0.663 | 0.666 | 0.647 | 0.643 | 0.664 | 1 |
| data#11 | 0.883 | 0.841 | 0.701 | 0.708 | 0.692 | 0.702 | 0.671 | 0.692 | 0.675 | 0.694 | 0.688 | 0.689 | 0.686 | 0.700 | 0.692 | 1 |
| data#12 | 0.899 | 0.892 | 0.717 | 0.668 | 0.725 | 0.782 | 0.646 | 0.721 | 0.646 | 0.692 | 0.699 | 0.688 | 0.665 | 0.731 | 0.720 | 1 |
| data#13 | 0.959 | 0.956 | 0.828 | 0.917 | 0.621 | 0.577 | 0.576 | 0.677 | 0.601 | 0.655 | 0.600 | 0.600 | 0.581 | 0.637 | 0.677 | 1 |
| data#14 | 0.935 | 0.877 | 0.837 | 0.814 | 0.742 | 0.744 | 0.800 | 0.759 | 0.784 | 0.764 | 0.737 | 0.735 | 0.694 | 0.735 | 0.736 | 1 |
| data#15 | 0.929 | 0.919 | 0.698 | 0.692 | 0.839 | 0.717 | 0.830 | 0.837 | 0.826 | 0.845 | 0.827 | 0.852 | 0.827 | 0.801 | 0.827 | 1 |
| data#16 | 0.926 | 0.901 | 0.701 | 0.682 | 0.695 | 0.695 | 0.691 | 0.691 | 0.689 | 0.693 | 0.695 | 0.695 | 0.691 | 0.695 | 0.695 | 1 |
| data#17 | 0.914 | 0.895 | 0.687 | 0.736 | 0.767 | 0.696 | 0.727 | 0.735 | 0.729 | 0.784 | 0.740 | 0.743 | 0.730 | 0.720 | 0.739 | 1 |
| data#18 | 0.827 | 0.763 | 0.696 | 0.700 | 0.732 | 0.690 | 0.709 | 0.706 | 0.706 | 0.735 | 0.706 | 0.709 | 0.700 | 0.690 | 0.706 | 1 |
| Avg. | 0.912 | 0.860 | 0.714 | 0.749 | 0.741 | 0.693 | 0.721 | 0.717 | 0.724 | 0.710 | 0.713 | 0.717 | 0.699 | 0.693 | 0.716 | 1 |
| Proposed Method | LOF | OC- SVM | iF | Mauceri et al. [14] | Rank | |||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Raw | KL | Cos | DTW | AC | Ch. | Ma. | Eu. | Gk | Sk. | Wa. | ||||||
| data#1 | 0.970 | 0.903 | 0.833 | 0.907 | 0.621 | 0.476 | 0.622 | 0.421 | 0.502 | 0.171 | 0.452 | 0.486 | 0.446 | 0.314 | 0.422 | 1 |
| data#2 | 0.934 | 0.928 | 0.818 | 0.849 | 0.544 | 0.140 | 0.399 | 0.372 | 0.369 | 0.258 | 0.399 | 0.443 | 0.399 | 0.072 | 0.366 | 1 |
| data#3 | 0.972 | 0.950 | 0.807 | 0.870 | 0.644 | 0.071 | 0.426 | 0.393 | 0.231 | 0.388 | 0.511 | 0.444 | 0.358 | 0.090 | 0.322 | 1 |
| data#4 | 0.967 | 0.909 | 0.783 | 0.936 | 0.741 | 0.184 | 0.619 | 0.426 | 0.705 | 0.439 | 0.446 | 0.567 | 0.378 | 0.307 | 0.457 | 1 |
| data#5 | 0.964 | 0.826 | 0.776 | 0.801 | 0.565 | 0.349 | 0.617 | 0.473 | 0.495 | 0.226 | 0.436 | 0.460 | 0.385 | 0.166 | 0.464 | 1 |
| data#6 | 0.934 | 0.853 | 0.812 | 0.828 | 0.143 | 0.127 | 0.440 | 0.130 | 0.327 | 0.326 | 0.130 | 0.127 | 0.100 | 0.130 | 0.130 | 1 |
| data#7 | 0.904 | 0.925 | 0.842 | 0.830 | 0.323 | 0.068 | 0.323 | 0.309 | 0.406 | 0.278 | 0.392 | 0.323 | 0.323 | 0.275 | 0.358 | 2 |
| data#8 | 0.913 | 0.880 | 0.828 | 0.788 | 0.240 | 0.171 | 0.075 | 0.087 | 0.058 | 0.255 | 0.097 | 0.139 | 0.082 | 0.171 | 0.125 | 1 |
| data#9 | 0.919 | 0.916 | 0.796 | 0.801 | 0.134 | 0.248 | 0.089 | 0.134 | 0.558 | 0.325 | 0.127 | 0.127 | 0.085 | 0.082 | 0.122 | 1 |
| data#10 | 0.898 | 0.834 | 0.783 | 0.780 | 0.396 | 0.227 | 0.090 | 0.159 | 0.237 | 0.281 | 0.168 | 0.177 | 0.098 | 0.071 | 0.168 | 1 |
| data#11 | 0.918 | 0.893 | 0.815 | 0.816 | 0.141 | 0.192 | 0.025 | 0.142 | 0.046 | 0.155 | 0.120 | 0.128 | 0.109 | 0.182 | 0.142 | 1 |
| data#12 | 0.924 | 0.921 | 0.812 | 0.786 | 0.412 | 0.586 | 0.093 | 0.400 | 0.093 | 0.295 | 0.319 | 0.279 | 0.182 | 0.433 | 0.398 | 1 |
| data#13 | 0.961 | 0.959 | 0.857 | 0.925 | 0.338 | 0.208 | 0.204 | 0.491 | 0.282 | 0.436 | 0.280 | 0.280 | 0.220 | 0.385 | 0.491 | 1 |
| data#14 | 0.952 | 0.914 | 0.890 | 0.874 | 0.368 | 0.378 | 0.571 | 0.433 | 0.520 | 0.451 | 0.348 | 0.338 | 0.149 | 0.338 | 0.343 | 1 |
| data#15 | 0.948 | 0.942 | 0.814 | 0.806 | 0.682 | 0.269 | 0.656 | 0.675 | 0.647 | 0.704 | 0.649 | 0.713 | 0.649 | 0.576 | 0.649 | 1 |
| data#16 | 0.946 | 0.930 | 0.815 | 0.802 | 0.159 | 0.159 | 0.138 | 0.138 | 0.126 | 0.149 | 0.159 | 0.159 | 0.138 | 0.159 | 0.159 | 1 |
| data#17 | 0.937 | 0.926 | 0.808 | 0.830 | 0.461 | 0.161 | 0.305 | 0.339 | 0.315 | 0.521 | 0.359 | 0.374 | 0.319 | 0.278 | 0.356 | 1 |
| data#18 | 0.880 | 0.848 | 0.812 | 0.809 | 0.335 | 0.133 | 0.225 | 0.212 | 0.212 | 0.446 | 0.212 | 0.228 | 0.182 | 0.133 | 0.212 | 1 |
| Avg. | 0.936 | 0.903 | 0.817 | 0.835 | 0.403 | 0.230 | 0.329 | 0.318 | 0.341 | 0.339 | 0.311 | 0.322 | 0.256 | 0.231 | 0.316 | 1 |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Chang, K.; Yoo, Y.; Baek, J.-G. Anomaly Detection Using Signal Segmentation and One-Class Classification in Diffusion Process of Semiconductor Manufacturing. Sensors 2021, 21, 3880. https://doi.org/10.3390/s21113880
Chang K, Yoo Y, Baek J-G. Anomaly Detection Using Signal Segmentation and One-Class Classification in Diffusion Process of Semiconductor Manufacturing. Sensors. 2021; 21(11):3880. https://doi.org/10.3390/s21113880
Chicago/Turabian StyleChang, Kyuchang, Youngji Yoo, and Jun-Geol Baek. 2021. "Anomaly Detection Using Signal Segmentation and One-Class Classification in Diffusion Process of Semiconductor Manufacturing" Sensors 21, no. 11: 3880. https://doi.org/10.3390/s21113880
APA StyleChang, K., Yoo, Y., & Baek, J.-G. (2021). Anomaly Detection Using Signal Segmentation and One-Class Classification in Diffusion Process of Semiconductor Manufacturing. Sensors, 21(11), 3880. https://doi.org/10.3390/s21113880






