Comprehensive Review of Wide-Bandgap (WBG) Devices: SiC MOSFET and Its Failure Modes Affecting Reliability
Abstract
1. Introduction
2. Wide-Bandgap (WBG) Devices
2.1. Material Advantages of SiC for Power Electronic Devices
2.2. Major Intrinsic Advantages of SIC Devices
- Semiconductors’ large band gaps enable operation at high electric fields. Because wide-bandgap materials have high-impact ionization energy, large electric fields may be reached without ionized carrier avalanche multiplication. Because of this, wide-bandgap semiconductors have an electric field for accelerating carriers that is many times greater than that of silicon. Breakdown voltages in wide-bandgap semiconductor devices are many times higher than in silicon devices [18,19,20,21].
- The inherent connection between a semiconductor’s intrinsic carrier concentration and energy gap allows for operation at high temperatures. A smaller concentration of intrinsic carriers is obtained with a wider gap. Wide-bandgap semiconductors, in contrast to silicon, have a greater transition temperature between intrinsic conductivity and doping-dominated extrinsic conduction. Wide-bandgap material-based devices have the benefit of operating at high temperatures [22,23].
- Wide-bandgap semiconductor devices may operate at high frequencies by shrinking in size, which is made possible by the strong electric field that allows for the use of larger doping concentrations in the active portion of the devices. As a result, the input and output capacitances of wide-bandgap semiconductor devices are decreased, opening the door to higher-frequency operation [24].
- Wide-bandgap semiconductors may operate at high current densities because of their high thermal conductivity and electron drift velocity. These characteristics offer the capacity to manage high current densities with low resistances [25].
3. SiC MOSFET Characteristics
3.1. Gate-to-Source Voltage (Vgs)
3.2. Threshold Voltage Shift
- Timing changes during switching because of the switch functioning in a regime that was not considered during design;
- Undesired conduction below the threshold;
- Inability to turn off.
3.2.1. Threshold Voltage Shift Characteristics Under Fast Switching
3.2.2. Threshold Voltage Shift Characteristics Under High Temperature
3.3. ON Resistance of SiC MOSFET
4. The SiC MOSFET Failure Modes and Their Implications for Reliability
4.1. Gate Oxide Layer Failure
4.2. Body Diode Failure
- Simulation-Based Optimization: Traditional trial-and-error approaches for optimizing SiC epitaxial growth are time-consuming and expensive. To overcome this, simulation methods have been developed to efficiently optimize growth parameters [57].
- High Growth Rates with Trichlorosilane (TCS): Research has shown that using TCS as a silicon precursor allows for high epitaxial growth rates in 4H-SiC. Optimal epilayers were obtained at 1600 °C, with a TCS flow rate of 12 sccm and a C/Si ratio of 0.42, resulting in satisfactory surface morphology [58].
- Step-Controlled Epitaxy: Recent advancements in silicon carbide (SiC) epitaxial growth have concentrated on refining approaches to improve material quality and device performance. A major advancement is the step-controlled epitaxy approach, which allows for the creation of single-phase SiC crystals by precisely manipulating the substrate’s surface steps during the chemical vapor deposition process. This approach has proved useful in creating high-quality epitaxial layers with fewer flaws, which improves the performance of SiC-based devices [59].
- Buffer-Layer Utilization: Implementing a Si1−XGeX buffer layer between the Si substrate and the SiC epitaxial layer has been found to reduce defects and improve the overall quality of the SiC epi-film. Optimizing the carbonization temperature and Ge concentration is crucial for achieving these improvements [60].
- Large-Area Uniform Graphene Growth: By optimizing the temperature field during the thermal breakdown of 4H-SiC, large-area uniform monolayer epitaxial graphene may be produced, which is useful in a variety of applications [61].
4.3. Gate Leakage Current Failure
- Gate Leakage Current as a Failure Indicator: A study provided an efficient screening method based on the relationship between initial gate leakage current and oxide failure time at a constant gate voltage. The study implies that monitoring early gate leakage could be used to predict oxide reliability [64].
- Gate Leakage Current Thresholds in Degradation Monitoring: In SiC MOSFET condition monitoring, a large gate leakage current is required for the estimate to exceed the threshold level, indicating MOSFET degeneration. According to the study, a threshold level of estimated leakage may be set as low as 3 mA without causing a false-positive monitoring signal [65].
- Gate Leakage Current in Short-Circuit Events: According to Ref. [64], SiC MOSFETs can break down in few microseconds owing to thermal runaway or gate failure during short-circuit events. This emphasizes the necessity of understanding gate leakage behavior in these kinds of conditions.
Impact of Load Current on Gate Leakage Current Failure
4.4. Avalanche Events Causing Failure
4.4.1. Impact of Avalanche Events on ON Resistance Causing Failure
4.4.2. Environmental Effects on Reliability of SiC MOSFET
- Humidity effects: Humidity significantly affects the reliability and performance of silicon carbide (SiC) MOSFETs. Exposure to high-humidity environments can cause a negative shift in the devices’ threshold voltage, as well as a drop in maximum transconductance and drain current. The degradation is caused by moisture-induced corrosion of metal contacts and interconnects, which increases device resistance [76]. Furthermore, studies show that thermomechanical stress caused by power cycling could accelerate humidity-induced degradation. Thermal stress can cause delamination and micro-cracks, which can allow moisture to enter and compromise device integrity [51]. In addition, prolonged exposure to high-humidity and -temperature conditions has been shown to cause corrosion in SiC devices, which stresses the importance of complete humidity robustness validation in design and application [77].
- Temperature effects: Temperature has an important impact on the performance and reliability of silicon carbide (SiC) MOSFETs. Elevated temperatures can cause a rise in ON resistance, which results in larger conduction losses [78]. On commercial SiC power MOSFETs, significant changes in device properties over 125 °C were found. In addition, [77], which compared temperature-sensitive electrical properties of SiC MOSFETs at extremely high temperatures, showed the devices’ capacity to operate under such conditions, stressing the need to understand temperature-dependent behaviors [79]. Analyzing the thermal performance of SiC MOSFETs under various situations showed that thermal management is crucial, as the maximum junction temperature decreased by over 31.7 °C and the junction temperature swing decreased by 46%.
- Mechanical Stress: Ref. [80] investigated SiC MOSFET failure processes during short-circuit events, indicating that these devices face significant electrical, thermal, and mechanical stresses. The findings showed that the combined effects of high temperature and mechanical stress degrade the gate oxide and increase leakage currents, ultimately leading to device failure. The study highlighted the need for better device packaging and stress-reduction approaches to improve SiC MOSFET reliability. Another study [81] investigated the combined electrical, thermal, and mechanical stress in SiC MOSFETs during short-circuit periods. The study presented improved test methodologies for assessing failure modes and reliability limits in 4H-SiC power MOSFETs. The findings showed that excessive mechanical stress accelerates degradation, especially when paired with numerous high-power switching events. This study concluded that thorough stress analysis and enhanced heat management measures are required to increase devices’ life. Furthermore, ref. [82] investigated the degradation of SiC MOSFETs under accelerated stress in power-factor correction (PFC) converters. Using an online monitoring system, Ref. [83] found that mechanical stress from repetitive power cycling resulted in greater threshold voltage changes and growing ON resistance (RDS(on). Ref. [84] found that packaging-induced mechanical stress causes a huge performance decline, requiring more effective mechanical design and stress-reducing materials.
5. Conclusions and Future Directions
- Improved Material Characterization: Future studies should concentrate on creating more sophisticated methods to identify flaws in SiC materials, especially those affecting the junctions and gate oxide. More resilient SiC MOSFETs may result from our growing understanding of the atomic-level nature and behavior of these flaws.
- Dependability in Adverse Environments: Further investigation is required to determine the long-term dependability of SiC MOSFETs in adverse environments, including intense radiation, extremely high temperatures, and high-frequency operations. This is especially significant given their use in the military, aerospace, and other vital industries.
- Better Device Architecture: Some of the existing reliability problems may be resolved by more device architecture innovation, such as the creation of innovative gate architectures and passivation layers. Investigating novel materials for passivation and gate oxides may potentially provide answers to the SiC MOSFET deterioration issues.
- Packaging and Thermal Management: Another critical area for future study is the development of sophisticated packaging methods that can withstand the greater thermal loads associated with SiC MOSFETs. Reaching the maximum potential of SiC devices in high-power applications would require effective thermal control.
- Integration with Developing Technologies: New avenues for power electronics may be created by combining SiC MOSFETs with other developing technologies, such as wide-bandgap semiconductors like gallium nitride (GaN). The development of hybrid systems that combine the advantages of GaN and SiC may result in devices with previously unheard-of performance levels.
Author Contributions
Funding
Conflicts of Interest
References
- Thakur, A.; Kumari, S. A comprehensive review of wide band-gap semiconductors technology. Int. J. Adv. Res. Innov. Ideas Educ. 2023, 9, 417–422. [Google Scholar]
- Ning, T.; Yuan, Y.; Kang, C.; Li, H.L. Review of Si IGBT and SiC MOSFET based on hybrid switch. Chin. J. Electr. Eng. 2019, 5, 20–29. [Google Scholar] [CrossRef]
- Alves, L.F.S.; Gomes, R.C.M.; Lefranc, P.; De Alves Pegado, R.; Jeannin, P.; Luciano, B.A.; Rocha, F.V. Sic Power Devices in Power Electronics: An Overview. In Proceedings of the Brazilian Power Electronics Conference (COBEP), Juiz de Fora, Brazil, 19–22 November 2017; pp. 1–8. [Google Scholar]
- Zhang, J. Power Electronics in Future Electrical Power Grids. In Proceedings of the IEEE International Symposium on Power Electronics for Distributed Generation Systems (PEDG), Little Rock, AR, USA, 8–11 July 2013; pp. 1–3. [Google Scholar]
- Agarwal, A.K. An Overview of Sic Power Devices. In Proceedings of the International Conference on Power, Control and Embedded Systems, Allahabad, India, 29 November–1 December 2010; pp. 1–4. [Google Scholar]
- Shenai, K.; Scott, R.S.; Baliga, B.J. Optimum semiconductors for high-power electronics. IEEE Trans. Electron Devices 1989, 36, 1811–1823. [Google Scholar] [CrossRef]
- Xue, H.; He, Q.; Jian, G.; Long, S.; Pang, T.; Liu, M. An overview of the ultrawide bandgap Ga2O3 semiconductor-based schottky barrier diode for power electronics application. Nanoscale Res. Lett. 2018, 13, 12. [Google Scholar] [CrossRef] [PubMed]
- Zhang, H.; Tolbert, L.M. Efficiency impact of silicon carbide power electronics for modern wind turbine full scale frequency converter. IEEE Trans. Ind. Electron. 2011, 58, 21–28. [Google Scholar] [CrossRef]
- Chen, X.; Yang, X.; Xie, X.; Peng, Y.; Xiao, L.; Chen, S.; Li, H.; Hu, X.; Xu, X. Research progress of large size SiC single crystal materials and devices. Light Sci. Appl. 2023, 12, 28. [Google Scholar] [CrossRef]
- He, Y.; Moore, D.C.; Wang, Y.; Ware, S.; Ma, S.; Pradhan, D.K.; Hu, Z.; Du, X.; Kennedy, J.; Glavin, N.R.; et al. Al0. 68Sc0. 32N/SiC based metal-ferroelectric-semiconductor capacitors operating up to 900 C. arXiv 2024, arXiv:2411.16652. [Google Scholar]
- Wang, R.; Boroyevich, D.; Ning, P.; Wang, Z.; Wang, F.; Mattavelli, P.; Ngo, K.T.D.; Rajashekara, K.A. high-temperature SiC three-phase AC-DC converter design for >100°C ambient temperature. IEEE Trans. Power Electron. 2013, 28, 555–572. [Google Scholar] [CrossRef]
- Zhang, L.; Zheng, Z.; Lou, X. A review of WBG and Si devices hybrid applications. Chin. J. Electr. Eng. 2021, 7, 1–20. [Google Scholar] [CrossRef]
- Langpoklakpam, C.; Liu, A.-C.; Chu, K.-H.; Hsu, L.-H.; Lee, W.-C.; Chen, S.-C.; Sun, C.-W.; Shih, M.-H.; Lee, K.-Y.; Kuo, H.-C. Review of Silicon Carbide Processing for Power MOSFET. Crystals 2022, 12, 245. [Google Scholar] [CrossRef]
- Glass, R.C.; Henshall, D.; Tsvetkov, V.F.; Carter, C.H., Jr. SiC-seeded crystal growth. MRS Bull. 1997, 22, 30. [Google Scholar] [CrossRef]
- Tsvetkov, V.F.; Allen, S.T.; Kong, H.S.; Carter, C.H., Jr. Recent Progress in SiC Crystal Growth. In Proceedings of the International Conference on Silicon Carbide and Related Materials, Tsukuba, Japan, 28 October–2 November 1995; Volume 7, pp. 73–84. [Google Scholar]
- ROHM Semiconductor. Application Note for Sic Power Devices and Modules. Rev.003. 2014. Available online: https://fscdn.rohm.com/en/products/databook/applinote/discrete/sic/common/sic_appli-e.pdf (accessed on 25 February 2025).
- Marcuzzi, A.; Favero, D.; Santi, C.D.; Meneghesso, G.; Zanoni, E.; Meneghini, M. A Review of SiC Commercial Devices for Automotive: Properties and Challenges. In Proceedings of the International Conference on Electrical and Electronic Technologies for Automotive (AEIT AUTOMOTIVE), Modena, Italy, 17–19 July 2023; pp. 1–6. [Google Scholar]
- Liu, T.; Zhu, S.; White, M.H.; Salemi, A.; Sheridan, D.; Agarwal, A.K. Time-Dependent Dielectric Breakdown of Commercial 1.2 kV 4H-SiC Power MOSFETs. IEEE J. Electron Devices Soc. 2021, 9, 633–639. [Google Scholar] [CrossRef]
- Masin, F.; De Santi, C.; Lettens, J.; Franchi, J.; Domeji, M.; Moens, P.; Meneghini, M.; Meneghesso, G.; Zanoni, E. non-monotonic threshold voltage variation in 4H-SiC metal–oxide semiconductor field-effect transistor: Investigation and modeling. J. Appl. Phys. 2021, 130, 14. [Google Scholar] [CrossRef]
- Zheng, Y.; Potera, R.; Witt, T. Characterization of Early Breakdown of SiC MOSFET Gate Oxide by Voltage Ramp Tests. In Proceedings of the IEEE International Reliability Physics Symposium (IRPS), Monterey, CA, USA, 21–25 March 2021. [Google Scholar]
- Wang, J.; Zhao, T.; Li, J.; Huang, A.Q.; Callanan, R.; Husna, F.; Agarwal, A. Characterization, modeling, and application of 10-kv sic mosfet. IEEE Trans. Electron Devices 2008, 55, 1798–1806. [Google Scholar] [CrossRef]
- Whitaker, B.; Passmore, B.; McNutt, M.T.; Lostetter, A.; Ericson, M.N.; Shane, S.; Charles, F.; Britton, L.; Mantooth, A.; Lamichhane, R.; et al. High-Temperature SiC Power Module with Integrated SiC Gate Drivers for Future High-Density Power Electronics Applications. In Proceedings of the IEEE Workshop on Wide Bandgap Power Devices and Applications, Knoxville, TN, USA, 13–15 October 2014; pp. 36–40. [Google Scholar]
- Funaki, T.; Balda, J.C.; Junghans, J.; Kashyap, A.S.; Mantooth, H.A.; Barlow, F.; Kimoto, T.; Hikihara, T. Power conversion with SiC devices at extremely high ambient temperatures. IEEE Trans. Power Electron. 2007, 22, 1321–1329. [Google Scholar] [CrossRef]
- Abou-Alfotouh, A.M.; Radun, A.V.; Chang, H.; Winterhalter, C. A 1-MHz hard-switched silicon carbide DC–DC converter. IEEE Trans. Power. Electron. 2006, 21, 880–889. [Google Scholar] [CrossRef]
- Wrzecionko, B.; Bortis, D.; Kolar, J.W. A 120 °C ambient temperature forced air-cooled normally-off SiC JFET automotive inverter system. IEEE Trans. Power Electron. 2014, 29, 2345–2358. [Google Scholar] [CrossRef]
- Rabkowski, J.; Peftitsis, D.; Nee, H.P. Parallel-operation of discrete SiC BJTs in a 6-kW/250-kHz DC/DC boost converter. IEEE Trans. Power Electron. 2014, 29, 2482–2491. [Google Scholar] [CrossRef]
- Whitaker, B.; Barkley, A.; Cole, Z.; Passmore, B.; Martin, D.; McNutt, T.; Lostetter, A.; Lee, J.; Shiozaki, K. A high-density, high-efficiency, isolated on-board vehicle battery charger utilizing silicon carbide power devices. IEEE Trans. Power Electron. 2014, 29, 2606–2617. [Google Scholar] [CrossRef]
- Liang, Z. Status and Trends of Automotive Power Module Packaging. In Proceedings of the International Symposium on Power Semiconductor Devices and Ics, Bruges, Belgium, 3–7 June 2012; pp. 325–331. [Google Scholar]
- Millan, J. A review of WBG Power Semiconductor Devices. In Proceedings of the International Semiconducter Conference (CAS), Sinaia, Romania, 15–17 October 2012; pp. 57–66. [Google Scholar]
- Agarwal, A.; Callanan, R.; Das, M.; Hull, B.; Richmond, J.; Ryu, S.-H.; Palmour, J. Advanced HF SiC MOS devices. In Proceedings of the European Conference on Power Electronics and Applications, Barcelona, Spain, 8–10 September 2009; pp. 5952–5961. [Google Scholar]
- Gonzalez, J.O.; Alatise, O. Impact of BTI-induced threshold voltage shifts in shoot-through currents from crosstalk in SiC MOSFETs. IEEE Trans. Power Electron 2021, 36, 3279–3291. [Google Scholar] [CrossRef]
- Puschkarsky, K.; Grasser, T.; Aichinger, T.; Gustin, W.; Reisinger, H. Understanding and Modeling Transient Threshold Voltage Instabilities in SiC MOSFETs. In Proceedings of the IEEE International Reliability Physics Symposium (IRPS), Burlingame, CA, USA, 11–15 March 2018; pp. 1–10. [Google Scholar] [CrossRef]
- Jiang, J.; Tang, X.; Tan, K.; Hu, Z.; Tian, M.; Xu, Y.; Li, H.; Zhu, W.; Li, H.; Hu, C.; et al. Characterization of Threshold Voltage Shift in SiC MOSFETs Under Nanosecond-Range Switching and Its Impact on High- Frequency Applications. IEEE Trans. Electron Devices 2024, 71, 4227–4232. [Google Scholar] [CrossRef]
- Cioni, M.; Bertacchini, A.; Mucci, A.; Zagni, N.; Verzellesi, G.; Pavan, P.; Chini, A. Evaluation of Vth and RON Drifts during Switch-Mode Operation in Packaged SiC MOSFETs. Electronics 2021, 10, 441. [Google Scholar] [CrossRef]
- Suganuma, K. : Wide Bandgap Power Semiconductor Packaging: Materials, Components, and Reliability (Woodhead Publishing Series in Electronic and Optical Materials); Woodhead Publishing: Sawston, UK, 2018. [Google Scholar]
- Chen, C.; Cai, Y.; Sun, P.; Zhao, Z. Threshold voltage instability of SiC MOSFETs under very-high temperature and wide gate bias. IET Power Electron. 2024, 17, 2393–2404. [Google Scholar] [CrossRef]
- Alatise, O.; Deb, A.; Bashar, E.; Ortiz Gonzalez, J.; Jahdi, S.; Issa, W. A Review of Power Electronic Devices for Heavy Goods Vehicles Electrification: Performance and Reliability. Energies 2023, 16, 4380. [Google Scholar] [CrossRef]
- Santini, T.; Sebastien, M.; Florent, M.; Phung, L.V.; Bruno, A. Gate Oxide Reliability Assessment of a SiC MOSFET for High Temperature Aeronautic Applications. In Proceedings of the IEEE ECCE Asia Downunder-5th IEEE Annual International Energy Conversion Congress Exhibition, Melbourne, Australia, 3–6 June 2013; pp. 385–391. [Google Scholar]
- Goel, N.; Tripathi, A. Temperature effects on Threshold Voltage and Mobility for Partially Depleted SOI MOSFET. Int. J. Comput. Appl. 2012, 42, 21. [Google Scholar]
- Shivendra, K.; Rathaur, A.D.; Chang, E.Y. Impact of temperature on threshold voltage instability under negative bias in ferroelectric charge trap (FEG) GaN-HEMT. Appl. Phys. Lett. 2024, 125, 102–104. [Google Scholar] [CrossRef]
- Poli, S.; Reggiani, S.; Denison, M.; Ghani, E.; Gnudi, A.; Baccarani, G. Temperature Dependence of the Threshold Voltage Shift Induced by Carrier Injection in Integrated STI-Based LDMOS Transistors. IEEE Electron Device Lett. 2011, 32, 791–793. [Google Scholar] [CrossRef]
- Etoz, B.; Gonzalez, J.O.; Deb, A.; Jahdi, S.; Alatise, O. Impact of Threshold Voltage Shifting on Junction Temperature Sensing in GaN HEMTs. In Proceedings of the 24th European Conference on Power Electronics and Applications (EPE’22 ECCE Europe), Hanover, Germany, 5–9 September 2022; pp. P.1–P.9. [Google Scholar]
- Ho, C.N.-M.; Breuninger, H.; Pettersson, S.; Escobar, G.; Canales, F. A comparative performance study of an interleaved boost converter using commercial Si and SiC diodes for PV applications. IEEE Trans. Power Electron. 2013, 28, 289–299. [Google Scholar] [CrossRef]
- Lostetter, A.; Hornberger, J.; McPherson, B.; Reese, B.; Shaw, R.; Schupbach, M.; Rowden, B.; Mantooth, A.; Balda, J.; Otsuka, T.; et al. High-temperature silicon carbide and silicon on insulator based integrated power modules. In Proceedings of the 2009 IEEE Vehicle Power and Propulsion Conference, Dearborn, MI, USA, 7–10 September 2009; pp. 1032–1035. [Google Scholar]
- Wood, R.A.; Salem, T.E. Evaluation of 1200-V, 800-A All-SiC Dual Module. IEEE Trans. Power Electron. 2011, 26, 2504–2511. [Google Scholar] [CrossRef]
- Horio, M.; Iizuka, Y.; Ikeda, Y. Packaging technologies for SiC power modules. Fuji Electr. Rev. 2011, 58, 75–80. [Google Scholar]
- Schorner, R.; Friedrichs, P.; Peters, D.; Stephani, D. Significantly improved performance of MOSFETs on silicon carbide using the 15RSiC polytype. IEEE Electron Device Lett. 1999, 20, 241–244. [Google Scholar]
- Gurfinkel, M.; Xiong, H.D.; Cheung, K.P.; Suehle, J.S.; Bernstein, J.B.; Shapira, Y. Characterization of Transient Gate Oxide Trapping in SiC MOSFETs Using Fast I–V Techniques. IEEE Trans. Electron Devices 2008, 55, 2004–2012. [Google Scholar] [CrossRef]
- Li, D.; Zhang, Y.; Tang, X.; He, Y.; Yuan, H.; Jia, Y.; Song, Q.; Zhang, M.; Zhang, Y. Effects of 5 MeV Proton Irradiation on Nitrided SiO2/4H-SiC MOS Capacitors and the Related Mechanisms. Nanomaterials 2020, 10, 1332. [Google Scholar] [CrossRef] [PubMed]
- Dasa, M.K.; Sumakeris, J.J.; Hull, B.A.; Richmond, J. Evolution of Drift-Free, High Power 4H-SiC PiN Diodes. Mater. Sci. Forum 2006, 527–529, 1329–1334. [Google Scholar] [CrossRef]
- Shi, L.; Qian, J.; Jin, M.; Bhattacharya, M.; Houshmand, S.; Yu, H.; Shimbori, A.; White, M.H.; Agarwal, A.K. Gate Oxide Reliability in Silicon Carbide Planar and Trench Metal-Oxide-Semiconductor Field-Effect Transistors Under Positive and Negative Electric Field Stress. Electronics 2024, 13, 4516. [Google Scholar] [CrossRef]
- Dasgupta, S.; Kaplar, R.J.; Marinella, M.J.; Smith, M.A.; Atcitty, S. Analysis and Prediction of Stability in Commercial, 1200 V, 33A, 4H-SiC MOSFETs. In Proceedings of the IEEE International Reliability Physics Symposium, Anaheim, CA, USA, 15–19 April 2012. pp. 3D.3.1–3D.3.5. [Google Scholar]
- Wang, Z.; Shi, X.; Xue, Y.; Tolbert, L.M.; Wang, F.; Blalock, B.J. Design and performance evaluation of overcurrent protection schemes for silicon carbide (SiC) power MOSFETs. IEEE Trans. Ind. Electron. 2014, 61, 5570–5581. [Google Scholar] [CrossRef]
- She, X.; Huang, A.Q.; Lucía, Ó.; Ozpineci, B. Review of silicon carbide power devices and their applications. IEEE Trans. Ind. Electron. 2017, 64, 8193–8205. [Google Scholar] [CrossRef]
- Adamowicz, M.; Giziewski, S.; Pietryka, J.; Krzeminski, Z. Performance Comparison of SiC Schottky Diodes and Silicon Ultra Fast Recovery Diodes. In Proceedings of the 7th International Conference-Workshop Compatibility and Power Electronics (CPE), Talinn, Estonia, 1–3 June 2011; pp. 144–149. [Google Scholar]
- Ranstad, P.; Nee, H.P. On dynamic effects influencing IGBT losses in soft-switching converters. IEEE Trans. Power Electron 2011, 26, 260–271. [Google Scholar] [CrossRef]
- Wu, D.; You, H.; Wang, X.; Zhong, S.; Sun, Q. Experimental Investigation of Threshold Voltage Temperature Effect During Cross-Temperature Write–Read Operations in 3-D NAND Flash. IEEE J. Electron Devices Soc. 2021, 9, 22–26. [Google Scholar] [CrossRef]
- Tian, J.; Tang, Z.; Tang, H.; Fan, J.; Zhang, G. Simulation of Epitaxial Growth of Silicon Carbide in a Horizontal Hot-wall CVD Reaction Chamber. In Proceedings of the 20th China International Forum on Solid State Lighting & 9th International Forum on Wide Bandgap Semiconductors, Xiamen, China, 27–30 November 2023; pp. 14–17. [Google Scholar] [CrossRef]
- Gang, J.; Sun, G.S.; Ning, J.; Kiu, X.F.; Zhao, Y.M.; Wang, L.; Zhao, W.S.; Zeng, Y.P.; Ji, G. High epitaxial growth rate of 4H-SiC using TCS as silicon precursor. In Proceedings of the 9th International Conference on Solid-State and Integrated-Circuit Technology, Beijing, China, 20–23 October 2008; pp. 696–698. [Google Scholar] [CrossRef]
- Suda, J. SiC and GaN from the viewpoint of vertical power devices. In Proceedings of the 74th Annual Device Research Conference (DRC), Newark, DE, USA, 19–22 June 2016; p. 1. [Google Scholar] [CrossRef]
- Zimbone, M.; Zielinski, M.; Barbagiovanni, E.G.; Calabretta, C.; Via, F.L. 3C-SiC grown on Si by using a Si1-xGex buffer layer. J. Cryst. Growth 2019, 519, 29. [Google Scholar] [CrossRef]
- Schrock, J.A.; Ray, W.B.; Lawson, K.; Bilbao, A.; Bayne, S.B.; Holt, S.L.; Cheng, L.; Palmour, J.W.; Scozzie, C. High-mobility stable 1200-V, 150-A 4H-SiC DMOSFET long-term reliability analysis under high current transient conditions. IEEE Trans. Power Electron. 2015, 30, 2891–2895. [Google Scholar] [CrossRef]
- Cannata, G.; De Caro, S.; Panarello, S.; Scimone, T.; Testa, A.; Russo, S. Reliability Assessment of Avalanche Mode Operating Power MOSFETs Through Coffin Manson Law Based Mathematical Models. In Proceedings of the International Symposium on Power Electronics, Electrical Drives, Automation and Motion, SPEEDAM, Ischia, Italy, 18–20 June 2014; pp. 139–145. [Google Scholar]
- Zhang, F.; Chen, X.; Yu, C.; Lu, S.; Xu, X.; Hu, X.; Li, T.; Zhao, X.; Zhang, Y.; Wang, R. Large-Area Uniform Epitaxial Graphene on SiC by Optimizing Temperature Field. In Proceedings of the 13th China International Forum on Solid State Lighting: International Forum on Wide Bandgap Semiconductors China, Beijing, China, 15–17 November 2016; pp. 54–57. [Google Scholar] [CrossRef]
- Shi, L.; Qian, J.; Jin, M.; Bhattacharya, M.; YU, H.; White, M.H.; Anant, K. An Effective Screening Technique for Early Oxide Failure in SiC Power MOSFETs. In Proceedings of the IEEE 10th Workshop on Wide Bandgap Power Devices & Applications, Charlotte, NC, USA, 4–6 December 2023; pp. 1–4. [Google Scholar] [CrossRef]
- Shi, L.; Qian, J.; Jin, M.; Bhattacharya, M.; Yu, H.; White, M.; Agarwal, A.K.; Shimbori, A. Evaluation of Burn-in Technique on Gate Oxide Reliability in Commercial SiC MOSFETs. In Proceedings of the IEEE International Reliability Physics Symposium (IRPS), Grapevine, TX, USA, 14–18 April 2024; pp. 1–6. [Google Scholar] [CrossRef]
- Zhang, M.; Li, H.; Yang, Z.; Zhao, S.; Wang, X.; Ding, L. Short Circuit Protection of Silicon Carbide MOSFETs: Challenges, Methods, and Prospects. IEEE Trans. Power Electron. 2024, 39, 13081–13095. [Google Scholar] [CrossRef]
- Cai, Y.; Sun, P.; Chen, C.; Zhang, Y.; Zhao, Z.; Li, X. Investigation on Gate Oxide Degradation of SiC MOSFET in Switching Operation. IEEE Trans. Power Electron. 2024, 39, 9565–9578. [Google Scholar] [CrossRef]
- Domeij, J.; Franchi, B.; Buono, K.; Lee, K.-S.; Park, C.-S.; Choi, S.; Sunkari, S.; Das, H. Avalanche Rugged 1200 V 80 m SiC MOSFETs with State-of-the-Art Threshold Voltage Stability. In Proceedings of the IEEE 6th Workshop Wide Bandgap Power Devices and Applications (WiPDA), Atlanta, GA, USA, 31 October–2 November 2018; pp. 114–117. [Google Scholar]
- Jang, M.-S.; Jeong, J.-H.; Lee, H.-J. Analysis of Ruggedness of 4H-SiC Power MOSFETs with Various Doping Parameters. Appl. Sci. 2023, 13, 427. [Google Scholar] [CrossRef]
- Pu, S.; Akin, B.; Yang, F. Active Channel Impact on SiC MOSFET Gate Oxide Reliability. In Proceedings of the IEEE Applied Power Electronics Conference and Exposition (APEC), Online, 14–17 June 2021; pp. 1250–1255. [Google Scholar] [CrossRef]
- Zhu, S.; Liu, T.; White, M.H.; Agarwal, A.K.; Salemi, A.; Sheridan, D. Investigation of Gate Leakage Current Behavior for Commercial 1.2 kV 4H-SiC Power MOSFETs. In Proceedings of the IEEE International Reliability Physics Symposiym (IRPS), Monterey, CA, USA, 21–25 March 2021; pp. 1–7. [Google Scholar] [CrossRef]
- Östling, M.; Ghandi, R.; Zetterling, C.-M. SiC Power Devices—Present Status, Applications and Future Perspective. In Proceedings of the IEEE 23rd International Symposium on Power Semiconductor and Devices, San Diego, CA, USA, 23–26 May 2011; pp. 10–15. [Google Scholar]
- Hosseinzadehlish, M.; Jahdi, S.; Yuan, X.; Ortiz-Gonzalez, J.; Alatise, O. High-Energy Dynamic Avalanche to Failure by Incremental Source-Voltage Increase in Symmetric Double-Trench & Asymmetric Trench SiC MOSFETs. IEEE Open J. Ind. Appl. 2024, 5, 235–252. [Google Scholar] [CrossRef]
- Takamori, T.; Wada, K.; Saito, W.; Nishizawa, S.-I. Paralleled SiC MOSFETs Circuit Breaker with a SiC MPS Diode for Avalanche Voltage Clamping. IEEE Open J. Power Electron. 2024, 5, 392–401. [Google Scholar] [CrossRef]
- Fu, H.; Wei, J.; Liu, S.; Wu, W.; Sun, W. Repetitive-avalanche-induced Electrical Degradation and Optimization for 1.2kV 4H-SiC MOSFETs. In Proceedings of the IEEE 26th International Symposium on Physical and Failure Analysis of Integrated Circuits (IPFA), Hangzhou, China, 2–5 July 2019; pp. 1–4. [Google Scholar] [CrossRef]
- Li, Z.; Jiang, J.; He, Z.; Hu, S.; Shi, Y.; Zhao, Z.; He, Y.; Chen, Y.; Lu, G. The Influence of Special Environments on SiC MOSFETs. Materials 2023, 13, 16–18. [Google Scholar] [CrossRef] [PubMed]
- Hanfa, M.; Hoffmannb, F.; Brunkoc, A.; Petersd, J.-H.; Clausnere, S.; Kaminskif, N. Power Cycling Performance of 3.3 kV SiC-MOSFETs and the Impact of the Thermo-Mechanical Stress on Humidity Induced Degradation. Solid State Phenom. 2024, 360, 195–204. [Google Scholar] [CrossRef]
- Ngwashi, D.K.; Phung, L.V. Recent review on failures in silicon carbide power MOSFETs. Microelectron. Reliab. 2021, 123, 114169. [Google Scholar] [CrossRef]
- Chen, Z.; Yao, Y.; Danilovic, M.; Boroyevich, D. Performance Evaluation of SiC Power MOSFETs for High-Temperature Applications. In Proceedings of the 15th International Power Electronics and Motion Control Conference (EPE/PEMC), Novi Sad, Serbia, 4–6 September 2012. pp. DS1a.8-1-DS1a.8-9. [Google Scholar] [CrossRef]
- Lu, X.; Wang, L.; Yang, Q.; Yang, F.; Gan, Y.; Zhang, H. Investigation and Comparison of Temperature-Sensitive Electrical Parameters of SiC mosfet at Extremely High Temperatures. IEEE Trans. Power Electron. 2023, 38, 9660–9672. [Google Scholar] [CrossRef]
- Yao, K.; Yano, H.; Tadano, H.; Iwamuro, N. Investigations of SiC MOSFET Short-Circuit Failure Mechanisms Using Electrical, Thermal, and Mechanical Stress Analyses. IEEE Trans. Electron Devices 2020, 67, 4328–4334. [Google Scholar] [CrossRef]
- Yu, R.; Jahdi, S.; Alatise, O.; Ortiz-Gonzalez, J.; Munagala, S.P.; Simpson, N. Measurements and Review of Failure Mechanisms and Reliability Constraints of 4H-SiC Power MOSFETs Under Short Circuit Events. IEEE Trans. Device Mater. Reliab. 2023, 23, 544–563. [Google Scholar] [CrossRef]
- Chen, J.; Jiang, X.; Li, Z.; Yu, H.; Wang, J. Investigation on Degradation of SiC MOSFET Under Accelerated Stress in PFC Converter. In Proceedings of the IEEE Energy Conversion Congress and Exposition (ECCE), Baltimore, MD, USA, 29 September–3 October 2019; pp. 6174–6178. [Google Scholar] [CrossRef]
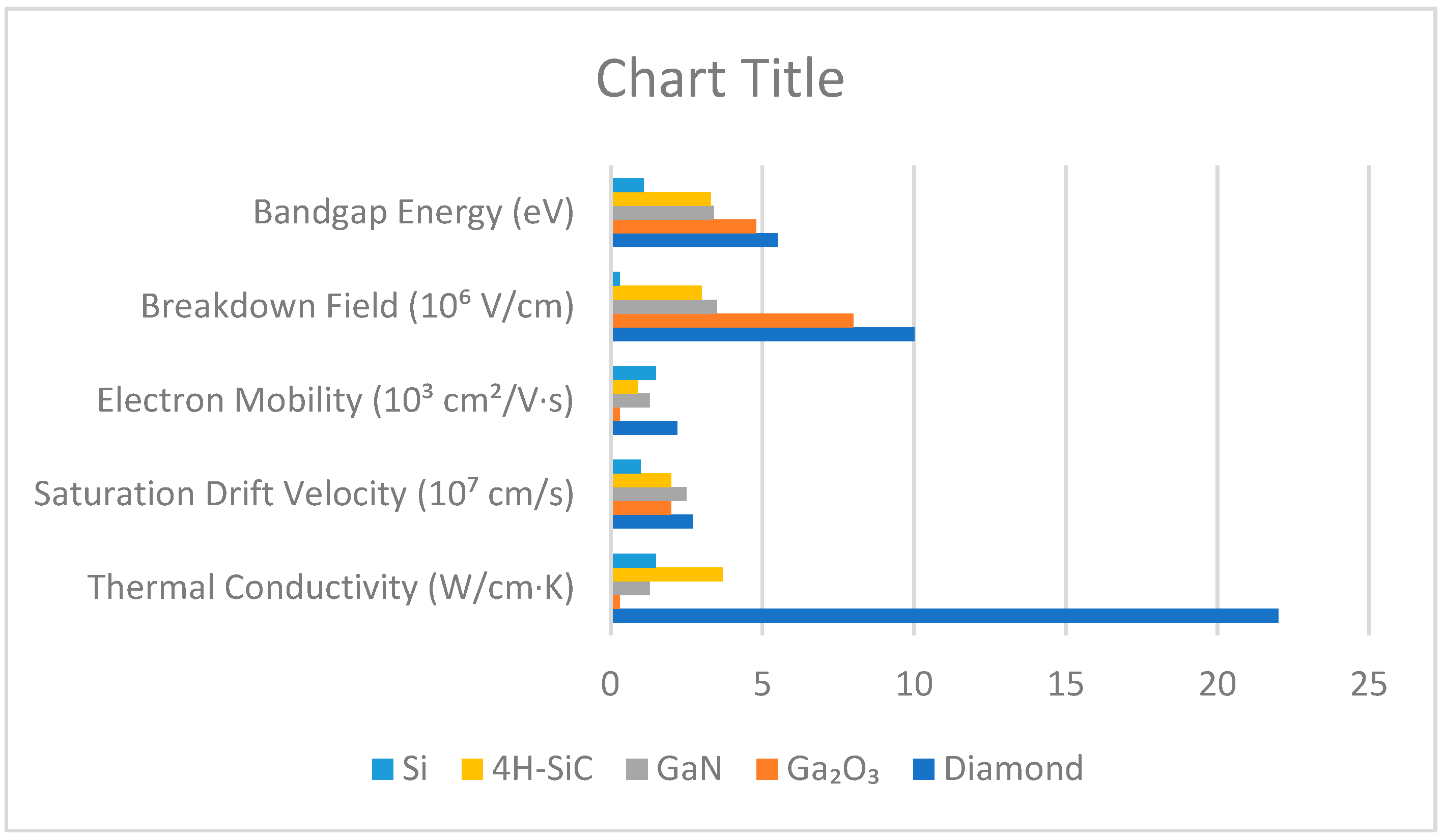

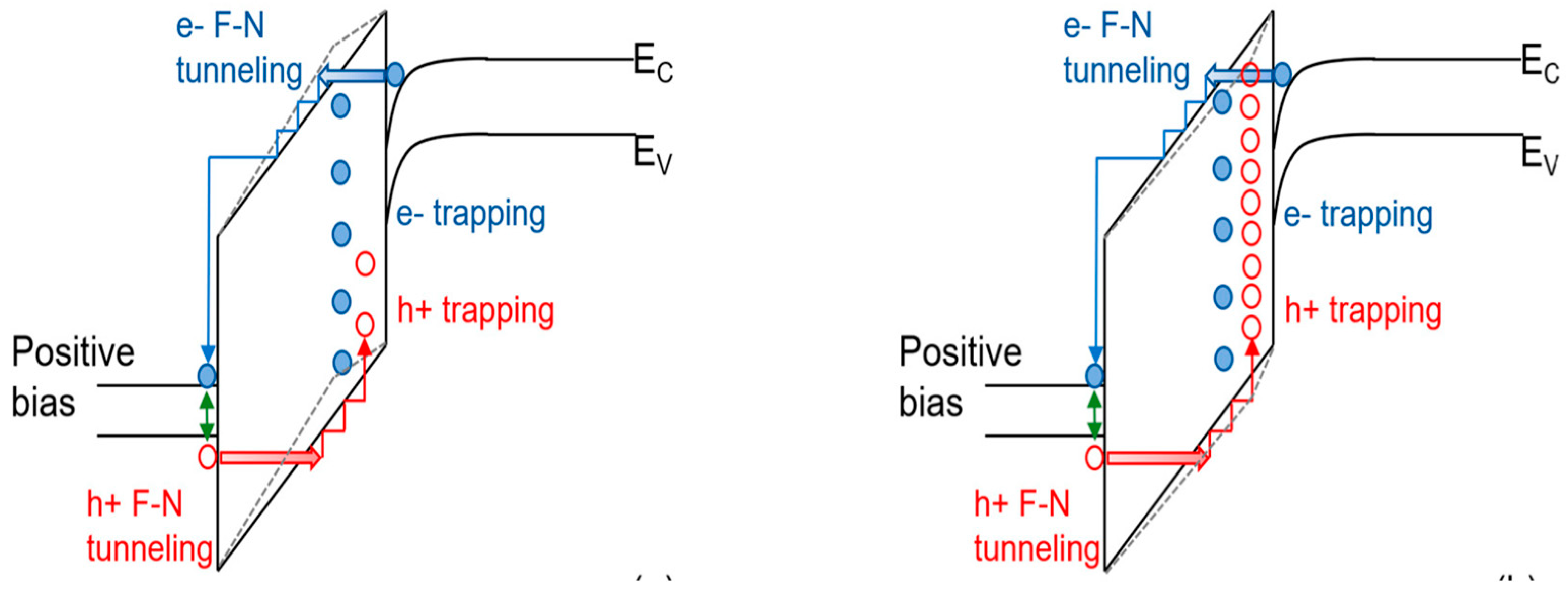
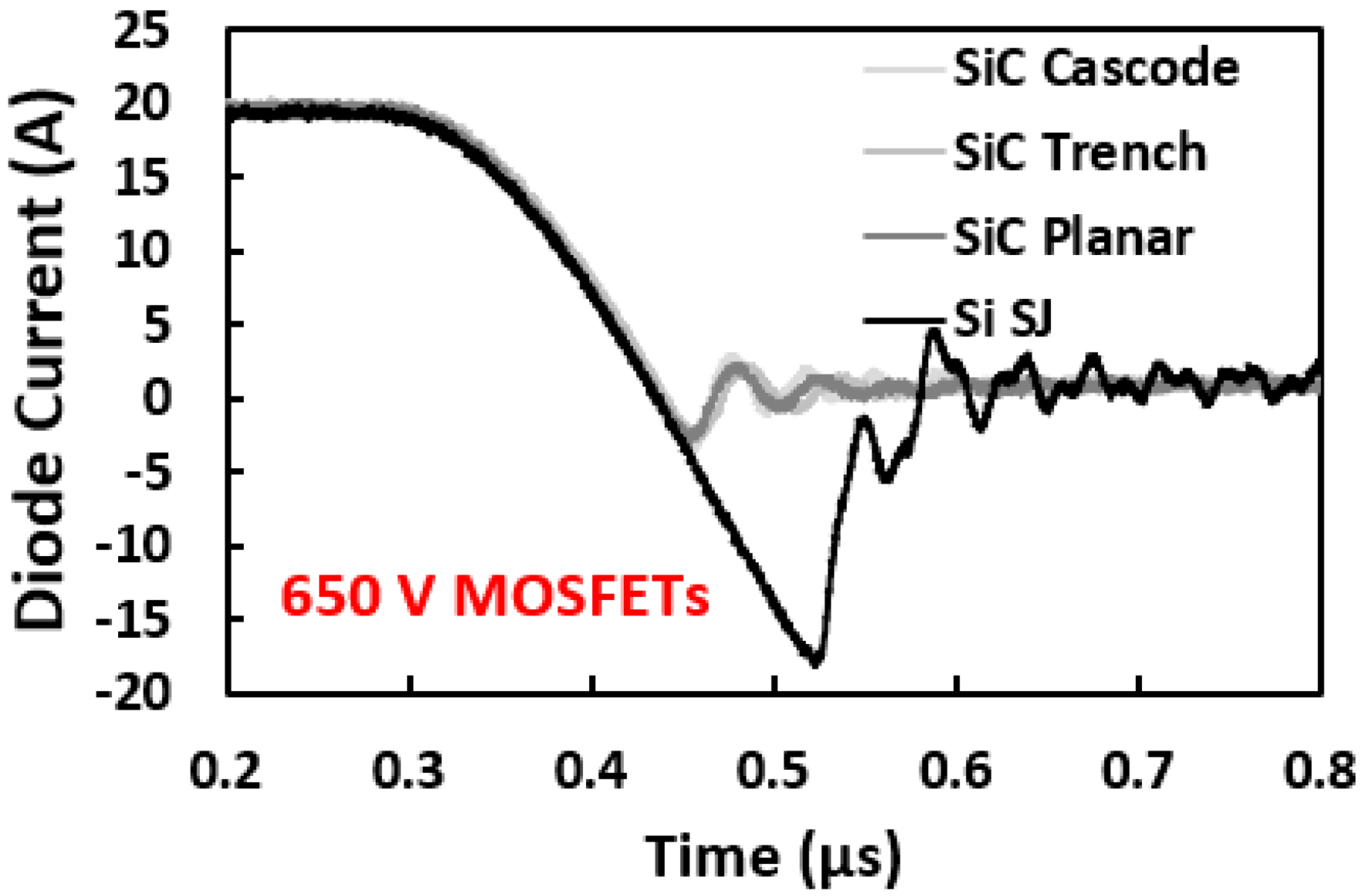
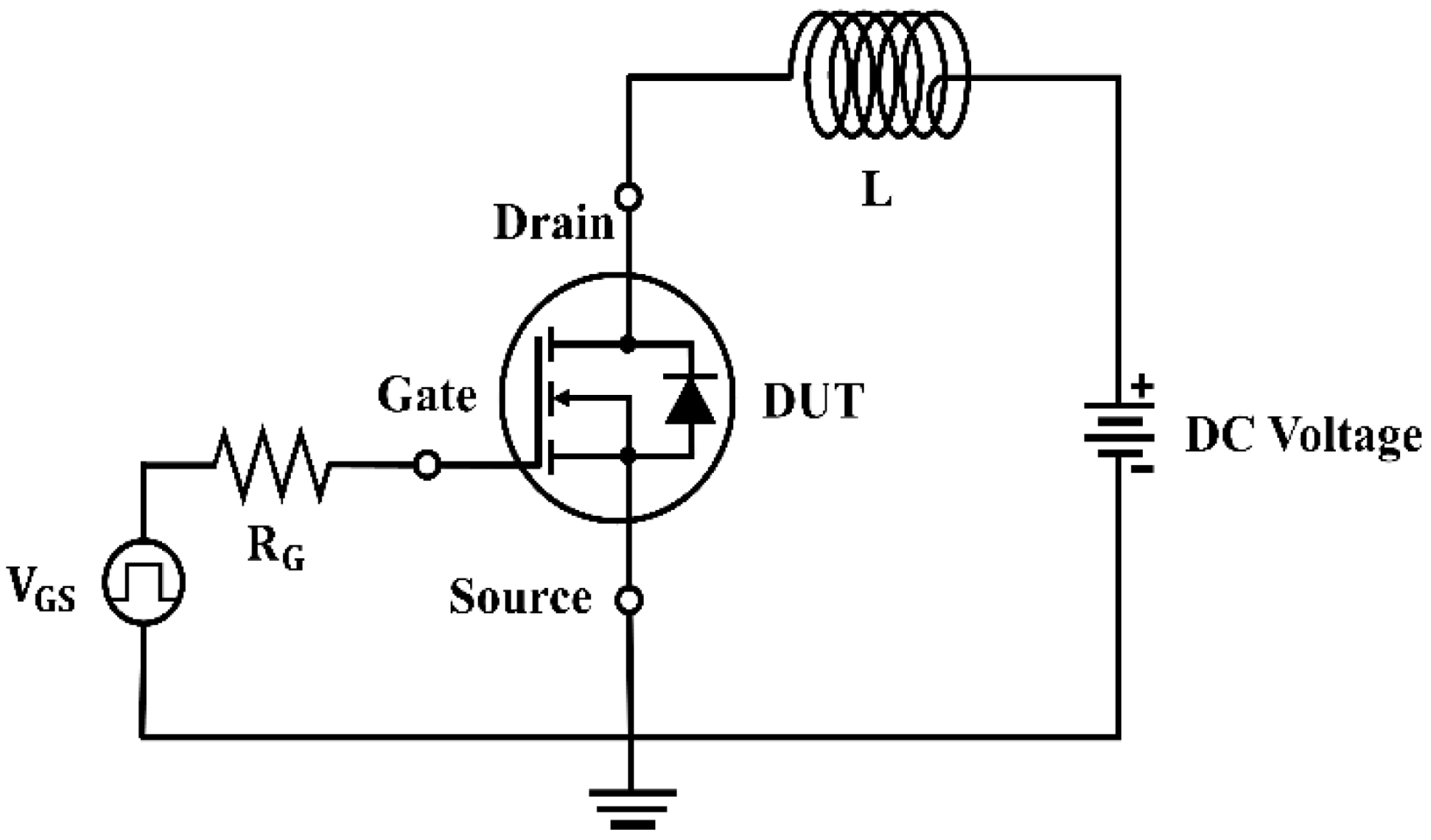
| Properties | Si | 4H-SiC | GaN | Ga2O3 | Diamond |
|---|---|---|---|---|---|
| Bandgap energy | 1.1 | 3.2 | 3.4 | 4.7 | 5.5 |
| Breakdown field (106 V/cm) | 0.3 | 3 | 3.5 | 8 | 13 |
| Electron mobility (103 cm2/V.s) | 1.3 | 0.9 | 1.5 | 0.3 | 2 |
| Saturation drift velocity (107 cm/s) | 1 | 2 | 2.5 | 2 | 1.5 |
| Thermal conductivity (W/cm.k) | 1.5 | 3.7 | 1.3 | 0.1 | 22.9 |
| Property | Si | 3C SiC | 6H SiC | 4H SiC |
|---|---|---|---|---|
| Dielectric constant | 11.8 | 9.7 | 9.7 | 9.7 |
| Energy gap (eV) | 1.12 | 2.39 | 3.03 | 3.26 |
| Critical field Ee (MV/cm) | 0.3 | 1.5 | 3.2 | 3 |
| Electron mobility (cm2/Vs) | 1400 | 750 | 370 | 800 |
| Hole mobility (cm2/Vs) | 600 | 40 | 90 | 115 |
| Electron drift velocity (×107 cm/s) | 1 | 2.5 | 2 | 2 |
| Thermal conductivity (W/cm.K) | 1.5 | 5 | 4.9 | 4.9 |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2025 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Akbar, G.; Di Fatta, A.; Rizzo, G.; Ala, G.; Romano, P.; Imburgia, A. Comprehensive Review of Wide-Bandgap (WBG) Devices: SiC MOSFET and Its Failure Modes Affecting Reliability. Physchem 2025, 5, 10. https://doi.org/10.3390/physchem5010010
Akbar G, Di Fatta A, Rizzo G, Ala G, Romano P, Imburgia A. Comprehensive Review of Wide-Bandgap (WBG) Devices: SiC MOSFET and Its Failure Modes Affecting Reliability. Physchem. 2025; 5(1):10. https://doi.org/10.3390/physchem5010010
Chicago/Turabian StyleAkbar, Ghulam, Alessio Di Fatta, Giuseppe Rizzo, Guido Ala, Pietro Romano, and Antonino Imburgia. 2025. "Comprehensive Review of Wide-Bandgap (WBG) Devices: SiC MOSFET and Its Failure Modes Affecting Reliability" Physchem 5, no. 1: 10. https://doi.org/10.3390/physchem5010010
APA StyleAkbar, G., Di Fatta, A., Rizzo, G., Ala, G., Romano, P., & Imburgia, A. (2025). Comprehensive Review of Wide-Bandgap (WBG) Devices: SiC MOSFET and Its Failure Modes Affecting Reliability. Physchem, 5(1), 10. https://doi.org/10.3390/physchem5010010











