Ripple Formation during Oblique Angle Etching
Abstract
1. Introduction
2. Monte Carlo Simulations
3. Results and Discussion
3.1. Morphology of Oblique Angle Etched (OAE) Surfaces
3.2. Dynamic Evolution Roughness and Ripple Wavelength during OAE
4. Conclusions
Author Contributions
Funding
Acknowledgments
Conflicts of Interest
References
- Zhao, Y.; Wang, G.-C.; Lu, T.-M. Characterization of Amorphous and Crystalline Rough Surface-Principles and Applications; Elsevier: Amsterdam, The Netherlands, 2000. [Google Scholar]
- Leondes, C.T. MEMS/NEMS Handbook; Springer: New York, NY, USA, 2006. [Google Scholar]
- Lüth, H. Solid Surfaces, Interfaces and Thin Films; Springer: Berlin, Germany, 2001. [Google Scholar]
- Karabacak, T.; Wang, G.-C.; Lu, T.-M. Physical self-assembly and the nucleation of three-dimensional nanostructures by oblique angle deposition. J. Vac. Sci. Technol. A Vac. Surf. Film 2004, 22, 1778–1784. [Google Scholar] [CrossRef]
- Antartis, D.A.; Mott, R.N.; Chasiotis, I. Silicon nanosprings fabricated by glancing angle deposition for ultra-compliant films and interfaces. Mater. Des. 2018, 144, 182–191. [Google Scholar] [CrossRef]
- Karabacak, T.; Lu, T. Shadowing growth and physical self-assembly of 3D columnar structures. In Handbook of Theoretical and Computational Nanotechnology; Rieth, M., Schommers, W., Eds.; American Scientific Publishers: Stevenson Ranch, CA, USA, 2005; pp. 729–779. [Google Scholar]
- Lu, T.-M.; Zhao, Y.-P.; Drotar, J.; Karabacak, T.; Wang, G.-C. Novel mechanisms on the growth morphology of films. MRS Online Proc. Libr. Arch. 2002, 749. [Google Scholar] [CrossRef]
- Pelliccione, M.; Karabacak, T.; Lu, T.-M. Breakdown of dynamic scaling in surface growth under shadowing. Phys. Rev. Lett. 2006, 96, 146105. [Google Scholar] [CrossRef]
- Karabacak, T.; Zhao, Y.-P.; Wang, G.-C.; Lu, T.-M. Growth-front roughening in amorphous silicon films by sputtering. Phys. Rev. B 2001, 64, 085323. [Google Scholar] [CrossRef]
- Yuksel, M.; Karabacak, T.; Guclu, H. Networking behavior in thin film and nanostructure growth dynamics. In Proceedings of the 2nd international conference on Nano-Networks, Catania, Italy, 24–26 September 2007; ICST: Brussels, Belgium, 2007. [Google Scholar]
- Li, L.; Zhang, C.; Tuan, C.-C.; Chen, Y.; Wong, C. High-aspect-ratio microstructures with versatile slanting angles on silicon by uniform metal-assisted chemical etching. J. Micromech. Microeng. 2018, 28, 055006. [Google Scholar] [CrossRef]
- Drotar, J.T.; Zhao, Y.-P.; Lu, T.-M.; Wang, G.-C. Mechanisms for plasma and reactive ion etch-front roughening. Phys. Rev. B 2000, 61, 3012. [Google Scholar] [CrossRef]
- Zhao, Y.-P.; Drotar, J.T.; Wang, G.-C.; Lu, T.-M. Roughening in plasma etch fronts of Si(100). Phys. Rev. Lett. 1999, 82, 4882. [Google Scholar] [CrossRef]
- Karabacak, T.; Guclu, H.; Yuksel, M. Network behavior in thin film growth dynamics. Phys. Rev. B 2009, 79, 195418. [Google Scholar] [CrossRef]
- Karabacak, T. Thin-film growth dynamics with shadowing and re-emission effects. J. Nanophotonics 2011, 5, 052501. [Google Scholar] [CrossRef]
- Boyd, G.D.; Coldren, L.A.; Storz, F.G. Directional reactive ion etching at oblique angles. Appl. Phys. Lett. 1980, 36, 583–585. [Google Scholar] [CrossRef]
- Umbach, C.C.; Headrick, R.L.; Chang, K.-C. Spontaneous nanoscale corrugation of ion-eroded sio 2: The role of ion-irradiation-enhanced viscous flow. Phys. Rev. Lett. 2001, 87, 246104. [Google Scholar] [CrossRef]
- Vourdas, N.; Kontziampasis, D.; Kokkoris, G.; Constantoudis, V.; Goodyear, A.; Tserepi, A.; Cooke, M.; Gogolides, E. Plasma directed assembly and organization: Bottom-up nanopatterning using top-down technology. Nanotechnology 2010, 21, 085302. [Google Scholar] [CrossRef]
- Martin, M.; Cunge, G. Surface roughness generated by plasma etching processes of silicon. J. Vac. Sci. Technol. B Microelectron. Nanom. Struct. Meas. Phenom. 2008, 26, 1281–1288. [Google Scholar] [CrossRef]
- Memos, G.; Lidorikis, E.; Kokkoris, G. Roughness evolution and charging in plasma-based surface engineering of polymeric substrates: The effects of ion reflection and secondary electron emission. Micromachines 2018, 9, 415. [Google Scholar] [CrossRef]
- Ono, K.; Nakazaki, N.; Tsuda, H.; Takao, Y.; Eriguchi, K. Surface morphology evolution during plasma etching of silicon: Roughening, smoothing and ripple formation. J. Phys. D Appl. Phys. 2017, 50, 414001. [Google Scholar] [CrossRef]
- Nakazaki, N.; Matsumoto, H.; Sonobe, S.; Hatsuse, T.; Tsuda, H.; Takao, Y.; Eriguchi, K.; Ono, K. Ripple formation on Si surfaces during plasma etching in Cl2. AIP Adv. 2018, 8, 055027. [Google Scholar] [CrossRef]
- Cansizoglu, M.F.; Karabacak, T. Engineering morphology of surfaces by oblique angle etching. MRS Online Proc. Libr. Arch. 2007, 1059. [Google Scholar] [CrossRef]
- Yurukcu, M. An Investigation of Conformality of the Core-shell Polymer Electrolyte Membrane (PEM) Fuel Cell Catalysts by Sputter Deposition. Ph.D. Thesis, University of Arkansas, Little Rock, AR, USA, May 2018. [Google Scholar]
- Yurukcu, M.; Cansizoglu, H.; Cansizoglu, M.; Karabacak, T. Conformality of PVD shell layers on vertical arrays of rods with different aspect ratios investigated by monte carlo simulations. MRS Adv. 2017, 2, 465–470. [Google Scholar] [CrossRef]
- Cansizoglu, H.; Yurukcu, M.; Cansizoglu, M.; Karabacak, T. Investigation of physical vapor deposition techniques of conformal shell coating for core/shell structures by monte carlo simulations. Thin Solid Films 2015, 583, 122–128. [Google Scholar] [CrossRef]
- Karabacak, T.; Wang, G.-C.; Lu, T.-M. Quasi-periodic nanostructures grown by oblique angle deposition. J. Appl. Phys. 2003, 94, 7723–7728. [Google Scholar] [CrossRef]

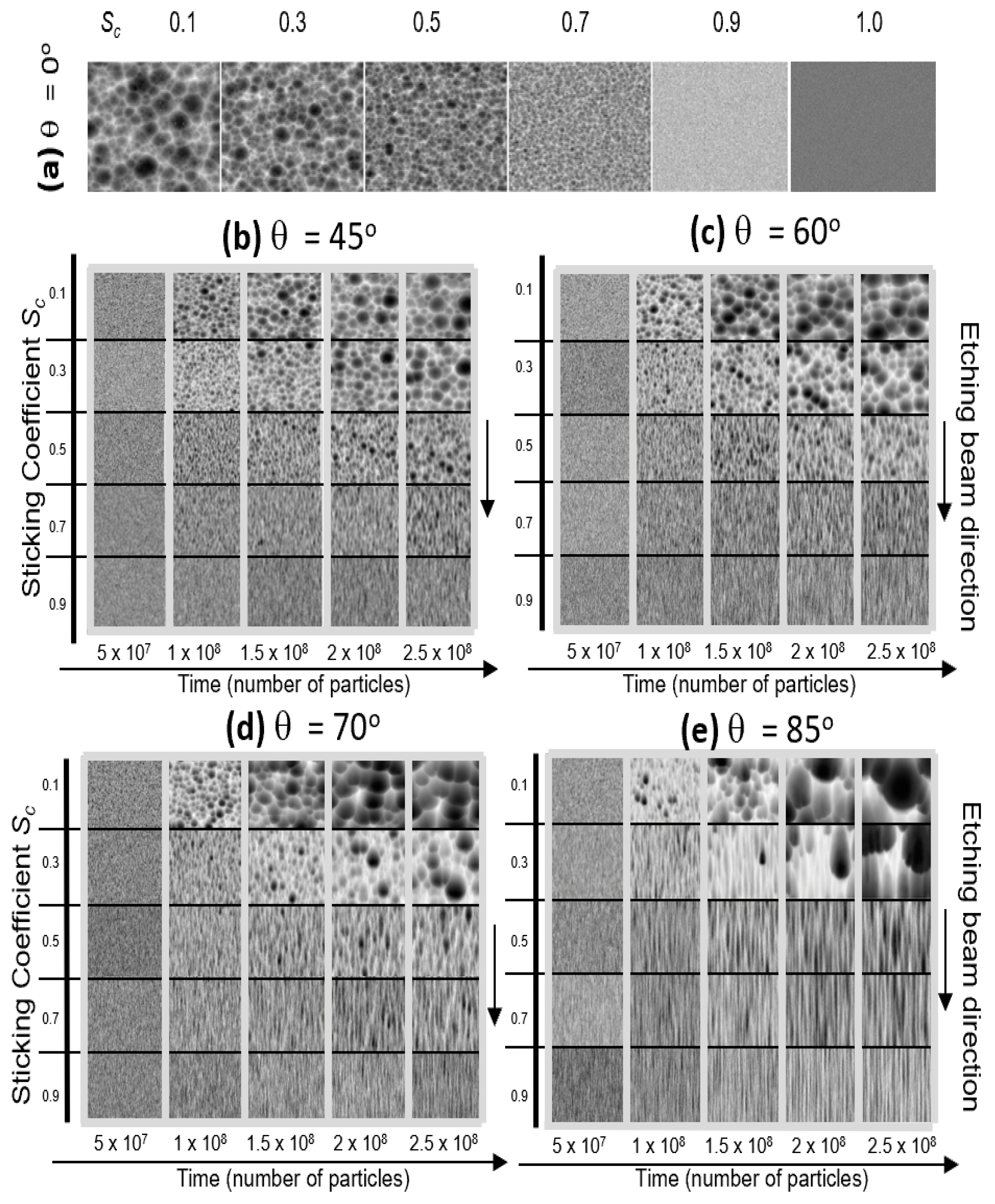
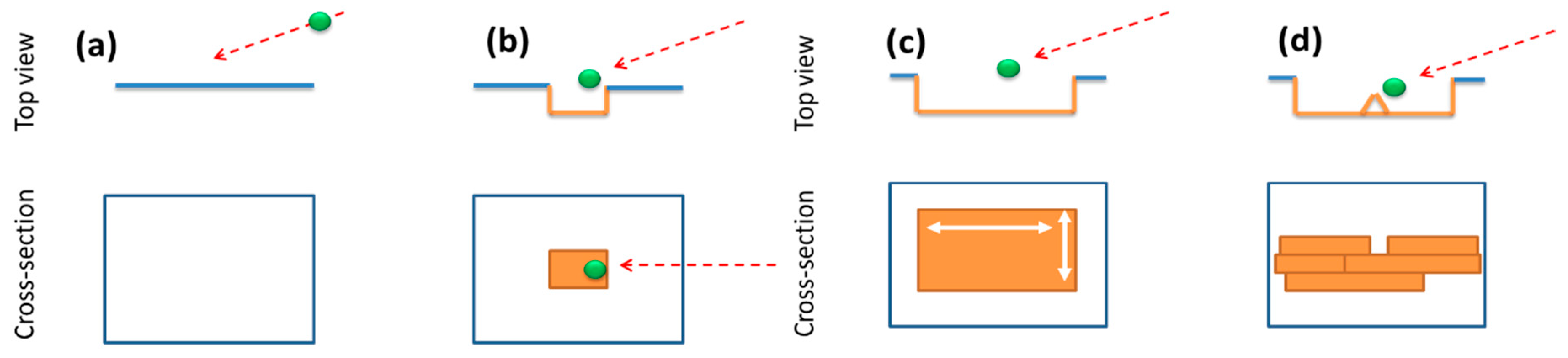

© 2019 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Cansizoglu, M.F.; Yurukcu, M.; Karabacak, T. Ripple Formation during Oblique Angle Etching. Coatings 2019, 9, 272. https://doi.org/10.3390/coatings9040272
Cansizoglu MF, Yurukcu M, Karabacak T. Ripple Formation during Oblique Angle Etching. Coatings. 2019; 9(4):272. https://doi.org/10.3390/coatings9040272
Chicago/Turabian StyleCansizoglu, Mehmet F., Mesut Yurukcu, and Tansel Karabacak. 2019. "Ripple Formation during Oblique Angle Etching" Coatings 9, no. 4: 272. https://doi.org/10.3390/coatings9040272
APA StyleCansizoglu, M. F., Yurukcu, M., & Karabacak, T. (2019). Ripple Formation during Oblique Angle Etching. Coatings, 9(4), 272. https://doi.org/10.3390/coatings9040272






